RSD二维数值模拟与预充过程分析
2012-09-16余岳辉冯仁伟
余岳辉 冯仁伟 梁 琳
(华中科技大学电子科学与技术系 武汉 430074)
1 引言
反向开关晶体管(Reversely Switched Dynistor,RSD)是一种基于借助可控等离子体层开通原理[1-4]的新型脉冲功率半导体器件。采用多元胞并联结构的RSD(见图1,RSD中含有大量的p+npn+与n+np单元)具有全面积开通、高 di/dt(可达 105A/μs)耐量的特点。同时作为两端器件,RSD无第三控制电极的特点使得其控制电路相对简单,同步开通一致性很好,易于组建高压堆体。因此在国防、高能物理、环保等领域有着广泛的应用潜力。

图1 RSD结构Fig.1 Structure of RSD
前苏联约飞物理科学研究院Grekhov等人首先提出了RSD器件工作机理[1],并基于大注入等离子体理论,给出了RSD的基本工作原理和一维物理模型[2-4]。文献[5]在此基础上考虑了强电场效应(迁移率随电场的变化)、载流子寿命和碰撞电离过程,建立了RSD基区等离子体分布的一维数值模型,并通过Matlab联立外电路模拟了器件的预充和开通过程。
以上理论和模型都是基于大注入等离子体理论的一维模型,而RSD作为一种具有多元胞并联结构(阴极和阳极都存在短路点结构)的器件很难使用一维模型分析短路点对其特性的影响[6],例如电流集中现象和载流子横向分布扩散现象等。同时,器件基区以外的区域在很大程度上工作在非大注入状态,再者器件的预充前期,电流换流过程和器件关断过程都可能出现器件内部载流子浓度过低或出现横向分布不均等一维大注入模型不能解释的现象[7]。因此,为了更深入的了解RSD器件的工作原理,需要建立适合各种注入状态的二维器件模型。
本文在考虑了载流子复合、产生、碰撞电离等诸多效应的基础上,通过联合求解半导体器件的基本方程和外电路方程获得了 RSD器件电压电流波形和器件内部载流子的分布数据。在此基础上,本文也分析和讨论了预充过程器件内部电流密度和载流子的分布。
2 RSD工作原理
RSD器件可视为电流控制的两端器件,如图2所示为RSD典型工作电路图。

图2 RSD典型工作电路Fig.2 Typical working circuit for RSD
RSD工作时,首先通过并联在 RSD两端的预充电路产生一个反向预充电流。此电流通过RSD的n+np单元由两端向基区注入载流子,使得器件内部形成一个等离子体源。而此时主电压被非线性开关(见图 2磁开关 MS)阻断。预充过程结束后,非线性开关打开(对应磁开关饱和,其感抗由趋于无穷大降低到可以忽略的量级),主电流通过RSD并使其电流换向。此开通换流过程前期对应的n+np单元有类似于二极管关断过程,但是由于RSD两端发射极的存在(对应p+npn+单元)使得器件在短时间内可以由发射极两端向基区注入载流子,从而使得基区等离子体得到补充和增加。这样RSD不会像普通二极管一样关断,而是可以保持在一个较低的电阻率,从而具有低损耗的特性。同时由于开通前等离子体在预充阶段已分布较为均匀,因此器件可在全面积开通,拥有高di/dt耐量。
由上可知,RSD必须在反向通过一定量的预充电流后才可通过一个高di/dt的正向电流。其正常工作的关键在于:①预充电流在基区产生足够多的等离子体。②电流换向过程中,减少的载流子能及时得到发射极注入的补充。
3 RSD器件二维数值模型
3.1 RSD器件模型
描述半导体器件内部载流子的基本方程主要有:泊松方程如式(1),载流子连续性方程如式(2)、式(3)和电流密度方程如式(4)、式(5)[8,9],以下方程中参数可参见文献[8,9]。


式中,n、p分别表示电子和空穴浓度;、分别为施主和受主掺杂浓度;E为电场强度;φ为电压;G为载流子产生率;R为载流子复合率;μn、μp分别表示电子和空穴的迁移率;Dn、Dp表示电子和空穴的扩散系数;q为电子电荷常数;ε为半导体材料介电系数。
全电流如式(6)为电子电流、空穴电流和位移电流之和,在瞬态器件数值分析与泊松方程作用等价。

另外,考虑电场和载流子间散射的迁移率模型采用式(7)。

载流子复合((Shockley Read Hall,SRH)复合与俄歇复合)与碰撞电离分别采用如下模型

如图3所示的元胞结构,其中x方向为器件电极方向,片厚380μm;y方向为器件径向,宽100μm。仿真器件有效面积为1.54cm2,n基区采用均匀掺杂7.10×1013cm-3,其他区域通过扩散形成,采用高斯分布近似。p基区表面掺杂浓度为1×1019cm-3,结深80μm;阳极短路点与阴极n+表面掺杂浓度为1×1021cm-3,结深20μm;阳极p+表面掺杂浓度为1×1017cm-3,结深10μm。另外阴阳极短路点面积比分别约为4%和8%。

图3 RSD模拟元胞结构Fig.3 Cell structure of RSD for simulation
使用 Scharfetter-Gummel指数格式的电流密度方程[9],并将其带入载流子连续性方程后与泊松方程共同构成描述器件模型的微分方程组。
在器件两电极边界重掺杂处(x=0处n+与p+,x=wrsd处n+区域)采用理想欧姆接触边界条件假设。而阴极短路点区域由于掺杂浓度较低,既不能视为理想欧姆接触也不能简单的视为肖特基接触[10],本文采用在换流时增加一个串联电阻的方式简化其模型。在径向方向(y方向)使用对称周期性边界条件。
在二维区域采用有限差分的方法将微分方程组转换成网格点非线性方程组。在给定外电压边界条件下,利用牛顿迭代法耦合求解非线性方程组[11-12],可获得满足电压变化条件下的任意时刻载流子分布和电势分布数据,最终可计算出电流密度分布从而获得流过器件的电流值。
3.2 RSD外电路模型
RSD器件仿真电路如图4所示,其参数由实验电路提取。其中MS采用理想化磁开关(预充阶段断开,延迟 1.2μs后接通开关),图中Lm=1.5μH,Cm=10μF,Rm=0.6Ω,Li=0.2μH,Ri=1.4Ω,CC=0.25μF,LC=4μΗ,电路初始值设置为Um=1 200V,Im=0A,URSD0=0V,IRSD0=0A,UC0=0V,IL0=270A。

图4 RSD谐振触发开通电路Fig.4 Circuit of RSD with resonant triggering method
对于瞬态问题的联合求解,首先采用Runge-Kutta方法预测RSD器件电流。然后通过线性外推的方法获取初始试探电压,利用器件模型迭代获得对应的模型电流值。再根据器件模型电流值和外电路模型电流值利用 Newton迭代的方法修正外加电压。以此方法循环迭代,直到最后获得同时满足器件内部模型和外电路模型的数值解。
4 结果分析讨论
4.1 实验数据与仿真数据对比
实验与仿真波形对比如图5与图6所示。其中虚线为仿真波形,实线为实验波形。总体上,实验与仿真波形符合得较好。仿真电压预充阶段峰值偏小,主要原因在于测量支路电感的存在使得测量值偏大同时仿真模型没有充分考虑 RSD两端接触阻抗。仿真模型计算得到的开通电压峰值约为8.37V,而实验波形峰值为 7.20V。其原因在于阴极处短路点p掺杂浓度较低(为1×1017cm-3)且与n+区域形成连接在同一电极上的pn结,实际模型非常复杂。采用本文简化的阴极短路点接触模型仍会在器件开通换流初期产生比实际情况大的抽取电流(pn结内建电势使得阴极 p区电势低与 n+区)。从而使得 p基区的载流子浓度的减少量增加,导致换流阶段出现电压较大的情形。而随着正向电流的增大阴极发射区注入增加,相对而言抽取电流比例减小,注入量远大于抽取量,因此电压下降到一个较为合理的值。模型仿真电流在预充阶段和换流初期与实验波形重合,而由于磁开关的非线性导致开通后实验波电流形存在一个拐点,这也可能是由测量工具误差引起的相位偏移。另外电路寄生参数提取不准确也是导致电流波形不一致的原因之一。
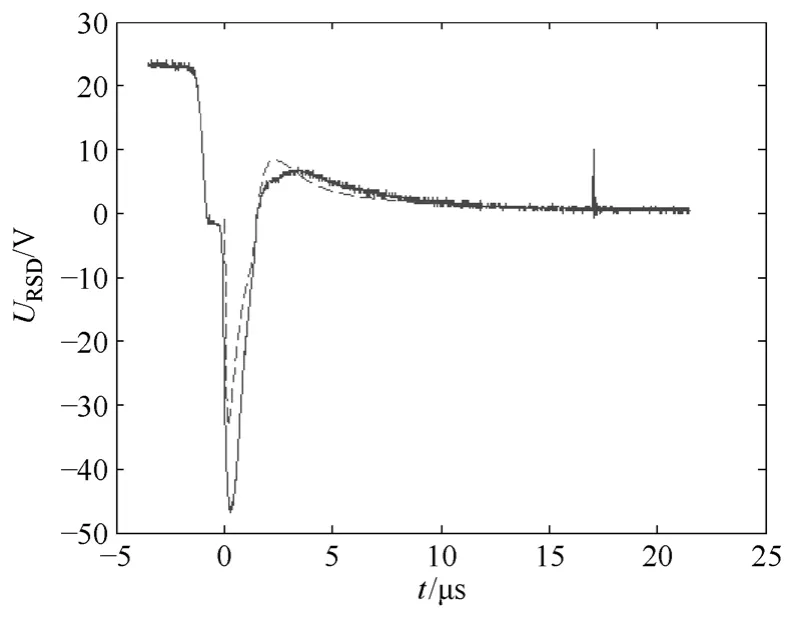
图5 实验与仿真电压波形Fig. 5 Experimental and simulated waveforms of voltage

图6 实验与仿真电流波形Fig.6 Experimental and simulated waveforms of current
4.2 预充过程分析
如图7所示为预充开始后250ns时间范围内器件内部的自由电子和空穴的横向平均浓度分布数据,其时间间隔约为25ns。其中虚线n为电子分布,实线p为空穴分布。

图7 载流子平均浓度分布Fig.7 Distributions of average concentrations of carriers
当预充电压加到RSD两端后,阴极电流由两部分组成:一部分由短路点经p基区从J2结向n基区注入空穴;另一部分表现为J3结空间电荷区展宽的结电容放电电流,该电流从阴极n发射区抽取J3的n侧电子,同时由p基区抽取p侧空穴,从而使得空间电荷区展宽。阳极区域有类似的结电容放电电流。此时,在J2结两端分别有横向(y方向)分布较均匀的电子空穴注入,其过程类似普通 pin二极管开通时的注入。
随着电压的增加,在J2结处首先形成浓度较高的等离子体区域,而n基区其他区域仅有少量注入。同时在阳极短路点n+与基区n形成的高低结区域也有相对其他 n基区较高浓度的等离子体薄层形成(如图7中靠近阳极处的空穴分布尖峰),而J2结的等离子体层前沿离这层等离子体薄层仍很远。另外,复合成分中SRH分量开始增加,但相比注入较小。
随着预充时间的增加,等离子体层分别向两个发射结移动。当等离子体层前沿到达发射结时(到达 J1结约为 100ns,到达 J3结约为 25ns),两个发射结将出现穿通击穿,空间电荷区不再展宽。阳极发射区(p+)和阴极发射区(n+)电流分别抽取 n基区和p基区临近发射结边缘的空穴和电子。尤其是两个发射区(阴极和阳极)与短路点交界处附近,由于等离子体浓度相对其他区域多很多,这些区域出现较大的抽取电流密度。如图8所示为500ns时刻器件两端全电流密度分布图,此时对应的电流值为-188.5A。图中JA为阳极全电流密度,JK为阴极全电流密度。从图可见阴阳极短路点发射极附近都出现较大的穿通抽取电流,同时发射极其他区域也有相对较小的抽取电流出现。抽取电流的引入不但不注入载流子,反而会抽取预充电荷使之减少。
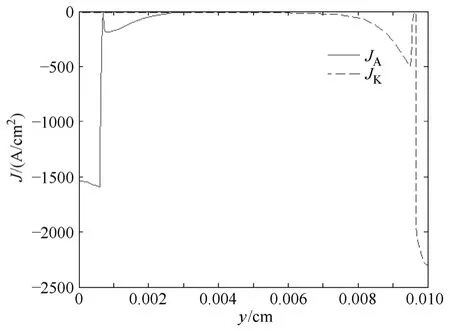
图8 阴阳极电流密度分布(t=500ns)Fig.8 Current density distribution at anode and cathode at t=500ns
随着电流增大,短路点区域出现电流集中现象,尤其是阴极短路点区域电流密度已超过 2 000A/cm2。随着等离子体层到达阳极的重摻杂短路点n+区域,俄歇复合迅速增强,导致注入效率降低。如图9所示为 500ns时刻对应的复合率二维分布图,从图可知复合峰值出现在阳极短路点区域,其值为 4.15×1022s/cm3。这也必然使得RSD预充阶段有效过剩载流子大量减少。
以往的模型都忽略了载流子的俄歇复合和发射极的抽取电流对预充阶段注入电荷的影响,在实验电路设计中也常常直接使用预充电流的积分值推测预充电荷总量。图 10为 n基区注入的多余电子量Qnn、pn基区电子增加量总和Qnnp和电流时间积分值Qi随时间变化的曲线。从图中可知基区预充电荷量(Qnn或者Qnnp,此处采用电子量代替电荷量,因大注入后电子与空穴量基本相等)比电流积分值少很多。在预充结束时(tc=1.54μs),pn基区过剩电子量仅为电流积分量的24.75%。显然以上讨论的两个效应大大减少了预充电荷总量,以至于直接采用电流时间积分值的近似做法不可取。而大量实验也发现预充电流积分值通常要大于文献[13]中提到的临界预充电荷量数倍。

图9 复合率分布(t=500ns)Fig.9 Recombination distribution at t=500ns

图10 基区注入载流子(电子)量Fig.10 Quantities of carriers(n)
预充结束时,等离子体分布在J2结附近非常均匀而阳极区域存在较大的不均匀性。RSD器件正向开通时器件电流换向,此时短路点处将产生较大的抽取电流。此抽取电流使得基区等离子体由两侧开始减少。阳极附近等离子体虽然在预充刚结束时存在较大的分布不均匀性,但较薄的发射极可以在短时间内注入空穴补充和增加等离子体的浓度,因此可获得较均匀的开通。而阴极由于p基区和n+发射区较宽,载流子补充延迟使得器件容易出现等离子体耗尽电场增加,甚至电流集中烧损器件的现象。同时应该注意的是n基区的过剩载流子在整个电流换向过程中几乎没有减少,而p基区的载流子减少很快(见图10Qnn在换流时基本保持不变)。因此相比 n基区而言,p基区参数对整个开通过程性能影响更大。以往忽略p基区结构分布直接对n基区进行分析的一维pin模型[5]会存在较大的误差。
5 结论
本文基于半导体基本方程建立了 RSD器件的二维数值模型。结合实验电路建立了外电路数值模型并连同器件模型求解获得了器件电压电流波形和器件内部载流子分布变化数据。仿真瞬态数据表明预充过程中存在显著的载流子复合效应,同是短路点区域也存在大量的发射极抽取电流,这两个效应将大大减少RSD基区有效预充电荷总量。因此,不宜直接使用电流时间积分值代替RSD预充电荷量。
[1]Grekhov I V, Gorbatyuk A V, Kostina L S, et al.Superpower switch of microsecond range[J]. Solid State Electronics, 1983, 26(11): 1132.
[2]Gorbatyuk A V, Grekhov I V, Nalivkin A V. Theory of quasi-diode operation of reversely swithed dinistors[J].SolidState Electronics, 1988, 31(10): 1483-1491.
[3]Grekhov I V. New principles of high power switching with semiconductor devices[J]. Solid State Electronics,1989, 32(11): 923-930.
[4]Grekhov I V, Mesyats G A. Physical basis for highpower semiconductor nanosecond opening switches[J].IEEE Transactions on Plasma Science, 2000, 28(5):1540-1544.
[5]邓林峰, 余岳辉, 彭亚斌, 等. 反向开关复合管的物理模型与数值方法实现[J]. 半导体学报, 2007,28(6): 931-937.
Deng Linfeng, Yu Yuehui, Peng Yabin, et al. Physical model and numerical algorithm realization for RSD[J].Chinese Journal of Semiconductors, 2007, 28(6):931-937
[6]Jankovic N, Pesic T, Igic P. All injection level power PiN diode model including temperature dependence[J].Solid State Electronics, 2007, 51(5): 719-725.
[7]Lisik Z, Turowski M. Two-dimensional simulation of thyristor transient states from conduction to forward blocking[J]. IEE Proceedings-G, 1991, 138(5):575-581.
[8]赛尔勃赫 S. 半导体器件的分析与模拟[M]. 阮刚,等译. 上海:上海科学技术文献出版社, 1988.
[9]仓田卫. 半导体器件的数值分析[M]. 张光华, 译.北京: 电子工业出版社, 1985.
[10]Schroeder D. An analytical model of non-ideal ohmic and schottky contacts for device simulation[J].Simulation of Semiconductor Devices and Processes,1991, 4: 313-319.
[11]伯登, 费尔斯. 数值分析[M]. 冯烟利, 朱海燕, 译.北京: 高等敎育出版社, 2005.
[12]李中杰, 李永东, 王洪广, 等. 半导体断路开关电路-流体耦合数值模拟[J]. 强激光与粒子束, 2010,22(6): 1411-1414.
Li Zhongjie, Li yongdong, Wang Hongguang. Numerical simulation of semiconductor opening swich with circuit-fluid coupled model[J]. High Power Laser and Particle Beams, 2010, 22(6): 1411-1414.
[13]杜如峰, 余岳辉, 胡乾, 等. 预充电荷对 RSD 开通特性的影响[J]. 电力电子技术, 2003, 37(50): 84-86.
Du Rufeng, Yu Yuehui, Hu Qian, et al. Influence of pre-charge upon RSD turn-on character[J]. Power Electronics, 2003, 37(50): 84-86.
