4H-SiC 基FinFET 器件的单粒子瞬态效应研究*
2022-12-03刘保军杨晓阔陈名华
刘保军,杨晓阔,陈名华
(1.空军工程大学航空机务士官学校,河南信阳 464000;2.空军工程大学基础部,西安 710051)
1 引言
FinFET 器件具有很好的扩展性和静电特性,有望成为替代主流CMOS 的新型器件之一[1-2]。随着空间技术、核科学的快速发展,先进电子器件被广泛应用于航空、航天等空间辐射环境中。高能粒子入射器件敏感区可能会诱发单粒子效应(SEE),造成电路故障甚至损坏。随着器件特征尺寸的不断缩减,单粒子瞬态(SET)效应已成为空间辐射环境中对集成电路可靠性的主要威胁之一[3-4]。
SiC 作为继Si 和GaAs 之后的第三代半导体材料,具有高击穿电场、高载流子饱和漂移速度和高热导率等优点[5]。SiC 材料的宽禁带和高原子临界位移能,使得其器件具有较强的抗电磁波冲击和抗辐射破坏的能力,特别是SiC 基的功率MOSFET 器件,表现出良好的抗单粒子栅穿(SEGR)和单粒子烧毁(SEB)性能。刘忠永等[5-6]研究了晶圆各向异性、超结和半超结、高介电常数k 栅介质及电荷失配等对功率MOSFET 的SEB 和SEGR 的影响,研究发现,4H-SiC材料的抗SEB 和抗SEGR 的综合性能更优。LU 等[7]分析了几种缓冲层结构对SiC 功率MOSFET 器件SEE的影响,研究了重离子撞击后的瞬态响应机理。于庆奎等[8]研究了SiC 高压功率MOSFET 和二极管SEE的敏感性,辐照实验表明,重离子会使得SiC 功率器件内部产生永久损伤,引起漏电流增加甚至烧毁器件。MCPHERSON 等[9]通过重离子输运物理分析和建模,直观展示了SiC 功率器件的能量沉积和电荷产生过程。AKTURK 等[10]研究了Si 基和SiC 基功率器件的中子诱导单粒子失效机理,发现与Si 相比,SiC 由中子诱导的失效率较低,但暴露在类地面谱的中子环境中会出现灾难性失效。张鸿等[11-12]开展了SiC 功率MOSFET 的SEB 辐照实验和TCAD 仿真,发现器件外延层的电场强度越大,重离子受电场作用在外延层运动的路径越长、沉积能量越多。尚也淳[13]认为,由于SiC 的禁带宽度比Si 的禁带宽度高2~3 倍,即产生1个电子空穴对所需的能量更高,从而使得SiC 器件抗SEE 的能力比Si 强。
虽然国内外针对SiC 功率MOSFET 器件的SEE开展了一些研究,但关于SiC 基FinFET 器件的SET效应目前鲜有报道。因此,本文对SiC 基FinFET 器件电荷收集机理和瞬态电流产生机制开展了研究,对新型先进器件在恶劣辐射环境中高可靠性的应用具有一定的理论指导意义。
2 器件结构及模型校准
本研究以n 型14 nm SOI“高k 栅”Si 基FinFET器件为基础,构建其3D 仿真模型,并与实验数据进行电学特性校准,FinFET 器件模型及电学特性如图1 所示,其中IDS为漏源电流,VDS为漏源电压,VGS为栅源电压。在此模型的基础上,将Fin 的Si 材料替换为4H-SiC 材料,设置材料参数,构建4H-SiC 基FinFET的仿真模型,器件参数如表1 所示。仿真用的物理模型包括与掺杂浓度和高k 栅介质相关的迁移率退化模型、飞利浦标准化迁移率模型、高电场饱和模型、能带隙和电子亲和性模型、BQP(Bohm Quantum Potential)模型、SRH(Shockley-Read-Hall)和Auger 重组模型、费米统计模型及重离子辐射模型等[14],材料参数如表2所示。

表1 14 nm n 型4H-SiC FinFET 器件的参数设置

表2 4H-SiC 材料参数设置
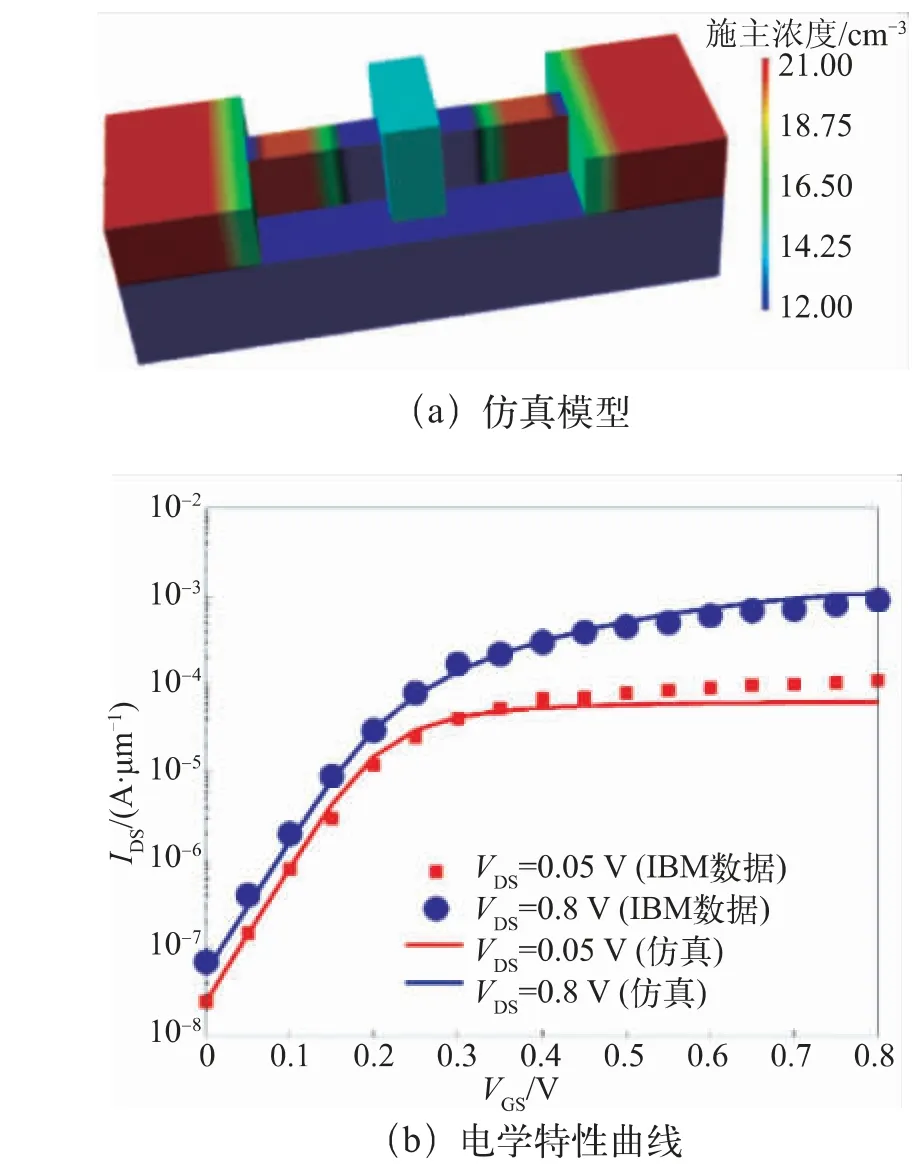
图1 FinFET 器件模型及电学特性
3 器件的SET 效应
在进行器件的SET 仿真时,设置高能粒子垂直入射器件源栅中间的Fin 敏感区,入射粒子的特征半径为10 nm、特征时间为0.5 ps,在4 ps 时延后入射器件,运行时间为1 ns。
3.1 不同Fin 材料的SET
基于TCAD,利用能量为138MeV 的Cl 离子[15]入射3 种不同Fin 材料的FinFET 器件[14,16],该高能粒子在Si材料中的线性能量转移(LET)为13.9 MeV·cm2·mg-1[15],仿真结果如图2 所示,收集电荷QC(t)[17]定义为:
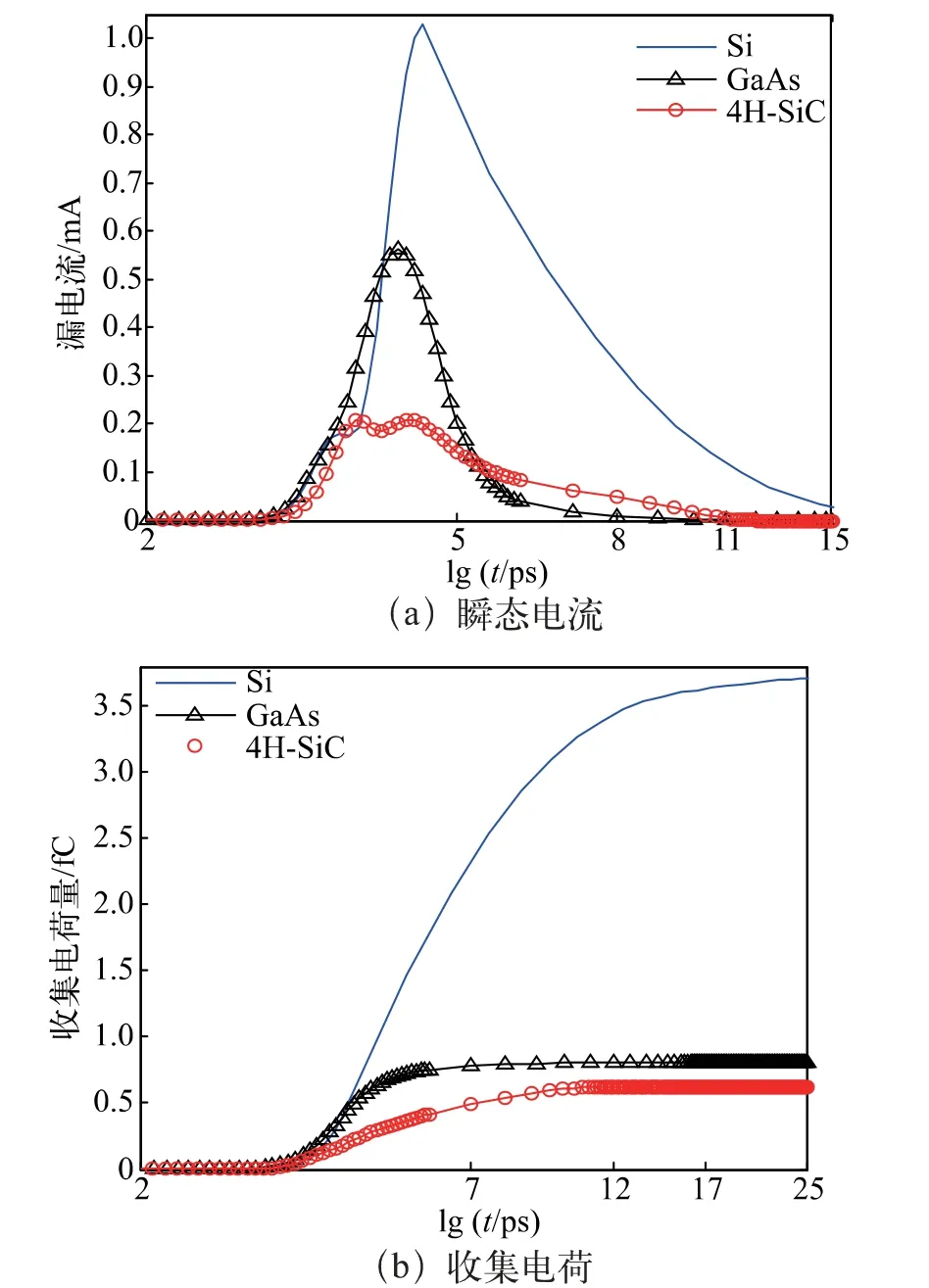
图2 3 种不同Fin 材料的SET 电流和收集电荷

其中ID(t)表示器件漏极的瞬态电流。则双极放大系数β 可以表示为:

其中QDep表示沉积电荷。
由图2 可得,与Si 基材料相比,GaAs 和4H-SiC基的FinFET 抗SET 性能更好。GaAs 和4H-SiC 材料的瞬态电流峰值相对于Si 基材料分别下降了45.32%、79.64%;收集电荷量相对于Si 基材料分别下降了78.03%、83.35%,可见4H-SiC 基器件产生的瞬态电流最弱。4H-SiC 材料具有宽禁带的特点,离子注入产生1 个电子空穴对所需要的能量要比Si 和GaAs材料所需的能量高2~3 倍[13],因此,相同能量的粒子入射时,4H-SiC 基器件产生的电子空穴对数量少,形成的瞬态电流相对也较小,且瞬态电流的形成时刻要稍晚一些。从图2(b)可得,GaAs 基器件收集电荷量最先到达自己的最大值,其次是4H-SiC 和Si 基器件,这意味着4H-SiC 和Si 基材料的扩散作用时间相对较长,双极放大效应较为显著。Si、GaAs、4H-SiC 基器件的累积电荷分别是0.895 fC、1.291 fC、0.479 fC,可见,GaAs基器件的累积电荷量最大,原因是单位长度累积的电荷量即线性电荷淀积(LCD)不仅与LET 有关,也与器件的密度、产生电子空穴对所需能量大小相关[18],而GaAs 材料的密度(5.32 g/cm3)相对较大,且产生电子空穴对所需能量与Si 基材料相当[13,18],因此,相同能量的粒子入射时,GaAs 材料的LCD 值相对较大,进而使得累积电荷量较大。
不同时刻对应的器件电势分布如图3 所示,在粒子入射的瞬间(4 ps),3 种材料器件的电势瞬间激增,特别是GaAs 材料,由于LCD 值较大,粒子向材料传递的能量较多,在入射区形成了电势最大值;在漂移和扩散的作用下,Si 材料的电势分布显著下降,而GaAs和4H-SiC 材料的电势分布变化不明显;当时间达到1 ns 时,3 种材料的电势分布回归到初始值。不同时刻对应的器件内复合率情况如图4 所示,在高能粒子入射时,GaAs 材料和4H-SiC 材料的复合率比Si 材料的复合率高1~2 个数量级,这意味着,当高能粒子入射所产生的电子空穴对相同时,GaAs 和4H-SiC 材料复合电子或空穴的速度比Si 要高数倍至数十倍。由于GaAs 的LCD 值较大,粒子入射产生的电子空穴对较多,故其复合范围较广,跨越栅极到达了源区。

图3 不同时刻对应器件的电势分布(单位:V)

图4 不同时刻对应的器件内复合率情况(单位:cm3/s)
尽管4H-SiC 材料的电场强度较大,致使重离子沉积的能量较多,但由于产生1 个电子空穴对所需能量较高,且复合率较大,使其产生的SET 电流较弱。虽然GaAs 材料的LCD 值较大,累积的电荷较多,产生的电子空穴对较多,但其复合率较高,且复合影响范围较大,使其产生的SET 电流较弱,双极放大效应偏弱。
3.2 粒子能量的影响
设置粒子能量的LCD 值在0.01~1 pC/μm 变化,不同LCD 值时Si 基和4H-SiC 基FinFET 器件的SET电流脉冲如图5 所示。随着LCD 值的增加,2 种材料的SET 脉冲电流呈增强趋势。不同材料的SET 的电流峰值、收集电荷量和双极放大系数如图6 所示,因为粒子入射4H-SiC 材料产生1 个电子空穴对所需的能量比Si 材料高2~3 倍,且4H-SiC 材料的复合率也高1~2 个数量级,所以在相同LCD 值时,4H-SiC 基FinFET 形成的SET 电流峰值更小,且存在多峰现象。不同LCD 值、不同时刻的电场强度沿Fin 轴向的分布情况如图7 所示。当LCD 值为0.01 pC/μm 时,电场强度随粒子入射呈现先增后减的趋势,此时形成的瞬态脉冲电流只有1 个峰值;当LCD 值增大到一定值时,电场强度在粒子入射的瞬间会骤增,且基本处于保持状态,因此在LCD 值较大时,SET 电流出现多峰。原因可能是第一个峰值是漂移作用产生的,而第二个峰值则是在扩散的作用下,4H-SiC 器件内部电场较强、快速收集电荷从而形成,同时SET 脉冲宽度也有所增加。随着LCD 值的增加,Si 器件的SET 电流峰值近似呈线性增加趋势,但由于存在多峰,4H-SiC 器件的瞬态峰值增加缓慢,与Si 器件的差值呈幂指数增加;对于收集电荷量而言,2 种材料的基本趋势基本一致,均随着LCD 值的增加而增加,且4H-SiC 器件与Si 器件的差值呈幂指数增加;Si 材料的双极放大系数远高于4H-SiC材料的双极放大系数,当粒子能量较小时,器件的双极放大效应更为显著。2 种器件的双极放大系数均随着LCD 值的增加而减小,这意味着它们收集电荷量的增加率比累积电荷的小。

图5 不同材料在不同LCD 值时的SET 电流脉冲

图6 不同材料的SET 的电流峰值、收集电荷量和双极放大系数

图7 不同LCD 值、不同时刻的电场强度沿Fin 轴向的分布情况(单位:106 V/cm)
与Si 材料相比,粒子入射4H-SiC 基FinFET 器件所形成的瞬态电流峰值更低、收集电荷量更少、双极放大系数更小,因此4H-SiC 材料具有更好的抗SET性能。
4 结论
随着技术节点的不断演进,SET 严重威胁着空间环境中先进电子器件的可靠应用。不断涌现出的新材料、新结构,对电子器件的SET 机理研究提出了新的挑战。本文针对14 nm SOI 4H-SiC 基FinFET 器件,研究了其SET 效应,分析了不同Fin 材料和粒子能量对SET 的影响,并探讨了影响机理。这些成果可以为FinFET 电路的抗辐射加固设计提供技术参考,为新型先进器件的SET 机理研究提供方法和思路。
