辐照源对LVMOS 器件总剂量辐射电离特性的影响*
2022-08-01刘国柱宋思德魏轶聃
陶 伟,刘国柱,宋思德,魏轶聃,赵 伟
(中国电子科技集团公司第五十八研究所,江苏无锡 214072)
1 引言
空间环境中存在X 射线、γ 射线等辐射源,金属-氧化物半导体场效应晶体管(MOSFET)器件总剂量(TID)辐射电离效应主要表现为高能光子或离子在氧化物中电离产生大量的离化电荷,而这些离化电荷的能量又会激发产生次级离化电荷,使离化电荷数量呈雪崩式增长,从而引起氧化层中陷阱电荷积累,诱导缺陷态和界面态的产生,导致器件性能退化,如阈值漂移和漏电[1-3]。
一般抗辐射电路的加固方法主要分为三大类:设计加固、版图加固以及工艺加固。设计加固主要包括三模冗余技术、校验纠错编码技术和电荷补充技术等;版图加固主要有环形栅[4]、H 型栅和双保护环加固;工艺加固主要通过改变栅氧化层的氧化方式[5-7]、氧化层的材料以及掺杂或者离子注入等实现。其中离子注入被认为是最简单高效的加固方式,因为它不仅与CMOS 工艺兼容,而且较容易控制,能在抗辐照和常态电学性能参数之间达到良好的折衷。
高能光子或离子入射到材料中与靶材料发生相互作用的物理机理主要包括康普顿效应和光电效应[8-13]。60Co 高能辐射电离效应以康普顿效应为主导,光子与靶材料原子的外层电子发生弹性碰撞,康普顿效应与原子序数关系较小,当没有原子序数较大的材料与SiO2相连时,在Si 和SiO2中60Co 的光学吸收更加均一,因此不会出现剂量增强效应[8-13]。X 射线辐射电离效应则以光子与内层电子作用的光电效应为主,因为光学吸收与原子序数紧密关联,光学吸收均一性差,原子序数大的材料中产生的光电子会在原子序数小的材料中产生能量沉积,所以会出现剂量增强效应[8-13]。
本文针对MOS 器件的总剂量辐照效应,采用浅槽隔离(STI)侧壁注入和底部注入加固工艺方法,对比分析了60Co(315 keV)和X 射线(40 keV)辐照源对NMOS 器件的总剂量特性的影响。
2 原理及实验
2.1 总剂量辐射电离效应
在正栅偏压作用下,MOS 结构因总剂量辐射电离效应引起电荷生成、传输和俘获过程如图1 所示[2,13-14]:(1)在高能粒子的辐射电离效应作用下,在SiO2层内产生大量电子或空穴,由于电子迁移率远大于空穴,在栅极电场作用下快速向栅极漂移,并移出SiO2层;(2)由于空穴输运速度慢,在SiO2体内发生局域态跳跃输运,并在栅极电场作用下向Si/SiO2界面漂移;(3)空穴在Si/SiO2界面附近被陷阱俘获形成正的氧化物陷阱电荷;(4)在一定偏置电压和温度条件下,辐射在SiO2/Si 界面处打破共价电荷键形成带有负电荷的界面陷阱,或者因氢离子(质子)跳跃式输运到Si/SiO2界面处被陷阱俘获,而形成带有正电荷的氧化物界面陷阱电荷。这种总剂量电离效应引起的电荷积累均会对CMOS 器件产生影响,并导致CMOS 电路的性能、功能和电流产生较大改变,随着剂量的增加,器件性能逐渐降低,当剂量积累到一定程度时,器件发生功能性失效。

图1 正栅偏压下MOS 结构总剂量辐射电离引起电荷生成、传输和俘获过程[2,13-14]
2.2 实验方法
2.2.1 STI 注入加固
STI 注入主要包括STI 侧壁注入和槽底注入,并采用硬掩蔽层和B 离子注入来增大STI 侧面和底部P-区表面的P 型杂质的浓度,从而有效增大“STI/P-”区表面的反型阈值,抑制漏电通道,进而可实现STI 总剂量电离辐射加固,具体的STI 注入加固方法如图2所示。

图2 STI 注入加固法[13]
2.2.2 TID 实验
基于0.18 μm CMOS 工艺,采用STI 注入法对1.8 V LVNMOS 器件进行总剂量加固,对比了60Co 和X 射线两种辐照源条件对LVNMOS 器件的总剂量辐射电离效应的影响(X 射线:40 keV;60Co:315 keV),其中,两种辐照源的剂量率均采用50 rad(Si)/s;ON 偏置条件为栅端电压VG=1.98 V,其余端口电压为0 V;OFF偏置条件为漏端电压VD=1.98 V,其余端口电压为0 V。LVNMOS 器件总剂量辐照实验条件如表1 所示。
3 分析与讨论
3.1 辐照机理分析
辐照过程中,光子与原子外层电子的相互作用会产生大量的电子-空穴对。在未复合的电子-空穴对中,电子被电场移走,剩下的空穴会以氧化物电荷和界面态的方式对体系的电性能产生影响。对于60Co 和X 射线辐照,在低氧化物电场作用下,大部分电子-空穴对发生复合,而在高氧化物电场作用下,复合的电子-空穴对数目显著降低。
依据能量和动量守恒原则,光电效应主要发生在K 层,其非相对论效应与相对论效应的光电效应表达式分别为[8-13]:

其中σK为K 层的光电截面,α 为精细结构常数,m0c2为电子的静止能量,hυ 为X 射线光子的能量,σTH为6.65×10-25cm2,Z为原子序数。
对于不同种类的元素,因为σK正比于Z5,所以Z越大的原子发生光电效应的概率越大;X 射线穿过高Z材料和低Z材料形成的界面时,高Z材料吸收剂量高于低Z材料,由高Z材料产生的光电子进入SiO2会产生电子-空穴对,未复合的电子-空穴对在电场下会产生氧化物电荷和界面态;同时,当X 射线穿过Si 和SiO2时,因为Si 和SiO2的平均原子量不同,Si 吸收大于SiO2,所以电子在移向SiO2进行能量沉积后,会在器件的界面附近产生剂量增强,使得损伤效果强于相同剂量的γ 射线[8-13]。
对于不同能量的辐照源,σK反比于入射光子的能量,高能光子入射后发生光电效应的概率更小,所以从光电截面角度考虑,60Co(315 keV)引发光电效应的概率小于X 射线(40 keV)[8,13]。X 射线光电效应产生的光电子从Si 和高Z材料进入界面附近区域中,形成能量沉积,引起界面的剂量增强[7]。即,Si 和高Z材料中产生的电子漂移到SiO2侧界面处,使得辐照过程中氧化物中的电荷增多,带正电的氧化物电荷会促进光电子向SiO2迁移,进而使得电性能退化增大。
3.2 实验数据分析
本文采用60Co 辐照源(315 keV)研究了LVNMOS器件的总剂量辐射效应,其中LVNMOS 器件采用STI加固工艺技术。在ON/OFF 偏置条件下,总剂量分别为50 krad(Si)、100 krad(Si)、150 krad(Si)时,LVNMOS 转移特征曲线ID-VG如图3 所示,ID为漏电流。实验发现,OFF 偏置条件下,总剂量达到150 krad (Si)时LVNMOS 器件的阈值漂移量仅为约-0.02 V;ON 偏置条件下,随着总剂量的提升,其关态ID呈现增加趋势,当总剂量达到150 krad(Si)时,LVNMOS 器件的阈值漂移量仅为约-0.36 mV,VG=0.014 V,ID达到纳安级以上。由此可见,OFF 偏置对LVNMOS 器件的漏电与阈值漂移几乎没有影响,而ON 偏置对LVNMOS器件的漏电影响显著,综合分析,在60Co 辐照源条件下,该LVNMOS 器件的TID 能力在100 krad(Si)左右。
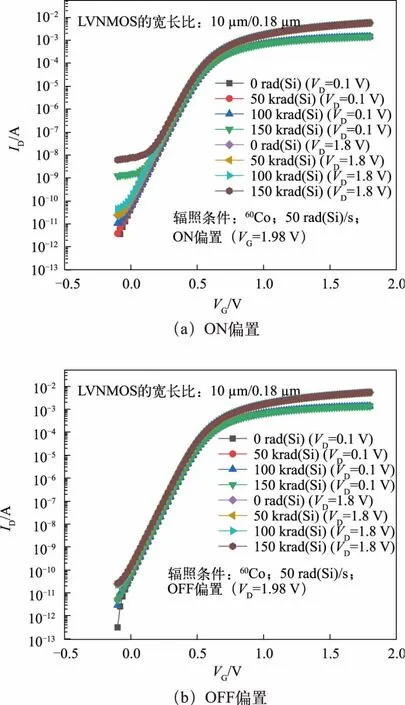
图3 60Co 辐照源下的LVNMOS 转移特征曲线
同时,本文也采用40 keV 的X 射线辐照源评估了LVNMOS 器件的TID 能力。在ON 偏置条件下,总剂量分别为50 krad(Si)、75 krad(Si)、100 krad(Si)时,LVNMOS 转移特征曲线ID-VG如图4 所示。实验发现,随着总剂量的提升,其关态漏电呈现增加趋势,当总剂量达到50 krad (Si) 时,LVNMOS 器件的关态ID(VD=1.8 V)达到纳安级以上,阈值电压漂移量为毫伏级。
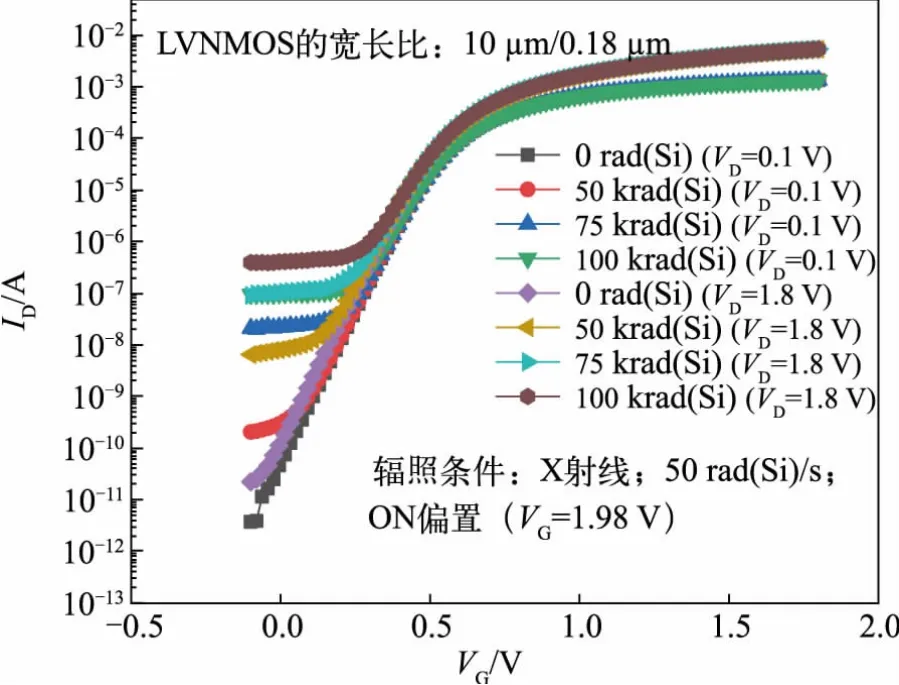
图4 X 射线辐照源下的LVNMOS 转移特征曲线
对比60Co 和X 射线两种辐照源条件对同种LVNMOS 器件的总剂量辐射电离效应的影响,研究了因总剂量辐照效应使源/漏(S/D)场边缘寄生管开启,导致器件内部源/ 漏漏电的问题。源/ 漏端ID(VG=0.014 V,VD=0.1 V/1.8 V)与总剂量之间的关系如图5所示,辐射偏置条件为ON 态(VG=1.98 V)。X 射线辐照引起的ID与总剂量近似成线性增强的关系[TID:0~100 krad(Si)],而60Co 引起LVNMOS 的ID与总剂量呈现两段近似线性增长关系,当TID 大于等于100 krad(Si)时,ID的变化趋势与60Co 基本一致,以ID小于1 nA 计为TID 能力的判据,则经过X 射线辐照源的LVNMOS 器件TID 能力小于25 krad(Si),而经过60Co 辐照源的LVNMOS 器件TID 能力可达到125 krad(Si)。分析其原因,60Co 与X 射线两种辐照源引起的MOS 器件辐射电离效应是完全不一样的,前者是康普顿效应和光电效应共同作用,后者主要是光电效应,是光子与内层电子作用,因此,根据LVNMOS器件漏电特性可以推断,X 射线辐照源引起LVNMOS的SiO2层产生的电子与空穴高于60Co。

图5 LVNMOS 器件源/漏端漏电流与不同辐照源总剂量之间的关系
4 结论
本文采用STI 注入加固方法对1.8 V MOS 器件进行总剂量加固,并对比分析了60Co(315 keV)和X 射线(40 keV)辐照源对NMOS 器件总剂量特性的影响。研究结果表明:(1)60Co 与X 射线对MOS 器件引起的辐射电离效应主要差异表现为前者是康普顿效应和光电效应共同作用,后者是光电效应,是光子与内层电子作用;(2)经过STI 加固,OFF 偏置对LVNMOS 器件的漏电与阈值漂移几乎没有影响,其TID 能力可达150 krad(Si),而ON 偏置对LVNMOS 器件的漏电影响显著,且在60Co 辐照源条件下,该LVNMOS 器件的TID 能力约为100 krad(Si);(3) X 射线辐照源下LVNMOS 器件的TID 能力小于25 krad(Si),而60Co 辐照源下LVNMOS 器件的TID 能力可达到125 krad(Si),推测其主要原因为X 射线辐照源引起LVNMOS 周围环境的SiO2层产生的电子与空穴高于60Co。
