60Co γ 射线对增强型GaN HEMT 直流特性的影响
2022-08-01邱一武吴伟林颜元凯周昕杰
邱一武,吴伟林,颜元凯,周昕杰,黄 伟
(1.中科芯集成电路有限公司,江苏无锡 214072;2.复旦大学微电子学院,上海 200443)
1 引言
氮化镓(GaN)是目前第三代半导体的主要代表材料之一,其拥有较宽的禁带宽度、高临界击穿电场、高电子饱和漂移速度以及高工作温度等优点,成为了当前电力电子系统备受瞩目的半导体材料代表[1-3]。其中,通过AlGaN/GaN 异质结结构制备的氮化镓高电子迁移率晶体管(GaN HEMT)器件,拥有极低的导通电阻且工作频率高,使得电源转化效率和功率密度大大提升。因此,在电源转换领域GaN HEMT 器件综合性能优势较为突出,在宇航、核能等极端环境下,GaN HEMT 器件同样具有极大的优势和很好的应用前景。
然而,在宇航、核能等复杂环境中存在大量的高能带电粒子,这些带电粒子通过和GaN HEMT 器件发生作用,导致一系列典型的空间辐射效应发生,比如总剂量效应(TID)和单粒子效应(SEE)等[4-6]。大量高能带电粒子入射到器件有源区会产生一些缺陷,使得器件电学特性退化甚至无法正常工作,严重影响器件的宇航应用可行性。在辐射效应方面,国内外诸多研究[7-9]表明GaN HEMT 器件的抗辐射性能突出,但GaN 材料特性受工艺环节影响较为明显,使得器件的抗辐照性能差异明显,导致GaN HEMT 器件难以凸显GaN 材料的性能优势。
异质结结构形成的GaN HEMT 器件通常是天然的耗尽型器件。在功率开关领域,耗尽型器件不利于电路安全、电路优化和节约成本,且耗尽型器件制备的开关难以在电路中集成,所以增强型GaN HEMT 器件变得尤为重要。目前,实现增强型GaN HEMT 器件的主要方法包括Cascode 结构、凹槽栅结构、F 离子注入技术和P 型栅结构[10-11]。其中,通过AlGaN/GaN 异质结上生长一层P 型栅结构实现对异质结界面处二维电子气(2DEG)的耗尽,使其浓度降低导致沟道关断。P 型栅技术是增强型GaN HEMT 器件产业化的主流技术,在界面质量、器件开态特性等方面具有突出优势,近年来获得学者的广泛关注和研究。
因此,本文利用60Co γ 射线对某商用P 型栅结构增强型GaN HEMT 器件开展零偏置状态下器件辐照实验及常温退火试验,深入研究不同剂量的γ 射线对GaN HEMT 器件直流特性参数的影响,研究成果对后期GaN HEMT 器件的抗辐照加固具有指导作用,为GaN HEMT 器件在宇航中的应用提供了重要的参考。
2 试验样品参数与试验方案
2.1 试验样品参数
本试验选取某商用的增强型GaN HEMT 功率器件为辐照试验样品,器件封装采用DFN 5×6 塑料封装。由于器件特性受工艺环节影响较大,所以本试验样品均为相同型号批次。样品剖面结构示意图以及器件等效电路图如图1 所示。
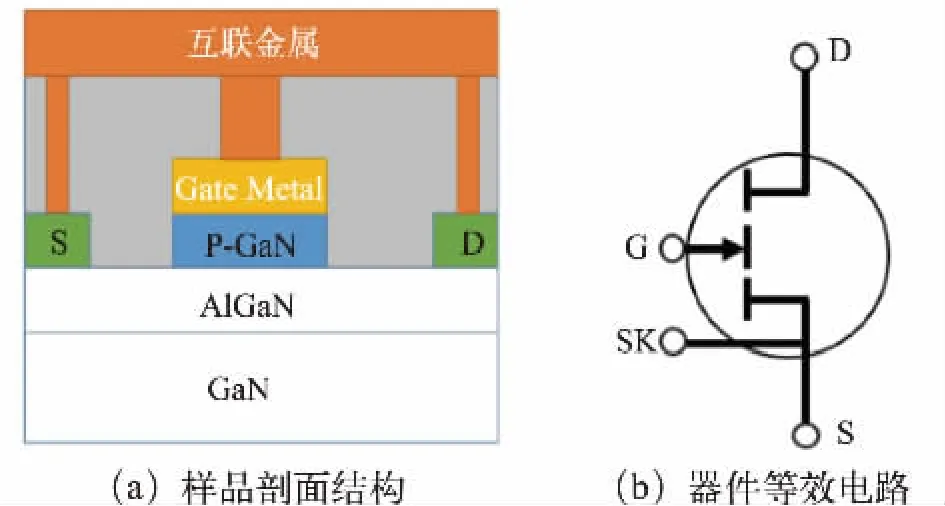
图1 样品剖面结构及器件等效电路
试验样品重要直流特性参数以及测试条件如表1所示。本次试验的GaN HEMT 器件均是P 型栅结构,阈值电压为正值,即为常关型(增强型)GaN HEMT 器件。

表1 试验器件重要直流特性参数及测试条件
2.2 试验测试方案
总剂量辐照试验在上海世龙科技有限公司的60Co γ 射线源上进行,辐照环境温度为室温,剂量率为100 rad(Si)/s,辐照剂量节点分别为0.2 Mrad(Si)、0.4 Mrad(Si)、0.6 Mrad(Si)、0.8 Mrad(Si)、1.0 Mrad(Si),γ 射线的平均能量为1.25 MeV,此次辐照最高剂量为1.0 Mrad(Si)。辐射过程中GaN HEMT 器件的栅/漏/源三端接地。
辐照试验开始前,对器件进行常规直流特性测试,筛选出一批电学特性一致的器件作为试验样品,确保试验结果的准确性,测量数据作为辐照前的初始数据,同器件辐照后的直流特性进行对比分析。辐照试验结束后,试验样品储存在干冰中避免离线测试过程中发生退火效应,为了获得精确的试验数据,测试过程尽量在1 h 内完成。器件电学特性均通过Kesight B1500A 半导体参数测试仪离线测量。试验样品直流特性的具体测试条件如表2 所示。

表2 器件测试时各电极电压偏置情况
3 辐照试验
图2为零偏置状态下不同辐照剂量对增强型GaN HEMT 器件转移特性的影响。测试条件是源漏电压Vd=3 V,以漏电流Id达到11 mA 时作为阈值电压的判定依据。图2 零偏置状态下不同辐照剂量对增强型GaN HEMT器件转移特性的影响
从图2 可知,器件Id-Vg曲线随着γ 射线辐照剂量的增加先负向偏移后慢慢正向移动。当辐照剂量达到0.4 Mrad(Si)时,负向偏移量达到最大,阈值电压Vth由辐照前的1.29 V 下降为0.94 V,阈值电压降低0.35 V。之后随着辐照剂量的继续增加,阈值电压降低量呈现减小趋势。当辐照剂量达到最大1.0 Mrad(Si)时,阈值电压仅负向漂移0.11 V,退化了8.5%。此结果可能是辐照导致感生界面态增加和引起2DEG 浓度下降,使得器件转移特性曲线出现偏移,阈值电压降低。
图3是从图2 的Id-Vg曲线中提取的跨导曲线随γ 射线辐照剂量的变化。跨导的计算如式(1)所示:


图3 GaN HEMT 器件的跨导曲线随辐照剂量点的变化
从图3 可知,器件跨导峰值随着辐照剂量的增加呈明显的下降趋势,当辐照剂量达到1.0 Mrad(Si)时,跨导峰值下降了25.3%。器件跨导与载流子迁移率的变化紧密相关,表明辐照导致器件载流子迁移率下降。
图4为GaN HEMT 器件在1.0 Mrad(Si)γ 射线辐射前后的输出特性曲线,测试偏置是栅压Vg为1~4 V,步长为1 V。
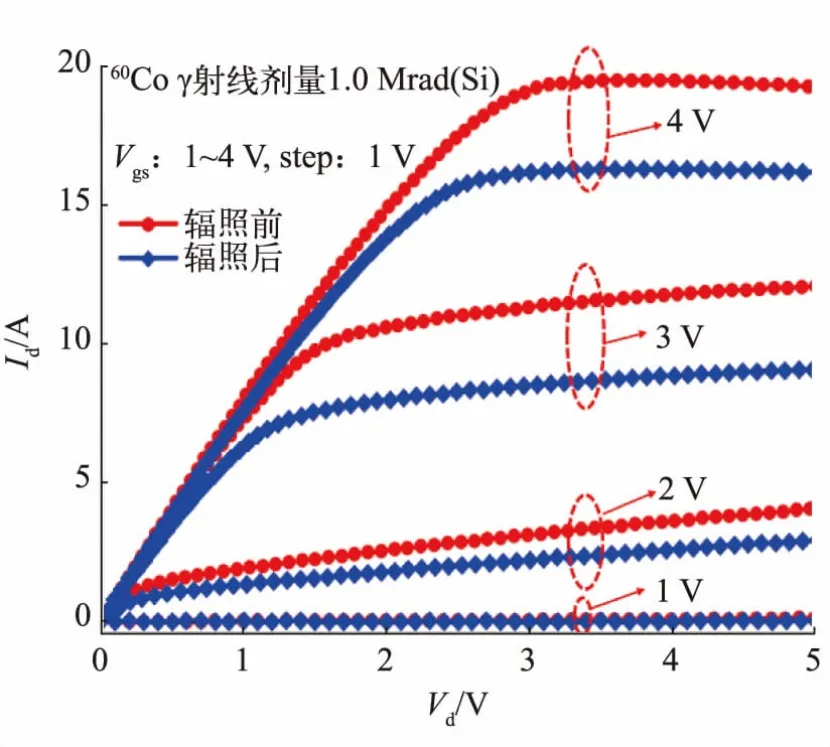
图4 GaN HEMT 器件在1.0 Mrad(Si)γ 射线辐射前后的输出特性曲线
从图4 可以看到,1.0 Mrad(Si)γ 射线辐照后器件漏极电流有明显退化趋势。在低栅压下(Vg为1~2 V),器件漏极电流的退化量相对较小,栅压继续增加,饱和漏极电流退化量也逐渐增大;在高栅压下(Vg为3~4 V),漏极电流退化情况逐渐加剧。栅压为4 V 时,饱和漏极电流退化量为16.3%。
P 型栅增强型GaN HEMT 器件栅极为肖特基接触,栅极的I-V特性确定了器件肖特基势垒高度,因此,肖特基栅特性是器件TID 的重要表征参数之一。图5 为GaN HEMT 器件在1.0 Mrad(Si)γ 射线辐照前后栅特性退化情况。

图5 1.0 Mrad(Si)γ 射线辐照前后GaN HEMT器件的栅特性退化情况
从图5 可以看出,1.0 Mrad(Si)γ 射线辐照后器件的栅特性退化甚微,表明γ 射线辐照后没有引起势垒层表面陷阱电荷的产生,未导致肖特基势垒层高度下降。由于P 型栅结构GaN HEMT 增强型器件栅极由PN 结构成,对陷阱辅助隧穿效应不敏感。
一般情况下,退火处理难以去除辐照在器件中产生的界面态,但表面态却容易得到恢复。为了进一步证明γ 射线是否会使GaN HEMT 器件产生界面态,对辐照后的器件开展室温退火处理。图6 为GaN HEMT器件在0.6 Mrad(Si)γ 射线辐照前后、室温退火后的转移特性曲线和跨导变化曲线。

图6 GaN HEMT 器件辐照前后、常温退火后转移特性曲线和跨导变化曲线
从图6 可知,经过0.6 Mrad(Si)γ 射线辐照后,器件阈值电压由1.29 V 下降到0.97 V。常温退火60 h后,器件转移特性变化甚微,此时阈值电压为1.0 V,仅仅恢复了0.03 V,随着退火时间的增加,器件转移特性曲线发生轻微的正向恢复,跨导峰值却有进一步退化的趋势。常温退火120h 后,器件阈值电压恢复到1.08V,退火过程中阈值电压变化不明显,表明辐照后器件直流特性退化可能由感生异质结界面态引起,导致没有发生明显的退火效应。
GaN HEMT 器件的阈值电压变化量ΔVth、跨导峰值变化量ΔGmmax、导通电阻ΔRon和饱和漏极电流ΔIdsat(Vg=4 V)随辐照剂量的退化情况如图7所示。随着辐照剂量的逐渐增加,饱和漏极电流和跨导峰值呈现下降趋势,阈值电压先降低后增加,而导通电阻受辐照影响不明显。当辐照达到最大剂量1.0 Mrad(Si)时,阈值电压退化8.5%,饱和漏极电流退化了16.3%,跨导峰值下降25.3%。
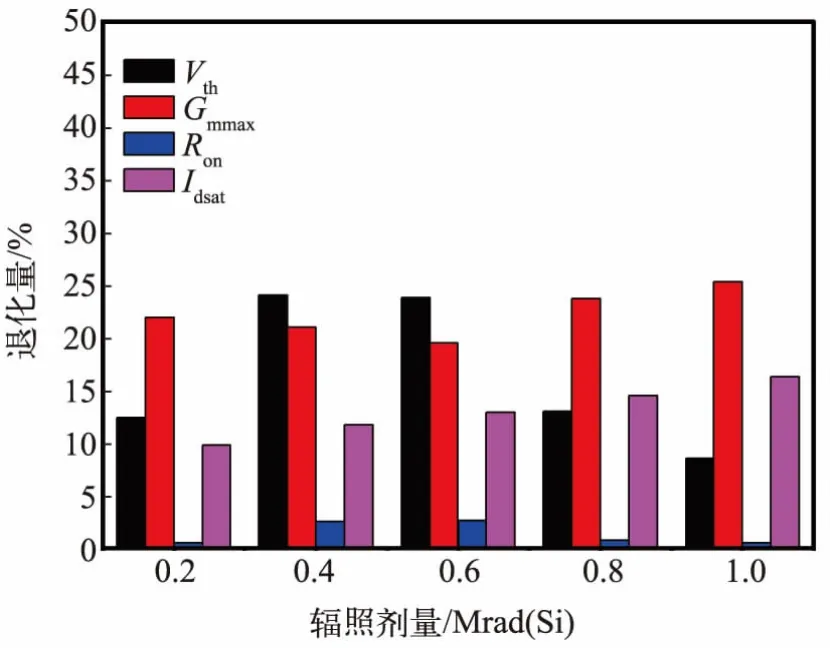
图7 GaN HEMT 器件主要电学特性随辐照剂量的退化情况
4 试验分析与讨论
器件辐照后转移特性先发生负向漂移后逐渐正向移动。这是因为器件阈值电压受沟道2DEG 浓度的影响,而2DEG 浓度又与势垒层的掺杂浓度密切相关。辐照后势垒层的掺杂浓度受到影响,导致2DEG浓度降低,引起器件阈值电压变化。此外,γ 射线会在器件中感生出界面态陷阱电荷,沟道电子被这些陷阱所捕获,沟道开启时间随之增加,使得Id-Vg曲线斜率减小[12]。从常温退火试验可见,器件直流特性随退火时间的增加变化并不明显,进一步说明辐照产生的界面态是导致器件退化的重要原因之一。
跨导的变化受载流子迁移率的影响很大,γ 射线辐照后在异质结附近形成散射中心,对GaN HEMT 器件而言,异质结形成的量子阱不仅深而且较窄,并且载流子的密度高,迁移率受到散射中心的制约[13]。辐照后器件跨导峰值降低,表明辐照导致载流子迁移率下降。
辐照后漏极电流下降,主要是因为器件受到γ 射线辐照后,在器件内部产生大量陷阱,沟道载流子被这些陷阱捕获,引起2DEG 浓度减小,辐照后由于散射中心的增多,载流子迁移率降低,所以在诸多原因的共同作用下引起了器件漏极电流减小的情况[14]。
辐照后器件的肖特基栅特性并未发生明显的退化,表明γ 射线辐照后没有影响势垒层高度,产生的势垒层表面陷阱电荷较少。
5 结论
通过对某商用P 型栅增强型GaN HEMT 器件进行60Co γ 射线辐射试验及退火试验,研究GaN HEMT阈值电压、饱和漏极电流、栅泄露电流、跨导等直流特性对TID 的响应规律及其退火效应。
测试数据表明,辐照后阈值电压、跨导峰值、饱和漏极电流均出现了不同程度的退化,而栅泄露电流和导通电阻退化不明显。转移特性曲线随着辐照剂量的增加先发生负向偏移后慢慢正向移动。在γ 射线辐照剂量为1.0 Mrad(Si)时,阈值电压减小0.11 V,退化8.5%,辐照对阈值电压的影响较小;跨导峰值退化25.3%,饱和漏极电流退化了16.3%(Vg=4 V);栅压逐渐增加,辐照对漏极电流的影响也随之增大。经过120h的退火试验,器件阈值电压恢复不明显,跨导反而有接着退化的趋势,没有发生明显的退火效应,与其他研究人员所得结果不一致,可能与试验样品型号和辐照试验条件不同有关。辐照后器件的肖特基正反向栅特性并未发生明显的退化,表明增强型GaN HEMT 器件的栅特性受γ 射线辐照影响甚微。
