Ar流量对磁控溅射制备Al掺杂ZnO薄膜的影响
2021-02-02赵笑昆李博研
赵笑昆,李博研 *,冯 波
(1.神华(北京)光伏科技研发有限公司,北京 102211;(2.北京市纳米结构薄膜太阳能电池工程技术研究中心,北京 102211;3.北京低碳清洁能源研究院,北京 102211)
0 引言
透明导电氧化物(TCO)薄膜光学透射率高,电导率高,在太阳能电池、显示面板、触摸屏、传感器等领域具有不可替代的作用[1]。Al掺杂ZnO(AZO)薄膜导电性能好、可见光透射率高、红外反射率高、紫外吸收率高,同时成本低、储量丰富、无毒性,近年来受到学术界和工业界的广泛关注[1−2]。利用溶胶−凝胶法(sol−gel)、磁控溅射沉积(magnetron sputtering)、化学气相沉积(CVD)、原子层沉积(ALD)等方法,均可制备性能良好的AZO薄膜[3]。尤其射频磁控溅射镀膜方法,薄膜沉积速度快,设备能耗低、对环境的污染小,适合大面积连续均匀镀膜,成为LED显示面板和太阳能组件行业重要的镀膜技术[2−3]。
磁控溅射沉积过程中,基片温度Ts、镀膜气压、溅射功率、靶材−基片距离等工艺参数均可影响薄膜晶粒生长,进而影响AZO薄膜的电导率和透射率[3−5]。溅射功率的改变可明显调节AZO薄膜晶粒的致密度[6−8];基片温度影响溅射原子在其表面的迁移,从而影响晶粒生长,特别是晶粒尺寸[9−11];气压的变化可影响薄膜生长速度,乃至影响晶粒生长取向的变化[12−13];靶材和靶基距显著影响薄膜结晶质量[14−17];镀膜室本底气压的优化和镀膜后退火,也可改进薄膜结晶质量[18−19]。
通常镀膜室的抽气速度是固定的,气压由溅射气体流量控制。研究者通过调节Ar、O、N2、H2等工艺气体的流量改变气压,调控薄膜晶粒生长方式,优化薄膜性能[2,11−13]。对于大面积连续式磁控溅射镀膜设备,镀膜室配有控制气体流量的质量流量计以及控制抽气速度的蝶阀,气压由气体流量和抽气速度共同控制。调节蝶阀的开合程度,可改变真空泵的抽速,进而控制气压。镀膜过程中,薄膜晶粒生长受气体流速和抽速的共同影响,而这种晶粒生长机制目前尚少见研究报道,因而本文将研究保持气压恒定时,气体流速对晶粒生长的影响。
本文利用流量计和蝶阀协同调节工艺气体压力,保持气压恒定为0.933 Pa,在Ar流量28 mL∕min、50 mL∕min、70 mL∕min、94 mL∕min条件下,在玻璃上制备30 cm×30 cm的大面积AZO薄膜。研究Ar流量对薄膜成分、相结构、微观形貌和光电性能的影响,分析晶粒生长过程,以期实现光电性能的优化。
1 实验
利用中国台湾SYSKEY公司的连续式磁控溅射设备镀膜,靶枪为定制的Angstroms公司的12.7 cm×55.88 cm平面靶,电源为SEREN公司3 kW、13.56 MHz射频电源。采用GfE公司的3 wt%Al2O3掺杂ZnO陶瓷靶材(纯度99.95%)、林德公司的99.999 9%高纯Ar。
将普通浮法玻璃裁成30 cm×30 cm作为基片,超声波清洗后装入镀膜室,抽气,待气压达到0.2×10−4Pa时,通入Ar调节气压至6.655 Pa,靶枪启辉并将功率逐步升至800 W。利用MFC质量流量计控制Ar流量分别为28 mL∕min、50 mL∕min、70 mL∕min、94 mL∕min,采用MKS Type 651C蝶阀控制器动态调节抽气阀门开合度,使压力保持在0.933 Pa。镀膜开始后,基片面向靶材线性往复运动以保证均匀镀膜,镀膜时间约50 min。镀膜结束后,关闭靶枪电源,取出样品。
薄膜厚度采用布鲁克Dektak−XT型台阶仪测试,薄膜的晶体结构用理学D∕max−2600∕PC型X射线衍射仪测试,薄膜的微观结构用赛默飞Nova Nano−SEM 450型场发射扫描电子显微镜分析,用EDS模块分析薄膜成分。薄膜的方块电阻用英国JANDEL公司的RM3000型四探针测试仪测量,载流子浓度和迁移率用美国MMR公司的K2500型霍尔效应测试仪测量。利用岛津UV3600型紫外−可见−红外分光光度计测试薄膜的透射率和反射率。
2 结果与讨论
2.1 AZO薄膜的组成和结构
表1列出了不同Ar流量下制备的AZO薄膜的厚度和化学组成,AZO靶材的成分也列入表中作为对比。当Ar流量为28 mL∕min时,AZO薄膜厚度为262 nm,随着Ar流量增加,薄膜厚度略微减小至255 nm,表明沉积速率有一定下降。一般情况下,镀膜室内气体压力增大时,粒子互相碰撞概率增大,使得粒子向更多方向运动,到达基片概率减小,薄膜生长速度降低[5,11]。研究表明,在溅射气压恒定的情况下,气体流量变大也可导致沉积速率下降。当Ar流量为28 mL∕min时,AZO薄膜中O、Zn、Al原子比分别为44.4 at.%、53.2 at.%和2.4 at.%,O含量低于靶材的50.6 at.%,Zn含量高于靶材的47.1 at.%,Al含量接近靶材。随着Ar流量增加,O含量逐渐上升至46.2 at.%,Zn含量逐渐降低至51.7 at.%,Al含量变化较小。在通常的溅射镀膜过程中,ZnO薄膜中易出现缺O现象,O含量低于理想配比(50 at.%),晶格中形成大量O空位,从而成为n型半导体[3]。而本文研究中,随着Ar流量增加,电子与Ar原子发生碰撞的概率增加,更多的Ar原子被电离成Ar离子并轰击靶材[11],溅射出的Zn、Al、O等离子活性更强,更易于在基片表面结合,形成接近理想化学计量比的薄膜,因而薄膜中O含量变大。

表1 不同的Ar流量下AZO薄膜的厚度和元素含量Tab.1 Thickness and element content ofAZO films
图1为采用不同Ar流量制备的AZO薄膜的XRD图。Ar流量为28~94 mL∕min时,薄膜衍射峰均符合ZnO六方纤锌矿特征峰,没有Al2O3和ZnAl2O4等杂相的衍射峰,表明Al进入ZnO晶格形成了固溶体。薄膜(002)峰强度大而(101)峰强度小,说明薄膜中晶粒垂直于基片的c轴向择优生长。由图1(b)可知,当Ar流量为28 mL∕min时,(002)峰相对强度较大,(101)峰几乎不可见,随Ar流量增大,(002)峰强度减小而(101)峰强度变大。

图1 不同Ar流量下制备的AZO薄膜的XRD图谱Fig.1 XRD patterns ofAZO films deposited at differentAr flow rate
从表2可以看出,当Ar流量为28 mL∕min时,样品的I(002)∕I(101)高达129.6,随着流量增加逐渐降低至6.4。I(002)∕I(101)比值的降低表明,薄膜c轴择优取向生长随Ar流量增加而变弱。这种溅射功率和气体压力均不变,择优取向生长的变化,此前极少报道[2]。当Ar流量为28 mL∕min时,(002)峰的位置2θ(002)为34.599°,随着 Ar流量增加,逐渐降低至 34.537°;(002)面间距d(002)相应地由2.590 4 Å逐渐增大至2.594 8 Å,如表2所列。可以认为,虽然AZO薄膜中O含量均低于理想配比,但随着Ar流量增大O含量有所升高,因而晶格膨胀,晶面间距变大[3]。表2还列出了(002)峰半高宽(FWHM)及由Scherrer公式计算的晶粒尺寸,随着Ar流量增加,FWHM由0.247°减小至0.238°,相应的晶粒尺寸由36.9 nm增加至38.5 nm,表明AZO薄膜具有纳米微观结构。
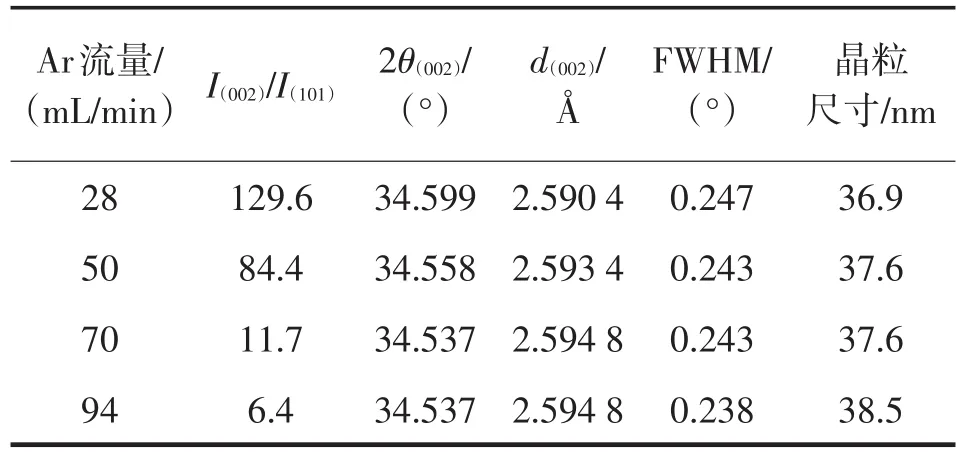
表2 AZO薄膜的特征参数Tab.2 Characteristic parameters ofAZO films
图2为用不同Ar流量制备的AZO薄膜样品的SEM图。当Ar流量为28 mL∕min时,薄膜表面由近等轴多边形晶粒紧密堆积形成,晶粒大小分布不均匀,其中大晶粒尺寸约40 nm,与XRD计算的36.9 nm接近(见表2)。随着Ar流量增大至50 mL∕min、70 mL∕min、94 mL∕min,大晶粒数量增多且尺寸变大,表明晶粒生长得到促进,分别如图2(b)、(c)、(d)所示。当Ar流量为70 mL∕min时,表面出现棒状晶粒,如图2(c)中圆圈所示,随着Ar流量增大至94 mL∕min,棒状晶粒数量增多且尺寸变大,长度约100 nm,宽度约30 nm。由图2(e)、(f)可知,采用28 mL∕min和94 mL∕min Ar流量制备的薄膜由垂直于基片的柱状晶粒构成,表明薄膜是c轴择优取向生长。而当Ar流量为70 mL∕min时,薄膜表面长度约100 nm的棒状晶粒平行于基片,表明是另一种方向的优择优取向。随着Ar流量增加,棒状晶粒变多,其代表的择优取向生长变强,导致薄膜c轴择优取向变弱,这也是I(002)∕I(101)减小的原因。进一步推断,随Ar流量增加,更多的Ar原子被电离成Ar离子并轰击靶材,溅射出来的Zn、Al、O等离子活性更强,更有利于在基片表面迁移,促进晶粒生长并在表面形成长晶粒,使得c轴择优取向变弱。

图2 不同Ar流量下制备的AZO薄膜的SEM图Fig.2 SEM images ofAZO films deposited at differentAr flow rate
2.2 AZO薄膜的电学性能
图3为AZO薄膜的电阻率、载流子浓度和迁移率与Ar流量的关系图。
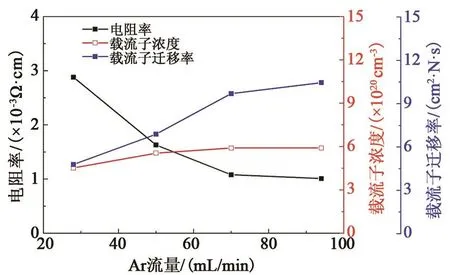
图3 AZO薄膜的电阻率、载流子浓度和迁移率与Ar流量关系图Fig.3 Resistivity,carrier concentration and mobility ofAZO films as a function ofAr flow rate
由图3可以看出,Ar流量为28 mL∕min时,载流子浓度和迁移率分别为4.52×1020cm−3和4.79 cm2∕(V·s),随着Ar流量增大至94 mL∕min,载流子浓度略微提高至5.90×1020cm−3,载流子迁移率明显提升至10.46 cm2∕(V·s)。载流子浓度的微小提高,可能与前文所述O含量提高,O空位减少有关[3]。载流子迁移率的增加可能与晶粒尺寸变化有关。通常,ZnO薄膜中载流子运动受离子碰撞散射、晶界散射及其他因素影响[1]。在本研究中,当Ar流量增加时,晶粒尺寸增大导致薄膜中晶界体积分数降低,载流子受到的晶界散射减少,迁移率变大。薄膜表面出现棒状晶粒,相当于在晶界“架桥”,使载流子通过晶界的概率减小,迁移得到促进。薄膜电阻率从2.88×10−3Ω·cm逐渐降低至1.01×10−3Ω·cm,主要受益于载流子迁移率的提高。
2.3 AZO薄膜的光学性能
为了考察薄膜的光学性能,图4给出了薄膜的透射率和反射率图谱,图5给出了禁带宽度Eg,具体数值如表3所列。由透射率T和厚度d计算得到薄膜吸收系数α=ln(1∕T)∕d,由波长λ计算得到光子能量hν=hc∕λ=1 240∕λ,用(αhν)2对hν拟合作图,将直接带隙半导体ZnO的线性区外推到横轴上的截距即为禁带宽度Eg。Ar流量为28~94 mL∕min时,薄膜均在300~400 nm紫外光区域出现光吸收截止边,由此拟合得到的禁带宽度均为3.82~3.85 eV。在780~2 400 nm的近红外区域,随着Ar流量下降,透射率下降,反射率上升,可能与薄膜中载流子浓度和迁移率的提高有关[1,3]。380~780 nm可见光区域的平均透射率和反射率如表3所列,Ar流量为28 mL∕min时,透射率为79.6%,反射率为13.9%;随着Ar流量增大,透射率和反射率分别降低至78.5%和13.1%。透射率尽管降低但损失不大,表明在薄膜电阻率得到优化的同时,仍可保持光学性能不退化。

图4 不同Ar流量下制备的AZO薄膜的光学性能曲线Fig.4 Optical spectrum of AZO films deposited at different Ar flow rate

图5 不同Ar流量下制备的AZO薄膜的禁带宽度(α:吸收系数,hν:光子能量)Fig.5 Band gap of AZO films deposited at different Ar flow rate1(α:absorption coefficient,hν:photon energy)

表3 AZO薄膜在380~780 nm区域的平均透射率、平均反射率和EgTab.3 Average transmission,reflectance and Eg of AZO films in visible from 380 nm to 780 nm
3 结论
采用射频磁控溅射法制备了AZO薄膜。在保持溅射气体压力恒定的情况下,研究了Ar流量对薄膜晶粒生长和光电性能的影响,结论如下:
(1)薄膜均为六方纤锌矿结构,晶粒沿垂直于基片方向的c轴择优取向生长,随Ar流量增大择优取向变弱。表面晶粒大小分布不均,Ar流量增大促进晶粒尺寸变大,诱导表面出现长度100 nm的棒状晶粒。
(2)载流子浓度和迁移率随Ar流量增大而提高,电阻率降低至1.01×10−3Ω·cm。薄膜光学平均透射率均大于78%,禁带宽度约3.8 eV,是一种性能良好的透明导电膜。
