氮气流量和退火处理对射频磁控溅射氮掺杂二氧化钛薄膜性能的影响
2019-07-16
(浮法玻璃新技术国家重点实验室,中建材蚌埠玻璃工业设计研究院有限公司,安徽 蚌埠 233018)
1 引 言
二氧化钛(TiO2)是一种宽禁带半导体氧化物,由于其无毒且具有优异的化学稳定性、光催化性能和超亲水性,而受到越来越多的关注[1-3],它具有良好的光催化性能,不仅被应用于水污染有机物的降解和光裂解水制备清洁能源氢,而且还被应用于材料表面的自清洁有机合成、海水和空气的净化等方面[4]。但是,TiO2禁带宽度仅为3.2eV,只能吸收紫外光用于光催化,太阳能利用率也低,因此限制了其应用[5]。
对TiO2薄膜进行掺杂改性,可以减小其禁带宽度,以扩展光吸收范围,提高太阳能利用率。因此,近年来对TiO2薄膜进行金属或非金属元素掺杂得到了越来越多的关注。如F掺杂[6],S掺杂[7]和N掺杂。例如,Asahi等[8]研究得出N掺杂可有效提高TiO2的可见光的光催化活性。这是由于N的p轨道电子与Ti的2p轨道电子耦合,使得薄膜的禁带宽度变窄,故能有效提高TiO2薄膜的可见光光催化活性。尽管已有大量关于N掺杂TiO2薄膜的磁控溅射研究,但大多数研究采用金属Ti靶材,以O2和N2为反应气体制备薄膜,影响因素相对较多。
本研究采用TiO2陶瓷为溅射靶材,以单一的N2为反应气体,实现了N掺杂TiO2薄膜的制备,研究了N2流量和后续的退火热处理对微观结构和性能的影响,进而探讨了N掺杂TiO2薄膜的成核和生长机理。
2 实 验
2.1 样品制备
采用K11-070型射频磁控溅射三室复合薄膜沉积系统制备N掺杂TiO2薄膜,实验装置如图1所示。溅射电源为CODEL 600W 13.56 MHz;溅射气体为高纯Ar,纯度5N,流量固定为30 sccm;反应气体为高纯N2,纯度5N。靶材为TiO2陶瓷靶(Ø=60 mm,4N),基板为康宁7095的玻璃基片,靶材到基板的距离为7 cm。使用前,玻璃基片先用丙酮、无水乙醇以及去离子水分别进行20 min超声清洗,之后使用高纯N2吹干放入反应室。溅射前本底真空度为5×10-4Pa,镀膜前预溅射30 min。
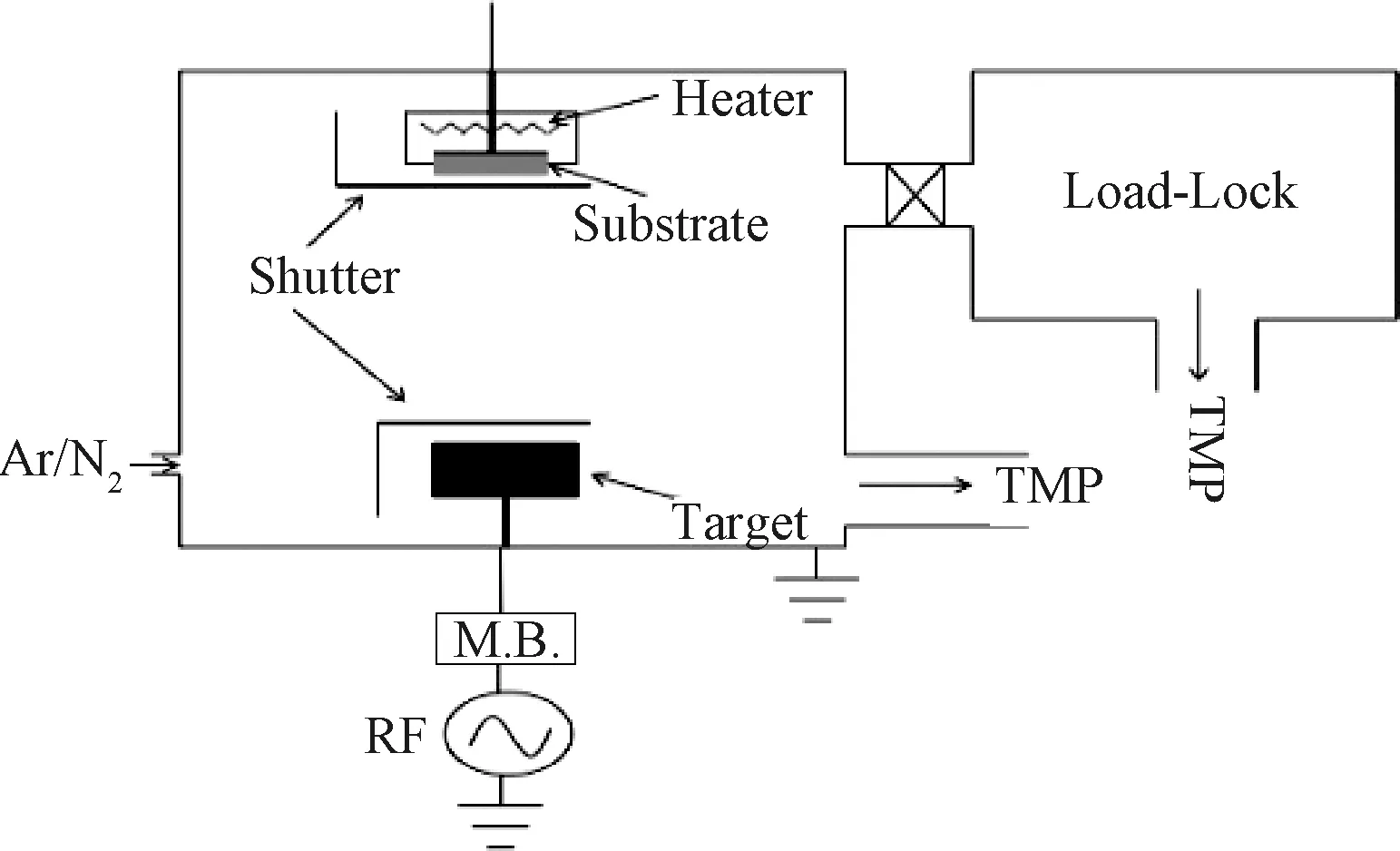
图1 射频磁控溅射装置示意图Fig.1 Schematic diagram of RF magnetron sputtering experiment device
通过改变N2流量,制备了一组N掺杂TiO2薄膜样品,分别命名为S0(0 sccm),S1 (4 sccm),S2 (8 sccm),S3 (12 sccm)和S4 (16 sccm)。所有样品的厚度均为400nm。磁控溅射制备N掺杂TiO2薄膜的具体工艺参数列于表1。

表1 制备N掺杂二氧化钛薄膜的工艺参数Table 1 Deposition parameters for the preparation of the N-doped TiO2 films
高温退火热处理设备为BTF-1200型电阻炉,退火温度为450℃,退火时间为120min,升温速率为5℃/min,退火气氛为Ar,自然冷却。
2.2 样品表征
采用Zeta-20型光学表面轮廓仪测量薄膜的厚度,步长为0.13nm;采用Advanced-80型X射线衍射仪(XRD)测量薄膜的晶型结构(Cu靶,辐射波长λ=1.5406 Å,管电压为40KV,管电流为30 MA,扫描速度为4°/min);采用ULTRA DLD 型X射线光电子能谱仪(XPS)分析薄膜的化学组成,Al Kα射线(hv=1484.6eV),所有样品在测试时均用Ar+进行表面轰击,以清除样品表面的杂质;采用U-4100紫外-可见分光光度计(UV-Vis)测试样品的透射光谱,测量范围为300~1100 nm,步长为2 nm。
3 结果和讨论
3.1 薄膜沉积速率

图2 N掺TiO2薄膜沉积速率与N2流量的关系Fig.2 Relationship between deposition rate and N2 flow rate
图2给出了N2流量和薄膜沉积速率之间的关系曲线图。薄膜沉积速率是沉积厚度和沉积时间的比值。从图可见,在N2流量为0sccm时,沉积速率为6.2nm/min,随着N2流量的增加,沉积速率单调下降,当N2流量为16sccm时,沉积速率降至3.74nm/min。这种变化产生的主要原因是薄膜沉积基元主要是依靠Ar+溅射出来的[15,16]。随着N2流量的增加,亚稳态的Ar原子(Ar*)和Ar离子(Ar+)的百分含量减少。因为Ar*和Ar+与N2和N的碰撞随着N2流量的增加而增加,Ar*和Ar+在碰撞过程中能量损失,进而导致溅射靶材的Ar+减少,靶材的溅射产额减少,使沉积速率下降。
3.2 薄膜晶体结构分析
退火前不同的N掺杂TiO2薄膜晶体结构的XRD分析结果如图3(a)所示。从图可知,S0样品呈现A(101)、A(004)和A(112)的锐钛矿相TiO2的特征峰。而所有掺N样品均没有呈现任何衍射峰,表明N掺杂TiO2薄膜为非晶结构,20~30°的宽峰为玻璃的特征峰。这可能是因为N掺杂进入TiO2晶格,导致TiO2的晶格被破坏,使薄膜呈现非晶结构[17-21]。
图3(b)是N掺杂TiO2薄膜退火后的XRD图谱。从图可见,样品中未出现TiN的衍射峰,所有样品均出现了高强度锐钛矿相的(004)峰和低强度的金红石相的(210)峰。导致这种现象的原因为:退火过程中,原子的表面自由能和迁移能增加促进晶粒的生长和晶粒间的重聚,进而晶体结构重建。锐钛矿相是低温相,通常在600℃以上转变为金红石相,但也有一些研究表明随原材料和制备方法的不同,转变的温度区间在400~1200℃之间[22-23]。

图3 退火前(a)、后(b)N掺杂TiO2薄膜的XRD图谱Fig.3 XRD patterns of the as-deposited films(a)and the annealed films(b)
3.3 XPS分析

图4 退火前N掺杂TiO2薄膜内部N1s的XPS图谱Fig.4 XPS N1s spectrum of the as-deposited films in the interior
图4为退火前N掺杂TiO2薄膜内部N 1s的XPS图谱,表2为薄膜中各元素的含量。薄膜中N的含量随着N2流量的增加而增加。文献[17]中关于N的种类有4个对应的特征峰,结合能分别为396.3±0.2eV(N1),397.2±0.2eV(N2),400.1±0.2eV(N3)和402.1±0.2eV(N4)。其中396.3±0.2eV的N1峰的结合能中N主要是以Ti-N键和取代TiO2晶格中O的形式存在于薄膜中[17-18];397.2±0.2eV的N2峰的结合能对应于TiN中N的结合能[24-25];400.1±0.2eV的N3峰的结合能有多种来源,一些研究者认为是薄膜吸附N2所对应的结合能[8,24,26],而另一些则认为是N存在于晶体晶格间隙所对应的结合能[27];402.1±0.2eV的N4峰的结合能被认为是多种吸附所对应的结合能[28]。

表2 退火前不同N2含量的N掺杂TiO2薄膜中各元素的含量(排除杂质C)Table 2 Content of elements in the as-deposited films (regardless of the impurities C)
除S0样品外,所有样品只有396.1eV峰。考虑测量误差,峰对应于N 1s,即随着N2流量的增加,N取代TiO2晶格中O的比例增加。N2在溅射过程被离化,N2流量的增加促进了N等离子体的放电和N离子与从TiO2靶溅射出的TiOx化合物的反应。N2流量的增加有助于N更多地以取代的形式掺杂进TiO2晶格中[29]。
图5为退火后的N掺杂TiO2N 1s的XPS图谱,表3为薄膜中各元素的含量。从图可知。S0,S1没有峰位,S2,S3,S4均有396.2eV(N1)处的峰。S4的结合能强度大于S2和S3。这是因为退火气氛虽然是Ar,但其中残留一些O2,O具有较强的氧化性,掺杂在TiO2晶格中的部分N在退火过程中被其氧化,薄膜中的N含量有所减少。因N掺入量的不同,样品被氧化的程度也不同。从表2和表3可以看出,不论是在退火前还是退火后,随着N2流量的增加,薄膜中含N量都在逐渐增加。

图5 退火后N掺杂TiO2薄膜内部N1s的XPS图谱Fig.5 XPS N1s spectrum for the annealed films in the interior

表3 退火后不同N2含量的N掺杂TiO2薄膜中各元素的含量(排除杂质C)Table 3 Content of elements in the annealed films (regardless of the impurities C)
图6为退火前N掺杂TiO2薄膜表面和内部Ti 2p的XPS图谱。因S2,S3,S4的Ti XPS图谱基本一致,本研究以S4为例。从图可见,样品表面有465.1和459.3eV两个峰,这是典型的纯TiO2的Ti 2p结合能的峰[24]。考虑测量误差,Ti在薄膜表面以对应于TiO2的Ti4+存在。在薄膜表面的Ti 2p3/2和Ti 2p1/2峰左右均对称,表明Ti在薄膜表面是以单一的价态形式存在的。薄膜内部的图谱运用CasaXPS软件解析得到有4个特征峰,分别为464.4,463.4,458.9和457.4eV。Yang等[30]研究表明Ti 2p峰经过解析分别有457.4eV处的Ti3+2p3/2峰,458.6eV处的Ti4+2p3/2峰,463.2 eV处的Ti3+2p1/2峰和464.3eV处的Ti4+2p1/2峰。表明薄膜内部的Ti是以Ti4+和Ti3+的混合形式存在。通过观察发现,薄膜内部的Ti 2p的结合能相比于薄膜表面的结合能有0.4eV的偏移。这是因为TiO2晶格中部分O2-被N-替位所取代,导致电子密度下降[31-32]和部分Ti4+转变为Ti3+,引起这种偏移[33]。

图6 退火前N掺杂TiO2薄膜S4 Ti 2p的XPS图谱 (a)表面;(b)内部Fig.6 XPS Ti 2p spectrum of as-deposited S4 (a)at the surface;(b)in the interior
图7为退火前后N掺杂TiO2薄膜内部Ti 2p的XPS图谱的对比。从图可见,退火前后的XPS图谱形状相似,但退火前Ti 2p峰的结合能强度大于退火后的强度。退火前后Ti 2p峰位有0.3eV的偏移。这主要归因于在退火过程中氧空位的减少和薄膜中部分N被氧化之故。

图7 退火前后N掺杂TiO2薄膜S4 内部Ti 2p的XPS图谱(a)退火后;(b)退火前Fig.7 XPS Ti 2p spectrum of S4 in the interior (a)annealed;(b)as-deposited.
3.3 禁带宽度
利用薄膜的厚度d和透过率谱T可以计算得到吸收系数α,如下式[34]:
(1)
根据紫外-可见吸收边可以推算出半导体的禁带宽度。当光子能量hν>Eg时,其本征吸收系数α与光子能量h关系如下式[35]:
(αhν)n=A(hν-Eg)
(2)
其中:Eg为带隙,h为普朗克常量,ν为光子频率,A为间接跃迁吸收常数,n为指数。TiO2为间接带隙半导体材料,所以n=1/2。
图8为不同N掺杂TiO2薄膜的(αhν)1/2-hν曲线。通过对图中拟合形成的切线进行计算,可得到不同N掺杂TiO2薄膜的禁带宽度。从图可见,薄膜的禁带宽度从3.19降至2.15eV,即吸收范围从389nm扩大到577nm。N掺杂使薄膜的吸收边红移至可见光区域。根据N掺杂理论[36-37]:掺杂N元素后,TiO2导带主要由N原子2p轨道电子和Ti原子3d轨道电子共同构成,同时N原子2p轨道电子与Ti原子3d轨道电子在导带区发生着强烈的交联作用,导致Ti原子3d轨道上的电子向N原子2p轨道移动,致使整个导带向费米能级附近移动,导致TiO2禁带宽度变窄。
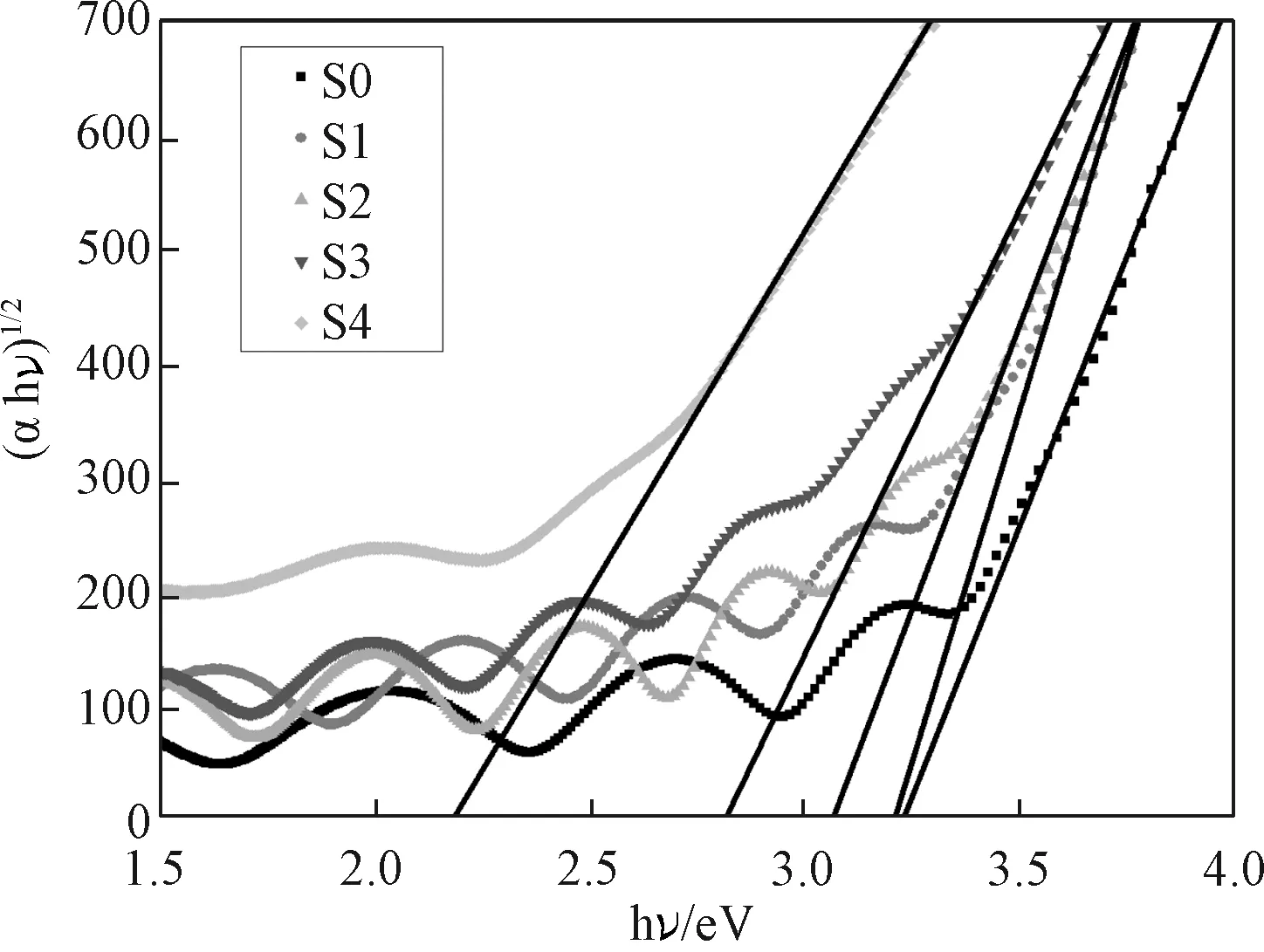
图8 退火前不同N掺杂TiO2薄膜的(αhν)1/2-hν曲线Fig.8 (αhν)1/2-hν of the as-deposited N doped TiO2 films in different N2 flow rate

图9 退火后不同N掺杂TiO2薄膜的(αhν)1/2-hν曲线Fig.9 (αhν)1/2-hν of the annealed N doped TiO2 films in different N2 flow rate
图9为退火后不同N掺杂TiO2薄膜的(αhν)1/2-hν曲线。从图可见,所有样品经退火后,禁带宽度均有所增加。这种变化是由以下原因造成的:真空腔内会残留有少量的氧气,由于氧原子比较活跃,在退火过程中会氧化薄膜中的氮原子,形成TiO2。另外,可能与无定型材料的带边展宽造成的禁带宽度变小有关,沉积的N掺杂TiO2均为无定型材料,经退火后的样品均为结晶性良好的晶体材料,无定型材料由于带边展宽的原因造成禁带宽度比晶体材料小。
4 结 论
本研究利用射频磁控溅射技术,在室温条件下,通过改变N2流量制备不同结构、性能的N掺杂TiO2薄膜,并对薄膜进行退火处理。研究发现随着N2流量的增加,薄膜的沉积速率单调下降。XRD分析结果表明样品在退火前为非晶态,退火后呈现为锐钛矿相和金红石相的混合相。XPS分析结果表明N在薄膜中只以取代TiO2晶格中的O的形式存在,在退火后N的含量减少。随着N2流量的增加,薄膜的禁带宽度从3.19eV下降到2.15eV,但退火后禁带宽度却均有所增加。这些结果为N掺杂TiO2薄膜的进一步应用提供了实验基础和理论依据。
