La施主掺杂SrTiO3单晶的阻变性能研究∗
2018-10-26李广辉夏婉莹孙献文
李广辉 夏婉莹 孙献文
(河南大学,光伏材料省重点实验室,物理与电子学院,开封 475004)
1 引 言
具有简立方结构的SrTiO3(STO)是一种典型的钙钛矿结构材料[1].通过元素掺杂,可以实现对STO光电性能的调控,近年来已有许多关于薄膜或单晶具有阻变存储性能的报道.对于受主掺杂(Fe,Cr)STO,研究表明其阻变与氧空位迁移密切相关.而对于施主掺杂(Nb,Nd)STO,金属与N型半导体STO之间的肖特基接触对阻变性能至关重要[2−6],一些研究发现阻变源于金属/NbSTO界面耗尽层的改变[7−9];但也有研究表明导电细丝对施主掺杂STO的阻变性能起着关键作用[10−12].综上不难发现,即便对于具有相同传导特性的N型STO材料,其阻变转换机制目前也尚未达成共识,而阻变机制的不明晰将严重阻碍阻变存储器的研发.
到目前为止,关于施主掺杂STO阻变性能研究的工作主要集中在Nb掺杂STO,因此针对不同金属掺杂的STO进行研究,将有利于阐明阻变机制.LaSTO单晶掺杂源于La元素替代Sr元素,虽然取代位与NbSTO不同,但其仍为施主掺杂[13].目前,仅有关于多晶薄膜[14]和多晶陶瓷[15,16]LaSTO的阻变研究的报道,还未见到关于单晶样品的相关报道.单晶具有均匀良好的物理化学性能,本文选择LaSTO单晶,制备了Pt/LaSTO/In结构器件,并对其电致阻变性能进行了详细探究,以期能进一步阐明STO的阻变机制,为LaSTO单晶在阻变存储器件中的应用奠定基础.
2 实 验
实验所用为单面抛光的(100)LaSTO单晶,其La掺杂浓度为0.5 wt%,尺寸为5 mm×3 mm×0.5 mm.为了制备Pt/LaSTO/In结构存储器件,利用掩膜板通过小型离子溅射仪在LaSTO单晶上生长直径200µm的Pt上电极,在其粗糙面按压In下电极.电学测试可证明In电极与LaSTO单晶形成欧姆接触.采用Keithley 2400数字源表对Pt/LaSTO/In器件进行电学测试,在测试过程中,下电极In接地.利用JEOL JES-FA200电子顺磁共振(electron paramagnetic resonance,EPR)对LaSTO单晶进行测试,以获得该单晶的缺陷信息.
3 实验结果与讨论
为了确定缺陷类型,我们研究了STO和LaSTO单晶的EPR.EPR常用来表征具有未成对电子的物种.EPR测试得出样品的g因子,通过与自由电子的g因子(ge)做对比可以确定样品中是否存在电子或空穴缺陷中心.很多科研工作者通过该技术研究诸如2等存在于STO表面的化学物种[17−19].图1为STO和LaSTO单晶的EPR测试结果,仅在g=2.012处观察到一吸收峰,该值大于ge=2.0023,表明LaSTO单晶中存在空穴中心,此类带正电的缺陷可以作为电子俘获中心.根据文献[20]报道,该EPR峰应由中心导致,电子从Ti3+离子转移到吸附在氧空位的分子O2,从而形成离子,因此g=2.012处的空穴中心与表面氧空位缺陷紧密相关.

图1 STO和LaSTO单晶的EPR图谱Fig.1.EPR results for STO and LaSTO single crystal.
图2(a)为In/LaSTO/In器件的电流-电压(IV)关系曲线,插图为器件的电学测试结构示意图,线性I-V关系证明In电极与LaSTO单晶形成欧姆接触.图2(b)为Pt/LaSTO/In器件的多周I-V测试结果,其整流特性证明Pt/LaSTO之间存在界面势垒.当对器件施加正(负)5 V写入电压时,可置其为低(高)阻态.即改变写入电压的极性可以调控该器件的阻态,从而实现在高低阻之间的切换.其循环测试结果表明该器件具有明显区分度且稳定的高低阻态.
此外,实验发现当改变最大写入电压(Vmax)的值,Pt/LaSTO/In器件可以呈现出一系列中间阻态,如图3所示.图3(a)为+5 V写入电压置器件于低阻态,当负向Vmax分别为−1,−2,−3,−4和−5 V时,器件的阻态随着负写入电压的增大而逐渐增大;图3(b)为用−5 V写入电压置器件于高阻态,正Vmax分别为1,2,3,4和5 V时,其阻态随着正写入电压的增大而逐渐降低.该器件阻态与Vmax值有关且随Vmax的改变而发生规律的变化,因此可以通过改变Vmax值来调控Pt/LaSTO/In器件的阻态.
为了深入探究Pt/LaSTO/In器件的多级存储态的稳定性和开关比等性能,我们对其电阻-电压(R-V)性能进行了测试.当改变写入电压从+5 V到−2 V(或−3,−4,−5 V)再到+5 V时,其R-V测试结果如图3(c)所示,读电压均为−0.1 V.从图3(c)可以看出,无论器件处于高或低阻态,在写入电压回复到零的过程中,器件的阻值基本保持不变,这表明该器件在不同写入电压作用下可实现稳定的多级阻态[21,22],其最大开关比值接近104.图3(d)为器件低阻态和高阻态(正负5 V脉冲激励)及中间阻态(−2和−3 V脉冲激励)被监测10 h的阻态保持性结果,没有观察到明显的阻值改变,证明该器件具有良好的非易失性.

图2 (a)In/LaSTO/In和(b)Pt/LaSTO/In器件的I-V循环曲线,图(a)内插图为电学测试结构示意图Fig.2.The I-V curves of(a)In/LaSTO/In and Pt/LaSTO/In devices.The inset in panel(a)is the device structure.

图3 (a)改变负Vmax的I-V曲线;(b)改变正Vmax的I-V曲线;(c)多级R-V曲线;(d)阻态的保持性,所给各阻态分别由+5,−2,−3,−5 V写入电压激励Fig.3.The I-V curves with(a)different negative Vmaxand(b)different positive Vmax;(c)multilevel R-V curves;(d)the retention capability of high resistance state/low resistance state and intermediate resistance states achieved by writing pulse of−2 and−3 V.
为了进一步理解写入电压大小对器件阻态的影响并探究阻变机制,测试了Pt/LaSTO/In器件被正负写入电压激励至不同阻态时在−0.5—+0.5 V小电压范围内的I-V曲线,其结果如图4所示.图4(a)为首先用+5 V电压将器件激励至低阻态,然后逐渐增大负写入电压(从−0.5—−5 V),器件阻态从低到高的变化过程;图4(b)为阻态从高到低的反向变化过程.由图4可知逐渐改变正或负写入电压,均可实现一系列阻态,相比而言负写入电压对器件的阻态调控较均匀更易于控制.

图4 器件的阻态(a)从低向高和(b)从高向低的转变过程及对应系列阻态在−0.5—+0.5 V小电压范围下的I-V结果Fig.4.The resistance of the device changes(a)from low resistance state to high resistance state and(b)from high resistance state to low resistance state(I-V curves of various resistance states from−0.5 V to+0.5 V).

图5 (a)高阻态拟合曲线满足lnI正比于V1/2;(b)低阻态I-V曲线拟合为I=Asinh(BV)Fig.5.(a)lnI is proportional to the V1/2of the fitting curve at high resistance state;(b)I-V curve at low resistance state is fitted to I=Asinh(BV).
对比图4中各阻态的I-V曲线,不难发现高阻态时具有明显的整流特性,而随着阻态的逐渐降低,I-V曲线逐渐趋向于正负对称.为了进一步说明高低阻态的输运机制,图5给出了其对应的拟合曲线.高阻态拟合曲线满足lnI正比于V1/2关系[23],其中I为电流值,V为电压值.如图5(a)所示,Pt/LaSTO界面存在界面势垒;图5(b)为低阻态的拟合曲线,满足I=Asinh(BV),A和B常数分别为0.00147和1.93921,拟合结果与电子隧穿模型特性一致[24].从图4还可观察到明显的电压零点偏移,高阻态时零点偏移可达到−0.2 V,随着向低阻态过渡,偏移值逐渐减小并消失.电压零点偏移应由肖特基界面电容的充放电效应引起,而随着阻态降低零点偏移逐渐消失则证明低阻态器件存在较大的漏电流,该结论与上述I-V拟合结果一致.以上分析表明Pt/LaSTO/In器件的电阻改变伴随着Pt/LaSTO界面势垒宽和高的改变.
结合前面关于缺陷的讨论结果——LaSTO单晶表面存在大量氧空位缺陷,因此这些带正电的空位缺陷在外电压作用下将诱导电子的俘获与去俘获,该过程致使Pt/LaSTO界面肖特基势垒发生改变,从而发生电致阻变.如图6所示,当正向偏压施加在Pt/LaSTO肖特基结,随着STO内费米能级的上移,界面势垒将随电压增大而迅速降低变窄,随之产生正向电流,相应电子从LaSTO单晶向Pt电极流动,这些流经界面的电子可被带正电的氧空位俘获;电子在Pt/LaSTO界面的聚集使得肖特基势垒变得更窄[25],因此器件被切换到低阻态,这与低阻态I-V满足电子隧穿模型特性相一致.反之,当施加负偏压时,随着STO内费米能级的下移,Pt/LaSTO界面势垒将随负电压增大而变宽变高,因此界面被俘获电子将受到较大的电场力而被释放,从而致使界面肖特基势垒变宽,器件随之切换到高阻态.总之,Pt/LaSTO/In器件的高低阻转变由界面氧空位缺陷在外电场作用下诱使的电子俘获与去俘获引起.此外,该器件阻态非易失性表明被俘获电子在正电压去除后状态不变,当作用反向电压后才会被释放,这是由于低阻态Pt/LaSTO界面势垒非常窄,因此被俘获电子(在高密度缺陷处或许形成了费米能级钉扎效应)只有在反向电压作用时,随着界面势垒的增宽,受到足够大电场力的作用才能去俘获,从而实现阻态切换.
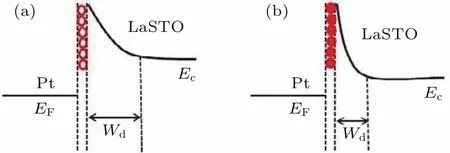
图6 (a)高阻态和(b)低阻态时的Pt/LaSTO界面能带结构示意图,其中红色空心和实心圆分别代表未被电子占据和已经占据的氧空位Fig.6.The schematic diagrams of band structure of the Pt/LaSTO interface at(a)high resistance state and(b)low resistance state.The red hollow and solid spheres at interface represent the unoccupied and occupied interface state,respectively.
众所周知,当光照射到STO材料时,会产生光生载流子[26,27].图7为将器件置于黑暗和光照下(单位面积光强为806µW/cm2)分别进行测试的I-V结果,可以观察到低阻时在光照条件下电流明显增大,即光照下器件低阻变得更低,这是由光生载流子所致.LaSTO单晶被光照射时,当价带内电子获得足够的能量后,就会向导带跃迁,致使材料内载流子浓度增大,体电阻随之减小.因此,当Pt/LaSTO/In器件处于低阻时,由于肖特基势垒较窄,光生载流子引起隧穿电流,因此光照下其电流明显增大;而高阻时,由于肖特基势垒对器件的传导起着主导作用,因此光照引起的载流子浓度的改变并没有引起电流的显著变化.

图7 Pt/LaSTO/In器件在光照和黑暗下的I-V曲线,所用光强为806µW/cm2Fig.7.The I-V curves of Pt/LaSTO/In devices in light and darkness.The light intensity is 806µW/cm2.
4 结 论
本文通过对Pt/LaSTO/In器件进行系统的电学性能测试,发现该器件具有稳定的多级阻变现象,其电阻可以随外加电压的改变而改变,最大开关比为104.EPR研究表明LaSTO单晶内存在带正电的空穴缺陷中心,进一步分析表明高低阻之间的转变由界面氧空位缺陷诱导的电子俘获与去俘获引起.此外发现光照会对LaSTO材料的低阻产生影响.该实验结果为LaSTO单晶在阻变存储器件中的应用提供了理论和技术指导.
