不同应变对Ge的光学性质影响的第一性原理研究
2017-06-19黄文奇吕媛媛韩旭辉卢贵武
李 佳, 黄文奇, 张 鹏*, 吕媛媛, 韩旭辉, 卢贵武
(1. 中国石油大学(北京) 理学院, 北京 102249; 2. 北京信息科技大学 理学院, 北京 100081)
不同应变对Ge的光学性质影响的第一性原理研究
李 佳1, 黄文奇2, 张 鹏1*, 吕媛媛1, 韩旭辉1, 卢贵武1
(1. 中国石油大学(北京) 理学院, 北京 102249; 2. 北京信息科技大学 理学院, 北京 100081)
研究了不同方向、不同强度的应变对Ge光学性质的影响。结果表明,Ge在单轴张应变和双轴张应变的调控下,均可由间接带隙转向直接带隙,其中,单轴应变有更低的转变点。Ge在常用波段处(0.4 eV)的介电函数实部和虚部在张应变作用下,均急速上升而后在一定应变范围内下降。对Ge进行[111]单轴应变调控能表现出更好的光学性能以及更便捷的器件设计(较低的应变量)。
锗; 第一性原理; 应变; 光学性质
1 引 言
近年来,Ge作为一种新型的光电探测器材料而受到人们的普遍关注,并且最近以其较高的电子空穴迁移率而被作为新型的硅基激光发射器的组成元素[1]。但Ge属于间接带隙结构,这种结构导致其在发光时空穴和电子复合动量不守恒,必须依靠发射声子来进行,所以光电效率较低。这个缺陷成为Ge材料光电应用的瓶颈。
研究表明,半导体的光学性能与其晶体结构关系密切[2]。施加一定的应变,可以调节材料间接带导带谷和直接带导带谷的相对位置[3],从而使Ge获得直接带隙结构。Fischetti等[4]利用非局域经验赝势的方法计算时发现,Ge在(110)双轴张应变的作用下时,其L谷的下降速度小于Γ谷的下降速度。当应变量增加到约1.7%时,能够使Ge实现间接带隙到直接带隙的转变。Jain[5]等利用微机械方法,对Ge施加了0.8%的双轴张应变,从而令Ge的1 550 nm波长的发光强度提升了将近130倍。许多研究小组通过不同方法对Ge施加应变,使其直接带隙发光强度都有不同程度的提高[6-8]。黄诗浩等从理论上解释了应变对于Ge能带结构的影响,并研究了N型掺杂下Ge的发光性质[9]。Tahini和Liu等[10-11]通过第一性原理,计算了应变对Ge电子结构的影响以及能带的变化。但这些理论和实验研究的对象均是对单一类型的应变Ge。此外,不同类型、不同方向应变对Ge光学性质影响的研究还未见报道。
针对上述问题,本文采用基于密度泛函理论的第一性原理方法并结合GGA+U修正系统地研究了Ge在单轴([100]、[110]和[111]方向)和双轴应变( (100)、(110)和(111)晶向)下能带结构、介电常数以及光学性质的变化规律,期望能通过对Ge能带和介电常数的调节,来提升Ge光电探测器的光电转换效率,改善其光学性能,为其材料生长、器件设计[12]以及其他类锗材料的研究提供理论指导。
2 计算方法
与杂化密度泛函(HSE06或GW)相比,密度泛函理论(DFT)具有较高的计算效率,同时在Ge-2p轨道上应用了原子占据位库仑修正(即所谓的GGA+U方法)又不失准确性。所以,本文选用DFT+U方法计算Ge原胞在应变下的带隙转变、介电函数实部和虚部的变化以及光学性能的变化。第一性原理的计算采用集成于VASP模拟软件包的投影缀加平面波方法产生的赝势[13],利用基于广义梯度近似下的PBE参数化方法描述电子件的交换关联作用。平面波的截断能设置为400 eV。在结构优化方面,采用GGA-PBE密度泛函计算方法,对于Ge原胞的Monkhorst-Pack[14]k-点采样网格设置为7×7×7。当晶胞内各个原子之间的相互作用力小于0.01 eV/A时,结构优化便收敛停止。在这个过程中,晶胞的基矢和原子位置都不允许被优化,k点采样选择为Γ点。而在结构优化过程中,k点采样网格设置同样为7×7×7。各个离子之间相互作用的收敛标准设置为0.01 eV/A。优化后的结构将用来计算Ge的电子结构和光学性质。为了保证后续计算的准确性,U参数设置为U=0 eV和J=3.5 eV,使得计算得到的Ge的带隙值接近于实验值。在计算过程中,带隙的计算以Γ点为基准,将倒格矢高对称点上沿着导带的最低点依次记为X、Γ、L,对应的带隙为EgX,EgΓ、EgL。特别之处在于,在施加应变的时候,EgX不会固定在X点,而是会位于布里渊区中连接Γ和X高对称点的路径上的某一位置。
3 结果与讨论
本文从能带结构入手,通过对Ge施加不同方向不同量的应变,研究了应变对于带隙、介电性能以及光学性能的影响。
3.1 不同应变对Ge能带结构的影响
表1中列出了DFT计算的晶格常数和弹性模量与实验值的比较。Ge虽然是间接带隙结构,但是计算出的Ge的直接带隙与间接带隙仅相差0.184 eV,已经和实验值[15]的0.14很接近。对于无应变下的Ge,优化后计算出的带隙为0.738 eV,与实验的带隙值保持一致。
从图1可以看出,Ge在[001]、[110]和[111]单轴应变的作用下,各点出现了不同的变化。在[110]和[111]的压应变作用下,L谷的下降速度高于Γ谷,X谷下降较缓;而在张应变作用下,Γ谷迅速下降,X谷变化平缓,L谷呈现出不同程度的上升。[110]转变点为1.81%,对应带隙为0.81 eV;[111]转变点为1.22%,相应带隙为0.84 eV。二者的带隙都大于无应变锗。在张应变作用下,Γ点价带下降速度大于导带的变化速度。在[100]的压应变作用下,X谷和L谷下降迅速,Γ点比较平缓,不存在转变趋势;而在张应变下,Γ谷下降速度大于L谷和X谷,转变点为3.03%。该点带隙为0.27 eV,大大低于无应变锗的带隙。
表1 Ge的晶格参数、弹性模量、间接带隙以及直接带隙的实验值和计算值
Tab.1 Experimental and calculated lattice parameter,elastic constants,the indirect and direct band gaps

实验值计算值晶格参数/nm0.56569a0.55985C11/GPa128.5b128.53C12/GPa48.3b48.26C44/GPa68.0b66.8直接带隙:Γv→Γc/eV0.89c0.9224间接带隙:Γv→Xc/eV—0.8882间接带隙:Γv→Lc/eV0.74d0.7384
a实验测量结果[16];b实验测量结果[17];c实验测量结果[18];d实验测量结果[19]

图1 [100]、[110]和[111]单轴应变下的带隙变化。
Fig.1 Change of the band gaps with uniaxial strain parallel to [100], [110] and [111] direction, respectively.
图2列出了Ge在(100)、(110)以及(111)双轴应变各点带隙的变化。在(100)和(110)压应变的作用下,Ge的Γ谷与X谷迅速上升,L点同时也以较缓的趋势上升;随着压应变的增大,两者又呈下降趋势。而在(111)压应变的作用下,Ge的Γ谷上升速率小于L谷,但两者随着压应变量的增加,都呈持续上升趋势;相比之下,X谷的变化较为缓慢。这些变化趋势与Tahini[10]等的研究结果基本相同。在(100)和(110)张应变的作用下,Ge的X谷变化幅度较小,但Γ谷和L谷均出现极大的下降趋势,并出现转变点。(100)转变点为2.62%,(110)转变点为3.17%。二者对应的带隙分别为0.35 eV和0.28 eV,均小于无应变锗的带隙。而在(111)张应变的作用下,Ge的Γ谷下降速度小于L谷,以至于没有出现转变点,继续增加应变量也将不能获得直接带隙。在(110)和(111)整个应变过程中,L谷变化量与应变呈线性关系。表2列出了部分实验测量以及理论预测结果,通过比较可以看出,计算结果与实验值基本吻合。同时,为了方便相关领域的研究人员使用这些规律和数据,本文在表4和表5中列出了不同应变对于Ge带隙值影响的函数表达式(x表示应变值,y表示带隙值)。

图2 (100)、(110)和(111)双轴应变下的带隙变化。
Fig.2 Change of the band gap with biaxial strain parallel to (100), (110) and (111) plane, respectively.
表2 单轴应变下带隙转变点的部分理论计算值和实验值
Tab.2 Partial theoretical experimental and calculated transition point of the direct band gap with unixial stain

OrientationofuniaxialstrainExperimentalresultsOthercomputationalresultsThiswork[100]—3%a3.03%[110]—1.71%a1.81%[111]—1.05%a1.22%
表3 双轴应变下带隙转变点的部分理论计算值和实验值
Tab.3 Partial theoretical experimental and calculated transition point of the direct band gap with biaxial stain

OrientationofbiaxialstrainExperimentalresultsOthercomputationalresultsThiswork(100)2%b2.91%c,2.3%d2.62%(110)—3.5%c,3%d3.17%(111)—unreachedunreached
a.DFT+U计算结果[20];b实验测量结果[21];cDFT+U计算结果[22];d杂化泛函计算结果[23]

表4 单轴应变下带隙的函数表达式

表5 双轴应变下带隙的函数表达式
3.2 不同应变对Ge介电常数的影响
经比较发现,计算出的无应变Ge的介电函数谱与Yang等[22]计算结果完全吻合。为了进一步了解应变对于Ge的光学性能的影响,本文详细分析了应变下的Ge的3个方向的静介电常数以及介电函数实部和虚部。
图3、4分别列出了Ge的静介电常数在单轴应变和双轴应变下的变化规律。在[100]单轴张应变作用下,Gex、y方向的静介电系数迅速增加,z方向增加缓慢;而在压应变作用下,随着应变量的增加,x、y、z方向都有略微的下降趋势,x,y方向的值略小于z方向的值。在[110]和[111]单轴应变作用下,当应变量增加时,x、y、z方向都呈上升趋势。在[111]应变下,x、y、z方向的值相同;在[110]张应变下,z方向的值上升趋势大于x、y方向。而在[110]压应变下,z方向的值上升趋势小于x、y方向。当对Ge施加双轴应变时,(111)应变的结果与[111]完全一致,在(100)和(110)应变下的变化趋势也与单轴应变保持一致。但在(100)应变下,z方向的静介电系数增大速率大于x、y方向;反而在(110)应变下,z方向的静介电系数增加缓慢,小于x、y方向。总之,Ge在双轴压应变作用下的静介电常数与单轴压应变下相差无几,且都变化缓慢;双轴和单轴张应变下的静介电常数增长迅速,且在双轴应变下的增长幅度大于单轴应变,在带隙转变点附近保持较高的静介电常数。同样,本文在表6和表7中列出了不同应变对于Ge带隙值影响的函数表达式(x表示应变值,y表示静介电常数值),便于相关领域的研究人员能够使用这些规律和数据。
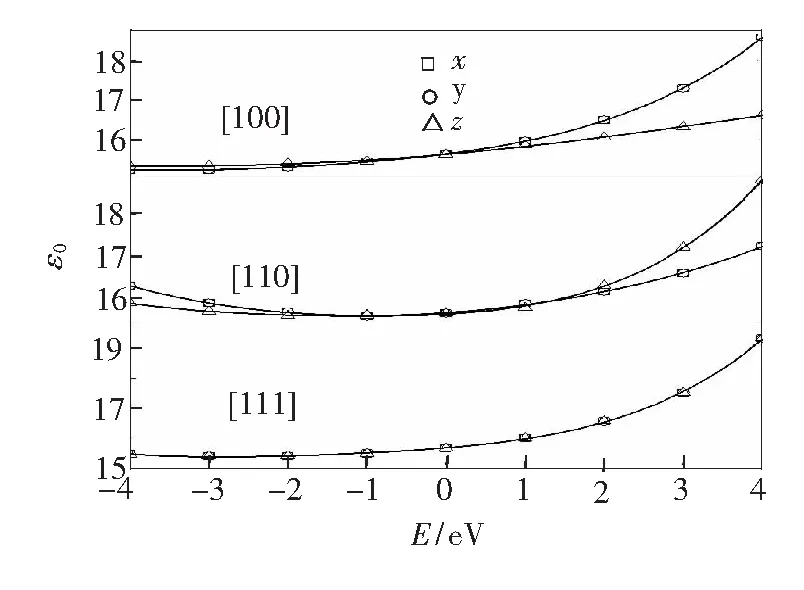
图3 单轴应变下的静介电常数变化图Fig.3 Change of the static dielectric constant with unixial strain
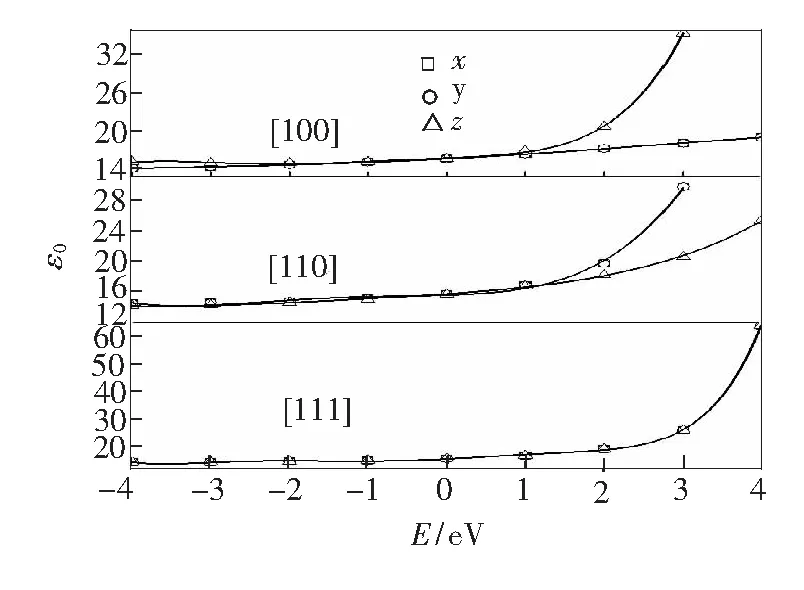
图4 双轴应变下的静介电常数变化图
Fig.4 Change of the static dielectric constant with biaxial strain

表6 单轴应变下静介电常数的函数表达式

表7 双轴应变下静介电常数的函数表达式
Ge在红外光电领域应用广泛[24],常用波段大约为0.4 eV。本文计算了Ge在应变下该频率的介电函数实部和虚部的变化图,为Ge的实际应用提供参考。
从图5可以看出,Ge在[100]、[110]和[111]单轴应变下,频率为0.4 eV对应的介电函数实部变化与静介电常数完全一致。在(100)、(110)以及(111)压应变的作用下,介电函数实部基本保持不变,维持在15;但在张应变作用下,随着应变量的增加,(100)的x、y值持续上升,z值在2%应变之后急速下降;而(110)的x、y值持续上升,同样在2%应变之后急速下降,z值在上升至3.5%处时出现了下降。通过图6比图5比较可以发现,Ge的频率为0.4eV对应的介电函数虚部变化与实部大体相同,只是存在细微的差别:在[100]单轴张应变的作用下,损耗因子的z轴分量呈现微弱的下降;而在双轴应变作用下,随着应变量的增加,(100)的数据拐点出现在3.17%,(110)与(111)的数据拐点在3.5%处。总体来说,Ge的在常用波段处介电函数实部和虚部在单轴、双轴压应变下均变化不大,在单轴、双轴张应变作用下,Ge的介电函数实部和虚部有较大的起伏。
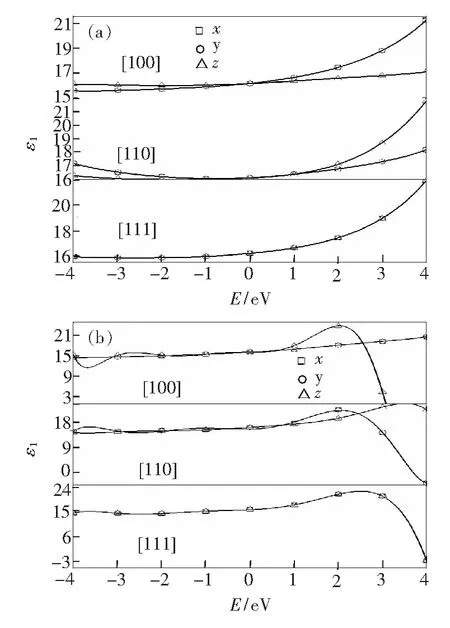
图5 单轴(a)和双轴(b)应变下的介电函数实部变化图
Fig.5 Change of the real part of dielectric function with unixial strain(a) and biaxial strain(b)

图6 单轴(a)和双轴(b)应变下的介电函数虚部变化图
Fig.6 Change of the imaginary part of dielectric function with unixial strain(a) and biaxial strain(b)
3.3 吸收谱、反射谱、折射率谱和损失函数谱
为了进一步研究应变对Ge光学性质的影响,考虑到器件的可行性,本文又分别选取了单轴和双轴两个应变量较小的直接带隙转变点:[111]1.22%和(100)2.62%,计算了它们的吸收谱、反射谱、折射率谱和损失函数谱,并与无应变Ge作了比较,如图7所示。其中[111]1.22%Ge的吸收系数略高于(100)2.62%Ge和Ge。三者的反射谱基本一致,高反射系数区域位于4.7 eV到7.5 eV,对应于红外波段。在低频范围内,(100)2.62%Ge的折射率略微高于[111]1.22%Ge和Ge,在高频范围三者都迅速衰减。损失峰位置三者基本相同,Ge的峰值最高,[111]1.22%Ge的峰值最低,说明适当的应变减小了损耗,但并没有改变Ge的半导体金属特性。

图7 无应变Ge、单轴[111]1.22%Ge、双轴(100)2.62%Ge的吸收谱、反射谱、折射率谱和损失函数谱。
Fig.7 Absorption spectrum, reflectivity, refrctive index and loss function of the unstrained Ge, Ge with uniaxial strain parallel to the [111] direction at 1.22%, and Ge with biaxial strain parallel to the (100) plane at 2.62%, respectively.
4 结 论
本文采用了基于密度泛函理论的第一性原理方法并结合GGA+U带隙修正方法对不同方向不同强度应变Ge的带隙和光学性能进行了研究。结果表明,Ge在[100]、[110]和[111]单轴张应变以及(100)、(110)双轴张应变调控下,均可以由间接带隙转向直接带隙,且[110]和[111]单轴应变调控下的带隙高于双轴应变,拥有更小的应变量。(100)和(110)双轴应变调控下的转变点分别为2.62%和3.17%,而[100]、[110]和[111]单轴应变调控下分别为3.03%、1.81%和1.22%。[110]和[111]单轴应变调控下的带隙均高于双轴应变,[110]单轴应变调控下的直接带隙为0.81 eV,[111]单轴应变调控下的直接带隙达到了0.84 eV,而(100)和(110)双轴应变调控下的直接带隙仅为0.35 eV和0.28 eV。Ge在压应变作用下,静介电常数变化缓慢;在张应变作用下,随着应变量的增加,静介电常数呈现上升趋势。Ge在常用波段处的介电函数的实部和虚部在单轴、双轴压应变下均变化不大;在单轴、双轴张应变作用下,Ge的介电函数的实部和虚部均出现先急速上升后在一定应变范围又下降的趋势。最后,对选取应变点的吸收谱、反射谱、折射率谱和损失函数谱进行了研究,结果表明,对Ge进行[111]单轴应变调控能表现出更好的光学性能(合理的禁带宽度、较高的静介电常数、较高的吸收系数以及更低的能量损耗)以及更便捷的器件设计(较低的应变量)。同时,也为类锗材料的能带和光学性质的调控提供了理论指导。
[1] HUANG W Q, CHENG B W, XUE C L,etal.. Comparative studies of band structures for biaxial (100)-, (110)-, and (111)-strained GeSn: a first-principles calculation with GGA+U approach [J].J.Appl.Phys., 2015, 118(16):165704.
[2] KOUVETAKIS J, MENENDEZ J, CHIZMESHYA A V G. Tin-based group Ⅳ semiconductors: new platforms for opto-and microelectronics on silicon [J].Mater.Res., 2006, 36:497-554.
[3] PEI Y, WU H B. Effect of uniaxial strain on the structural, electronic and elastic properties of orthorhombic BiMnO3[J].J.Semicond., 2015, 36(3):7-11.
[4] FISCHETTI M V, LAUX S E. Comment on ‘Influence of the doping element on the electron mobility in n silicon’ [J.Appl.Phys. 83, 3096 (1998)] [J].J.Appl.Phys., 1999, 85(11):7984-7985.
[5] JAIN J R, HRYCIW A, BAER T M,etal.. A micromachining-based technology for enhancing germanium light emissionviatensile strain [J].Nat.Photon., 2012, 6(6):398-405.
[6] CAMACHO-AGUILERA R E, CAI Y, PATEL N,etal.. An electrically pumped germanium laser [J].Opt.Express, 2012, 20(10):11316-11320.
[7] KASPER E, OEHME M, WERNER J,etal.. Direct band gap luminescence from Ge on Si pin diodes [J].Front.Optoelect., 2012, 5(3):256-260.
[8] DUTT B, SUKHDEO D S, NAM D,etal.. Roadmap to an efficient germanium-on-silicon laser: strainvs. n-type doping [J].IEEEPhotonicsJ., 2012, 4(5):2002-2009.
[9] 黄诗浩, 李成, 陈城钊, 等. N型掺杂应变Ge发光性质 [J]. 物理学报, 2012, 61(3):036202-1-8. HUANG S H, LI C, CHEN C Z,etal.. The optical property of tensile-strained n-type doped Ge [J].ActaPhys.Sinica, 2012, 61(3):036202-1-8. (in Chinese)
[10] TAHINI H, CHRONEOS A, GRIMES R W,etal.. Strain-induced changes to the electronic structure of germanium [J].J.Phys.Condens.Matter, 2012, 24(19):195802-1-4.
[11] GAO Y B, CHEN Z L, LI J G,etal.. Genetic landscape of esophageal squamous cell carcinoma [J].Nat.Genet., 2014, 46(10):1097-1102.
[12] CHEN J M, SHU B, WU J B,etal.. Enhanced electroluminescence from a free-standing tensilely strained germanium nanomembrane light-emitting diode [J].J.Semicond., 2015, 36(10):65-68.
[13] KRESSE G, JOUBERT D. From ultrasoft pseudopotentials to the projector augmented-wave method [J].Phys.Rev. B:Condens.Matter, 1999, 59(3):1758-1775.
[14] MONKHORST H J, PACK J D. Special points for Brillouin-zone integrations [J].Phys.Rev. B:Condens.Matter, 1976, 13(12):5188-5192.
[15] MAEDA Y. Visible photoluminescence from nanocrystallite Ge embedded in a glassy SiO2matrix: evidence in support of the quantum-confinement mechanism [J].Phys.Rev. B:Condens.Matter, 1995, 51(3):1658-1670.
[16] SINGH H P. Determination of thermal expansion of germanium, rhodium and iridium by X-rays [J].ActaCrystallogr. A, 1968, 24(4):469-471.
[17] DIETZE W, SCHULZ M, WEISS H,etal..TechnologyofSi,Ge,andSiC/TechnologievonSi,GeundSiC[M]. Berlin Heidelberg: Springer, 1984.
[18] ASPNES D E. Schottky-barrier electroreflectance of Ge: nondegenerate and orbitally degenerate critical points [J].Phys.Rev. B:Condens.Matter, 1975, 12(6):2297-2310.
[19] SZE S. Physics of semiconductor devices [J].J.Appl.Polym.Sci., 1970, 14(9):2427-2428.
[20] BOZTUG C, SNCHEZ-PÉREZ J R, SUDRADJAT F F,etal.. Tensilely strained germanium nanomembranes as infrared optical gain media [J].Small, 2013, 9(4):622-630.
[21] LIU L, ZHANG M, HU L J,etal.. Effect of tensile strain on the electronic structure of Ge: a first-principles calculation [J].J.Appl.Phys., 2014, 116(11):113105-1-6.
[22] YANG C H, YU Z Y, LIU Y M,etal.. Dependence of electronic properties of germanium on the in-plane biaxial tensile strains [J].Phys. BCondens.Matter, 2013, 427:62-67.
[23] YANG J Y, LIU L H, TAN J Y. Temperature-dependent dielectric function of germanium in the UV-Vis spectral range: a first-principles study [J].J.Quant.Spectrosc.Radiat.Transf., 2014, 141:24-30.
[24] 李向娜, 黄翀, 李颖. 全球锗资源供需格局分析 [J]. 中国矿业, 2016, 25(S1):13-17. LI X N, HUANG C, LI Y. Analysis of global germanium resources supply and demand pattern [J].ChinaMin.Mag., 2016, 25(S1):13-17. (in Chinese)

李佳 (1993-),男,甘肃天水人,硕士研究生,2015年于北京科技大学获得学士学位,主要从事类锗材料的能带调控以及光学性质的研究。

E-mail: 132698538868@163.com张鹏 (1963-),女,黑龙江嫩江人,博士,教授,2014年于中国石油大学(北京)获得博士学位,主要从事非线性光学晶体的研究。
E-mail: zhangpeng1998@126.com
Comparative Studies on The Optical Properties of Different Strained Ge:A First-principles Calculation
LI Jia1, HUANG Wen-qi2, ZHANG Peng1*, LYU Yuan-yuan1, HAN Xu-hui1, LU Gui-wu1
(1.CollegeofScience,ChinaUniversityofPetroleum,Beijing102249,China;2.CollegeofScience,BeijingUniversityofScienceandTechnologyInformation,Beijing100081,China)
To explore the changes of the optical properties for Ge in different orientations and different strains, we performed the first principle calculations based on density functional theory combined with GGA+U approach. The results show that Ge undergoes a transition from indirect- to direct-gap on uniaxially tensile strains (along [100], [110] and [111] directions) and biaxially tensile strains (parallel to (100), (110) planes).The band gaps of Ge with uniaxially strains (along [110] and [111] directions) are higher than those with biaxially strains, and the transition points of uniaxially strains are lower than those of biaxially strains. Under uniaxially and biaxially compressive strains, the changes of dielectric constants and loss factors of Ge between the frequency bands are both negligible. However, the dielectric constants and loss factors rise first and then fall in a definite range of strains when Ge is under uniaxially and biaxially tensile strains. Compared with unstrained Ge, Ge under [111] 1.22% strain possesses excellent optical properties: reasonable forbidden bandwidth, higher static dielectric, higher absorption coefficient, lower loss function and lower strains.
Ge; first principle; strain; optical properties
1000-7032(2017)06-0702-07
2016-11-24;
2017-01-04
国家自然科学基金青年科学基金(11604016);北京市教育委员会科技计划一般项目资助 Supported by National Natural Science Foundation for Youth of China(11604016); General Project of Science and Technology Program of Beijing Education Commission
O472+.3
A
10.3788/fgxb20173806.0702
*CorrespondingAuthor,E-mail:zhangpeng1998@126.com
