SiC MOSFET 栅极漏电流传输机制研究*
2023-10-25鹿存莉谈威季颖赵琳娜顾晓峰
鹿存莉,谈威,季颖,赵琳娜,顾晓峰
(江南大学电子工程系物联网技术应用教育部工程研究中心,江苏 无锡 214122)
1 引言
由于SiC 材料具有禁带宽度大、导热性高和击穿电场高等优异的物理性能[1-2],使得SiC MOSFET 在高压、高温和高开关频率应用领域显示出巨大的应用前景[3-5]。然而,由于复杂的氧化过程,分布在SiO2层中的高密度缺陷会加速栅极氧化物的退化,并导致SiC MOSFET 的过早击穿[6]。器件的栅极漏电流反映了栅极氧化层缺陷的产生过程,因此研究人员深入研究了SiC MOSFET 器件栅极漏电流的传输机制,并提出了几种具有建设性的电流传输模型。AVINO-SALVADÓ等人基于FN(Fowler-Nordheim)隧穿机制,计算出173~523 K 温度范围内的平面型SiC MOSFET 的SiC/SiO2界面的电子势垒高度为2.76~2.96 eV[7];SOMATANI 等人提出,由于碳相关缺陷或氧空位缺陷的存在,当平面型4H-SiC MOSFET 温度高于300 K时,PF(Poole-Frenkel)发射机制在栅极氧化物的漏电流传输过程中占主导地位[8]。XIANG 等人基于热解和干氧中氧化制造的4H-SiC MOSFET,通过温度相关电流电压(T-I-V)测试,提出在高电场下FN 隧穿和PF 发射共同主导了栅极漏电流[9];CHEN 等人基于T-I-V 试验方法和时间依赖的介电击穿测量(TDDB)方法,评估了平面型SiC MOSFET 结型场效应晶体管(JFET)区栅极氧化物和沟道区栅氧化物的可靠性,提出了沟道栅极氧化物比JFET 区域的栅极氧化物更容易发生FN 隧穿效应[10];CHBILI 等人认为TAT(Trap-Assisted Tunneling)隧穿是导致平面型SiC MOSFET 器件栅极氧化物中漏电流增加和栅极氧化物发生早期击穿的原因[11]。上述文献从不同机制深入研究了栅极出现漏电流的原因,然而同时研究不同温度下正反向偏置时的栅极漏电流传输机制的文献较少,此外,还有一些学者计算了不同温度下的势垒高度,却没有解释势垒高度随温度变化的原因。因此,本文在300~450 K 的温度范围内,通过T-I-V 测量方法,深入研究了SiC MOSFET 在正向和反向栅极高偏置下的电流传输机制,并阐述了势垒高度与温度的关系。
2 器件结构与测试方法
试验选用1 200 V/40 A/80 mΩ 的平面型SiC MOSFET 作为待测器件(DUT)。阈值电压Vth约为4.5 V,零栅极电压漏极电流Idss的典型值(漏源极电压Vds=1 200 V,栅源极电压Vgs=0 V)为1 μA,最大值为100 μA,栅源极漏电流Igss的典型值(Vgs=20 V,Vds=0 V)为1 nA,最大值为100 nA,图1 为SiC MOSFET的横截面和SEM 图。
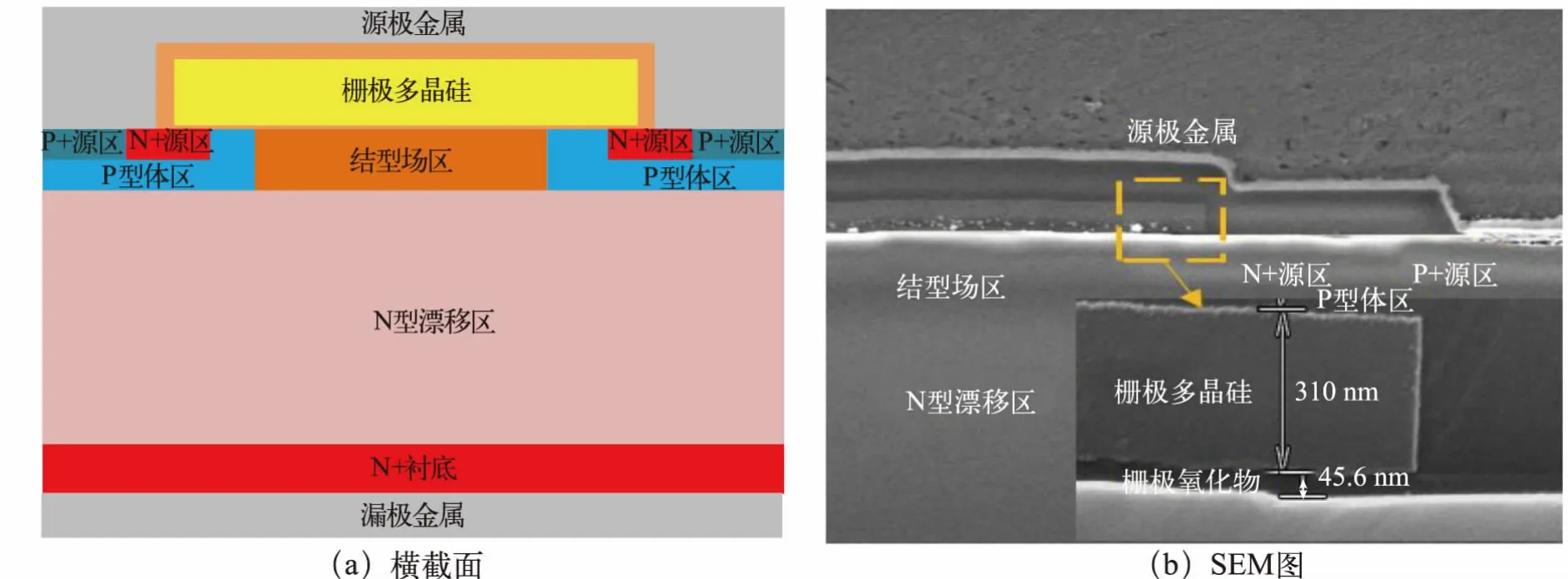
图1 SiC MOSFET 的横截面和SEM 图
SiC 外延层厚度为12 μm,器件的栅极长度、沟道长度以及栅极氧化物的厚度分别为5 μm、0.5 μm、50 nm。P 型体区和N 型漂移区的掺杂浓度分别为1×1017cm-3、8×1015cm-3。室温下,在SiC 芯片的N 型漂移区上,以4°的倾斜角注入铝离子形成P 型体区,同时通过注入大剂量的磷离子形成N+ 源区和N+ 衬底,随后淀积厚度为50 nm 的栅极氧化物,并淀积多晶硅层作为器件的栅极,最后淀积铝金属和钛/镍/银层作为源极和漏极。
使用Keithley 2636B 双通道系统数字源表和TC-77K 温度控制器测量DUT 的T-I-V特性,测试方法为将器件的漏极和源极短接接地,栅极电压从-35 V扫描到35 V,测试温度范围为300~450 K,步长为25 K。不同温度下Igss-Vgs测试曲线如图2 所示,Igss在正向栅极高偏压(30~35 V)和反向高偏压(-28~-35 V)下随着温度升高而增大。

图2 不同温度下Igss-Vgs 测试曲线
3 测试结果和分析
3.1 电流传输机制
FN 隧穿和PF 发射的两种电流传输模型如图3所示。其中,EC为导带底能级,EV为价带顶能级。
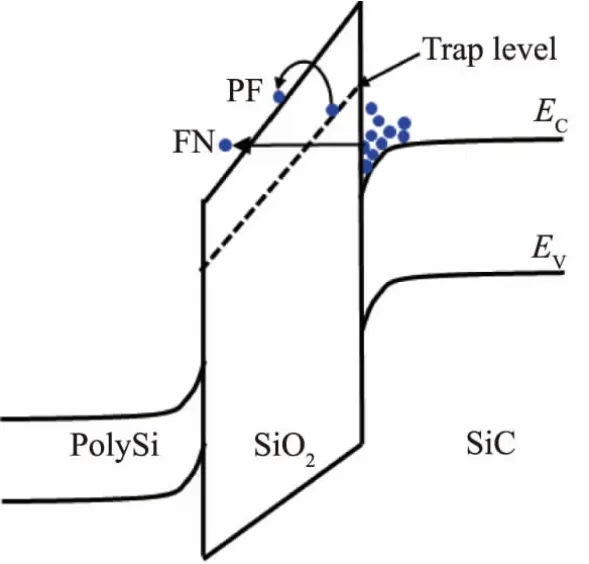
图3 FN 隧穿和PF 发射的两种电流传输模型
当栅介质层厚度大于5 nm 并处于高电场下,载流子从金属或半导体接触的导带隧穿到电介质的导带中,形成FN 隧穿电流[7]。FN 隧穿的电流密度JFN[12]可表示为
其中,A和B为与势垒相关的参数,q是电子的电荷量,Eox是栅极氧化层的电场强度,mox是SiO2中的有效电子质量,mSiC是SiC 中的有效电子质量,mox=0.42m0,mSiC=0.29m0,m0是自由电子质量,h是普朗克常数,ΦB是SiC/SiO2界面的电子势垒高度。整理公式(1)得到
从式(4)可以看出,若器件的Igss由FN 隧穿机制主导,则ln(JFN/)与呈线性关系,斜率为-B,截距为lnA。
PF 发射是高偏压下的一种陷阱辅助机制,PF 机制的发生与材料中的强电场有关,强电场使得能带出现弯曲,导致材料中的缺陷能级减小[13]。PF 机制的电流密度JPF[14]可表示为
其中,δPF是PF 的导电系数,δPF=qμn,n是氧化物导带中的态密度,μ 是氧化物中的电子迁移率。Φt是缺陷态电子发射势垒高度,ε0是真空中的介电常数,εSiO2是SiO2的相对介电常数,T是绝对温度,k是玻尔兹曼常数。将式(5)进行整理得到
从式(6)可以看出,若器件的Igss由PF 发射机制主导,则ln(JPF/Eox)与E1/2ox呈线性关系,其中m(T)为斜率,b(T)为截距。
3.2 正向栅电流传输机制
栅极正向高偏压下不同温度的ln(JFN/E2ox)与的关系如图4 所示,从图4 可以看出,ln(JFN/)与呈线性关系,符合FN 隧穿特性,说明FN 隧穿机制在正向栅极高偏置下主导了栅极漏电流的传输过程。
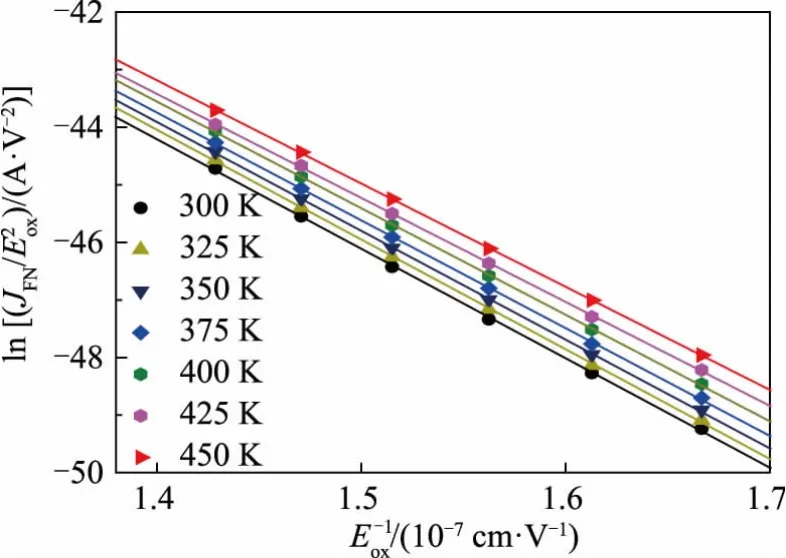
图4 栅极正向高偏压下不同温度的ln(JFN/)与 的关系
由于SiC/SiO2界面的电子势垒高度对载流子传输机制起着重要作用,因此基于图4 计算了ΦB随温度的变化关系。由于ln(JFN/)与呈线性关系,其斜率为-B,由式(3)计算可得ΦB的值。正向和反向偏压下ΦB随温度的变化关系如图5 所示,在正向栅极偏置,300~450 K 的温度范围内,ΦB的范围为2.58~2.69 eV,与文献[7]得到的势垒高度值(2.7 eV)接近。从图中可以看出,ΦB与T呈线性关系,在300~450 K 范围内ΦB随着温度的升高而逐渐降低,dΦB/dT拟合结果为-0.768 meV·K-1,与理论值(-0.7 meV·K-1)相符[7]。因此,ΦB随温度的升高而降低、图2 中Igss随温度的升高而逐渐增大的原因可解释为,当温度升高时,原子围绕其平衡点做随机运动,即鞍点的高度开始波动。如果附近的原子恰好靠近彼此,鞍点高度将减小,若原子之间的距离增加,则鞍点高度增加。总体来看,由于式(1)的指数特性,势垒高度降低时电流密度的增加趋势远大于势垒高度升高时电流密度的减少趋势,这意味着随着温度升高,Igss逐渐增大,平均势垒高度降低[15]。

图5 正向和反向偏压下ΦB 随温度的变化关系
此外,由于热生长的SiC MOSFET 氧化物中存在缺陷[8],PF 发射也被认为是栅漏电流的传输机制之一。图6 为不同温度下正向高偏压的ln(JPF/)与的关系。从图6 中提取斜率m(T),并根据公式(6)中的斜率m(T)的表达式计算出εSiO2的值为0.76~1.52,这与εSiO2的理论值3.9 相差较大,因此基于拟合结果排除了PF发射机制对高偏压下栅极电流的主导作用。
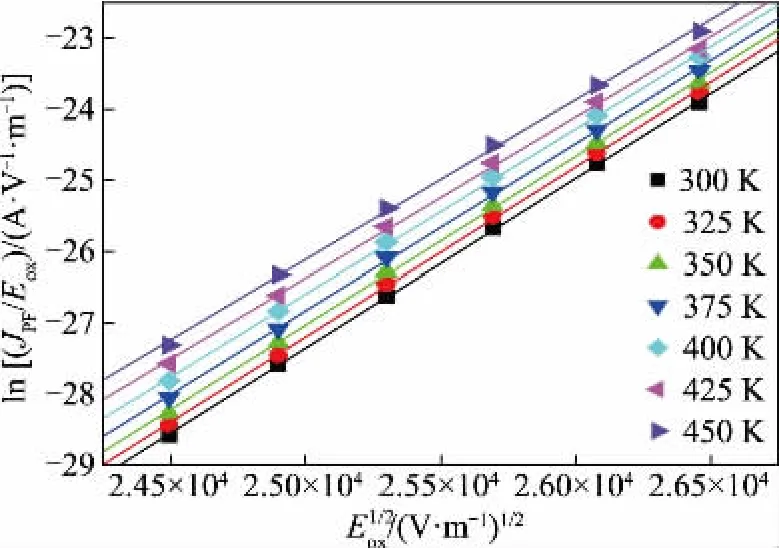
图6 不同温度下的ln(JPF/Eox)与 关系
3.3 反向栅电流传输机制
反向栅极偏压不同温度下的ln(JPF/)与的关系如图7 所示,从图中可以看出,ln(JPF/)与遵循线性关系,符合FN 隧穿特性。图5 中的黑色线为计算得到反向栅极偏压和不同温度下的ΦB,其范围为3.02~3.26 eV,与理论值(3.15 eV)一致[16]。通过对ΦB与T的拟合,得到dΦB/dT拟合结果约为-1.47 meV·K-1。ΦB与温度T的关系为线性函数,即ΦB=-1.47×10-4×T+3.69。

图7 反向栅极偏压不同温度下的ln(JFN/)与 的关系
由于SiC MOSFET 栅极氧化物的可靠性与栅极漏电流密切相关,图2 中,当正向偏压大于30 V、反向偏压小于-28 V 时,Igss开始呈指数增长。由于SiC MOSFET 的沟道区栅极氧化物比JFET 区栅极氧化物更容易发生FN 隧穿,导致平面型SiC MOSFET 发生FN 隧穿时出现不对称的Vgs[10]。通过对比正反向栅电流传输机制发现,当栅极处于反向高偏置时,势垒高度随温度下降得更快。原因在于当温度升高时,原子围绕其平衡点做随机运动,即靶点高度开始波动,平均势垒高度随温度升高而降低,当栅极处于反向高偏置时,JFET 区域的空穴注入到栅极氧化物中,与此同时随着温度的升高碰撞电离增强,产生了大量的电子-空穴对,注入到栅极氧化物中的空穴浓度进一步增大,电子势垒高度进一步降低。
4 结论
本文主要研究了SiC MOSFET 的栅极漏电流传输机制。通过对300~450 K 温度范围的栅电流数据进行拟合,提出了正向高偏置下的栅电流传输由FN 隧穿机制主导,并通过FN 隧穿公式计算得到势垒高度的范围为2.58~2.69 eV,且在300~450 K 范围内随着温度的升高而逐渐降低,dΦB/dT 约为-0.768 meV·K-1。基于拟合结果排除了PF 发射机制对高偏压下栅极电流的主导作用。对反向高偏压下的栅极漏电流传输数据进行拟合,得出栅漏电流传输同样由FN 隧穿机制主导,计算得到FN 隧穿时的势垒高度的范围为3.02~3.26 eV,且在300~450 K 范围内随着温度升高而逐渐降低,dΦB/dT 拟合结果约为-1.47 meV·K-1。对比正反向栅电流传输机制发现,当栅极处于反向高偏置时,势垒高度随温度下降得更快。这是由于在正向栅极电流传输机制中,当温度升高时,原子围绕其平衡点做随机运动,即鞍点的高度开始波动。由于FN 隧穿模型的指数特性,势垒高度降低时电流密度的增加趋势远大于势垒升高时电流密度的减少趋势,表现为温度升高,ΦB随温度的升高而降低,Igss随温度的升高而逐渐增大。而在反向栅极电流传输机制中,平均势垒高度随温度升高而降低的同时,由于碰撞电离产生了大量的电子-空穴对,注入到JFET 区栅极氧化物中的空穴浓度增大,势垒高度进一步降低,因此反向高偏压下势垒高度随温度升高下降的速度更快。本文研究的高电场下SiC/SiO2界面的电流传导机制,有利于优化SiC MOSFET 器件的工艺和可靠性设计。
