Si 杂质扩散诱导InGaAs/GaAs(P)量子阱混杂研究
2022-05-28王予晓朱凌妮孔金霞刘素平马骁宇
王予晓,朱凌妮,仲 莉,孔金霞,刘素平,马骁宇,3
(1.中国科学院半导体研究所 光电子器件国家工程中心,北京 100083;2.中国科学院大学 电子电气与通信工程学院,北京 100049;3.中国科学院大学 材料科学与光电技术学院,北京 100049)
1 引言
自1962 年问世至今,半导体激光器被广泛应用于光纤通信、信息存储、工业加工等多个领域,成为现代科学发展不可或缺的一部分。975 nm半导体激光器是固体激光器及掺铒光纤放大器的良好泵浦源。随着光纤通信技术的发展,人们对泵浦源的功率、光束质量以及可靠性要求逐渐提高。而腔面光学灾变损伤(Catastrophic Optical Mirror Degradation,COMD)一直是影响大功率半导体激光器输出功率及可靠性的重要因素[1-3]。
预防COMD 的主要方法有:(1)使用大光腔结构或锥形结构等,以降低激光器输出光功率密度;(2)在腔面镀光学膜或钝化膜等,以减少腔面缺陷,从而减少非辐射复合;(3)利用二次外延或量子阱混杂(Quantum Well Intermixing,QWI)技术,增大腔面处量子阱材料的禁带宽度,形成腔面非吸收窗口(Non-Absorbing Window,NAW)。量子阱混杂技术主要分为高温退火、杂质诱导、空位诱导、离子注入、激光诱导等方式[4-6],其目的都是通过在外延层内部引入点缺陷,促进量子阱与量子垒组分互扩散,增大腔面处带隙宽度,减小腔面光吸收。其中高温退火技术容易实现,但重复性和可靠性差;空位诱导技术退火温度过高,容易造成器件量子阱结构损坏,离子注入技术和激光诱导技术等所需设备昂贵,工艺成本较高[7]。相比之下,杂质诱导量子阱混杂技术工艺简单、可重复性好,因而被广泛应用。
自20 世纪80 年代起,Si 在GaAs 基半导体中的扩散引起广泛研究,并被应用于半导体激光器波长调谐[8]、腔面非吸收窗口以及掩埋异质结半导体激光器制备[9]等。Si 杂质一般通过介质膜生长[5-8,10]、离子注入[11-12]或使用Si 化合物量子垒材料[13]等方法引入,高温退火促进Si 杂质扩散,诱导量子阱和量子垒元素互扩散。国内对Si 诱导量子阱混杂研究少有报道。
本文实验分析了Si 介质膜厚度、退火条件、量子垒材料、牺牲层材料等对InGaAs/GaAs(P)量子阱混杂的影响,旨在找到最优化的条件以应用于GaAs 基半导体激光器,以在不影响器件效率的基础上提高器件的COMD 阈值和可靠性。
2 芯片生长及测试
本文主要针对InGaAs/GaAs(P)量子阱结构进行了Si 杂质诱导QWI 研究,采用不含P(GaAs)和含P(GaAsP0.12)两种外延结构,研究量子垒材料对QWI 效果的影响。量子阱不含P(GaAs)外延结构记作W1,含P(GaAsP0.12)记作W2。外延结构如图1(彩图见期刊电子版)所示。
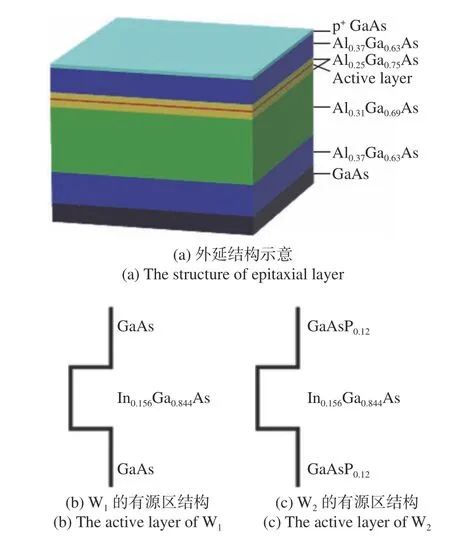
图1 两种外延结构示意图Fig.1 The structures of two types of epitaxial layers
早期实验发现,高温退火后,Si 介质膜性质因为发生改变而难以去除,且处理后外延片表面变得粗糙,欧姆接触层遭到破坏,以上问题会影响芯片电极制备,进而降低器件性能。因此本文引入了牺牲层结构,在Si 介质膜和欧姆介质层间生长50 nm InGaP(记作S1),退火后可以采用化学试剂有选择性地去除表面介质层和S1层而不破坏欧姆接触层,下文未特别声明均采用InGaP 牺牲层。
目前已报道的文献中,由于外延结构、材料、限制层掺杂材料及浓度、Si 杂质引入方式以及退火方式等的不同,Si 杂质诱导所产生的蓝移效果也不尽相同。由于过高的退火温度可能会引入额外的缺陷,影响激光器性能,本文的实验选取800 ℃以下的退火温度。退火设备采用管式退火炉,使用N2作为保护气体,实验样片上下表面覆盖GaAs 衬底片形成As 压保护。实验主要通过光致荧光(Photoluminescence,PL)谱表征退火造成的波长蓝移量。由于应用于NAW 的QWI 技术的主要目的是诱导量子阱波长蓝移,且PL 谱的强度变化受测试过程中腐蚀条件的影响较大,因而本文采用归一化的PL 谱来分析QWI 对波长漂移的影响。生长Si 介质膜之前对外延片测量PL 谱,W1和W2的原始波长分别为961.5 nm和960.2 nm。
3 实验及结果分析
3.1 介质膜厚度对QWI 的影响
介质膜厚度不同会产生不同的QWI 效果。实验测量了不同Si 厚度下的波长蓝移。在800 ℃、4 h 的退火条件下,对比了Si 介质膜厚度分别为70 nm 和150 nm 时对波长蓝移的影响,如图2(a)、2(b)(彩图见期刊电子版)所示。可以看到在Si 厚度分别为70 nm 和150 nm时,W1的蓝移量分别为19.6 nm 和17 nm,W2的蓝移量分别为25.4 nm和22.1 nm,不同的厚度对蓝移量的影响差别不大,70 nm 厚度促进效果相对较好。在780℃、10 h条件下,对比了Si 介质膜分别为50 nm 和70 nm时的PL 谱表征结果,如图2(c)(彩图见期刊电子版)所示,蓝移量分别为60.4 nm 和70.5 nm,Si 厚度为70 nm 时有较好的促进蓝移效果。由此选定70 nm 作为后续实验Si 介质膜的厚度。
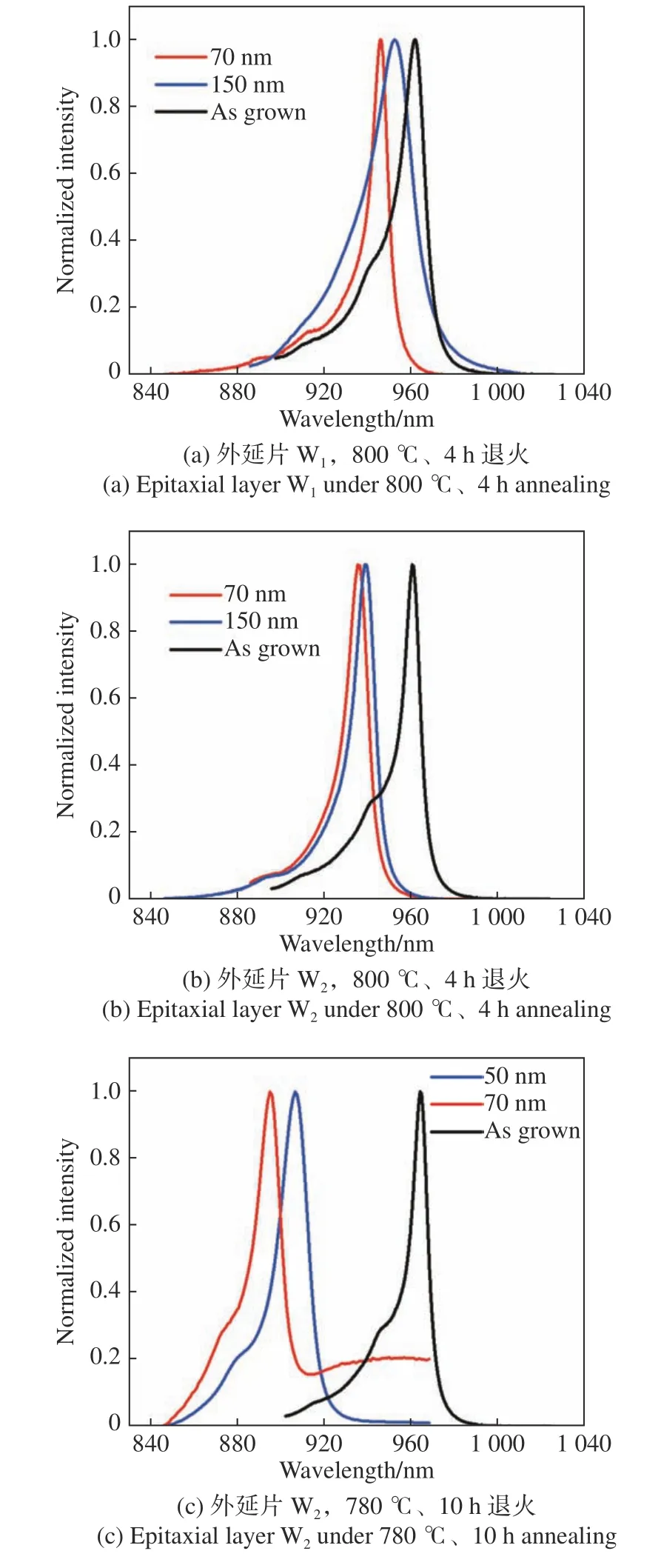
图2 不同Si 介质膜厚度下退火后的归一化PL 谱Fig.2 Normalized PL spectra varying with different Si dielectric film thicknesses after annealing
3.2 退火条件(温度、时间)对QWI 的影响
图3 为采用70 nm Si 介质膜时,W1、W2两种外延结构在不同退火条件下的归一化PL 谱表征结果。可以看到两种结构的PL 谱有相同的变化趋势。仅观察前4 组图像,发现蓝移量随退火时间和温度的增大而增大,在780 ℃、10 h 条件下分别达到32.6 nm 和70.2 nm 的蓝移。而在退火时间为10 h,退火温度大于795 ℃时,相同测试条件下,两种结构的PL 表征结果均呈现强度极弱(归一化图上未体现)的宽谱线,量子阱激射峰消失。认为可能是由于元素互扩散,量子阱与量子垒组分接近相同,不再有阱垒的界限,量子垒失去了对载流子的限制作用,因而不再发生受激辐射。

图3 当Si 厚度为70 nm,牺牲层为InGaP,不同退火条件下的PL 谱Fig.3 PL spectra under different annealing conditions when the thickness of Si is 70 nm with InGaP as sacrificial layer
退火温度为800℃、退火时间为4 h 时,两种结构波长蓝移量较小,最多只有25.4 nm,而将退火时间延长到10 h,激射峰消失。对于上述现象,认为是当退火时间较短时,Si 杂质扩散深度较浅,量子阱发生轻度混杂,导致PL 谱波长蓝移;而退火时间足够长时,Si 扩散至量子阱并充分促进阱垒元素互扩散,量子阱被破坏,因而无法测得正常谱峰,呈现强度极低的宽谱线。
Si 杂质常用作GaAs/AlGaAs、InGaAs/GaAs等量子阱结构的混杂诱导元素,认为其混杂机理是量子阱与量子垒的Ⅲ族元素互扩散导致量子阱组分变化,进而增大量子阱带隙,使波长蓝移。多数文献中提出Ga、Al 元素会发生扩散诱导混杂,但对于In 元素的扩散却没有固定的结论。为了探索本文退火实验中是否存在In 扩散,对800 ℃、10 h 下退火的样片进行二次离子质谱(Secondary Ion Mass Spectroscopy,SIMS)测试,如图4(彩图见期刊电子版) 所示。可以看到,该温度下W1、W2两种外延结构的Si 浓度均在1.7 μm 处骤降,说明Si 已经扩散至1.7 μm,到达量子阱以下,与图4(c)SiN 保护下未扩散的结果相比,Si 诱导混杂后的样片在量子阱处的In 元素向阱外两侧有明显的扩散,且InGaP 牺牲层中In 也有向下扩散的现象。结合文献[14],认为对于本文采用的In-GaAs/GaAs 和InGaAs/GaAsP 结构,阱垒In、Ga元素互扩散是本结构发生QWI 的主要原因。
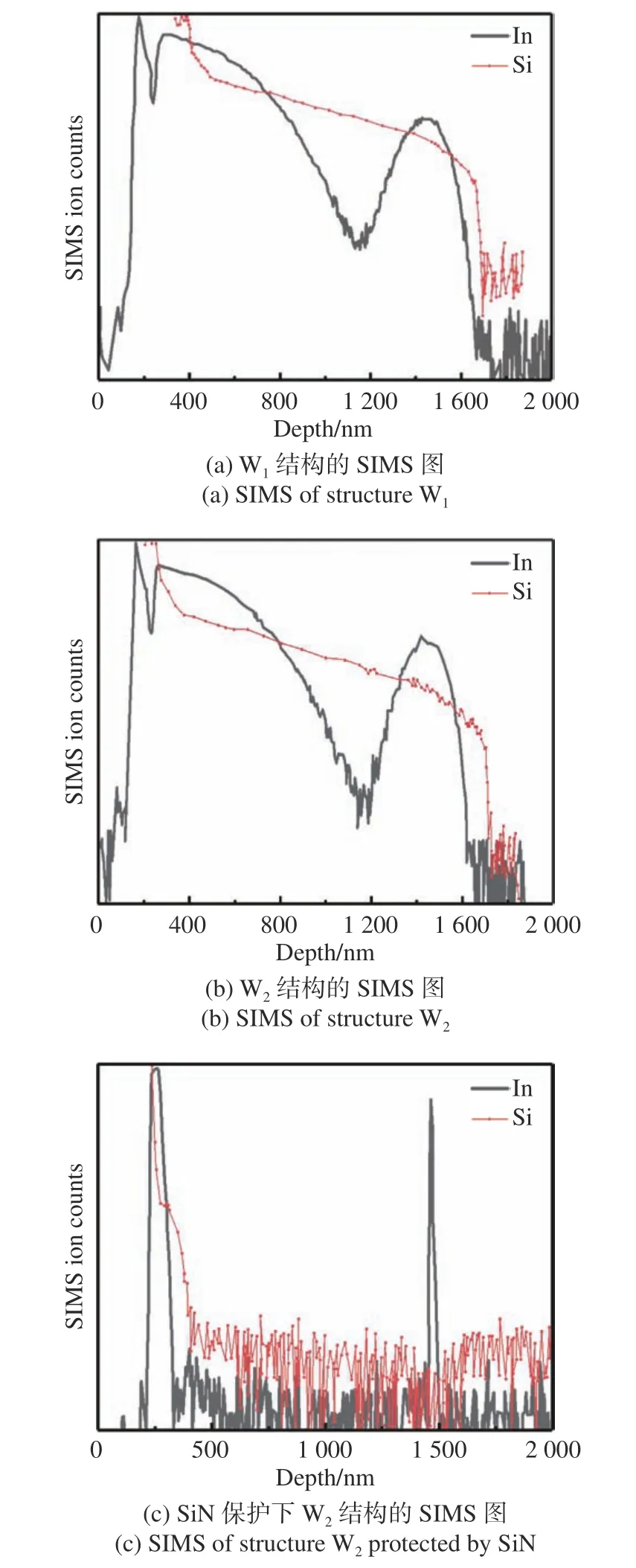
图4 800 ℃/10 h 下退火后,W1、W2 外延片在硅诱导下以及W2 在SiN 保护下的SIMS 图Fig.4 SIMS of samples with W1 and W2 structure induced by Si and W2 structure protected by SiN after 800 ℃、10 h annealing
本文对退火时间的选择较少,需要进一步实验得到Si 破坏量子阱的临界点,尽量缩短退火时间,减小对外延片的损伤。另外由图3 可以看到,选择退火时间为10 h 时,当退火温度从780 ℃增加到795 ℃,仅15 ℃的差别即导致量子阱破坏,说明QWI 效果对于退火的温度较为敏感。后续实验可以通过微调退火温度来减小退火时间。
3.3 量子垒材料对QWI 的影响
由图3 可以看到在780 ℃、4 h,780 ℃、10 h 以及800 ℃、4 h 退火条件下,外延结构W2的蓝移量分别为22.5 nm、70.5 nm 和25.4 nm,分别比相同退火条件下的W1结构的蓝移量增加了15.5 nm、40.6 nm 和5.8 nm。由此推测Si 在外延结构中的扩散速度与量子垒P 含量有关,且P 元素的存在可以促进Si 的扩散。
3.4 牺牲层材料对QWI 的影响
采用W1外延结构,在780 ℃、4 h 退火条件下,实验验证了有无牺牲层的QWI 效果,图5(彩图见期刊电子版)为归一化PL 表征结果。无牺牲层时,波长蓝移为4.8 nm;而有S1牺牲层时,蓝移量为23.5 nm,说明S1牺牲层对于蓝移有促进作用。为了探索牺牲层材料对QWI 的影响,应用InGaP 和AlGaAs 两种牺牲层进行了QWI 对比实验,实验采用W2外延结构。Si 介质膜厚度为50 nm(同步于厚度实验,所以未采用最佳厚度),退火条件为780 ℃、10 h,PL 谱表征结果如图6(彩图见期刊电子版)所示。牺牲层为In-GaP 时的样片,蓝移量达到60.1 nm,而牺牲层为AlGaAs 的样片蓝移只有17.5 nm。
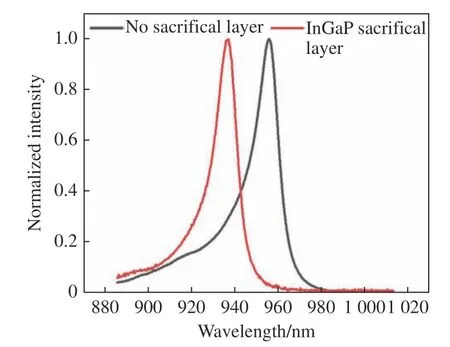
图5 有无牺牲层的W1 外延片在780 ℃、4 h 条件下退火后的PL 图像Fig.5 PL spectra of structure W1 with and without a sacrificial layer after annealing at 780 ℃、4 h
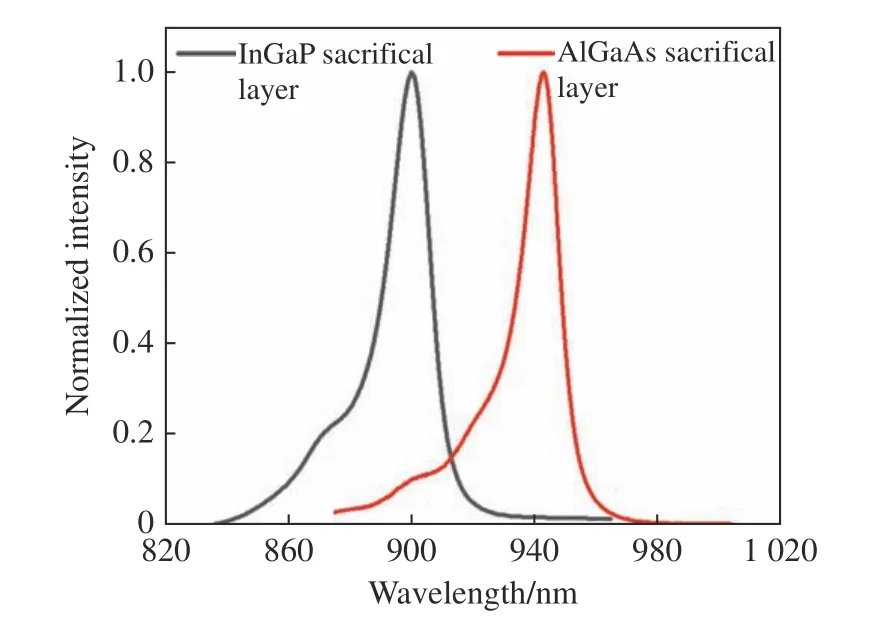
图6 不同牺牲层结构的W2 外延片在780 ℃、10 h 条件下退火后的PL 图像Fig.6 PL spectra of structure W2 with different sacrificial layers after annealing at 780 ℃、10 h
文献[15] 提出由Si 诱导的Iny(AlxGa1-x)1-yP结构的无序主要由Ⅲ族晶格原子引起,在Si 扩散过程中引发Ga、In、Al 原子脱离晶格原点,形成对应空位和间隙原子缺陷,由于层间组分不同,缺陷在层间扩散,进而形成混杂,而P 元素在混杂过程中不会发生扩散。对于本文采用的外延结构,外延层材料主要为Al0.25~0.37GaAs,由于牺牲层材料与限制层间的材料组分浓度梯度,热退火之后在Si 扩散的主要区域会诱导产生大量的Ⅲ族缺陷,这些缺陷在热作用下向量子阱运动,增大量子阱附近的缺陷浓度,量子阱与量子垒元素在缺陷和材料组份浓度梯度共同作用下发生元素互扩散,实现量子阱混杂。对于AlGaAs 牺牲层,其与限制层组分差别较小,产生的Al、Ga 晶格缺陷较少。相反,InGaP 牺牲层与限制层Al0.25~0.37GaAs的In 和Al 浓度差异较大,可产生较多的Ⅲ族元素晶格缺陷,因而InGaP 牺牲层相较于Al-GaAs 牺牲层对阱垒元素的混杂有更大的影响,对应产生的波长蓝移也更大。
4 结论
本文基于GaAs 基半导体激光器外延结构,采用高温管式炉退火的方式,探索了Si 介质膜厚度、退火条件、量子垒材料以及牺牲层材料对量子阱混杂效果的影响。实验发现,量子阱和量子垒的混杂效果随着扩散时间以及退火温度增加而增大,但对温度尤其敏感。量子垒含P 可以在一定程度上促进阱垒混杂互扩散。不含P 和含P 的量子垒在780 ℃、10 h 退火条件下波长蓝移分别为29.9 nm 和70.5 nm,在795 ℃、10 h 条件下,量子阱被破坏,激射峰消失。此外,相同外延结构下,InGaP 牺牲层结构相比AlGaAs 牺牲层有更好的促进蓝移效果。本文结果仅通过小片实验样片获得,后续将进行半导体激光器芯片的量子阱混杂工艺制备,以验证Si 诱导量子阱混杂工艺对器件光电性能及其可靠性的影响。
猜你喜欢
杂志排行
中国光学的其它文章
- 面结构光在机检测的叶片反光抑制技术
- Structural optimization and performance testing of gold microarray electrode fabricated by DMD lithography and electrodeposition
- A study on the epitaxial structure and characteristics of high-efficiency blue silicon photodetectors
- 基于自抗扰算法的光电跟踪伺服控制方法研究
- 基于液晶光波导的电控偏振旋转器
- 基于焦面复制方法的自适应光学系统静态像差校正技术
