基于PSP-SOI,BSIM-IMG和HiSIM-SOTB的DG SOI建模与仿真
2020-06-08汪国芳吴钰鑫
汪国芳,刘 军,吴钰鑫,罗 琳
(杭州电子科技大学射频电路与系统教育部重点实验室,浙江 杭州 310018)
0 引 言
随着集成电路工艺逐步进入纳米尺度,互补金属氧化物半导体(Complementary Metal Oxide Semiconductor,CMOS)和传统的平面单栅(Single Gate,SG)结构难以满足器件结构和材料所施加的物理极限要求[1]。为了满足上述要求并有效抑制短沟道效应,增强栅极对沟道的控制能力,双栅(Double Gate,DG)金属氧化物半导体场效应管(Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)器件[2]被提出并应用。研究表明,双栅结构在不影响器件良好电气特性的情况下能集成更多的沟道宽度和每单位硅面积的驱动电流[3],所以双栅绝缘体上硅(Silicon-On-Insulator,SOI)MOSFET具有广泛的应用前景。从行业实际应用情况来看,DG SOI MOSFET器件模型的选用并没有形成统一,比如BSIM-SOI,PSP-SOI,HiSIM-SOI,HiSIM-SOTB,BSIM-IMG等均出现在不同设计应用中,表现出不同的应用精度和适用性。表面势紧凑型模型因其表征精度高、模型参数表达简洁等优点发展为当前CMOS先进工艺节点模型开发的标准方法。其中,以基于表面势开发的PSP-SOI[4],HiSIM-SOTB[5]和BSIM-IMG[6]模型为代表,通过不同的模型方程来表征器件特性。本文分别采用PSP-SOI,HiSIM-SOTB和BSIM-IMG模型,对典型DG SOI MOSFET器件进行直流建模。通过3个模型的对比,建立DG SOI MOSFET器件的直流特性,对模型的适用性进行分析,选出一种相对适用于DG SOI MOSFET器件直流建模的模型。
1 模型分析
1.1 PSP-SOI
PSP-SOI模型是基于PSP模型[7]开发的一种模型,在直流对称性和高阶倒数连续性上具有优势,主要包含将近400个模型参数和方程,具有漏致势垒降低(Drain Induced Barrier Lowering,DIBL)效应、浮体效应、自热效应等效应,详细描述了体电流机制。PSP-SOI主要包括表面势模型、漏电流模型、体电阻模型和电荷模型等。其中,表面势模型的计算忽略了泊松方程中的横向场梯度,如下所示:
(VGB-VFB-φs)2=γ2φT{exp(-u)+u-1+nbkn[exp(u)-u-1-χ(u)]/pb}
(1)


图1 PD-SOI体接触电荷模型

1.2 HiSIM-SOTB
为了实现超低电压集成电路设计和功能,日本广岛大学开发出一种新的紧凑型晶体管模型——HiSIM-SOTB模型。HiSIM-SOTB模型具有超薄SOI和BOX层,可作为薄埋氧化物上硅器件的标准模型,适用于低压电路设计。HiSIM-SOTB模型不仅具有可控的阈值电压和软错误免疫力,而且无掺杂的SOI沟道还能提供更好的性能、更低的噪声、更高的精度以及更低的操作功耗[8]。HiSIM-SOTB模型的结构如图2所示。Vs为参考电压(本文中Vs=0),Vgs为前栅到源的电压,Vds为漏到源的电压,Ves为背栅或者衬底到源的电压,TFOX为栅氧化层厚度,TBOX为BOX层厚度,TSOI为SOI层厚度,NSUBS为沟道掺杂浓度,NSUBB为衬底掺杂浓度。图3描述了HiSIM-SOTB模型中的SOTB-MOSFET器件沿垂直方向的电位分布,可以看到SOI层内的φ′b及3个表面电位(φb,φbulk,φs)。
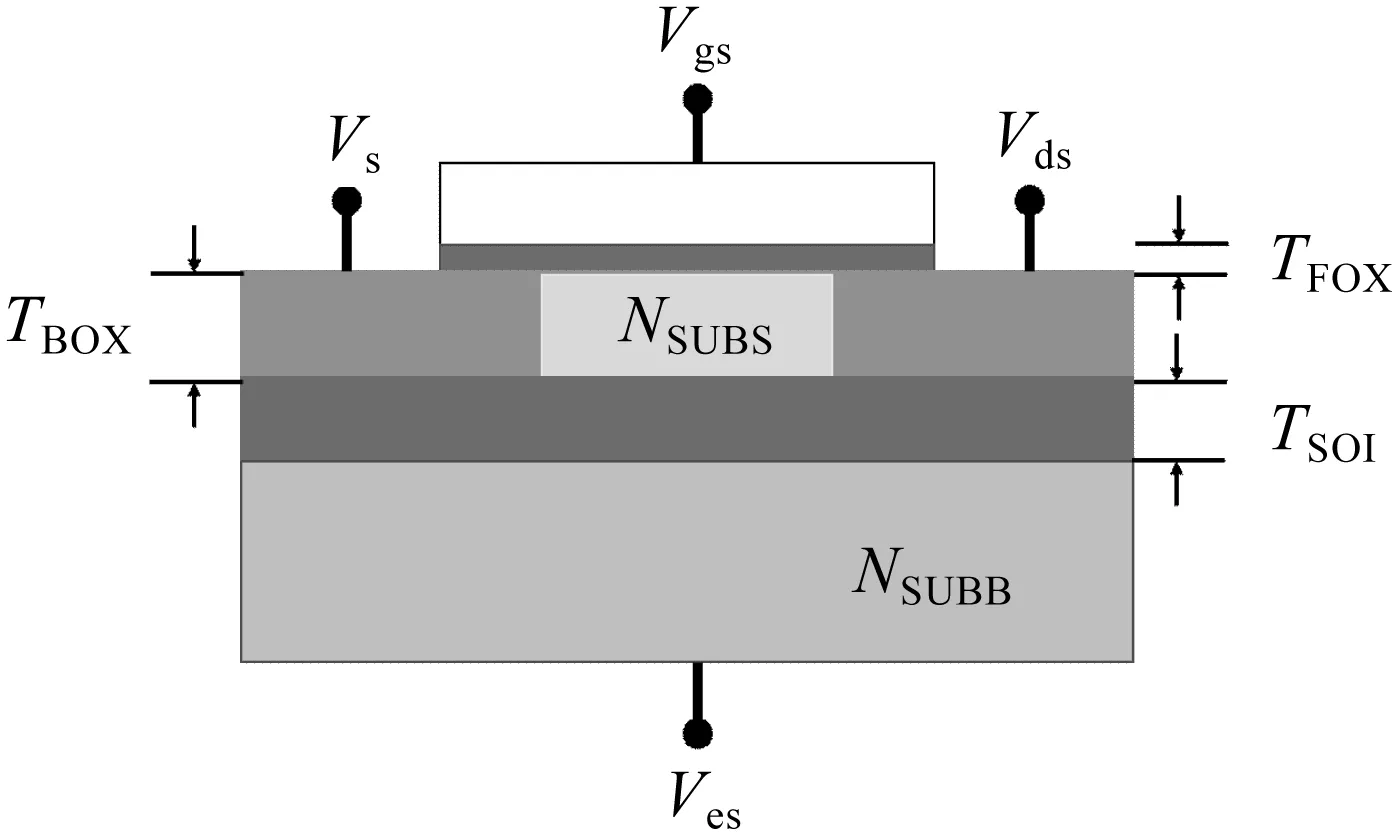
图2 HiSIM-SOTB模型结构

图3 HiSIM-SOTB模型中沿器件垂直方向的电位分布图
HiSIM-SOTB模型通过高斯定律求解4个表面势,求解过程如下:
φs=Vgs-VFB+ΔVth+(Qbulk+Qi+Qdep,SOI+Qb+Qh)/CFOX
(2)
式中,Qdep,SOI=Qs,dep+Qb,dep,Qi,Qb,Qs,dep,Qb,dep分别为前栅表面和背栅表面处的反转电荷以及前栅表面和背栅表面处引起的耗尽电荷,Qbulk为在体衬底处BOX表面引起的体电荷,Qh为由于碰撞电离引起的SOI层中的过量电荷。
当Qbulk<0时,前表面势控制沿器件深度方向平滑电位的变化(φb=φ′b)
φs-φ′b=(2Qbulk+Qdep,SOI)/2CSOI
(3)
当Qbulk>0时,背表面势控制沿器件深度方向平滑电位的变化(φs=φ′b)
φb-φ′b=(2Qbulk+Qdep,SOI)/2CSOI
(4)
当Qbulk≈0时,前表面势和背表面势都可控制沿器件深度方向平滑电位的变化(Qbulk<0与Qbulk>0之间的过渡区)
φb=φs=(2Qbulk+Qdep,SOI)/2CSOI
(5)
φbulk=φb+Qbulk/CBOX
(6)
为求解4个表面势,需要至少4个条件方程,因此,加入式(3)-(5)这3个不同偏置条件的方程以及利用高斯定律推导的1个附加方程(6)。进一步通过得到的4个表面势计算沟道两端的电荷。在SOTB-MOSFET器件中,对电流有贡献的是反转电荷Qi和Qb,通过电荷积分得到漏极电流Ids,f=Weff·N·μf·Idd,f/β·(Leff-ΔL)和Ids,b=Weff·NF·μb·Idd,b/β·(Leff-ΔL)。在渐近沟道近似下,可以将器件看成栅极结构和均匀掺杂的沟道结构,这时,漏极电流方程为Ids=Ids,f+Ids,b,其中,Weff和Leff分别为有效沟道宽度和长度,ΔL为夹断区长度,μf和μb分别为Qi和Qb的高场载流子迁移率,N为栅的叉指数,Idd,f,Idd,b分别为前栅和背栅(或衬底)的诱导的电流。
1.3 BSIM-IMG

图4 BSIM-IMG模型结构
BSIM-IMG模型由加州大学伯克利分校开发,常用于描述高级工艺节点中的双栅器件。模型具有独立的双栅结构(前栅和背栅),前栅和背栅具有不同的功函数(Δφ1,Δφ2)、电介质厚度和介电常数。BSIM-IMG模型主要是通过全耗尽、轻掺杂和有效解析等方法近似计算泊松方程,得到源/漏两端的表面势和电荷密度,且BSIM-IMG模型的本征和非本征模型方程都是基于表面势方程推导的[9]。BSIM-IMG模型的结构如图4所示。EOT1和EOT2为前栅氧化层厚度和背栅氧化层厚度,TSI为硅体厚度,前栅电压为Vfg(后面统称栅极电压),背栅电压为Vbg。
通过对背栅电场的简化,利用泊松方程计算前栅和背栅的表面势[6]:
(7)
边界条件为:
Es1εsi=Cox1(Vfg-Δφ1-φs1)
(8)
Es2εsi=Cox2(Vbg-Δφ2-φs2)
(9)
式中,q为电子电荷,Nc为导带密度,Vth为热电压,Vch为沟道势能,Δφ1为前栅功函数,Δφ2为背栅功函数,Cox1和Cox2分别为前栅氧化层电容和背栅氧化层电容。假设背栅在弱反转区,则前栅表面势(φs1)和背栅表面势(φs2)之间的关系表示为φs2Cox2+Csi(φs2-φs1)=Cox2(Vbg-Δφ2),其中,Csi为硅层电容。考虑沟道的垂直电场对载流子迁移率退化的影响,即可得到漏极电流表达式:
ids0=qiaΔφ+VtΔqi
(10)
(11)
式中,qia,Δqi,Δφ分别为源漏端的平均电荷、电势,μ0为迁移率相关分量,Cox1为前栅氧化层电容,Moc为DIBL相关的输出电导分量,Dob为迁移率退化分量,Dr为串联电阻分量,Dvsat为速度饱和分量,Vt为阈值电压。Vt公式为:ΔVth,all=ΔVth,vtroll+ΔVth,dibl+ΔVth,rsce+ΔVth,dsc+ΔVth,nbody+ΔVth,temp+ΔVth,vbg。其中,ΔVth,vtroll表示Vt的Roll-off对阈值电压的影响;ΔVth,dibl表示DIBL效应对阈值电压的影响;ΔVth,rsce表示反向短沟道效应对阈值电压的影响;ΔVth,nbody表示衬底掺杂对阈值电压的影响;ΔVth,temp表示温度效应对阈值电压的影响;ΔVth,vbg表示背栅偏压对阈值电压的影响;ΔVth,dsc表示中等沟道长度的器件在高漏极偏压下的短沟道效应对阈值电压的影响。
与PSP-SOI模型和HiSIM-SOTB模型不同的是,BSIM-IMG针对背栅增加了背栅偏置效应和背栅耗尽,可以更好地控制BSIM-IMG中的阈值电压。
2 参数提取分析
选取沟道宽度和沟道长度分别为8 μm和3 μm的n型DG SOI MOSFET器件。在Cascade11000载片测试平台上,通过安捷伦4156C半导体器件参数分析仪进行C-V和I-V直流特性测试。在Keysight ICCAP建模软件中完成PSP-SOI,HiSIM-SOTB和BSIM-IMG模型的参数提取和仿真,结合测试数据和3种模型的仿真数据,选出一种最适用双栅器件的模型。
由于器件中的耗尽层受到栅极电压变化的影响,本征区的栅电荷引起的栅极电容Cgg随着栅极电压的变化而变化[10]。栅极电容随栅极电压的变化曲线如图5所示。从图5可以看出:HiSIM-SOTB模型对栅电容的拟合结果最好,而PSP-SOI和BSIM-IMG模型在负栅压偏置时无法精确拟合。因为HiSIM-SOTB模型考虑了器件中产生的所有电荷,所以可以精确表征部分耗尽结构中产生的电容;而PSP-SOI模型虽然考虑了部分耗尽结构,但在双栅结构的负栅压偏置时,平带电压对器件的C-V特性影响较小,无法精确表征C-V特性;BSIM-IMG模型只是对轻掺杂和全耗尽器件进行表征,没有电荷积累过程,也不能拟合好栅极电容的负偏压部分。
通过对测试数据的拟合得到3种模型的参数提取值,表1给出了3种模型的主要参数提取值,参数单位皆是行业标准单位(可以从每个模型的开发手册中查找)。图6分别展示了3种不同模型的阈值电压、线性电流和饱和电流,线性阈值电压的变化范围为400~700 mV,饱和阈值电压的变化范围为380~630 mV,线性电流的变化范围为36~51 μA,饱和电流的变化范围为200~390 μA。在Vds=100 mV时提取线性电流,在Vds=1.8 V时提取饱和电流,而阈值电压是通过公式计算得来,即:Id=10-7W/L。由于BSIM-IMG考虑了背栅偏置效应,可以更好地控制阈值电压,故BSIM-IMG比PSP-SOI和HiSIM-SOTB更精确。
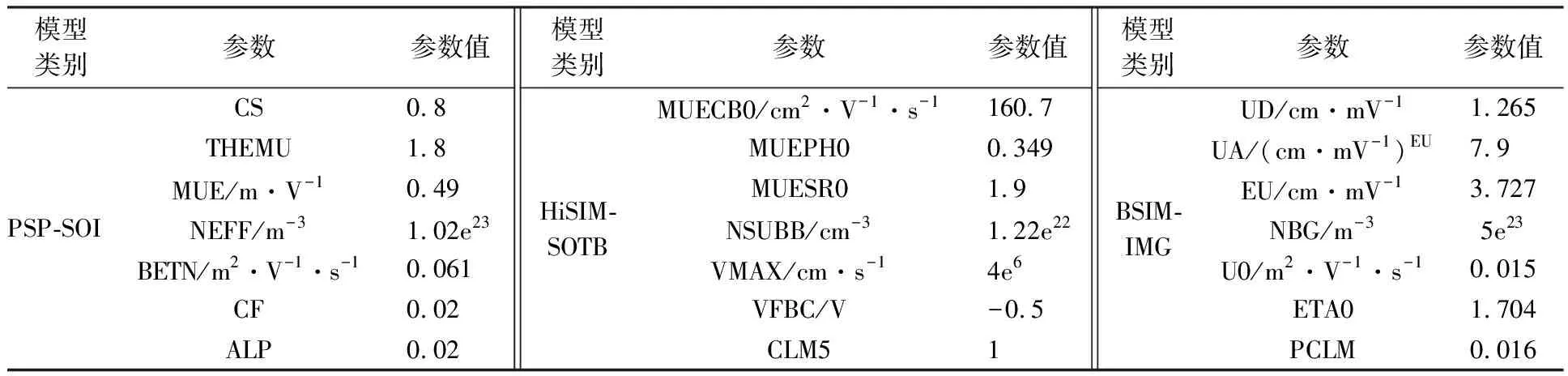
表1 3种模型的主要参数提取值

图6 3种模型表征的线性阈值电压、饱和阈值电压、线性电流和饱和电流与背栅电压的关系
进一步分析仿真数据和测试数据的精度误差,以Vth_lin为例,误差计算公式如下:
(12)
表2 3种模型仿真结果的精度误差对比 %

误差PSP-SOIHiSIM-SOTBBSIM-IMGeVth_lin5.2912.213.86eVth_sat5.5310.544.89eIds_lin5.218.141.40eIds_sat6.7711.994.32
式中,n为数据的点数,Vi,sim为仿真数据,Vi,meas为测试数据。通过PSP-SOI,HiSIM-SOTB和BSIM-IMG模型表征的阈值电压(Vth_lin,Vth_sat),线性电流(Ids_lin)和饱和电流(Ids_sat)的仿真精度误差如表2所示。根据表2分别计算3种模型的Vth_lin,Vth_sat,Ids_lin,Ids_sat的平均误差,计算结果表明,BSIM-IMG模型表征的仿真精度比PSP-SOI模型表征的仿真精度平均提高2.08%,比HiSIM-SOTB模型表征的仿真精度平均提高7.10%。
当Vbg为-5 V,0 V,5 V时,分别使用PSP-SOI,HiSIM-SOTB和BSIM-IMG模型表征漏电流随栅极电压变化关系,结果如图7所示,3种模型表征跨导随栅极电压变化关系如图8所示。从图7(a)和图8(a)可以看出:PSP-SOI在Vbg=-5 V,0 V时,2个偏压的仿真数据很接近。而HiSIM-SOTB在Vbg=0 V,5 V时,2个偏压的仿真数据很接近。这是因为在PSP-SOI模型中没有考虑背栅偏置效应,所以在不同的背栅偏置下,I-V曲线精度较低;在HiSIM-SOTB模型中虽然考虑了背栅产生的电荷及电流,但是阈值电压中并没有加入背栅偏置的影响,所以在亚阈值区的精度不高;而BSIM-IMG模型不仅考虑了背栅偏置效应,还在阈值电压中加入了背栅偏置和衬底偏置的影响,通过式(7)进一步精确表征了源漏电流。

图7 3种模型表征的漏电流随栅极电压的变化曲线
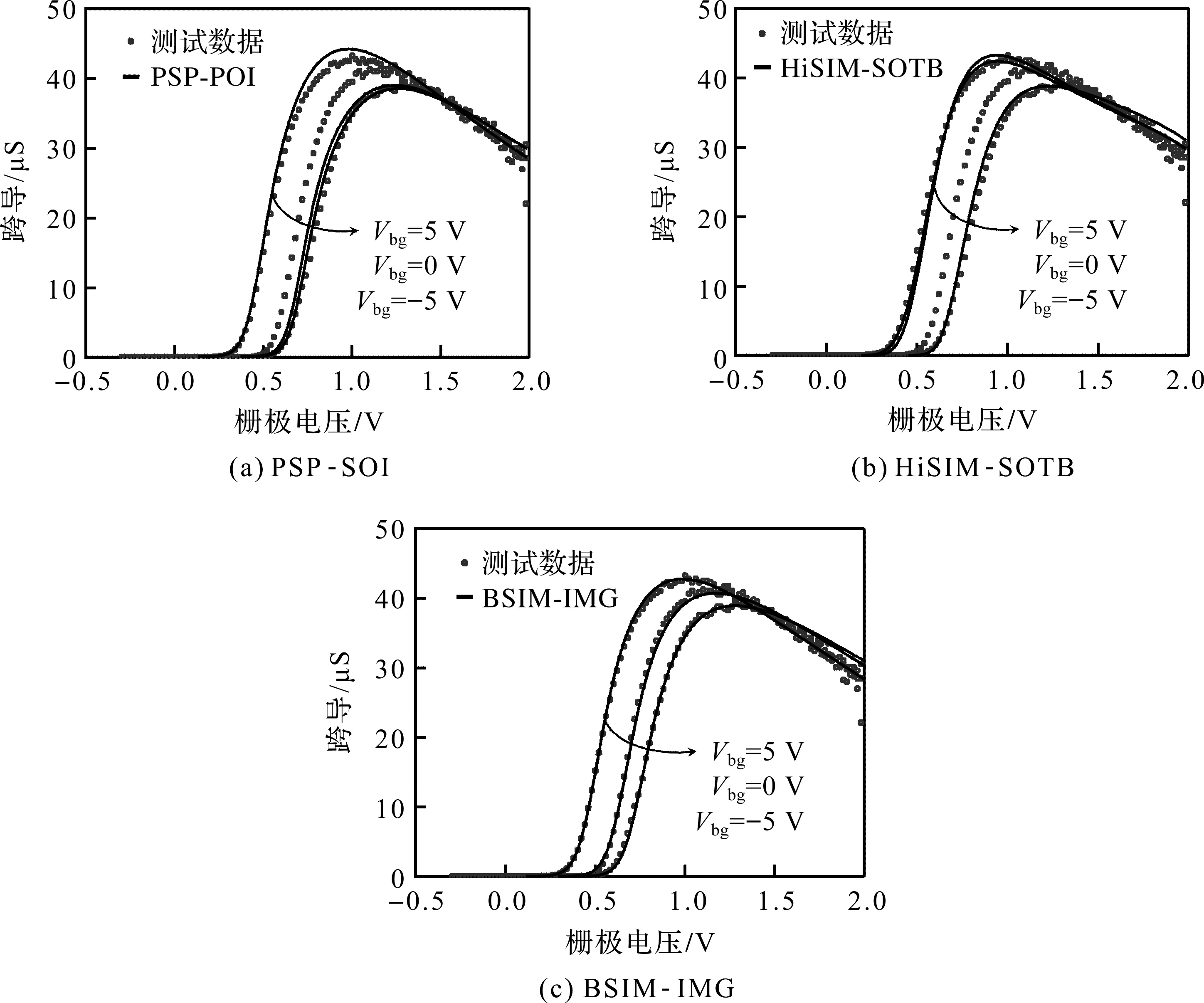
图8 3种模型表征的跨导随栅极电压的变化曲线
3 结束语
本文基于p型衬底的DG SOI MOSFET器件,对PSP-SOI,BSIM-IMG和HiSIM-SOTB模型工作机理进行分析和仿真,结果表明BSIM-IMG模型的表征精度比PSP-SOI和HiSIM-SOTB更准确,其直流可适用性更高。但是,由于实验室条件限制无法获得射频测试数据,本文并未对射频特性进行分析,下一步将在可靠的射频数据上进行分析,选出综合适用性最高的模型。
