聚酰亚胺正性光刻胶材料的制备及性能研究综述
2017-07-07路庆华
郑 凤,路庆华
(上海交通大学 化学化工学院,上海 200240)
聚酰亚胺正性光刻胶材料的制备及性能研究综述
郑 凤1,路庆华1
(上海交通大学 化学化工学院,上海 200240)
对聚酰亚胺(PI)+二叠氮萘醌(DNQ)型及聚酰亚胺前驱体(聚酰胺酸,PAA)+DNQ型正性光刻胶材料的研究成果进行了综述。讨论了这两种正性光刻胶材料中成膜剂的设计和制备方法。其中:前者在PAA主链中引入疏水基团,抑制PAA的溶解性;后者在PI主链中引入亲水基团,促进PI的溶解性,从而使其能被用于正性光敏聚酰亚胺。讨论了DNQ光敏剂的结构设计和种类、光刻胶的配比和光刻性能,以及正性光敏聚酰亚胺在航天领域中的应用现状与展望。
聚酰亚胺; 聚酰胺酸; 光刻胶; 二叠氮萘醌; 光敏剂; 制备; 光刻性能; 航天应用
0 引言
聚酰亚胺(PI)是一种具有优异的耐热性、力学性能、电绝缘性能和化学稳定性的聚合物材料,是航天、半导体、光电子和微电子领域中最重要的电子化学品材料之一,被作为层间绝缘、表面钝化、应力缓冲、射线屏蔽等材料而广泛应用[1]。相对普通聚酰亚胺来说,光敏聚酰亚胺(PSPI)不需要借助其他光刻胶就能实现图形的形成,不仅节约了材料成本,而且显著缩短了工艺线路,提高了成品率,因此是电子和微电子领域的理想绝缘材料[2]。根据光化学机理的不同,光敏聚酰亚胺又分为正性光刻胶(p-PSPI)和负性光刻胶(n-PSPI),前者是光照部分溶解,一般使用碱水稀溶液作为显影液,后者是光照部分固化被留下,使用有机溶剂作显影液。考虑环境相容性和图形分辨率,正性聚酰亚胺光刻胶成为科学界和工业界的主要研究目标。
从分子结构设计角度看,正性PSPI分为自增感型和外加光敏剂型两大类[3]。相对于自增感型,外加光敏剂型PSPI的分子设计窗口宽,体系敏感度和分辨率可在更宽的范围调控,因此成为最主要的研究对象。此类光敏PSPI材料中树脂不受光敏剂限制,两者独立存在;树脂的作用是留下图形,光敏剂的作用则是抑制树脂溶解,此组合使树脂结构更为多元化。聚酰亚胺前驱体,包括聚酰胺酸(PAA)、聚酰胺酸酯(PAE),或聚异酰亚胺(PII),以及侧链带碱溶性基团的特殊结构的P,均可与二叠氮萘醌磺酸酯(DNQ)类光敏剂复合,起到正性光刻胶的效果[4-7]。已经商品化的正性光敏聚酰亚胺多为PI/PI前体+正性光敏剂型光刻胶[8]。
目前理想的PI/PI前体+DNQ型正性PSPI仍在研究之中,为获得更高的图形分辨率,对PI/PI前体+DNQ型正性PSPI的研究主要聚焦于PI/PI前驱体聚合物的结构设计和光敏剂的结构设计两方面。该领域的基础性研究,尤其是对正性PSPI溶解抑制机理的研究也在进行中。本文对PI/PAA+DNQ型正性PSPI的研究进行了综述。
1 PAA+DNQ型正性光敏聚酰亚胺
使用聚酰亚胺前驱聚合物的正性PSPI又被称为前驱体型正性PSPI,通常是指在PAA的基础上,加入光敏剂等助剂得到可光固化的胶液,经涂布曝光得到光交联薄膜,经亚胺化处理得到PI结构[9]。PAA,PI的合成路径如图1所示。由PAA的结构通式可知:PAA聚合物主链含大量亲水基团(羧酸),在碱性水溶液中的溶解性非常好,故由PAA,DNQ光敏剂组成的PSPI体系通常难以获得理想的对比度。研究发现:通过对PAA聚合物的主链进行特定功能基团的化学修饰,引入疏水基团(芳香或含氟基团),调控亲疏水基团间的比例,可抑制PAA的溶解性,使其能被用于正性光敏聚酰亚胺。

图1 聚酰氨酸和聚酰亚胺的通用制备路途Fig.1 General preparation rote for poly (amic acid) (PAA) and polyimde (PI)
1.1 引入疏水基团的PAA
在PAA聚合物中引入更多的疏水结构(如芳香基团和含氟基团),利于抑制PAA在碱性水溶液中的溶解,可使制备而成的PSPI具合适的光感度和良好的图形分辨率。
文献[10]将不同疏水性能的二胺单元引入PAA主链,发现由具较强疏水性的二胺,1,3-双(4-氨基苯氧基)苯(TPE-R)与4,4’-(六氟异丙烯)二酞酸酐(6FDA)制备的PAA与光敏剂混合后,其PSPI膜经i线(波长365 nm)紫外光辐照,并在质量分数0.1%的四甲基氢氧化氨(TMAH)水溶液中显影后,得到了分辨率10 mm的正性图形,灵敏度100 mJ/cm2,对比度7.1。在此基础上,文献[11]用2,2’,6,6’-联苯二酐(2,2’,6,6’-BPDA)与TPE-R制备PAA,将2,2’,6,6’-BPDA的扭曲构型引入PAA聚合物主链中,使其在波长365 nm处具优异的透明性和良好的溶解度。将此PAA与质量分数20%的DNQ光敏剂复合后得到的正性膜的灵敏度和对比度分别为110 mJ/cm2,2.0,其图形的分辨率(L/S)为10 mm/2 mm。
含氟基团的引入不仅可提高PAA的透明度,而且能改善PAA的疏水性,从而起到抑制溶解度的作用。因此,在制备正性PSPI材料时,含氟二酐,如6FDA和含氟二胺,2,2’-双三氟甲基-4,4’-二氨基联苯(TFMB)都是很好的选择[4,10, 12-17]。文献[4]制备的PAA中既有氟基团(TFMB),又含刚性和柔性的二酐单元(PMDA和BPDA),混合质量分数30%的DNQ光敏剂后,正性PSPI膜在波长365 nm处的灵敏度和对比度分别为80 mJ/cm2,7.8,并具很低的热膨胀系数(10.3×10-6℃-1)和介电常数(3.04)。文献[12-14]在使用含氟PAA(FPAA)作为正性PSPI的树脂材料的基础上,又将4,4’-(六氟异亚丙基)二酚(6F-BPA)用1,2-萘醌-2-二叠氮基-5-磺酰氯(215-DNQ)酯化,得到含氟光敏剂FDNQ。将质量分数25%的FDNQ与PAA,FPAA的混合树脂,或纯的FPAA树脂相混合制备正性PSPI,在i线区域均显示了优良的灵敏度(45 mJ/cm2)和对比度(10),以及很好的图形分辨率(6 mm)。
1.2 抑制亲水基团的PAA
另外一个解决PAA在碱性水溶液中溶解度过高的方法是减少PAA主链中亲水基团(羧酸)的含量,此法可通过将PAA部分酯化实现。
20世纪80年代末、90年代初,一些特殊的聚酰胺酸材料被陆续开发并用于正性光刻胶[18-20]。BREWER,SNYDER首先将聚酰胺酸在135 ℃的前烘温度下进行部分酯化,以降低聚合物在碱水溶液中的溶解[21]。但这种方法并不适于普通的聚酰胺酸型PSPI,因为磺酸酯类化合物在此温度下分解快速,而聚酰胺酸却未必被酯化。为获得合适的溶解度,文献[22]用二氢吡喃(DHP)对PAA进行部分保护(如图2所示),但此法既不能量化控制又需使用酸性催化剂和很长的反应时间,故未被广泛采用。
文献[15-16]将含酰亚胺的二胺单体用于制备PAA,将酰亚胺基团引入PAA聚合物的主链控制溶解度。与热亚胺化相比,此法可精确地控制羧酸在聚合物中的含量。研究发现:当PAA的亚胺化程度为摩尔分数10%~15%时,与质量分数30%的DNQ光敏剂混合后可得图形良好的正性PSPI,经质量分数0.1%的TMAH水溶液显影后,在波长365 nm处的光感度和对比度分别为250 mJ/cm2,0.65[15]。在此基础上,HASEGAWA等将芳香酯链环引入PAA的主链,由此制备而成的正性PSPI,具与铜箔相近的低热膨胀系数(12×10-6~23×10-6K-1)[16]。
之后,文献[17]又用环化脱水剂(乙酸酐/吡啶)控制PAA的亚胺化程度,由氢化均苯四甲酸二酐(H’’-PMDA)和4,4’-二氨基二苯醚(ODA)制备成的PAA的亚胺化程度为约80%时,其正性PSPI(含质量分数20%的DNQ)在波长365 nm处有良好的透明度并能形成分辨率20 mm的正性图形。
与此同时,文献[23-24]报道了用N-二甲基甲酰胺二乙基缩醛(DMFDEA)作为酯化剂,将PAA定量酯化的方法(如图3所示):由3,3’,4,4’-联苯

图2 DHP对聚酰胺酸的酯化反应[22]Fig.2 Esterification reaction of PAA by DHP[22]

图3 DMFDEA对聚酰胺酸的酯化反应[23-24]Fig.3 Esterification reaction of PAA by DMFDEA[23-24]
醚四甲酸二酐(ODPA)和ODA制备的PAA,经DMFDEA酯化后,与质量分数20%的DNQ混合制得正性PSPI,其曝光区域的溶解速率远大于未曝光区域,形成分辨率10 mm的正性图形。在此基础上,TOMIKAWA等开发了能用于显微镜头的图像传感的正性PSPI,其中的树脂部分PAA由ODPA和ODA/6FAP聚合而成,并经DMFDEA部分酯化[24]。
2 PI+DNQ型正性光敏聚酰亚胺
对PAA+DNQ型正性光敏聚酰亚胺来说,该体系普遍存在先天缺陷,如曝光区域在碱水溶液中溶解性太高导致了显影过程中出现严重的膜损失,稳定性差不利于保存,以及亚胺化过程中膜收缩率较大导致图像变形等[25]。为解决这些问题,由聚酰亚胺(PI)作为树脂母体的正性PSPI材料受到了广泛关注,出现了大量关于此类体系研究的相关报道。作为正性PSPI的树脂母体,PI聚合物的结构设计与PAA相反。PAA的分子设计是基于抑制其在碱性水溶液中过高的溶解度,在PAA聚合物中引入疏水基团或减少亲水基团。PAA亚胺化后,主链中羧酸中的羟基因脱水而去除,导致PI在碱性水溶液中的溶解度明显降低,有些甚至不相溶,故对PI的结构设计需从促进PI的溶解性入手,在PI主链中引入亲水基团,如弱酸性的—OH和—COOH等基团,制备出可溶性的PI聚合物。
2.1 可溶性PI
2.1.1 带—COOH基团的PI
在20世纪90年代初,文献[26]将3,5-二氨基苯甲酸(DBA)和双[4-(3-氨基苯氧基)苯基]砜(BAPS),与二酐,环丁烷四甲酸二酐(CBDA)共聚,制备了既有透明度又可溶解于碱性溶液的PI聚合物。此材料的光感度随—COOH基团含量、DNQ含量,以及PI相对分子量而变。当羧酸基团达到摩尔分数30%,DNQ的质量分数达30%时,所得的正性PSPI的灵敏度和对比度分别为80 mJ/cm2,4.96,并可得到的图形分辨率10 mm。此后,文献[27]用含氟二酐(6FDA)取代了CBDA,与DBA,BAPS共聚,同样获得了透明可溶的PI聚合物,其溶解性可通过DBA的比例进行调节。该PI聚合物与DNQ光敏剂复合后,经i线曝光和TMAH溶液显影,得到了分辨率10 mm的正性图形。文献[28]也报道了主链中含羧基和羟基的正性PSPI材料。此类PI由3,3’,4,4’-二苯甲酮四甲酸二酐(BTDA)与弱酸性的二胺,DBA或3,5-二氨基-4-羟基-苯甲酸(DAPHBA)和聚硅氧烷二胺(PLSX),以及ODA共聚而成,与质量分数12%的光敏剂混合后可得正性PSPI,经质量分数1%的Na2CO3水溶液显影后,得到的图形分辨率3 mm。
2.1.2 带—SO3H基团的PI
将磺酸基修饰到PI聚合物中,也可增加PI在碱性水溶液中的溶解度。文献[29]用6FDA与ODA和含磺酸基的二胺,1,3-苯二胺-4-磺酸(PDAS)共聚,经热亚胺化后得到可溶性PI,与质量分数30%的DNQ混合后得到正性光刻胶,在波长365 nm处的图形分辨率10 mm,灵敏度和对比度分别为100 mJ/cm2,1.7。之后,MORITA等又用2,2’-硫双(5-氨基苯磺酸)(TBAS)制备了另一种带磺酸基团的PI[30]。此类PI作为成膜剂,在波长365 nm紫外辐照下,对比度优于PDAS体系,达到2.6,得到的正性图形分辨率20 mm。
2.1.3 带—OH基团的PI
带羟基的可溶性聚酰亚胺是被研究最多的一类,—OH基团可通过二胺或二酐的分子设计而引入PI聚合物的主链中。
文献[31]将二酐,氢化PMDA(HPMDA)与带羟基的二胺,2,2-双-(3-氨基-4-羟苯基)六氟丙烷(BisApAf)及BAPS共聚制得透明可溶的聚酰亚胺,与质量分数20%的DNQ光敏剂混合后得到正性光刻胶。此类光刻胶经i线紫外线辐照,并使用质量分数5%的TMAH水溶液显影,得到分辨率10 mm的正性图形,灵敏度250 mJ/cm2,对比度2.56。文献[32]用含—OH基的二胺制备了两种PI材料,一种是由PMDA/BPDA与BisApAf/TFMB用一锅法共聚的方法制得,另一种是由3,3’,4,4’-二苯基砜四甲酸二酐(DSDA)和2,2’-双[4-(4-氨基苯氧基)苯基]丙烷(BSDA)/PLSX共聚而成。这两种PI作为成膜剂,与质量分数30%的光敏剂混合后,可获得良好的正性光刻性能。文献[33]报道了6FDA+BSDA/PLSX体系的聚酰亚胺,这种PI(质量分数约60%)与普通PAA(质量分数约40%)混合后,再与加入质量分数30%的光敏剂配伍,得到的正性光刻胶在波长365 nm处灵敏度60 mJ/cm2,图形分辨率10 mm。文献[34]报道了一种新型的可溶性聚酰亚胺,主链中引入了具非平面且有2个羟基的2,2’-二羟基-7,7’-二氨基-9,9’-螺双芴单体结构,与光敏剂配伍后得到性能优异的正性PSPI。该结构的树脂经曝光后光照部分更易溶解于碱性水溶液中,缩短了显影时间并减少了胶膜损失。
先将羟基修饰到二酐单体中,再通过与普通二胺或带羟基的二胺聚合制备可溶性聚酰亚胺的方法也经常被报道。文献[35]用氯化偏苯三酸酐(TA)与BPAS反应,制备了含羟基酰胺的二酐(如图4所示),将这种二酐与二胺ODA及2,2’-双[4-(4-氨基苯氧基)苯基]六氟丙烷(HFBAPP)共聚得到可溶性PI。据报道,此类PI的溶解性与ODA/HFBAPP的比例有关,当这两种二胺的质量比为4∶1时,与质量分数30%的光敏剂混合后得到正性PSPI,经波长435 nm紫外辐照后,得到分辨率20 mm的图形。文献[36]也报道了用如图4所示二酐与含羟基的二胺(PLSX)及ODA等共聚制备可溶性PI树脂的方法,这些树脂与不同含量、不同结构的DNQ光敏剂配伍,得到的正性PSPI具优异的图形分辨率,最高可达3 mm。
2.1.4 反应型显影制图(RDP)型PSPI
此类正性PSPI也是由聚酰亚胺和DNQ光敏剂复合而成,其最显著特征是对PI结构无任何限制,不需在PI主链中修饰光敏基团,或—OH和—COOH等亲水基团,因其光刻机理与传统PSPI有所不同,而被定义为反应型显影制图(RDP)型PSPI[18,37]。由日本横滨国立大学的研究人员开发的PI体系,(BPDA/DAT)(BPDA/BAPP)型PI(DTA=2,4’-二氨基甲苯;BAPP=2,2’-双[4-(4-氨基苯氧基)苯基]丙烷),(6FDA/HFBAPP)型聚酰亚胺和(6FDA/HFBAPP)(BPDA/2-DMB)
(2-DMB=2,2’-二甲基联苯胺)型PI,都属于RDP型PSPI[18,37]。文献[38]报道了RDP型PSPI,树脂母体是由6FDA、HFBAPP和ODA)共聚而成[38]。这些聚酰亚胺胶体中含大量柔性基团,可溶解于N-甲基-2-吡咯烷酮(NMP)中,加入质量分数30%的光敏剂可获得正性光刻胶。这类光刻胶经过紫外辐照后,用乙醇胺/NMP/水(质量比1/1/1)溶液显影,可得到分辨率良好的光刻图形。
RDP型正性PSPI的树脂母体,PI聚合物的主链不含—OH或—COOH之类的亲水基团,无法与DNQ形成氢键,光化学的反应过程也不发生在显影前的PSPI膜内,因此图形形成机理既不同于普通的PSPI,也异于化学增幅型PSPI。对RDP型PSPI来说,与图形形成直接相关的主要化学反应在显影的过程中进行,如图5所示[18]。在曝光区域,显影液与PSPI膜的接触面上,DNQ经光致重排后转变成的茚酸与显影液中的氨基乙醇发生酸-碱反应,其胺盐产物可促进显影液渗透进曝光区域的胶体中;随后,PI的二胺部分因氨的亲核进攻发生开环反应,并引起PI的加速分解,生成低相对分子量的酰胺化产物;而未曝光部分,未反应的DNQ抑制了乙醇胺向PI胶体的扩散,使PI膜在显影液中的溶解度减弱,与曝光区形成较强的溶解度差异,从而实现了光刻的目的。
3 光敏剂结构设计
光敏剂(PAC)是一种由酚类化合物和二叠氮萘醌磺酰氯(DNQ)反应而成的酯类化合物(如图6所示),是正性光敏PSPI中必不可少的组分。为提高正性PSPI的分辨率及感光性能,合成不同结构的叠氮萘醌型光敏剂,对最合适的导入母体(酚类化合物)研究已成为近年来国内外的研究热点之一[19,39-41]。文献中常见的光敏剂PAC-1~PAC-9如图6所示。因这些酚类化合物中的羟基数不同,空间位置各异,故酯化难易程度也不相同,其酯化物的感光性能亦有所区别。

图4 含有羟基酰胺的二酐单体的制备[35]Fig.4 Synthetic route of hydroxyamide-containing tetracarboxylic dianhydride[35]

图5 RDP型正性PSPI的图形形成机理[18]Fig.5 RDP mechanism of positive PSPI system with DNQ treated with ethanolamine-containing developer[18]

图6 相关正性PSPI文献中的常见光敏剂Fig.6 Common used DNQ PACs in relative references of PSPI
就酚醛树脂型正性光刻胶而言,光敏剂的分子结构与光刻胶的溶解抑制效果间的关系已被深入研究[19-21,39,41-43]。相关研究发现:酚类化合物的类型可直接影响光敏剂的疏水性和形成氢键的能力;取代基团的数量(即酚类化合物上可修饰DNQ基团的羟基数量),以及DNQ基团的相邻性,都是影响光敏剂感光性能的因素[20]。光敏剂疏水性的增加可提高溶解阻断效果,而酚类母体上取代基团的增加及DNQ基团间相邻性的增加则有相反作用,其中光敏剂的疏水性和DNQ基团的相邻性对溶解抑制起主导性作用[21]。
基于上述发现,正性PSPI在选择光敏剂时有据可依,但这也导致了正性PSPI领域此类研究的相对欠缺。在为数不多的相关研究中,认为酚类化合物的极性及DNQ的取代率均与正性PSPI的感光性能密切相关。
3.1 光敏剂的极性和结构
光敏剂的疏水性取决于它的极性。文献[20-21]是以光敏剂化合物在高效液相色谱(HPLC)上的保留时间作为判断极性大小的依据,而近期对正性PSPI中光敏剂的研究则使用酚类化合物的偶极矩推测极性,极性大的化合物往往具有大的偶极矩值(ENREF_45)[36,44]。文献[44]用一种更先进的方法——分子轨道计算对各种结构的酚类化合物(如图6所示的PAC-2,PAC-4,PAC-9,以及如图7所示的PAC-10,PAC-11)进行了偶极矩计算,发现用偶极矩小的酚类化合物获得的叠氮萘醌类光敏剂(如PAC-4,PAC-9)的疏水性增强,正性PSPI在显影过程中的膜损失率小;但为获得好的灵敏度,则需使用偶极矩大的酚类化合物制备光敏剂。

图7 文献[36]的含不同数量苯环的光敏剂Fig.7 DNQ PACS containing benzen rings reported in reference [36]
文献[36]揭示了更详细的信息,用偶极矩在3.34×10-31C·m以上和5.344×10-30C·m以下的酚类化合物制备DNQ光敏剂,结果发现:当偶极矩小于3.34×10-31C·m时,光敏剂与PI聚合物的相溶性差;当偶极矩大于5.344×10-30C·m时,光敏剂对未曝光部位的保护效果减小。此外,文献[36]对含不同苯环数量的光敏剂也进行了考察(如图7所示),发现光敏剂的导入母体——酚类化合物可具2个以上的苯环,当只有1个苯环时,光敏剂对碱性水溶液的溶解抑制效果差;当有10个以上苯环时,与PI聚合物的相溶性变差。文献[36]还指出,可用一种结构的光敏剂,也可将多种不同结构的光敏剂混合使用,利用不同极性,降低正性PSPI膜在显影过程中的膜损失,同时提高感光灵敏度。
文献[12-14]用6F-BPA与215-DNQ反应制备了含氟的光敏剂PAC-3(如图6所示),其疏水性远高于普通光敏剂,因此在PSPI膜前烘后,PAC-3会自动富集到膜的表层,形成了一层“保护膜”,阻断了显影液与PI树脂的接触,溶解抑制效果明显优于普通光敏剂。
3.2 光敏剂酯化程度
在选择光敏剂时,需考虑酚类化合物的结构和光敏剂的酯化程度两个主要因素[44]。当酚类化合物被叠氮萘醌磺酰氯全部酯化后,其产物在常规试剂中的溶解性很低,限制了其实际应用,因此有使用价值的光敏剂通常是酯化程度不同的混合产物,而调控各酯化产物的比例又是提高光敏剂感光性能的途径之一[43]。如用2,3,4-三羟基二苯甲酮(THK)作为光敏剂的导入母体时,215-DNQ可分别与其3个羟基反应生成一酯化、二酯化和三酯化产物。目前一种已商业化的光敏剂就是这三种酯化产物的混合物(如图8所示)[27]。
光敏剂的合成条件也会影响各种酯化产物间的比例,因此对合成备光敏剂的反应条件进行了研究。对图8中的反应,文献[42]指出,该反应的化学组分、反应溶剂的极性、碱催化剂的类型、反应温度和反应浓度等因素,都会影响酯化产物的生成。文献[45]发现在进行图8的反应时,用体积比85∶15的丙酮和水作为溶剂,用三乙胺作催化剂时,所得到的酯化产物的溶解度最高。由于高度的商业敏感性,作为商品化的光敏剂的合成条件仍不会公开,因此控制合成取代比例仍是设计光敏剂的关键。
4 正性PSPI在航天领域的应用

图8 一种商业化光敏剂的组分[27]Fig.8 Composition of one commercial DAQ PAC[27]
聚酰亚胺材料因其突出的综合性能而广泛用于航空航天领域。国际上,这种热塑性材料已用于太阳帆、太阳电池阵和飞机的制造[46-52]。国内,针对航空航天技术发展对内高温胶膜材料的需要,也开展了对聚酰亚胺材料的研究[53-54]。其中,长征三号甲运载火箭的气动机叶片采用了碳纤维增强的热塑性聚酰亚胺符合材料,为成功完成嫦娥一号探测卫星的发射做出了重要贡献[55]。
空间太阳电池阵是航天器的核心供电设备[56]。其中,柔性太阳电池阵采用了平面型隔离二极管,为防止二极管本体与互联片间形成短路(如图9所示),需在二极管表面涂敷绝缘材料,且涂敷的绝缘材料图形要与二极管的电极图形精确吻合。聚酰亚胺具极优秀的电绝缘性,同时其预聚物可通过旋涂方式获得涂层,特别适于半导体和微电子加工工艺。普通聚酰亚胺涂层在半导体器件制作工程中常需在薄膜中开孔或形成图形,要借助一般的光刻胶实现。因此本身具感光性能的正性光敏聚酰亚胺多用于太阳电池阵中,作为二极管和互联片的层间绝缘和保护材料,阻挡各种射线对器件的影响。
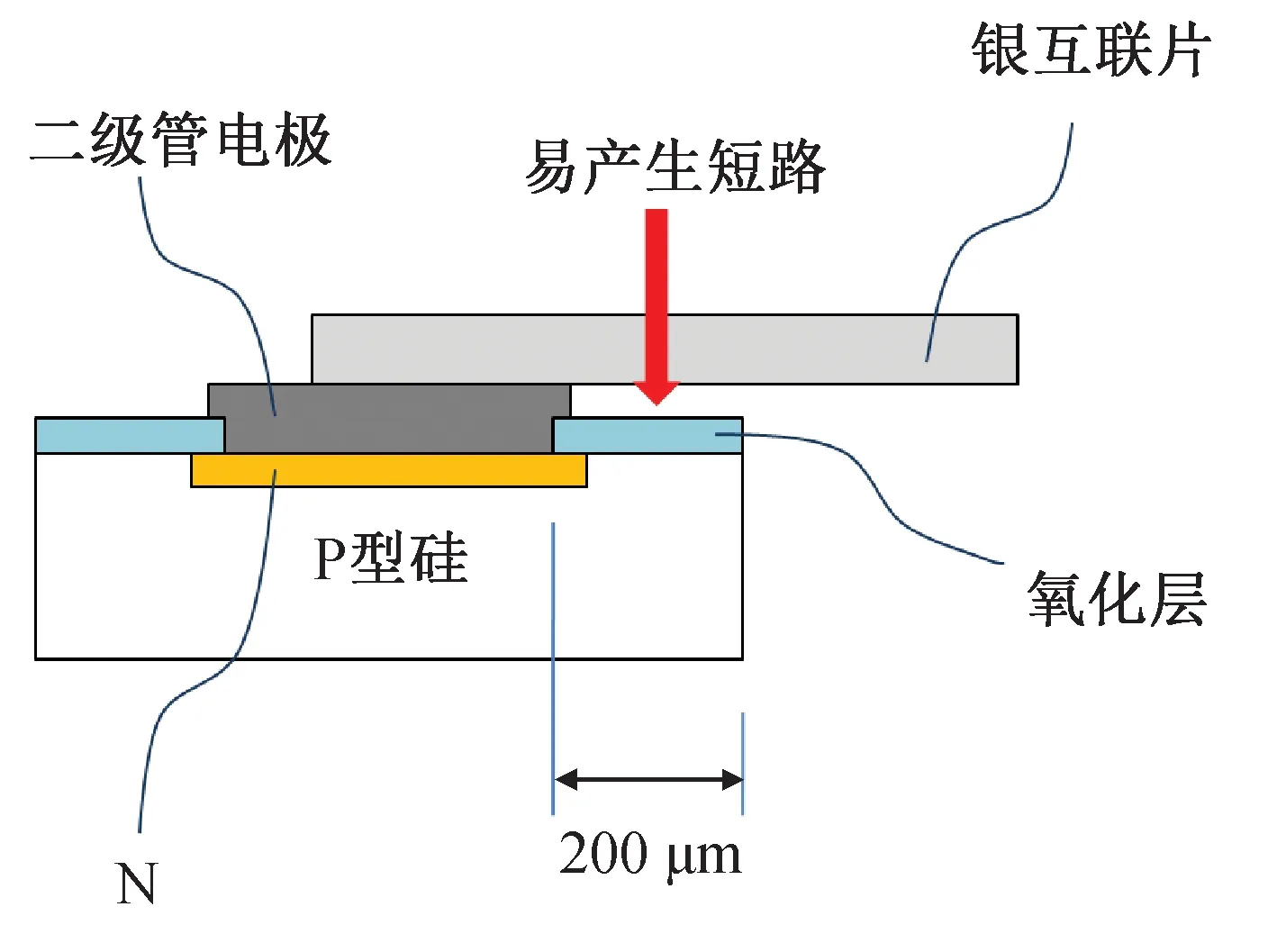
图9 平面二极管与电极引线间的连接示意Fig.9 Schematic of connection between planar diode and electrode wire
作为聚酰亚胺电子材料的主流产品,正性光敏聚酰亚胺材料应尽可能满足微电子及半导体器件加工所需的要求。在今后的开发中应致力于降低正性PSPI材料的介电常数和介电耗散系数,使其有更优异的电子性能,并同时确保正性PSPI体系具高灵敏度和分辨率,从而在未来更广泛地用于航空航天领域。
5 结束语
本文对PAA/PI+DNQ光敏剂型正性光刻胶材料的成膜剂制备、所用光敏剂类型、成膜剂与光敏剂间的配伍比例,以及各种光刻胶材料的光刻参数和性能进行了综述。虽然聚酰亚胺正性光刻胶在国际上(日本)已有商业化产品,但目前该领域的基础性研究尚未终止,特别是在国内由于基础研究的不足,这类对国民经济至关重要的电子化学品材料尚没有成熟的产品。就目前来看,绝大部分对正性PSPI的研究集中于PI或PI前驱体聚合物的结构设计与合成,对正性PSPI光化学的研究很少。为设计出性能优异的正性PSPI光刻胶,对溶解抑制机理的理解至关重要。为早日开发出有自主知识产权的正性光敏聚酰亚胺光刻胶材料,并用于航空航天及半导体、微电子器件的生产,还需要我国的科研工作者加强相关研究。
[1] 丁孟贤. 聚酰亚胺: 化学, 结构与性能的关系及材料[M]. 北京: 科学出版社, 2012.
[2] FUKUKAWA K I. Recent progress of photosensitive polyimides[J]. Polymer Journal, 2008, 40(4): 281-296.
[3] 刘金刚, 袁向文, 尹志华, 等. 正性光敏聚酰亚胺研究与应用进展(一)[J]. 电子与封装, 2008, 8(12): 1-6.
[4] SEINO H, MOCHIZUKI A, HABA O, et al. A positive-working photosensitive alkaline-developable polyimide with a highly dimensional stability and low dielectric constant based on poly (amic acid) as a polyimide precursor and diazonaphthoquinone as a photosensitive compound[J]. Journal of Polymer Science, Part A, Polymer Chemistry, 1998, 36(13): 2261-2267.
[5] HSU S. Synthesis and characterization of a positive-working, aqueous-base-developable photosensitive polyimide precursor[J]. Journal of Applied Polymer Science, 2002, 86(2): 352-358.
[6] MOCHIZUKI A. Positive-working alkaline-developable photosensitive polyimide precursor based on polyisoimide using diazonaphthoquinone as a dissolution inhibitor[J]. Polymer, 1995, 36(11): 2153-2158.
[7] FUKUSHIMA T, OYAMA T, IIJIMA T, et al. New concept of positive photosensitive polyimide: reaction development patterning (RDP)[J]. Journal of Polymer Science, Part A, Polymer Chemistry, 2001, 39(19): 3451-3463.
[8] LIU J G, YUAN X W, YIN Z H, et al. Research and development of positive-working photosensitive polyimides (2)[J]. Electronics & Packing, 2009(9): 7-23.
[9] 陈小刚, 廖学明, 何晓东. 前驱体型光敏聚酰亚胺的合成研究[J]. 合成材料老化与应用, 2015, 44 (5): 111-118.
[10] HABA O, OKAZAKI M, NAKAYAMA T, et al. Positive-working alkaline-developable photosensitive polyimide precursor based on poly (amic acid) and dissolution inhibitor[J]. Journal of Photopolymer Science and Technology, 1997, 10(1): 55-60.
[11] SAKAYORI K, SHIBASAKI Y, UEDA M. A positive-type alkaline-developable photosensitive polyimide based on the polyamic acid from 2,2′,6,6′-biphenyltetracarboxylic dianhydride and 1, 3-bis (4-aminophenoxy) benzene, and a diazonaphthoquinone[J]. Polymer Journal, 2006, 38 (11): 1189-1193.
[12] INOUE Y, HIGASHIHARA T, UEDA M. Alkaline-developable positive-type photosensitive polyimide based on fluorinated poly (amic acid) and fluorinated diazonaphthoquinone[J]. Journal of Photopolymer Science and Technology, 2013, 26(3): 351-356.
[13] INOUE Y, SAITO Y, HIGASHIHARA T, et al. Facile formulation of alkaline-developable positive-type photosensitive polyimide based on fluorinated poly (amic acid), poly (amic acid), and fluorinated diazonaphthoquinone[J]. Journal of Materials Chemistry C: Materials for Optical and Electronic Devices, 2013, 1(14): 2553-2560.
[14] INOUE Y, ISHIDA Y, HIGASHIHARA T, et al. Alkaline-developable and positive-type photosensitive polyimide based on fluorinated poly(amic acid) from diamine with high hydrophobicity and fluorinated diazonaphtoquinone[J]. Journal of Photopolymer Science and Technology, 2014, 27(2): 211-217.
[15] HASEGAWA M, TOMINAGA A. Environmentally friendly positive- and negative-tone photo-patterning systems of low-K and low-CTE polyimides[J]. Journal of Photopolymer Science and Technology, 2005, 18(2): 307-312.
[16] HASEGAWA M, TANAKA Y, KOSEKI K, et al. Positive-type photo-patterning of low-CTE, high-modulus transparent polyimide systems[J]. Journal of Photopolymer Science and Technology, 2006, 19(2): 285-290.
[17] HASEGAWA M, NAKANO J. Colorless polyimides derived from cycloaliphatic tetracarboxylic dianhydrides with controlled steric structures (4): applications to positive-type photosensitive polyimide systems with controlled extents of imidization[J]. Journal of Photopolymer Science and Technology, 2009, 22(3): 411-415.
[18] FUKUSHIMA T. New concept of positive photosensitive polyimide: reaction development patterning (RDP)[J]. Journal of Polymer Science. Part A, Polymer Chemistry, 2001, 39(19): 3451-3463.
[19] KAWATA S, KASHIWAGI M, MITSUHIRA Y, et al. Effective PAC for high performance i-line positive photoresist[J]. Journal of Photopolymer Science and Technology, 1991, 4(1): 101-108.
[20] UENISHI K, KAWABE Y, KOKUBO T, et al. Structural effects of diazonaphthoquinone-photoactive compound backbone on resist lithographic properties[J]. Advances in Resist Technology and Processing VIII, Proceedings of SPIE——the International Society for Optical Engineering, 1991, 1466(Adv Resist Technol Process 8): 102-116.
[21] NEMOTO H, INOMATA K, OTA T, et al. Structural effects of diazonaphthoquinone photoactive compounds and novolak resin on resist performance[J]. Advances in Resist Technology and Processing IX, Proceedings of SPIE——the International Society for Optical Engineering, 1992, 1672 (Adv Resist Technol Process IX): 305-316.
[22] SIMMONS H E. Positive-working photodefinable polyimide precursors: 5399655[P]. 1995-03-21.
[23] TOMIKAWA M, YOSHIDA S, OKAMOTO N. Novel partial esterification reaction in poly (amic acid) and its application for positive-tone photosensitive polyimide precursor[J]. Polymer Journal, 2009, 41(8): 604-608.
[24] TOMIKAWA M, SUWA M, NIWA H, et al. Novel high refractive index positive-tone photosensitive polyimide for microlens of image sensors[J]. High Performance Polymers, 2011, 23(1): 66-73.
[25] RYU S. Synthesis and characterizations of positive-working photosensitive polyimides having 4, 5-dimethoxy-o-nitrobenzyl side group[J]. Bulletin of the Korean Chemical Society, 2008, 29(9): 1689-1694.
[26] ABE T, MISHINA M, KOHTOH N. Positive photosensitive polyimides with cyclobutane structure[J]. Polymers for Advanced Technologies, 1993, 4(4): 288-293.
[27] FUKUSHIMA T, HOSOKAWA K, OYAMA T, et al. Synthesis and positive-imaging photosensitivity of soluble polyimides having pendant carboxyl groups[J]. Journal of Polymer Science, Part A, Polymer Chemistry, 2001, 39(6): 934-946.
[28] HWANG K Y, TU A P, WU S Y, et al. Novel water soluble polyimide resin, its preparation and use: 20110172324 A1[P]. 2011-07-14.
[29] MORITA K, EBARA K, SHIBASAKI Y, et al. New positive-type photosensitive polyimide having sulfo groups[J]. Polymer, 2003, 44(20): 6235-6239.
[30] MORITA K, SHIBASAKI Y, UEDA M. New positive-type photosensitive polyimide having sulfo groups 2 Polyimides from 2, 2′-oxy (or thio) bis (5-aminobenzenesulfonic acid), 4, 4′-oxydianiline, and 4, 4′-hexafluoropropylidene-bis (phthalic anhydride)[J]. Journal of Photopolymer Science and Technology, 2004, 17(2): 263-268.
[31] JIN X, ISHII H. A novel positive-type photosensitive polyimide having excellent transparency based on soluble block copolyimide with hydroxyl group and diazonaphthoquinone[J]. Journal of Applied Polymer Science, 2005, 96(5): 1619-1624.
[32] ISHII J. Organo-soluble polyimides and their applications to photosensitive cover layer materials in flexible printed circuit boards[J]. Journal of Photopolymer Science and Technology, 2008, 21(1): 107-112.
[33] SEONG H R, PARK C H, OH D H, et al. Positive photosensitive polyimide composition photoresist for organic LED fabrication: PCT Int Appl, WO 2009110764 A2 [P]. 2009-09-11.
[34] ZHU D, LI L, JIN R, et al. Method for preparation of water-based positive-working photosensitive polyimide materials: CN 105820338 A[P]. 2016-08-03.
[35] HASEGAWA M. Hydroxyamide-containing positive-type photosensitive polyimides[J]. Journal of Photopolymer Science and Technology, 2007, 20(2): 175-180.
[36] TOMOKAWA M, SUWA M, FUJITA Y. Positive-working photosensitive polyimide precursor composition: PCT Int Appl WO 2000073852 A1[P]. 2000-12-07.
[37] MIYAGAWA T, FUKUSHIMA T, OYAMA T, et al. Photosensitive fluorinated polyimides with a low dielectric constant based on reaction development patterning[J]. Journal of Polymer Science, Part A, Polymer Chemistry, 2003, 41(6): 861-871.
[38] JI C, XU L. Positive photosensitive polyimide composition with low thermal expansion coefficient and high resolution: CN 105585847 A[P]. 2016-05-18.
[39] JHA S, REISER A,ROUBKOVA L, et al. A new design principle for the photoactive components (PACs) of dissolution inhibition resists[J]. Macromolecules, 1998, 31(19): 6549-6553.
[40] KOSHIBA M, MURATA M, HARITA Y. Dissolution inhibition mechanisms of naphthoquinone diazides[J]. Polymer Engineering and Science, 1989, 29(14): 916-919.
[41] AOAI T, YAMANAKA T, YAGIHARA M. Structural effect of polymer and inhibitor on alkali dissolution and dissolution inhibition characteristics[J]. Journal of Photopolymer Science and Technology, 1997, 10(3): 387-396.
[42] ZAMPINI A, SANDFORD H, CARDIN W, et al. Diazonaphthoquinone-5-sulfonate composition variants: synthesis and properties[J]. Advances in Resist Technology and Processing XIII, Proceedings of SPIE——the International Society for Optical Engineering, 1996, 2724(Advances in Resist Technology and Processing XIII): 525-532.
[43] DICARLO J, EVANS O B, FEDYK J, et al. Identification of diazonaphthoquinone esters of polyhydroxybenzophenone compounds[J]. Advances in Resist Technology and Processing XI, Proceedings of SPIE——the International Society for Optical Engineering, 1994, 2195(Advances in Resist Technology and Processing XI): 696-706.
[44] TOMIKAWA M, YUBA T, OHBAYASHI G. Effect of photoactive compound structure on photosensitivity of positive photosensitive polyimide[J]. High Performance Polymers, 2006, 18(5): 603-615.
[45] 刘陆, 邹应全. 2, 3, 4-三羟基二苯甲酮与2, 1-重氮萘醌-5-磺酰氯酯化反应条件和酯化产物溶解度关系研究[J]. 高等学校化学学报, 2010, 31(3): 520-523.
[46] 沈自才, 张帆, 赵春晴. IKAROS太阳帆的关键技术分析与启示[J]. 航天器工程, 2012, 21(2): 101-107.
[47] RIKIO Y. Aromatic polyimide A-ODPA/4, 4’-ODA thin film for world first solar sail “IKAROS” membrane[C]// Program & Absratacts of the 5thInternational Symposium on Engineering Plastics. Kunming: Institute of Chemistry, 2011: 71-72.
[48] 李柱生, 吴建华, 朱小华. 高性能聚酰亚胺的进展[J]. 化工新型材料, 2002, 30(6): 19-24.
[49] 王存恩. SFU在轨应用成果分析[J]. 中国航天, 1998(12): 31-34.
[50] 王兴刚, 于洋, 李树茂. 先进热塑性树脂复合材料在航天航空上的应用[J]. 纤维复合材料, 2011, 6(2): 44-47.
[51] 杨宇航, 刘钡钡. 空客A380飞机可靠性工程中的确认和检验方法[J]. 航空技术科学, 2012(1): 36-41.
[52] 邱银, 汪树军. 聚酰亚胺泡沫材料[J]. 化工新型材料, 2003, 31(8): 15-17.
[53] 霍海涛, 孙宏杰, 莫松. 聚酰亚胺胶膜的研究进展[J]. 宇航材料工艺, 2010(1): 1-6.
[54] 孙宏杰, 杨士勇, 范琳. 蜂窝夹层结构粘接用聚酰亚胺胶膜的研究[J]. 宇航材料工艺, 2011(1): 51-53.
[55] 宋艳江, 高鑫, 朱鹏. 表面处理碳纤维增强聚酰亚胺复合材料力学性能[J]. 复合材料学报, 2008, 25(5): 64-68.
[56] KEENER D N, MARVIN D. Progress in the multijunction solar cell mantech program[R]. NASA: NASA/CP-2004-212735, 2004.
Progress Review on Preparation and Lithographic Performance of Positive-Tone Photosensitive Polyimides
ZHENG Feng, LU Qing-hua
(School of Chemistry and Chemical Engineering, Shanghai Jiao Tong University, Shanghai 200240, China)
The latest researches on positive-tone photosensitive polyimides (p-PSPIs) composed of polyimide (PI) /poly (amic acid) (PAA) and a diazonaphthoquinone photoactive compound (DNQ PAC) were summarized in this paper. The design and perparation of these two positive-tone photosensitive polyimides were discussed. In order to prepare suitable resists for the fabrication of p-PSPIs, hydrophobic groups were introduced into PAA polymer chains to depress their solubility, while hydrophilic groups were introduced into PI polymer chains to improve their solubility. The detailed preparation methods of the PI and PAA resists were summarized. The structural design of DNQ PACs, DNQ loading and lithographic performance of each p-PSPI were described. Furthermore, the applications of p-PSPIs to aerospace were also presented.
polyimide; poly (amic acid); photosensitive polyimide; diazonaphthoquinone; photoactive compound; preparation; lithographic performance; aerospace application
1006-1630(2017)03-0136-12
2017-02-21;
2017-03-21
航天先进技术联合研究中心技术创新项目资助(USVAST2015-27)
郑 凤(1980—),女,博士,主要研究方向为新型高分子材料的研发、分子模拟理论计算在高分子化学中的应用。
TB34
A
10.19328/j.cnki.1006-1630.2017.03.019
