H2稀释比对RF-PECVD制备a-Si:H/nc-Si:H薄膜的光电特性的影响
2015-02-26程自亮蒋向东王继岷刘韦颖连雪艳
程自亮,蒋向东,王继岷,刘韦颖,连雪艳
(电子科技大学光电信息学院,成都610054)
H2稀释比对RF-PECVD制备a-Si:H/nc-Si:H薄膜的光电特性的影响
程自亮,蒋向东*,王继岷,刘韦颖,连雪艳
(电子科技大学光电信息学院,成都610054)
摘要:研究了H2稀释比对a-Si:H/nc-Si:H薄膜光电特性及微结构的影响。采用RF-PECVD法,以高纯SiH4及H2/SiH4混合气体为反应气源交替反应制备样品,并通过紫外-可见光分光光度计、椭偏仪及Keithley 4200、XRD对样品进行分析测试。实验表明:在纳米级厚度的a-Si:H薄膜基础上,随着第二反应气H2/SiH4混合气中H2比率(99%、97%、95%、92%、80%)的升高,沉积速率持续下降,薄膜消光系数、禁带宽度以及电导率呈现先增大后减小的趋势。针对实验现象,结合薄膜生长机理对实验结果原因进行了分析。
关键词:a-Si:H/nc-Si:H;氢稀释; RF-PECVD(射频等离子体化学气相沉积);光电性能;生长机理
自1976年RCA公司实验室的Carlson D和Wronski C利用PECVD法制备出第一块非晶硅薄膜电池以来[1],氢化非晶硅(a-Si:H)已经被广泛应用于薄膜太阳能电池、薄膜晶体管及微传感器等器件的研制中。非晶硅薄膜具有较强的光吸收能力、制备工艺简单、与硅半导体工艺兼容、成本低等优点;其缺点在于薄膜中存在大量的缺陷态,以致于会形成所谓的光致衰退效应[2]。研究表明,在PECVD法制备非晶硅薄膜的成膜过程中,通入一定量的H2气,在辉光作用下产生的H原子可以进入非晶网络内部弥补悬挂键等缺陷[3],同时,H等离子体能够打断弱Si-Si键使之再结合[4],从而改善非晶硅薄膜性能。
氢化纳米硅(nc-Si:H)作为器件光敏层或有源层的缺点在于制备成膜速率通常特别低,对于工业生产十分不利,在单晶硅片或石英玻璃上以提高沉积温度的方法可以提高成膜速率[5],但成本随之上升。本文实验采用RF-PECVD技术,在ITO基底上以高纯硅烷及硅烷氢气混合气体为气源交替沉积非晶硅和纳米硅薄膜,并通过改变用于沉积纳米硅薄膜的H2/SiH4混合气体的比例,研究H2稀释比对薄膜的影响。
1 实验
实验利用频率为13.56 MHz的RF-PECVD设备,以高纯SiH4(纯度>99.999%)以及H2/SiH4按比例混合的气体为反应气源,在K9玻离衬底上制备了a-Si:H/nc-Si:H薄膜。工艺参数为电极间距为22 mm,本底真空度小于6.0×10-4Pa,反应压强为80 Pa,功率密度为100 mW/cm2,衬底温度为250℃,气体温度为160℃,气体总流量为80 sccm,反应方式为:高纯硅烷混合气高纯硅烷混合气交替反应,以高纯硅烷为第一反应气制备非晶硅的时间为0.5 min。以H2/SiH4为第二反应气源制备纳米硅的具体参数如表1所示,其中反应时间括号外为混合气体每次的反应时间,括号内为总反应时间。

表1 H2/SiH4混合气体制备纳米硅实验参数
为了进行薄膜电导率测试,制备出的样品,进一步通过电子束蒸镀的方式在非晶硅表面镀上Al电极,形成欧姆接触,电极长宽分别为10 mm和5 mm,电极间距为0.5 mm。
本文实验使用英国BeDe D1多功能X射线衍射仪对样品薄膜进行XRD图谱分析,德国红外-可见光-近红外光谱椭偏仪SENTECH SE850测量薄膜厚度、消光系数k、折射率;日本岛津UV-1700紫外-可见光分光光度计测试薄膜透射光谱,分析薄膜禁带宽度; Keithley 4200半导体性能测试仪分析薄膜电导率。
2 结果与讨论
2.1沉积速率和XRD分析

图1 沉积速率随H2稀释比的变化曲线
图1为不同H2稀释比下制备a-Si: H/nc-Si: H薄膜沉积速率变化趋势图。薄膜的生长和成膜结构与扩散到衬底表面的SiH、SiH2、SiH3、…、SiHn等活性基团浓度及迁移速率有关,当表面活性基团的浓度较高、迁移速率较大时,成膜速率较高、致密性较好[6]。实验过程中,起初的0.5 min高纯SiH4反应为后续提供活性基团。氢稀释比很高时,反应室内大量的氢等离子体轰击非晶硅表面,产生刻蚀效应[7],使原来沉积在衬底表面活性基团内键能较弱的Si-Si键、Si-H键断开,同时,由于硅烷浓度很低,后续活性基团的形成量很少,两方面作用,使薄膜沉积速率很低。但由于刻蚀效应的作用,衬底表面将留下更有利于结构稳定的强Si-Si键,使薄膜晶化程度加大。随着氢稀释比的降低,活性基团浓度不断增大,氢等离子体刻蚀作用减弱,沉积速率不断增大。
图2为不同H2稀释比混合气体下薄膜的XRD图谱。从图中可以看出H2稀释比为99%、95%时,在28.4°衍射角中心位置处出现了代表晶态硅的(111)衍射峰,当H2稀释比达到80%时,衍射峰基本消失。

图2 不同H2稀释比下的XRD图谱
研究表明[8],非晶硅成膜过程中,氢等离子体对薄膜表面具有刻蚀,当H2比例很高时,大量的氢等离子体可以打断弱Si-Si键,减小薄膜中缺陷态密度,阻碍无序网络生长,促进硅原子重新排列,同时成键氢可补偿薄膜中的悬挂键,增强硅原子迁移能力,这两方面作用使得硅原子在排列成膜的弛豫过程中逐渐向有序化方向进行[9]。根据Layer by Layer纳米硅制备方法理论[10],非晶硅薄膜在高H等离子体环境中,在几纳米厚度的范围内会受到刻蚀,而导致表面原子重新排列,并趋于有序。H2比例较低时,H等离子体含量不足以对薄膜形成有效的刻蚀作用,薄膜不再出现晶化现象。
2.2光学性能分析
不同H2稀释比系列样品的紫外-可见光分光光度计透射光谱如图3所示。由图可以看出,不同H2稀释比参数薄膜对550 nm~700 nm内的可见光有较强吸收,干涉振荡峰出现在红光及红外波段,550 nm处,干涉峰开始消失,电子跃迁状态由带内跃迁向带间跃迁转移。可以看出,随着H2稀释比的增大,吸收带边出现蓝移现象,因为,薄膜中悬挂键的未成键电子位置被进入其中的氢原子填充,减少了缺陷态密度,降低了由于结构缺陷而产生的入射光子的吸收,因此入射光透过率增大[11]。蓝移现象还表明随着硅烷浓度降低,所沉积的薄膜禁带宽度要有所展宽。

图3 透过率随H2稀释比的变化曲线
为进一步深入研究,利用紫外-可见光分光度计测得的透射光谱拟合得到光学禁带宽度。根据带隙计算公式[12]:

hν为入射光子能量;α为相应波长的吸收系数,氢化非晶/纳米硅为间接带隙材料,故n取2,结合Tauc作图法[13]绘制样品光学禁带宽如图4所示。
光学禁带宽度从一方面反应了薄膜对光的利用率,对用于太阳能电池窗口层、有源层和传感器的敏感层的薄膜来说,不同的禁带宽度直接决定了器件的性能优劣。
图4中,H2稀释比分别为99%、97%、95%、92% 和80%时的禁带宽度分别为1.77 eV、1.80 eV、1.83 eV、1.76 eV和1.71 eV。可见,当H2稀释比小于等于95%时,薄膜禁带宽度均大于1.77 eV,超过非晶硅薄膜的1.7 eV[14]。H2稀释比为80%和92%两个位置的禁带宽度虽然比前三者要小,但也分别达到了1.71 eV和1.76 eV。推测由于在非晶硅薄膜中形成了纳米尺寸硅短程有序结构,其量子限制效应造成了带隙的展宽。如图4所示,当H2稀稀比大于等于95%时,禁带宽度随稀释比增大而减小,推测是因为过多的氢等离子体由于不能及时抽出系统,氢原子之间碰撞频率急剧加大,具有很高能量的氢等离子体含量加大,对薄膜形成过刻蚀,导致Si-H键减少,禁带宽度下降。H2稀释比小于95%之后,禁带宽度随稀释比下降而迅速减小,因为此时氢含量过少,反应过程中作为缺陷态悬挂键的重配位原子的氢原子含量过少,氢原子的填充作用不明显,另外,由于氢原子刻蚀作用减弱,薄膜定域态降低,缺陷态增加,禁带宽度减小。

图4 禁带宽度随H2稀释比的变化曲线
图5为样品薄膜的消光系数k随H2稀释比的变化曲线,消光系数k从另一方面反应了薄膜对光的吸收和禁带宽度。本文实验利用椭偏仪对制备的样品进行消光系数k的测量,从图5中可以看出,H2稀释比为95%和97%时,消光系数明显较小,消光系数的整体变化趋势与透过率及禁带宽度变化符合较好;在长波段,只有80% H2稀释比下有少量的光吸收,符合非晶硅消光系数k规律。
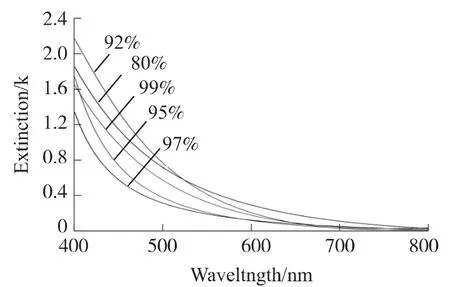
图5 消光系数k随H2稀释比的变化曲线
2.3电导率分析
实验通过Keithley 4200半导体测试仪测量薄膜电阻数据。电导率由以下公式计算得到:

式中:d为薄膜厚度,L为电极间距,h为电极长度,R为所测得的电阻数据。
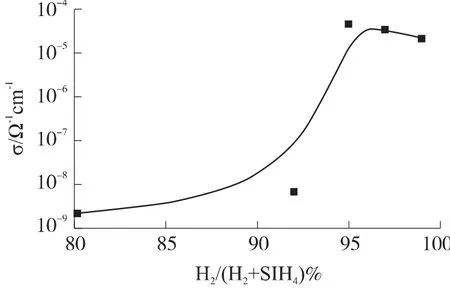
图6 电导率随H2稀释比的变化曲线
图6中可以看出,随着H2稀释比的升高,电导率先增大再略微减小。H2稀释比较小时(<92%)沉积得到的薄膜σ<10-8Ω-1·cm-1,导电性较差,具有典型的本征a-Si:H薄膜导电特性。随着H2稀释比升高,电导率以指数形式上升到10-5Ω-2·cm-2,从前面的分析可知,H2稀释比大于95%时,薄膜结晶程度变高,从a-Si:H转化为nc-Si:H。
薄膜的电学特性可从两方面解释,薄膜中有序结构作为导电通道对电子的输运以及电子穿过异质结界面势垒的量子隧穿效应,而薄膜中的缺陷态密度直接影响电子的输运和隧穿过程,对于非晶硅,薄膜中不仅存在Si悬挂键,还含有较多的微孔和空位等局域态,电子的输运和隧穿除了要经过这些局域态;对于nc-Si:H,由于H等离子体的刻蚀与补偿作用,薄膜中的局域态密度较小,电子主要是穿过非晶和晶态的异质结界面所需能量较小,因此对于nc-Si:H,它的导电性比a-Si:H要好[15]。至于,当H2稀释比过高时,电导率又有所下降,推测可能是由于H的过刻蚀,导致缺陷态密度增大,电子在晶粒间的散射作用增大,导致电导率下降。
3 结论
本文利用RF-PECVD技术以高纯硅烷及氢气硅烷混合气为气源,采用交替反应方式制备了一系列a-Si:H/nc-Si:H薄膜,分析讨论了H2稀释比对薄膜微结构和光学性能的影响。得出以下主要结论:
(1)随着H2稀释比的增大,成膜速率持续下降。
(2)增大H2稀释比可使薄膜内Si原子的排列逐渐朝有序方向发展。
(3)薄膜禁带宽度并不是一味的随H2稀释比增大而增大,变化是先增大后减小,并在5%附近时达到最大。
(4)薄膜电导率随H2稀释比的增大,呈现先缓慢增大,当稀释比大于95%时,电导率相对稀释比呈指数级上升,但当稀释比大于97%时,电导率又有小幅下降。
参考文献:
[1]Carlson D E,Wronski C R.Amorphous Silicon Solar Cell[J].Appl Phys Lett,1976,28:671-676.
[2]Spear W E,Comber L P G.Eleetronic Properties of Substitutionnally Doped Amorphous Si and Ge[J]Philosophical Magazine,1976,33:935-949.
[3]Spear W E,Comber L P G.Substitutional Doping of Amorphous Silicon[J].Solid State Communication,1975,17(9) :1193-1196.
[4]张学宇.氢化纳米晶硅薄膜的制备及生长机理研究[D].大连:大连理工大学,2012:15-16.
[5]陈乙豪,蒋冰,马蕾,等.衬底温度对nc-Si:H薄膜微结构和氢键合特征的影响[J].人工晶体学报,2013,42(10) :2033-2037.
[6]Matsuda A.Microcystalline Silicon Growth and Device Application [J].Journal of Non-Crystalline Solids,2004,338-340:1-12.
[7]Ali A M.Mechanism of Growth of Nanocrystalline Si:H Films Deposited by PECVD[J].Journal of Non-Crystalline Solids,2006,352:3126-3133.
[8]Funde A M,Nabeel A B,Kamble D K.Influence of Hydrogen Dilution on Structural,Electrical and Optical Properties of Hydrogenated Nano-Crystalline Silicon(nc-Si:H) Thin Films Prepared by Plasma Enhanced Chemical Vapor Deposition(PE-CVD)[J].Solar Energy Materials and Solar Cells,2008,92(10) :1217-1223.
[9]李志.氢化非晶硅薄膜的晶化处理研究[D].成都:电子科技大学,2010:24-26.
[10]Goh B T,Wah C K,Aspanut Z.Structural and Optical Properties of nc-Si:H Thin Films Deposited by Layer-by-Layer Technique[J].Mater Electron,2014,25:286-296.
[11]Ali A M.Optical Properties of Nano-Crystalline Silicon Films Deposited by Plasma-Enhanced Chemical Vapor Deposition[J].Optical Materials,2007,30(2) :238-243.
[12]邱毅娇,李伟,吴茂阳,等.RF-PECVD法制备a-Si1-xCx:H薄膜的光学性能研究[J].电子器件,2011,34(1) :22-23.
[13]Tauc J,Grigorovici R,Vancu A.Optical Properties and Electronic Structure of Amorphous Germanium[J].Phys Status Solidi,1966,15(2) :627-637.
[14]Wronski C R.Amorphous Silicon Technology:Coming of Age[J].Solar Energy Materials and Solar Cells,1996,41-42:427-439.
[15]Gupta A,Vashistha M,Sharma P.Single Junction a-Si:H Solar Cell with a-Si:H/nc-Si:H/a-Si:H Quantum Wells[J].Thin Solid Films,2013,550:643-648.

程自亮(1988-),男,汉族,安徽省六安市人,在读硕士,主要从事光敏材料与器件的研究,cheng_ziliang@ 163.com;

蒋向东(1964-),男,汉族,博士,电子科技大学光电信息学院副教授、硕士研究生导师,主要研究方向为功能材料及器件的研究等,xdjiang@ 163.com。
项目来源:国家自然科学基金项目(61006044,60776051,61006059);北京市自然科学基金项目(4142007,4143059);北京市优秀跨世纪人才基金项目(67002013200301)
A Novel Fully Differential Active Inductor with Concurrently High Q Value High Inductance Value and High Linearity*
DENG Qiangwei,ZHANG Wanrong*,JIN Dongyue,XIE Hongyun,WANG Zhongjun,LIU Peng,CHEN Penghui,WANG Xiao,ZHANG Lianghao
(College of Electronic Information and Control Engineering,Beijing University of Technology,Beijing 100124,China)
Abstract:A novel fully differential Cascode active inductor with concurrently high Q value,high inductance value and high linearity is presented.The novel DAI features a combination of a Cascode topology,resistive feedback network and feed-forward current source(FFCS) technique.Based on TSMC 0.18 μm CMOS process,the novel DAI is verified by Agilent’s Advanced Design System(ADS),and layout of novel DAI is completed by Cadence Virtuoso.The results show that Q and inductance value of the new DAI can be tuned by changing the applied bias voltage,the Q reaches the maximum value 2 653 at 1.2 GHz,and the inductance value is up to 15.563 nH simultaneously,meanwhile the linearity of inductance is improved by 11.3 dBV compared with traditional DAI without FFCS.
Key words:active inductor; the linearity of inductance; Cascode topology; resistor feedback network; feed-forward current source
中图分类号:TB742; O756
文献标识码:A
文章编号:1005-9490(2015) 03-0485-04
收稿日期:2014-07-25修改日期:2014-08-30
doi:EEACC:211010.3969/j.issn.1005-9490.2015.03.004
