在镜像投影曝光机上使用相移掩膜提高解像力的初步研究
2014-02-02黎午升惠官宝崔承镇史大为薛建设
黎午升,惠官宝,崔承镇,史大为,郭 建,孙 双,薛建设
(1.京东方科技集团 TFT-LCD技术研发中心,北京 100176; 2.北京京东方光电科技有限公司,北京 100176)
1 引 言
在目前许多现行的分辨率强化技术中,相位移掩模一直是用来提升分辨率的重要工具之一。一般说来,当曝光光源通过传统掩模后,由于曝光光源发出的光的相位并没有被偏移,因此,部分光线到达基板表面时产生了光的相长干涉(construction interference),造成基板表面上不应该被照射到光线的图形因为干涉作用而有了曝光的现象,使得图形的分辨率下降。相位移掩膜则是在图案本身上选择性使用了一相位移层(phase shifter)。当曝光光源通过相位移掩模的相位移层后,曝光光源发出的光的相位会被位移了一预定角度,使得位移后的光的相位与先前入射的光的相位产生相位差,造成光到达基板表面时,产生了相消干涉(destructive interference)。经由光的相消干涉效应来消除绕射所引起的干涉效应,大幅提升了图案边界的分辨率[1-3]。
比较典型的相移掩膜有李文森交替型相移掩膜、无铬相移掩膜、边缘相移掩膜、部分边缘相移掩膜、辅助相移掩膜、连续色调相移掩膜和衰减相移掩膜等等[4-6]。考虑掩膜板的制作精度、成本、交期等风险因素,我们采用无铬相移掩膜,即用透过率约为8%的相移膜(成分为MoSiOxNy)代替铬膜。
本文对比分析了传统掩膜与相移掩膜在相同条件下模拟、实验的结果,得到结论:在Canon镜像投影曝光机MPA-7800上使用相移掩膜能增大镜像投影曝光机分辨率以下间距(线宽)的工艺容限,从而提高了光刻的解像力。
2 软件模拟和结果分析
2.1 软件介绍
Athena是美国Silvaco公司推出的一种商用的TCAD工具。TCAD就是Technology Computer Aided Design,指半导体工艺模拟以及器件模拟工具。ATHENA提供了一个易于使用、模块化的、可扩展的平台,能对所有关键制造步骤(离子注入、扩散、刻蚀、沉积、光刻以及氧化等)进行快速精确的模拟[7-10]。它有一个交互式、图形化的实时运行环境Deckbuild,在工艺仿真中作为仿真平台,既有仿真输入和编辑的窗口,也有仿真输出和控制的窗口。它还包括了一个应用傅里叶变换方法和光衍射理论的光学模块(OPTOLITH)。
2.2 模拟过程及结果分析
通过使用Athena软件的Deckbuild仿真平台画出2.5 μm等间隔线的掩膜图形,并模拟Canon镜像投影曝光机MPA-7800光学系统的参数,如表1所示。

表1 模拟参数

图1 等间隔线(2.5 μm)光强分布对比Fig.1 Image intensity distributions of equidistant lines(2.5 μm) on PSM(Phase Shift Mask) and normal mask
再利用该软件的OPTOLITH模块模拟光强分布,如图1所示。可以看出,相移掩膜(PSM)的光强分布更密,这样的光强分布在光刻胶中可使光刻图形的衬比(度)增大,从而改善曝光容限。
以上是离焦量(Defocus)为0时的情况,由于MPA-7800的焦深保证范围为±30 μm,所以我们还模拟了离焦量为15、30 μm时通过掩膜得到的光刻间距情况,如图2所示,可以看出:该间距随着离焦量的增大而减小,但相移掩膜与传统掩膜相比,其变化幅度小0.045 μm。因此,在相同的设备焦深变化范围内,通过相移掩膜得到光刻间距的波动更小,更稳定(3sigma小)。

图2 光刻间距与离焦量关系的对比Fig.2 Space DICD v.s. defocus on PSM(Phase Shift Mask) and normal mask
3 光刻实验及结果分析
3.1 实验介绍
实验采用的是5代的曝光机MPA-7800(解像力Resolution=4.0 μm)及对应的Track机,条件如表2所示。为了便于比较和节约成本,我们在一块掩膜板上制作了传统铬膜掩膜区域和相移掩膜区域,并在这两个区域设计了一样的多组等间隔线,仅取2.5 μm等间隔线为例来加以说明。
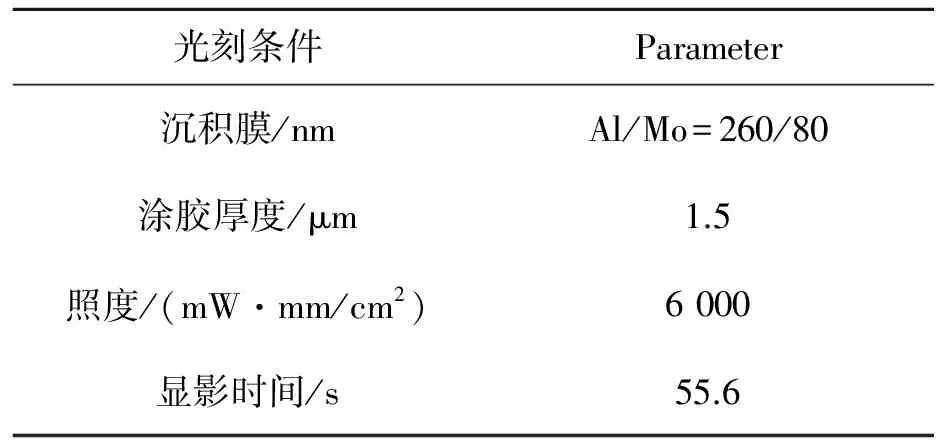
表2 光刻条件
3.2 实验结果分析
图3比较了通过传统掩膜和相移掩膜得到的光刻间距与曝光量的关系。在2.0~3.0 μm区间(2.5±0.5 μm)看曝光量的变化范围,可知道传统掩膜的曝光容限为4 mJ/cm2,相移掩膜的曝光容限为8 mJ/cm2,相移掩膜的曝光容限大于传统掩膜(约为2倍)。这与模拟光强分布得到的结论相吻合,同时,相移掩膜的3sigma更小,这也与模拟光刻间距与离焦量关系对比得到的结论吻合。

图3 光刻间距与曝光量关系的对比Fig.3 Space DICD v.s. exposure dose on PSM(Phase Shift Mask) and normal mask
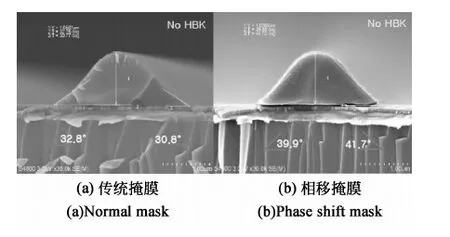
图4 剖面图的对比Fig.4 Cross section of line used normal mask and phase shift mask
图4展现了我们用2.5 μm等间隔线的不同掩膜在光刻后得到线宽/间距也为2.5 μm/2.5 μm时(相移掩膜需曝光量31.7 mJ/cm2,传统掩膜需曝光量25.4 mJ/cm2),光刻线条剖面坡度角的不同。显然,相移掩膜得到的光刻线条剖面的坡度角更大(约10°左右),由以前的工艺经验可知这样会有一个更好的光刻工艺容限。这与模拟和实验的结论吻合,从剖面的角度说明了相移掩膜的优势。
4 结 论
本文对用相移掩膜和传统掩膜的2.5 μm的等间隔线的光刻进行了模拟和实验对比分析。结果表明,相移掩膜能使镜像投影曝光机分辨力以下间距(线宽)的工艺容限增大1倍,并使相应曝光量下间距(线宽)的分布更集中,从而增加细线化的稳定性,提高了光刻的解像力。在随后的研究中,我们还将研究相移掩膜相比传统掩膜在孔图形、拐角图形以及复杂图形上的优势。
[1] Levenson M D,Viswanatha N S,Simpson R A. Improving resolution in photolithography with a phase-shifting mask [J].IEEETransactiononElectronDevices,1982,ED-29(12):1828-1836.
[2] 童志义.国外光刻制版设备发展动态(续)[J].半导体技术,1993,4:33-34.
Tong Z Y. Foreign photolithographic equipment developments (continued) [J].SemiconductorTechnology,1993,4:33-34. (in Chinese)
[3] 罗先刚,姚汉民,周冲喜,等.可提高光刻分辨率的新技术[J].光学学报,2000,29(9):834-837.
Luo X G,Yao H M,Zhou C X,etal. New technology which can improve lithography resolution [J].ActaPhotonicaSinica,2000,29(9):834-837. (in Chinese)
[4] 冯伯儒,陈宝钦.边缘相移掩模技术[J].光电工程,1997,24:12-17.
Feng B R,Chen B Q. Edge phase shift mask technology [J].Opto-ElectronicEngineering,1997,24:12-17. (in Chinese)
[5] 冯伯儒,陈宝钦.无铬相移掩模技术[J].光学学报,1995,25(4):328-332.
Feng B R,Chen B Q. Chromium-free phase shift mask technology [J].ActaPhotonicaSinica,1995,25(4):328-332. (in Chinese)
[6] 周崇喜,冯伯儒,侯德胜,等.用于0.35 μm接触孔图形相移掩膜研究[J].光学学报,2000,20(4):543-547.
Zhou C X,Feng B R,Hou D S,etal. Phase shifting mask for 0.35 μm contact holes [J].ActaPhotonicaSinica,2000,20(4):543-547. (in Chinese)
[7] 阮刚,庞海舟,冒慧敏.集成电路工艺模拟软件SSUPREM4的校验[J].电子学报,1999,27(8):1-6.
Ruan G,Pang H Z,Mao H M. The check of Integrated circuit process simulation software SSUPREM4 [J].ActaElectronicaSinica,1999,27(8):1-6. (in Chinese)
[8] 周伟峰,薛建设,金基用,等.不同狭缝与遮挡条设计对TFT特性的影响与规律[J].液晶与显示,2011,26(2):165-169.
Zhou W F,Xue J S,Kim K Y,etal. Effect and regularity of different Slit&Bar design on TFT characteristics [J].ChineseJournalofLiquidCrystalsandDisplays,2011,26(2):165-169. (in Chinese)
[9] 田铁印,王红,吴国栋.杂光对三线阵相机光学系统成像的影响[J].液晶与显示,2012,27(6):847-851.
Tian T Y,Wang H,Wu G D. Impact of stray light on image of three line array camera [J].ChineseJournalofLiquidCrystalsandDisplays,2012,27(6):847-851. (in Chinese)
[10] 孙辉.相位相关技术实现离焦模糊图像运动估计[J].液晶与显示,2012,27(2):223-228.
Sun H. Estimation of displacement for out-of-focus blurred image using phase-only correlation [J].ChineseJournalofLiquidCrystalsandDisplays,2012,27(2):223-228.(in Chinese)
