基于圆片级阳极键合封装的高gn值压阻式微加速度计*
2013-10-22袁明权孙远程张茜梅屈明山熊艳丽
袁明权,孙远程,张茜梅,武 蕊,屈明山,熊艳丽
(中国工程物理研究院电子工程研究所,四川绵阳 621900)
0 引言
同大多数MEMS器件实现从实验室阶段向产业化过渡所面临的问题一样,高gn值压阻式微加速度计在技术上主要的障碍之一就是封装[1~3]。
尽管目前MEMS产品越来越多,发展越来越快,但是“封装”问题并没有得到研究机构足够的重视,致使大量的产品构想陷入了困境,甚至失败,都是因为没有找到有效且合适的封装方法。现今大多数MEMS产品的生产环节中,封装往往是最昂贵的部分。封装的发展和应用将决定一个MEMS 产品的成败[4~6]。
高gn值压阻式微加速度计中既有传统IC中常见的元素—电阻,又有力学传感器常见的梁、质量块等可动结构[7,8]。因此,同传统IC封装相比,高gn值压阻式微加速度计的封装除满足引线连接、隔离外部环境以避免外界气氛对其腐蚀或破坏外,更重要的作用还包括让外界信号能够更真实地传递到敏感芯片上[9],并提高传感器的抗冲击能力,能够在恶劣的侵彻过程中具有良好性能等。因此,探索有效且合适的封装成为高gn值压阻式微加速度计走向应用的重要环节。
1 封装结构设计
1.1 封装需要考虑的关键因素
对于高gn值压阻式微加速度计敏感芯片来说,密封性、小型化和批量化是重点考虑的关键因素。
1)密封性
如图1所示,本研究的封装对象是典型的悬臂梁加质量块结构的高gn值压阻式微加速度计敏感芯片。其核心部分是可动的,封装过程必须对可动结构加以密封保护,防止异物进入影响梁和质量块的自由运动。由于高gn值压阻式微加速度计在工作时需要供电,而且测得的信号还需要输出,这些都必须通过制作在芯片上的焊盘来实现。因此,在密封的同时还要确保焊盘不被覆盖,否则,后续的引线键合工艺将无法进行。在“密封”的同时考虑“开放”,这往往就成为封装工艺的难点之一。
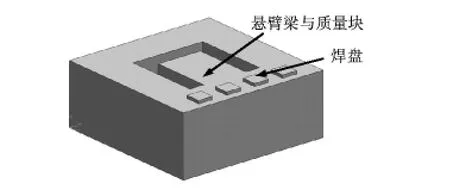
图1 高gn值压阻式微加速度计敏感芯片结构图Fig 1 Structure diagram of high gnpiezoresistive micro-accelerometer chip
2)小型化
研究表明:小型化是提高传感器抗冲击能力的有效手段,这就对封装提出了更高的要求。由于封装技术的落后,往往导致最终失去了器件和系统微型化所带来的优点,这一点对高冲击传感器来说很可能是致命的。
3)批量化
使用机械化自动操作来进行圆片级的封装,有利于提高封装的可靠性和稳定性,提高工作效率、降低成本。
1.2 封装结构
为了有效地保护芯片、提高器件的抗冲击能力,本文提出了一种采用玻璃—硅—玻璃键合的三层式结构,如图2所示。加速度计的检测部分制作在中间硅层上,底层玻璃衬底和上层玻璃盖板一起保护中间结构层,而且给质量块和悬臂梁留有运动间隙,同时上层玻璃盖板具有与中间硅层上的电极引线相对应的精密引线槽。

图2 三层式结构示意图Fig 2 Schematic diagram of the triple stack structure
整片键合示意图见图3。整片键合的实现可以通过2次双层硅—玻璃阳极键合来完成,也可以通过一次三层玻璃—硅—玻璃阳极键合来完成。焊盘通道的建立可以通过精确的划片来实现。
2 制作工艺
2.1 芯片制作工艺过程

图3 整片键合示意图Fig 3 Schematic diagram of the whole chip bonding
高gn值压阻式微加速度计采用玻璃盖板—敏感芯片—玻璃衬底结构,通过阳极键合工艺实现圆片级封装。其加工过程包括:敏感芯片工艺[10,11]、玻璃盖板工艺、玻璃衬底工艺和键合成型工艺等部分。
敏感芯片制作工艺流程见图4。

图4 高gn值压阻式微加速度计敏感芯片工艺流程Fig 4 Fabrication process of high gnpiezoresistive micro-accelerometer sensitive chip
具体的工艺过程描述如下:
高温氧化,光刻,去氧化层,淡硼离子注入,硼推进,形成压阻区(图4(a));光刻,去氧化层,浓硼扩散,硼推进,形成欧姆接触区(图4(b));光刻,去氧化层,磁控溅射金属铝,光刻,金属铝腐蚀,光刻,氧化硅腐蚀,形成金属电极(图4(c));光刻,正面ICP刻蚀,形成悬梁结构(图4(d));光刻,背面ICP刻蚀,释放结构,完成高gn值压阻式微加速度计敏感芯片制作(图4(e))。
2.2 玻璃盖板制作工艺过程
玻璃盖板制作工艺流程见图5。
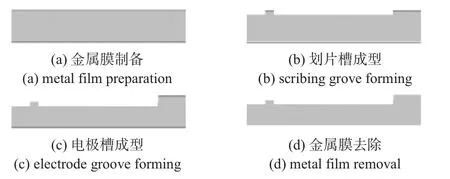
图5 高gn值压阻式微加速度计玻璃盖板工艺流程Fig 5 Fabrication process of the glass cover of high gn piezoresistive micro-accelerometer
具体的工艺过程描述如下:
溅射金属铬金,形成硼硅玻璃腐蚀所需金属掩蔽膜(图5(a));光刻,湿化学腐蚀金属铬金,湿化学腐蚀硼硅玻璃,形成划片所需隔离间隙(图5(b));光刻,湿化学腐蚀金属铬金,湿化学腐蚀硼硅玻璃,形成电极引线槽(图5(c));化学腐蚀金属铬金,去除金属掩蔽膜层,完成高gn值压阻式微加速度计玻璃盖板制作(图5(d))。
2.3 玻璃衬底制作工艺过程
玻璃衬底制作工艺流程见图6。

图6 高gn值压阻式微加速度计玻璃衬底工艺流程Fig 6 Fabrication process of the glass substrate of high gn piezoresistive micro-accelerometer
具体的工艺过程描述如下:
溅射金属铬、金,形成硼硅玻璃腐蚀所需金属掩蔽膜(图6(a));光刻,湿化学腐蚀金属铬金,湿化学腐蚀硼硅玻璃,形成质量块运动所需间隙(图6(b));化学腐蚀金属铬金,去除金属掩蔽膜层,完成高gn值压阻式微加速度计玻璃衬底制作(图6(c))。
2.4 键合成型制作工艺过程
键合成型制作工艺流程见图7。具体的工艺过程描述如下:
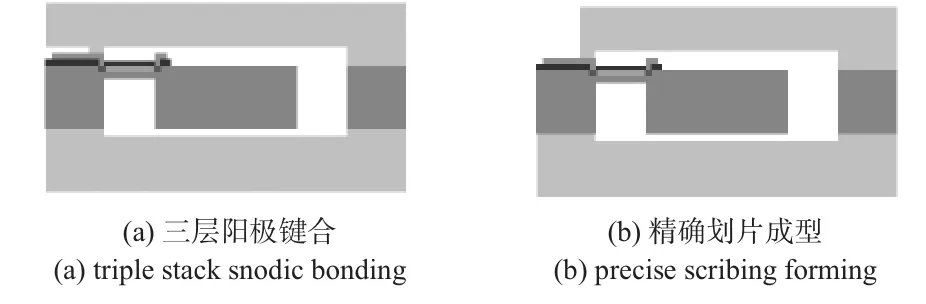
图7 键合成型工艺流程Fig 7 Fabrication process of bonding and shaping
玻璃盖板、敏感芯片与玻璃衬底三层精确对位,三层阳极键合(图7(a));精确划片成型,完成高gn值压阻式微加速度计传感器制作(图7(b))。阳极键合是在三层玻璃—硅—玻璃对位完成后一次完成的。
3 结果与分析
3.1 样品制作
基于上述圆片级制作与封装工艺,采用N〈100〉晶向、电阻率为4~7 Ω·cm、直径为 100 mm、厚度为 400 ±10 μm双面抛光单晶硅片和直径为100mm、厚度为200±10μm双面抛光硼硅玻璃片成功制作出一种圆片级封装的高gn值压阻式微加速度计。图8为圆片级封装后的工艺片。
3.2 性能测试

图8 高gn值压阻式微加速度计圆片级封装样片Fig 8 Wafer-lever packaging sample of high gnpiezoresistive micro-accelerometer
采用Endevco 2925 POP Shock Calibrator和自制便携式高gn值冲击试验装置对加速度计进行背靠背冲击测试[12,13]。选用Endevco 2270型压电式加速度计作为标准传感器,该传感器电荷灵敏度为0.858 pC/gn。图9为6000gn左右冲击下的测试结果。结果显示:传感器灵敏度是0.1512 μV/gn/V,同设计值 0.15μV/gn/V 比较吻合。在该冲击下测得传感器的谐振频率约为200 kHz。
采用Endevco 2973A SMAC Hopkinson高冲击校准装置对加速度计进行了抗冲击性能测试[15]。测试结果表明:传感器在105gn短脉冲(80 μs)下能够正常工作。目前正在进行宽脉冲(ms量级)高冲击试验的准备工作。

图9 高gn值压阻式微加速度计测试曲线Fig 9 Testing curve of high gnpiezoresistive micro-accelerometer
4 结论
为了解决高gn值压阻式微加速度计制造过程中的芯片密封性、小型化和批量化等生产难题,设计了一种圆片级封装结构,突破了芯片制造过程中电极通道建立、焊盘保护、精确划片等关键技术。采用玻璃—硅—玻璃3层对准、阳极键合一次完成的圆片级封装方式,在4 in硅基MEMS生产线上制作出了尺寸仅为1 mm×1 mm×0.8 mm的高gn值压阻式微加速度计样品;测试结果表明:样品具备105gn的抗冲击能力、0.15 μV/gn/V的灵敏度以及200 kHz的谐振频率。
通过对封装结构的适应性改变,圆片级键合封装技术也可应用于其他具有相似结构的MEMS器件研制过程。
[1] 孙远程,杨 波,彭 勃,等.微机械高冲击传感器的一种失效模式研究[J].传感技术学报,2006,5:1610 -1612.
[2] 王玉传.MEMS圆片级芯片尺寸封装研究[D].上海:中国科学院上海微系统与信息技术研究所,2006.
[3] 张 卓,汪学方,王宇哲,等.MEMS圆片级真空封装金硅键合工艺研究[J].电子与封装,2011,11(1):1 -4.
[4] 杨杏敏.大过载压阻式加速度计设计、封装与测试[D].太原:中北大学,2011.
[5] Tummala R R.微系统封装基础[M].黄庆安,等,译.南京:东南大学出版社,2005.
[6] 蒋玉齐.高量程MEMS加速度计封装研究[D].上海:中国科学院上海微系统与信息技术研究所,2004.
[7] 刘凤丽,郝永平.高gn值压阻式微加速度计设计[J].光学精密工程,2009,6:1442 -1446.
[8] 李 伟.高gn值硅微加速度计的结构设计与分析[D].南京:南京理工大学,2005.
[9] 何洪涛.一种基于BCB键合技术的新型MEMS圆片级封装工艺[J].微纳电子技术,2010,47(10):629 -651.
[10] Ning Yuebin ,Loke Yan ,McKinnon G.Fabrication and characterization of high g-force,silicon piezoresistive accelerometers[J].Sensors and Actuators A,1995,48:55 -61.
[11] Elwenspoek M.硅微机械加工技术[M].Jansen,等,译.北京:化学工业出版社,2006.
[12]王 超,陈光焱,邓开举.一种便携式高gn值冲击试验装置的设计[J].振动与冲击,2010,29(12):227 -229.
[13] Sill R D.Testing techniques involved with the development of high shock acceleration sensors[M].San Juan Capistrano,CA:Endevco Corporation,284.
