掺杂GaN间隔层对双波长发光二极管光谱调控作用的研究*
2011-10-23张运炎范广涵郑树文
张运炎 范广涵 章 勇 郑树文
(华南师范大学光电子材料与技术研究所,广州 510631)
(2010年3月7日收到;2010年5月18日收到修改稿)
掺杂GaN间隔层对双波长发光二极管光谱调控作用的研究*
张运炎 范广涵†章 勇 郑树文
(华南师范大学光电子材料与技术研究所,广州 510631)
(2010年3月7日收到;2010年5月18日收到修改稿)
采用软件理论分析的方法对p型及n型掺杂的GaN间隔层在InGaN/GaN多量子阱双波长发光二极管中对光谱调控作用进行模拟分析.分析结果表明,掺杂的GaN间隔层的引入,可以有效地控制各阱中的电子或空穴浓度,很好地解决了双波长发光二极管中两种阱发光强度不均的问题,并且通过控制阻挡层的厚度,可以调控两种阱中的载流子浓度,从而调控发光峰的相对强度.这些可以归因于掺杂GaN间隔层对电子或空穴的阻挡作用.
GaN,间隔层,数值模拟,双波长发光二极管
PACS:85.60.Jb,85.50.-n,87.15.A - ,78.60.Fi
1.引 言
近年来,随着发光二极管(LED)技术的不断进步,LED在发光效率、使用寿命以及成本控制等方面都取得了长足进展.随着生产应用的需要,科研人员正把注意力集中到多波长LED芯片的研制上来.多波长LED,也就是在同一个芯片上能够同时发多种波长.较我们现在所用的色光组合法,即用多个封装好的发不同波长光的LED组合出我们所需要的色光,多波长LED芯片有其独特的优点,它可以减少生产成本,特别是芯片制造成本和封装成本.同时它的体积较小,有利于提高集成度.多波长发光二极管有一个重要用途,就是大功率白光LED的制作.目前市场上主流的大功率白光LED主要是以GaN蓝光芯片激发发射黄光的荧光粉获得白光.尽管该类LED在发光效率方面不断提升,但其在显色指数指标上的不足阻碍了其在普通照明领域的应用和推广.并且由于荧光粉的无辐射复合使得LED效率下降,转化效率低,同时老化实验表明,荧光粉的劣化是LED寿命缩短的一大原因[1].因此科研人员致力于研发无荧光粉的单芯片半导体白光 LED[2—9],调整芯片光谱,让它直接发出的各种波长的光组合成白光,因此多波长LED芯片成为一种最佳选择,可以避免使用荧光粉从而克服荧光粉的各种不足.本文对双波长LED的发光机理进行软件模拟研究,并深入讨论了不同掺杂类型的GaN间隔层和量子阱垒层对双波长LED发光光强、内量子效率、电子空穴浓度分布等的影响,对白光LED的制作具有指导作用.
2.理论模型和器件结构
2.1.器件模拟的基本方程
Crosslight公司的半导体器件模拟专用软件APSYS(advanced physical models of semiconductor devices)[10]是利用二维有限元的分析方法,以漂移-扩散模型和电流连续方程为基础,结合边界条件自洽解泊松方程


得到LED器件电学与光学特性.
(1)和(2)式中,Rsp代表自发辐射复合速率;Rst代表受激辐射复合速率;Gopt(t)代表光产生率;n,p为电子与空穴浓度;NA,ND为浅层施主、受主掺杂密度;fD,fA分别为电子占据施主和空穴占据受主杂质的概率.

分别是电子流与空穴流密度,其中μ为迁移率,EF为准费米能级.
(3)式中 ΔV为电场,εdc为相对介电常数.
器件中的非辐射复合过程采用SRH深能级陷阱复合和俄歇复合.
SRH复合速率表示为:

式中cnj,cpj为载流子俘获系数,n1j(p1j)为电子或空穴准费米能级与J陷阱中能级Etj合并时的载流子浓度.Ntj为第j个 SHR深能级陷阱的密度;ftj为电子占据第j个深能级陷阱的概率,δ为1代表施主,为0代表受主.
俄歇复合速率表示为

式中,Cn,Cp为材料的俄歇系数是常数且取决于材料本身,ni指本征载流子密度.
在处理含应力的InGaN量子阱导带和价带能级时,为了简化能级计算,在能带结构上求解忽略了导带和价带的能级之间的耦合作用,分别采用 抛 物 带 模 型[11]和 有 效 质 量 近 似 模 型[12].InGaN与AlGaN的能带间隙可用下列方程式表示:

A表示GaN二元合金,B表示InN或AlN二元合金,C为弯曲系数.
在氮化物元件各层交接面中,考虑了内建极化效应机制[13—15].在模拟中,三元氮化物材料极化效应公式如下:

ε为薄膜结构与基板间的应变,计算如下:

这里 asub为基板晶格常数,a为氮化物薄膜晶格常数.
APSYS模拟程序按照有限元方法在空间离散泊松方程、电流连续性方程、载流子输运方程和量子机制的波方程等,形成非线性方程组,然后用求解非线性方程组的方法,如牛顿法进行迭代求解,从而得到LED器件电学与光学特性.软件还考虑了氮化物元件各层交接面的内建极化效应,同时兼顾了载流子的自发辐射复合和缺陷所造成的SRH非辐射复合速率问题.此软件具有数值稳定和计算速度高的特点.
2.2.器件结构
本文研究了InGaN量子阱结构的发光二极管,其中器件面积为300 μm×300 μm,器件结构如表1所示,从下到上依次为 3 μm n-GaN(掺杂浓度为5×1018cm-3);活性层Ⅰ;GaN间隔层;活性层Ⅱ;0.03 μm的 p-Al0.07Ga0.93N(p型掺杂浓度为3×1017cm-3)电子阻挡层;0.15 μm p-GaN(p型掺杂浓度为7×1017cm-3).每个活性层包括两个量子阱层及它们的垒层,本文选取的两种活性层分别以In0.11Ga0.89N和In0.18Ga0.82N为阱层材料,厚度均为2.2 nm,两种量子阱结构的垒层均为GaN,厚度均为15 nm.具体结构如表1中所示.

表1 器件结构表
在本文中,器件工作温度为300 K,活性层Ⅰ与活性层Ⅱ是两种不同的阱.针对间隔层进行了数种设计,总的分为n型掺杂间隔层和p型掺杂间隔层.再细分对比了两种活性层间有无间隔层,及不同厚度的间隔层时的结果.然后交换两种阱位置,同样比较它们间有无间隔层,及不同厚度的间隔层时的结果.详细对比了发光光谱随电流的变化及电子空穴分布.
3.结果与讨论
3.1.n型掺杂间隔层
这里对间隔层进行 n型掺杂,掺杂浓度为3×1017cm-3,同时也对量子阱垒层进行 n型掺杂,掺杂浓度为3×1017cm-3.虽然电子空穴浓度分布、复合率分布等会随电流大小而变化,但是根据计算结果显示,间隔层及量子阱垒层对载流子分布及对光谱调控的一系列作用,在其他大小的电流下与在20 mA电流下特征趋势相同.限于篇幅,我们只选取了20 mA作为代表,并结合发光光谱随电流的变化进行补充说明论证.
3.1.1.不同阱(In含量不同)对空穴限制作用比较
1)活性层Ⅱ为 In0.18Ga0.82N/GaN,活性层Ⅰ为In0.11Ga0.89N/GaN且它们之间不加间隔层.
图1是在20 mA时芯片的自发发射谱,从图可见,In0.18Ga0.82N阱所发的0.45 μm光的光强度非常大,而In0.11Ga0.89N阱却几乎看不到发光峰.观察图2,图中N表示此端靠近N电极,P表示此端靠近P电极.图中两个阱的电子浓度大体相同,但In0.18Ga0.82N阱中空穴浓度却比In0.11Ga0.89N阱中的空穴浓度至少大了4个数量级.
2)交换活性层Ⅰ与Ⅱ阱类型,即活性层Ⅱ为In0.11Ga0.89N/GaN,活性层Ⅰ为In0.18Ga0.82N/GaN且它们之间不加间隔层.

图1 芯片20 mA时自发发射谱图

图2 芯片20 mA时电子空穴浓度分布图 n表示浓度
从图3与图1对比可以看出,In0.11Ga0.89N阱所发的0.41 μm光的峰出现,但是峰高还是远远低于In0.18Ga0.82N阱所发的0.45 μm光的峰高.从图4可以看出,In0.18Ga0.82N阱虽然较 In0.11Ga0.89N阱远离空穴源,但In0.18Ga0.82N阱中平均空穴浓度还是大于In0.11Ga0.89N阱中的平均空穴浓度,而电子浓度却相差甚小.
3)小结
对比图2和图4可以看出,不论高In组分的阱是靠近空穴源还是远离空穴源,其阱中的平均空穴浓度都大于低In组分的阱,所以高In组分的阱对空穴的限制作用强于低In组分阱.同时,电子浓度分布比空穴浓度均匀得多.n型掺杂间隔层及量子阱垒层,对电子来说势垒较低,有利于电子的流动,形成均匀分布,结合图4,图5和图6情况便可以看出.但对于空穴来说n型掺杂间隔层及量子阱垒层势垒较高,所以对空穴流动形成障碍,使得越是远离空穴源的阱中的空穴浓度越低,形成浓度梯度分布.从图2和图4中量子阱内空穴浓度可以看出,对于相同组分的阱,远离空穴源的那个阱中的空穴浓度要比靠近空穴源的那个阱的空穴浓度要低.在各阱中电子浓度大体相同时,空穴浓度越大,其复合效率就越高,发光光强就越大,从而产生了图1与图3的发光光谱.

图3 芯片20 mA时自发发射谱图

图4 芯片20 mA时电子空穴浓度分布图
3.1.2.间隔层对空穴流的阻挡作用
由于不同阱对空穴的限制作用的不同,导致两个阱的空穴浓度差异,造成发光强度悬殊.所以活性层Ⅱ设为 In0.11Ga0.89N/GaN,活性层Ⅰ设为In0.18Ga0.82N/GaN,并引入间隔层对空穴进行阻挡.这样,虽然近源区的低In组分阱对空穴的限制作用弱,但是阻挡层把从源区流来的空穴阻挡了一部分在低In组分阱中,从而平衡两种阱间的空穴浓度,达到对两种阱发光谱强度调控的目的.

图5 芯片20 mA时电子空穴浓度分布图

图6 芯片20mA时电子空穴浓度分布
1)间隔层0.015 μm 图7是在20 mA时自发发射谱,对比图3,可以看出 In0.11Ga0.89N阱所发的0.41 μm光的峰高与 In0.18Ga0.82N阱所发的0.45 μm光的峰齐平.从图5可以看出,随着间隔层的引入,使得空穴在两种阱间的势垒增加,进而阻挡了空穴的流动.对比图4,In0.18Ga0.82N阱中两个量子阱的空穴浓度变小,In0.11Ga0.89N阱中两个量子阱的空穴浓度增大,而电子浓度却依然相差甚小.从两种活性层量子阱中的空穴电子浓度变化,可以看出间隔层对空穴流有阻挡作用,从而调节光谱产生了图5与图7的变化.
2)间隔层 0.075 μm 从图8可以看出,对比图6,In0.18Ga0.82N阱所发的 0.45 μm光的峰消失了,而In0.11Ga0.89N阱所发的0.41 μm光的峰高急剧增加.从图6中可以看出,对比图5,电子浓度依旧没有太大的变化,但是 In0.11Ga0.89N阱中两个量子阱的空穴浓度大幅度增加,In0.18Ga0.82N阱中两个量子阱的空穴浓度减小得更严重.空穴浓度的变化造成了图9的载流子复合率分布,高In组分阱中空穴浓度大,所以载流子复合率较高,低In组分阱中,空穴浓度分布小,所以在图9中小得难以看到其载流子复合率峰.在图8中的表现就是0.41 μm的发光峰极高,而0.45 μm的发光峰几乎看不到.

图7 芯片20 mA时自发发射谱图

图8 芯片20 mA时自发发射谱图

图9 芯片20 mA时载流子复合率位置分布图
3)小结 从以上分析可以看出,随着间隔层的增厚,空穴在两种量子阱间的势垒不断增大,它对空穴的阻挡作用增强,把大量的空穴阻挡于靠近空穴源的那个阱.因此能通过控制间隔层的厚度来调节空穴在各阱中的分布,从而控制各阱的发光强度,使LED所发各种色光满足设计要求.再者,通过观察图5与图6左下方粗实线所示的溢出空穴可以看出,因为间隔层的增厚,溢出空穴减少了近3个数量级,有利于提高载流子的复合率.
3.1.3.发光光谱随电流增大的变化

图10 当间隔层为0.015 μm时自发发射谱与电流变化图

图11 当间隔层为0.019 μm时自发发射谱与电流变化图

图12 当芯片间隔层为0.015 μm,活性层Ⅰ设为In0.11Ga0.89N,活性层Ⅱ设为In0.18Ga0.82N时自发发射谱与电流变化图
图10与图11均为芯片发光光谱随电流变化图,其芯片活性层Ⅱ设为In0.11Ga0.89N/GaN,活性层Ⅰ设为 In0.18Ga0.82N/GaN.图10芯片间隔层厚0.015 μm,从图10中可以看出,随着电流的增大,高In组分阱的发光峰增幅大于低In组分阱.图10中20 mA时两种阱的发光峰峰高还大体等高,但是随着电流增大到60 mA,0.45 μm的峰高就大大高于0.41 μm的发光峰峰高.这是高In组分阱的空穴限制作用强,在大电流下,高 In组分阱对空穴的束缚表现了更大优势,从而高In组分阱的空穴浓度增幅大于低In组分阱,使得载流子复合率更高.结合3.1.1和3.1.2就更容易理解.In0.11Ga0.89N阱比In0.18Ga0.82N阱更靠近P电极,空穴从 P电极流出,必先经过In0.11Ga0.89N阱再经过 In0.18Ga0.82N阱,这样In0.11Ga0.89N阱对空穴的束缚就位置上占有较大的优势.如果两种阱对空穴的束缚作用相同,那么In0.11Ga0.89N阱自发发射谱随电流增大的增幅将会比In0.18Ga0.82N阱大.为了进一步论证,我们设计了间隔层为0.015 μm,活性层Ⅰ为 In0.11Ga0.89N,活性层Ⅱ为In0.18Ga0.82N的芯片,其自发发射谱随电流变化如图 12所示.因为 In0.11Ga0.89N阱较 In0.18Ga0.82N阱远离P电极,其对空穴的束缚在位置上较为不利,再加上In0.11Ga0.89N阱对空穴束缚作用弱,使得其阱中空穴浓度低,导致复合率低,从而发光峰与In0.18Ga0.82N阱的发光锋比小得难以观察.所以图10中两种阱发光锋随电流变化增幅不同是由于这两种阱对空穴束缚作用强弱不同造成的.
从图11中可以看出,在图10芯片结构上进一步加厚间隔层达0.019 μm,使得两种阱间空穴势垒增大,通过这个势垒对空穴的限制作用阻挡一部分空穴于低In组分阱中,从而再次平衡两种阱中的空穴浓度,芯片在60 mA时的发光峰就可以齐平.
通过模拟分析可以看出,在由发两种不同波长的InGaN量子阱组成的LED中,高In组分阱对空穴限制作用强于低In组分阱,而在这种间隔层及量子阱垒层均为n型掺杂的LED器件中电子的分布受间隔层影响较小,所以为了调控两种阱的发光强度,使得两种阱发光强度相对平均,制作时必须把低In组分的阱制作得比高In组分阱靠近P电极.再通过间隔层对空穴流进行部分阻挡,使得靠近空穴源的低In组分阱中的空穴浓度增加,从而增强低In组分阱的发光强度.因此把低In组分阱制作得靠近空穴源,并且控制间隔层的厚度,可以有效地控制两种阱的相对发光强度,从而达到设计要求.此外,间隔层的引入能有效地减少空穴流的溢出.
3.2.p型掺杂间隔层
这里对间隔层进行 p型掺杂,掺杂浓度为3×1017cm-3,同时也对量子阱垒层进行 p型掺杂,掺杂浓度为3×1017cm-3.与n型掺杂间隔层情形类似,我们选取了驱动电流为20 mA时作为代表,并结合发光光谱随电流的变化进行补充说明.
3.2.1.不同阱层(In含量不同)对电子限制作用比较
1)活性层Ⅱ为 In0.18Ga0.82N/GaN,活性层Ⅰ为In0.11Ga0.89N/GaN,且它们之间不加间隔层.
图13是在20 mA时芯片的自发发射谱.从图可见,In0.18Ga0.82N阱所发的0.45 μm光的光强度非常大,而In0.11Ga0.89N阱却只有微弱发光.从图14可以看出,In0.18Ga0.82N阱虽然较In0.11Ga0.89N阱远离电子源,但In0.18Ga0.82N阱中平均电子浓度还是大于In0.11Ga0.89N阱中的平均电子浓度.

图13 芯片20 mA时自发发射谱图
2)当交换活性层Ⅰ与Ⅱ阱类型时,即活性层Ⅱ为 In0.11Ga0.89N/GaN,活性层Ⅰ为 In0.18Ga0.82N/GaN,且它们之间不加间隔层.
从图15中可以看出,对比图13,In0.11Ga0.89N阱所发的0.41 μm光的峰消失.从图16可以看出,In0.18Ga0.82N阱中的平均电子浓度显然大于In0.11Ga0.89N阱中的平均电子浓度.
3)小结 从以上对比可以看出,不论高In组分阱是靠近电子源还是远离电子源,其阱中的平均电子浓度都大于低In组分的阱,可见高In组分的阱对电子的限制作用比较强.同时由于p型掺杂GaN量子阱垒层对电子来说势垒较大,限制了电子的流动,使得在相同In组分的两个阱中远离电子源的那个阱的电子浓度较近电子源的那个阱小,这一点随后给出验证.当然,最靠近p极的那个阱中的电子浓度突然升高,主要是P-Al0.07Ga0.93N的电子阻挡层对电子进行阻挡的结果.

图14 芯片20 mA时电子空穴浓度分布图

图15 芯片20 mA时自发发射谱图

图16 芯片20 mA时电子空穴浓度分布图
3.2.2.间隔层对电子流的阻挡作用
由于不同阱对电子的限制作用的不同,导致两个阱的电子浓度差异,造成发光强度不同.所以把低In组分阱设置近 N极,即近电子源,这样更有利于增加低In组分阱中的电子浓度,同时引入间隔层对电子进行阻挡,使从电子源流过的电子一部分被阻于低In组分阱中,以平衡两种阱间的电子浓度,从而达到对两种阱发光谱强度的调控.所以将活性层Ⅱ设为 In0.18Ga0.82N/GaN,活性层Ⅰ设为 In0.11Ga0.89N/GaN.
1)间隔层为 0.017 μm
图17是在20 mA时自发发射谱,对比图13可以看出,随着0.017 μm的间隔层的引入,In0.11Ga0.89N阱所发的0.41 μm光的峰高变得与 In0.18Ga0.82N阱所发的0.45 μm光的峰高等高.从图18可以看出,In0.18Ga0.82N阱中两个量子阱的电子浓度对比图14变小,In0.11Ga0.89N阱中两个量子阱的电子浓度对比图14增大.两种阱的平均电子浓度大小变得相同.从两种活性层量子阱中的电子浓度变化可以看出,间隔层对电子有一定的阻挡作用,从而产生了图17与图18的变化.
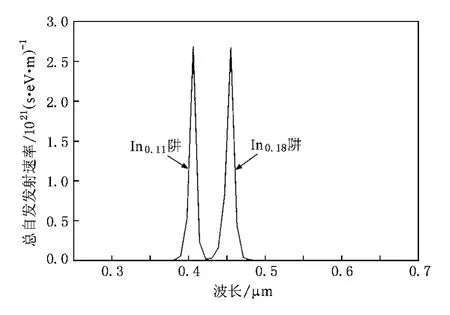
图17 芯片20 mA时自发发射谱图
2)间隔层再增厚达0.06 μm
从图19可以看出,对比图17,In0.18Ga0.82N阱所发的0.45 μm光的峰急剧下降,而 In0.11Ga0.89N阱所发的0.41 μm光的峰高急剧增加.从图20中可以看出,In0.18Ga0.82N阱中两个量子阱的电子浓度对比图18减小得严重.

图18 芯片20 mA时电子空穴浓度分布图

图19 芯片20 mA时自发发射谱图

图20 芯片20 mA时电子空穴浓度分布
3)小结 从以上分析可以看出,电子在p型掺杂GaN中的势垒较高,随着间隔层的增厚,它对电子的阻挡作用增强,结合图16与图21中In0.11Ga0.89N阱中电子浓度的对比就更容易看出间隔层对电子的阻挡作用.因此能通过控制间隔层的厚度来调节电子在各阱中的分布,从而控制各阱的发光强度,使LED所发色光满足设计要求.再者,通过观察图18和图20,图16与图21右下方实线所示的溢出电子,可以看出,因为间隔层的增厚,溢出电子急剧减少,有利于提高载流子的复合率.

图21 芯片活性层Ⅱ为In0.11Ga0.89N,活性层Ⅰ为In0.18Ga0.82 N,间隔层为0.06 μm,20 mA时电子空穴浓度分布
3.2.3.发光光谱随电流增大的变化
图22与图23均为芯片发光光谱随电流变化图,芯片活性层Ⅱ设为 In0.18Ga0.82N/GaN,活性层Ⅰ设为为 In0.11Ga0.89N/GaN.图22芯片间隔层厚0.018 μm.与3.1.3中类似,从图22中可以看出,随着电流的增大,高In组分阱的发光峰增幅大于低In组分阱.图22中20 mA时两种阱的发光峰峰高还大体等高,但是随着电流增大到60 mA,0.45 μm的峰高就大大高于0.41 μm的发光峰峰高.这是高In组分阱对电子的束缚限制能力强,在大电流下,高In组分阱对电子的束缚表现了更大优势,从而高In组分阱的电子浓度增幅大于低 In组分阱,使得载流子复合率更高.结合3.2.1和3.2.2就更容易理解.In0.11Ga0.89N阱比In0.18Ga0.82N阱更靠近N电极,电子从N电极流出,必先经过In0.11Ga0.89N阱再经过 In0.18Ga0.82N阱,这样 In0.11Ga0.89N阱对电子的束缚就位置上占有较大的优势.如果两种阱对电子的束缚作用相同,那么In0.11Ga0.89N阱自发发射谱随电流增大的增幅将会比In0.18Ga0.82N阱大.为了进一步论证,我们设计了间隔层为0.018 μm,活性层Ⅱ为 In0.11Ga0.89N,活性层Ⅰ为In0.18Ga0.82N的芯片.其自发发射谱随电流变化如图24所示,因为 In0.11Ga0.89N阱较 In0.18Ga0.82N阱远离了N电极,其对电子的束缚在位置上较为不利,再加上In0.11Ga0.89N阱对电子束缚作用弱,使得其阱中电子浓度比In0.18Ga0.82N阱小得多,复合率低,从而其发光峰与In0.18Ga0.82N阱的发光锋比小得难以观察.所以图22中两种阱发光锋随电流变化增幅不同是由于这两种阱对电子束缚作用强弱不同造成的.

图22 当间隔层为0.018 μm时自发发射谱与电流变化图
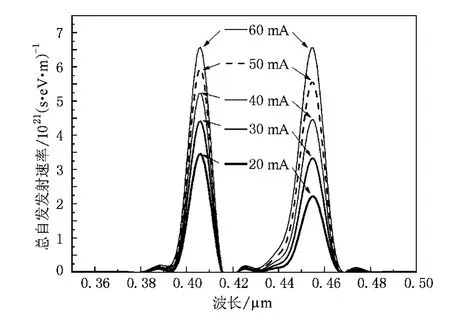
图23 当间隔层为0.023 μm时自发发射谱与电流变化图
从图23中可以看出,当在图22芯片上进一步加厚间隔层达0.023 μm,使得两种阱间电子势垒增大,通过势垒增强对电子的阻挡作用,使低 In组分阱中电子浓度增大,再次平衡两种阱中的电子浓度,芯片在60 mA时的发光峰就可以齐平.

图24 芯片间隔层为0.018 μm,活性层Ⅱ设为In0.11Ga0.89N,活性层Ⅰ设为In0.18Ga0.82N,自发发射谱与电流变化图
通过模拟分析可以看出在由发两种波长光的InGaN量子阱组成的LED中,高In组分的阱对电子限制作用强于低In组分的阱,所以在这种间隔层及量子阱垒层均为p掺杂的LED器件中,为了调控两种阱的发光强度,使得两种阱发光强度相对平均,制作时必须把低In组分的阱制作得比高In组分阱靠近N电极.再通过间隔层对电子流进行部分阻挡,使得靠近电子源的低In组分阱中的电子浓度增加,从而使得其光强度增加,并减小近p型层高In组分阱中的电子浓度,减小其电子与空穴复合,从而降低其发光强度.因此把低In组分阱制作得靠近电子源,并且控制间隔层的厚度,可以有效的控制两种阱的相对发光强度,从而使芯片达到设计要求.
4.结 论
间隔层的引入,可以有效地控制电子空穴的浓度分布,可以很好地解决两种波长的光发光光强不均的现像.并且通过控制间隔层的厚度,可以有效地调控两种阱的相对发光强度,以达到芯片光谱设计的要求.
[1]Zheng D S,Qian K Y,Luo Y 2005Semicond.Optoelectro.26 87
[2]Shen G D,Zhang N G,Liu J P,Niu N H,Li T,Xing Y H,Lin Q M,Guo X 2007Semicond.Optoelectron.28 349
[3]Yamada M,Narukawa Y,Mukai T 2002J.Appl.Phys.41 246
[4]Qi Y D,Liang H,Tang W,Lu Z D,Lau K M 2004J.Cryst.Growth272 333
[5]Damilano B,Grandjean N,Pernot C,Massies J 2001J.Appl.Phys.40 918
[6]Li Y L,Gessmann T H 2003J.Appl.Phys.94 2167
[7]Yamada M,Narukawa Y,Mukai T 2002J.Appl.Phys.41 246
[8]Chen H S,Yeh D M,Lu C F 2006IEEE Photon.Technol.Lett.18 1430
[9]Ozden I,Makarona E,Nurmikko A V,Takeuchi T,Krames M 2001Appl.Phys.Lett.79 2532
[10]Crosslight Software Inc http://www.crosslight.com [February 2,2010]
[11]Chuang S L,Chang C S 1997Semicond.Sci.Technol.12 252
[12]Chuang S L,Chang C S 1996Phys.Rev.B 54 2491
[13]Goano M, Bellotti E,Ghillino E,Garetto C, Ghione G,Brennan K F 2000J.Appl.Phys.88 6476
[14]Bernardini F,Fiorentini V,Vanderbilt D 1997Phys.Rev.B 56 10024
[15]Fiorentini V,Bernardini F,Ambacher O 2002Appl.Phys.Lett.80 1204
PACS:85.60.Jb,85.50.-n,87.15.A - ,78.60.Fi
Effect of spectrum-control in dual-wavelength light-emitting diode by doped GaN interval layer*
Zhang Yun-Yan Fan Guang-Han†Zhang Yong Zheng Shu-Wen
(Institute of Opto-Electronic Materials and Technology,South China Normal University,Guangzhou 510631,China)
(Received 7 March 2010;revised manuscript received 18 May 2010)
A two-dimensional simulation of electrical and optical characteristics of dual-wavelength LED(light-emitting diode)with doped GaN interval layer is conducted with software.It shows that by the use of doped GaN interval layer,we can solve the luminescence intensity disparity of the two kinds of quantum wells in dual-wavelength LED.And through control of the thickness of the interval layer,we can adjust the relative luminescence intensity of the two kinds of quantum wells.Therefore,the effect of spectrum-control in dual-wavelength LED is due to the blocking effect of holes or electrons by doped GaN interval layer.
GaN,interval layer,numerical simulation,dual-wavelength light-emitting diode
*广东省产学研结合引导项目(批准号:2009B090300338)、粤港关键领域重点突破项目(批准号:2007A010501008)和高等学校博士学科点专项科研基金(批准号:350163)资助的课题.
†通讯联系人.E-mail:gfan@scnu.edu.cn
*Project supported by the Guided Program of Guangdong Province-Ministry of Education of China on Industry-University-Research Collaboration(Grant No.2009B090300338),the Crucial Field and Key Breakthrough Project of Guangdong Province and Hongkong,China(Grant No.2007A010501008)and the Specialized Research Fund for the Doctoral Program of Higher Education of China(Grant No.350163).
†Corresponding anthor.E-mail:gfan@scnu.edu.cn
