Ge 掺杂GaN 晶体双光子诱导超快载流子动力学的飞秒瞬态吸收光谱研究*
2020-08-29方宇吴幸智陈永强杨俊义宋瑛林
方宇 吴幸智 陈永强 杨俊义 宋瑛林
1) (苏州科技大学物理科学与技术学院, 江苏省微纳热流技术与能源应用重点实验室, 苏州 215009)
2) (苏州大学物理科学与技术学院, 苏州 215006)
1 引 言
氮化镓(GaN)是蓝色发光器件的关键材料,被公认为是仅次于硅(Si)的最重要的半导体之一[1].由于具有出色的导热性、高饱和速度和高击穿电场, GaN 极其适用于大功率和高频等器件[2]. 与窄间接带隙半导体Si 相比, GaN 具有很宽的直接带隙(室温下约为3.4 eV), 具有极宽的透明窗口, 跨越紫外、可见光和红外波段, 这使其适合于制备超宽带的光学设备, 尤其是在光通信频段[3−5]. 众所周知, 宽带隙半导体材料(譬如GaN, ZnO)中的固有(本征)缺陷可以极大地改变器件的光学性能和指标. 诸如杂质和空位之类的点缺陷是GaN 中非辐射复合的主要来源[6,7], 非辐射复合会缩短载流子寿命从而严重影响发光器件的效率[8]. 另外,线位错(threading dislocations, TDs)和表面缺陷的存在对载流子传输和复合也起着重要的作用[9].因此, 要设计基于GaN 的先进光学和电子器件,探测和控制非平衡载流子寿命, 对载流子动力学机制的清晰认识都是至关重要的.
Si 是GaN 最常见的n 型掺杂剂, 但是在外延层中出现显著的拉伸应变导致Si 掺杂GaN 的总缺陷密度增加. 最近, 几个研究小组发现, 使用锗(Ge)代替Si 作为n 型掺杂剂可能有助于解决该问题, 因为由于Ge 和Ga 原子具有相似的离子半径,Ge 替换Ga 点位所引起的晶格畸变会较小[10,11].Ge 也是一种浅施主, 其激活能约为20 meV, 与Si(17 meV)相似[12,13]. Ge 可作为GaN 中非常有利的n 型掺杂剂, 它将使GaN 的表面更平滑, 膜应力更低, 缺陷更少[14,15]. 因此, 对Ge 掺杂GaN(GaN:Ge)晶体缺陷态的载流子动力学研究尤为必要.
GaN 中缺陷引起的载流子动力学除了与缺陷本身有关, 还和载流子的产生方式有关. 利用单光子吸收和双光子吸收都可以产生载流子, 这两种方式不仅可以改变光生载流子的浓度还可以控制非平衡载流子的分布. 在单光子激发下(one-photon excitation, 1PE), 高吸收系数会在半导体表面区域产生极不均匀的光生载流子. 在这种情况下, 载流子扩散和表面复合等效应会导致GaN 基发光二极管内部量子效率显著下降[16,17]. 而相反, 双光子激发(two-photon excitation, 2PE)会在半导体内部产生较均匀的光生载流子, 这可以有效地避免载流子扩散和表面复合效应, 更准确地获得缺陷引起的载流子复合弛豫等载流子动力学特性. 基于自由载流子吸收的时间分辨泵浦探测技术是探究GaN 载流子动力学十分有效的方法[18]. 然而, 大部分瞬态吸收测量都只利用单波长进行探测[19−21].利用白光超连续谱(宽波段)作为探测光可以同时了解光生载流子的光谱和时间特性, 了解不同缺陷态之间载流子的弛豫复合机制和寿命, 给载流子动力学提供更丰富和准确的信息[22,23]. 最近, 利用飞秒瞬态吸收光谱, 成功区分了p 型GaN 中的表面复合和体缺陷俘获过程, 获得了相应的表面复合寿命和载流子俘获时间[24].
本文利用飞秒脉冲2PE 下的近红外探测吸收光谱方法探究GaN: Ge 的缺陷载流子动力学机制.在近红外波段下宽带半导体中的载流子吸收会明显强于可见光波段下. 实验发现, 在n 型GaN 中,载流子吸收随着探测波长增加而显著增强, 光学声子辅助的空穴间接吸收对载流子动力学起着决定性的作用. 瞬态吸收响应呈现双指数衰减, 其中较快的寿命t1几乎不随激发能流发生变化, 而较慢的寿命t2随着激发能流逐渐增大. 利用载流子复合模型可以很好地解释实验结果, 并且获得了相应缺陷态的载流子俘获系数.
2 样品与实验方法
(0001)取向的GaN 晶体利用氢化物气相外延(hydride vapor phase epitaxy, HVPE)生长在GaN/蓝宝石基底上(约3 mm), 在生长过程中通过控制HCl 流量来控制Ge 掺杂的浓度. 实验所用的样品是从块状GaN 晶体中距离基底约1 mm 处切下, 并对两面进行了抛光, 尺寸为10 mm×10.5 mm×2 mm. 样品具有很低的位错密度(约1×106cm–2),通过霍尔效应确定GaN: Ge 在热平衡下的载流子浓度n0约为0.5×1018—1×1018cm–3. 利用二次离子质谱(secondary ion mass spectroscopy, SIMS)方法测量了GaN: Ge 中最常见的杂质氧(O)和碳(C)的 浓 度 分 别 约 为2×1016—5×1016cm–3和0.8×1016—2.2×1016cm–3, 证明了HVPE 生长的GaN 具有很高的纯度.
本文利用瞬态吸收光谱(transient absorption spectroscopy, TAS)来探究GaN: Ge 的超快载流子动力学, 进行了波长相关的瞬态吸收测量. 与时间分辨光致发光相比, TAS 方法不受载流子复合方式的影响, 能够在不同光子能量探测下获得非平衡载流子浓度, 可以通过吸收谱线获得缺陷态的跃迁能级, 具体测量光路以及原理参见文献[25,26].TAS 的激 发 脉冲光 源为Light Conversion 公司掺镱光纤(Yb: KGW)飞秒激光器(PHAROS,1030 nm)泵浦的光学参量放大器(OPA, Light Conversion ORPHEUS, 190 fs, 6 kHz), 激发光在样品处的光斑半径约为0.8 mm.500—1100 nm 波长 范 围 的 白 光 超 连 续 谱 (white-light supercontinuum, WLS)探测脉冲由OPA 泵浦脉冲(1030 nm)聚焦到5 mm 非线性介质YAG 晶体上而产生, 在样品处的光斑半径小于100 µm. 利用成像光谱仪结合Si 二极管阵列光电探测器检测样品之后的透射探测脉冲信号. 在每个延迟时间对300 个瞬态吸收光谱进行平均处理来消除泵浦光和光谱的浮动. 通过标准同步锁相放大器比较在有泵浦脉冲和无泵浦脉冲时的透过样品的WLS 强度, 即可得到不同探测波长lp和延迟时间t下样品的差分光密度(∆OD):

式中Iunpumped为没有泵浦光激发时WLS 的强度,而Ipumped为有泵浦光激发时WLS 的强度. 本文涉及的所有实验测量均在室温下进行.
3 结果与讨论
3.1 双光子激发下的瞬态吸收光谱
图1(a)显示了GaN: Ge 晶体的线性吸收光谱, 当波长大于带隙对应的波长时(365 nm,3.4 eV)时, 样品不存在任何光吸收, 证明了样品具有很高的纯度及极低的缺陷密度. 利用650 nm 下的飞秒Z扫描测量技术来验证GaN: Ge 晶体的双光子吸收特性. 光源与瞬态吸收光谱所用的光源一致, 在焦点处光斑的半径约为45 µm. 在不同入射脉冲能量下的开孔Z扫描曲线如图1(b)所示. 样品表现出明显的反饱和吸收, 样品的吸收系数变化Da可表示为

其中b为双光子吸收系数,I为样品处的峰值光强.利用Z扫描理论[27]拟合得到b≈ 5.1 cm/GW,其值不随入射能量变化, 证明了反饱和吸收来自于双光子吸收. 图1(a)的内插图还显示了在2PE(650 nm)下GaN: Ge 晶体的照片, 整个晶体发出了明亮的黄光. GaN 的黄带发光是GaN 中最常见的由点缺陷引起的发光[7]. HVPE 生长的低位错GaN 晶体在室温下的光致发光(photoluminescence)光谱可参考文献[28,29], 除了很强的带边发射(bandedge emission, BE)以外, 依然可以观测到中心约为2.2 eV 的黄色发光(yellow luminescence, YL)带. 说明即使在较低的位错密度和杂质浓度下,GaN 中的缺陷依然会对其光学性质产生严重的影响.

图1 (a) GaN: Ge 晶体的线性吸收谱, 内插图为2PE 下的发光图片; (b)不同脉冲能量激发下GaN: Ge 的开孔Z 扫描曲线, 实线为理论拟合曲线Fig. 1. (a) Linear absorption spectrum of GaN: Ge crystal.The inset shows the two-photon excited photoluminescence photograph of sample; (b) open-aperture Z-scan data of GaN: Ge at several input pulse energies, the solid lines are theoretical fitting curves.

图2 (a) 2PE 下GaN: Ge 的 超快瞬 态 吸收光谱, 激发能流 为0.8 mJ/cm2; (b) 1PE 下GaN: Ge 的 超 快 瞬 态 吸 收 光谱, 激发能流为0.5 mJ/cm2. 内插图均为可见光探测下的结果Fig. 2. (a) Ultrafast TAS in GaN: Ge using 2PE under the excitation fluence of 0.8 mJ/cm2; (b) ultrafast TAS in GaN:Ge using 1PE under the excitation fluence of 0.5 mJ/cm2.The insets show the TAS probed at visible wavelengths.
图2 显 示 了2PE(650 nm)和1PE(325 nm)下GaN:Ge 的TAS 响应. 在不同的激发波长下,整个吸收光谱(1.1—2.6 eV)都随着探测波长的增加单调增强, 这是自由载流子吸收才具备的特点[30,31].此外, 没有任何吸收峰的存在, 也证明可以忽略带内缺陷引起的光吸收. 据此, 瞬态吸收可认为由导带和价带内的电子和空穴间接吸收引起, 瞬态吸收响应的衰减对应着导带电子和价带空穴的复合. 但是与2PE 下TAS 响应不同的是, 1PE 下的TAS响应几乎不随延迟时间衰减, 即使在特别低的激发能流下(0.1 mJ/cm2). 这是由于1PE 下非平衡载流子浓度(约1018cm–3)远大于样品中的缺陷浓度(约1016cm–3), 缺陷对载流子弛豫的影响很小. 而2PE 下的非平衡载流子浓度与缺陷浓度相近, 因此, 本文重点分析2PE 下的TAS 响应来研究缺陷对GaN: Ge 超快载流子动力学的影响及机制. 利用关系拟合2PE 下的吸收光谱(seh为载流子吸收截面), 可见光光谱下b= 2.5, 这满足极性光学声子辅助的载流子吸收[32]. 但是, 对于近红外光谱,b值从刚激发时(3 ps)的6.5 逐渐降低到2.5(500 ps). 根据文献[31]的报道: 在1050 nm附近由于GaN 的能带结构, 空穴引起的吸收将占主导; 而在较短的波长至可见光波段, 电子吸收的比重逐渐增大; 此外, 能带的非抛物性也会导致b> 2.5. 对瞬态吸收光谱机制的进一步探究将在3.3 节中进行.
3.2 超快载流子动力学
图3(a)显示了2PE 不同激发能流下从TAS响应中提取的GaN: Ge 在探测波长1050 nm 下的瞬态吸收衰减响应. 为了看到更快的超快过程, 图3(a)中的内插图展示了短时间尺度下的瞬态吸收响应(0.8 mJ/cm2). 在零延迟附近超快的尖峰响应(0—0.4 ps)来源于泵浦光和探测光重合时产生的相干散射, 而在之后观察到吸收信号约1 ps 的上升时间, 这可认为是非平衡载流子产生与弛豫到导带底部的过程(带内载流子弛豫过程). 在2—3 ps 后吸收响应逐渐衰减, 利用双指数衰减方程可以很好地拟合实验结果:

其中,Ai和ti分别代表指数前常数(振幅)和相应的衰减时间常数(寿命). 在不同激发能流下拟合得到的载流子寿命如图3(b)所示. 可以发现: 快速寿命几乎不随激发能流发生变化, 弛豫时间在30—60 ps 之间; 而慢速寿命当激发能流大于0.4 mJ/cm2时随着激发能流增大而显著增加.
通常, 半导体中的载流子可以通过平衡方程模拟[18]:


图3 (a)不同激发能流下GaN: Ge 的瞬态吸收 动力学,探测波长为1050 nm, 实线为双指数拟合曲线, 内插图为较短时间尺度下(7 ps)的数据; (b)不同激发能流下瞬态吸收衰减曲线拟合得到的快速和慢速弛豫寿命(分别为t1 和t2)Fig. 3. (a) The transient absorption kinetics in GaN: Ge under various excitation fluence probed at 1050 nm, the solid lines denote the theoretical curves using bi-exponential decay, and the inset illustrates the transient absorption kinetics in a 7 ps time window; (b) the fast and slow relaxation time (t1 and t2, respectively) extracted from transient absorption kinetics under various excitation fluence.
3.3 载流子弛豫复合机制
为了进一步解释载流子动力学机制, 根据3.2 节的分析, 基于图4 所示的能级系统, 利用速率方程对载流子动力学进行模拟. 在图4 中, Ge 杂质产生的浅施主能级在室温下全部电离提供热平衡下的自由电子. 把样品中的缺陷能级分为两类:1)辐射受主(-/0)能级CN, 其浓度为Ni, 该缺陷导致了缺陷发光(YL); 2)引起非辐射复合的线缺陷,估计TDs 引起的载流子寿命tnRad= 40 ns. 对于第一类情况: CN受主能级在价带上方约0.9 eV处[33,39], 在n 型GaN 中由于施主能级的存在(浓度为Nd), CN带一价负电(即CN—), 它可以以俘获系数Cpi俘获价带中产生的空穴, CN—变为CN0;随后, 被俘获的空穴可以与导带中的电子以系数Cni发生复合, 发出光子(YL), CN0再转变为CN—.此外, 我们也考虑了导带电子与价带空穴的直接复合, 通过复合速率BRad带间辐射复合产生BE.
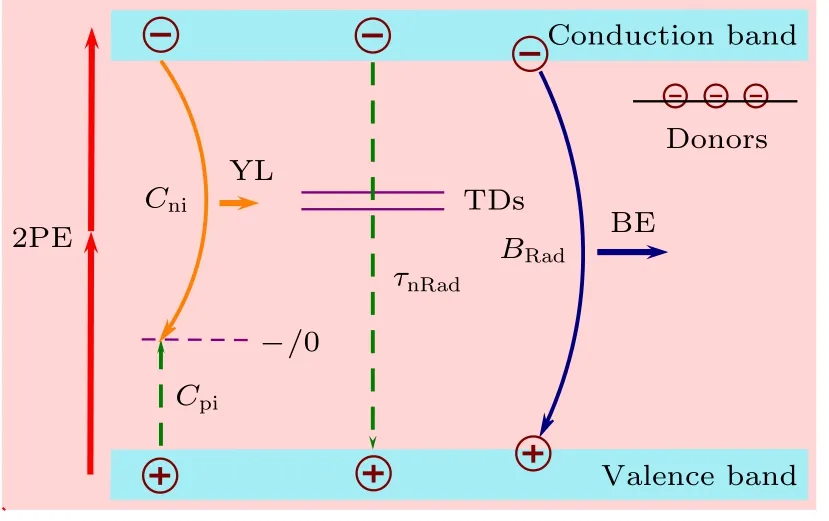
图4 用于模拟2PE 下GaN 载流子动力学的能带示意图.直虚线箭头表示无辐射跃迁, 向下曲线箭头表示通过辐射复合产生的发光Fig. 4. Energy band diagram used to model the carrier dynamics of GaN under 2PE. Straight broken arrows denote non-radiative transitions and curvy downwards arrows denote emissions via radiative recombination.
根据3.1 节的分析, 随着探测波长的增加, 空穴吸收对载流子吸收的贡献逐渐增大. 由于(–/0)能级距离价带较近, 因此, 空穴俘获的速度将远快于导带电子的复合速度(Cpi>Cni), 这导致了图2(a)中瞬态吸收谱线的b值随着延迟时间逐渐降低.当Dn
根据图4 的示意图, 可以建立如下的速率方程:

式中,G同(4)式中的定义,和分别为中性受主态和负电受主态浓度. 总的电子浓度n为热平衡 下 的 电 子 浓 度n0(Nd–Ni)与 光生 电 子 浓 度Dn之和. 电荷中性条件为Dp为光生空穴浓度. 通过数值求解这组速率方程,可以确定2PE 下布居在各态的载流子动力学过程.同时, 瞬态响应可以通过以下方程获得:

其中,se(h)表示电子(空穴)吸收截面, 同时定义吸收截面比值S=sh/se. 拟合的动力学结果如图5所示, (5)式和(6)式使用和确定的所有参数在表1中列出. 与实验结果完全一致, 快速过程几乎保持不变而慢速衰减过程随着能流增大而逐渐减慢. 同时也计算了更高能流激发和1PE 下(0.5 mJ/cm2)的超快载流子动力学. 可以发现, 随着激发能流的进一步增大, 快速衰减过程的占比将逐渐减小; 甚至当1PE 激发时, 样品表面处的Dn> 1018cm–3,此时电子的慢速复合过程会完全限制载流子的复合, 造成了无快过程的单指数衰减, 与图2(b)的结果完全一致.的空穴俘获系数Cpi数值与文献报道的6 × 10–7cm3·s–1几乎一致[34], 并且Cpi≫Cni和S> 1 也与之前的分析和预测完全相符.

图5 利用载流子复合模型拟合和模拟不同激发能流下GaN: Ge 的超快载流子弛豫动力学 (a)实验结果拟合;(b)更大的激发能流和1PE 情况Fig. 5. Fitting and simulation of ultrafast carrier relaxation dynamics in GaN: Ge using carrier recombination model:(a) The fitting of experimental results; (b) under higher excitation fluence and 1PE.

表1 用于模拟实验结果使用和确定的参数.Ni 和tnRad 的数值为预估值, BRad 数值来自参考文献[18], Cni, Cpi 和S 数值为拟合实验数据确定的参数Table 1. Parameters used/determined to model the experimental results. The values of Ni and tnRad were estimated. The value of BRad was extracted from Ref. [18]. The values of Cni, Cpi and S were determined by fitting the data.
载流子寿命是光子器件的关键, 而根据(5)式以及载流子动力学实验和模拟结果可知: 1)在高载流子注入下(>1018cm–3), n 型GaN 的载流子寿命主要由位错密度和辐射复合决定; 2)在适中的载流子注入下(1016—1017cm–3), 辐射缺陷、非辐射复合缺陷以及固有载流子浓度将会共同决定载流子的寿命. 图6 显示了在1PE 和2PE 下GaN:Ge 在通讯波段1310 nm 探测下的超快瞬态吸收响应. 和我们分析的一致, 1PE 下的载流子寿命(约10 ns)远远大于2PE 下的载流子寿命. 根据参考文献[41], 可估算出1PE 下GaN:Ge 的发光内量子效率约50%. 2PE 下内量子效率虽然严重下降,但更快的载流子寿命反而有利于其应用于超快全光开关器件.
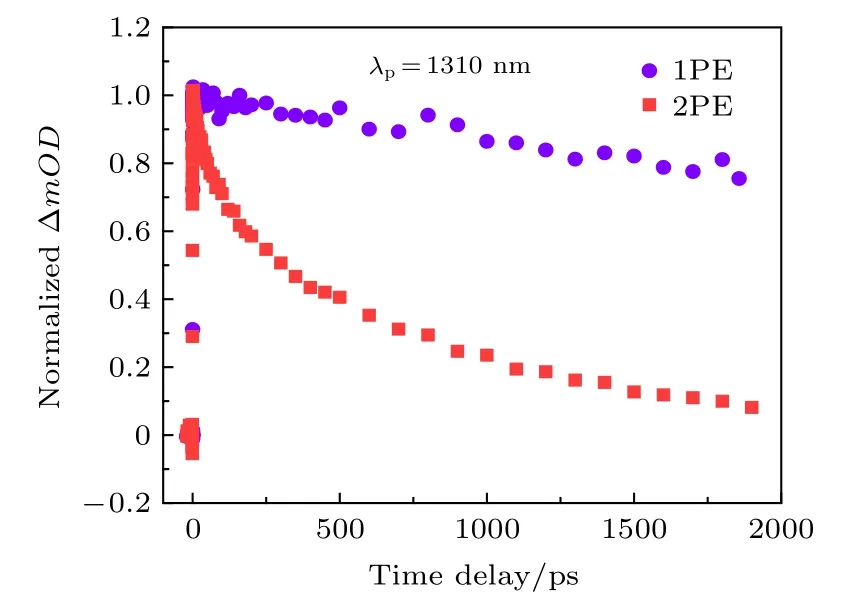
图61 PE(0.8 mJ/cm2)和2PE(1.6 mJ/cm2)下GaN:Ge在通讯波段1310 nm 下的超快瞬态吸收动力学Fig. 6. Ultrafast transient absorption kinetics in GaN:Ge probed at communication band 1310 nm under both 1PE(0.8 mJ/cm2) and 2PE (1.6 mJ/cm2).
4 结 论
以飞秒瞬态吸收光谱作为探测手段, 在近红外波段对n 型GaN: Ge 晶体进行了超快载流子动力学研究. 实验发现, 瞬态吸收响应随着探测波长而单调增强, 主要源于声子辅助的间接空穴吸收, 其占比随着探测波长增加而增高. 在双光子激发下,瞬态吸收表现为双指数动力学过程. 其快速寿命t1(30—60 ps)来源于深能级CN—对空穴的俘获.而慢速寿命t2则主要对应导带电子与俘获空穴的复合过程, 对应于缺陷黄带发光. 由于缺陷能级的饱和,t2随着激发能流的增大逐渐增加. 通过建立包括辐射缺陷、非辐射缺陷态在内的载流子弛豫模型很好地模拟了载流子动力学, 并得到了空穴俘获系数等一系列光物理参数. 研究结果为n 型GaN 中的载流子复合提供了很重要的信息, 为GaN 在发光器件、光导器件和全光开关器件的应用提供了重要的实验和理论参考.
