极端温度下功率SiGe HBTs辐照特性研究
2023-12-23胡开龙魏印龙秦国轩
胡开龙 魏印龙 秦国轩
(天津大学微电子学院,天津市成像与感知微电子技术重点实验室,天津 300072)
0 引言
硅锗异质结双极晶体管(SiGe HBTs)具有体积小,兼容性好,更高的特征频率和最大振荡频率等特性,因而通常被集成在射频器件中,如:通信系统。此外,它有较宽工作温度范围及辐照耐受性等优势,因而在抗辐照领域具有广阔大的应用前景[1-7]。
研究表明,辐照对器件造成的损伤机制主要包括位移损伤和电离损伤,同时揭示了辐照对SiGe HBTs 的EB 结附近以及浅沟道隔离层(STI,shallow trench isolation)影响最大[5,8-13]。除了在射频通信等领域,功率SiGe HBTs 更多应用于功率放大器中[14-18]。因其具有较大发射极面积,所受辐照损伤也更加严重[19-20],因而系统性地对不同发射极面积的功率SiGe HBTs 进行研究。此外,SiGe HBTs 能在较宽的环境温度下正常工作,对其在不同温度环境中的辐照特性研究也是极为必要[5,21-22]。迄今为止,对SiGe HBTs 在不同温度下质子辐照特性和不同发射极面积的SiGe HBTs 质子辐照特性已有初步的研究[23-26]。本文系统性地对不同发射极面积的功率SiGe HBTs 器件在极端温度和室温下进行辐照实验及表征,同时建模研究质子辐照对器件内部物理机制具体的影响。
本工作中对极端温度下功率SiGe HBTs 的辐照特性进行了相关研究:(1)在3 种不同温度环境下进行不同发射极面积的功率SiGe HBTs 质子辐照实验,同时表征出器件在辐照损伤下的直/交流特性;(2)采用Sentaurus TCAD 软件上按照实际SiGe HBTs 器件的参数建立工艺模型和器件结构模型,基于建立的模型在不同温度和辐照通量下仿真得到的直流特性和交流特性与实际器件相符;(3)基于模型表征了不同条件下辐照前后电子密度变化量(Δ edensity)、载流子复合率变化量(Δ SRH recombination)以及载流子迁移率变化量(Δ emobility)具体分析功率SiGe HBTs 内部物理机制,为空间实验研究提供了可靠的理论指导。
1 实验方法与建模
本工作质子辐照实验中,使用Tower Jazz 公司采用0.35 μm SiGe BiCMOS 工艺技术制造到的功率SiGe HBTs 器件[27],图 1 显示了功率SiGe HBTs 的光学显微镜图像。
采用Sentaurus TCAD 软件对功率SiGe HBTs 器件进行建模如图2 所示。建立的模型结构和工艺参数与辐照实验的功率SiGe HBTs 保持一致。在建好的模型中引入缺陷和调整载流子输运模型仿真位移损伤,用等效剂量γ射线仿真电离损伤。实验和仿真中器件的具体参数见表1。基于建立的模型,仿真功率SiGe HBTs 的直/交流辐照损伤特性。表征出不同条件下辐照前后Δ edensity、Δ SRH recombination 以及Δ emobility,对辐照影响功率SiGe HBTs 的内部物理机制进行分析。

表1 实验和模型器件参数Tab.1 Experimental and model device parameters
2 结果与讨论
2.1 SiGe HBTs实验测试和模型仿真性能表征
基于器件模型进行仿真,将仿真的转移特性与实验测试结果进行了比较(图3)。在不同温度下,辐照前后的SiGe HBTs 的仿真结果和实验测试结果拟合较好。图3(a)可见基极电流(IB)对质子辐照较为敏感,而质子辐照对集电极电流(IC)影响不明显。此外,比较图3(a)(b)可得出,不同温度对辐照后的SiGe HBTs的特性有不同的影响。
2.1.1 直流性能表征
2.1.1.1 发射极面积对功率SiGe HBTs 辐照特性的影响
图4 显示了不同辐照通量下ΔIB和Δ1/β随发射极面积的变化,ΔIB=IB-post-IB-pre(IB-post:辐照后IB,IB-pre:辐照前IB),1/β=IB/IC。可以看出在同一发射极面积(AE)下,ΔIB和Δ1/β随着辐照通量的增大而增大,主要原因是质子辐照使得SiGe HBTs 在EB 结附近形成产生/重组(G/R)陷阱中心,从而产生基极漏电流,而基极漏电流与辐照通量成正比。同时,随着发射极面积的增大,质子辐照引起更多的IB和β退化(即更高的漏电流),对SiGe HBTs的损伤越大。
2.1.1.2 极端温度对功率SiGe HBTs 辐照特性的影响
为了研究极端温度对功率SiGe HBTs 辐照特性的影响,分别固定VBE(在低温时,开启电压较高VBE=0.7 V;在室温和高温时,VBE=0.5 V)和固定IC条件,将IB进行归一化处理进行分析,如图5所示。两种条件的结果均表明,与室温相比在77 或393K 时,SiGe HBTs 的IB退化更少。结果表明,极端温度能抑制质子辐照损伤。
2.1.2 交流性能表征
通过Gmax来表征功率SiGe HBT 的交流性能。实验测量了不同温度下发射极面积为438 μm2SiGe HBTs 辐照前后的Gmax。由图6(a)(c)看出,辐照后Gmax降低,同时与横坐标频率的交点(即最大振荡频率fmax)减小,表明器件在辐照后交流特性退化。此外,图6(d)显示ΔGmax随温度的变化,结果显示功率SiGe HBTs 在极端温度下的|ΔGmax|较小,进一步证明极端温度能抑制辐照损伤。
2.2 辐照下SiGe HBTs内部物理机制分析
2.2.1 发射极面积对辐照下SiGe HBTs 内部物理机制影响
为更直观的分析SiGe HBTs 在质子辐照后器件内部物理机制的变化,表征不同发射极面积在辐照前后器件的 Δedensity,如图7 所示。质子辐照主要对SiGe HBTs 在EB 结附近造成损伤,辐照前后大面积的功率SiGe HBTs 内部Δedensity 更大。验证了辐照主要对SiGe HBTs 的电子密度产生影响,同时表明功率SiGe HBTs的发射极面积与辐照损伤成正比。
2.2.2 温度对辐照下SiGe HBTs 内部物理机制影响
基于建立的模型,分别在固定VBE和IC,提取在不同温度下器件在辐照前后EB 结附近的电子密度,如图8 所示。一方面,各温度条件下电子密度变化Δ edensity 为正,表明质子辐照使得SiGe HBTs 的电子密度增加,从而导致使得IB增加。另一方面,对比不同温度下的Δedensity,室温下的明显比在极端温度下的大,表明室温下SiGe HBTs 受质子辐照损伤更大。在固定VBE和IC条件下均表现出一致的结论,揭示出质子辐照影响器件内部电子密度以及极端温度对辐照损伤具有抑制作用。
此外,表征了不同温度下辐照前后模型中的载流子复合率变化量ΔSRH。一般来说,发射极-基极的消耗区与基极的SRH 载流子复合率可用公式1 近似表示,式中R(y)为EB 结附近的SRH 载流子复合率,n(y)和p(y)分别为电子和空穴浓度。
辐照后在EB 结附近产生更多的G/R 陷阱中心,使得在EB 结附近的载流子浓度增加。同时质子辐照对器件造成的位移损伤和电离损伤使得载流子寿命(τ)减小[28]。从而导致在质子辐照后EB 结附近SRH 载流子复合率增加。图9 显示SiGe HBTs 在辐照前后SRH 载流子复合率变化量为正,验证了辐照使得SRH 载流子复合率增加。此外,极端温度下SRH 载流子变化量相对于在室温较小。解释了极端温度对质子辐照有抑制效果。
对于极端温度抑制辐照对SiGe HBTs 的损伤原因:一方面在77 K 下,晶格具有较小的热能,G/R 陷阱中心被冻结,因此在辐照后产生较少的陷阱[29],从而辐照诱导产生的基极泄露电流更小。另一方面在393K下,较高的热能会产生更多的陷阱态,因此即使没有质子辐照也会产生更高的本征基极漏电流。结果表明,在极端温度下,质子辐照对SiGe HBTs 的损伤较小。
为了研究交流条件下,温度对质子辐照下的功率SiGe HBTs 的内部物理机制的影响,基于该模型同样表征出不同温度下器件内部的电子迁移率变化量(Δ eMobolity)。温度升高导致电子密度升高,电子迁移率降低,因此,Gmax变小。由图10得出结论:辐照前后SiGe HBTs 内部电子迁移率变化量(Δ eMobolity)为负,表明辐照使得功率器件电子迁移率降低,器件交流特性退化。此外,与室温相比,|Δ eMobolity| 在极端温度下更小,揭示Gmax的退化更少。
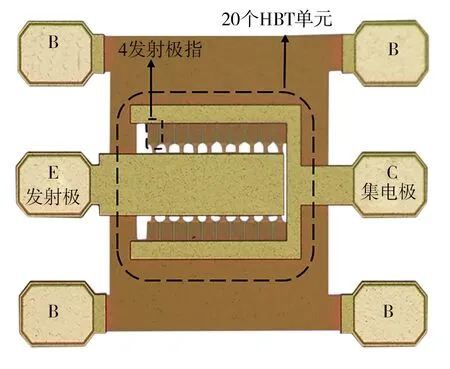
图1 功率SiGe HBTs的光学显微镜图像Fig.1 Optical microscopic image of the SiGe HBTs with multi-fingers
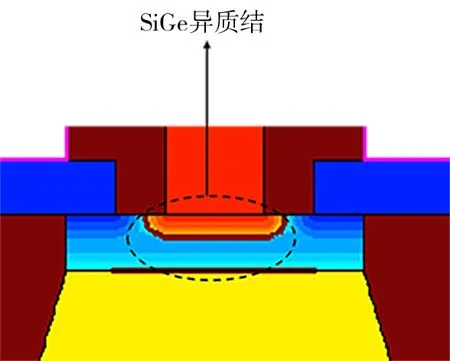
图2 TCAD模型结构Fig.2 Model structure of TCAD

图3 不同温度下辐照前后SiGe HBTs的转移特性Fig.3 Gummel characteristics of pre-and post-radiated SiGe HBTs at different temperatures
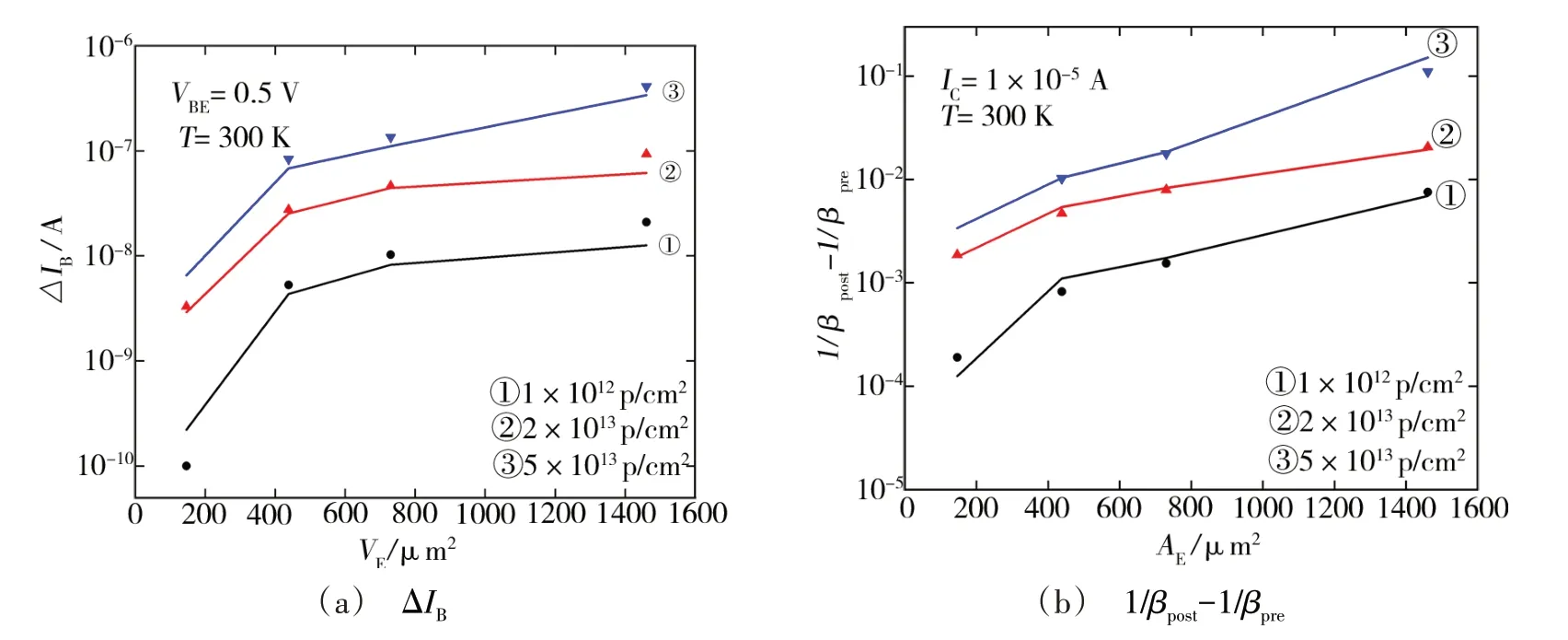
图4 不同辐照通量下Δ IB和1/βpost-1/βpre随发射极面积的变化Fig.4 ΔIB and 1/βpost-1/βpre vs.emitter area(AE)with different radiation fluences

图5 固定VBE和IC,不同辐照通量下ΔIB/IB-pre随温度的变化Fig.5 ΔIB/IB-pre vs.temperature with different radiation fluences with fixed VBE(a)and I(Cb)
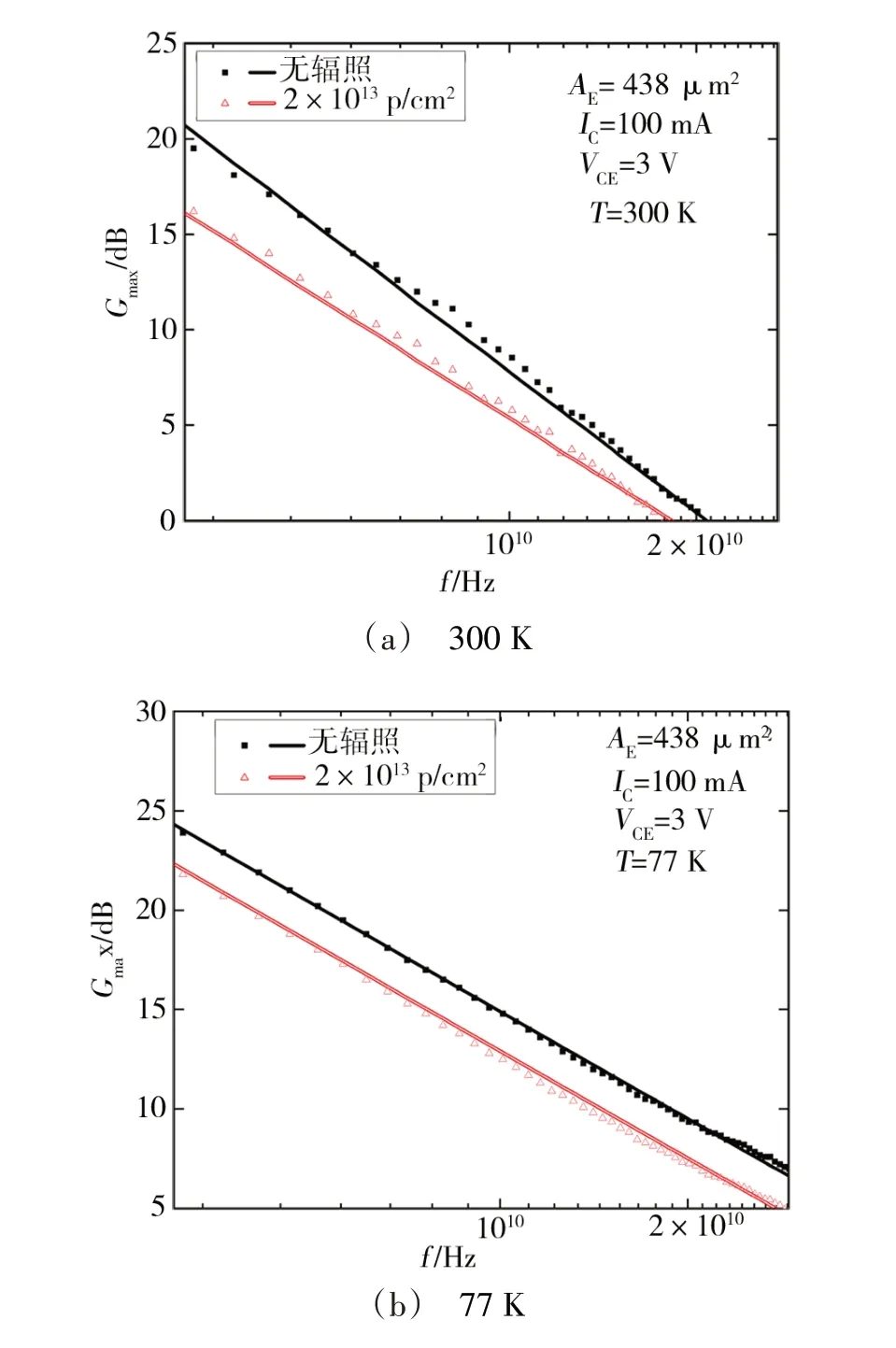
图6 不同温度辐照前后Gmax随频率的变化和不同辐照通量下ΔGmax随温度的变化Fig.6 Gmax vs.frequency of the pre-and post-radiated SiGe HBTs at different temperatures,ΔGmax vs.temperature at different radiation fluence

图7 不同发射极面积下SiGe HBTs EB结附近电子密度变化量Fig.7 Δedensity near the EB junction of the SiGe HBTs with different emitter areas
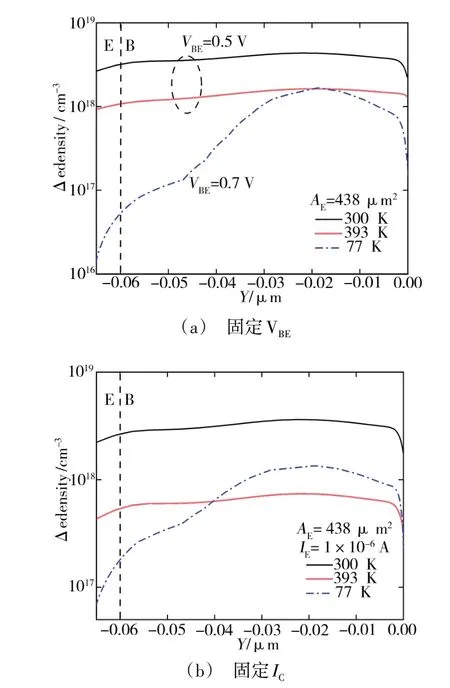
图8 固定VBE和IC,不同温度下SiGe HBTs EB结附近辐照前后电子密度变化量Fig.8 Δ edensity near EB junction of the pre-and postradiated SiGe HBTs at different temperature with fixed VBE and IC
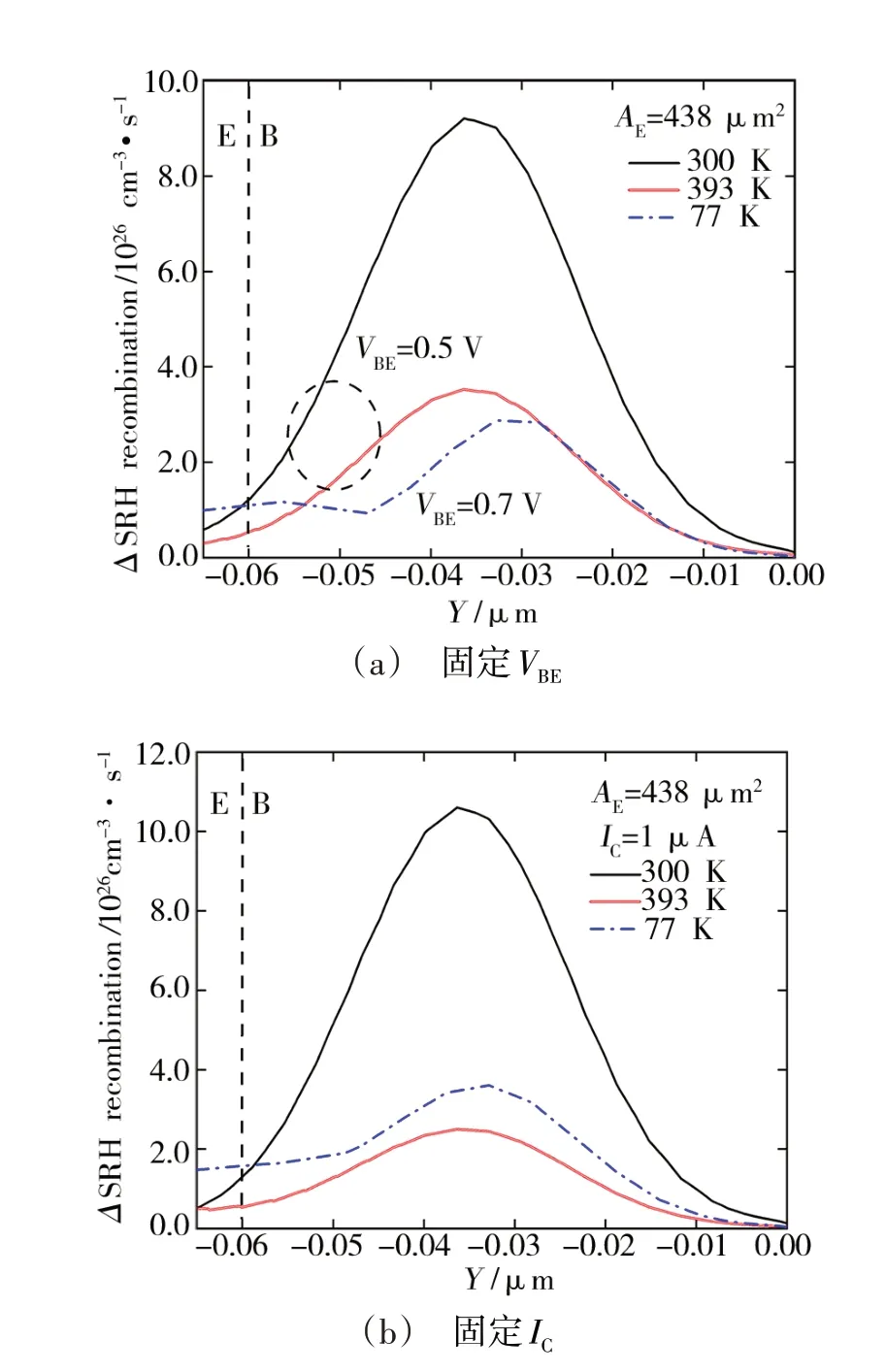
图9 固定VBE和IC,不同温度下SiGe HBTs EB结附近辐照前后SRH 载流子复合率变化量Fig.9 Δ SRH recombination near the EB junction of the pre-and post-radiated SiGe HBTs at different temperature with fixed VBE and IC

图10 不同温度下辐照前后SiGe HBTs载流子迁移率变化量Fig.10 Δ eMobolity of the pre-and post-radiated SiGe HBTs at different temperatures
综上所述,载流子迁移率是影响质子辐照SiGe HBTs 交流性能的主要因素;与室温相比,极端温度可以相对抑制功率SiGe HBTs质子辐照损伤。
3 结论
研究了质子辐照下不同发射极面积的功率硅锗异质结双极晶体管(SiGe HBTs)在极端温度和室温下的直/交流特性,同时揭示了辐照影响功率SiGe HBTs的内部物理机制。研究结果表明:
(1)发射极面积越大,产生更高的泄露电流,质子辐照引起更多的IB和β 退化,性能退化越严重,说明SiGe HBTs功率器件比高速SiGe HBTs器件更容易受到辐照的影响;
(2)功率SiGe HBTs 在极端温度下对质子辐照的耐受性优于室温;
(3)通过模型提取影响功率SiGe HBTs 辐照特性的主要因素为载流子密度、Shockley-read-Hall(SRH)载流子复合率和载流子迁移率,研究了在辐照下器件的内部物理机制。
综上,SiGe HBTs 具有良好的抗辐照特性,在极端环境下有很大的应用潜力。
