铜互连CMP工艺中缓蚀剂应用的研究进展*
2022-12-28牛新环张银婵朱烨博侯子阳屈明慧
闫 晗 牛新环 张银婵 朱烨博 侯子阳 屈明慧 罗 付
(1.河北工业大学电子信息工程学院 天津 300130;2.天津市电子材料与器件重点实验室 天津 300130)
由于铜具有高导电性、低电阻率和良好的抗电迁移性而被普遍用作理想的金属互连材料[1-2]。铜互连中每一层的表面形貌和结构都会对器件的性能和寿命造成影响[3-4]。为了获得优异的表面,每一层都需要进行平坦化处理[5],化学机械抛光(CMP)是唯一可实现全局平坦化的工艺技术[6-7]。在CMP过程中,抛光液起着至关重要的作用,其各个组分发挥的作用不同,各化学添加剂的选择以及含量的变化都会极大地影响抛光效果。而抛光液中的缓蚀剂可以通过螯合成键、沉积保护、物理或化学等吸附方式,降低铜表面凹处的化学腐蚀与溶解,在凹凸区域形成去除速率差,进而实现铜互连的纳米级平坦化[8]。
为了满足集成电路技术节点不断降低对抛后表面质量越来越高的要求,国内外科研人员对缓蚀剂的选择及其机制进行了大量的研究。本文作者首先介绍了铜互连CMP中缓蚀剂的作用机制,并阐述和归纳了各类缓蚀剂在铜互连CMP中的应用研究现状;同时,总结了近几年关于缓蚀剂和其他添加剂的复配协同作用对改善铜互连CMP质量的研究进展;最后对铜互连CMP工艺中缓蚀剂的研究方向进行了展望。
1 缓蚀剂在铜互连CMP中的作用机制
在铜互连CMP抛光液中,缓蚀剂通过物理或化学吸附作用吸附在待抛铜晶圆表面或与抛光液中电离出的铜离子 (Cu2+) 反应生成一层致密的钝化膜沉积在铜表面,阻碍抛光液与铜的进一步反应。如图1所示,在动态CMP过程中,在一定抛光压力和磨料的机械作用下,铜凸起区域承受更大的动能和摩擦能,使得铜凸处的钝化膜易于被去除,露出的铜继续与抛光液反应,所以铜凸处下降较快。而在凹处区域,由于缓蚀剂钝化膜起到有效的保护作用,同时受到的压力和磨料作用远远小于凸起区域,因此凹处区域铜不易被直接溶解或机械研磨掉,去除缓慢,形成明显的凹凸去除速率差。随着CMP进行,最终实现全局和局部平坦化并获得优异的抛后表面[9]。

图1 缓蚀剂作用机制
2 各类缓蚀剂在铜互连CMP中的应用研究
近年来,应用于铜互连CMP的缓蚀剂种类层出不穷。一般认为分子结构中含有N、O、S、P或共轭环的缓蚀剂是有效的缓蚀剂。唑类、异噻唑啉酮类和表面活性剂类等各类缓蚀剂的应用与研究为进一步优化抛后表面质量提供了理论依据。
2.1 唑类缓蚀剂
唑类缓蚀剂在铜互连CMP工艺中的应用最为广泛,主要包括:苯并三氮唑 (BTA)、1,2,4-三氮唑 (TAZ)、2,2′-[[(甲基-1H-苯并三唑-1-基)甲基]亚氨基]双乙醇 (TT-LYK)[10]、5-羧基苯并三唑 (CBT)、5-氨基四唑 (ATA)、吡唑、嘌呤及其衍生物等。各缓蚀剂的结构与性能各异,在应用中的抑制效果与作用机制也不同。
BTA作为最具代表性的唑类缓蚀剂能够有效抑制铜凹处的腐蚀速率,达到表面平坦化的效果,被广泛应用于铜互连CMP[11]。XU等[12]发现通过合理选择BTA的浓度可以有效降低片内非均匀性和表面粗糙度,同时保持较高的铜去除速率。在此基础上,研究人员对BTA的钝化机制进行了大量的研究。徐瑞峰等[13]通过分析得出BTA在铜表面形成了一层化学吸附的钝化膜从而抑制铜的腐蚀,并且钝化膜的结构随环境而变化。而LI等[14]通过吸附等温线和表面分析研究了BTA在CMP过程中的抑制机制,研究发现当pH=4时符合焦姆金吸附等温线,pH=10时符合弗兰德里希吸附等温线,并提出了混合吸附模式(物理吸附和化学吸附)。之后WANG等[15]将不同质量比的BTA和甲基苯并三氮唑 (TTA) 复配使用,发现在BTA/TTA质量比为2∶3或3∶2的情况下,铜表面质量达到最佳,如图2所示,且铜的去除速率达到较大值(>800 nm/min)。然而,BTA与铜形成的钝化膜不易解吸,残留的钝化膜使铜表面具有高度疏水性,并且对于抛光后清洗也是极大的挑战。
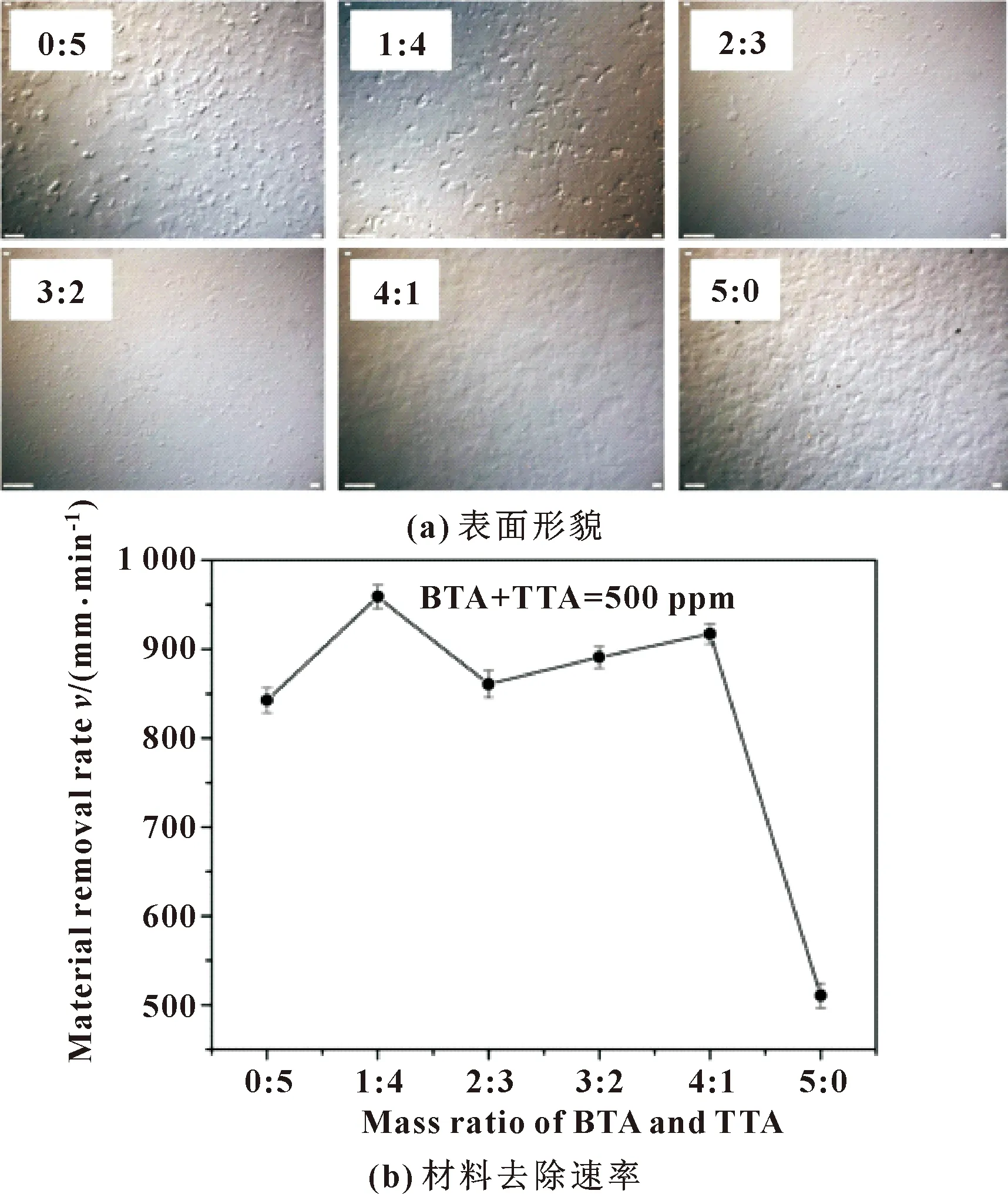
图2 不同BTA/TTA比例下抛光结果[15]
TAZ是一种低毒、高溶解性的芳香杂环唑类缓蚀剂,近年来大量研究证明TAZ是另一种有效的铜缓蚀剂。因此,TAZ作为一种替代BTA的缓蚀剂逐渐应用于铜CMP中。JIANG等[16]通过对TAZ和BTA的抑制效果进行比较,得出45 mmol/L的TAZ可以与2 mmol/L 的BTA有相同的表面保护效果。同时,WANG 等[17]通过接触角、电化学阻抗谱(EIS)和X射线光电子能谱(XPS)对TAZ处理后的铜晶片进行分析,建议在使用H2O2作为氧化剂时,使用TAZ作为缓蚀剂,以获得对铜凹处区域更好的抑制效果。
TT-LYK是一种新型金属缓蚀剂,属于一种BTA的衍生物,且TT-LYK溶于水,这是工业生产中非常重要的性质。HU等[18]研究发现铜的去除速率和静态腐蚀速率随着TT-LYK浓度的增加而降低,分析其抑制效率高的原因是铜(I)-TT-LYK钝化膜在铜表面的吸附,阻断了铜与其他添加剂的接触,从而抑制了铜的腐蚀。基于此,他们通过TT-LYK和油酸钾 (PO) 的协同抑制作用,建立了铜在TT-LYK和PO二元体系中的抑制模型,如图3所示[19],可见2种缓蚀剂的协同使用可以有效降低铜的去除速率并显著改善铜表面质量。MA等[20]通过电化学和CMP实验证实了TT-LYK和铜表面有更多的吸附位点,并且含有TT-LYK的抛光液具有良好的稳定性,经其处理后的铜表面状态更优异。ZHOU等[21]通过TT-LYK和TAZ的复配使用,使铜表面的抑制效果和表面质量均得到了有效改善。
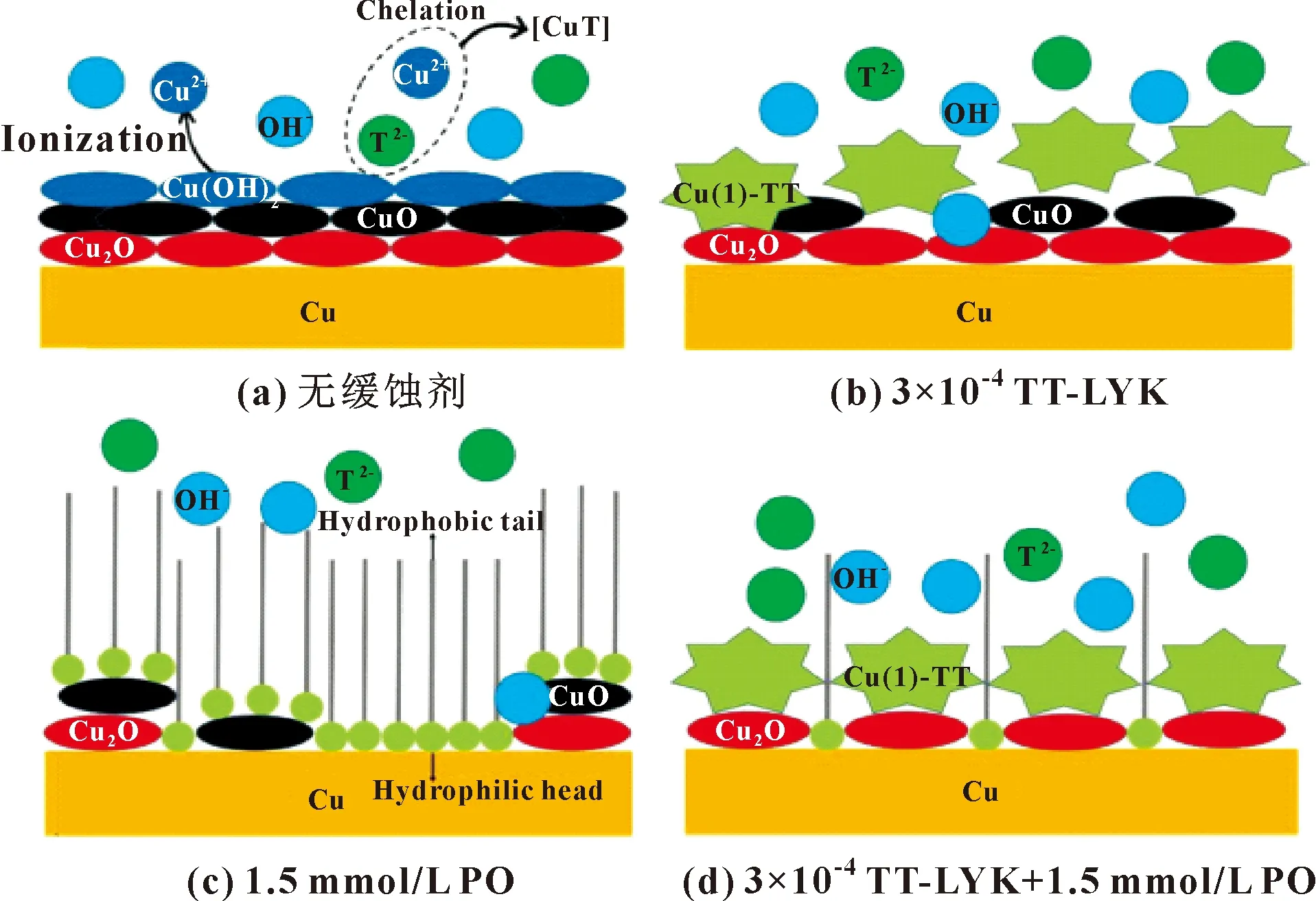
图3 TT-LYK和PO抑制模型[19]
CBT是另一种BTA的衍生物,具有多中心吸附特性,有利于其在铜表面的快速吸附。TIAN等[22]通过电化学和XPS测试,表明CBT能有效降低铜钴腐蚀电位差,并且当缓蚀剂质量分数为2.5×10-6时,铜钴之间的腐蚀电位差最小。
ATA是一种结构类似于BTA的唑类缓蚀剂,它比BTA更容易与Cu2+反应。刘宇宏等[23]通过ATA和BTA比较,得出在氨基乙酸-过氧化氢 (H2O2) 基抛光液中,当pH值在3~5范围内时,ATA的抑制效果更好。为了研究其抑制机制,LEE等[24]研究了BTA和ATA的性质,通过紫外可见光谱和红外光谱分析发现,ATA通过与铜表面的Cu2+形成比BTA更稳定的离子键来抑制铜腐蚀,如图4所示。同时,从静态腐蚀速率和图形片抛光的结果中可以得出,ATA抑制铜腐蚀效果更好。

图4 ATA与Cu2+反应生成钝化层[24]
吡唑是一种氮杂环芳香化合物,有腐蚀抑制性能,并且水溶性较高 (>4 mol/L)。GOSWAMI等[25]使用微图形腐蚀测试、电化学和XPS分析证明了吡唑在CMP后清洗溶液中是有效的铜缓蚀剂。


图6 不同抛光液抛光后铜晶片的AFM图像和浸入不同抛光液5 min后铜晶片的SEM图像[27]
尿酸是一种类似于BTA的杂环氮化合物,是碱性抛光液中合适的铜缓蚀剂。PRASAD和RAMANATHAN[28]发现,在抛光液中添加0.01 mol/L尿酸,铜的去除速率和静态腐蚀速率下降,并且抑制效应在0.05 mol/L的浓度下达到饱和。同时通过循环伏安测试表明,尿酸对铜表面提供的抑制能力是稳定的。
2.2 异噻唑啉酮类缓蚀剂
异噻唑啉酮类缓蚀剂如苯并异噻唑啉酮 (BIT),近年来受到广泛关注,有望作为新型的缓蚀剂用于铜互连CMP中。MA等[29]比较了BIT与BTA作为缓蚀剂时铜的动态电位极化曲线并计算了腐蚀抑制效率,结果表明BIT和BTA都是有效的铜缓蚀剂。同时,通过图形片的缺陷图和扫描电子显微镜(SEM) 测试表明,在阻挡层CMP工艺中,经BIT处理后的图形片表面缺陷更少。齐嘉城等[30]发现在含有H2O2和FA/OⅡ螯合剂的抛光液中加入BIT,能有效降低铜的去除速率,同时对腐蚀坑和碟形坑深度有抑制效果。
2.3 表面活性剂作缓蚀剂
表面活性剂是铜互连CMP过程中必不可少的添加剂,具有洗涤性、增溶性、发泡性、消泡性、润湿性、分散性和乳化性等作用。仅少量表面活性剂就能使抛光液体系的界面状态发生明显的变化,抛光液与金属表面的表面张力和接触角都大幅降低;同时表面活性剂也可以吸附在磨料表面,提高磨料分散度;另外表面活性剂对抛光后的反应产物或残留物还起到清洗作用。近年来科研人员还发现,表面活性剂不仅可以抑制铜的腐蚀,还可以提高铜表面的质量,减少缺陷,因此对其做了大量的研究。
HONG等[31]证明了在酸性含甘氨酸的H2O2基抛光液中,阴离子表面活性剂十二烷基硫酸钠(ADS)和十二烷基硫酸铵 (SDS) 可用作为铜CMP的有效缓蚀剂。王彦等人[32]研究了弱碱性条件下ADS的作用,结果表明ADS可以有效降低片内非无效性和表面粗糙度,并且能有效控制CMP过程中碟形坑的延伸。
聚乙烯吡咯烷酮(PVP)的分子结构如图7所示。YANG等[33]通过研究发现PVP具有与BTA相当的抑制能力,并通过开路电压测试证明了PVP能在高效抑制腐蚀的同时保留较快的铜去除速率。同时他们建立了如图8所示的不同膜结构等效电路,并得到了铜片在含有PVP的抛光液中不同浸泡时间下的奈奎斯特图、波特图和相位图,结果表明,未浸入含有PVP的抛光液时,其EIS数据可以很好地拟合为单层膜模式,而浸入含有PVP的抛光液中超过30 min后只能拟合双层膜模式。

图7 PVP分子结构[33]

图8 BTA抛光液(a)和PVP抛光液(b)等效电路,在BTA抛光液(c)和PVP抛光液(d)中浸泡不同时间下的奈奎斯特图,在BTA抛光液(e)和PVP抛光液(f)中浸泡不同时间下的波特图和相位图[33]
2.4 其他缓蚀剂
除以上类型的缓蚀剂外,山梨酸钾和肼也可用于铜互连CMP中的缓蚀剂。
山梨酸钾是山梨酸的钾盐,图9所示为其分子结构。NAGAR等[34]通过实验得出山梨酸盐在铜表面可形成氧化物和山梨酸盐钝化膜,从而增强了钝化效果,扩大了钝化区域。在之后的研究中发现,随着山梨酸盐浓度的增加,在铜表面实现了较低的粗糙度,并观察到铜腐蚀有所减少,证明了山梨酸盐的添加能够改善铜的凹陷区域深度与CMP性能,如图10所示,凹陷深度随山梨酸钾质量浓度的增加而下降[35]。

图9 山梨酸钾分子结构

图10 凹陷值与山梨酸钾质量浓度的关系[35]
肼被认为是硝酸中抑制铜腐蚀的有效缓蚀剂。 SEKHAR和RAMANATHAN[36]研究了在含二氧化硅磨料和不同浓度硝酸的抛光液中加入肼的缓蚀效果,发现铜的去除速率和静态腐蚀速率随着0.01 mol/L肼的添加而降低,但进一步添加肼后,铜的去除速率和静态腐蚀速率不会显著降低,表明肼能抑制铜在硝酸中的腐蚀,当肼的浓度为0.01 mol/L时效果最好。
3 铜抛光液中缓蚀剂与其他添加剂间的复配协同
在铜互连CMP过程中,采用缓蚀剂的复配协同,既可以减少缓蚀剂的用量,又可以扩大缓蚀剂的选取范围,且可获得比单一缓蚀剂更优异的效果[37]。
3.1 缓蚀剂和表面活性剂
在2.3节中,介绍了阴离子表面活性剂ADS可以作为铜互连CMP中的一种溶解性和绿色环保型缓蚀剂。然而,单独使用ADS时,铜表面形成的钝化膜致密性和覆盖性不完全,会存在一些开放的吸附位点。基于“空间填充”理论,研究人员使用BTA和TAZ等缓蚀剂与ADS协同使用,BTA或TAZ分子可以通过这些开放区域吸附到未被占据的铜/铜氧化物位点上[38]。因此BTA/TAZ和ADS的协同使用对于铜的抑制效果要优于单独添加ADS。
HONG等[38]在抛光液中掺入ADS使BTA的使用量大幅减少,并且复配的缓蚀剂在抑制铜腐蚀和增强平坦化效果方面表现出了优异的性能。YANG等[39]将ADS和TAZ混合探究了其作用机制。如图11所示,ADS通过物理吸附,形成一层多孔薄膜附着在铜表面;同时,化学吸附的TAZ分子可有效地在孔处进行填充,形成了致密的钝化膜来保护铜表面。

图11 ADS和TAZ在铜表面的吸附示意[39]
3.2 缓蚀剂和络合剂
在铜互连CMP过程中,抛光过程中随Cu2+含量增加,会逐渐削弱抛光液的化学作用。络合剂可以与反应产生的Cu2+结合,从而防止Cu2+的再沉积,加速铜的去除,使抛光速率保持在一个较高的水平[40]。在络合剂的作用下,铜凸处去除速率变快,而凹处在缓蚀剂的保护下去除速率很小,因此在两者的协同下可有效提高铜平坦化效率。
基于此,YAN等[41]研究了铜CMP过程中BTA和络合剂甘氨酸的协同竞争关系,提出了平坦化机制,如图12所示。CMP过程中,在凸起区域甘氨酸可与Cu2+络合形成易溶的反应产物并被迅速带走。在凹陷区域,铜-BTA钝化膜抑制铜的腐蚀,有利于最终实现平坦化。江亮和雒建斌[42]在铜抛光阶段,使用TAZ和低浓度Trilon®P的复配协同,实现了对铜的有效抑制,并获得了良好的表面质量。

图12 甘氨酸-BTA体系中的作用机制[41]
3.3 缓蚀剂和氧化剂
氧化剂的作用是与铜反应,在铜表面产生铜氧化物(如氧化铜、氧化亚铜和氢氧化铜),这些氧化物不溶于水,覆盖在铜表面形成钝化膜[43]。然而,仅靠氧化剂的钝化作用所形成的钝化膜是不连续且多孔的。因此,有必要引入额外的缓蚀剂以减缓铜凹处的腐蚀并提高表面质量[44]。
杨程辉等[45]研究了TAZ和氧化剂H2O2的配比对铜膜CMP台阶高度修正能力的影响。结果表明:H2O2过量时,不利于提高铜膜表面台阶高度修正能力,适当增大TAZ的用量能有效修正台阶高度。含有质量分数0.3% H2O2和0.003% TAZ的抛光液台阶高度修正能力最佳,高达118.6 nm,如图13所示。
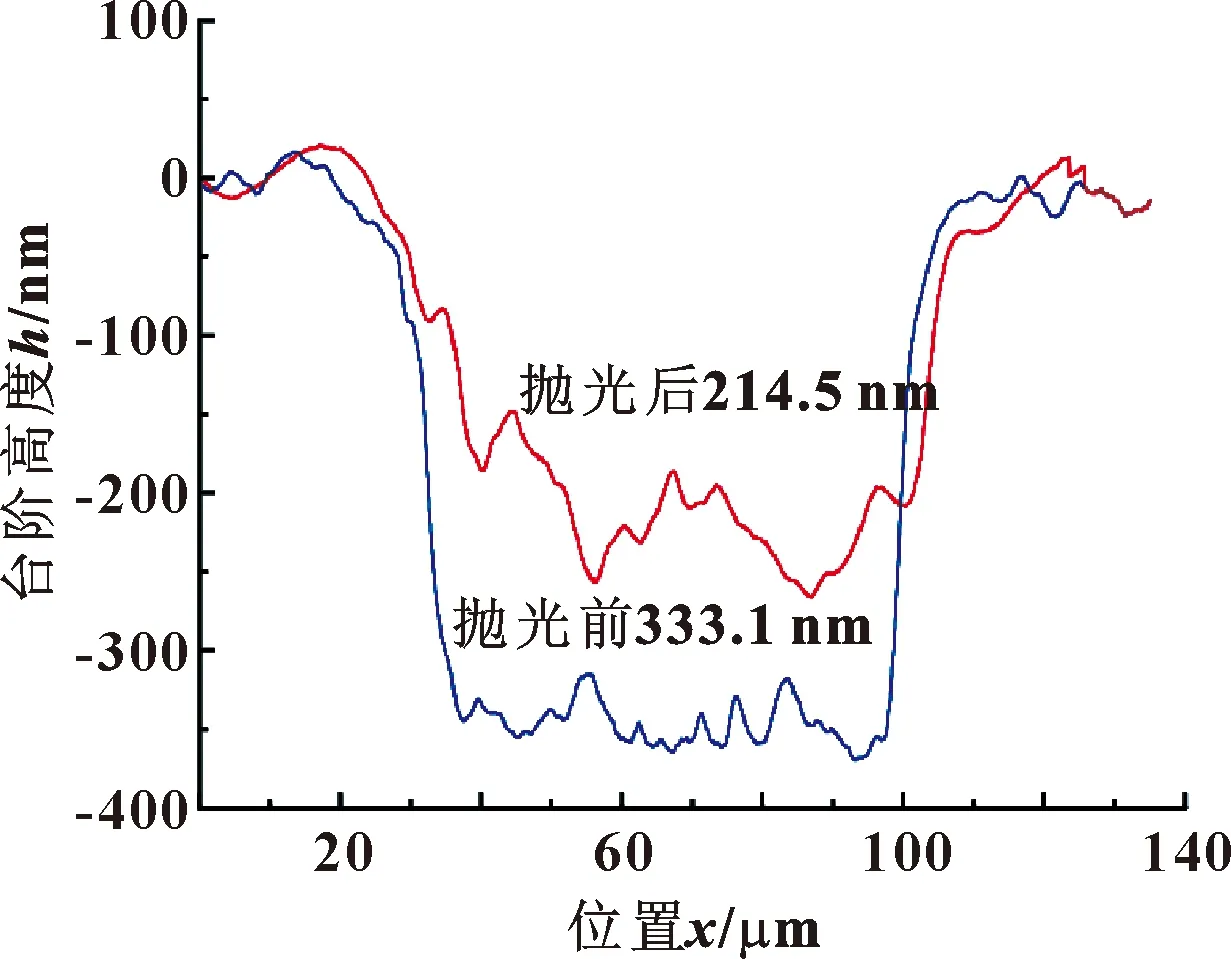
图13 采用质量分数0.3% H2O2和0.003% TAZ 的抛光液抛光前后的台阶高度[45]
4 总结与展望
(1)目前主流的缓蚀剂仍然是唑类及其衍生物,但有些缓蚀剂具有腐蚀性和毒性,不仅会对设备造成一定的破坏,使用后废液的处理和后清洗的难易程度也是需要考虑的问题。因此,寻找绿色环保的铜互连CMP缓蚀剂迫在眉睫。
(2)部分缓蚀剂单一使用时抑制效率低,难以获得高质量的抛后表面。因此,可以通过缓蚀剂的复配协同作用,进一步提高凹凸去除速率差,以获得优异的平坦化性能,这也有望成为未来铜互连CMP缓蚀剂研究的热点。
(3)虽然目前提出了许多抑制效率优异的缓蚀剂,但作用机制尚不明确。随着量子力学或分子动力学模拟等方法日趋成熟,可以从微观角度揭示其机制,以进一步优化CMP后平坦化效果。
