声表面波器件光刻的衍射效应研究
2022-05-13孟腾飞陈晓阳段英丽于海洋周培根王永安北京航天微电科技有限公司北京00854北京无线电测量研究所北京00854
孟腾飞,陈晓阳,段英丽,于海洋,周培根,王永安(. 北京航天微电科技有限公司,北京 00854;. 北京无线电测量研究所,北京 00854)
0 引言
声表面波(SAW)器件已广泛应用于手机、基站等通信系统及卫星、导航等武器装备的收发系统中。随着5G通信和商用卫星技术的发展,SAW器件因其具有体积小,质量小,一致性好的特点,应用需求越来越广[1-3]。
SAW器件一般采用光刻、镀膜及剥离等工艺在压电衬底上制备由数百根叉指线条组成的叉指换能器(IDT)来实现谐振、滤波等功能,IDT的线宽是影响器件频率特性的关键指标。在光刻工序的图形制作过程中,曝光时间和光强、烘烤温度和时间、显影液质量浓度和显影时间等工艺参数的变化均将影响制作的IDT线条宽度[4]。由于同一IDT处于同一晶圆和同一曝光场,上述工艺参数的改变会使同一IDT上的所有线条发生近似等幅的宽度变化,然而对于粗细相间或宽度逐渐变化的非均匀线条,这种等幅的变化会造成不同线条的宽度比偏离设计要求,进而影响产品性能。除上述工艺参数外,如何精确控制非均匀IDT线条宽度的难题尚未见报道。
在SAW器件曝光过程中,光源发出波长为λ的光经掩模版上明暗相间的叉指线条(即衍射光栅)照射到光刻胶(像平面)。根据光学衍射的基本原理,当光遇到障碍物时将发生衍射,从而偏离原来的传播路径。当障碍物或孔尺寸为波长的几十倍时,衍射效应不能忽略。一般选择SAW器件曝光的光刻机光波长为365 nm,对于IDT线条宽度或缝隙为几个微米的掩模版,曝光时光发生衍射偏离直线传播,且光线偏离角度与掩模版上线条或缝隙大小有关,这将导致光刻胶被衍射光照射,进而改变其显影特性,表现为线条宽度发生变化。
本文针对SAW器件的一般特性(IDT线条尺寸或间距为曝光波长的几十倍),用夫琅禾费衍射理论来分析光在曝光系统中的传播过程,详细分析了掩模版线宽、衍射光强、掩模版与光刻胶间距对线条宽度的影响。通过建立光学模型计算不同宽度线条经曝光后的线宽变化值,从而达到精确计算线宽变化值的目的。
1 实验
1.1 实验耗材
本文所用耗材包括光刻胶AZ、去离子水(电阻率为18.2 MΩ·cm)、显影液(质量分数为2.38%的四甲基氢氧化铵水溶液)及丙酮(分析纯,质量分数≥99.5%)。AZ反转光刻胶的工艺条件:匀胶速度为5 000 r/min;曝光前,在94 ℃下烘烤2 min,曝光波长为365 nm,光强为18 mW/cm2;曝光后,在94 ℃下烘烤2 min,泛曝光时间为5 s,显影时间为10 s。
1.2 实验设备
通过OPTICoat型匀胶机旋涂制备光刻胶薄膜,RT-2型加热平台用于固化烘烤,曝光设备为ABM光刻机,采用OPTISpin正胶处理系统显影,采用MX51显微镜观察表面和测量长度,采用DektakXT型台阶仪测量膜厚。
2 光学模型
2.1 曝光衍射效应原理
SAW器件图形化的步骤:在压电晶圆上旋涂光刻胶后放到热板上进行前烘,再采用光刻机进行曝光,最后进行后烘和显影,即可将掩模版上的图形转移到光刻胶上,制备出SAW器件的IDT胶图形,工艺流程如图1所示。

图1 SAW器件光刻工艺流程
SAW器件掩模版上明暗相间、交错对插的叉指线条尺寸一般为0.4~15 μm,曝光一般选择λ=365 nm的光刻机。光经过掩模版照射光刻胶,此过程可用衍射理论进行分析,以接近式曝光为例,掩模版和光刻胶可分别作为光学系统的衍射光栅和像平面,由于光栅(叉指线条)尺寸为曝光波长的几倍至几十倍,根据光学理论,这一过程中光的衍射效应不可忽略。
曝光时,光经过掩模版上的缝隙(即线条间距)发生衍射,缝隙宽度为w,随着像平面与缝隙的间距D的增大(见图2),衍射效应分别符合基尔霍夫(D<λ/2)、菲涅耳(D≈w)、夫琅禾费(D≫w)衍射理论。对于SAW器件的接近式曝光,建立以夫琅禾费衍射理论为基础的光学模型来定量描述曝光衍射效应。

图2 衍射效应理论适用范围
根据夫琅禾费衍射理论,光经过掩模版上的线条缝隙后光强为
(1)
(2)
式中:θ为衍射光与入射光间的夹角;I0为通过缝隙的最大光强。
衍射光强分布如图3所示。中心主极强位于缝隙中心位置,称为零级条纹,光强I=I0/2对应的角度称为半角宽度θ0,即:
θ0=λ/w
(3)

图3 衍射光强分布图
其他各次极强依次出现在sinθ=±1.43λ/w,±2.46λ/w,…;相对光强I/I0分别为4.7%,1.7%,…。
2.2 光学模型
针对SAW器件的接近式曝光(λ=365 nm),当掩模版与光刻胶的间距远大于缝隙尺寸时,建立基于夫琅禾费衍射理论的光学模型,设掩模版上非均匀IDT的线条和缝隙尺寸分别为a、b、c、d,如图4所示,宽度为b的线条两侧存在宽度为a、c的缝隙,光通过缝隙后发生衍射,偏离原来的传播方向,从而照射到a′、c′处的光刻胶。根据不同的衍射光强,通过设定曝光时间控制曝光量可改变a′、c′处光刻胶的显影特性,从而改变线条b、d的宽度。

图4 接近式曝光衍射效应示意图
首先确定曝光时间T与线条宽度变化值a′、c′的关系,设光刻胶被强度为I0的光照射时间为T0后,经固定的后烘、显影工艺后溶于显影液。当掩模版与光刻胶的距离为L时,将曝光时间从T0增加至T,可实现部分衍射光使光刻胶充分曝光,衍射光强与曝光时间的关系为
(4)
(5)
根据式(1)、(2)、(4)、(5)可分别得到缝隙a、c的衍射光强I(θ)对应的角θ1、θ2,从而得到线条b的变化值:
Δb=L·tanθ1+L·tanθ2
(6)
针对掩模版上缝隙尺寸a=c,且非均匀线宽包括4 μm、4.5 μm、5 μm的SAW器件,在L为25 μm、50 μm、100 μm时,计算线条尺寸变化值。根据式(2)、(5)、(6),通过编程建立数学模型可计算出线宽变化值Δb与曝光时间T/T0的关系,如图5所示。
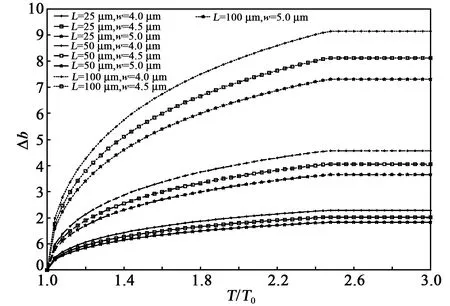
图5 Δb与T/T0的关系
3 结果与讨论
选择型号为SBP60.19的SAW器件,其阳性掩模版上,a=b=c=d=6.82 μm,采用接近式曝光,根据式(2)、(5)、(6)可得Δb与T/T0的关系,如图6所示。实验选择AZ光刻胶用5 000 r/min旋涂得到厚1.2 μm的光刻胶薄膜,然后用94 ℃热板烘烤2 min,采用接触式曝光,光强18 mW/cm2,曝光2 s,再经后烘、泛曝光和显影后得到间距7.95 μm的线条,如图7所示。

图6 线宽变化值与曝光时间的曲线图
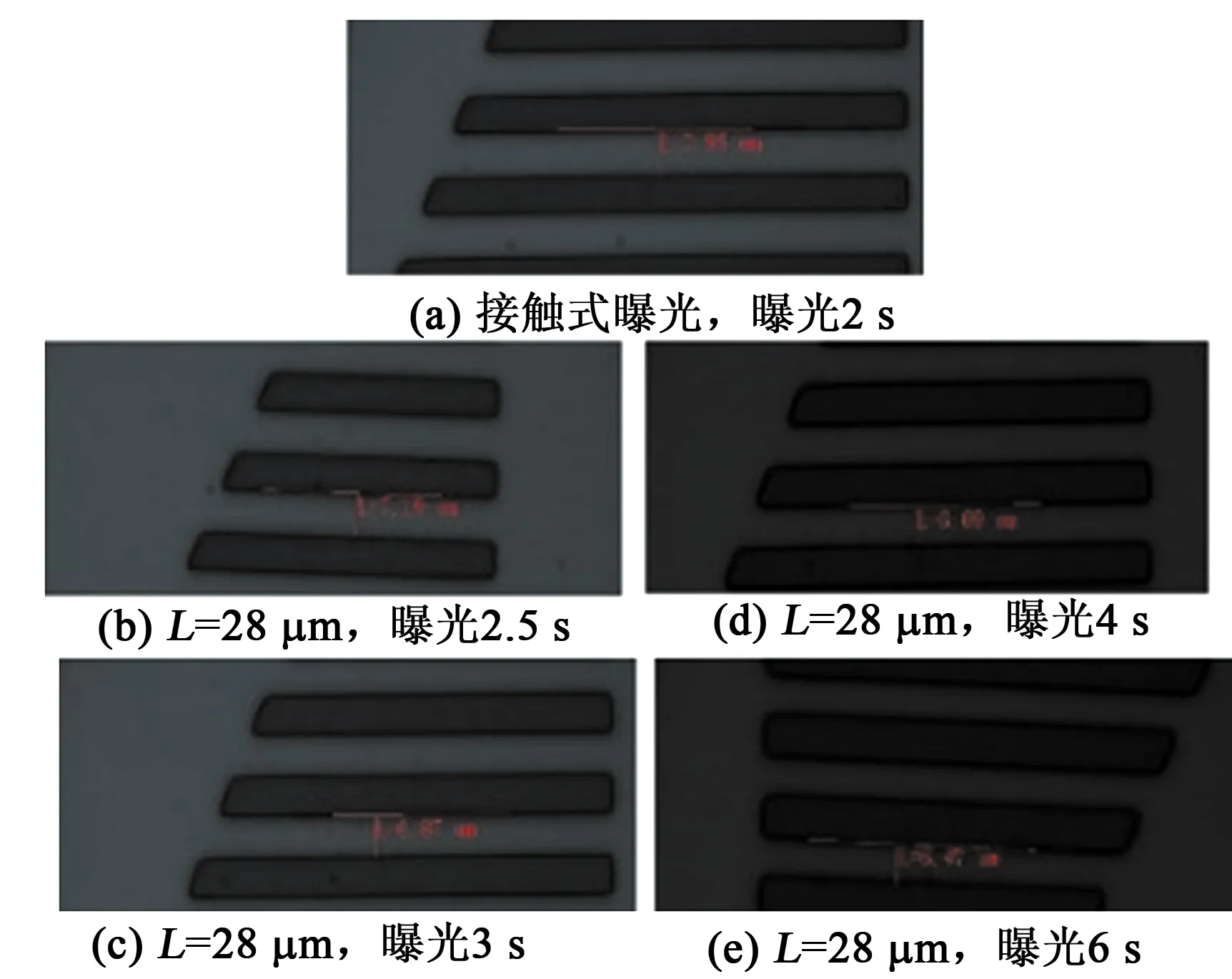
图7 实验结果图
调整掩模版与光刻胶的间距L=28 μm,分别曝光2.5 s、3 s、4 s、6 s,其他工艺参数不变,进行对比实验,所得线条宽度分别为7.19 μm、6.87 μm、6.69 μm和6.47 μm,线宽变化值分别为0.76 μm、1.08 μm、1.26 μm、1.48 μm,与计算结果相符。线条宽度6.69 μm的器件频率响应曲线如图8所示。

图8 频率响应曲线
4 结束语
本文针对SAW器件掩模版上线条和缝隙尺寸为曝光波长的几十倍的特点,采用夫琅禾费衍射理论分析接近式曝光的过程,并建立了光学模型。根据掩模版线条和缝隙尺寸、掩模版与光刻胶间距、衍射光角度及曝光时间等变量可计算出线条尺寸的变化值,通过程序编程可对掩模版数据中不同尺寸的线条和缝隙进行宽度补偿,从而实现非均匀线条宽度的精确控制。
