混合介质层类同轴垂直硅通孔的高频性能研究
2021-11-09丁英涛王一丁肖磊王启宁陈志伟
丁英涛, 王一丁, 肖磊, 王启宁, 陈志伟
(北京理工大学 信息与电子学院,北京 100081)
随着军用、民用通信技术的飞速发展,作为有源相控阵雷达中的关键部件,T/R组件的工作频率越来越高,并开始向小型化、集成化发展. 采用2.5 D转接板技术,可以实现T/R组件高密度集成[1]. 然而,作为2.5 D转接板技术的关键部分,传统的穿透硅通孔(through silicon via, TSV)会在信号频率变高时产生更高的损耗,同时在TSV之间以及TSV与有源电路之间产生耦合噪声,这些现象都会影响系统的射频性能[2-3].
近年来,适用于高频领域的TSV结构引起了国内外的广泛关注. 2006年,SOON等[4-5]提出了由传输信号的中心TSV、接地的金属屏蔽环以及介质层组成的同轴TSV结构. 通过仿真分析,该结构可以有效地降低损耗和耦合噪声. 2011年,IVAN等[6]提出了一种以Si与BCB共同作为介质层的同轴TSV结构. 研究结果表明:当中心介质层BCB的厚度为11 μm时,在60 GHz工作频率下,该结构的插入损耗小于15%;并且随着BCB厚度的增加,损耗可降到3%. 2013年,中国航空无线电电子研究所于乐等[7]提出一种空气间隙的同轴TSV. 采用SU-8作为介质层,并通过对介质层的部分刻蚀形成空气间隙,仿真结果显示该TSV结构比传统的TSV带宽高1.6倍~4倍. 然而上述研究工作大多停留在性能仿真阶段,而制备完成并进行射频性能测试的同轴TSV结构则少有报道. 同时,传统的同轴TSV结构在制备过程中会存在工艺实现困难,结构可靠性降低等问题. 基于此,本文提出一种混合介质层类同轴TSV结构,探究了外围TSV数量、TSV直径、混合介质层厚度对回波损耗、插入损耗以及串扰等性能的影响,并与传统同轴TSV结构对比,评估了优化尺寸后混合介质层类同轴TSV的性能.
1 结构设计与工艺流程
传统的同轴TSV中,内外导体之间一般以硅衬底作为介质层或者填充介电常数相对较低的高分子聚合物作为介质层,如图1(a)(b)所示,这在高密度、小直径同轴TSV中已经得到广泛应用[8]. 然而在特定射频应用中,常需要将传输信号的中心TSV直径扩大至几十微米甚至百微米量级. 然而,根据同轴传输线设计规范,此时介质层厚度需要大幅度增加. 尤其当内导体直径为50 μm时,BCB介质层厚度需高达70 μm,而这在工艺中是很难实现的. 首先,在采用化学机械抛光技术(CMP)实现表面平坦化的过程中,厚度较大的BCB层会导致中心TSV区域的硅柱出现部分碎裂现象(如图2(a)所示),导致刻蚀面积以及深度的不同,这会增加后续深反应离子刻蚀工艺(DRIE)的不稳定性;其次,BCB质软,CMP过程中易抛光至内导体TSV区域,如图2(b)所示,形成了一层刻蚀掩膜,这可能会导致后续的DRIE刻蚀无法顺利进行. 同时BCB价格较高,大尺寸BCB介质层将大大增加2.5 D转接板制作成本. 据此,将全BCB介质层优化设计为混合型介质层,并采用高阻硅衬底,即图1(c)所示的“高阻硅-BCB-高阻硅”结构,在减小工艺难度的同时有效控制工艺成本. 此外,外部屏蔽环的金属电镀工艺也一直是三维集成技术中的一个工艺难点. 相比于相同尺寸柱型TSV,环形区域的电镀由于需要填充的体积更大,所以会存在屏蔽环电镀时间长且与中心TSV电镀不同步等问题. 而若将屏蔽环尺寸缩小,又会引入在电镀过程中易提前封口导致不完全铜电镀等问题. 本文依此提出一种“类同轴”结构,即在中心TSV周围摆放与其相同结构尺寸的TSV环形阵列,如图1(d)所示,并在RDL层实现环形阵列的互联,以此形成屏蔽层. 类同轴结构充分利用了成熟的TSV盲孔电镀工艺,在缩短电镀时间的同时,充分保证了电镀过程中表面的一致性.

图1 4种同轴TSV结构示意图Fig.1 Schematic diagram of four kinds of coaxial TSV structures
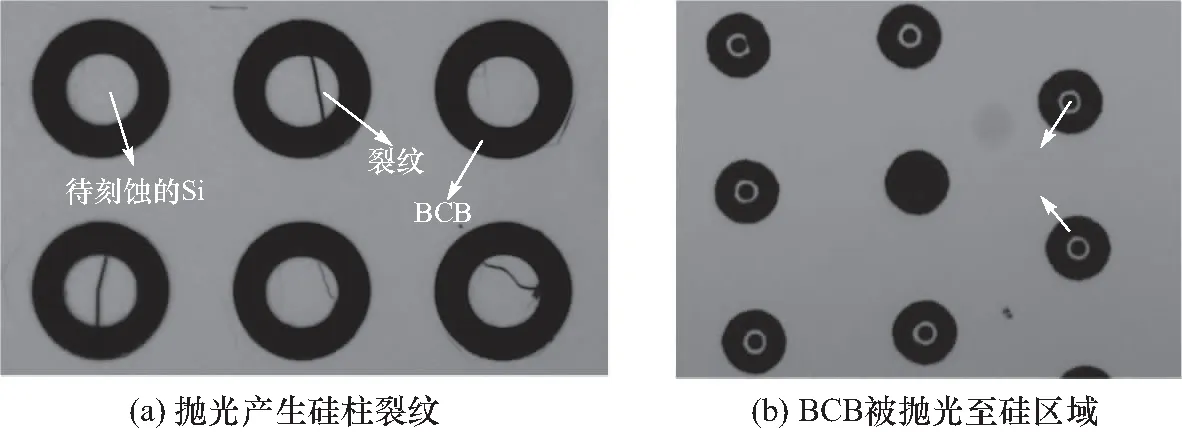
图2 全BCB介质层同轴TSV会出现的问题Fig.2 Problems of the coaxial TSV with BCB dielectric layer
基于混合介质层的类同轴TSV转接板的工艺流程如图3所示. 首先通过光刻、深反应离子刻蚀工艺进行高阻硅上的环形槽的制备,然后利用真空辅助旋涂技术实现BCB的填充并采用CMP的方法去除表面多余BCB,如图3(a)~(c);再次通过光刻、深反应离子刻蚀工艺得到铜电镀区域,在PECVD沉积SiO2介质层、ALD沉积TiN阻挡层、溅射Cu种子层之后进行Cu的电镀、表面平整化以及正面RDL的制造,如图3(d)~(h);随后,通过临时键合和背部减薄抛光的方法,露出背部铜柱,完成背部RDL和铜锡微凸点的制造,如图3(i)~(l). 最终得到的转接板如图3(l)所示,其中A区域为传输信号的中心TSV,B区域为由外围TSV构成的类同轴结构.

图3 类同轴TSV工艺流程图Fig.3 The fabrication process flow of coaxially shielded TSV
2 实验与结果讨论
2.1 实验建模
图4为采用HFSS软件建立的混合介质层类同轴TSV模型. 其中混合介质层由Si-BCB- Si构成,同时硅基底采用高阻硅材料,通过两端的RDL层实现外围TSV结构的电学互联. 本文采用的基础模型尺寸如表1所示.

图4 混合介质层类同轴TSV模型Fig.4 Coaxially shielded TSV model

表1 混合介质层类同轴TSV尺寸
2.2 混合介质层类同轴TSV参数优化
2.2.1外围TSV数量对混合介质层类同轴TSV射频传输性能的影响
外围TSV结构可以实现类似于同轴TSV结构屏蔽环的作用,因此对于本文的类同轴结构而言,外围TSV结构是一个重要的设计参数. 本文分析了外围TSV数量对类同轴结构回波损耗(S11)、插入损耗(S21)以及串扰等性能的影响. 当外围TSV数量为4时,在1~45 GHz的频率范围内,混合介质层类同轴TSV的S11小于-16.9 dB,S21大于-0.12 dB,特征阻抗为47 Ω左右. 由图5所示,随着外围TSV数量的增多,混合介质层类同轴TSV的S11变大,S21变小. 这是由于接地TSV增多时会增加信号到地的电容,从而降低整个TSV的特征阻抗,导致阻抗失配,进而使混合介质层类同轴TSV的S11变大,S21变小[9].

图5 外围TSV数量对混合介质层类同轴TSV S参数的影响Fig.5 Influence of ground TSV number on S parameters of coaxially shielded TSV with the mixed dielectric layer
随着转接板的工作频率越来越高,TSV之间串扰会增强. 本文进一步探究了在1~45 GHz的频率范围内,不同外围TSV数量对转接板串扰(S31)性能的影响,并将结果与普通TSV信号对的串扰特性进行对比分析. 从图6可以看出,在45 GHz工作频率下普通高阻硅中TSV信号对的串扰为-22.17 dB,然而对于外围TSV数量为4的类同轴TSV结构而言,TSV之间的串扰为-76.34 dB. 并且随着外围TSV数量的增多,不同类同轴TSV结构之间的串扰减小,这是由于当外围TSV数量越多时,类同轴结构越接近同轴结构,外围TSV越来越能够起到屏蔽层的作用.
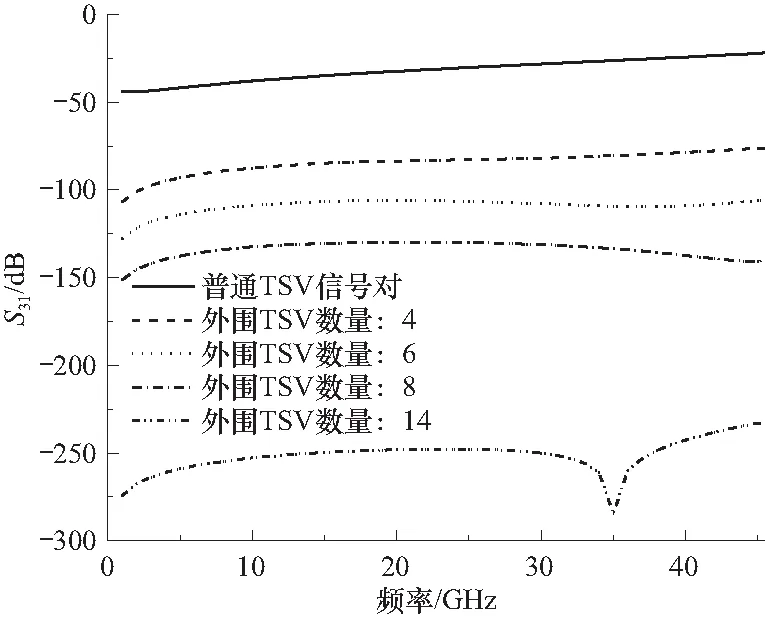
图6 外围TSV数量对混合介质层类同轴TSV串扰的影响Fig.6 Influence of ground TSV number on the crosstalk of coaxially shielded TSV with the mixed dielectric layer
2.2.2TSV直径对混合介质层类同轴TSV射频传输性能的影响
在制造2.5 D转接板时,会在硅基底上制备大量的孔结构,孔的直径不仅会影响整个转接板TSV密度还会影响电镀的时间,因此本文在外围TSV数量为4的基础上对TSV直径进行变参分析. 实验结果如图7所示. 可以看出,随着TSV直径的增大,混合介质层类同轴TSV的S11变大,S21变小.

图7 TSV直径对混合介质层类同轴TSV S参数的影响Fig.7 Influence of the diameter of TSV on the S parameters of coaxially shielded TSV with the mixed dielectric layer

续图7 TSV直径对混合介质层类同轴TSV S参数的影响Fig.7 Influence of the diameter of TSV on the S parameters of coaxially shielded TSV with the mixed dielectric layer
这是由于随着TSV直径的增大,信号线到地线的寄生电容变大,降低了整个TSV结构的特征阻抗,从而增大整个结构的插入损耗[9].
2.2.3混合介质层尺寸对混合介质层类同轴TSV射频传输性能的影响
本节通过仿真对混合介质层中高阻硅材料(BCB介质层内外侧)的厚度进行变参分析研究,其中考虑工艺实际情况,混合介质层中BCB厚度设定为30 μm,仿真结果如图8所示. 实验结果显示,内环Si的厚度越小S11越小,S21越大;外环Si的厚度越大S11越小,S21越大. 综合考量仿真结果与工艺的可实现性,内环Si的厚度为10 μm,外环Si的厚度为30 μm时混合介质层类同轴TSV回波损耗、插入损耗性能最佳. 在1~45 GHz频率范围内,该尺寸下的类同轴TSV结构的S11小于-20.2 dB,S21大于-0.07 dB,性能满足传输线使用要求,兼具良好的高频特性.

图8 介质层中硅的厚度对混合介质层类同轴TSV S参数的影响Fig.8 Influence of the thickness of silicon in the dielectric layer on the S parameters of coaxially shielded TSV with the mixed dielectric layer
通过以上参数分析的结果,可以得到混合介质层类同轴TSV结构中各参数对S11、S21的影响,设计参考如表2所示.

表2 混合介质层类同轴TSV各尺寸对S11、S21的影响
2.3 混合介质层类同轴TSV与同轴TSV性能对比
通过2.2节对混合介质层类同轴TSV的参数优化,本文最后设计的模型参数为:外围TSV数量为4,TSV直径为50 μm,混合介质层中内环Si厚度为10 μm,BCB厚度为30 μm,外环Si厚度为30 μm. 为了进一步评估优化后的混合介质层类同轴TSV的性能,本文选取了同尺寸的全BCB介质层同轴TSV、全Si介质层同轴TSV以及混合介质层同轴TSV与之进行对比研究. 图9所示为4种不同TSV结构在1~45 GHz频率范围内的回波损耗与插入损耗性能,可以看出:混合介质层类同轴TSV结构在制造工艺简单的前提下,具有良好的高频性能.

图9 混合介质层类同轴TSV与同轴TSV性能对比Fig.9 Performance comparison of coaxial TSV and coaxially shielded TSV with mixed dielectric layer
3 结 论
本文针对大直径同轴TSV结构在制造过程中所面临的诸多难题,提出了一种混合介质层类同轴TSV结构,并设计了相应的工艺流程. 对比相同尺寸下的传统同轴TSV结构,该结构可以有效解决由于介质层厚度过大造成的刻蚀区域碎裂以及CMP后难以刻蚀等问题,并减小了电镀工艺的难度. 在对外围TSV数量、铜柱直径以及混合介质层尺寸等参数分析研究的基础上,设计了一种具有良好的回波损耗、插入损耗以及串扰等性能的类同轴TSV尺寸. 仿真结果显示,即使在45 GHz的工作频率下,优化后的混合介质层类同轴TSV结构也具有良好的高频特性. 其回波损耗为20.20 dB,插入损耗为0.07 dB,串扰为-76.34 dB,为应用于T/R组件的2.5 D转接板提供了设计参考.
