六角氮化硼(h-BN)对单层硒化铟(InSe)的调制效应及这一新结构的电子性质
2019-07-08谢子锋张智慧
谢子锋, 张智慧, 李 赫, 郑 丹, 段 理
(1.长安大学材料科学与工程学院,西安 710064; 2.长安大学环境科学与工程学院,西安 710064)
1 引 言
自石墨烯从石墨中分离出来以后,二维材料由于其独特的光电性质,越来越受到人们的重视[1]. 但是本征石墨烯带隙为零,不具备半导体性质,这限制了其在纳电子学器件中的应用[2]. 作为替代方案,已经出现了其他二维材料的研究. 如二维硫族化合物,其带隙介于1-3 eV,这意味着可制造出较高开关比的器件[3, 4]. 黒磷,从块体到单层有0.3-2.0 eV的直接带隙以及较高的载流子迁移率,然而进一步研究发现,单层或几层BP在大气环境中不稳定,受空气中的水分和氧气的严重降解[5,6]. 具有类似石墨层状结构的六角氮化硼(h-BN),带隙理论计算值为4.8 eV左右,实验值为5.9 eV左右,是一种宽禁带半导体[7]. 直接的宽带隙可用于远紫外光发射,同时具有良好的化学稳定性和力学性能. 比起常用的SiO2表面,h-BN片是原子级的薄片且没有电荷杂质以及悬挂键,h-BN作为一种良好的电介质材料而受到人们亲睐[8].
最近Geim等人成功制备出只有几个原子厚度的二维硒化铟(InSe)材料,它拥有比石墨烯、黒磷及其他过渡金属二硫属元素更好的半导体属性[9]. InSe,六方晶系结构,每层都有一个蜂窝状晶格. 层与层之间通过范德华力连接起来,层间距约为0.8 nm. 超薄InSe电子迁移率高,室温下超过1000 cm2V-1s-1,远远超过了硅,液氮温度下载流子迁移率可以达到104cm2V-1s-1[10, 11]. 这些研究表明二维InSe在超快电子领域和光电子领域有很大的应用潜力.
几年前,范德华(vdW)异质结构的概念由Geim和Grigorieva提出[12]. 这种vdW异质结通过层叠二维结晶原子层合成,层与层之间没有化学键,依靠范德华力结合在一起. 目前,用不同二维材料堆垛成三维空间里具有原子层精度的异质结成为研究的热点. 最近有一些人开始制备硒化铟基异质结器件. Chen等人制造了硒化铟/石墨烯异质结光电探测器,该器件光响应性和外部量子效率比单纯二维硒化铟高四个数量级[13];Ding、Padilha等人研究了硒化铟/黒磷范德华异质结的结构和电子特性,其载流子迁移率有了很大的提升[14, 15];Alharbi等人制备了硒化铟/氮化硼异质结,通过透射率,反射率和吸收光谱的光学分析揭示了设计一种新型光通信传感器的可能性[16].
因此,考虑到单层硒化铟和六方氮化硼的优异性质,在本文的研究中,我们将单层InSe堆叠于h-BN片层上构建出新型InSe/h-BN异质结构,研究该异质结的稳定性和能带结构.
2 理论方法和模型
采用基于密度泛函理论(DFT)的第一性原理计算程序包CASTEP模块计算InSe/h-BN体系的结构和电子性质[17]. 广义梯度近似(GGA)下的PBE泛函用来估计电子交换关联作用,用超软赝势(USPP)来描述离子实和电子之间的相互作用[18]. 通过使用Grimme提出的经验校正方案消除vdW相互作用的影响. Monkhorst-Pack网格布里渊区K点取样为5*5*1[19]. 为了避免相邻两个超胞间的相互影响,我们设置真空层厚度为15 Å,此时层间作用可以忽略不计. 经过收敛性测试,平面波函数截断能值取为400 eV,在结构优化时,能量收敛标准为每个单胞能量为10-5eV,力的收敛判据为0.03 eV/Å.
首先优化孤立状态的单层InSe和h-BN,优化后单层InSe晶格常数为a=b=4.084 Å,单层h-BN晶格常数为a=b=2.510 Å,两者晶格失配率为超过38%. 为了降低失配率,我们选用超胞匹配,在本文的研究中选用3*3*1的硒化铟超胞和5*5*1的h-BN超胞进行匹配,超胞的晶格参数分别为a=b=12.25 Å和a=b=12.55 Å,此时晶格失配率小于2.4%,在计算中认为是合理的[20]. 为此,我们建立三个不同模型来研究InSe/h-BN异质结的结构性质,结构A固定六方氮化硼,建立晶格常数为a=b=12.55 Å的模型,结构B取两种物质晶格常数的平均数a=b=12.40 Å构建模型,结构C固定硒化铟,建立晶格常数为a=b=12.25 Å的模型.异质结结构如图1所示.
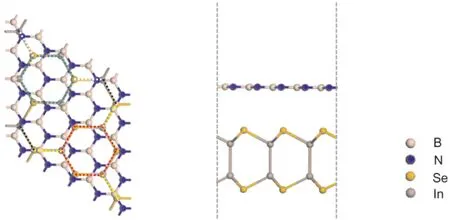
图1 优化后InSe/h-BN异质结的俯视图(左)和侧视图(右)Fig. 1 Top view (made) and side view (right) of the InSe/h-BN heterojunction after optimization.
3 结果和讨论
形成能是反映异质结形成难易程度和稳定性的一个重要参数[14]. 为了考察异质结形成的合理性,我们计算了单层InSe和单层h-BN的能量以及三种异质结的总能量,本文中形成能Ef的计算采用以下公式:
Ef=EInSe/h-BN-(EInSe+Eh-BN)
这里EInSe/h-BN为异质结构的总能量,EInSe为单层硒化铟的能量,Eh-BN为单层六角氮化硼的能量. 计算得出结构A、B、C的结合能如表1所示.
表1 三种硒化铟/六角氮化硼异质结的形成能
Table 1 Binding energies of InSe/h-BN heterostructure with three stacking conformations.

StructureABCEf(eV)-0.2712-0.2345-0.0023
由表中形成能数值可以看出均为负值,表明体系为放热过程,三种异质结构均能稳定存在. 三种结构相比,结构A能量最小为-0.2712 eV,说明结构A最稳定.
为了便于比较,我们首先计算了单层InSe和h-BN的能带结构,如图2所示. 从能带图中可以看出单层InSe带隙为1.44 eV,导带底位于Γ点,而价带顶位于Γ和K点之间靠近K点处,是间接带隙半导体. h-BN带隙为4.68 eV,导带底位于Γ点而价带顶于K点,也为间接带隙,与文献中报道一致[21-23],说明我们选取的计算参数是合理的.

图2 单层硒化铟(a)和六方氮化硼(b)的能带结构图(图中虚线表示费米能级位置)Fig. 2 Band structures of monolayer InSe (a) and h-BN (b). (The dotted line indicates the Fermi level position)
接着,我们研究了将单层h-BN放在单层InSe层上的三种特殊情况,堆叠结构如图1所示. 差分电荷密度可以判断体系中的电荷转移情况,如图3(d)所示(由于三种结构差分电荷密度基本一致,所以本文只给出了一幅图),其中蓝色区域表示差分电荷密度为负值,意味着电子的损失,相反黄色区域意味着电子的聚集,由图中可以看出电子的转移都在层内发生,层与层之间未发现电荷转移. 由鲍林标度[24]可知N原子比B原子电负性大1.0,Se原子比In原子电负性大0.77,因此N原子和Se原子周围区域均为黄色,意味着得到电子,而且氮原子周围黄色更深. 从图中电荷转移可以看出h-BN由B-N共价键连接起来,InSe是由四个通过共价键(Se-In-In-Se)连接起来的原子平面组成(中间是较弱的In-In键). 层与层之间没有电荷交换,进一步证实层间是弱的范德华力结合.
所以InSe/h-BN异质结可以视为单层InSe和单层h-BN的叠加 .相应的能带结构如图3(a)-(c)所示,结构A、B、C的带隙分别为0.952 eV、1.105 eV、1.211 eV. 异质结的价带顶位于G和K点之间靠近K点位置,导带低位于G点,所以异质结也为间接带隙半导体. 与单层硒化铟相比,三种异质结构的带隙均有所减小. 为了获得更多细节信息,我们研究了每个体系和单层InSe的分波态密度,如图3(e)-(h)所示. 很明显,三种结构VBM主要由In原子和Se原子的p态所贡献,而CBM则由In原子的s态和Se原子的p态之间的杂化态组成,和单层硒化铟能量分布类似,即异质结的VBM与CBM电子贡献都来源于InSe. h-BN中的N原子和B原子在能量为-1.1 eV,-2.3 eV,-3.5 eV和-15.0 eV(图中未画出)处存在一个尖峰,在费米能级以上没有贡献. 三种结构的分态密度只有带隙宽度和费米能级附近有所不同. 三种结构带隙的变化的不同,我们认为是六方氮化硼对硒化铟层的调控作用.
为了更好的理解带隙的变化,我们计算探讨了异质结InSe/h-BN中h-BN层对InSe层的具体晶格调控. 我们发现经过优化以后,InSe/h-BN异质结中由于原子之间的相互作用,共价键Se-In、In-In和B-N的键长等物理参数均发生了变化,如下表所示:
表中dSe-Inn、dIn-Inn、dB-N、dc-c分别表示优化后Se-In键、In-In键、B-N键以及InSe和h-BN层的层间距的大小. 由于六方氮化硼中硼原子和氮原子在硒化铟上方所处的位置不同,所以它对硒化铟中Se-In键、In-In键的调控会有不同. dSe-In1表示B原子正好位于硒化铟六元环的中心位置时Se-In键的长度(图1中红色线条表示),这六个Se-In键所处环境相同,具有相同的键长. dSe-In2表示N原子正好位于硒化铟六元环的中心位置时Se-In键的长度(图1中绿色线条表示);dSe-In3表示B原子位于Se-In键桥位上方时Se-In键的键长(图1中黄色线条表示);dSe-In4表示N原子位于Se-In键桥位上方时Se-In键的键长(图1中白色线条表示);dSe-In5为Se-In键垂直方向上没有B、N原子时Se-In键的键长(图1中黑色线条表示);同样地,共价键In-In键处于三种不同的环境,键长数据如表中dIn-Inn所示. 由表中数据可以看出,与单层硒化铟和氮化硼相比异质结价键参均发生了变化. 不同原子之间由于电子云的涨落,正负电荷重心发生瞬时的不重合从而产生瞬时偶极,产生色散力,色散力越大引起的变形性越大. 我们用Se-In键键长和In-In键键长的方差(分别为σ1和σ2)来分析键长的变化情况,我们发现σ1A>σ1B>σ1C,同时σ2A>σ2B>σ2C,这说明结构A中硒化铟中处于不同位置的Se-In键和In-In键的键长波动变化最为显著,结构B次之,结构C中键长基本趋于稳定. 同时键长波动最明显的A结构带隙值变化也最为显著(为0.952 eV),B结构次之,键长趋于稳定的C结构带隙变化相对较弱(为1.211 eV). 说明在固定六方氮化硼的结构A中,调控作用最明显.


图3 (a)-(c)依次为结构A、B、C的能带结构(图中虚线表示费米能级位置);(d)为异质结的差分电荷密度图,(e)-(h)依次为结构A、B、C和InSe的分波态密度图.Fig. 3 (a)-(c) Band structures of structures A, B, and C, respectively (the dotted line indicates the Fermi level position). (d) Differential charge density of the heterojunction. (e)-(h) partial DOSs of structures A, B, C, and InSe, respectively.

StructuredSe-In1dSe-In2dSe-In3dSe-In4dSe-In5σ1dIn-In1dIn-In2dIn-In3σ2dB-Ndc-cPristine2.687—2.879—1.449—A2.6872.6792.6742.7132.7073.0×10-42.8012.7972.8364.6×10-41.4493.874B2.6692.6642.6572.6962.6872.7×10-42.7882.7872.8185.5×10-41.4323.886C2.6742.6722.6732.6732.6735.0×10-42.8382.8372.8383.4×10-41.4143.888
接着,研究了经过h-BN调控后的单层InSe的能带结构,也就是晶格参数变化如表2中所示的单层InSe的结构. 图4给出了三种情况下的能带图. 我们发现此时三种结构任为间接带隙,带隙分别为0.953 eV、1.126 eV和1.301 eV,此时的带隙与InSe/h-BN异质结体系的带隙差别甚微,分别为0.001 eV,0.021 eV,0.090 eV,不同于无应变的单层InSe的能带结构(带隙为1.444 eV). 这说明在异质结构中,带隙的变化为h-BN的调控作用所致. 结构中h-BN和InSe片层之间的相互作用导致在InSe片层中存在较大的应变,从而导致InSe能带的变化. 三种结构中h-BN的调控作用依次减弱,这是因为在相同的晶格失配度下结构A中固定了h-BN,而结构C中固定了InSe,六方氮化硼的结构发生了轻微的改变,所以三种结构其对硒化铟的调控作用依次减弱.

图4 优化好的InSe/h-BN异质结中去掉h-BN后InSe层的能带结构(图中虚线条表示费米能级位置)Fig. 4 Band structures of InSe in the optimized InSe /h-BN system without h-BN substrate. (the dotted line indicates the Fermi level position)
4 结 论
总之,我们采用基于密度泛函理论的第一性原理成功地预测了三种InSe/h-BN异质结构的稳定构型. 二维InSe/h-BN异质结和单层InSe一样都是间接带隙. 通过差分电荷密度,态密度,能带结构的研究发现异质结层与层之间没有电荷转移,带隙的变化是由InSe和h-BN之间的相互作用而诱导的晶格应变引起的. 三种结构的对比发现,固定h-BN后对体系的调控作用最明显,改变h-BNd的结构,其对体系带隙的调控作用有所减弱. 我们的研究结果表明,单层InSe沉积或生长在不同h-BN片上可以获得不同的晶格应变,实现对单层InSe能带结构的有效调控. 这一发现可以实现在原子精度定向改变系统的带隙,对实际实验具有一定的指导意义.
