利用XPS平行成像技术进行材料表面微区分析*
2017-11-02徐建郝萍周莹上海市计量测试技术研究院
徐建 郝萍 周莹 / 上海市计量测试技术研究院
利用XPS平行成像技术进行材料表面微区分析*
徐建 郝萍 周莹 / 上海市计量测试技术研究院
利用XPS能谱分析结合平行成像技术,在功能器件等材料微区测量方面进行了一些探索,并选取了三类比较有代表性样品,通过设计合理的方法分别对其表面微区进行了有效测量,获得较好的测量结果。
XPS分析;平行成像技术;表面微区分析
0 引言
X射线光电子能谱(XPS)是利用软X射线激发样品电子能量谱,主要用于分析样品表面元素及其价态。它也是表面分析中最有效、应用最广的分析技术之一。这主要是因为它表面灵敏度高,可同时提供元素定性定量和化学态信息。与俄歇电子能谱(AES)相比更便于分析元素的化学态。另外,XPS实验易于制样,可以分析导体、半导体、绝缘体样品,对样品破坏性小等优点。但是常规XPS因束斑大只能对较大面积进行分析,提供大面积内平均信息,而且所用的激发源为非纯单色化X射线,得到的XPS谱能量分辨力不够好。
随着电子能谱仪器制造技术的发展以及对分析技术的需求,近年来迅速发展起来的高灵敏度单色化XPS(简称Mono XPS),小面积XPS或小束斑XPS(简称SAXPS,也称为Selected Area XPS,即选区XPS)和成像XPS倍受关注。这些新的分析功能在制造水平、性能和功能上都是一般常规XPS谱仪无法相比的,是常规XPS分析的拓展。单色SAXPS(Mono SAXPS)可提供高的能量分辨力、高信背比、选定分析微区(目前可达到约10 μm)内XPS信号。成像XPS是指在分析区域内显示化学元素及化学状态分布信息的图像,小面积微区分析是通过缩小分析面积来提高空间分辨力。随着科学技术的发展,特别是微电子器件和非导电不均匀材料的发展,成像XPS和微区分析的空间分辨力有了很大的提升。当样品表面材料成分不均匀时,可通过快速平行成像XPS的方法检测样品(最佳空间分辨力可以达到1 μm),以表征样品表面不同的化学信息分布,然后可有目的性地在图像指定微区内(最小束斑尺寸可低于15 μm)进行XPS取谱研究,从而获得微区样品信息。成像XPS不仅可以进行化学元素成像,而且当同一种元素有不同的化学环境或者不同价态的原子存在时,只要其结合能差别(化学位移)足够大(2 eV或者更大),即可利用成像XPS显示同种元素不同的化学态分布。虽然这些微分析功能目前在空间分辨力仅达到微米量级,远不及AES的分辨力,但由于XPS分析的相对突出的优点以及性能的不断改善,这些功能在微电子器件和纤维材料分析、薄膜等器件的表面污染分布、金属偏析及高聚化合物表面的研究等方面,具有较好的应用前景。
本文利用XPS能谱分析,结合平行成像技术以及作者长期操作XPS积累的工作经验,对诸如半导体功能器件等材料的表面微区分析进行了一些有益的探索,通过选取三类比较有代表性样品(表面沾污样品微区分析、丝状样品微区分析以及功能器件微区元素分布分析),设计合理的测试方法,分别对其表面微区进行了有效测量,均获得较好的测量结果。
本文样品均选用岛津Kratos AXIS Ultra DLD 型X射线光电子能谱仪进行平行成像和能谱分析。
1 半导体器件样品表面沾污分析
金手指的表面沾污在半导体器件失效分析中极为常见,防止金手指污染是在生产和使用过程中需要着重注意的问题,但实际上仍然难以避免。对金手指表面微区污点进行有效分析在失效分析实际操作中相对比较困难。以半导体器件金手指表面污染分析为例,对半导体器件的微区失效分析提供了一种较为有效的方法。首先选取一表面污染金手指样品(图1),利用XPS平行成像对所选取的金手指区域进行金元素成像(见图2),成像面积为800 μm× 800 μm,扫描区域面积可以根据污染区域大小选择,然后再在成像区域上选取特定污染区域进行能谱分析(见图3),由XPS全谱扫描谱图可见,金手指表面污染区域的主要成分为Au、C和O元素。通过对样品污染物主含量元素C元素进行窄谱扫描并进行谱峰拟合(见图4),可以拟合成三个C 1s谱峰,峰位分别约为284.8 eV、286.1 eV和288.2 eV,主要对应有机污染物中碳元素的结合能,这也表明金手指表面污染物主要为有机污染物。根据能谱定量结果表面Au元素的相对原子浓度只有3.6%,碳和氧污染元素之和超过95%,最终导致器件功能失效。生产商可以根据XPS微区分析结果的有机污染物元素组成,查找相关可能的污染来源,有效杜绝污染和器件失效发生。

图1 金手指光学像

图2 Au元素平行成像
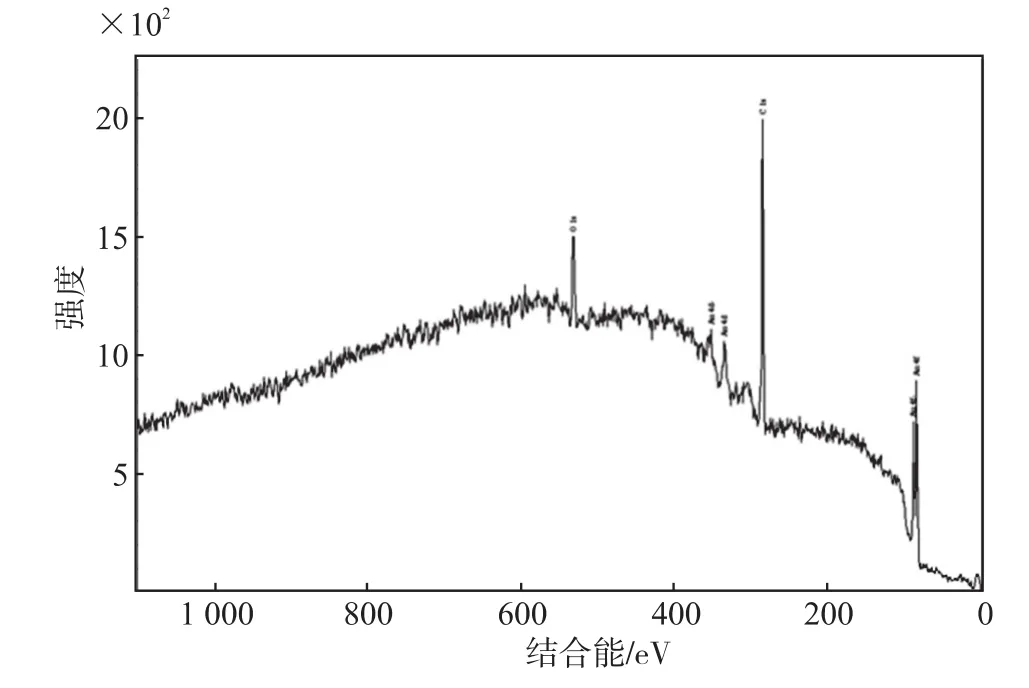
图3 选区XPS微区分析全谱扫描谱图

图4 C元素窄扫描谱图
2 丝状样品XPS分析
针对细丝状以及纤维状样品,在进行XPS分析时由于受制样方法的限制,经常会受到样品托或者样品夹具基底元素以及因样品取样面积过小造成的信号灵敏度太低等因素的干扰,大大影响了测量结果的准确性。为了去除样品托或样品夹具带来的影响,设计了图5中上部中空的样品托,可以把细丝悬空交叉绕在样品托上,通过XPS全谱扫描获取样品含量最多的主元素,再利用主元素成像,如图5所示,进而把缠绕细丝的交叉点移至XPS检测视野中心,通过选区XPS来对细丝状样品进行表面分析,获得样品真实的信息,去除样品托基底元素的干扰。

图5 细丝状样品XPS分析示意图
选取直径在50 μm左右的金丝线为例,首先把金丝交叉缠绕在如图5中特别设计的中悬空样品托上,并利用Au的4f7/2电子的84.0 eV结合能进行Au元素平行成像,成像面积为800 μm×800 μm,样品所成Au元素像见图6,然后再根据测试要求选取待分析区域进行能谱分析,获得金丝样品的全谱和Au元素的窄扫描谱(见图7和图8),进而获取样品组成以及各元素的化学态等信息。同时还可以利用金丝交叉点位置进行XPS光学像和元素像的有效对中,确保XPS仪器良好的工作状态。

图6 金属金丝的Au元素平行成像
对于丝状以及纤维状样品的表面分析,通过设计特别的样品托可以去除样品托所含元素带来的干扰。在通常的分析中,特别是针对一些纤维状的有机质样品,由于所含元素的检测灵敏度相对较低,在实际的制样过程中,可以在中悬空的样品托上作多次缠绕,进而获取相对更大的样品分析面积,获得更好的检出信号,填补因分析元素灵敏度过低带来的样品分析困难。

图7 选区分析XPS全谱

图8 Au元素窄扫描谱图
3 功能器件微区元素分布分析
在各种功能元器件的制备过程中,常需要在特定性能的薄膜或基底上加工、制作各种形状,如导电线路等。这些加工不但要求精度高,而且主要集中在器件的表面,如微电子线路板制作的关键基础技术:光刻或腐蚀技术、离子束精密刻蚀技术等。表面微细加工技术往往是在材料表面(一般不大于100 μm)区域内进行各种形状或尺寸的精密、微细加工,使其成为具有特定功能的器件。如何对这些经过精加工获得的功能器件进行有效的质量控制或失效分析呢?同样可以选用XPS平行成像技术对样品进行微区分析,获得样品微区元素的分布情况。
选取一块经微加工的功能器件样品进行XPS微区分析。在对选取样品进行微区分析过程中,首先利用110 μm 选区模式XPS的全谱扫描获得样品元素组成,本样品主要含有Al、O、Si、F等元素。在获得了样品所含的主要元素之后,为了获得样品各主含量元素在样品表面分布情况,利用Al 2p3/2、O 1s、Si 2p3/2以及F 1s的结合能分别进行XPS平行成像分析,成像面积为800 μm×800 μm,可以根据样品尺寸大小选取合适的成像区域,如400 μm×400 μm或200 μm×200 μm的分析区域,以获得更精细化的元素表面分布。由图9所知,不同元素在微加工器件样品的分布位置完全不同,Al元素主要分布在器件设计图形的所有边框边缘位置,F元素主要分布在样品中三个矩形图形的中心点位置,Si和O元素也在样品图形中有特定的分布位置。通过样品主含量元素微区平行成像,可以很清楚地了解各元素在器件上的分布情况,对功能器件的质量控制和失效机制作很好的把控和解析,解决样品质量控制以及失效分析,进而不断优化产品工艺和技术。

图9 功能器件样品Al、O、Si和F元素的XPS平行成像图
4 结语
XPS在进行样品微区分析时,由于仪器自身原因有很大的先天不足,同时由于其在表面分析领域特有的优势往往不可或缺,因此利用XPS仪器进行微区分析还存在一定的困难,这就需要XPS分析人员在分析过程中进行某些改进,有效提升仪器在微区分析的能力。本文利用XPS能谱分析,结合平行成像技术,在XPS微区分析领域作了一些尝试,选择三类样品的具体实例,对选用XPS微区分析技术进行了一些探索。
通过对三类具体实例的XPS微区分析,作总结如下:
1)在选用小面积模式XPS分析时,所要分析的样品微区所含元素最好具有异于周围区域的特定元素,便于在分析前先行元素成像,再根据样品平行成像结果选区进行表面微区分析;
2)对于样品直径在50 mm或者更小的细丝状或纤维状样品,可以选用经特别设计的样品托,采用悬空制样方法以去除样品托基底信号的干扰,达到有效分析样品的目的,但前提必须满足XPS分析元素检出信号要求。为了达到上述要求,对于细丝状或纤维状样品,可以考虑多缠绕一些,增加样品有效分析面积,以达到样品分析信号要求;
3)对于功能器件微区表面元素分布分析,可以直接选用XPS平行成像技术获得功能器件表面元素的分布情况,进而达到功能器件微区表征要求。
虽然利用XPS手段可以实现某些表面微区测量的目的,但基本还是局限于微米尺度,对于亚微米和纳米尺度的微区测量,还是存在较大的难度。如果样品是导体或者半导体样品,则选用俄歇电子能谱(AES)进行表面微区分析更为适合。
[1]黄惠忠.光电子成像电子能谱仪新一代DLD(延迟线检测器)系统[J].现代仪器,2006,(1):13-14.
[2]黄惠忠.表面化学分析[M].上海:华东理工大学出版社, 2007.
[3]余锦涛,郭占成,冯婷,等.X 射线光电子能谱在材料表面研究中的应用[J].表面技术,2014,43(1):119-124.
[4]刘福玉,李文玉.SMT生产中金手指污染的处理方法[J].电子工艺技术,2012,33(6):355-358.
Application of XPS parallel imaging technique to the microanalysis of material surface
X ü Jian,Hao Ping,Zhou Ying
(Shanghai Institute of Measurement and Testing Technology)
In this paper, the material microanalysis measurement on functional devices was investigated by using XPS analysis combined with parallel imaging technology. Three kinds of representative samples were selected and the surface microanalysis was effectively measured by reasonable design method, and good results were obtained.
XPS analysis; parallel imaging technique; surface microanalysis
上海市质量技术监督局科研项目(2015-03)
