6H-SiC衬底上AlGaN基垂直结构紫外LED的制备
2017-06-19刘明哲李鹏翀邓高强张源涛张宝林
刘明哲, 李鹏翀, 邓高强, 张源涛, 张宝林
(吉林大学电子科学与工程学院 集成光电子学国家重点联合实验室, 吉林 长春 130012)
6H-SiC衬底上AlGaN基垂直结构紫外LED的制备
刘明哲, 李鹏翀, 邓高强, 张源涛*, 张宝林
(吉林大学电子科学与工程学院 集成光电子学国家重点联合实验室, 吉林 长春 130012)
利用金属有机物化学气相沉积方法,在n型6H-SiC衬底上制备了15对Si掺杂Al0.19Ga0.81N/Al0.37Ga0.63N DBR,并采用低温AlN缓冲层有效抑制了DBR结构中裂纹的产生,得到了表面均方根粗糙度仅为0.4 nm且导电性能良好的n型DBR,其在369 nm处峰值反射率为68%,阻带宽度为10 nm。在获得导电DBR的基础上,进一步在n型6H-SiC衬底上构建了有、无DBR的垂直结构紫外LED。对比两者电致发光光谱,发现DBR结构的引入有效增强了LED紫外发光强度。
AlGaN; 紫外发光二极管; 分布式布拉格反射镜; 金属有机物化学气相沉积; 垂直结构
1 引 言
高亮度的紫外发光二极管(Ultraviolet light emitting diode, UV LED)在杀菌消毒、水/空气净化、紫外固化、高密度数据存储、生化探测、非视距通讯等领域有着广阔的应用前景,近年来受到越来越多的关注和重视[1-4]。AlxGa1-xN是直接带隙半导体材料,通过调节Al组分,禁带宽度在3.4~6.2 eV之间连续可调,波长覆盖范围涵盖大部分紫外波段(200~365 nm),并且具有良好化学稳定性和热稳定性,是制备UV LED的理想材料[5-6]。相比于传统的紫外光源—汞灯,采用Ⅲ族氮化物材料制备的UV LED具有高效节能、无汞环保、可靠耐用、体积小等优点[7]。
6H-SiC与AlN之间的晶格失配仅为1%,远小于α-Al2O3(蓝宝石)、Si与AlN之间的晶格失配度,两者分别为13%、19%。因此,在6H-SiC衬底上外延制备AlGaN基UV LED有利于改善外延层质量,提高器件内量子效率[8]。同时,由于n型6H-SiC衬底具有良好的电导性,可用于制备垂直结构(Vertical structure, VS) UV LED[9]。相较于传统的通过刻蚀台面将p、n电极置于同侧的水平结构LED,VS LED可以有效避免电流拥堵效应,提高有源区利用率[10]。此外,6H-SiC衬底具有良好的导热特性(热导率为4.9 W·cm-1·K-1),有利于器件散热。然而,6H-SiC禁带宽度仅为3.05 eV,会吸收紫外光,因此在6H-SiC衬底上制备的VS UV LED有必要在有源区与衬底之间制备可导电的分布式布拉格反射镜 (Distributed Bragg reflectors, DBR),以提高光提取效率[11]。
6H-SiC与AlGaN之间存在热失配,所以在生长结束后的降温过程中,AlGaN层内会产生张应力致使薄膜开裂。与此同时,构成DBR的不同铝组分AlGaN层之间的晶格失配以及制备n型导电结构时Si的掺杂会加剧外延层中张应力的产生,使制备无裂纹n-DBR变得更为困难[12-14]。而裂纹的出现会增强光在材料内部的散射和吸收,从而降低DBR的反射率[15]。为了解决6H-SiC衬底上外延DBR开裂的问题,Tao等人采用SiNx插入层的方法减少外延层中张应力的积累,成功制备出无裂纹的Al0.2Ga0.8N/GaN DBR[16]。Wang等人利用AlN/Al0.1Ga0.9N双缓冲层替代单一的Al0.1Ga0.9N缓冲层,同样在6H-SiC衬底上制备出无裂纹Al0.2Ga0.8N/GaN DBR[17]。值得注意的是,以上结果中各层材料均未掺杂,制备得到的DBR不具有导电特性,因而不能应用于垂直结构器件。在AlGaN基导电DBR方面,Liu等人在蓝宝石衬底上生长的Si掺杂GaN模板上生长n型Al0.12Ga0.88N/GaN DBR,但是由于蓝宝石衬底的绝缘特性,不能实现垂直结构器件的制备[18]。Ikeyama等人在n-GaN衬底上制备Si掺杂Al0.82-In0.18N/GaN DBR,得到具有高反射率和良好导电特性的DBR。但自支撑GaN衬底的价格十分昂贵,使得器件生产成本过高,不利于实用化[19]。
本文通过金属有机物化学气相沉积(Metal organic chemical vapour deposition, MOCVD)方法,在n型导电6H-SiC衬底上制备了Si掺杂Al0.19Ga0.81N/Al0.37Ga0.63N DBR,并利用低温AlN缓冲层抑制薄膜中裂纹的产生,得到了表面平整的导电DBR。在此基础上构建垂直结构紫外LED,通过引入DBR提高光提取效率,增强LED的发光强度。
2 实 验
实验所用外延设备是德国AIXTRON公司紧耦合喷淋头高温MOCVD系统(CCS 3×2″FT)。以氢气作为载气,三甲基镓(TMGa)和三甲基铝(TMAl)作为Ⅲ族源,氨气(NH3)作为Ⅴ族源,硅烷(SiH4)作为Si源,二茂镁(Cp2Mg)作为Mg源。先将n型6H-SiC衬底置于反应室内,在1 150 ℃下氢气气氛中处理5 min。之后,降温至1 100 ℃,在10 kPa压强下生长Si掺杂的Al0.6Ga0.4N(50 nm)/Al0.3Ga0.7N(50 nm)作为缓冲层,两层中Si的掺杂浓度分别为5×1018cm-3和2×1018cm-3。然后,在缓冲层之上生长15对Si掺杂浓度为1×1018cm-3的Al0.19Ga0.81N/Al0.37Ga0.63N DBR,其中Al0.19Ga0.81N、Al0.37Ga0.63N两层材料厚度分别为36 nm和38 nm。将该结构称为样品A,其结构示意图如图1(a)所示。基于样品A,我们制备了样品B,其结构示意图如图1(b)所示,即在6H-SiC衬底与Al0.6Ga0.4N/Al0.3Ga0.7N双缓冲层之间生长了50 nm Si掺杂浓度为1×1019cm-3的低温(800 ℃)AlN层。进一步,在获得的导电DBR基础上,制备了VS UV LED(样品D,结构示意图如图1(d)所示):以1 050 ℃下生长的200 nm n-Al0.2Ga0.8N作为电子注入层,100 nm未掺杂GaN(u-GaN)作为有源区,再在985 ℃下通过维持通入反应室的TMGa流量不变而逐渐降低TMAl流量生长50 nm Mg掺杂的极化诱导p型AlxGa1-xN作为空穴注入层,相较于固定铝组分的p-AlGaN极化诱导p型AlxGa1-xN可提高注入有源区的空穴浓度,并生长10 nm Mg重掺杂的GaN层以便p型一侧电极欧姆接触的获得。此外,为了对比,我们还制备了与样品D具有相同结构但无导电DBR结构的 VS UV LED(样品C),其结构如图1(c)所示。
利用紫外-可见光光谱分析系统(SHIMADZU, UV-1700)来测试6H-SiC衬底的透射光谱和DBR结构的反射光谱。采用光学显微镜(Olympus, BX51M)和原子力显微镜(Veeco, Demension Icon)对样品表面形貌进行表征。用Agilent B2902A源表对器件进行电学测试。器件的室温电致发光光谱通过光栅光谱仪(Zolix, Omni-λ5007)获得,薄膜的晶体质量通过高分辨率X射线衍射仪(Rigaku, Ultima Ⅳ)进行表征。

图1 器件结构示意图。(a) 样品A,不带有低温AlN缓冲层的15对n-DBR;(b) 样品B,带有低温AlN缓冲层的15对n-DBR;(c) 样品C,不带有导电DBR的垂直结构紫外LED;(d) 样品D,带有导电DBR的垂直结构紫外LED。
Fig.1 Epitaxial structure of the samples. (a) Sample A, 15-pair n-DBR without LT n-AlN buffer layer. (b) Sample B, 15-pair n-DBR with LT n-AlN buffer layer. (c) Sample C, VS UV LED without electrically conducting n-type DBR. (d) Sample D, VS UV LED with electrically conducting n-type DBR.
3 结果与讨论
图2所示为样品A和样品B表面的高倍光学显微镜照片。可以看到,密集的裂纹布满了样品A表面,而样品B则呈现出无裂纹的平整表面。因此,低温AlN缓冲层的引入可有效抑制6H-SiC衬底上制备的Si掺杂Al0.19Ga0.81N/Al0.37-Ga0.63N DBR中裂纹的产生。

图2 样品A(a)和样品B(b)表面的放大倍数为500倍的光学显微镜照片
Fig.2 Optical microscope images with 500 magnification of the surface of sample A(a) and sample B(b)
图3中插图所示为实验所用n型6H-SiC衬底的透射光谱,可以看到波长短于390 nm的光已被完全吸收而不能透过衬底出射。因此,在6H-SiC上制备的垂直结构紫外发光器件,为了抑制衬底对紫外光的吸收,提高器件出光效率,在有源区与衬底之间引入导电DBR是行之有效的方案。图3为样品A和样品B在光线垂直入射时的反射光谱。如图所示,样品B在369 nm处的峰值反射率为68%,阻带宽度为10 nm。由于样品B中低温AlN缓冲层成功抑制了DBR的开裂,减弱了光在材料内部的散射和吸收,所以样品B的峰值反射率相较于样品A提高了8%左右。通过计算,15对Al0.19Ga0.81N (36 nm) /Al0.37Ga0.63N (38 nm) DBR在369 nm处的反射率理论上可达到69%,接近样品B的反射率峰值,两者相差1%。如要得到更高反射率的DBR,必须增加DBR对数或是提高构成DBR的两层AlGaN材料之间的铝组分差,而这些方法都会增大结构内产生的张应力从而造成薄膜开裂,影响后续的器件制备。

图3 样品A和样品B的反射光谱,插图为实验所用n型6H-SiC衬底的透射光谱。
Fig.3In-situreflectance spectra for sample A and sample B. Inset shows the transmission spectrum of n-type 6H-SiC substrate.
为了表征制备得到的n-DBR的导电特性,我们用激光划片机将样品B切出直径为2 mm的圆盘,先用甲苯、丙酮、乙醇和蒸馏水依次对所得样品进行超声清洗,而后在6H-SiC一侧与n-DBR一侧分别蒸镀金属Ni电极和Al电极,再在500 ℃氮气氛围中进行退火处理。电极面积为1.5 mm2。在室温环境下测试得到样品的电流-电压(I-V)特性曲线,如图4(a)所示。制备得到的Si掺杂Al0.19-Ga0.81N/Al0.37Ga0.63N DBR具有较好的导电性能,在10 V电压下电流为190 mA,电流密度为12.7 A/cm2,电阻率为50 Ω·cm。该结构较高的电阻率来源于AlN缓冲层的引入和n-DBR较低的Si掺杂浓度。I-V曲线所呈现出的非线性特点,是由电荷在带阶处的积累对内建电场造成影响所致[16]。为了减少光在DBR表面的散射,同时提高生长在DBR之上的有源区的质量,制备得到的导电DBR需要具有光滑的表面。图4(b)所示为样品B表面的原子力显微镜图片。可以看到制备得到的n-DBR表面平整,均方根粗糙度仅为0.4 nm。
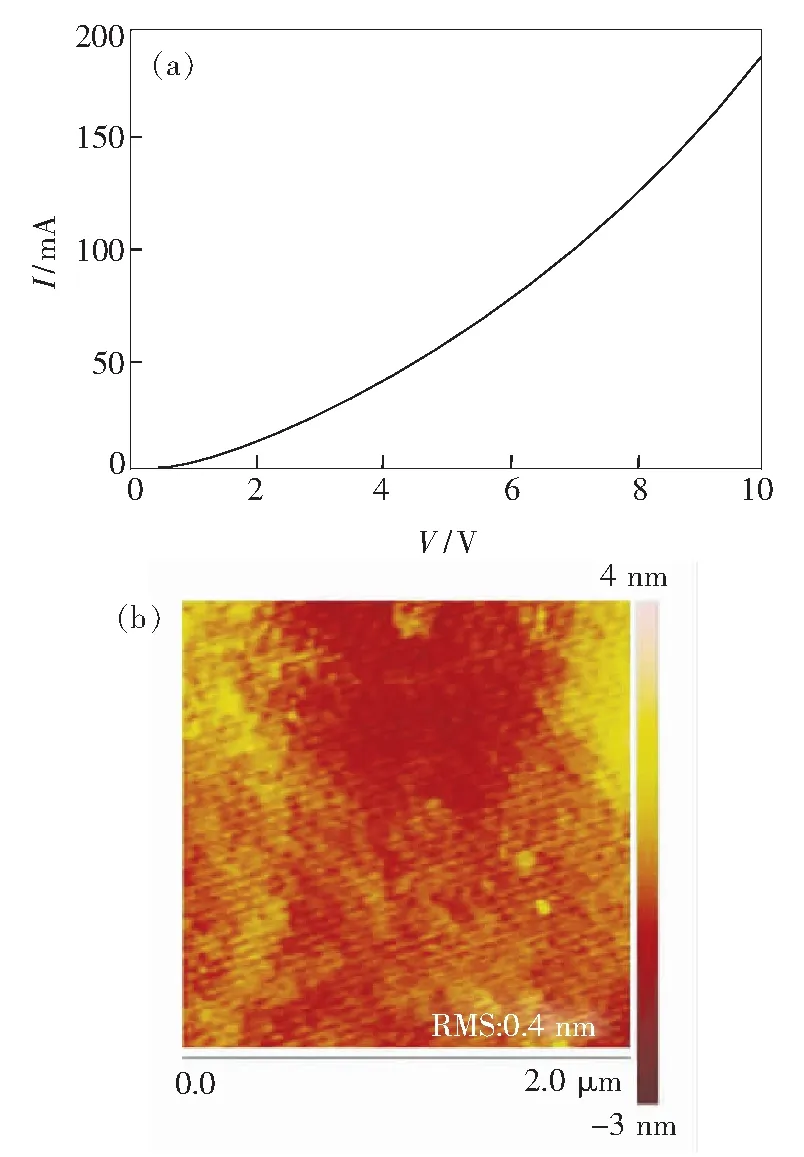
图4 样品B的室温下电流-电压特性曲线(a)和2 μm×2 μm尺寸原子力显微镜图像(b)
Fig.4 (a) RTI-Vcharacteristics and 2 μm×2 μmatomic force microscope image(b) of sample B
在获得表面平整、导电性能良好的DBR基础上,我们进一步在n型6H-SiC衬底上分别制备了 有、无导电DBR的以u-GaN作为有源区的双异质结VS UV LED,分别为样品C和样品D,结构如图1(c)、(d)所示。图5中插图为样品C和样品D在室温下的I-V特性曲线。从图中可以看到,制备得到的VS UV LED具有明显的整流特性。图5为样品C和样品D在室温50 mA注入电流下的电致发光光谱,测试垂直方向出射的光且保持器件与光谱仪入射狭缝之间的距离不变。 可以清晰地看到两个样品在368 nm附近有一个发光峰,我们认为该发光峰来源于GaN的禁带边发光。由于量子限制斯塔克效应的影响,发光波长相较于365 nm产生了红移。在430 nm 到600 nm处有一个很宽的发光峰, 来源于GaN材料的缺陷发光[20]。通过图5可以得出,样品D与样品C的发光峰积分强度比约为1.7,表明导电DBR的引入可以显著提高垂直结构LED的发光强度。

图5 室温下样品C和样品D在注入电流为50 mA时的电致发光光谱,插图为样品C和样品D的I-V特性曲线。
Fig.5 RT EL spectra of sample C and sample D under 50 mA forward current.Inset showsI-Vcharacteristics of sample C and sample D.
为了表征有源区的晶体质量,我们测试得到样品C和样品D中u-GaN层的X射线(002)面和(102)面的摇摆曲线,如图6所示。通过对比发现,从样品C到样品D,GaN薄膜X射线(002)面的摇摆曲线半峰宽由387 arcsec下降至227 arcsec,(102)面的摇摆曲线半峰宽由539 arcsec下降至507 arcsec。GaN层中螺位错密度和刃位错密度可由以下公式得出:
(1)
(2)
(3)


图6 样品C和样品D中u-GaN层的 (002)面(a)和(102)面(b)的XRD摇摆曲线
Fig.6 X-ray rocking curves of (002) (a) and (102) (b) diffractions for u-GaN films in sample C and sample D
GaN作为有源区,其内量子效率与位错密度的关系可通过以下公式[21-22]得出:
(4)
(5)
(6)
(7)
式 (4) 中,NC、NV分别为导带和价带的有效态密度,在温度为300 K时,NC=2.3×1018cm-3,NV= 4.6×1019cm-3;k为波尔兹曼常数;T为温度;EC、EV分别为导带底和价带顶能级位置(禁带宽度EG=EC-EV);ED为位错有关能级(ED=EV+ 0.4 eV)。电子(空穴)的载流子寿命τn(τp)可由式 (5) 和 (6) 计算得到,其中Dn(Dp) 为电子(空穴)扩散系数(Dn= 15 cm2/s,Dp= 2 cm2/s);Vn(Vp) 为电子(空穴)热运动速率(Vn=2.6×107cm/s,Vp=9.4×106cm/s);a为GaN晶格常数(a=0.318 9 nm);S为位错芯上的电活性位点分数(Fraction of electrically active sites on the dislocation core,S=0.5)。再由式 (7) 可计算得到内量子效率η,其中B为双分子复合速率常数(B=2.4×10-11cm3/s)[23];n=n0+ Δn,p=p0+ Δn,n0、p0为背景载流子浓度,n0= 6.0×1016cm-3;Δn为非平衡载流子浓度。通过式 (4)~(7) 可得出样品C、D中有源区u-GaN层内量子效率与注入非平衡载流子浓度之间的关系,如图7所示。

图7 样品C和样品D中u-GaN层内量子效率与非平衡载流子浓度之间的关系
Fig.7 Internal quantum efficiencyvs. nonequilibrium carrier concentration calculated for u-GaN films in sample C and sample D
从图7可以看出,样品D中u-GaN层的内量子效率要高于样品C。由此可知,引入DBR可以提高后续生长的薄膜材料的晶体质量,进而可以提高器件内量子效率。可见,带有导电DBR的VS UV LED发光强度的提高,不仅与DBR可反射射向衬底方向的紫外光有关,还与有源区晶体质量的改善提高了器件的内量子效率有关。
4 结 论
在n型6H-SiC衬底上制备了15对Si掺杂Al0.19Ga0.81N/Al0.37Ga0.63N导电DBR,通过低温AlN缓冲层成功抑制了薄膜开裂,得到了表面均方根粗糙度为0.4 nm、在389 nm处峰值反射率为68%、阻带宽度为10 nm且导电性能良好的DBR。在此基础上,进一步在n型6H-SiC衬底上制备了有、无导电DBR的垂直结构UV LED,比较两者电致发光光谱,发现DBR可有效提高器件的发光强度。XRD测试表明,引入DBR还可以提高有源区GaN层的晶体质量,有利于增强器件的内量子效率。带有n-DBR的VS UV LED紫外发光峰强度的提高,不仅与DBR对光的反射有关,还与有源区晶体质量的提高有关。
[1] KHAN A, BALAKRISHNAN K, KATONA T. Ultraviolet light-emitting diodes based on group three nitrides [J].Nat.Photon., 2008, 2(2):77-84.
[2] MOUDAKIR T, GAUTIER S, SURESH S,etal.. Suppression of crack generation in AlGaN/GaN distributed Bragg reflectors grown by MOVPE [J].J.Cryst.Growth, 2013, 370:12-15.
[3] 王军喜, 闫建昌, 郭亚楠, 等. 氮化物深紫外LED研究新进展 [J]. 中国科学: 物理学 力学 天文学, 2015, 45(6):067303-1-20. WANG J X, YAN J C, GUO Y N,etal.. Recent progress of research on III-nitride deep ultraviolet light-emitting diode [J].Sci.SinicaPhys.Mech.Astron., 2015, 45(6):067303-1-20. (in Chinese)
[4] 陈航洋, 刘达艺, 李金钗, 等. 高Al组分Ⅲ族氮化物结构材料及其在深紫外LED应用的进展 [J]. 物理学进展, 2013, 33(2):43-56. CHEN H Y, LIU D Y, LI J C,etal.. Development of high Al content structural III nitrides and their applications in deep UV-LED [J].Prog.Phys., 2013, 33(2):43-56. (in Chinese)
[5] LIU X T, LI D B, SUN X J,etal.. Stress-induced in situ epitaxial lateral overgrowth of high-quality GaN [J].CrystEngComm, 2014, 16(34):8058-8063.
[6] 路慧敏, 陈根祥. 极化效应对InGaN/GaN多量子阱结构光电特性的影响 [J]. 发光学报, 2011, 32(3):266-271. LU H M, CHEN G X. Influence of polarization effect on optoelectronic properties of InGaN/GaN multiple quantum well [J].Chin.J.Lumin., 2011, 32(3):266-271. (in Chinese)
[7] LI J M, LIU Z, LIU Z Q,etal.. Advances and prospects in nitrides based light-emitting-diodes [J].J.Semicond., 2016, 37(6):061001-1-14.
[8] HUANG Z, ZHANG Y T, ZHAO B J,etal.. Effects of AlN buffer on the physical properties of GaN films grown on 6H-SiC substrates [J].J.Mater.Sci.:Mater.Electron., 2016, 27(2):1738-1744.
[9] GUO H, ZHAO Y Q, ZHANG Y M,etal.. Influence of n-type doping on the oxidation rate in n-type 6H-SiC [J].J.Semicond., 2015, 36(1):013006-1-5.
[10] ADIVARAHAN V, HEIDARI A, ZHANG B. Vertical injection thin film deep ultraviolet light emitting diodes with AlGaN multiple-quantum wells active region [J].Appl.Phys.Express, 2009, 2(9):092102.
[11] SHI ZH F, XIA X C, YIN W,etal.. Dominant ultraviolet electroluminescence from p-ZnO∶as/n-SiC(6H) heterojunction light-emitting diodes [J].Appl.Phys.Lett., 2012, 100(10):101112-1-4.
[12] CANTU P, WU F, WALTEREIT P,etal.. Role of inclined threading dislocations in stress relaxation in mismatched layers [J].J.Appl.Phys., 2005, 97(10):103534-1-10.
[13] ACORD J D, MANNING I C, WENG X J,etal..Insitumeasurement of stress generation arising from dislocation inclination in AlxGa1-xN∶Si thin films [J].Appl.Phys.Lett., 2008, 93(11):111910-1-3.
[14] MANNING I C, WENG X, ACORD J D,etal.. Tensile stress generation and dislocation reduction in Si-doped AlxGa1-xN films [J].J.Appl.Phys., 2009, 106(2):023506-1-7.
[15] HUANG G S, LU T C, YAO H H,etal.. Crack-free GaN/AlN distributed Bragg reflectors incorporated with GaN/AlN superlattices grown by metalorganic chemical vapor deposition [J].Appl.Phys.Lett., 2006, 88(6):061904-1-3.
[16] TAO P C, LIANG H W, WANG D S,etal.. Crack-free AlGaN/GaN distributed Bragg reflectors synthesized by insertion of a thin SiNxinterlayer grown on 6H-SiC substrate by metal-organic chemical vapor deposition [J].Mater.Sci.Semicond.Process., 2014, 27:841-845.
[17] WANG D S, LIANG H W, TAO P C,etal.. Crack-free ultraviolet AlGaN/GaN distributed Bragg reflectors grown by MOVPE on 6H-SiC (0001) [J].Superl.Microstruct., 2014, 70:54-60.
[18] LIU Y S, HAQ A F M S, KAO T T,etal.. Electrically conductingn-type AlGaN/GaN distributed Bragg reflectors grown by metalorganic chemical vapor deposition [J].J.Cryst.Growth, 2016, 443:81-84.
[19] IKEYAMA K, KOZUKA Y, MATSUI K,etal.. Room-temperature continuous-wave operation of GaN-based vertical-cavity surface-emitting lasers with n-type conducting AlInN/GaN distributed Bragg reflectors [J].Appl.Phys.Express, 2016, 9(10):102101-1-4.
[20] 宿世臣, 吕有明. ZnMgO/n-ZnO/ZnMgO/p-GaN异质结LED的紫外电致发光 [J]. 发光学报, 2011, 32(8):821-824. SU S C, LV Y M. Ultraviolet electroluminescence of ZnMgO/n-ZnO/ZnMgO/p-GaN heterojunction light emitting diode [J].Chin.J.Lumin., 2011, 32(8):821-824. (in Chinese)
[21] KARPOV S Y, MAKAROV Y N. Dislocation effect on light emission efficiency in gallium nitride [J].Appl.Phys.Lett., 2002, 81(25):4721-4723.
[22] KNEISSL M, KOLBE T, CHUA C,etal.. Advances in group III-nitride-based deep UV light-emitting diode technology [J].Semicond.Sci.Technol., 2011, 26(1):014036-1-6.
[23] IM J S, MORITZ A, STEUBER F,etal.. Radiative carrier lifetime, momentum matrix element, and hole effective mass in GaN [J].Appl.Phys.Lett., 1997, 70(5):631-633.

刘明哲 (1991-),男,山东淄博人,硕士研究生, 2014年于吉林大学获得学士学位,主要从事基于Ⅲ族氮化物材料的紫外LED的研究。

E-mail: mingzhe_liu@foxmail.com张源涛 (1976-),男,吉林长春人,教授,博士生导师,2005年于吉林大学获得博士学位,主要从事GaN基宽禁带半导体材料与器件的研究。
E-mail: zhangyt@jlu.edu.cn
Fabrication of Vertical Structure Ultraviolet LED on 6H-SiC Substrate
LIU Ming-zhe, LI Peng-chong, DENG Gao-qiang, ZHANG Yuan-tao*, ZHANG Bao-lin
(StateKeyLaboratoryonIntegratedOptoelectronics,CollegeofElectronicScienceandEngineering,JilinUniversity,Changchun130012,China)
Silicon-doped Al0.19Ga0.81N/Al0.37Ga0.63N DBRs were grown on n-type 6H-SiC substrates by metal organic chemical vapor deposition(MOCVD). To suppress the generation of cracks, a low-temperature AlN pre-deposition layer on 6H-SiC(0001) substrate was used as buffer. A smooth-surface 15-pair electrically conducting DBR with a reflectance of 68% at 369 nm was obtained. The stop-band bandwidth and RMS value of DBR are 10 nm and 0.4 nm, respectively. Furthermore, the vertical structure UV LEDs with and without n-DBR on 6H-SiC substrate were fabricated. By comparing EL spectra, it is shown that the introduction of DBR structure can effectively improve the UV emission.
AlGaN; ultraviolet LED; distributed Bragg reflectors; metal organic chemical vapor deposition; vertical structure
1000-7032(2017)06-0753-07
2017-01-03;
2017-02-19
国家重点研发计划(2016YFB0400103);吉林省科技发展计划(20130204032GX,20150519004JH,20160101309JC);教育部新世纪人才计划(NCET13-0254)资助项目 Supported by National Key R&D Projects (2016YFB0400103); Science and Technology Development Plan of Jilin Province (20130204032GX,20150519004JH,20160101309JC); New Century Talent Program of Education Ministry (NCET13-0254)
TN383; TH691.9
A
10.3788/fgxb20173806.0753
*CorrespondingAuthor,E-mail:zhangyt@jlu.edu.cn
