V形坑尺寸对硅衬底InGaN/AlGaN近紫外LED光电性能的影响
2017-06-19聂晓辉王小兰莫春兰张建立刘军林
聂晓辉, 王小兰, 莫春兰, 张建立, 潘 拴, 刘军林
(南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047)
V形坑尺寸对硅衬底InGaN/AlGaN近紫外LED光电性能的影响
聂晓辉, 王小兰*, 莫春兰, 张建立, 潘 拴, 刘军林
(南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047)
使用MOCVD在图形化Si衬底上生长了InGaN/AlGaN近紫外LED,通过改变低温GaN插入层的厚度调控V形坑尺寸,系统地研究了V形坑尺寸对InGaN/AlGaN近紫外LED(395 nm)光电性能的影响。结果表明,低温GaN插入层促进了V形坑的形成,并且V形坑尺寸随着插入层厚度的增加而增大。在电学性能方面,随着V形坑尺寸的增大,-5 V下的漏电流从5.2×10-4μA增加至6.5×102μA;350 mA下正向电压先从3.55 V降至3.44 V,然后升高至3.60 V。在光学性能方面,随着V形坑尺寸的增大,35 A/cm2下的归一化外量子效率先从0.07提高至最大值1,然后衰退至0.53。对V形坑尺寸影响InGaN/AlGaN近紫外LED光电性能的物理机理进行了分析,结果表明:InGaN/AlGaN近紫外LED的光电性能与V形坑尺寸密切相关,最佳的V形坑尺寸为120~190 nm,尺寸太大或者太小都会降低器件性能。
硅衬底; 近紫外LED; 低温GaN插入层; V形坑尺寸; 光电性能
1 引 言
尽管InGaN/GaN结构的可见光LED是当前研究的热点,但是由于紫外光LED在固化、防伪检测、杀菌等领域拥有广阔的应用前景,因此吸引了越来越多研究者将其作为研究方向[1-2]。由于GaN薄膜与异质外延衬底(如硅衬底、蓝宝石衬底等)之间存在巨大的晶格失配和热失配[3-4],导致LED外延生长过程中产生的位错密度高达108~1010/cm2[5]。虽然有如此高的位错密度,但是相对于AlGaInP体系,AlGaInN体系LED仍能保持较高的发光效率。目前,针对这一现象形成了局域态屏蔽位错理论和V形坑屏蔽位错理论两种主要的观点,但V形坑对LED光电性能的影响,一直存在争议。Le等人通过研究发现,载流子容易被V形坑捕获并泄漏至与其相连的线位错非辐射复合中心,降低了LED的发光效率,认为减小V形坑尺寸、降低V形坑密度对于获得高性能的LED器件非常关键[6-7]。Hangleiter等通过研究发现在材料生长过程中,V形坑侧壁会形成侧壁量子阱,这些侧壁量子阱相对于平台区域的量子阱厚度更薄,禁带宽度更大,因而能够形成势垒有效阻挡载流子进入V形坑,从而起到屏蔽位错、提高辐射复合效率的作用[8]。Tomiya等使用三维原子探针和高角环形暗场透射电子成像技术证实了侧壁量子阱的存在并测量了其厚度和In组分,认为V形坑有利于提高LED发光效率[9]。Okada等通过改变V形坑尺寸调控侧壁量子阱势垒高度,研究了V形坑尺寸对LED内量子效率的影响并得出V形坑的最佳尺寸[10]。作者所在单位的前期研究结果表明,屏蔽位错只是V形坑的一个作用,另外一个非常重要的作用是提高量子阱的空穴注入能力,从而显著提高LED的发光效率,降低LED的工作电压[11-14]。
V形坑对InGaN/GaN结构可见光LED光电性能的影响已有大量研究,但是V形坑的形成,尤其是V形坑尺寸对InGaN/AlGaN结构近紫外LED光电性能的影响研究还很少。特别地,有报道指出由于近紫外LED量子阱中In组分相对于可见光LED更少,其发光效率更容易受到位错的影响[15-16]。因此,研究V形坑的形成和尺寸对近紫外LED光电性能的影响,对于提高近紫外LED的发光效率和器件的稳定性具有积极的意义。本文通过改变低温GaN插入层的厚度调控V形坑尺寸,系统地研究了V形坑尺寸对InGaN/AlGaN近紫外LED光电性能的影响。使用二次离子质谱仪(SIMS)、原子力显微镜(AFM)、扫描电子显微镜(SEM)、LED电致发光测试系统等对材料和器件的性能进行了表征。研究结果表明,InGaN/AlGaN近紫外LED的光电性能与V形坑尺寸密切相关,最佳的V形坑尺寸为120~190 nm,尺寸太大或者太小都会降低器件性能。
2 实 验
实验所用的样品均使用Thomas Swan MOCVD外延生长系统在图形化Si(111)衬底上制备,设计芯片尺寸为1 mm × 1 mm。器件的外延结构如图1所示,自下向上分别为Si(111)衬底、130 nm AlN过渡层、2.4 μm n型GaN层、低温GaN插入层、9个周期InGaN/AlGaN多量子阱(阱3 nm,垒10 nm)、25 nm AlGaN电子阻挡层和100 nm GaN接触层。在A、B、C、D 4个样品中,低温GaN插入层厚度分别为0,150,300,400 nm,除插入层厚度外,其余条件保持一致。标准LED器件的制备过程已有报道,器件结构为垂直结构[17]。
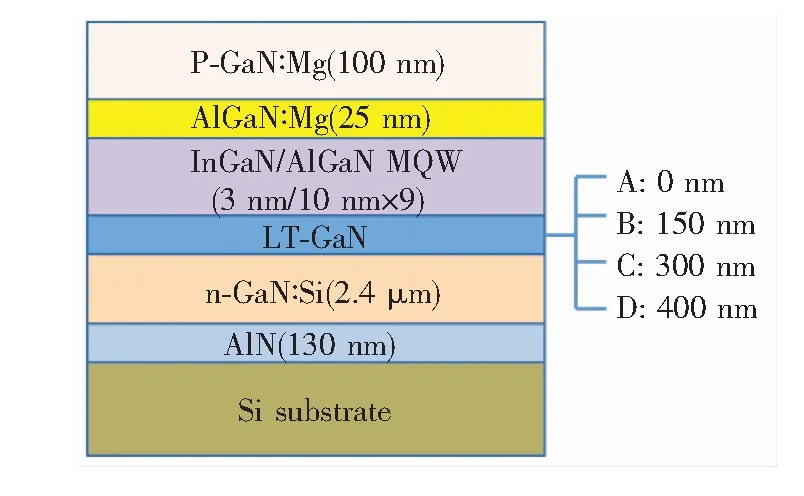
图1 InGaN/AlGaN近紫外LED结构示意图
3 结果与讨论
使用Keithley 2635A恒流源测试4个样品的反向I-V曲线,结果如图2所示。从图中可以看出:反向漏电流均随着反向偏压的增加而增大,并且随着低温GaN插入层厚度的增加,呈数量级递增趋势。在-5 V下,样品A、B、C、D的反向漏电流分别为5.2×10-4,5.7×10-3,1.2×10-2,6.5×102μA。4个样品唯一的差别是低温GaN插入层厚度导致的V形坑尺寸的不同。为探究反向漏电流与V形坑尺寸之间的关系,解释各个样品反向漏电流的差异,我们对4个样品的形貌特征进行了表征。
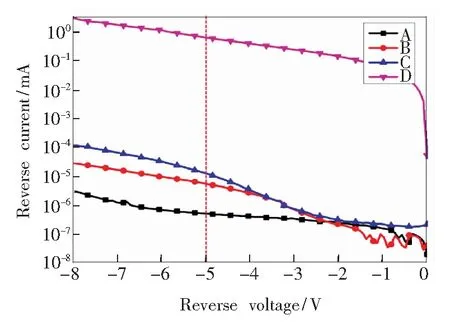
图2 样品 A、B、C、D的反向I-V曲线。Fig.2 ReverseI-Vcurves of sample A,B,C and D,respectively.

图3 样品A(a)、B(b)、C(c)、D(d)的外延层表面AFM图片。
由于本次实验设置单一变量为低温GaN插入层厚度导致的不同尺寸的V形坑,因此,为了研究不同尺寸的V形坑对外延层质量的影响,使用Dimension Edge原子力显微镜(AFM)对4个样品的外延层表面形貌进行表征,扫描范围为2 μm × 2 μm,扫描模式为轻敲模式,结果如图3所示。从AFM结果可以看出,样品A、B、C 的表面较为平整,均可观察到不同程度的二维台阶流生长模式,说明外延层表面生长质量较高,V形坑已经被合并填平。而在样品D的表面观察到明显的孔洞,可能是由于V形坑尺寸过大导致无法被合并填平,外延层的表面完整性受到较大的破坏。这个结果说明必须合理控制V形坑尺寸,否则V形坑尺寸过大将会严重影响外延层的结构质量。
为探究具有不同厚度低温GaN插入层的样品中V形坑结构特征的差异,我们使用CAMECA IMS 7f二次离子质谱仪(SIMS),利用离子溅射技术将4个样品的p型层溅射剥离至露出量子阱表面[18],使用HITACHI S8010扫描电子显微镜(SEM)对V形坑的结构进行表征。
图4(a)~(d)展示了4个样品量子阱表面的SEM图片。当低温GaN插入层厚度为0 nm时,量子阱表面光滑平整;当低温GaN插入层厚度增加至150,300,400 nm时,在量子阱表面观察到轮廓清晰的六边形凹坑。图4(e)为样品D的断面SEM图片,可以看出,六边形凹坑的两个正对面之间的夹角约为56°,基于这些特殊的结构特征可以判断这些六边形凹坑即是V形坑。V形坑随着低温GaN插入层的生长而出现说明使用低温GaN插入层可以促进V形坑的形成,这一结果与文献报道一致[19]。仔细观察SEM图片可以发现:(1)V形坑随机分布在量子阱的表面,其尺寸大小既不相同也不连续变化,而是呈现出离散分布的特点;(2)对比各个样品发现,V形坑尺寸随着低温GaN插入层厚度的增加而增大;(3)除样品A外,其余每个样品均可观察到至少2组V形坑,一组尺寸较小(用Ⅰ表示),一组尺寸较大(用Ⅱ表示)。图4(f)清晰展示了样品B、C、D中不同尺寸V形坑的分布统计结果。根据统计结果和V形坑两对面之间的夹角,我们分别计算了每个样品中Ⅰ组和Ⅱ组V形坑的平均尺寸、平均深度以及密度,结果见表1。
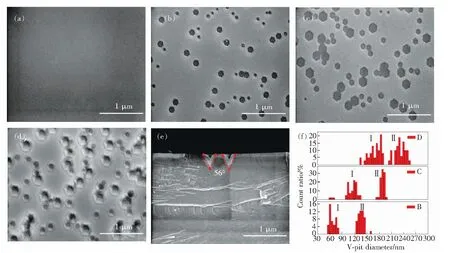
图4 3样品A(a)、B(b)、C(c)、D(d)的量子阱表面SEM图片,样品D的断面SEM图片(e),以及样品B、C、D的V形坑尺寸分布统计图(f)。
Fig.4 SEM images of MQWs surface of sample A(a), B (b), C (c), D(d), cross-sectional SEM image of sample D(e), and statistical charts of V-pit size distribution of sample B, C, D(f), respectively.
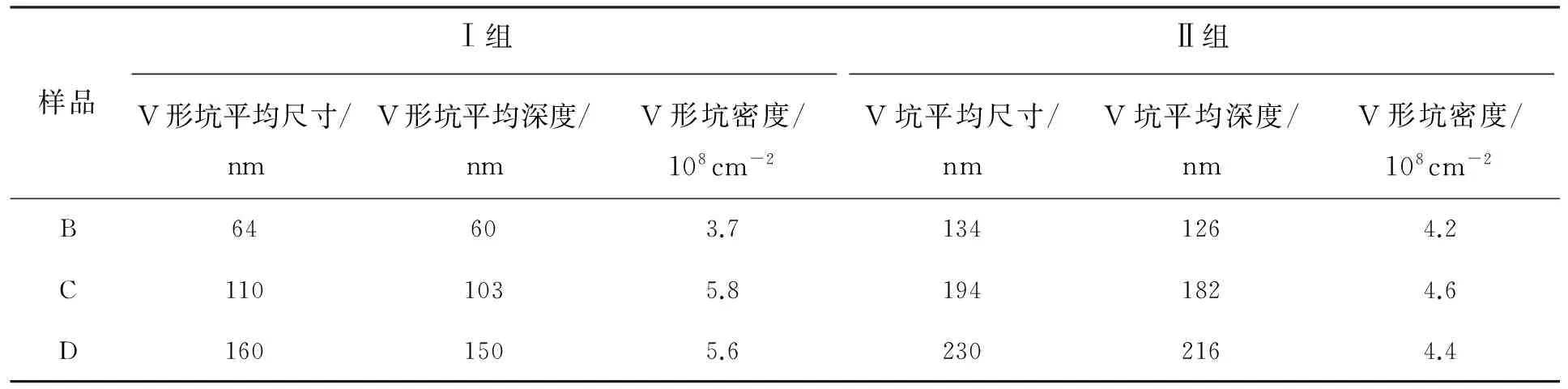
表1 样品B、C、D中Ⅰ、Ⅱ组V形坑的平均尺寸、平均深度和密度
从表1可以看出,随着低温GaN插入层厚度的增加,样品B、C、D中Ⅰ、Ⅱ两组V形坑的平均尺寸、平均深度均随之显著增大。将每个样品中Ⅱ组V形坑的平均深度与量子阱总厚度(约117 nm)对比发现,每个样品中Ⅱ组V形坑的平均深度均超过量子阱总厚度,说明Ⅱ组V形坑均形成于低温GaN插入层。类似地,样品B、C中Ⅰ组V形坑的平均深度均小于量子阱的总厚度,说明两个样品中Ⅰ组V形坑是在量子阱中形成的。而样品D中Ⅰ组V形坑平均深度超过量子阱总厚度但小于Ⅱ组V形坑的平均深度,说明这组V形坑主要形成于低温GaN插入层中靠近量子阱的位置。在3个样品中,Ⅱ组V形坑的密度基本一致,但Ⅰ组V形坑的密度随着低温GaN插入层厚度的增加而显著增大。原因可能是随着低温GaN插入层厚度的增加,不断增大的累积应力在量子阱中或者插入层靠近量子阱的位置释放产生的位错不断增多,诱导形成的V形坑密度显著增大[20]。综合反向I-V结果、AFM和SEM测试结果,对比样品A和B可以看出,V形坑的形成使反向漏电流显著增大;对比样品B、C、D可以看出,随着V形坑尺寸和密度的增大,反向漏电流呈数量级增加。因此可以得出结论,V形坑的形成严重影响了LED反向电学性能,反向漏电流随着V形坑尺寸和密度的增大而增大,这一结果与文献报道一致[6-7]。需要指出的是,样品D的反向漏电流相对于其他样品高出几个数量级,导致这一反常现象的原因可能是V形坑尺寸过大,外延层表面受到破坏导致结构质量下降,进而严重影响了器件的电学性能。
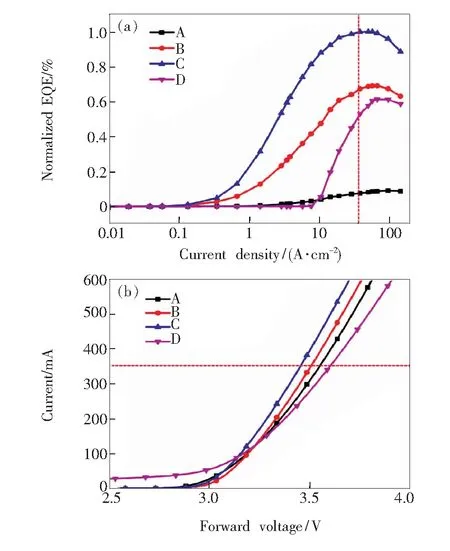
图5 样品A、B、C、D的归一化外量子效率曲线(a)和正向I-V曲线(b)。
Fig.5 Normalized EQE curves (a) and forwardI-Vcurves (b) of sample A,B, C and D, respectively.
LED电致发光测试系统由CAS140CT光谱仪和ISP250-211积分球以及Keithley 2635A恒流源组成。图5给出了样品的归一化外量子效率(采用样品C的EQE最大值归一化)随注入电流密度的变化曲线和正向I-V曲线。从图5(a)可以看出,与样品A相比,样品B在整个电流密度下的归一化EQE显著提高,35 A/cm2下的归一化EQE从0.07提高至0.67。随着V形坑尺寸的增大,35 A/cm2下的样品C的归一化EQE达到最大值1。但当V形坑尺寸进一步增大时,样品D的发光效率大幅下降,35 A/cm2下的归一化EQE仅为0.53。从图5(b)可以看出,随着V形坑尺寸的增大,样品A、B、C的正向电压依次减小。在350 mA下,样品A、B、C的正向电压分别为3.55,3.50,3.44 V。但是当V形坑尺寸进一步增大时,样品D的正向电压反而增加到3.60 V。
综合归一化EQE和正向I-V结果可以看出,V形坑尺寸大小对InGaN/AlGaN近紫外LED的光电性能产生了显著影响。相对于没有V形坑的样品A,样品B、C、D的归一化EQE显著提高,说明V形坑的形成有效屏蔽了位错,抑制了非辐射复合,提高了辐射复合效率;并且除样品D外,正向电压连续降低,说明V形坑的形成显著提高了量子阱的空穴注入能力。可见,含有V形坑结构的LED具有更高的发光效率和更低的工作电压。对比含有V形坑的样品B、C、D,样品C的光电性能提升至最佳值,但样品D的光电性能却出现明显的衰退。为更好地对比样品B、C、D的归一化EQE和正向I-V的结果,分析V形坑尺寸增大对LED光电性能的影响,下面结合图6进行讨论。
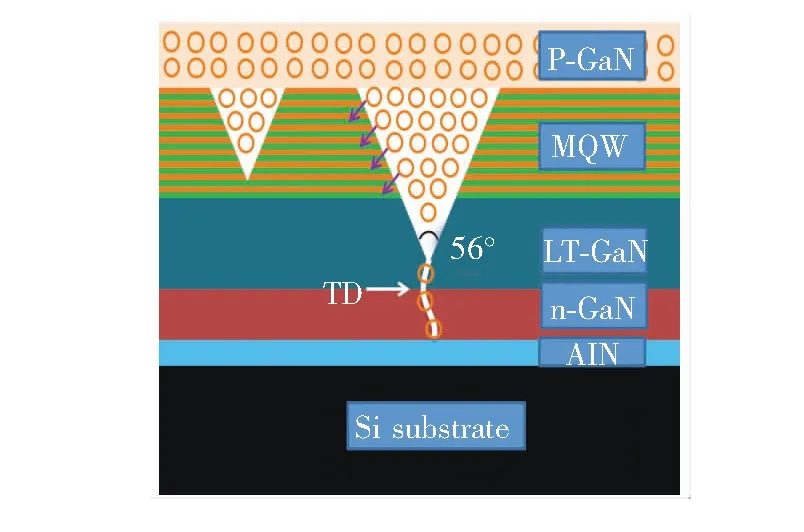
图6 InGaN/AlGaN近紫外LED不同尺寸V形坑及其侧壁量子阱空穴注入示意图
Fig.6 Schematic side-view illustration of V-pits with different size and related side-wall MQW hole injcetion in InGaN/AlGaN near-UV LED
图6为不同尺寸V形坑及其侧壁量子阱空穴注入示意图。由上文分析可知,除样品A外,每个样品至少含有两组V形坑,并且由于V形坑产生位置和生长时间的不同,Ⅰ、Ⅱ两组V形坑的尺寸存在显著差异。研究表明,尽管V形坑可以形成侧壁量子阱,具有屏蔽位错、抑制非辐射复合和增强空穴注入的作用,但是侧壁量子阱屏蔽位错和空穴注入的能力与V形坑尺寸大小密切相关[10-12, 21]。因此,要想研究V形坑尺寸增大对InGaN/AlGaN近紫外LED光电性能的影响,就必须把两组尺寸不同的V形坑分别讨论。
当V形坑尺寸太小时,对LED光电性能的提升有限,原因可能有:(1)V形坑尺寸太小,其侧壁量子阱的势垒较低,不足以提供有效的势垒屏蔽位错[10];(2)V形坑尺寸越小,其侧壁量子阱空穴注入能力越弱[12];(3)V形坑尺寸太小,其边界与位错中心的距离较短,载流子被位错捕获的几率较大[22]。根据图4(f)中V形坑尺寸分布的统计结果和图6可以推断,样品B中Ⅰ组V形坑尺寸太小(50~80 nm),因而对InGaN/AlGaN近紫外LED的光电性能提升有限;而Ⅱ组V形坑的尺寸相对较大(120~150 nm),因此侧壁量子阱势垒较高,空穴注入能力较强,同时V形坑边界到位错中心的距离较大,对于LED光电性能的提升有明显的促进作用。样品B中Ⅰ、Ⅱ两组V形坑的综合作用效果使得其光电性能相对于样品A得到明显提升。与样品B相比,样品C中Ⅰ、Ⅱ两组V形坑尺寸同时增大,因此其屏蔽位错能力、空穴注入能力进一步增强,并且V形坑边界离位错中心的距离增大,降低了位错中心捕获载流子的几率,从而使InGaN/AlGaN近紫外LED的光电性达到最佳值。
当V形坑尺寸太大时,LED的光电性能随之显著衰退,原因可能有:(1)V形坑尺寸太大,导致量子阱有效发光面积减小,发光效率降低;(2)V形坑尺寸太大,导致其无法被合并填平,外延层结构质量下降,光电性能显著恶化。基于以上认识,样品D中Ⅰ组V形坑的尺寸介于样品C中两组V形坑尺寸之间(120~190 nm),有较高的屏蔽位错、空穴注入的能力,有利于InGaN/AlGaN近紫外LED光电性能的提升;但是由于Ⅱ组V形坑尺寸太大(200~250 nm),量子阱有效发光面积减小,并且V形坑无法被有效合并填平,因此器件出现严重的漏电行为,归一化EQE显著下降,正向电压明显升高,综合光电性能大幅衰退。这一结果表明,V形坑尺寸对InGaN/AlGaN近紫外LED的光电性能有严重影响,最佳的V形坑尺寸为120~190 nm,尺寸太大或太小都对器件的性能不利。
4 结 论
采用MOCVD生长了InGaN/AlGaN近紫外LED,并通过改变低温GaN插入层厚度调控V形坑尺寸,系统地研究了V形坑尺寸对InGaN/AlGaN近紫外LED光电性能的影响。结果表明,V形坑尺寸在一定范围内具有屏蔽位错、抑制非辐射复合、增强空穴注入的作用,光学性能和正向电学性能随着V形坑尺寸的增大而提高。在35 A/cm2下,当没有V形坑时,归一化EQE值仅为0.07;随着V形坑的形成和尺寸增大,归一化EQE值分别增至0.67和最大值1。在350 mA下,随着V形坑的形成和尺寸增大,正向电压从3.55 V降至3.50 V和3.44 V。但当V形坑尺寸超过一定限度后,由于量子阱的有效发光面积减小,并且V形坑难以被合并填平,外延层结构质量下降,导致器件光学性能和正向电学性能随着V形坑尺寸的增大而衰退。35 A/cm2下的归一化EQE降至0.53,350 mA下的正向电压增至3.60 V。反向漏电流随着V形坑尺寸和密度增加而单调衰退,-5 V下的漏电流分别为5.2×10-4,5.7×10-3,1.2×10-2,6.5×102μA。综上所述,InGaN/AlGaN近紫外LED的光电性能与V形坑尺寸密切相关,最佳的V形坑尺寸为120~190 nm,尺寸过大或者过小都会降低器件性能。
[1] KHAN A, BALAKRISHNAN K, KATONA T. Ultraviolet light-emitting diodes based on group three nitrides [J].Nat.Photon., 2008, 2(2):77-84.
[2] TAMULAITIS G. Ultraviolet light emitting diodes [J].Lith.J.Phys., 2011, 51(3):177-193.
[3] KONG J, FENG M X, CAI J,etal.. GaN grown on nano-patterned sapphire substrates [J].J.Semicond., 2015, 36(4):26-29.
[4] ZHAO D M, ZHAO D G, JIANG D S,etal.. Impact of GaN transition layers in the growth of GaN epitaxial layer on silicon [J].J.Semicond., 2015, 36(6):21-24.
[5] LESTER S D, PONCE F A, CRAFORD M G,etal.. High dislocation densities in high efficiency GaN-based light-emitting diodes [J].Appl.Phys.Lett.,1995, 66(10):1249-1251.
[6] LE L C, ZHAO D G, JIANG D S,etal.. Carriers capturing of V-defect and its effect on leakage current and electroluminescence in InGaN-based light-emitting diodes [J].Appl.Phys.Lett., 2012, 101(25):252110-1-4.
[7] LE L C, ZHAO D G, JIANG D S,etal.. Effect of V-defects on the performance deterioration of InGaN/GaN multiple-quantum-well light-emitting diodes with varying barrier layer thickness [J].J.Appl.Phys., 2013, 114(14):143706-1-5.
[8] HANGLEITER A, HITZEL F, NETZEL C,etal.. Suppression of nonradiative recombination by V-shaped pits in GaInN/GaN quantum wells produces a large increase in the light emission efficiency[J].Phys.Rev.Lett., 2005, 95(12):127402-1-4.
[9] TOMIYA S, KANITANI Y, TANAKA S,etal.. Atomic scale characterization of GaInN/GaN multiple quantum wells in V-shaped pits [J].Appl.Phys.Lett., 2011, 98(18):181904-1-3.
[10] OKADA N, KASHIHARA H, SUGIMOTO K,etal.. Controlling potential barrier height by changing V-shaped pit size and the effect on optical and electrical properties for InGaN/GaN based light-emitting diodes [J].J.Appl.Phys., 2015, 117(2): 025708-1-7.
[11] QUAN Z J, WANG L, ZHENG C D,etal.. Roles of V-shaped pits on the improvement of quantum efficiency in InGaN/GaN multiple quantum well light-emitting diodes [J].J.Appl.Phys., 2014, 116(18):183107-1-5.
[12] QUAN Z J, LIU J L, FANG F,etal.. A new interpretation for performance improvement of high-efficiency vertical blue light-emitting diodes by InGaN/GaN superlattices [J].J.Appl.Phys., 2015, 118(19):193102-1-6.
[13] WU X M, LIU J L, QUAN Z J,etal.. Electroluminescence from the sidewall quantum wells in the V-shaped pits of InGaN light emitting diodes [J].Appl.Phys.Lett., 2014, 104(22):221101-1-5.
[14] WU X M, LIU J L, JIANG F Y. Hole injection from the sidewall of V-shaped pits intoc-plane multiple quantum wells in InGaN light emitting diodes [J].J.Appl.Phys., 2015, 118(16):164504-1-4.
[15] MUKAI T, NAGAHAMA S, IWASA N,etal.. Nitride light-emitting diodes [J].J.Phys.Condens.Matter, 2001, 13(32):7089-7098.
[16] JEON S R, LEE S J, JUNG S H,etal.. Effect of V-shaped defects on structural and optical properties of AlGaN/InGaN multiple quantum wells [J].J.Phys. D:Appl.Phys., 2008, 41(13):132006-1-4.
[17] LIU J L, FENG F F, ZHOU Y H,etal.. Stability of Al/Ti/Au contacts to N-polar n-GaN of GaN based vertical light emitting diode on silicon substrate [J].Appl.Phys.Lett., 2011, 99(11):111112-1-3.
[18] 齐维靖, 张萌, 潘拴, 等. InGaN/GaN超晶格厚度对Si衬底GaN基蓝光发光二极管光电性能的影响 [J]. 物理学报, 2016, 65(7):077801-1-8. QI W J, ZHANG M, PAN S,etal.. Influences of InGaN/GaN superlattice thickness on the electronic and optical properties of GaN based blue light-emitting diodes grown on Si substrates [J].ActaPhys.Sinica, 2016, 65(7):077801-1-8. (in Chinese)
[19] SON K S, KIM D G, CHO H K,etal.. Formation of V-shaped pits in GaN thin films grown on high temperature GaN [J].J.Cryst.Growth, 2004, 261(1):50-54.
[20] CHO H K, LEE J Y, YANG G M,etal.. Formation mechanism of V defects in the InGaN/GaN multiple quantum wells grown on GaN layers with low threading dislocation density [J].Appl.Phys.Lett., 2001, 79(2):215-217.
[21] KIM J, CHO Y H, KO D S,etal.. Influence of V-pits on the efficiency droop in InGaN/GaN quantum wells [J].Opt.Express, 2014, 22(S3):A857-A866.
[22] CHYI J I, FUJIOKA H, MORKOÇ H,etal.. Study of efficiency droop in InGaN/GaN light emitting diodes with V-shape pits [J].SPIE, 2015, 9363:93631Q-1-6.

聂晓辉(1991-)男,山东临沂人,硕士研究生,2014年于南昌大学获得学士学位,主要从事硅衬底LED材料和器件的研究。

Email: xiaohuinanchang@163.com王小兰(1977-),女,湖南沅江人,副研究员,硕士生导师,2007年于中国科学院北京半导体所获得博士学位,主要从事硅衬底LED材料与器件的研究。
Email: wangxiaolan@ncu.edu.cn
Effect of V-pit Size on Optical and Electrical Properties of InGaN/AlGaN Near-ultraviolet Light Emitting Diode
NIE Xiao-hui, WANG Xiao-lan*, MO Chun-lan, ZHANG Jian-li, PAN Shuan, LIU Jun-lin
(NationalInstituteofLEDonSiliconSubstrate,NanchangUniversity,Nanchang330047,China)
InGaN/AlGaN near-ultraviolet light emitting diode (near-UV LED) were grown on patterned Si substrate by metal-organic chemical vapor deposition (MOCVD). The effects of V-pit size on optical and electrical properties of InGaN/AlGaN near-UV LED (395 nm) were investigated systematically by manipulating the thickness of low temperature GaN interlayer to change the V-pit size. The results show that the low temperature GaN interlayer can enhance the formation of V-pit, and the V-pit size increases with the increasing of the thickness of low temperature GaN interlayer. In terms of electrical properties, with the increasing of the V-pit size, the leakage current at -5 V increases from 5.2×10-4μA to 6.5×102μA, and the forward voltage at 350 mA decreases from 3.55 V to 3.44 V initially and then increases to 3.60 V. In terms of optical properties, with the increasing of the V-pit size, the normalized external quantum efficiency (EQE) at 35 A/cm2increases from 0.07 to the maximum of 1 initially and then decreases to 0.53. The mechanism of the effects of V-pit size on optical and electrical properties of InGaN/AlGaN near-UV LED were analyzed. The analyzing results show that the optical and electrical properties of InGaN/AlGaN near-UV LED are closely related to V-pit size. The optimized V-pit size is approximately 120-190 nm, too large or too small will deteriorate the properties of devices seriously.
Si substrate; near-UV LED; low temperature GaN interlayer; V-pit size; optical and electrical properties
1000-7032(2017)06-0735-07
2016-11-24;
2017-01-18
国家自然科学基金青年基金 (21405076)资助项目 Supported by Youth Fund of National Natural Science Foundation of China(21405076)
O484.4; TN383+.1
A
10.3788/fgxb20173806.0735
*CorrespondingAuthor,E-mail:wangxiaolan@ncu.edu.cn
