交叉杆结构忆阻器件的研究进展
2017-06-13敬秦媛程海峰刘东青张朝阳
敬秦媛,程海峰,刘东青,张朝阳
交叉杆结构忆阻器件的研究进展
敬秦媛1,程海峰2,刘东青2,张朝阳2
(国防科技大学新型陶瓷纤维及其复合材料重点实验室,湖南长沙 410073)
忆阻器被认为是除电容器、电感器、电阻器之外的第四种无源器件,具有器件结构简单、操作速度快、功耗小等优点,是具有电阻记忆特性的非易失性的电阻元件。而交叉杆结构忆阻器件作为忆阻器的一种结构,由于其较之其他结构的忆阻器具有结构简单、集成度高、容错性和并行性优良等特性,受到了外界广泛的关注及研究。文章综述了近年来交叉杆忆阻器的兴起和发展现状,阐述了以交叉杆结构为基础的各类忆阻器的制备及应用。
交叉杆;忆阻器;综述;记忆;柔性;并行性
忆阻器是一个有关磁通和电荷的非线性双终端的无源电子器件。1971年电路理论学家蔡少棠[1]在《Memristor—The Missing Circuit Element》文章中,根据电路理论的数学关系式,对忆阻器的循环方式做出了以下的假设:忆阻器的阻变特性不是恒定的,而是取决于曾经流过电路的电流,当下的电阻性能取决于电荷曾经流往的方向,即电路元件能“记住”电流的历史记录——这种特性被称为非易失性。2008年惠普实验室研究小组结合蔡少棠提出的忆阻器的概念通过分析计算发现了第四种基本元件——《The Missing Memristor Found》这一结果被发表在《Nature》上[2]。2005年Terabe等[3]通过使用阻变器件转换从而实现多重构逻辑电路。2012年Miyamura等[4]利用互补原子开关构建出了多种逻辑功能,从而大大缩小了器件每个单元的面积,大大促进了忆阻器的发展。
由于电致变换而产生的非易失性忆阻器叫做电阻式随机存储忆阻器(Resistive Random Access Memory,简称RRAM)。RRAM结构简单,通常的结构为顶/底电极、中间绝缘体或半导体的三明治结构。在外电场作用下,RRAM电阻会发生从高阻态(HRS)到低阻态(LRS)的可逆变化。在撤掉外电场后,其电阻的状态依然能够保持,该现象就是电致电阻效应。通过从“HRS”到“LRS”以及“LRS”到“HRS”的循环变化来达到信息储存的目的。研究发现通过选择适当的触发电压,能够获得多个稳定的电阻储存状态,这就有可能实现多态存储,使在相同尺寸的存储单元下,存储容量得到大幅度增加。简单的结构组成和独特的转变和存储方式,使它能用于交叉点阵结构。
目前有关忆阻器的结构报道过的有:点电极忆阻器、共面电极忆阻器以及交叉杆忆阻器等。交叉杆结构是由两层平行电极相互垂直交叉,加之中间的阻变层形成的二维阵列,如图1所示。交叉点的每一个节点均可看做一个有效的逻辑储存单元。交叉杆结构的器件具有结构简便、集成度高、高度的非易失性、良好的容错性和并行性、多重逻辑功能等巨大的应用潜力[5-7]。最早提出交叉杆结构忆阻器是2002年[8],由美国Sharp实验室最先报道了在COMS(Complementary Metal Oxide Semiconductor)上制造了0.5 μm 64位的1T1R(1个晶体管1个忆阻器串联)交叉杆器件,为交叉杆结构的忆阻器的发展奠定了基础。随后,2003年Chen等[9]通过纳米压印技术制备出了1 μm2大小的交叉杆结构忆阻器,从此交叉杆结构忆阻器正式登上了忆阻器的舞台。
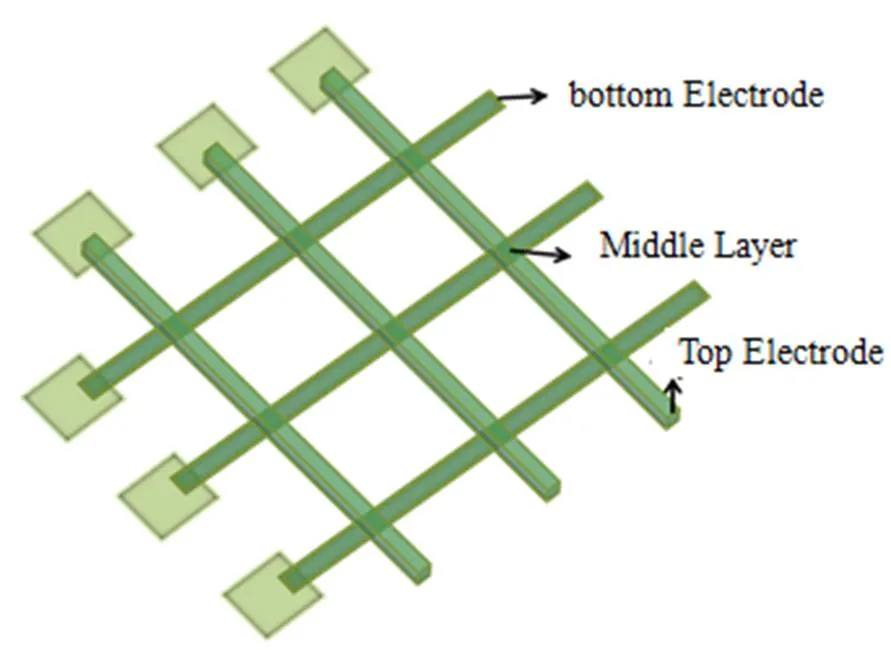
图1 交叉杆结构示意图
交叉杆结构忆阻器件的制备方法有很多,目前报道过的有:纳米压印技术、电子束光刻技术、电子束蒸发技术、等离子体增强化学气相沉积技术、喷墨打印技术等。由于忆阻器有众多优良特性,其中交叉杆式忆阻器的储存量大于其他忆阻器,因而受到了广泛的关注。本文主要介绍交叉杆结构忆阻器件近几年的研究进展。
1 交叉杆忆阻器
现在研究报道的非线性的点电极忆阻器已经能够实现阻变特性达到102以上[10],循环周期高达60次以上,在一定时间能保持其阻变特性。可以看出阻变器件的研究取得了较为显著的成效,但是要想使忆阻器件能真正地离开实验室,走进人类的生活,这些成功是远远不够的。这就需要性能更好、循环使用次数更多、集成度更高的忆阻器件。作为集成度更高、结构简单、工艺流程少、具有容错与并行等方面先天优势的交叉杆结构的忆阻器得到了越来越多的关注。通过在交叉点处实现具有不同特性的功能单元,整个交叉结构阵列可以表现出不同的功能,在高密度非易失性数据存储、可重构逻辑电路设计等领域有广泛的研究基础和长远的发展潜力。
2002年美国Sharp实验室最先报道了在COMS上制造了0.5 μm 64位的1T1R交叉杆器件后[8],许多电子公司如Sony[11]、Panasonic[12]、Unity Semiconductor[13]和Sandisk[14]都积极地参与了交叉杆电子器件的研究。最近,Sandisk和 Toshiba成功研制出了基于MeO的2层32 Gb的1D1R(一个二极管和一个忆阻器串联)结构的RRAM测试芯片[14],其尺寸低至24 nm,相比于之前的RRAM储存内存得到了显著的提高。但是这些大型的交叉杆器件通常都没有详细的测试数据,因此,下面主要讨论相对小的有详细测试数据的交叉杆忆阻器件。
1.1 二维(2D)和三维(3D)交叉杆忆阻器
随着对交叉杆忆阻器的不断研究,不同结构和构型的交叉杆忆阻器也逐渐被制备出来。2010年,Lee课题组[15]报道了Al/PI(polyimide):PCBM(6-phenyl-C61 butyric acid methylester)/Al结构的8×8的二维交叉杆忆阻器,通过电子束蒸发的手段,使用线宽100 μm掩膜版将底电极Ti(10 nm)、Au (30 nm)、Al(70 nm)依次蒸发镀膜到PET(polyethylene terephthalate)基底上,再将有机复合溶液旋涂到底电极之上,100 ℃烘24 h,使有机阻变层均匀成膜,最后再通过电子束蒸发用掩模将顶电极交叉制备到阻变层之上,得到Ti/Au/Al/PI:PCBM/Al二维交叉杆忆阻器。该忆阻器的ON/OFF比率超过104,且经过140次循环,器件的性能无明显的下降。器件在正常状态以及弯曲状态都能在104s内保持良好的稳定性,如图2所示。
除了2D的交叉杆忆阻器外,由于三维结构能大大扩大忆阻器件的单元密度,因而3D结构的交叉杆忆阻器开始进入人们的研究范畴。2010年,Jeong等[16]制备了2层8×8的交叉杆忆阻器Al/a-TiO2/Al,如图3所示。比起无机的3D交叉杆结构,由于有机材料的化学和热性能的稳定性,在采用旋涂的方式来制备时能很好地解决由于旋涂时溶剂过多,使下层的电极溶解的情况。通过研究发现忆阻器的每一层都表现出稳定的忆阻特性以及阻变机制的稳定性,不会造成层与层之间的干扰,证明了未来发展3D电子的可行性。该忆阻器具有良好读取保持性,读取电压为–1 V时,能保持循环104次性能不退化,3D堆叠结构的两层单元的保持时间一致都高达104s,且堆叠的两层单元之间的ON和OFF状态之间互不干扰,证明了3D堆叠方式的可行性。
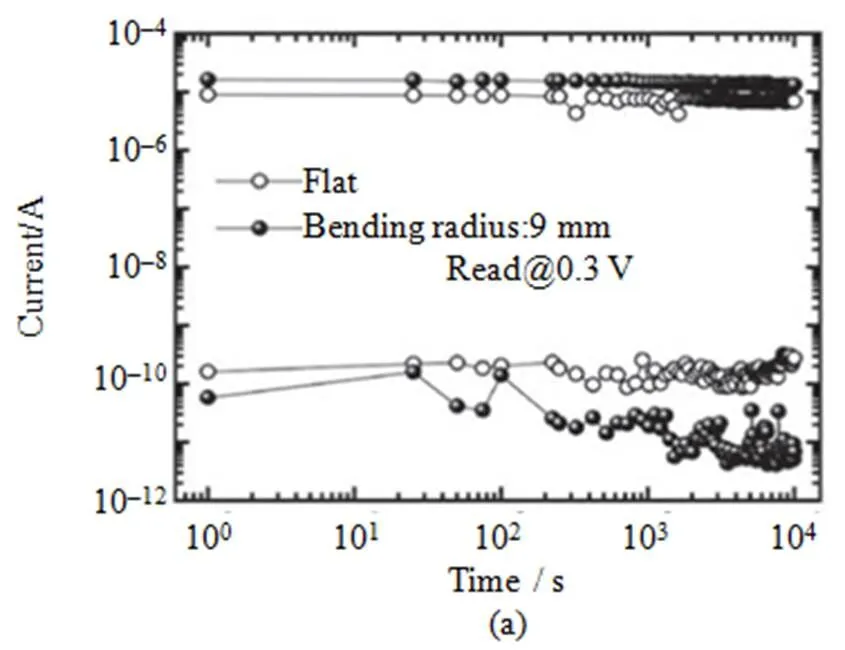
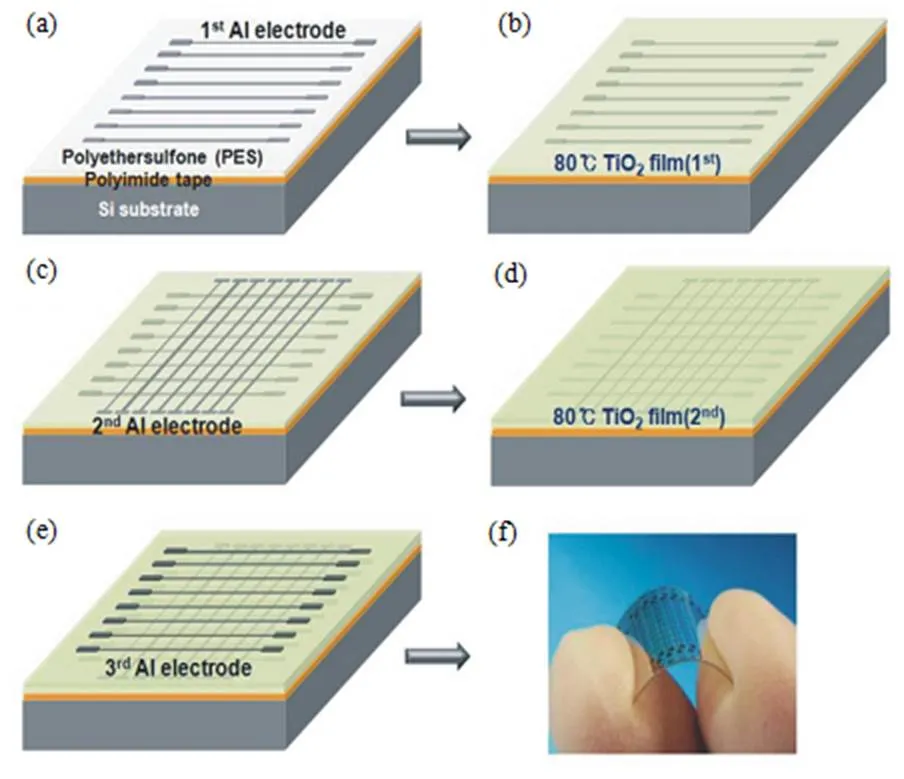
图3 制备Al/TiO2/Al/TiO2/Al双层堆叠交叉杆忆阻器的过程示意图[16]
2010年,Song等[17]研究制备出来一个3层,8×8的Al/PI:PCBM/Al交叉杆忆阻器,该器件有效单元的数量能达到83.3%,且层与层之间的ON和OFF之间的电流只差一个单位数量,而且阈值电压也只有很小的差别。且器件的每层都具有良好的重复循环稳定性,每层结构在能保持直流电压扫描60次其性能不退化,其时间的保持性在测试也高达5×104s,而外推的保持时间甚至能超过一年,ON/OFF的比率也超过103,该3D结构的交叉杆结构忆阻器具有良好的性能,具有很大的应用潜能。
1.2 柔性及瞬态交叉杆忆阻器
随着便携式电子产品的发展,柔性的交叉杆忆阻器也开始备受关注。2010年,Hu等[18]在室温下制备了Al/GO/Al/PES柔性忆阻器。通过掩膜版将线宽50 μm、厚度70 nm的Al电极通过热蒸发的方法沉积到柔性衬底PES(Polyethersulfone Resin)上,再在其上旋涂上GO(Graphene Oxide)干燥,最后在GO薄膜上沉积顶电极Al,GO薄膜如同三明治结构般夹在两层电极Al中间形成5×5的交叉杆结构,如图4(a)所示。通过对该忆阻器的特征曲线的扫描,如图4(b),HRS和LRS间是可逆的双稳态阻变,不同于典型的金属氧化物忆阻器,第一次负向扫描的“ON”状态没有任何“预成型”过程[19-23]。在反向偏压阻变过程中产生的是一个典型的BRS(Reproducible Bipolar Resistive Switching)行为,且在无任何优化的情况下,阻变单元的数量高达80%。通过对其的弯曲测试如图4(c)和(d)所示,在弯曲1000次的情况下,器件依然能保持一定的高低阻态。当器件达到极限弯曲状态(弯曲半径达7 mm),ON和OFF比率依然能保持相对稳定,该器件的阻变保持时间高达105s,能稳定操作的循环次数也多达100次,如图4(e)和(f)。从而说明Al/GO/Al/PES器件是具有柔性的非易失性忆阻器。

图4 (a)基于GO的交叉杆忆阻器示意图;(b)Al/GO/Al/PES对数I-V特征曲线;(c)连续弯曲对器件的影响;(d)不同弯曲半径下的HRS和LRS间的阻变测试;(e)读取电压为-0.5 V期间的保持时间测试;(f)100次扫描循环下的耐久力测试[18]
除了使用PES作为柔性交叉杆忆阻器衬底外,以PET(Polyethylene Terephthalate)、PC(Polycarbonate)、PEN(Polyethylene Naphthalate Two Formic Acid Glycol Ester)等为衬底的柔性交叉杆忆阻器也逐渐被研究。2016年,Zhang等[24]使用掩模通过磁控溅射的方法将Pt电极溅射到PET柔性基底上,再采用旋涂的方式将制备好的Co9Se8量子点PVP(CSQDs-PVP)混合纳米材料溶液旋涂到Pt电极上,Al电极垂直于Pt电极通过电子束蒸发的方式沉积到CSQDs-PVP纳米薄膜上制备得到Al/CSQD-PVP/Pt/PET交叉杆忆阻器件。通过对该忆阻器件在室温下施加电压,当电压从0 V到操作电压(1.6 V)时,器件处于低电流导通状态(OFF状态),随后当应用电压超过操作电压时,器件处于高电流状态,在后面的正负电压扫描过程中,器件一直保持ON状态不会回到OFF状态,从而表明了器件的写入—一次读取—多次写入的一个阻变过程。当读取电压为0.4 V时,忆阻器具有极高的ON/OFF比率以及较低的错误率,其ON/OFF比率高达105。且该忆阻器的ON和OFF的保留特性可以保持超过3200 s而没有明显的衰退,有良好的耐力,能保持循环200次以上其阻变性能不受影响。
由于医疗以及环境等对电子设备的要求越来越高,如何利用可降解材料结合先进的电子加工技术来实现可降解电子器件的制备,逐渐成为当前国际电子器件研究中的一个主流方向。在瞬态电子器件如火如荼进行之时,瞬态交叉杆忆阻器也逐渐萌芽。2015年,以浙江大学信电学院汪小知和骆季奎教授为主的研究团队与浙大材料学院及英国剑桥大学卡文迪许实验室研究人员合作,在下一代可降解电子技术上突破性完成了一项新型技术[25]。他们利用纯天然鸡蛋白(Egg Albumen)材料和可降解金属研制出生物兼容的可降解非挥发性Mg/albumen/W忆阻器。该储存器的核心材料是一层30 nm厚的蛋白,上下电极分别由Mg和W薄膜金属构成。底电极W是通过光刻出图形结构再采用溅射的方式制备于具有SiO2薄膜层的Si基底上。因为光刻的方式可能会损坏蛋白质阻变层,因而顶电极Mg是采用掩模通过溅射与底电极垂直交叉制备于基底之上。通过对器件进行特征曲线测试,当=1.0 V或–0.8 V时,电流会突然发生变化,出现阻变效应,进行HRS和LRS之间的转变,见图5(a)。
图5(b)是总结HRS和LRS测试120次的结果。忆阻器显示了一个相对稳定的低电阻的状态,HRS的阻值变化范围不超过2个数量级,而LRS的阻值基本保持一致,这是因为LRS的导电细丝一旦形成就不会改变,而HRS会根据导电细丝形成位置和状态的不同而改变。该忆阻器的ON/OFF比率高达103个数量级,具有明显的忆阻效应。在室温下对忆阻器的阻值保持时间进行了测试,如图5(c)所示。在=0.1 V的情况下测试HRS和LRS,其阻值能保持在104s的时间里无任何衰退,表明期间有良好的阻值保持性。经过对器件在不同温度下进行阻变测试,如图5(d)所示,证明器件对温度无依赖性。当器件放入水中时,整个器件在3d时间内几乎完全溶解于水,仅留下少许的痕迹。这项研究为未来植入人体的各类电子系统提供了技术基础。
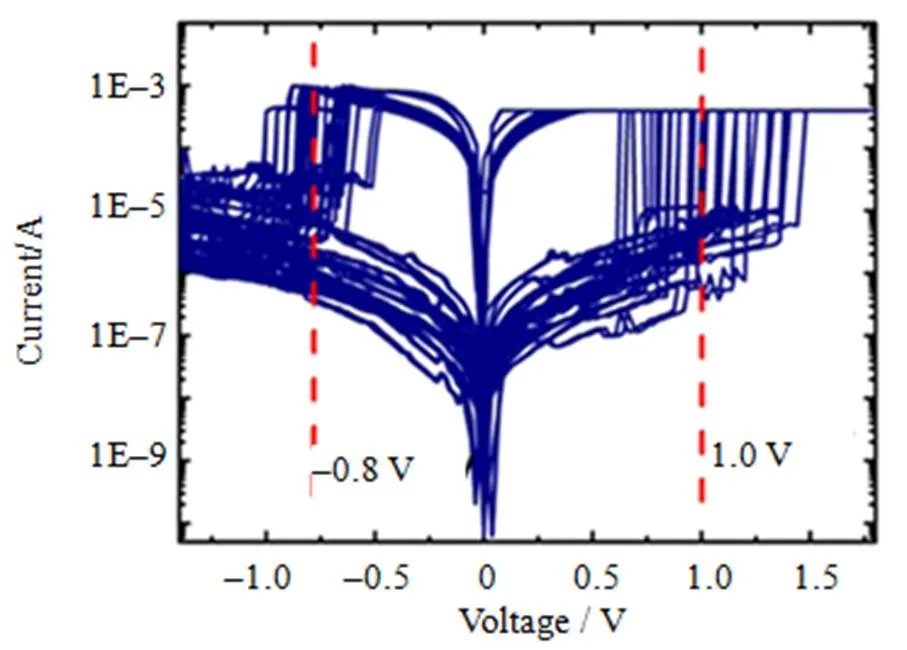
(a)
(b)

(c)
(d)
图5 (a)Mg/Albumen/W忆阻器一个单元循环15次的曲线;(b)120次set和reset过程HRS和LRS的阻值保持性;(c)0.1 V下HRS和LRS的保持时间示意图;(d)0.1V不同温度下的HRS和LRS阻值变化曲线[25]
Fig.5 (a)curves for Mg/Albumen/W cross-bar array measured 15 times for one cell; (b) Retention of HRS and LRS resistance for 120 consecutive set−reset cycling tests; (c) Retention time tests of HRS and LRS at a bias of 0.1 V; (d) The curves of HRS and LRS resistances of a memristor cell under different temperatures[25]
2 结束语
综上所述,交叉杆结构忆阻器具有高密度存储、制备方便、结构简单等众多优势,为忆阻器性能的提高以及更加广泛的应用提供了一个新思路。其在加工工艺、器件设计、材料合成等方面提出了更多新要求,极大地促进了忆阻器的进一步发展。交叉杆结构忆阻器正朝着集成度更高、性能更好以及瞬态可降解的方向发展,将会使忆阻器拥有更加广阔的应用前景。交叉杆结构忆阻器研究是跨学科、高度交叉的研究领域,需要更多的国内外相关科研工作者积极参与。
[1] CHUA L O. Memristor the missing circuit element [J]. IEEE Trans Circuit Theory, 1971, 18(5): 507-519.
[2] STRUKOV D B, SNIDER G S, STEWART D R, et al. The missing memristor found [J]. Nature, 2008, 453: 80-83.
[3] TERABE K, HASEGAWA T, NAKAYAMA T, et al. Quantized conductance atomic switch [J]. Nature, 2005. 433(7021): 47-50.
[4] MIYAMURA M, TADA M, SAKAMOTO T, et al. First demonstration of logic mapping on nonvolatile programmable cell using complementary atom switch [C]//IEEE International Electron Devices Meeting. NY, USA: IEEE, 2012, 1109.
[5] 朱玄. 基于纳米交叉结构的阻变存储阵列与寻址部件研究[D]. 长沙: 国防科学技大学, 2009.
[6] 闫安. 基于钛氧化物阻变存储阵列的制备与机理研究[D]. 长沙: 国防科学技术大学, 2012.
[7] 汤振森. TiO2阻变器件导电机理及其抗总剂量辐照性能研究[D]. 长沙: 国防科学技术大学, 2013.
[8] ZHUANG W W, PAN W, ULRICH B D, et al. Novel colossal magnetoresistive thin film nonvolatile resistance random access memory (RRAM) [C] // IEDM. NY, USA: IEEE, 2002: 193-196.
[9] CHEN Y, OHLBERG D A, LI X, et al. Nanoscale molecular-switch devices fabricated by imprint lithography [J]. Appl Phys Lett, 2003, 82(10): 1610-1612.
[10] WASER R, DITTMANN R, STAIKOV G. Redox-based resistive switching memories-nanoionic mechanisms, prospects, and challenges [J]. Adv Mater, 2009, 21(25/26): 2632-2663.
[11] WASER R. Resistive non-volatile memory devices [J]. Microelectron Eng, 2009, 86(7/8/9): 1925-1928.
[12] WASER R, AONO M. Nanoionics-based resistive switching memories [J]. Nat Mater, 2007, 6(11): 833-840.
[13] 管伟华. 前瞻非挥发性半导体存储器研究[D]. 北京: 中国科学院微电子研究所, 2008.
[14] LIU T Y, YAN T H, SCHEUERLEIN R, et al. A 130.7-mm2-layer 32-Gb ReRAM memory device in 24-nm technology [C]//IEEE International Solid-State Circuits Conference. NY, USA: IEEE, 2013, 210.
[15] JI Y, CHO B, SONG S, et al. Stable switching characteristics of organic nonvolatile memory on a bent flexible substrate [J]. Adv Mater, 2010, 22: 3071.
[16] JEONG H Y, KIM Y I, LEE J Y, et al. A low-temperature-grown TiO2-based device for the flexible stacked RRAM application [J]. Nanotechnology, 2010, 21: 115203.
[17] SONG S, CHO B, KIM T W, et al. Three-dimensional integration of organic resistive memory devices [J]. Adv Mater, 2010, 22: 5048.
[18] HU Y J, JONG Y K, JEONG W K, et al. Graphene oxide thin films for flexible nonvolatile memory applications [J]. Nano Lett, 2010, 10: 4381-4386.
[19] LEE M J, HAN S, JEON S H, et al. Electrical manipulation of nanofilaments in transition-metal oxides for resistance-based memory [J]. Nano Lett, 2009, 9: 1476-1481.
[20] LEE M J, KIM S I, LEE C B, et al. Low-temperature-grown transition metal oxide based storage materials and oxide transistors for high-density non-volatile memory [J]. Adv Funct Mater, 2009, 19: 1587-1593.
[21] YANG J J, PICKETT M D, LI X, et al. Memristive switching mechanism for metal/oxide/metal nanodevices [J]. Nat Mater, 2008(3): 429-433.
[22] YANG J J, MIAO F, PICKETT M D, et al. The mechanism of electroforming of metal oxide memristive switches [J]. Nanotechnology, 2009, 20: 215201.
[23] YANG J J, BORGHETTI J, MURPHY D, et al. A family of electronically reconfigurable nanodevices [J]. Adv Mater, 2009, 21: 3754-3758.
[24] ZHANG P, XU B H, GAO C X, et al. Facile synthesis of Co9Se8 quantum dots as charge traps for flexible organic resistive switching memory device[J]. ACS Appl Mater Interfaces, 2016(8):30336−30343.
[25] HE X L, ZHANG J, WANG W B, et al. Transient resistive switching devices made from egg albumen dielectrics and dissolvable electrodes [J]. ACS Appl Mater Interfaces, 2016(8): 10954-10960.
(编辑:陈渝生)
Research progress of cross-bar resistive switching memory devices
JING Qinyuan1, CHENG Haifeng2, LIU Dongqing2, ZHANG Chaoyang2
(Key Laboratory of Advanced Ceramic Fibers & Composites, National University of Defense Technology, Changsha 410073, China)
Memristor is considered to be a fourth passive device other than capacitors, inductors and resistors. It has the advantages of simple device structure, fast operation speed and low power consumption. It is nonvolatile with resistive memory characteristic of the original resistance. The cross-bar structure as a memristor, because of its simple structure, high integration level, high error tolerance and excellent parallel characteristics, receives the outside world wide attention and research. In this paper, the rise and development of the cross-bar resistive switching memory devices in recent years is reviewed, and the preparation and application of various memristors based on cross-bar structure is described.
cross-bar; memristor; review; memory; flexibility; parallel characteristic
10.14106/j.cnki.1001-2028.2017.06.002
TN602
A
1001-2028(2017)06-0008-06
2017-04-19
敬秦媛
国家自然科学基金资助(No. 51502344)
程海峰(1971-),男,安徽安庆人,研究员,主要从事功能材料研究,E-mail: chf.cfc@gmail.com ;敬秦媛(1992-),女,四川南充人,研究生,主要从事忆阻器研究,E-mail: labusite@126.com 。
网络出版时间:2017-06-07 13:40
http://kns.cnki.net/kcms/detail/51.1241.TN.20170607.1340.002.html
