新型整平剂TS-L对铜电沉积的影响
2016-09-23丁辛城彭代明陈梓侠程骄
丁辛城*,彭代明,陈梓侠,程骄
(广东东硕科技有限公司,广东 广州 510280)
新型整平剂TS-L对铜电沉积的影响
丁辛城*,彭代明,陈梓侠,程骄
(广东东硕科技有限公司,广东 广州 510280)
通过极化曲线、电化学阻抗谱、计时电流等电化学测量方法研究了整平剂 TS-L对铜电沉积的影响。基础镀液组成为:CuSO4·5H2O 75 g/L,H2SO4240 g/L,Cl-60 mg/L。结果表明,TS-L会抑制铜的电沉积,有利于得到平整、光亮的镀层。随TS-L用量增大,其抑制作用增强。TS-L的用量为50 mg/L时,铜的电沉积由基础镀液的三维瞬时成核转变为三维连续成核。随TS-L质量浓度的增大,镀液的深镀能力提高。在电镀液中添加50 mg/L整平剂TS-L、10 mg/L光亮剂TS-S和600 mg/L抑制剂TS-W时,深镀能力为87%,铜镀层的延展性和可靠性满足印制线路板行业的应用要求。
电镀铜;整平剂;深镀能力;极化;电结晶;延展性;可靠性
First-author's address: Guangdong Toneset Science & Technology Co., Ltd., Guangzhou 510280, China
随着电子信息行业的高速发展,提升高厚径比 PCB(印制线路板)产品的深镀能力变得尤为重要。深镀能力的提高不仅可以提升产品性能,而且能节约成本。开发高性能的添加剂是提高深镀能力最快捷有效的方式之一。PCB通孔电镀添加剂一般分为光亮剂、整平剂和抑制剂。光亮剂多为带有磺酸基的硫化物[1],例如聚二硫丙烷磺酸钠(SPS)、苯基聚二硫丙烷磺酸钠(BSP)、聚二甲基酰胺基磺酸钠(TPS)等。抑制剂多为聚醚类表面活性剂,例如聚乙二醇(PEG)、辛基酚聚氧乙烯醚(OP)、脂肪胺聚氧乙烯醚(AEO)等。整平剂的结构一般较复杂,并且对深镀能力有很大的影响,是添加剂开发的重点和难点。厉小雯等[2]以N-乙基咪唑和1,4-丁二醇二环氧甘油醚为原料合成的带聚醚链的整平剂能细化晶粒,并且具有良好的均镀能力。谢金平[1]以吡咯与咪唑的含氮杂环化合物为整平剂,电镀较大厚径比(10∶1)的板件,深镀能力达到85%。马倩等[3]用季铵盐类化合物作为整平剂,镀液深镀能力可以达到90%。本文采用自行开发的TS-L整平剂,在哈林槽中电镀高厚径比板件,探究深镀能力随TS-L整平剂用量的变化趋势。
添加剂对铜电沉积的影响大多通过电化学测试方法进行研究[4]。本文采用线性电位扫描、计时电流法、电化学阻抗谱(EIS)等常见测试方法研究了整平剂TS-L在酸铜镀液中对铜电沉积的影响,以探索整平剂TS-L的作用机理。
1 实验
1. 1 基础镀液和添加剂
(1) 基础镀液:CuSO4·5H2O 75 g/L,H2SO4240 g/L,Cl-60 mg/L。
(2) 添加剂:光亮剂 TS-S(有机硫化物),抑制剂 TS-W(聚醚类非离子型表面活性剂),整平剂 TS-L(含氮杂环化合物的季胺盐)。
1. 2 哈林槽电镀
采用1.5 L哈林槽进行电镀,以表征镀液的深镀能力。阳极为磷铜板,基体为1.6/0.25(即厚度1.6 mm,最小孔径0.25 mm)的高厚径比沉铜板。镀前依次对基体进行除油(东硕6169NF,50 °C)、酸洗(质量分数10%的硫酸,室温)和水洗。
电镀完毕,采用OLYMPUS BX51金相显微镜测定孔铜厚度和面铜厚度,按式(1)计算镀液的深镀能力TP。

1. 3 电化学测量
在上海辰华CHI660C电化学工作站上进行电化学测量,采用三电极体系,以旋转圆盘铂电极作为工作电极,铂丝为辅助电极,饱和甘汞电极(SCE)为参比电极。线性电位扫描均从开路电位起负向扫描,扫描速率为10 mV/s,旋转圆盘电极的转速固定为1 500 r/min。计时电流测试均从开路电位阶跃到某一负电位。电化学阻抗谱在开路电位下测定,频率为100 000 ~ 0.01 Hz,振幅为5 mV。
1. 4 镀层的延展性和可靠性测试
采用200 mm × 300 mm的钢板为基材,在电流密度2.7 A/dm2下电镀150 min,剥下电镀铜箔后在125 °C下烘烤6 h,冷却后分别在铜箔横向面和纵向面裁取152 mm × 13 mm样品,在CMT 6502型电子万能试验机上测定延伸率和抗拉强度。
在电镀后的板件上取孔径为1 mm的样品,先在130 °C下将样品烘烤6 h,再在无铅锡炉中对其进行6次浸锡热可靠性测试(温度288 °C,时间10 s),取微切片,用OLYMPUS BX51金相显微镜观察镀层是否出现缺陷。
2 结果与讨论
2. 1 线性电位扫描测量
图1是在基础镀液中加入不同质量浓度TS-L时的极化曲线,其中电流急剧增大处对应的电位为铜开始沉积的电位。从图1可以看出,镀液中加入TS-L后,铜的沉积电位负移,随着TS-L质量浓度的增大,极化曲线的负移量增大。这表明TS-L能够增强铜电沉积的阴极极化作用,抑制铜的电沉积,有利于得到晶粒细小的镀层。这可能是由于TS-L具有带正电荷的自由基,吸附在高负电荷位点,抑制了铜的沉积。
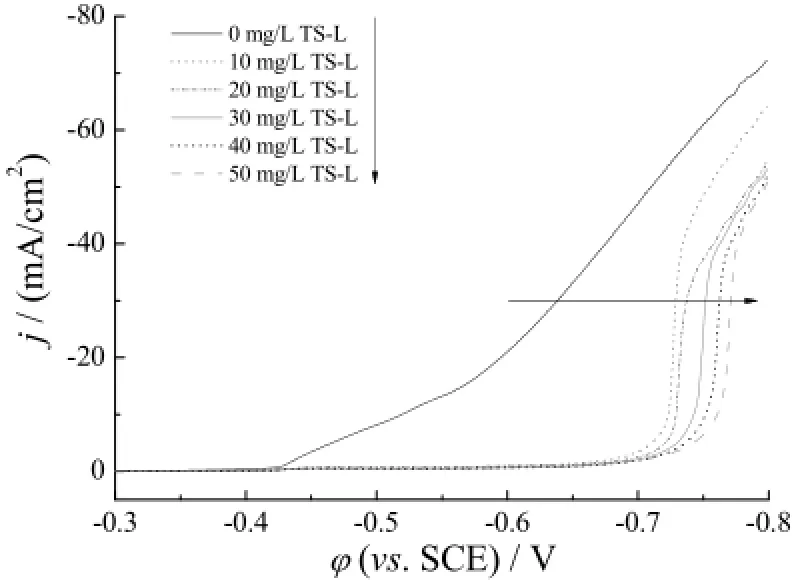
图1 TS-L用量不同时的阴极极化曲线Figure 1 Cathodic polarization curves for baths with different dosages of TS-L
2. 2 计时电流测量
采用计时电流法测定基础镀液中加入不同质量浓度TS-L时的电流-时间暂态(CTTS)曲线,结果如图2所示。电位阶跃开始后,由于双电层充电,暂态电流先迅速上升再下降,随后由于晶核的形成和生长,电流再次上升,最后由于扩散层的松弛作用,电流衰减[5-6]。从图2可以看出,随着镀液中TS-L质量浓度的增大,相同时间下的电流逐渐降低,这是由于TS-L对铜沉积的抑制作用使成核速率明显降低。
利用Scharifker模型[7],将图2的数据转换成无因次形式,即(i/im)2-(t/tm)2曲线(其中im为峰电流,tm为峰电流对应的时间)并与理论曲线对比就可以推断出金属电沉积的成核方式[8-10],结果见图3。从图3可以看出,不加添加剂时,铜的电沉积与瞬时成核理论模型比较接近;当镀液中添加20 mg/L TS-L时,铜在初始阶段的电沉积与瞬时成核接近,但随着时间的延长,向连续成核靠近;当镀液中添加50 mg/L TS-L时,铜的电沉积与连续成核理论模型比较接近。

图2 TS-L用量不同时的电流-时间暂态曲线Figure 2 Transient current vs. time curves for baths with different dosages of TS-L

图3 TS-L用量不同时的无因次(i/im)2-(t/tm)曲线Figure 3 Non-dimensional (i/im)2-(t/tm) curves for baths with different dosages of TS-L
2. 3 电化学阻抗谱测量
图4为镀液中加入不同质量浓度TS-L时的EIS谱。从图4可以看出,镀液中添加TS-L后,高频区容抗弧的半径增大,弧的顶点所代表的双电层电容也增大,说明TS-L的加入对铜的电沉积有阻碍作用。当TS-L的质量浓度增大时,容抗弧半径增大,即TS-L对铜沉积的阻碍作用增强。这与极化曲线测量的结论一致。
2. 4 TS-L对深镀能力的影响
在基础电镀液中添加10 mg/L TS-S、600 mg/L TS-W以及0、10、20、30、40和50 mg/L TS-L进行电镀,镀液的深镀能力随镀液中TS-L质量浓度的变化见图5。由图5可以看出,镀液中加入整平剂TS-L后,其深镀能力显著提高,均满足客户要求(80% ~ 90%),并且随TS-L质量浓度的增大而逐渐提高。当TS-L的质量浓度为50 mg/L时,TP达到87%,达到业内较高水平。继续增大TS-L用量,孔口会有拖尾缺陷(如孔口凹陷、不平整)。广东东硕现有成熟整平剂VCPL的深镀能力为80% ~ 83%,TS-L的深镀能力明显高于VCPL。

图4 TS-L用量不同时的EIS谱Figure 4 EIS spectra for baths with different dosages of TS-L

图5 TS-L用量不同时的深镀能力Figure 5 Throwing power of baths with different dosages of TS-L
2. 5 镀层性能
在基础镀液中分别添加10 mg/L TS-S、600 mg/L TS-W和50 mg/L TS-L进行电镀,对所得镀层进行性能表征。
2. 5. 1 显微形貌
图6为镀层的金相显微截面形貌。从图6可知,不同部位的镀层厚度分布均匀,表面较为平整。
2. 5. 2 镀层的延展性和可靠性
延展性测试结果列于表1。从表1可知,电镀铜箔的延展性满足IPC-TM-650《印制电路协会试验方法指南》中抗拉强度>248 MPa、延伸率>15%的要求。

图6 通孔表面铜镀层的截面形貌(×200)Figure 6 Cross-sectional morphology of copper coatings on through via (×200)

表1 铜镀层延展性测试结果Table 1 Ductility test results of copper coating
图7所示为电镀板件经可靠性测试后的金相形貌。从图7可知,经可靠性测试后,镀层没有出现孔壁分离、镀层断裂、内层拉脱等缺陷。
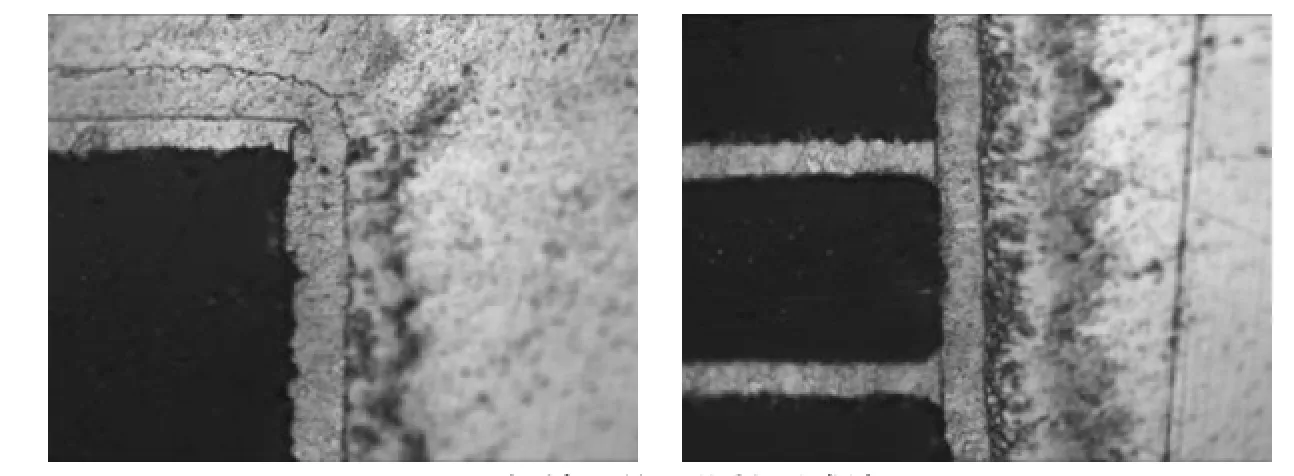
图7 铜镀层的可靠性测试结果Figure 7 Reliability test results of copper coating
3 结论
(1) 极化曲线和电化学阻抗谱测量均表明,整平剂TS-L对铜的电沉积有抑制作用,有利于得到平整的镀层。随TS-L用量增大,其抑制作用增强。
(2) 计时电流测量表明,镀液在不含TS-L时,铜的电沉积与瞬时成核模型较接近。当添加20 mg/L TS-L时,铜电沉积的初始阶段与瞬时成核接近;随时间延长,向连续成核靠近。当添加50 mg/L TS-L时,铜的电沉积与连续成核理论模型比较接近。
(3) 整平剂TS-L能够提高镀液的深镀能力,并且随TS-L质量浓度增大,深镀能力逐渐升高。
(4) 在基础电镀液中添加50 mg/L TS-L、10 mg/L TS-S和600 mg/L TS-W时,深镀能力为87%,铜镀层的延展性和可靠性满足PCB行业的应用要求。
[1] 谢金平. PCB通孔镀铜添加剂[J]. 印制电路信息, 2012 (7): 21-24.
[2] 厉小雯, 唐有根, 罗玉良, 等. 印制线路板酸性镀铜整平剂的研究[J]. 电镀与涂饰, 2011, 30 (7): 34-36.
[3] 马倩, 靳焘, 宗同强, 等. 印制电路板通孔电镀铜添加剂的研究[J]. 电镀与涂饰, 2014, 33 (24): 1049-1052.
[4] 胡立新, 占稳, 欧阳贵, 等. 镀铜研究中的电化学方法[J]. 电镀与涂饰, 2008, 27 (9): 9-12.
[5] 钟琴, 辜敏, 李强. 添加剂3-巯基-1-丙烷磺酸钠对铜电沉积影响的研究[J]. 化学学报, 2010, 68 (17): 1707-1712.
[6] 李强. 添加剂PEG、Cl-、SPS作用下的铜电结晶过程研究[D]. 重庆: 重庆大学, 2007: 13-15.
[7] SCHARIFKER B, HILLS G. Theoretical and experimental studies of multiple nucleation [J]. Electrochimica Acta, 1983, 28 (7): 879-889.
[8] TAN M, GUYMON C, WHEELER D R, et al. The role of SPS, MPSA, and chloride in additive systems for copper electrodeposition [J]. Journal of the Electrochemical Society, 2007, 154 (2): D78-D81.
[9] GRUJICIC D, PESIC B. Reaction and nucleation mechanisms of copper electrodeposition from ammoniacal solutions on vitreous carbon [J]. Electrochimica Acta, 2005, 50 (22): 4426-4443.
[10] 辜敏, 杨防祖, 黄令, 等. 氯离子对铜在玻碳电极上电结晶的影响[J]. 化学学报, 2002, 60 (11): 1946-1950.
[ 编辑:周新莉 ]
Effect of novel leveling agent TS-L on electrodeposition of copper
DING Xin-cheng*, PENG Dai-ming, CHEN Zi-xia,CHENG Jiao
The effect of leveling agent TS-L on copper electrodeposition was studied by electrochemical methods including polarization curve measurement, electrochemical impendence spectroscopy and chronoamperometry. The basic plating bath is composed of 75 g/L CuSO4·5H2O, 240 g/L H2SO4and 60 mg/L Cl-. The results showed that TS-L has an inhibitive effect on copper electrodeposition, which is beneficial to preparing level and bright coating. With increasing dosage of TS-L, its inhibitive effect is strengthened. The copper electrodeposition is changed from the three-dimensional instantaneous nucleation in basic bath to three-dimensional progressive nucleation when the dosage of TS-L is 50 mg/L. The throwing power of plating bath is improved with increasing TS-L content. The throwing power of the plating bath containing 50 mg/L leveling agent TS-L,10 mg/L brightener TS-S and 600 mg/L inhibitor TS-W is 87% and the ductility and reliability of copper coating obtained from it meet the application demand of printed circuit board.
cooper electroplating; leveling agent; throwing power; polarization; electrocrystallization; ductility; reliability
TQ153.14
A
1004 - 227X (2016) 11 - 0556 - 04
2015-12-30
2016-04-26
丁辛城(1987-),男,湖北黄冈人,硕士,工程师,主要从事电化学方面的研究。
作者联系方式:(E-mail) 164482967@qq.com。
