电荷耦合器件的γ辐照剂量率效应研究
2016-09-10武大猷汪朝敏何承发李豫东曾俊哲
武大猷,文 林,汪朝敏,何承发,郭 旗*,李豫东,曾俊哲,汪 波,刘 元
(1.中国科学院特殊环境功能材料与器件重点实验室,新疆电子信息材料与器件重点实验室,中国科学院新疆理化技术研究所,新疆乌鲁木齐 830011;2.中国科学院大学,北京 100049; 3.重庆光电技术研究所,重庆 400060)
电荷耦合器件的γ辐照剂量率效应研究
武大猷1,2,文林1,汪朝敏3,何承发1,郭旗1*,李豫东1,曾俊哲1,2,汪波1,2,刘元1,2
(1.中国科学院特殊环境功能材料与器件重点实验室,新疆电子信息材料与器件重点实验室,中国科学院新疆理化技术研究所,新疆乌鲁木齐 830011;2.中国科学院大学,北京 100049; 3.重庆光电技术研究所,重庆 400060)
对电荷耦合器件进行了不同剂量率的γ辐照实验,通过多种参数的测试探讨了剂量率与电荷耦合器件性能退化的关系,并对损伤的物理机理进行分析。辐照和退火结果表明:暗信号和暗信号非均匀性是γ辐照的敏感参数,电荷转移效率和饱和输出电压随剂量累积有缓慢下降的趋势;暗场像素灰度值整体抬升,像元之间的差异显著增加;电荷耦合器件的暗信号增量与剂量率呈负相关性,器件存在潜在的低剂量率损伤增强效应。分析认为,剂量率效应是由界面态和氧化物陷阱电荷竞争导致的。通过电子-空穴对复合模型、质子输运模型和界面态形成对机理进行了解释。
电荷耦合器件;暗信号;低剂量率损伤增强效应;暗场像素统计
1 引 言
电荷耦合器件(Charge coupled device,CCD)是一种具有MOS(Metal oxide silicon,MOS)结构的固态光学成像器件[1],通过栅压在氧化层下形成转移势垒,把耗尽层生成的光生电荷转移到输出放大器而输出电学信号。由于具有体积小、功耗低、动态范围大和量子效率高等优点,CCD被广泛应用于卫星的光学成像系统中[2-3]。但是空间辐射环境中高能射线和带电粒子辐射CCD诱发的电离效应和位移效应,会使器件参数严重退化甚至引起功能失效[4-7],这严重降低了器件的成像质量和使用寿命。
空间辐照总剂量的累积需要很长时间,在近地轨道中空间辐射累计总剂量大约是10-3~10-2rad(Si)/年;在中高地球轨道中,空间辐射累计总剂量在1~10 krad(Si)/年,平均辐射剂量率低于10-3rad(Si)/s。为了研究真实太空环境中器件的抗辐射性能及低剂量率辐照下器件的损伤效应,国内外工作者进行了深入的研究。1991年,Enlow[8]首次报道了在线性双极器件中存在低剂量率增强效应(Enhanced low-dosed rate sensitivity,ELDRS)。在进一步的研究中,Johnston[9]发现PNP晶体管比NPN管在低剂量率下退化得更严重,在低剂量率下参数退化可以是高剂量率下的5倍,同时指出在一些具有高缺陷密度的氧化层中可以观测到明显的ELDRS。在后续工作中,研究者对ELDRS损伤机理构建了一些物理模型,其中包括:电子、空穴和质子在SiO2中转移模型,电子空穴的复合效应,SiO2中电子陷阱在有效电场下的俘获模型,聚合氢原子与界面态的竞争模型等[10]。通过实验发现,能够增强ELDRS的因素主要有以下几种:(1)SiO2中氧空位的浓度和分布;(2)氧化层中氢的浓度、分布和反应;(3)辐照和退火中的温度和偏压;(4)器件的钝化层工艺;(5)辐照前器件施加热应力或者老化[11-14]。2006年,Witczak[15]首次在文章中报道MOS器件存在剂量率效应。近年来,随着工艺和隔离技术不断的改进,人们针对MOS器件的损伤效应展开了深入研究,并用第一性原理计算了物理机理[16]。由于CCD的像素也具有MOS结构,其辐射效应一直是研究的热点。从上世纪70年代开始,针对其辐射效应的研究已经展开,但直到近年才有文章报道了低剂量率辐照下CCD存在损伤增强[17],但对产生的机理仍没有明确的解释。根据美军标,实验室典型的辐照剂量率为50~300 rad(Si)/s,如果CCD存在低剂量率增强效应,则现存的实验评估方法会高估器件在太空中实际的抗总剂量能力,且随着CCD像元数的不断增加,其损伤机理会更加复杂。因此,为了保证实验评估方法的准确性和可靠性,有必要开展剂量率与CCD参数退化关系的研究,对产生的机理进行深入的分析。
2 实验样品及方法
CCD样品为国产科学级埋沟CCD,图像采集区像素阵列为64×64光敏单元,存储区阵列为64×64存储单元,像元尺寸为48 μm×48 μm,器件栅介质采用复合结构。器件像素单元结构如图1所示。
辐照和测试分别在新疆理化所钴源和光电成像器件抗辐射性能检测设备上完成,实验中γ剂量率选择0.1,5,50 rad(Si)/s。实验过程中的主要测试参数包括器件暗信号、暗信号非均匀性、饱和输出电压和电荷转移效率(CTE)。在每次测试中,保存CCD在暗场下最小积分时间内的raw图(像元获得的原始图像),并对raw图中的像素灰度值进行统计。以上参数都是通过移位测试得到,且每次测试在0.5 h内完成。

图1 CCD像素单元结构Fig.1 Pixel structure of CCD
3 结果与讨论
3.1电荷转移效率退化
本受试样品CCD采用重掺杂N+埋沟工艺,可有效避免界面态对转移电荷的散射作用,因此电荷转移效率主要受埋沟中的缺陷影响。埋沟中能级接近导带中央的缺陷对多子具有陷阱作用,在CCD积分时间内,如果陷阱俘获光生电荷,且在随后的转移时钟周期内不能及时发射回导带,将使输出的电荷数量减少从而使电荷转移效率退化[18]。CCD在γ剂量率50 rad(Si)/s辐照及辐照结束后的退火实验如图2所示。在辐照过程中,电荷转移效率有所降低;在常温加电退火实验中,CTE有适量恢复,但CTE在γ辐照和退火过程中变化微弱,不是γ辐照下的敏感参数。

图2 CTE随辐照剂量和退火时间的变化Fig.2 Variation of CTE of CCD with γ irradiation and room temperature annealing time
3.2饱和输出电压退化
饱和输出电压是CCD在工作状态下,其输出端得到的最大电压,它主要由耗尽层深度和输出放大器增益决定[19]。辐照引起饱和输出电压的变化如图3所示。在辐照过程中,饱和输出电压随辐照剂量的累计呈线性下降。在剂量率为50 rad(Si)/s的γ辐照下,在辐照剂量达到100 krad(Si)后下降约10%。辐照结束后,在室温加电退火的100 h内,饱和输出电压有适量的恢复,但超过这段时间后,饱和输出电压基本不再产生显著变化。

图3 饱和输出电压随辐照剂量和退火时间的变化Fig.3 Variation of saturated output signal of CCD with γ irradiation and room temperature annealing time
耗尽层的深度主要由N+埋沟层和P外延层的浓度决定。文献[20]指出:电离辐射损伤产生了大量的界面态,引起MOS电容阈值电压正向漂移,像素单元耗尽层深度减小,使可储存光生电荷量减小,从而使输出到放大器的电荷量减少;而输出放大器的增益退化也会降低饱和输出电压。CCD样品输出端主要有三级放大器,其组成如图4所示。
在工作周期内,IN为输入光电信号,它使MOS管T工作在导通状态。饱和输出电压OUT的值为T管的饱和输出电流IDSAT和电阻R的乘积。MOS管的饱和电流为

其中u为电子迁移率,Cox为MOS等效电容,VDSAT为饱和电压。
电离辐照会导致MOS单管的饱和输出电流降低,使输出电阻R的分压降低,同时也削弱了输出放大器的增益能力[20-21]。综上所述,电离辐照会导致像素耗尽中容纳的电荷量减少,同时辐照引起的输出放大器退化使输出增益减小,两者的共同作用使得输出电压降低。
3.3暗信号退化
暗信号是在无光暗场下CCD的输出端信号,它主要是由光敏区原子热激发产生的。图5所示为暗信号随γ辐照及相应的常温退火时间的变化。暗信号随着辐照剂量的累积不断上升,且增速不断加快。在辐照结束后的100 h内,暗信号迅速退火,有明显的降低;在常温加电退火200 h以后,暗信号变化缓慢,退火速度明显降低。
CCD暗信号的来源主要是耗尽区暗信号IDEP和表面暗信号ISUR,如图6所示。

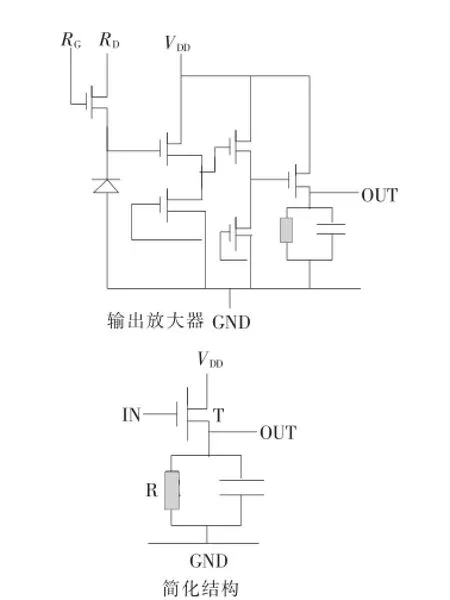
图4 CCD输出放大器及其简化结构Fig.4 Output amplifier of CCD and its simplified structure

图5 暗信号随辐照剂量和退火时间的变化Fig.5 Variation of dark signal of CCD with γ irradiation and room temperature annealing time
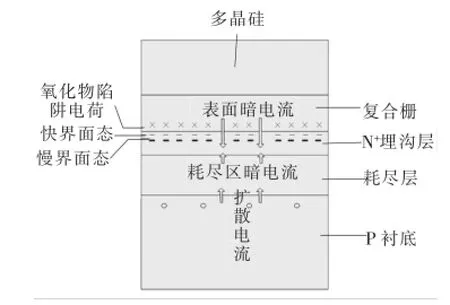
图6 CCD暗信号示意图Fig.6 Schematic diagram of CCD dark signal
式中,q为电子电荷,XDEP为耗尽区宽度,ni为硅的本征载流子浓度,子DEP为耗尽区有效载流子寿命,Nss为硅-二氧化硅界面态密度,滓为电子俘获截面,Dn为电子的扩散系数,NA为硅的掺杂浓度,L为特征长度。若扩散长度大于耗尽区下面的场自由区宽度,则L为场自由区的宽度,否则L为扩散长度[22]。
其中耗尽层暗信号主要来源于耗尽层缺陷激发的电子-空穴对。由于耗尽层中有低的自由载流子密度和高的自建电场,能级位于禁带中央附近的缺陷激发的电子-空穴对在自建电场作用下迅速分离,其中电子漂移进入埋沟成为转移电荷。由于γ辐照不能产生位移损伤,扩散电流主要与P衬底中电子浓度梯度有关,它和耗尽层暗信号对CCD整体的暗信号贡献度不大,因此表面暗电流占主导地位,暗信号主要由氧化物和界面态的生长所决定。
γ辐照在氧化层中产生氧化物陷阱电荷并改变了Si/SiO2界面下的电势场分布,同时辐照隔断Si/SiO2界面电荷的连接使界面态大量产生,而界面态会向埋沟中输运电荷包交流电荷,从而使得暗信号密度增大。在辐照结束后的常温加电退火过程中,一般氧化物陷阱电荷很快中性化,暗信号在初期有明显下降,但是界面态和深能级氧化物陷阱不容易退火[23],因此在常温加电退火一段后,暗信号不再显著变化。
3.4暗信号的非均匀性退化
暗信号非均匀性即固定图像噪声,定义为在无光照条件下,积分时间为1 s,测试得到的各个有效像元输出信号的均方根偏差。其中考虑到暗信号噪声多为高斯型白噪声,即噪声平均值为0,所以采取连续采集多帧信号,先对其取平均值,然后再进行数据计算:

式中,M为像元个数,Voi为第i个像元在1 s内的平均输出信号,Vo为整个像元的平均输出信号,VFPN为器件的固定图像噪声[24]。
暗信号非均匀性主要反映像元之间暗信号分布的差异。图7所示为暗信号非均匀性随γ辐照及相应的常温退火时间的变化。其变化趋势与暗信号相似,随着辐照剂量的累积,像元之间暗信号的差异增大,并在退火初期有明显的恢复。图8、9为在辐照前和累积剂量达到100 krad(Si)后的CCD工作在暗场下的raw图,可以看出,像素灰度值随辐照剂量的累积明显抬升。

图7 暗信号非均匀性随辐照剂量和退火时间的变化Fig.7 Variation of dark non-uniformity signal of CCD with γ irradiation and room temperature annealing time

图8 辐照前的raw图像素统计Fig.8 Raw image pixel statistics of pre-irradiation

图9 辐照100 krad(Si)后的raw图像素统计Fig.9 Raw image pixel statistics after irradiation of 100 krad(Si)

图10 不同剂量下的暗场像素灰度值统计Fig.10 Dark pixel gray value statistics under different dose
图10为对raw图中的的像素灰度值的统计结果。随着辐照剂量的累积,暗场下灰度值峰值右移,说明像素的暗信号随辐照累积普遍增加。同时,峰值随剂量增加而不断下降,且波型整体展宽,说明像素灰度值的分布变得分散,像元之间暗信号的差异显著增加。
4 暗信号退化的剂量率效应
4.1剂量率效应实验结果
剂量率辐照和退火实验结果如图11所示。在辐照阶段,暗信号随γ剂量的累积而上升。辐照100 krad(Si)后,低剂量率辐照下的暗信号增量显著高于高剂量率。在长时间辐照过程中,低剂量率辐照也伴随着暗信号的退火,为了排除时间相关效应,高剂量率辐照加退火时间应与低剂量率辐照时间相等,并且整个辐照和退火过程中器件偏置和环境温度完全相同。实验结果表明:当高剂量率辐照加退火时间与低剂量率的辐照时间相等时,高剂量率辐照产生的暗信号仍大约是低剂量率辐照下的2倍,这表明本款器件存在潜在的低剂量率损伤增强。暗信号增量与辐照累积的剂量和辐照时间有关。忽略辐照时间,在辐照不同剂量下,对比初值暗信号增量,结果如表1所示。在辐照30 krad(Si)和50 krad(Si)后,在剂量率为0.1 rad(Si)/s辐照下,暗信号增幅分别是剂量率50 rad(Si)/s的6.8倍和5.5倍;但随着辐照剂量的继续累积,在100 krad(Si)后,高剂量暗信号增幅只是低剂量率的大约2倍,说明选择适当辐照剂量也许会使ELDRS效应更加明显。

图11 不同剂量率下的暗信号随辐照剂量率和退火时间的变化Fig.11 Variation of dark signal of CCD under different dose rate and room temperature annealing time

表1 累积不同剂量下的暗信号对比初值的增量Tab.1 Increment of the dark signal under different doses

图12 暗信号与辐照剂量率的关系Fig.12 Relationship between dark signal and irradiation dose rate
暗信号与剂量率的关系如图12所示。0.1 rad(Si)/s辐照下的暗信号增幅最大,暗信号与剂量率呈负相关,实验中没有发现剂量率拐点。
4.2剂量率效应的机理分析
在栅介质的制备过程中,由于工艺原因和空气中水气的介入,栅氧化物中含有取代二氧化硅桥氧的氢原子(图13(a)),它俘获空穴极化后形成质子并通过跳跃输运到界面,如图13(b)、(c)所示。质子输运到Si/SiO2界面处与该硅氢键作用生成氢分子,同时产生一个悬挂键。由于质子对电子的俘获截面小于慢移动或者处于亚稳态的空穴,所以相比于质子,空穴更容易和电子复合[25-27]。高剂量率辐照产生高密度电子-空穴对,大量空穴在被氢原子俘获之前更倾向与电子复合,这大大降低了氢原子俘获空穴的几率[28-29],减少了氧化物中释放的质子,这使得输运到Si/SiO2界面的质子数量降低,从而抑制了界面态的产生过程,如公式(6)所示。相反,低剂量率辐照下的低密度空穴-电子对使氢原子俘获空穴几率增加,更有利于质子输运到Si/SiO2界面,从而促进界面态的产生。因此,在辐照剂量相同时,低剂量率γ辐照对表面暗信号的增强高于高剂量辐照。


图13 (a)二氧化硅中桥氧形成空位机理;(b)二氧化硅与氢分子的热作用图;(c)俘获空穴后,氢原子电离成质子通过跳跃输运向截面。Fig.13 (a)Schematic diagram of a dimer O vacancy in SiO2as processed.(b)Exothermic reaction between SiO2and H2.(c)H capture an hole.
5 结 论
在不同γ射线辐照剂量率条件下,考察了CCD主要性能参数的辐射敏感性和剂量率效应。辐照CCD器件会使得暗信号及暗信号非均匀性增加,电荷转移效率和饱和输出电压降低(在剂量率为0.1,5,50 rad(Si)/s时,参数退化表现出相同趋势)。辐照引起像元暗信号增加,随着剂量的累积,暗场像素灰度值整体抬升,且像素间灰度值差异增大。分析认为,暗场下的灰度值随着暗信号而变化。饱和输出电压下降是由于辐照中引起CCD栅氧正电荷和界面态大量产生,使得耗尽层深度降低,其可储存光生电荷量减小,同时输出放大器的受损也会使得饱和输出电流降低。暗信号对γ剂量率是比较敏感的参数,且γ辐照存在低剂量率损伤增强。在累积辐照50 krad(Si)时,低剂量率损伤增强最明显,剂量率0.1 rad(Si)/s辐照下的暗信号的增量比50 rad(Si)/s大5.5倍。初步认为导致低剂量率损伤增强的原因是:取代桥氧的氢原子俘获空穴的几率低于电子对空穴的俘获几率,高剂量率辐照使栅氧化物中电离效应感生电子-空穴对的复合速率迅速增加,减少桥氢原子的释放,通过跳跃输运到Si/SiO2界面的质子数量减少,从而抑制了界面态的产生。同时,剂量率效应的增强程度与剂量有关,选择适当的剂量可以观测到明显的低剂量率增强效应。以上工作将对评估太空中电荷耦合器件的抗辐照能力提供实验基础和依据。
[1]BEBEK C,GROOM D,HOLLAND S,et al..Proton radiation damage in p-channel CCDs fabricated on high-resistivity silicon[J].IEEE Trans.Nucl.Sci.,2002,49(3):1221-1225.
[2]CHUGG A M,JONES R,MOUTRIE M J,et al..Analyses of images of neutron interactions and single particle displacement damage in CCD arrays[J].IEEE Trans.Nucl.Sci.,2004,51(6):3579-3584.
[3]SOLTAU H,HOLLA P,KEMMER J,et al..Performance of the pn-CCD X-ray detector system designed for the XMM satellite mission[J].Nucl.Instrum.Methods Phys.Res.Sect.A,1996,337(2-3):340-345.
[4]PICKEL J C,KALMA A H,HOPKINSON G R,et al..Radiation effects on photonic imagers—a historical perspective[J].IEEE Trans.Nucl.Sci.,2003,50(3):671-688.
[5]HOPKINSON G R.Radiation effects on solid state imaging devices[J].Radiat.Phys.Chem.,1994,43(1-2):79-91.
[6]从忠超,余学峰,崔江维,等.半导体器件总剂量辐射效应的热力学影响[J].发光学报,2014,35(4):465-469. CONG Z C,YU X F,CUI J W,et al..Thermodynamic impact on total dose effect for semiconductor components[J]. Chin.J.Lumin.,2014,35(4):465-469.(in Chinese)
[7]李豫东,汪波,郭旗,等.CCD与CMOS图像传感器辐射效应测试系统[J].光学精密工程,2013,21(11):2778-2784.LI Y D,WANG B,GUO Q,et al..Testing system for radiation effects of CCD and CMOS image sensors[J].Opt.Precion Eng.,2013,21(11):2778-2784.(in Chinese)
[8]ENLOW E W,PEASE R L,COMBS W,et al..Response of advanced bipolar processes to ionizing radiation[J].IEEE Trans.Nucl.Sci.,1991,38(6):1342-1351.
[9]FLEETWOOD D M,RIEWE L C,SCHWANK J R,et al..Radiation effects at low electric fields in thermal,SIMOX,and bipolar-base oxides[J].IEEE Trans.Nucl.Sci.,1996,43(6):2537-2546.
[10]FLEETWOOD D M,KOSIER S L,NOWLIN R N,et al..Physical mechanisms contributing to enhanced bipolar gain degradation at low dose rates[J].IEEE Trans.Nucl.Sci.,1994,41(6):1871-1883.
[11]JOHNSTON A H,RAX B G,LEE C I.Enhanced damage in linear bipolar integrated circuits at low dose rate[J].IEEE Trans.Nucl.Sci.,1995,42(6):1650-1659.
[12]RASHKEEV S N,CIRBA C R,FLEETWOOD D M,et al..Physical model for enhanced interface-trap formation at low dose rates[J].IEEE Trans.Nucl.Sci.,2002,49(6):2650-2655.
[13]HJALMARSON H P,PEASE R L,WITCZAK S C,et al..Mechanisms for radiation dose-rate sensitivity of bipolar transistors[J].IEEE Trans.Nucl.Sci.,2003,50(6):1901-1909.
[14]BOCH J,SAIGN F,SCHRIMPF R D,et al..Physical model for the low-dose-rate effect in bipolar devices[J].IEEE Trans.Nucl.Sci.,2003,53(6):3655-3660.
[15]WITCZAK S C,LACOE R C,OSBORN J V,et al..Dose-rate sensitivity of modern nMOSFETs[J].IEEE Trans.Nucl. Sci.,2005,52(6):2602-2608.
[16]RASHKEEV S N,FLEETWOOD D M,SCHRIMPF R D,et al..Proton-induced defect generation at the Si-SiO2interface[J].IEEE Trans.Nucl.Sci.,2001,48(6):2086-2092.
[17]WANG Z J,HE B P,YAO Z B,et al..Dose rate and bias effects on COTS array CCDs induce dark signals increase[J]. IEEE Trans.Nucl.Sci.,2014,61(3):1376-1380.
[18]HOPKINSON G R,DALE C J,MARSHALL P W.Proton effects in charge-coupled devices[J].IEEE Trans.Nucl. Sci.,1996,43(2):614-627.
[19]汪波,李豫东,郭旗,等.电荷耦合器件中子辐照诱发的位移效应[J].发光学报,2016,37(1):44-49. WANG B,LI Y D,GUO Q,et al..Neutron irradiation induced displacement damage effects on charge coupled device[J].Chin.J.Lumin.,2016,37(1):44-49.(in Chinese)
[20]SCHWANK J R,SHANEYFELT M R,FLEETWOOD D M,et al..Radiation effects in MOS oxides[J].IEEE Trans. Nucl.Sci.,2008,55(4):1833-1853.
[21]MA T P,DRESSENDORFER P V.Ionizing Radiation Effects in MOS Devices and Circuits[M].New York:Wiley,1989.[22]雷仁方,王艳,高建威,等.CCD表面暗电流特性研究[J].电子科技,2014,27(5):26-28. LEI R F,WANG Y,GAO J W,et al..Study on surface dark current of CCD[J].Electron.Sci.Technol.,2014,27(5):26-28.(in Chinese)
[23]BOCH J,SAIGNE F,SCHRIMPF R D,et al..Elevated temperature irradiation at high dose rate of commercial linear bipolar ICs[J].IEEE Trans.Nucl.Sci.,2004,51(5):2903-2907.
[24]王祖军,罗通顶,杨少华,等.电离辐照诱发面阵电荷耦合器暗信号增大试验[J].中国空间科学技术,2014,34(4):72-78. WANG Z J,LUO T D,YANG S H,et al..Experiment of ionizing radiation induced array charge coupled devices dark signal increase[J].Chin.Space Sci.Technol.,2014,34(4):72-78.(in Chinese)
[25]VANHEUSDEN K,KARNA S P,PUGH R D,et al..Thermally activated electron capture by mobile protons in SiO2thin films[J].Appl.Phys.Lett.,1998,72(1):28-30.
[26]MA T P,DRESSENDORFER P V.Ionizing Radiation Effects in MOS Devices and Circuits[M].New York:Wiley,1989:87-192.
[27]FLEETWOOD D M,SCOFIELD J H.Evidence that similar point defects cause 1/f noise and radiation-induced-hole trapping in metal-oxide-semiconductor transistor[J].Phys.Rev.Lett.,1990,64(5):579-582.
[28]LU Z Y,NICKLAW C J,FLEETWOOD D M,et al..Structure,properties,and dynamics of oxygen vacancies in amorphous SiO2[J].Phys.Rev.Lett.,2002,89(28):285505-1-4.
[29]WARREN W L,SHANEYFELT M R,SCHWANK J R,et al..Paramagnetic defect centers in BESOI and SIMOX buried oxides[J].IEEE Trans.Nucl.Sci.,1993,40(6):1755-1764.

武大猷(1988-),男,甘肃金昌人,硕士研究生,2010年于兰州大学获得学士学位,主要从事光电成像器件空间辐照效应的研究。
Email:1175052897@qq.com

郭旗(1964-),男,新疆乌鲁木齐人,研究员,博士生导师,1986年于北京理工大学获得学士学位,主要从事光电材料与器件空间辐射效应方面的研究。
E-mail:guoqi@ms.xjb.ac.cn
Dose Rate Effects of γ Irradiation on CCDs
WU Da-you1,2,WEN Lin1,WANG Chao-min3,HE Cheng-fa1,GUO Qi1*,LI Yu-dong1,ZENG Jun-zhe1,2,WANG Bo1,2,LIU Yuan1,2
(1.Key Laboratory of Functional Materials and Devices Under Special Environments of Chinese Academy of Sciences,Xinjiang Key Laboratory of Electric Information Materials and Devices,Xinjiang Technical Institute of Physics and Chemistry,Chinese Academy of Sciences,Urumqi 830011,China;2.University of Chinese Academy of Sciences,Beijing 100049,China;3.Chongqing Optoelectronics Research Institute,Chongqing 400060,China)
*Corresponding Author,E-mail:guoqi@ms.xjb.ac.cn
The experiments of dose rate on charge coupled devices(CCDs)were carried out to investigate the relationship between the dose rate and the electrical parameters of the device,and the degradation mechanism was analyzed.With the accumulation of the dose,the dark signal(DS)and dark non-uniformly signal(DNS)increase significantly,and the both charge transfer efficiency(CTE)and saturation output voltage(SOV)tend to decrease slowly.The whole dark pixel value uplifts and the non-uniform between pixels becomes obviously.The dark signal of the CCD is negatively correlated with the dose rate,and the device presents the potential of the-low-dose-rate-damage enhancement effect.It is considered that the dose rate effect is caused by the competition between the interface states and oxide traps,and the mechanism is explained by the electron-hole pair recombination model and the damage model in the annealing process.
charge coupled device;dark signal;enhanced low-dosed rate sensitivity;dark pixel statistics
TP212.14;TN386.5
A
10.3788/fgxb20163706.0711
1000-7032(2016)06-0711-09
2016-02-03;
2016-03-15
国家自然科学基金(11005152);中国科学院“西部之光”人才培养计划重点项目“CCD的空间位移损伤效应及评估技术研究”资助
