Smart-cut 方法制备GeOI 材料的Ge 表面腐蚀研究
2015-03-06邓海量张轩雄
邓海量,杨 帆,张轩雄,
(1.上海理工大学 光电信息与计算机工程学院,上海 200093;2.中国科学院 微电子研究所,北京 100029)
随着半导体技术的发展,器件尺寸的不断缩小和芯片面积的增加,导致现有的硅材料[1]和硅工艺已经接近硅的物理极限,已无法满足集成电路的要求,同时在现代集成电路应用中体硅材料出现一系列的问题,譬如硅MOS 电路中的闩锁效应、漏源区的寄生电容、易形成浅结[2]等。因此,影响了半导体材料的电学特性和应用,绝缘体上的硅[3](Silicon on Insulator)SOI是在顶层硅与衬底之间引入了一层埋氧层,作为全介质隔离结构,SOI 材料具有硅材料无法比拟的优越性,消除了硅的CMOS 电路的寄生通道。然而随着摩尔定律的延续,科研人员不得不考虑将具有更高迁移率的材料引入到场效应管中。由于锗材料[4]具有较高的空穴迁移率和电子迁移率,基于锗材料的MOS 场效应晶体管受到研究人员不断关注和研究,同时锗材料可兼容现有成熟的硅工艺平台技术,但Ge 的禁带宽度为0.66 eV,存在着较大漏电风险,不易于在集成电路中应用。
科研人员想到利用类似于SOI 结构的GeOI[5](Germanium-on-Insulator)结构来抑制漏电,同时能克服Ge 材料的缺点。智能剥离技术[6](Smart-cut)是近年来用于制备GeOI 晶片常用的方法之一。如图1所示为Smart-cut 制备GeOI 晶片的工艺流程图,其原理是向一个Ge 片中注入H 离子[7],然后在低温下与另一块通过热生长方法在表面生长氧化层SiO2的Si 片对粘起来形成键合片,键合完成后将键合片加热退火处理,使Ge 片内的气泡层气体膨胀产生压力,随着压力的不断增大达到临界值时,注入氢的Ge[8-9]片会在气泡层脱离下来并与表面生长SiO2的衬底Si片结合在一起形成GeOI 晶片,从而实现锗的薄层转移[10]。因为该方法生产出来的产品质量好,顶层膜的厚度可根据注入离子的能量来控制,能满足大规模集成电路技术的使用。要想制备出符合器件制作要求的高质量GeOI 晶圆片,需要对制备过程、制备条件等做大量的研究,还需要进一步对实验过程进行调整和优化。在GeOI 材料的制备过程中,由于在晶圆裂片(Splitting)后需要对表层Ge 进行平整化,同时去除由于H 离子注入所造成的表面损伤,因此需化学机械抛光(CMP)。故本研究是对Splitting 后的GeOI 晶片进行湿法化学腐蚀,探讨湿法化学腐蚀对GeOI 上层薄膜(Ge 膜)表面粗糙度的影响。同时,观察非晶层的去除状况,为制备高质量的GeOI 晶片提供参考。
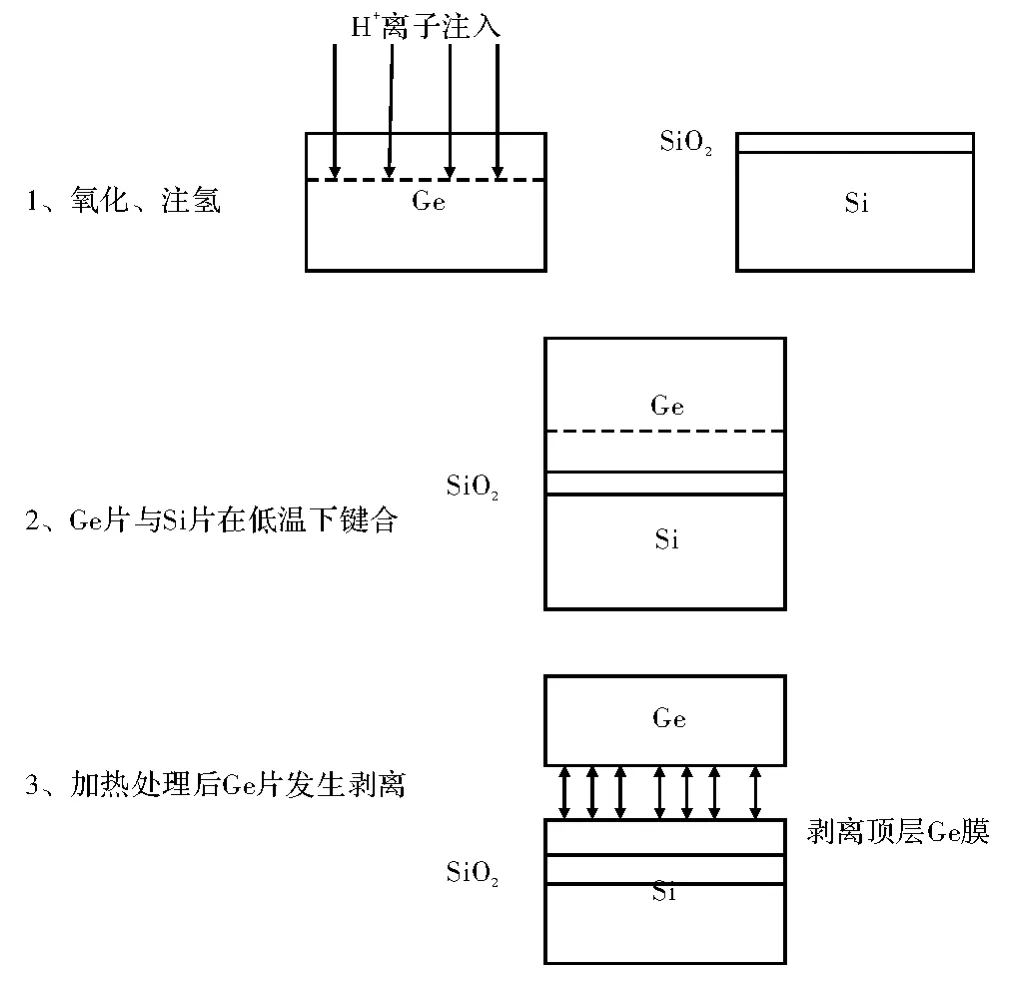
图1 智能剥离技术的工艺流程
1 实验方法
本实验采用直径50 mm 的P 型(100)抛光Ge 片,Ge 片经清洗后去除表面的杂质,然后向Ge 片中注入能量为100 keV 剂量为3.5×1016cm-2的H 离子,注入时离子偏离法线7°用于避免沟道效应;N 型Si 片表面生长一层厚度300 nm 致密氧化层,将Ge 片与表面生长SiO2层的Si 片在低温下形成键合,然后再将键合片放在炉管中以3 ℃/min 加热到270 ℃保温40 h 后退火处理,退火处理后使Ge 片从微腔层发生剥离现象,从而导致键合片在H+射程Rp 附近分离(Splitting),出现Ge 片表层薄膜转移到SiO2片上,形成GeOI。GeOI 制备好后将样品切割成两块,分别编号为样品A、样品B,样品A 清洗后未对其进行操作,样品B 清洗后在室温条件下浸泡在用配置好的溶液NH3H2O:H2O2:H2O(1∶2∶200)中进行腐蚀,腐蚀1 min后,然后用去离子水清洗干净样品B 表面,清洗完成后用蔡司光学显微镜(OM)型号为imager.M2 观察Splitting 后Ge 表面形貌,用原子力显微镜(AFM)测试表面粗糙度,用透射电镜(TEM)观察GeOI 的键合界面和Ge 表层的晶格像。
2 实验结果和讨论
为确定晶圆剥离温度,文中对不同剂量的H 离子注入Ge 晶圆退火后所发生的起泡(Blistering)动力学做了研究,研究表明,Ge 材料动力学曲线从低温到高温转折方向和其他材料相反,如图2 所示,Ge 表面起泡过程中,气泡内部的H 来自于注入时产生缺陷复合物的解析,解析过程按照结合能的大小,H 逐渐从缺陷复合物中释放出来,同时复合物的解离过程处于一种竞争机制下,当剂量比较高时,两种竞争机制会出现一定的融合。
H 离子注入Ge 片后,会在离子注入射程附近产生大量的缺陷,同时因为H 离子注入后会使Ge 片在H离子射程附近两边产生大量的非晶区,所以文中在利用智能剥离技术时需要考虑离子注入与低温键合以及它们之间的相互影响,找到温度和退火时间的最佳组合,这就是动力学曲线的意义。此时如果样品键合在衬底片上,随着退火时间的增加,裂纹不断地横向扩张直至整个发生断裂从而实现转移层。
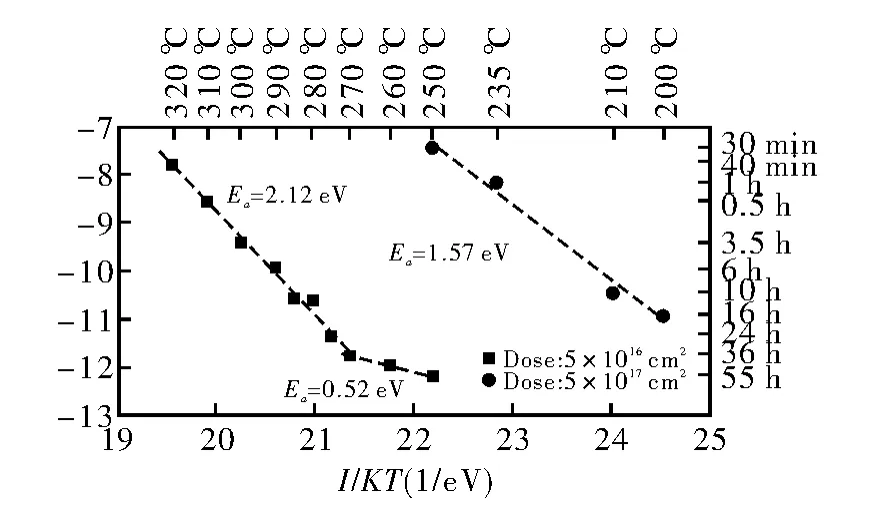
图2 不同剂量的H 离子注入Ge 片的动力学曲线
根据起泡动力学的研究结果,用智能剥离技术(Smart-cut)制备出的GeOI 样品首先用光学显微镜观察样品表面的形貌,样品A(未经腐蚀)即为没做过任何处理的GeOI 晶圆的光学显微镜图像,如图3 所示,未经过任何处理的样品A 表面有明显的连续起伏坡面同时有明显的纹路,由此得出经智能剥离技术(Smart-cut)制备出的GeOI 晶圆转移Ge 层(Splitting)表面相对比较粗糙。
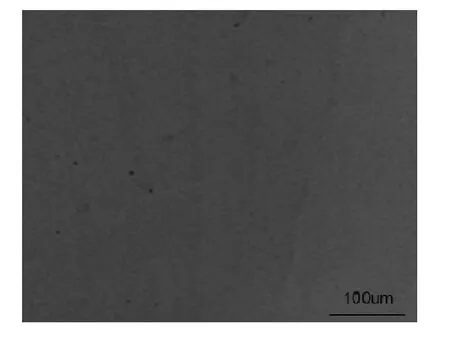
图3 样品表面的光学显微镜图像
为了能直观观察湿法化学腐蚀对样品的表面粗糙度的影响,文中用原子力显微镜(AFM)对样品A 和样品B 的表面进行观察,如图4 所示,样品A 样品表面粗糙度为13.277 nm,粗糙度较大,由3D 图可看到样品A表面不平稳,高低不平,起伏变化比较大;有许多凸出的尖端比其他部分多;样品B 粗糙度为9.236 nm,相对样品A 粗糙度要小,由3D 图可看到样品B 表面尖端凸出的部分已被腐蚀,表面比较平稳、高度起伏变化小。

图4 样品原子力显微镜(AFM)图像
证实了化学湿法腐蚀能够使GeOI 晶圆的表面粗糙度降低。同时为了清楚湿法化学腐蚀对GeOI 晶片微结构的影响,还对是否能去除GeOI 转移Ge 层非晶带做进一步的验证,通过对样品B 进行制样,在透射电镜(TEM)下对其截面进行观察,如图5 所示,GeOI晶片分层比较明显,上层为Ge 层,中间为埋氧层SiO2,底层为Si 片,经过湿法化学腐蚀过后表面平整,上层Ge膜厚度均匀,埋氧层SiO2层致密,Ge 与SiO2层、SiO2与衬底Si 层上下界面的陡直、界面清晰。再通过高分辨透射电镜(HRTEM)文中对样品B 的转移Ge 层晶体质量Ge 与SiO2层界面做进一步的观察,图5 中箭头所指分别为转移Ge 层晶体质量图像和Ge 片与SiO2埋氧层界面图像,由图可知顶层Ge 片晶格呈周期性排列,纹路清晰,晶格质量完好,没有观察到非晶态的晶格出现,证实湿法化学腐蚀已将转移Ge 层的非晶带腐蚀掉,Ge 与SiO2层键合界面陡峭清晰可见,没有观察到缺陷的存在,键合界面完整,得到的GeOI 晶片质量好。

图5 样品B 横截面的TEM 图像
相对与A 号样品(未经腐蚀)来说样品B(湿法化学腐蚀过)转移Ge 层表面发生了变化,这些变化的发生是由于样品未腐蚀前,样品表面起伏部位尖角处突出来较为明显的部分,自由能较高,平坦的部位自由能低,经NH3H2O:H2O2:H2O(1∶2∶200)溶液充分接触反应后,自由能高的地方先发生反应,自由能低的地方不反应或者反应极慢,导致样品表面凸出部位腐蚀速度比平坦部位要快的多,这样会先对凸出部位进行腐蚀,再对平坦部位腐蚀,当腐蚀进行一定时间后,凸出部位变得与平坦部位高度基本相同,表面不平整的地方经过腐蚀反应后变的平整,非晶带经过腐蚀反应过后被去除掉,腐蚀反应结束。所以得出GeOI 晶片经过湿法化学腐蚀过后,晶片表面粗糙度降低、表面变得也更加平滑,同时转移Ge 层表面非晶区已被去除。
4 结束语
通过实验可得到,化学腐蚀溶液NH3H2O:H2O2:H2O(1∶2∶200)与GeOI 晶片充分反应过后,能使GeOI晶片的转移Ge 薄层厚度以及表面粗糙度均有所降低,表面也变的更加的平滑,这对GeOI 晶片的研究起着重要作用。通过透射电镜看到湿法化学腐蚀过后的GeOI 晶片分层明显,表面平整,各界面处结构陡峭、清晰,同时未能观察到GeOI 晶片转移Ge 层非晶带区域(已被腐蚀掉),转移Ge 层晶格质量完好。因此,可得出采取湿法化学腐蚀方法不仅能去除GeOI 晶片转移Ge 层的非晶带,同时也能降低转移Ge 层表面的粗糙度,且其对GeOI 晶片质量提高有所帮助。
[1] Wu A M,Chen J,Wang X A.Very sensitive pressure senor on a SOI-on-cavity substrate[C].In Proceedings of 2007 IEEE Internation SOI Conference,2007:151-152.
[2] Stephen W,Bedel J William.Alanford inverstigation of surface blistering of hydrogen inplanted crystals[J].Journal Aal Physics,2001,90(3):1138-1146.
[3] Bruel M.Silicon-on-insulator iechnology materrials to VLSI[M].Roma:Kluwer Acdemic Poblishers,1997.
[4] Shangh Frankmm,Gusev E P.Germanium channel MOSFETs:Opportunities and challenges[J].IBM Journal Research,2006(50):377-386.
[5] Clarence J Tracy,Peter Fejes,Davil Theadore N,et al.Germanium-on-Insulator substrates by water boding[J].Journal Electro Mater,2004,33(8);886-892.
[6] Bruel M.Silicon-on-insultor material technology[J].Electronics Letters,1995(31):1201-1202.
[7] Hourahine B.Hydrogen molecules and piatelets in germanium[J].Physica:B,2006,37(6):103-108.
[8] Zahler J M.Gelayer transter to Si for photovoltaic applications[J].Thin Solid Films,2002,40(2):558-562.
[9] Rochat N,Tauzin A,Mazen F,et al.Germanium and silicon:a comparative study of hydrogenated interstitial and vacancy defects by IR spectroscopy[J].Electrochem Solid State Letter,2010(13):40-42.
[10]Alatsu T,Bourdelle K K,Richthrch C,et al.Study of exteded defect formation in Ge and Si after H ion inplantation[J].Applications Physics Letter,2005(86):181-190.
