溅射气压对铜基复合薄膜结合性能的影响
2024-12-31徐全国张健宗世强




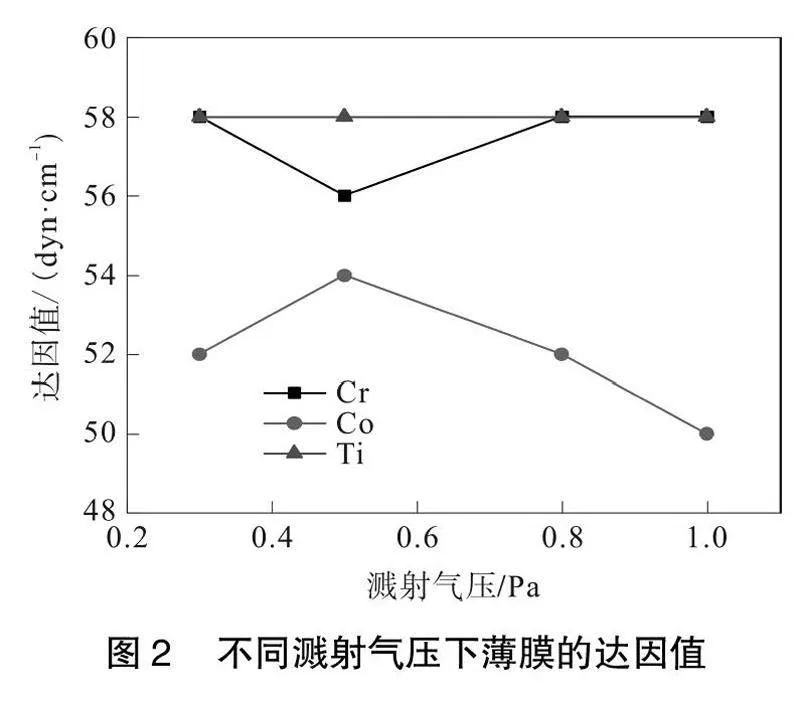
摘 """""要: "采用直流磁控溅射的方式,在镀有镍层的铜箔基底上改变设备溅射气压分别沉积铬、钴、钛薄膜,再用水电镀在这三3种薄膜表面制备铜膜,对薄膜的表面能和结合力进行研究,用达因法和万能拉力仪进行检测。结果显示表明:随着溅射气压的增大,铬薄膜的表面能先减小后增大,直到气压0.8"Pa时不再变化,钴薄膜的表面能先增大后减小,两种2种薄膜的表面能变化趋势都在气压0.5"Pa时发生转折,钛薄膜的表面能一直保持不变。铬和钴薄膜的结合力在0.3-~0.5"Pa时维持不变,之后开始下降,钛薄膜的结合力先上升再在降低,其在气压0.5"Pa时发生转变。
关 "键 "词:磁控溅射;结合力;表面能;溅射气压
中图分类号:TQ051.4 """"""文献标志码: A """""文章编号: 1004-0935(2024)07-00001005-0×4
近年来,随着我国电子类产品以及锂电池行业的发展,致使电解铜箔也向着越来越薄的方向发展[1-2]。采用传统的工艺很难制备且在运输过程中也会出现褶皱、撕裂等问题,会不利于后续的使用。目前,超薄铜箔[3]采用载体支撑可剥离的方法获取,整个构成部分由载体箔、剥离层和超薄铜箔层组成。此种方法制备的难点是处理好载体与铜箔的剥离问题。在制备复合铜箔过程中,许多学者认为,可在载体与铜箔层中间形成一个剥离层[4-5],从而控制载体箔与铜箔之间的结合力,致使载体箔与铜箔层间拥有一定的剥离强度,使其在热压加工后易于分离。在制备复合铜箔过程中[6-7],可将金属薄膜层用于制备剥离层的材料,运用磁控溅射技术进行沉积薄膜,其中如何把载体箔与铜箔间过渡的附着层做好是极为关键的,附着层与载体箔间结合力太差则附着薄膜生长不好,太强又会难以分离。
薄膜与基底之间的结合强度是限制着薄膜使用寿命和效果的重要因素,在薄膜与基底之间制备过渡层,利用其结构的过渡能更好的能更好地增强薄膜与基底之间的结合强度,使薄膜的内应力减少,能更好的能更好地提高薄膜的性能[8-11]。这里采用直流磁控溅射设备制备实验薄膜,直流磁控溅射成本较低,在后期的设备维护更加的便宜,能在低温、低压下能以较高的沉积速率制备出致密的薄膜,并且与基片结合力好,又不受基片种类的影响[12-15]。目前常见的制备薄膜方法有溅射法、真空反应蒸发法、溶胶-凝胶法、化学气相沉积法、电镀法、离子注入[16-17]。众多学者对薄膜结合力进行了深入研究,陈向阳等[18]在采用电弧增强磁控溅射设备制备了含有TiN过渡层的BCN薄膜,发现加入过渡层的BCN薄膜的摩擦学性能得到改善同时TiN过渡层显著降低了膜基和与薄膜膜之间结合面的晶格差异,改善了膜基间的结合力,致使BCN薄膜在磨损过程中不易脱落。周永等[19]利用线性阳极层离子源混合磁控溅射技术沉积Ti/Al-DLC薄膜,实验表明Ti/Al过渡层的添加,大大大幅改善了薄膜与基底物化性能的差异,也显著改善了基底与DLC薄膜晶格匹配差异与热膨胀系数不同引起的界面"""应力。
本文利用直流磁控溅射技术以不同的制备工艺在铜箔基底表面制备Ni-Cr、Ni-Ti、Ni-Co复合薄膜,然后在薄膜表面用水电镀的方法制备一层薄铜膜,并研究其结合强度。
1 "实验制备与检测部分
1.1 "试样制备
PVD500磁控溅射镀膜系统(如图1所示),腔室呈长方体形,靶位有3个实验所用为,直流溅射电源1个,中国科学院沈阳科学仪器股份公司生产的PVD500磁控溅射镀膜系统设备,腔室呈长方体型,靶位有3个,示意图如图1所示,直流溅射电源1个。腔室内采用靶在下、基板在上的结构,由下自上溅射,这可以防止细微颗粒落到基材上。基材为40"mm×ⅹ40"mm的铜箔,实验开始前把铜箔放入丙酮溶液中超声清洗15"min,,然后用去离子水冲洗,再用无尘纸沾上无水乙醇溶液擦拭,以清除表面的油脂等一些杂质,再用洗耳球吹干。屏蔽罩用砂纸和无尘纸擦拭一遍,屏蔽罩与靶材之间留有一定的间隙,防止在该处产生辉光放电。磁控溅射过渡层用纯镍靶材(纯度为99.9%),上层薄膜分别为纯铬靶材(纯度为99.9%),)、纯钴靶材(纯度为99.9%)和纯钛靶材(纯度为99.9%)。在高纯氩气(纯度为99.999%)氛围内制备薄膜。
实验前把铜箔固定到基板上,调节靶基距为120"mm,把基底的挡板关上,最后关闭腔室。打开总电源,通过机械泵和分子泵把腔室内的本底真空度抽至2×ⅹ10-3"Pa,固定氩气流量为40"mL·min-1,sccm,通过气动挡板控制Ni薄膜的生长压力为0.5"Pa,,沉积时间4"min,正式溅射前先欲溅射10"min以去除靶材表面的污染物。待过渡层沉积完成后在其再其上沉积铬薄膜,钴薄膜和钛薄膜沉积过程同沉积铬薄膜的一致(,具体沉积参数如表1所示)。为了控制溅射时基板的温度,保证薄膜的质量,采用冷却水来控制基板温度,同时基板随转架台匀速转动,使镀层渡层均匀,转速为2"r·pmin-1。
1.2 "实验检测
采用达因法和万能拉力仪分别对薄膜的达因值和结合力进行测定。
2 "实验结果与分析
2.1 "薄膜的表面能分析
膜材的达因值是材料表面吸附效果能力的体现,可以反映出膜材最外边层的表面能,即达因值越高,膜材表面能量越大,表面越不稳定。不同溅射气压下薄膜的达因值如图2所示,。在不同气体压强下Cr,Ti,Co薄膜达因值的变化由图2,可以看出,Ti薄膜的达因值整体最大,Co薄膜的最小,则表示Ti薄膜表面吸附粒子能力最强,Co薄膜吸附粒子能力最小且表面最稳定。在气体压强0.5"Pa下,3种薄膜的表面能平均来说是最大的。分析认为,钛薄膜表面的粒子排列比较松散,钴薄膜表面的粒子排列有规则且紧密。根据热力学原理可知道表面能的高低与晶粒尺寸大小有关系,表面能高的则表示薄膜表面的晶粒尺寸小。
2.2 "薄膜的结合力分析
图3为在不同溅射气压下制备的3种复合薄膜的膜基结合力。如由图3可知,在气压为0.2至0~0.5"Pa之内时,随着溅射气压的增大Ti薄膜的结合力也会增大,Cr和Co薄膜的结合力保持不变。其中Cr薄膜的结合力在为3至4~4"N之间,作为剥离层在其上沉积铜箔最为合适。分析认为,,在气体压强较低时,分子的平均自由程较大,这就减少了电子与氩气分子的碰撞概率几率,使电离产生的氩离子数目很少,进而轰击目标靶材的离子数目减少,导致从靶材表面逸出的靶材原子数目少,沉积在基底表面形成的薄膜厚度不够,同时靶材原子沉积在整个基底表面的能力不够,使薄膜的致密度变差,造成结合力不够理想。随着工作气压的增大,会使电离出的氩离子数目增多,从而使靶面溅射出更多的靶材原子,使薄膜厚度增大,促使薄膜表面致密性变好。当气体压强过大时,从靶材表面溅射出的原子不断增多,其溅射原子的平均自由程会变小,与Ar气原子的碰撞概率几率增大,使溅射原子的平均动能减小,沉积在基底表面的迁移能力减弱,形成的薄膜表面粗糙,晶粒间的间隙变大,致密度变差,使膜基结合力减小。其中Cr和Co薄膜比Ti薄膜能更早的地获得合适的溅射气压。分析认为,钛薄膜的溅射产额比钴和铬薄膜的少,在气压为0.3"Pa时相同数目的入射离子氩离子能从钴和铬靶材上溅射出的靶原子数目比钛靶材多,致使基底上的铬和钴薄膜形成过程比钛薄膜更早,好的表面致密性能更早地的达到。
图3所示3种薄膜整体结合力有明显的差距,分析认为其与薄膜间的晶格失配有关系,晶格失配通常与薄膜的晶格常数有关系,如下式所示[20]:]。
式中:a1与a2分别代表薄膜与基底的晶格常数
表格2中就是Cr、Co、Ti与Cu的晶格常数如表格2所示。由表2可知,钛与铜的晶格失配度最低,即钛与铜之间产生的晶体缺陷越小越容易结合,产生的结合力整体较铬与钴的要强。
3 "结 论
本文采用直流磁控溅射方式在铜箔上分别沉积了""3种复合薄膜,在再用水电镀的方法在薄膜表面制备一层薄铜膜,以寻求与铜膜合适的结合力。通过实验结果分析,在不同溅射气压下得到的薄膜表面能和结合力变化有以下得到结论如下:
(1)在不同溅射气压下制备出的薄膜,钛薄膜的表面能最大且不随溅射气压发生变化,钴薄膜的表面能整体最小,其表面吸附粒子能力最小,且表面最稳定,在溅射气压0.5"Pa下,3种薄膜的表面能平均来说是最大的。
(2)随着溅射气压的改变,3种薄膜与铜膜的结合力都有不同程度的变化。在溅射气压为0.5"Pa时,""3种薄膜与铜膜的结合力都是最大的,其中铬薄膜与铜膜的结合力在为3-~4"N范围内,适合作为剥离层。这""""3种薄膜与铜的晶格失配各不相同,钛与铜的晶格失配最小,其与铜的结合最好。
参考文献:
[[1]]"祝大同.世界及我国电解铜箔业的发展回顾[J].世界有色金属,2003,((08))::7-11
[[2]]"张洪文.在高密度互连中应用的超薄型铜箔[J].印制电路资讯,2006,((4))::9-1.
[[3]]"邓庚凤,何桂荣,黄崛起,等.可剥离型载体超薄铜箔的研究现状[J]. 有色金属科学与工程,2010,,1((06))::22-24+38.
[[4]]"高梨哲聪,,岩切健一郎,,杉元晶子,等. 高温耐热用带承载箔的电解铜箔的制造方法以及用该方法制得的电解铜箔:[P]. 日本,:CN1533450[P].,"2004-09-29.
[[5]]"吉冈淳志,,杉元晶子,,土桥诚,等. 带载体的电沉积铜箔及其制造方法:[P]. 日本:CN1335898[P].,2002-02-13.
[[6]]"YUUJI"Suzuki Yuuji, AKIRA Matsuda Akira. Method of producing ultra"-thin copper foil with carrier, ultra"-thin copper foil with carrier produced by the same, printed circuit board, multilayer printed circuit board and chip on film circuit board:[P]."US:,7223481[P].,2007"-05-29.
[[7]]"GALES R",LANNERS"R",STREEL"M","et al."Composite copper foil and manufacturing method thereof:[P]."US:,7153590[P].,2006-12-26.
[[8]]"KABIR"M S, MUNROE P, ZHOU"Z, et al. Study of the structure, properties, scratch resistance and deformation behaviour of graded Cr-CrN-Cr(1-x)AlxN"coatings[J]. Ceramics International,2018,44(10):"11364-11373.
[[9]]"张艺玮,,宋恒博,,李小燕,等.不同厚度Cr中间层对Gd/FeCo薄膜磁电阻效应转变的影响[J].物理学报,,2022,,71((21))::349-357.
[[10]]"李晓,,刘成,,陈道勇,等.过渡层Cr/Cr-Si中Si含量对不锈钢表面生长金刚石薄膜的影响[J].硅酸盐学报,,2020,,48((04))::608-614.
[[11]]"常潇,,赵青南,,王晓宏,等.碳氧化硅过渡层对玻璃基DLC薄膜性能的影响[J].硅酸盐通报,,2019,,38((10))::3033-3039.
[[12]]"张健,,齐振华,,李建浩,等.直流磁控溅射法制备GZO薄膜及其结构和光电性能的研究[J].真空科学与技术学报,,2022,,42((04))::311-316.
[[13]]"王誉,,张茂彩,,辛博,等.直流磁控溅射膜厚分布实测与数值模拟研究[J].真空科学与技术学报,,2022,,42((01))::37-45.
[[14]]"王朝勇,,李伟,,王凯宏,等.直流磁控溅射制备锐钛矿TiO2薄膜生长速率的研究及其在多层膜制备中的应用[J].真空,,2020,,57((05))::19-23.
[[15]]"高恒蛟,,徐友慧,,熊玉卿,等.直流磁控溅射技术在柔性基底上制备光电屏蔽薄膜的研究[J].表面技术,,2021,,50((03))::225-231.
[[16]]"包稚群,,丘克强.真空蒸发法从硫化锑渣中回收锑[J].有色金属((冶炼部分)),,2019((03))::11-14.
[[17]]"唐伟忠. 薄膜材料制备原理、技术及应用[M]. "北京:冶金工业出版社,2003:74 -"79.
[[18]]"陈向阳,,张瑾,,马胜利,,等.具有TiN过渡层的BCN薄膜制备与力学性能[J]. 稀有金属材料与工程,2016,,45((02))::503-506.
[[19]]"周永,,孔翠翠,,李晓伟,,等.Ti/Al过渡层对共掺杂类金刚石薄膜性能的影响[J]."表面技术,2019,,48((01))::268-275.
[[20]]"田民波,刘德令.薄膜科学与技术手册[M]. 北京:机械工业出版社,1991:850-860.
Effect of Sputtering Pressure"on Bonding Properties"of
Copper Based Composite Films
XU Quanguo, ZHANG Jian, ZONG Shiqiang
(School of Mechanical and Power Engineering,"Shenyang University of Chemical Technology, Shenyang"Liaoning 110142,"China)
Abstract:""By DC magnetron sputtering, chromium, cobalt and titanium films were"deposited on the copper foil substrate with nickel coating by changing the sputtering pressure of the equipment, and then copper films were"prepared on the three kinds of films by water electroplating."The results showed that, with the increase of sputtering pressure, the surface energy of chromium thin films first decreased"and then increased"until the pressure was"0.8"Pa, and the surface energy of cobalt thin films first increased"and then decreased, the change trend of surface energy of both films occurred"at a pressure of 0.5 Pa, and the surface energy of titanium films remained"unchanged. The binding force of chromium and cobalt thin films remained unchanged at 0.3~0.5"Pa and then began to decrease. The binding force of titanium thin films first increased and then decreased, and a transition occurred at 0.5"Pa.
Key words:""Magnetron sputtering; Binding force; Surface energy; Sputtering pressure
