晶态IGZO薄膜晶体管的研究进展
2023-08-16姜柏齐刘斌刘贤文张硕翁乐史大为郭建苏顺康姚琪宁策袁广才王峰喻志农
姜柏齐, 刘斌, 刘贤文, 张硕, 翁乐, 史大为, 郭建, 苏顺康,姚琪, 宁策, 袁广才, 王峰, 喻志农*
(1.北京理工大学 光电学院, 北京市混合现实与先进显示技术工程研究中心,北京 100081;2.重庆京东方显示技术有限公司, 重庆 400714;3.北京京东方显示技术有限公司, 北京 101520)
1 引言
薄膜晶体管(TFT)是使用半导体材料制成的绝缘栅极场效应管。近年来,薄膜晶体管液晶显示器在电视、电脑、手机和可穿戴电子设备等领域有广泛的应用[1]。作为液晶显示器的重要组成部分,薄膜晶体管对显示器大容量、高清晰度、高分辨率的显示要求具有重要作用。因此,提升薄膜晶体管整体的性能是提高液晶显示品质的关键。TFT通常由半导体薄膜、绝缘栅极和金属电极构成,对半导体薄膜材料的选择会直接影响晶体管的整体性能。
当前,金属氧化物铟镓锌氧化物(Indium Gallium Zinc Oxide, IGZO)作为宽禁带的n型半导体得到了广泛的关注,并被应用于薄膜器件(TFT)沟道层中[2]。其中非晶铟镓锌氧化物(a-IGZO)薄膜晶体管因其载流子迁移率高、柔性好、透明度高等特点在显示应用方面吸引了相关学者的极大关注[2-7]。然而a-IGZO薄膜晶体管在光照、偏压、温度等外界条件的影响下存在性能退化等可靠性问题[8-13]。研究人员对不同形态IGZO的内部机制进行了大量的研究发现,通过形成晶态IGZO替代原来的非晶IGZO有源层,所制备的TFT具有较好的均匀性[14],是提高IGZO TFT性能和稳定性的选择之一。
将晶态IGZO运用于TFT最早由Nomura等人[15]提出,并得到了性能优异的薄膜晶体管器件。随着对晶态IGZO TFT研究的不断推进,陆续出现了将c轴取向结晶、六方多晶IGZO、尖晶石型、纳米晶型以及原生晶型IGZO应用于薄膜晶体管的研究,在保持相应电学性能的情况下提升了器件稳定性,是薄膜晶体管未来发展的重要方向。本文总结了近年来晶态IGZO在薄膜晶体管中的应用,并展望了其未来发展前景。
2 单晶IGZO薄膜晶体管
2.1 IGZO的基本晶体结构
1985年,Kimizuka等人[16]首次识别出In-Ga-Zn-O系化合物晶相,他们对InGaO3(ZnO)n同系化合物(n=1~13)的粉末进行X射线衍射(X-Ray Diffraction, XRD),揭示了其晶相之间的关系和溶解度范围。该结构由沿c轴堆叠的金属氧化物层组成,当n为偶数时是三方晶系晶胞,n为奇数时是六方晶系晶胞。随着研究的推进,In-Ga-Zn-O系化合物晶体结构得到深入分析。以InGaO3(ZnO)晶体为例,Nespolo等人[17]将In2O3、Ga2O3和ZnO粉末放入铂管中,在1 200 ℃、2 GPa的压力下反应20 h,合成了较大尺寸的InGaO3(ZnO)晶体。根据其测定的结构参数,研究人员构建出的晶体结构模型如图1所示。所有阳离子和阴离子都在三角晶格上,如图1(a)。晶体结构由两部分组成:(1) In3+和周围6个O2-离子组成的InO6共棱八面体;(2) Ga3+或Zn2+和周围5个O2-离子组成的三角双锥。将InO6共棱八面体形成的层状结构描述为InO2-单元,同时将三角双锥结构描述为(GaZn)O2+单元,三角双锥的两个四面体平行于c轴堆叠。InO2-和(GaZn)O2+单元交替堆叠,如图1(b),层间经由共用的O2-离子相连,并沿着c轴排列。正是这样交替堆叠的单元组成了IGZO的基本晶体结构。
2.2 单晶IGZO薄膜晶体管的制备工艺与性能
类似于InGaO3(ZnO)晶体结构,InGaO3(ZnO)3是由InGaO3(ZnO)加上两个ZnO层组成的三方晶系晶胞。其在(GaZn)单元的上方和下方各有一层四面体纤锌矿型ZnO层,四层连续的三角双锥和四面体构成一个(GaZn3)单元。如图2所示,3个沿c轴方向重复的单元构成InGaO3(ZnO)3的基本结构[18-19]。
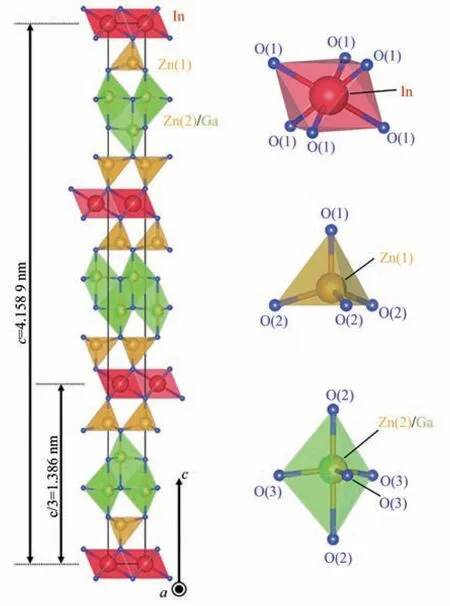
图2 InGaO3(ZnO)3的晶体结构,InO6为共棱八面体,Zn(1)O4为四面体,Zn(2)/GaO5为三角双锥[19]。Fig.2 Crystal structure of InGaO3(ZnO)3, InO6 has common-edged octahedron structure, Zn(1)O4 has tetrahedron structure, and Zn(2)/GaO5 has triangular bicone structure [19].
同理,在InGaO(3ZnO)3晶体结构的单元上下方各加入一层ZnO层可以得到基本单元。将其与周期性交替排列可得到InGaO(3ZnO)5的基本结构,如图3(a)。该周期性多层结构被称为“自然超晶格”[20],可以对二维层面的电子进行空间限制。其中层作为氧扩散的阻挡层,抑制氧空位形成,使得载流子在层内的横向移速远高于其在层和层之间的纵向移速。2003年,Nomura等人[15]提出并制备了单晶透明氧化物InGaO(3ZnO)5薄膜晶体管有源层,所得器件电流开关比和迁移率达到约106和80 cm2/(V·s),在390~3 200 nm波长范围内的光学透过率>80%。
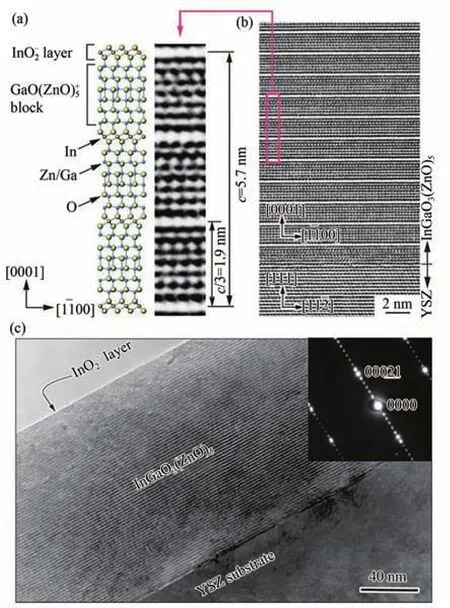
图3 (a) InGaO3(ZnO)5晶体结构;(b,c)通过固相外延反应在YSZ(111)上生长的InGaO3(ZnO)5薄膜的横截面透射电子显微镜(TEM)图像[15]。Fig.3 (a) InGaO3(ZnO)5 crystal structure; (b, c) Crosssectional TEM image of InGaO3(ZnO)5 thin films grown on YSZ(111) by reactive solid-phase epitaxy[15].
采用传统的气相生长技术制备层状结构和成分复杂的金属氧化物单晶薄膜较为困难,因此Nomura等人提出使用一种生长层状复合氧化物单晶的方法:反应固相外延技术(Reactive Solid-Phase Epitaxy, R-SPE)[21]。首先在600 ℃下利用激光脉冲沉积(PLD)制备2~200 nm厚度的ZnO外延层到单晶钇稳定氧化锆(YSZ)衬底上,然后在室温下将InGaO(3ZnO)5沉积到ZnO薄膜上,沉积过程与ZnO薄膜类似。沉积的InGaO3(ZnO)5和ZnO薄膜相对厚度将决定InGaO3(ZnO)m中m的大小。接下来在沉积薄膜表面覆盖YSZ板并将其置于1 400 ℃空气中退火0.5 h,最后得到单晶InGaO3(ZnO)5薄膜,横截面透射电子显微镜(TEM)图如图3(b,c)所示,可以见到清晰的层状结构。
2014年,Yoshinori等人[22]在未沉积ZnO外延层的情况下成功制备出单晶InGaO3(ZnO)3薄膜。他们首先在YSZ衬底上沉积c轴取向结晶IGZO薄膜,而后1 200 ℃高温退火1 h,将其转化为单晶IGZO薄膜,最后所得TFT器件开关比约为107,迁移率为8.1 cm2/(V·s),各项性能均优于未经高温退火的CAAC-IGZO TFT器件。随着对单晶IGZO研究的深入,研究人员还提出了很多制备单晶IGZO的方法,如光学浮区法制备大尺寸InGaO3(ZnO)[19]、基于溶液前驱体的固相扩散生长InGaO3(ZnO)n纳米线[23]等,但其制备方法并不适用于薄膜晶体管,在此不展开讨论。
总的来说,单晶IGZO薄膜晶体管具有良好的场效应迁移率、开关比以及稳定性,但是制备条件非常严苛,过高的退火温度导致其暂时无法投入实际生产应用中。研究人员需要探究可以低温制备且能投入实际应用的晶态IGZO。
3 C轴取向结晶IGZO薄膜晶体管
3.1 CAAC-IGZO的晶体结构
在实际生产过程中,由于YSZ基板成本较高,难以实现大规模生产。因此科研人员对在其他衬底上制备IGZO的方法进行了研究。2009年,Yamazaki等人[24]首次发现,IGZO可以在600~700 ℃的高温退火下从薄膜内部结晶,并且在距离该薄膜表面深度约5 nm的区域内有平行于表面的层状晶体。由于该区域晶体的c轴垂直于表面,因此这种晶体被命名为c轴取向晶体(C-Axis Aligned Crystalline, CAAC)。CAAC-IGZO是介于单晶和非晶之间的一种晶体形态,具有连续的晶格结构。相较于多晶和非晶材料,CAAC-IGZO的结构更接近单晶[25],如图4所示。其中亮点为原子序数较大的In,一层In层(亮点)和两层Ga或Zn层(暗点)交替排列。同时可以看出,CAACIGZO薄膜和单晶InGaZnO4具有相同晶体结构和相似的In、Ga和Zn原子间距,沿c轴周期性排列。图5为大视场下观察到的CAAC-IGZO薄膜,其内部晶体结构连续,无明显晶界。同时薄膜表面凹凸不平,但内部IGZO原子层始终平行于不均匀表面。放大的截面TEM图如图6(a)所示,对圆圈中表示的每个区域进行快速傅里叶变换(Fast Fourier Transform, FFT)处理(图6(c)),可以清晰地观察到区域内关于c轴排列的点,并且c轴取向角变化平稳[24]。虽然CAAC-IGZO薄膜具有沿c轴的排列,但与单晶IGZO薄膜不同的是,其在a~b面不具有排列结构。

图4 (a) 单晶InGaZnO4、(b) CAAC-IGZO薄膜和(c)InGaZnO4模型的HAADF-STEM截面图[18]。Fig.4 Cross-sectional HAADF-STEM images of (a) singlecrystal InGaZnO4, (b) CAAC-IGZO film and (c)InGaZnO4 model[18].

图5 (a) CAAC-IGZO薄膜TEM图;(b)图(a)表面部分放大图;(c) 对(b)重建的反傅里叶变换图[24]。Fig.5 (a) TEM image of CAAC-IGZO thin film; (b) Enlarged image of (a) surface part; (c) Inverse Fourier transform image reconstructed from (b)[24].

图6 (a)图5中的放大TEM截面图;(b)边界区域放大图; (c)圆形区域的FFT分析[24]。Fig.6 (a) Magnified image of a boundary region in Fig.5(b); (b) Enlarged boundary region; (c) FFT analysis of circular region[24].
3.2 CAAC-IGZO薄膜晶体管的制备工艺与性能
Yamazaki等人[24]在600~700 ℃高温下退火结晶形成CAAC-IGZO,但是长时间退火会导致IGZO晶体内部形成多晶,从而产生不完全的CAAC薄膜。因此,为制备良好的CAAC结晶形貌,研究人员发现了在较高衬底温度下溅射沉积可以得到结晶态薄膜,该方法被称为原位退火法。其有两个基本要素:衬底温度和氧流量比。
Kimizuka等人[18]使用原子比In∶Ga∶Zn=1∶1∶1的InGaZnO4多晶靶材,通过溅射法在石英衬底上沉积100 nm CAAC-IGZO薄膜。同时变化溅射时衬底温度和氧流量比,得到如图7所示XRD图。当溅射沉积时衬底温度和氧流量比越高时,XRD峰值强度越高,CAAC-IGZO的结晶度越高。2014年Lynch等人[26]在0.665 Pa的Ar和O2气氛中使用射频磁控溅射系统制备了c轴取向的IGZO晶体。他们发现在190 ℃沉积温度下制备的薄膜为非晶结构,而衬底温度达到310 ℃能够得到c轴取向结晶,且在10% O2分压下晶体具有较为一致的c轴取向。但随着O2分压的增长,晶体c轴取向的一致性会减弱,形成随机排列的纳米晶粒形貌。Hsu等人[27]在150~200 ℃的衬底上溅射制备IGZO薄膜时发现,较低的衬底温度可以控制初始成核的分布以及后续晶粒尺寸,从而提高栅极电介质和有源层间的界面质量。而后,他们对所得薄膜后退火并制备薄膜晶体管,器件在500 ℃后退火下迁移率为1.33 cm2/(V·s),开关比约为105,另外器件具有极低的关态电流和亚阈值摆幅。这是因为c轴取向IGZO结晶程度的提高导致薄膜通道内影响关态电流的氧空位减少。为了进一步探究衬底温度和氧气比例和IGZO结晶质量的关系,Zhu等人[28]使用区域探测器衍射系统(General Area Detector Diffraction System, GADDS)对不同衬底温度和氧流量比下制备的IGZO薄膜进行测试,通过分析X射线在θ和χ两个方向的数据分别得出CAAC-IGZO结晶程度和温度、氧流量比的关系。如图8(a)所示,在200~310 ℃之间,随着衬底温度的升高,薄膜XRD峰值强度增强,CAAC-IGZO的结晶度升高。χ方向的FWHM变化则表明,在185~250 ℃时曲线峰值宽度下降,薄膜晶体排列逐渐有序,在250~310 ℃下排列良好,而继续提高温度晶体失去排列。如图8(b)所示,当氧流量比达到20%时,XRD峰值强度趋于稳定,结晶度较高,并且晶体排列的有序程度较高。根据结晶度和晶体排列的量化分析得到图8(c),在低氧分数或衬底温度下,只有a-IGZO形成;随着O2气流量比例或衬底温度的升高,薄膜进入到c轴取向结晶区;而随着O2气流量比例或衬底温度的进一步升高,排列丢失,薄膜倾向于形成无序排列的多晶IGZO。
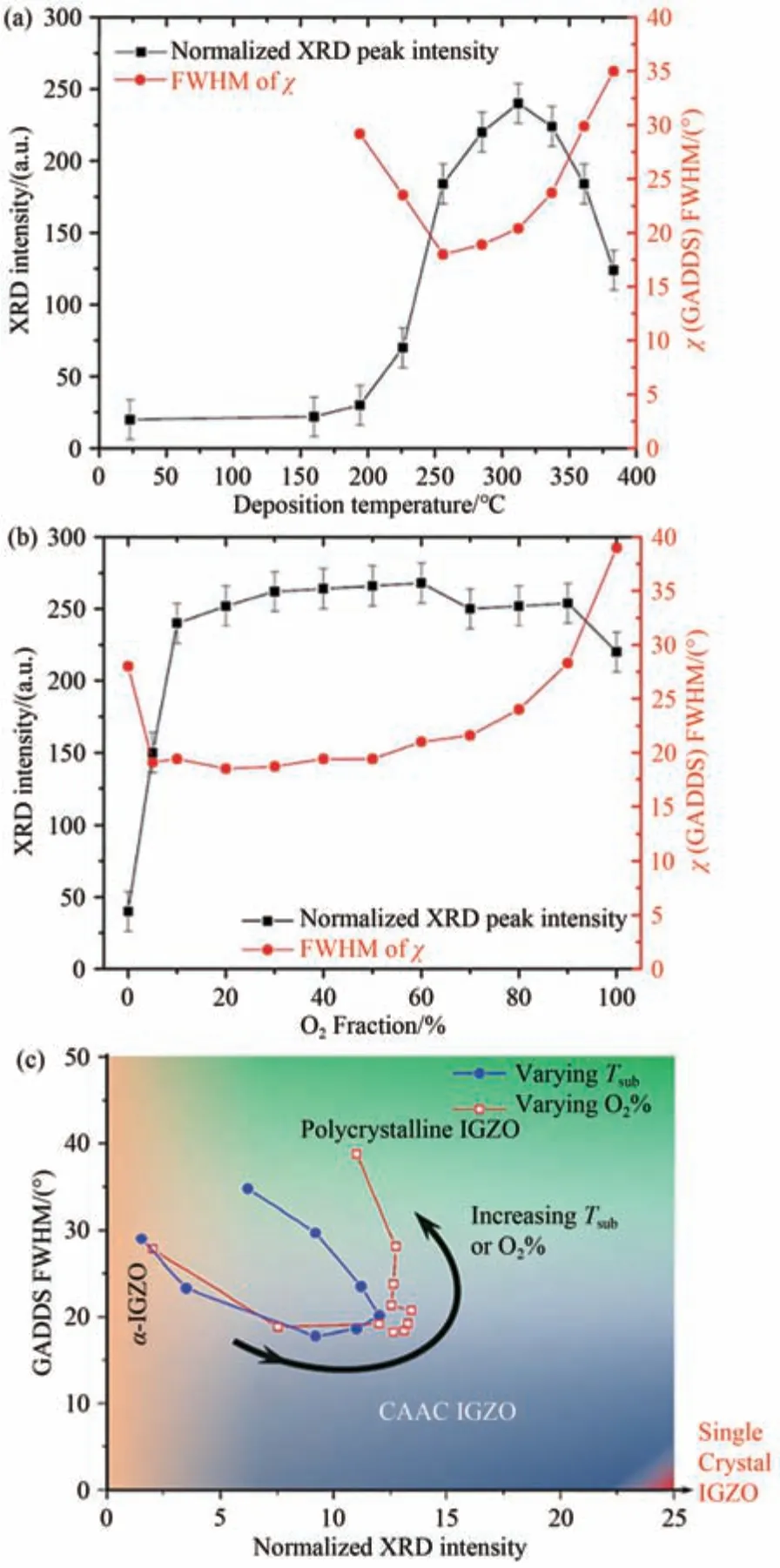
图8 (a)不同衬底温度和(b)不同氧流量比下的XRD衍射峰强度和χ方向的FWHM关系;(c)IGZO的结构相示意图,其中x轴为XRD强度(结晶程度的度量),y轴为χ方向的FWHM值(晶体排列的度量)[28]。Fig.8 FWHM relationship between XRD diffraction peak intensity and χ direction at different (a) substrate temperature and (b) oxygen flow ratio; (c) Schematic diagram of the structural phase of IGZO,where the x-axis is the XRD intensity and the yaxis is the FWHM value in the χ direction [28].
在上述研究中,只有在较高的衬底温度下溅射才能获得CAAC-IGZO。Zhang等人[29]提出Zn含量是影响IGZO薄膜结晶的重要因素,Zn含量的提升有助于晶态IGZO薄膜形成。Zn含量越高,IGZO结晶所需的衬底温度越低。基于该发现,Zhang等人使用原子比In∶Ga∶Zn=0.42∶0.25∶1的IGZO多晶靶材,通过溅射法在室温下引入氧分压制备得到了c轴取向的IGZO薄膜,所得器件在氧分压为12 mPa时TFT迁移率达到4.49 cm2/(V·s),开关比约为107。随后,他们对其进行后退火处理,由于氧空位相关缺陷减少,器件在300~400 ℃下迁移率提高至9.03 cm2/(V·s)。
3.3 CAAC-IGZO薄膜晶体管的稳定性
氧化物TFT的不稳定性主要是由不同外界应力以及其多种组合引起的[30]。其中,VTH偏移的主要原因是载流子(电子或空穴)在栅极电介质和氧化物半导体间的界面处被捕获[31]。例如,在正栅极偏压应力(PBS)条件下,电子在IGZO/栅极电介质界面处被捕获,导致VTH正向偏移。此外,在正栅极偏压温度应力(PBTS)的环境下,氧相关缺陷处的电子俘获会导致VTH的大范围偏移和异常电子转移行为[32]。相比于传统的薄膜晶体管沟道,CAAC-IGZO沟道在不同的栅偏压、温度和光应力等条件下表现出较好的稳定性。
Kang等人[33]针对CAAC-IGZO薄膜晶体管电学和光学稳定性进行了研究,分别对a-IGZO、纳米晶型IGZO(Nanocrystalline, nc-IGZO)和CAAC-IGZO薄膜晶体管进行了正负偏压应力和光学稳定性测试。图9(a)、(b)、(c)表明,在正栅极偏压及其他环境组合应力测试中,由于nc-IGZO中存在晶界和氧空位相关缺陷,nc-IGZO TFT的ΔVTH远大于a-IGZO TFT和CAAC-IGZO TFT,其稳定性较差。负栅极偏置及其他环境组合应力测试结果如图9(d)、(e)、(f)所示。通常在IGZO TFT器件中,负栅极偏压和光照(NBIS)条件下产生的光生空穴被IGZO薄膜深能级缺陷捕获,被捕获的空穴随着负栅极偏压注入SiO2薄膜等栅极电介质的缺陷态,从而导致VTH的负向偏移[34]。在测试中,CAAC-IGZO TFT表现出更小的VTH偏移。随着时间的推移,CAAC-IGZO TFT的VTH偏移趋于饱和(图9(f)),而a-IGZO TFT则表现出持续的VTH负向偏移(图9(e))。由于a-IGZO和CAAC-IGZO膜有相似带隙(a-IGZO:3.76 eV,CAAC-IGZO:3.71 eV),可以认为在光强和栅极偏压相同的情况下,两器件注入到栅极电介质缺陷态的光生空穴数量相似。因此,a-IGZO薄膜中较大VTH负向偏移可以归因于其具有大量与氧空位缺陷相关的深能级态,而晶态半导体具有较少的深能级态。

图9 a-IGZO、CAAC-IGZO和nc-IGZO在(a) HCS、(b) PBS和(c) PBTS测试中阈值电压变化和应力作用时间的关系;(d) NBIS测试过程中a-IGZO和CAAC-IGZO阈值电压变化和应力作用时间的关系;(e) a-IGZO和(f)CAAC-IGZO TFT在NBIS测试中的转移特性曲线;a-IGZO和CAAC-IGZO TFT在(g)紫外脉冲和(h)连续紫外光照射下的瞬态光响应曲线[33]。Fig.9 Relationship between threshold voltage change and stress time in (a) HCS,(b) PBS and (c) PBTS tests of a-IGZO, CAAC-IGZO and nc-IGZO; (d) Relationship between a-IGZO and CAAC-IGZO threshold voltage variation and stress action time during NBIS test; Transfer characteristic curves of (e) a-IGZO and (f) CAAC-IGZO TFTS in NBIS tests; Transient light response curves of a-IGZO and CAAC-IGZO TFT under (g) ultraviolet pulse and (h) continuous ultraviolet light irradiation[33].
除了电学不稳定性外,光致不稳定性如光致电导变化和持续光电导效应(Persistent Photoconductivity, PPC)是另一个产生不稳定性的重要因素。具体来说,氧化物半导体暴露在光照下时,即使停止光照,光诱导电流也会继续存在。有分析认为,这种现象是由于光照时氧化物通道中过氧化物的形成[35]或氧空位(VO)的光电离(VO→VO++e-或VO→VO2++2e-)[36]引起的。而光电离氧空位的中和过程需要活化能[37]。因此,多余的光生电子倾向于在通道层中停留较长时间,从而导致持续的高导电性。图9(g)和图9(h)分别显示了脉冲和连续紫外线(UV)光照下随时间变化的漏极电流变化(ΔI)。无论是何种输入光,CAAC-IGZO TFT对光的响应都弱于a-IGZO TFT。尤其在脉冲紫外条件下,10次脉冲后a-IGZO TFT的光生电流约为33 μA,CAAC-IGZO TFT的约为0.3 μA。在连续紫外光照射下,ΔI分别约为100 μA和57 μA。这表明CAAC-IGZO TFT能有效地抑制光电流的产生,在光照下表现出较好的稳定性。另外,CAAC-IGZO TFT具有较低的光生电子重组和中和活化能,因而具有较弱的PPC效应。
综上所述,CAAC-IGZO TFT在电学和光学等环境组合应力条件下,表现出更高的稳定性,这与CAAC-IGZO TFT沟道中含有较少的氧空位相关深能级缺陷态以及CAAC-IGZO薄膜中较低的光生载流子重组和中和活化能相关。
3.4 金属诱导结晶制备CAAC-IGZO薄膜晶体管
金属诱导结晶(Metal Induced Crystallization,MIC)是指将非晶半导体与金属相接触,从而诱导非晶半导体在极低的温度下结晶的过程。MIC可以在很大程度上降低非晶半导体薄膜的晶化温度,为低温下直接在热敏基底上制备晶体半导体器件提供了一种全新途径[38]。MIC过程早期被应用于非晶、纳米晶、微晶和多晶形态硅和锗硅的结晶[39],随着研究的深入,被引入诱导金属氧化物结晶的应用中。其基本过程是:诱导金属的阳离子将其价电子传输到金属氧化物材料中,通过在固体氧化物晶格中的迁移,暂时破坏金属—氧键(M—O键),使[MOx]多面体旋转并在较低能量的结晶相中与邻近的[MOx]基团重组键[40]。根据系统的不同,阳离子可以有利于或不利于特定晶体相的形成,从而成为一种调节纯度和晶体相比的方法。
近年来,不断有研究人员将金属诱导结晶和薄膜晶体管的制备联系起来。最近,Jeong团队[41]证明了利用金属钽(Ta)进行的MIC工艺沉积的非晶半导体在低温下可以产生高质量的ZnSnO3晶体半导体。随后,Jeong等人又相继实现了金属Ta诱导金属氧化物IGZO[42]、ZnON[43]和IGO[44]在较低温度下结晶,并制备得到了性能优越、稳定性高的薄膜晶体管器件。其中,a-IGZO经过Ta诱导结晶过程所得结晶为c轴取向结晶IGZO[45],具体制备流程如下:首先使用原子比In∶Ga∶Zn=1∶1∶1的靶材在Ar气氛下溅射沉积15 nm a-IGZO,而后置于400 ℃的O2环境中进行1 h的后退火。然后在形成的a-IGZO薄膜上溅射沉积20 nm Ta薄膜作为结晶诱导层,置于300 ℃的O2环境中后退火处理1 h,实现CAAC-IGZO的诱导结晶。该MIC过程降低IGZO薄膜结晶温度的主要原因是诱导金属促成了M—O键的断裂,而后金属原子In和Ga进行重排和局部扩散。如图10(a)所示,Ta层向下层IGZO释放电子,这些电子转移到M—O键的反键轨道上,削弱了M—O键,在之后的退火中,弱化的M—O键可能会断裂。随后由于晶态和非晶态IGZO之间吉布斯自由能差异所形成的热力学驱动力,热断裂的M—O键重新排列,形成较为稳定的晶态结构[42]。如图10(b),(c)所示,TEM图像中出现了明显的CAAC-IGZO层状结构,且相较于a-IGZO薄膜,其XRD图谱出现明显c轴取向结晶峰。通过Ta诱导结晶制备的CAAC-IGZO TFT整体性能优越,迁移率达到54 cm2/(V·s),开关比约为107[42],相较于a-IGZO TFT,其在电学性能和器件稳定方面都得到了很大提升。

图10 (a) Ta金属层诱导IGZO结晶原理示意图[42]; (b)包含Ta/IGZO层的闪存器件截面的TEM图(左图),IGZO的结晶度在所选区域电子衍射(SEAD)(右图),FFT(右小图);(c) 300 ℃和O2气氛下退火1 h后CAAC-IGZO和a-IGZO材料在Si上的XRD图谱[45]。Fig.10 (a) Schematic diagram of IGZO crystallization induced by Ta metal layer[42]; (b) Transmission electron microscopy image of flash memory device containing Ta/IGZO layer (left), IGZO crystallinity electron diffraction (SEAD) in the selected region (right), Fast Fourier Transform (FFT)(small right figure); (c) XRD patterns of CAACIGZO and a-IGZO on Si after annealing at 300 ℃and O2 for 1 h [45].
总而言之,金属诱导结晶过程降低了CAACIGZO的制备温度,同时提高了器件性能,为在有工艺限制温度(<400 ℃)的玻璃和柔性基底上制备高性能CAAC-IGZO TFT提供了新思路。
3.5 CAAC-IGZO薄膜晶体管的应用
由于CAAC-IGZO具有高场效应迁移率和极低的关态电流,CAAC-IGZO TFT在有机发光二极管(Organic Light-Emitting Diode,OLED)显示技术中有广泛的应用。相较于传统OLED显示器中使用的低温多晶硅(Low Temperature Polysilicon, LTPS) TFT,CAAC-IGZO TFT不需要进行激光晶化,因此其显示器具有高均匀性和高画质。2022年,Kato等人[46]将Si CMOS和CAACIGZO TFT整体集成,在Si CMOS上制造了驱动电路,使用CAAC-IGZO TFT制造了像素电路,并以高驱动电压串联OLED,成功制造了像素密度超过5 000 ppi的OLED显示器样机。另外CAAC-IGZO TFT极低的关态电流使得其可以应用于随机存取存储器[47]和非易失性触发器[48]等数字元件的制造,在大规模集成电路(Large Scale Integration,LSI)中有广阔的应用前景。表1为量产过程中CAAC-IGZO薄膜的制备条件,所得器件迁移率需大于10 cm2/(V·s)[49]。

表1 CAAC-IGZO薄膜的制备工艺参数[18]Tab.1 Preparation conditions for CAAC-IGZO thin film[18]
4 多晶IGZO薄膜晶体管
4.1 六方多晶型IGZO薄膜晶体管
2009年,Nakata团队[50]利用准分子激光器辐照射非晶态IGZO薄膜,制备了多晶IGZO薄膜晶体管,但其通过激光结晶制备的TFT没有任何I-V特性,同时没有详细鉴定多晶IGZO的结构。Park等人[51]通过射频溅射法制备了IGZO薄膜,置于300~1 000 ℃的空气环境中退火。在退火温度达到800 ℃时,薄膜XRD图谱出现了六方In2Ga2-ZnO7的结晶峰,表明多晶IGZO的形成。所得六方多晶IGZO TFT器件迁移率为6.16 cm2/(V·s),开关比约为108,与非晶IGZO TFT相比电学性能有所下降。这是由于多晶结构存在较多的晶界散射,载流子在通过晶界的过程中会损失能量,导致器件迁移率下降[52]。但是多晶IGZO TFT的器件稳定性有显著提升,因为薄膜结晶导致栅极绝缘层和沟道层之间或沟道层本身陷阱密度减小。
由此可见,六方多晶型IGZO薄膜晶体管虽然在器件稳定性上有了显著提升,但其受到多晶结构的限制较大,器件性能较差,与高性能需求相悖,应用价值较低。
4.2 尖晶石型IGZO薄膜晶体管
尖晶石型IGZO是以尖晶石型ZnGa2O4(GZO)晶体结构为基础的结晶形态。尖晶石型GZO属于Fd3m空间群,氧原子呈现变形面心立方堆积,Ga占据八面体空隙位置,Zn占据四面体空隙位置[53-54]。尖晶石型IGZO的基本结构为ZnInxGa2-xO4,相较于GZO,其在八面体位置上有50%的Ga原子被In取代,并且In和Ga原子可以以7种对称不相等的方式分布在八面体位置上[55],图11(a)所示为其中一种尖晶石型IGZO的晶体结构。
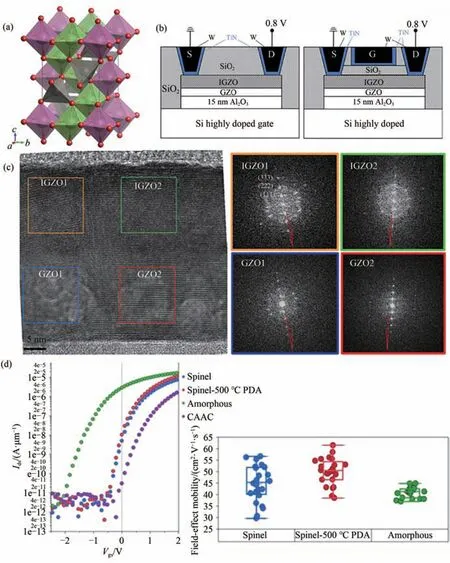
图11 (a)原子比 In∶Ga=1∶1的尖晶石IGZO参考构型,属于空间群P2221(17),In(粉色)和Ga(绿色)交替占据八面体空隙,Zn(灰色)占据四面体空隙;(b)多晶尖晶石型IGZO TFT结构;(c)左图为尖晶石型GZO模板和沉积其上IGZO薄膜的TEM截面图,右图为各指定区域的FFT变换图像;(d)左图分别为尖晶石、500 ℃退火后的尖晶石、非晶和CAAC IGZO TFT的转移特性曲线,右图为相应的场效应迁移率[55]。Fig.11 (a) Reference configuration of spinel IGZO with atomic ratio In∶Ga=1∶1, represented in the space group P2221(17),In (pink) and Ga (green) occupy octahedral coordinated sites alternately, Zn (gray) occupies tetrahedral coordinated sites; (b) Polycrystalline spinel IGZO TFT structure; (c) The left image shows the TEM cross-section of the spinel GZO template and the IGZO film deposited on it, the image on the right is the FFT transform image of each specified region; (d) The left figure shows the transfer characteristics of spinel, the spinel with 500 ℃ PDA, amorphous and CAAC IGZO TFT, the graph on the right shows the corresponding field-effect mobility[55].
尖晶石型IGZO薄膜最早由Shimomura等人[56]制备,通过对非c轴取向的IGZO薄膜(后被证实为nc-IGZO薄膜[18])进行激光结晶形成尖晶石型IGZO。近年来,为了在保持金属氧化物薄膜晶体管高迁移率的同时提高器件的稳定性,不同类型IGZO结晶态受到广泛研究,尖晶石型IGZO也逐渐受到重视。2022年Dekkers等人[55]利用改变衬底温度(Td)溅射沉积薄膜的方法,在200 ℃的衬底温度下制备了尖晶石型IGZO与非晶以及CAAC IGZO的混合薄膜。
该方法在沉积过程中不会直接形成尖晶石微晶,而是首先形成原生结晶IGZO薄膜[57]。因此,为了得到不含其他结晶相的尖晶石型IGZO TFT,Dekkers等人利用模板效应,将IGZO薄膜沉积在尖晶石型GZO衬底上。虽然IGZO和GZO之间存在晶格失配,但其容易在GZO模板上生长,并可以保留尖晶石型多晶结构,如图11(c)所示。而后,将制备得到的多晶尖晶石型TFT(图11(b))置于500 ℃的O2环境下后退火,所得器件场效应迁移率达到了50 cm2/(V·s),高于a-IGZO TFT(图11(d))。尽管尖晶石型IGZO具有多晶结构,但相较于六方相,尖晶石相的单晶IGZO具有较小的有效电子质量,因而电子迁移率较大。
综上,尖晶石多晶型IGZO薄膜晶体管具有较高的迁移率,是制备高性能薄膜晶体管候选材料之一。但是对于尖晶石多晶型IGZO材料的研究尚处于初始阶段,其多晶结构中存在的晶界散射以及可靠性等问题还缺乏系统性的研究和讨论。
5 其他结晶种类IGZO薄膜晶体管
5.1 纳米晶型IGZO薄膜晶体管
纳米晶型IGZO(nc-IGZO)是介于单晶和非晶IGZO之间的一种中间态。纳米晶型IGZO薄膜由大量纳米尺寸的晶体团簇组成,薄膜内部没有明显的晶界,具有较稳定的晶体结构[58]。相较于CAAC-IGZO,nc-IGZO晶体团簇尺寸较小,且不具有长程有序结构。2014年Sorida等人[59]发现在常温下沉积的IGZO薄膜经过450 ℃退火后,薄膜内部存在微小结晶结构,即纳米晶型IGZO。而后,Waseda等人[58]对纳米晶型IGZO薄膜的结构进行研究,发现nc-IGZO的晶体团簇结构由长程有序的IGZO晶体层状结构分解而成。薄膜内部的InO6八面体向较小的InO5或InO4转变,并和(GaZn)O2+三角双锥形成中程有序的结构,如图12所示。而后,利用反蒙特卡洛模拟(RMC)计算可以得出nc-IGZO晶体团簇尺寸为1.8 nm。该纳米晶簇复杂的结构和不规则的原子排列提高了薄膜对原子重排的弹性,使nc-IGZO薄膜结构更加稳定。随后研究人员对其在薄膜晶体管应用中的电学性能进行了研究。Kang等人[33]采用射频溅射法制备了nc-IGZO TFT,器件迁移率为1.3 cm2/(V·s),开关比约为109,器件性能差于a-IGZO和CAAC-IGZO TFT。之后,Obonai等人[60]在室温下沉积IGZO薄膜,并在沉积过程中改变O2的比例(O2/Ar+O2)。实验发现随着O2气体流量比的增加,纳米晶型IGZO沉积的结晶度和c轴对准度都有所提高,薄膜晶体管迁移率也有所提升。在O2气流量比为50%的条件下,nc-IGZO薄膜晶体管表现出良好的性能,器件场效应迁移率约为20 cm2/(V·s)。然而,Glushkova等人[61]在室温及O2气流量比为80%的条件下沉积IGZO薄膜时却没有观察到nc-IGZO的存在,关于nc-IGZO的研究还需深入进行。

图12 nc-IGZO薄膜晶体结构,其中白色为InOx,条纹为GaOy,灰色为ZnOz,白色椭圆为中程有序团簇结构[58]。Fig.12 Crystal structure of nc-IGZO film, where white is InOx, stripe is GaOy, gray is ZnOz, and white ellipse is mid-range ordered cluster structure[58].
由此可见,在nc-IGZO薄膜沉积时选择合适的氧气流量比例,可以提高薄膜结晶取向的排列有序程度,优化薄膜结晶质量,提升TFT器件性能。此外nc-IGZO能够在室温下沉积形成,符合批量生产的要求。但是nc-IGZO的制备和形成条件目前还存在许多争议,有待进一步研究。
5.2 原生结晶型IGZO薄膜晶体管
在非晶/多晶硅系统的转变过程中,存在一种非晶和纳米晶相混合共存的形态,称为原生结晶态(protocrystalline),该形态由非晶氢化硅(a-Si∶H)和少量纳米晶粒组成[61]。Si∶H生长的原晶形态由薄膜厚度和氢的稀释率决定[62]。在Si∶H原生结晶中,a-Si∶H的生长占主导地位,但随着薄膜厚度的增加,转变为非晶和纳米晶的混合相生长[63]。类比原生结晶型Si∶H,原生结晶型IGZO定义为a-IGZO随着沉积时氧气比例和沉积厚度的增加而向混合非晶+纳米/微晶相演变的生长形态。原生结晶型IGZO仅在中等沉积温度(Tsub=200 ℃)下形成,如图13所示。当Td=25 ℃时,薄膜呈非晶形态;随着Td的提高,薄膜底层开始出现具有层状结构的纳米晶型IGZO;当Td=200 ℃时,CAAC-IGZO开始形成,同时,随着氧气比例和薄膜厚度的增加,尖晶石型微晶IGZO逐渐形成,该混合了非晶、纳米晶和微晶的形态即为原生结晶;而当Td=300 ℃时,薄膜中的CAAC-IGZO开始占据主导地位。
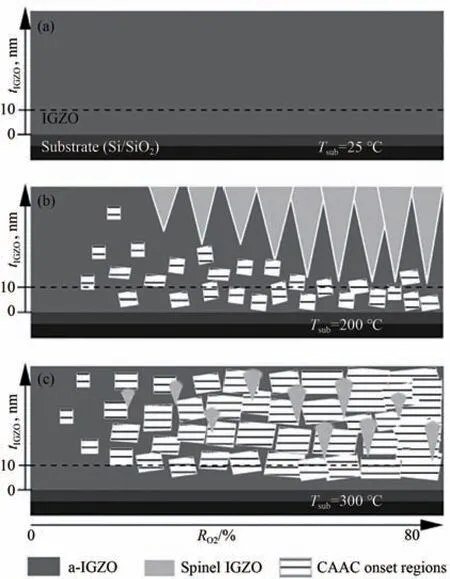
图13 原生结晶型IGZO的生长过程[57]Fig.13 Formation process of protocrystalline IGZO [57]
Glushkova等人[57]通过改变沉积的衬底温度和氧气浓度,分别制备了非晶、原生结晶和CAAC型IGZO TFT。相较于a-IGZO TFT的低稳定性和CAAC-IGZO TFT不可兼得的最高性能和最佳稳定性,原生结晶型IGZO TFT在氧气比例为20%时器件的迁移率为13.5 cm2/(V·s),在PBS和NBS下的开态电压的偏移分别为0.043 V和-0.215 V,表现出了高性能和良好的稳定性。因此,原生结晶型IGZO是提升薄膜晶体管性能和稳定性重要选择之一。
6 结论
本文系统介绍了晶态IGZO和其薄膜晶体管的研究进展。阐述了各类晶态IGZO薄膜的结构,分析了晶态薄膜的结构和电学特性的关系,总结了各类晶态薄膜晶体管的制备方法、器件性能和稳定性。总的来说,晶态IGZO TFT相较于a-IGZO TFT具有电子迁移率高、稳定性好、漏电流小等优点。目前,以CAAC-IGZO为主的晶态IGZO TFT在显示器和大规模集成电路等领域得到了广泛应用,同时也在新型光电子器件和智能电子设备等领域中有着广阔的应用前景。
然而,当前对晶态IGZO薄膜晶体管的研究相对较少,为了进一步提高其应用价值,应着重于以下3个方面的研究:
(1)晶态IGZO的制备难度高,需要高温、高真空等条件,制备过程复杂、成本较高。应着力研究MIC低温结晶的方法,简化制备流程。
(2) 对于晶态IGZO的理论研究还相对较少,且表征技术亟待完善。需要进一步探索晶态IGZO的内在机理和性质,完善表征技术,以便更准确地了解其结构、性质和应用特性。
(3) 晶态IGZO的应用范围还比较有限,需要进一步探索其在新型显示器、光电器件等领域的应用前景。
因此,需要继续深入研究晶态IGZO的制备技术、稳定性、表征技术、理论机理和应用前景等方面,进一步完善晶态IGZO TFT性能,拓展其应用领域。
