直拉法单晶硅制备过程控氧技术研究进展
2022-10-10张梦宇杜汕霖黄振玲吕国强马文会
张梦宇,李 太,杜汕霖,黄振玲,赵 亮,吕国强,马文会
(1.昆明理工大学冶金与能源工程学院,昆明 650093;2.云南省硅工业工程研究中心,昆明 650093)
0 引 言
光伏产业正积极推动着我国能源结构向着绿色低碳的方向发展,截至2021年7月,我国太阳能发电装机容量约2.7亿kW[1]。目前晶硅电池在太阳能电池市场中占据主导地位,其中单晶硅电池技术最成熟,性能最稳定,与多晶硅电池相比,它有着更低的缺陷密度和更高的转换效率,因此受到了人们的广泛关注[2,3]。我国单晶硅硅片在全球的市场占有率也在飞速增长,2017年,我国单晶硅片全球市场占有率仅占27%左右,而到2020年底,市场占有率已经上升到了90.2%左右。目前,我国各大光伏企业依旧在单晶硅产业方面不停布局,2021年我国单晶硅总产能为372.5 GW,较2020年上升了58.3%,由此可见,单晶硅产业在我国正呈现出欣欣向荣的发展趋势。
目前光伏行业大规模使用波兰科学家Czochralski在1916年发明的直拉(CZ)法制备单晶硅。CZ法制备单晶硅包含熔料、引晶缩颈、放肩、转肩、等径生长、收尾等步骤。在100多年的时间里,伴随着一系列的研究成果的出现,众多学者也对CZ法进行了大量的改进与优化,催生出许多新的拉晶工艺、理论和方法,比如用于提纯硅的西门子法、用于消除位错的Dash缩颈工艺[4]、Hurle[5]关于晶体直径的控制理论、Voronkov[6]提出的用于消除晶体固有点缺陷的生长速度(V)/温度梯度(G)比值法、利用磁场控制熔体流动的磁拉法[7]以及零缺陷或“完美”硅单晶的生长工艺[8]等。目前,采用CZ法制备出的单晶硅正向着高纯度、高均匀性、高成晶率、大尺寸的方向发展。相应地,与之匹配的热场尺寸也在增加,热场尺寸的增加导致了复杂熔体对流、传热传质难以预测、掺杂剂分布不均匀以及溶氧量过高等问题。单晶中过高的氧含量是导致许多缺陷形成的重要原因,对少子寿命以及电阻率也会产生影响,不利于后续电池产品的制备。表1为光伏制造行业规范对晶硅产品内部性能指标的要求,内部氧含量控制在6×1017atoms/cm3以下时为合格产品。而如何在保证成本的前提下制备出氧含量更低且分布均匀性更好的产品依旧是整个行业亟待解决的问题。

表1 晶硅内部性能指标
本文在总结单晶硅中氧的传输机理与氧对单晶硅性能的影响的基础上,综述了国内外对CZ法单晶硅的氧含量控制的研究状况,归纳了生产过程中热场结构、工艺参数、掺杂元素、氩气气氛及新型直拉技术对氧含量的影响机理,进而提出合理有效的控氧方案,以期对未来的实际生产提供参考。
1 氧的传输机理及氧对电池性能的影响
1.1 氧的传输机理
在CZ法制备单晶硅过程中,氧的来源大致可以分为两种:一种是硅原料中的氧;另一种是石英坩埚中的氧。其中硅原料大多是经过还原法处理的多晶硅,纯度达到了9 N,其内部的氧原子数目通常控制在1016~1017atoms/cm3之间,远低于坩埚中进入的氧的量,因此直拉单晶硅中的氧主要来源于坩埚的溶解。氧进入单晶硅中的传输过程大致分为溶解、扩散、挥发与掺入四个阶段[9-10]。如图1所示,制备过程中坩埚内部温度可以达到1 400 ℃以上,石英坩埚在高温下分解,反应方程式如式(1)所示。

图1 溶氧及氧传输机理
(1)
该过程满足通量守恒(见式(2))。
(2)
式中:DO为氧在熔体中的扩散系数;CO为熔体中的氧浓度;n为熔体中的氧扩散的距离;DC为氧在坩埚涂层中的扩散系数;δdissO为溶解边界层厚度;δC为涂层厚度;ΔGdissO为溶解自由能;CdissO为浓度系数;kB为玻尔兹曼常数;T为温度。
氧在硅熔体中的扩散也受熔体对流强度的影响,Luo等[11]研究了不同学者的连续介质模型中氧的扩散系数,发现有很大的差别,而实际中氧的扩散系数较连续介质中氧的扩散系数要小,因此氧在熔硅中的扩散能力较低,运动主要受熔体对流影响。进入硅熔体的氧与硅熔体进一步发生反应生成SiO气体,反应方程式如式(3)所示。
(3)
在熔体内的传输过程中,超过99%的SiO会从熔硅液体表面挥发,随着氩气进入排气管道,剩下的SiO会在固液界面处分解,其中的氧会沿着固液界面经偏析进入单晶硅棒中与相邻的硅原子形成Si—O—Si键,以间隙态的形式存在于硅晶体中[12]。
在CZ法的熔料阶段硅熔体与石英坩埚的接触面积最大,高温下较多的氧会从石英坩埚进入到硅熔体中。在拉制过程中,硅熔体逐渐减少,熔体与坩埚的接触面积也在逐渐减少,氧进入硅熔体的速度也逐渐变慢。另一方面,拉制过程中氩气的流量与炉压基本保持不变,SiO挥发的速度可以看作基本不变,因此拉制过程中氧在熔硅中的含量是呈下降趋势的,这也使得单晶硅棒中的氧含量分布基本都是头部高而尾部低。因此,目前各大光伏企业对生产出的单晶硅棒中的氧含量进行检测时,一般都会取头部硅片作为样片。氧在单晶硅中的固溶度随着温度的降低而降低,因此晶棒经过冷却之后,内部的氧含量通常都是过饱和的,且太阳能级单晶硅中的氧含量较高,其浓度一般在4.3×1017~8.6×1017atoms/cm3之间。
从单晶硅中氧的传输机理中可以看出,单晶硅中氧的来源主要是石英坩埚的溶解,研究降低氧含量的方法可以从两方面入手:一是抑制石英坩埚与硅熔体接触部分的溶解;二是加强SiO在自由液面的挥发,两者都可以有效地降低单晶硅中的氧含量。
1.2 氧杂质对电池性能的影响
氧的存在有利有弊,有利的点在于间隙氧可以提高硅片的机械性能,降低硅片经过热处理后的翘曲程度。这是由于单晶硅中的间隙氧对位错产生钉扎效应从而抑制位错的产生和增殖[13-15]。Fukushima等[16]通过数值分析的方法研究了氧对CZ单晶硅中位错增殖的影响。图2为不同氧浓度下硅晶体退火后位错的三维分布。如图2所示,热处理后单晶硅中的位错密度随间隙氧浓度增加而降低,位错的固定很大程度上取决于间隙氧浓度。间隙氧在热处理时会与硅中的空位结合成团,吸引周围的氧原子聚集成氧沉淀,较低浓度的氧沉淀可作为吸杂中心,对点缺陷或生产中引入的金属杂质产生吸除作用,进而改善硅片的性能。

图2 不同氧浓度下硅晶体退火后位错的三维分布[16]
不利的点在于:(1)氧沉淀的产生会导致单晶硅中少子寿命的降低及漏电流的增加,图3为少子寿命在单晶硅棒中的轴向分布规律(图中R为硅棒半径),与氧含量较低且一致性较好的中部和尾部段相比,氧含量较高的头部段少子寿命明显偏低。尤其对于P型单晶硅而言,Binns等[17]研究发现掺硼P型单晶硅在氧含量较高的情况下经热处理退火后,内部的硼与氧结合成B—O复合体,显著降低了单晶硅内的少子寿命。高氧晶圆与低氧晶圆的少子寿命图如图4所示。经掺硼与退火氧化后,相较于氧含量在4.3×1017~5.6×1017atoms/cm3之间的低氧晶圆,氧含量在6.4×1017~7.1×1017atoms/cm3之间的高氧晶圆内部的少子寿命发生了显著的衰减。光致衰减会降低太阳能电池的效率,有研究表明,单晶硅中较高浓度的氧沉淀可能使太阳能电池的效率降低5%左右[18-21]。(2)氧沉淀会引发体微缺陷从而降低单晶硅内少子寿命,对太阳能电池的性能产生影响。(3)氧沉淀在高温热处理时会成为氧化诱生层错,氧化诱生层错环导致“黑心圆”的产生[22-24]。(4)热处理温度在300~500 ℃时氧在硅片中会产生热施主效应,高氧含量条件下更易产生热施主效应,而氧含量低于3×1017atoms/cm3的单晶硅中则不易形成热施主[25-29]。热施主的产生会改变单晶硅的载流子浓度。对于N型单晶硅来说,热施主会显著提升电子浓度进而导致硅晶体电阻率下降,而对于P型单晶硅来说,热施主产生的电子会与单晶硅内的空穴复合,导致电阻率上升。无论是对于N型或是P型单晶硅,热施主都会造成硅片的电阻率失真,影响太阳能电池的转换效率。因此目前单晶硅中的氧杂质含量偏高所产生的影响弊大于利,不利于后续太阳能电池组件的生产。
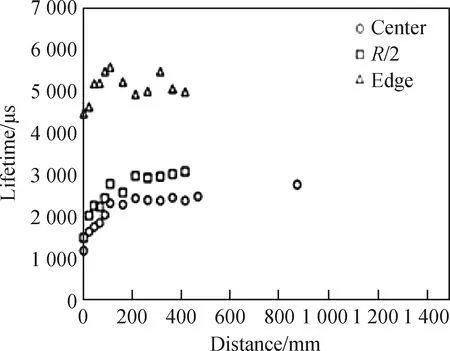
图3 少子寿命随硅棒的轴向分布规律[17]

图4 高氧晶圆与低氧晶圆在初始状态与经过处理后的少子寿命图[17]
2 CZ法生产单晶硅控氧技术现状
2.1 热场结构优化
2.1.1 坩埚材料
用于CZ法的石英坩埚要求具有高纯度与高熔点的特点[30],由式(2)可知,在使用添加了涂层的坩埚材料时,氧在熔体内的传输受到氧在熔硅中的扩散系数和氧在涂层中的扩散系数的共同影响,降低氧的掺入可以从坩埚的涂料方面入手,选择高温条件下性质稳定,不与石英和熔硅发生反应,且氧的扩散系数较低的材料。有学者提出在石英坩埚内喷涂碱土金属(如Ba)的离子溶液,可以改进坩埚质量,降低坩埚的溶解[31-32],目前有很多单晶企业在大规模使用钡涂层石英坩埚(NQC)。莫宇等[33]研究了两种不同石英坩埚对制备出的硅晶体的影响,一种是内层为高纯合成石英砂的坩埚(SQC),另一种是NQC,使用SQC的情况下溶解更为缓慢,降低了熔体中的氧含量。Sturm等[34]通过化学气相沉积的方法在石英坩埚内部添加Si3N4涂层,试验结果显示添加涂层后有效阻止了坩埚的腐蚀,抑制了坩埚内氧的传输。
2.1.2 加热器优化
高农农等[35]通过数值模拟研究了不同加热器内径对加热器效率及晶体氧含量的影响。初始条件下加热器内径为600 mm,生长出的晶体内氧含量为7.5×1017atoms/cm3,试验过程中当加热器内径降低到550 mm时,氧含量降低到了5.5×1017atoms/cm3,下降了约27.1%,且单晶炉的功率也降低了约25.7%。试验表明加热器内径的减小可以提高加热器对石墨坩埚的加热效率,减少能源消耗,并且降低坩埚侧壁与底部的温度,有效降低石墨坩埚进入熔体的氧含量。Zhou等[36]对主加热器的结构进行了优化,如图5所示,将原来单个的加热器设计为两个,分别由独立的电源供能,下面的部分仅在熔料阶段开启,缩短熔料时间,而上部分又被分为两段,下段在晶体生长阶段提供较少的热量。

图5 单晶炉的主要部件示意图[36]
该设计的优点在于晶体生长时坩埚侧壁的温度较传统热场坩埚侧壁温度下降了约10 K,降低了熔硅与石英坩埚的反应速度。两种加热器生产的晶棒的氧含量与光致衰减率如图6所示,新型加热器生长的单晶硅头部氧含量为6.2×1017atoms/cm3,较传统加热器生产的单晶硅头部氧含量下降了3×1017atoms/cm3,而光致衰减率也平均降低了约0.64%。

图6 两种加热器生产的晶棒的氧含量与光致衰减率[36]
通过优化热场来降低氧含量是一种可行的手段,同时也可以起到提高效率、降低功耗的作用。然而成本较高,需要根据需求定制合适结构的组件,组件厂商也要针对结构的改变进行生产方式的调整。
2.2 工艺参数优化
2.2.1 埚位
一般情况下将熔料时坩埚顶端与加热器顶端的相对位置称为初始埚位,埚位需要根据炉内热场结构确定,过低的埚位会导致加热器熔料阶段产生大量的热量损失,加热效率下降。而过高的埚位又会增加硅料与导流筒剐蹭的风险,且坩埚侧壁与底部上升,导致坩埚溶解加剧,造成熔硅内部氧含量偏高。郝玉清[37]研究发现当坩埚的初始埚位降低时,生产出的单晶硅内部的氧含量有了明显的下降。任丽等[38]通过研究不同初始埚位条件对单晶硅少子寿命与氧含量的影响也发现了相同的规律,当坩埚处于较低的初始埚位时,坩埚底部和侧壁的温度降低,降低了石英坩埚的溶解速度,硅棒内的少子寿命得到了提高,且达到了降低氧含量的目的。高忙忙等[39]研究了坩埚与加热器的相对位置对单晶成品质量的影响,试验中通过升高加热器的位置起到降低初始埚位的作用,结果显示,随着初始埚位的降低,坩埚底部的温度下降,熔体内部的径向和轴向温度梯度下降,起到了抑制熔体内部对流的作用,氧含量降低了约2.7%,且固液界面波动程度降低,抑制了缺陷的形成。
2.2.2 埚转
生产过程中坩埚的旋转可以改善熔体内部的温度分布情况并提高内部杂质分布的均匀性,但是过高的埚转又会加剧熔体内部的对流强度,增加坩埚的溶解,使更多的氧杂质进入熔体中。Zulehner[40]对CZ法过程进行了研究,考虑了如坩埚旋转、熔体流动、坩埚原料和界面反应等条件,并着重对氧在CZ硅中的行为进行了详细的解释。Kanda等[9]研究了埚转对硅熔体中氧含量的影响,研究发现在不施加埚转的情况下,由于氧在熔硅中的扩散能力较弱,仅在热对流的作用下缓慢运动,氧大量存在于硅熔体与坩埚的接触区域附近,在拉制的末期进入单晶硅中,引起晶棒尾部氧含量上升。Chen等[41]研究了晶转相同(13 r/min)而埚转不同时硅熔体内部的对流以及氧含量分布情况,发现当坩埚与晶体以相反方向旋转时,固液界面下方产生的泰勒-普劳德曼漩涡会抑制坩埚壁附近的氧向固液界面传输以及硅熔体内的热量传递。埚转较高时,泰勒-普劳德曼漩涡强度增大,压缩了浮力-热毛细漩涡的空间,导致坩埚壁附近的温度较高且氧蒸发量减少,而埚转较低时,泰勒-普劳德曼漩涡强度减小,其抑制氧传输的能力减弱。不同埚转下固液界面氧含量分布如图8所示,在埚转为3 r/min时,单晶硅内部氧含量最低,熔体内部的对流也较为平衡。

图7 熔体内部对流产生的漩涡[41]

图8 不同埚转下固液界面氧含量分布[41]
Popescu等[42]针对不同埚转对氧含量的影响进行了数值模拟,晶转设为10 r/min,埚转分别设置为2 r/min、4 r/min、6 r/min和8 r/min,取固液界面中心处为M1点,硅片半径1/2处为M2点,得到不同埚转下两个监测点的氧含量和距坩埚底部11.3 cm处氧含量曲线,如图9所示。熔体内部的氧含量分布如图10所示。随着埚转增加,氧含量呈先下降后升高的趋势,当埚转为4 r/min时,氧含量达到了较低水平,大约为4.7×1017atoms/cm3,此时熔体内部的氧含量也处于较均匀的分布状态,而当埚转处于8 r/min的高转速时,熔体靠近坩埚壁处的氧含量处于一个较高的水平,也验证了高埚转下泰勒-普劳德曼漩涡变大、浮力-热毛细漩涡被压缩的现象。

图9 两个监测点的氧含量及距坩埚底部上方11.3 cm处氧含量曲线[42]

图10 不同埚转下熔体内部的氧含量分布[42]
2.2.3 晶转
当晶体与坩埚以相反的速度旋转时,会对熔体产生搅拌作用,随着晶转的提高,熔体内部的氧杂质或者其他掺杂元素分布更加均匀,尤其是晶体的径向氧含量分布,但是过高的晶转又会在固液界面下方产生较强的对流,对固液界面的稳定性带来不利影响[43]。杨凤艳[44]使用CGSim软件模拟了不同晶转条件下的拉制过程,结果显示当晶转在10~15 r/min时,生长出的单晶硅中的氧含量保持在了较低的水平,且径向分布均匀性较高。当晶转继续增加时,氧含量整体水平不降反增,不利于成品的质量。
目前企业使用的单晶炉基本上都集成了数字化控制系统,可以通过计算机来实时监测和调控生产过程,因此通过优化工艺参数达到降低氧含量的目的是一种低成本、高性价比的方式。综上所述,当设置较低的初始埚位、较高的晶转(10~15 r/min)和较低的埚转(3~4 r/min)时,能得到氧含量较低且分布均匀性良好的晶棒。
2.3 炉内气氛优化
2.3.1 炉内压力
CZ法单晶硅的制备过程中通常使用氩气作为保护气体,除了起到冷却硅棒的作用外,氩气气氛还有调节炉内压力、带走碳氧杂质的能力。SiO在熔体的自由液面经过蒸发进入氩气气氛后随氩气一起进入排气管道,其满足通量守恒。
(4)
(5)
式中:DSiO为SiO在氩气气氛中的扩散系数;CSiO为氩气气氛中的SiO浓度;n为氩气中的氧扩散的距离;DO为氧在熔体中的扩散系数;DA是流动振荡引起的附加扩散系数;KSiO为扩散一致性参数;α为扩散系数随温度变化的函数指数;Pgas为炉内压力。
由式(4)、式(5)可知,随着炉内压力的增大,SiO在氩气中的扩散能力减弱,SiO分压增强,导致自由液面上的蒸发受到抑制,不利于降低熔体内的氧含量,经过溶氧热力学分析计算[45],当炉压控制在2 300 Pa时,自由液面下方硅熔体内的氧含量大约为1.1×1018atoms/cm3,而当炉压降低至1 500 Pa时,氧含量则会降低至6.9×1017atoms/cm3左右,起到了明显的降氧效果。因此在生产中可以将炉内的压力维持在一个较低的水平,有利于降低熔体内部的氧浓度。
2.3.2 氩气气氛
Machida等[46]研究发现随着氩气的流速增加,单晶硅的氧含量降低。但当氩气流速继续增加时,自由液面出现了剪切对流,抑制了SiO的挥发,反而不利于降低氧含量。Kalaev等[47]研究了氩气流速对晶体生长过程中全局热传递和熔体对流的影响,并提出了CZ法单晶硅生长过程的全局传热、熔体湍流对流和氩气流的耦合模型。Teng等[48]通过改变热屏的形状研究了氩气流速对单晶硅氧含量的影响,发现减小热屏到坩埚侧壁的距离可以有效提高氩气在自由表面的流速,带走更多的SiO气体,有效降低单晶硅内部的氧含量。结果显示随着热屏到坩埚侧壁的距离从70 mm降低到10 mm,单晶硅头部氧含量从6.4×1017atoms/cm3降低到了5.8×1017atoms/cm3。
在保持氩气消耗量不增加的前提下,提高氩气在自由液面的流动速度可以有效降低熔体中的氧含量。进行试验时可以从调整热屏的形状与位置入手,降低热屏的高度,减小液口距,提高热屏的直径以减小与石英坩埚壁之间的距离,缩小氩气气路面积,进而提高氩气流速。
2.4 掺杂剂影响
为了使产品达到不同的性能要求,在CZ法制备单晶硅时还会添加各种不同的掺杂剂,例如制备N型单晶硅时掺杂磷元素,制备P型单晶硅时掺杂硼、镓元素,为提高硅片机械强度掺杂锗元素以及砷、锑、锡等其他元素。掺杂剂的种类及浓度对单晶硅内氧含量的影响已有大量研究[49-52],Nozaki等[53]采用带电粒子活性分析法检测单晶硅中的氧含量,发现在掺锑单晶硅中的氧含量比未掺杂单晶硅中的氧含量低,锑在固液界面蒸发的过程也会加速SiO蒸发。Huang等[54]通过试验验证了氧在掺锑单晶硅中的偏析系数随着锑浓度的增加而减小,两者之间的关系如式(16)所示。
KO=1-0.196CSb2
(6)
式中:KO为氧在单晶硅中的偏析系数;CSb为熔体中的锑浓度。
Gupta等[55]研究了氧在碳掺杂硅中的扩散机理,将样品在460~850 ℃进行热处理,在690 ℃以下时,观察到了氧扩散增强的现象,而当温度高于这个范围时,扩散增强的现象又被抑制。结果表明在熔体中形成的CO化合物会加速熔体中氧的扩散。Scala等[56]研究了砷、磷掺杂浓度对单晶硅中氧含量的影响,结果显示在相同的生长条件和掺杂浓度下,磷掺杂晶体中的氧含量大于砷掺杂晶体,如图11所示。砷元素与磷元素分别在硅熔体中与氧结合生成了对应的氧化物AsmO(AsO、As2O和As4O)和PmO(P2O、P4O),提高了氧的蒸发速度,其中As2O的蒸发速度远高于PmO的蒸发速度,这是砷掺杂晶体中氧含量较低的原因。综上所述,不同的掺杂剂对氧的扩散行为影响程度不同,因此,在单晶硅的生长过程中选择合适的掺杂剂和浓度对于降低氧含量十分重要。

图11 两种掺杂单晶硅中电阻率和掺杂剂浓度与氧含量的关系曲线[56]
2.5 新型直拉技术
2.5.1 连续直拉法
传统CZ法的熔料阶段中,坩埚与熔体接触面积大导致溶氧量高,因此连续直拉(CCZ)法应运而生[57]。CCZ法是一种可以在单晶生长中无需停炉即可添加硅原料的方法,可以节省大量的生产时间,Xu等[58]使用CCZ法在一个坩埚中生长了5根晶棒。与传统CZ法相比,使用CCZ法显著降低了N型单晶硅的生产成本。另一方面由于可以持续加料,坩埚内部的硅熔体可以一直维持较浅的熔体深度,与传统CZ法相比,熔体内部的对流强度降低,有助于抑制氧的传输,获得更高品质的硅晶体[57]。早期的CCZ法面对的主要问题是连续添加的硅料在对流驱动下会向着固液界面移动,造成固液界面振荡,引发位错甚至断棱与掉苞。在石英坩埚内部添加一个圆形的石英隔板,可以阻止硅料的移动,即为双坩埚法。如图12、图13所示,当石英隔板加入后,在外部区域添加硅料可以有效解决硅料向固液界面移动的问题。但石英隔板的加入也带来了一个新的氧杂质来源,可以通过对石英隔板的形状及安装位置进行优化来达到降低熔体内氧含量的目的,Jafri等[59]的研究发现内径较大的隔板有助于减少固液界面附近的氧含量。Kitashima等[60]通过数值模拟的方法研究双坩埚和传统坩埚内熔体中的氧含量分布情况,结果显示与传统坩埚相比,石英隔板与固液界面距离较短时,熔体内的氧含量明显增加。Zhao等[61]研究了石英隔板内径大小对固液界面处熔体氧浓度的影响,结果显示当隔板内径大小为300 mm时,氧含量在9×1017atoms/cm3左右,较传统单坩埚条件下增加了约2.1×1017atoms/cm3,而当内半径增加到400 mm时,氧含量为5.2×1017atoms/cm3左右,降低了约25%。Nguyen等[62]研究了隔板插入熔体的深度H对固液界面处氧含量分布的影响,如图14所示,在深度H从20 mm升高至80 mm的过程中,固液界面处氧含量不断提升,而在深度H继续升高时,则呈现出了相反的趋势。结果显示当H值较高时,能有效削弱熔体内部的对流强度,减少坩埚壁附近的氧进入硅熔体内部的含量,具有实际生产意义。

图12 双坩埚法简化图
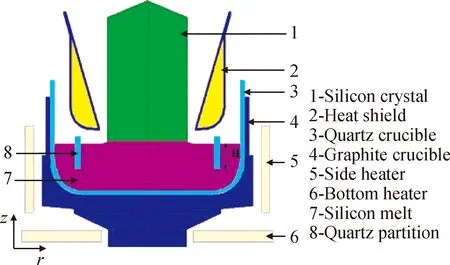
图13 安装了隔板的CCZ生长炉原理图[62]

图14 不同深度H固液界面处径向氧含量分布[62]
双坩埚法的应用会因为石英隔板的加入而引进新的氧杂质源,在此提出一种解决思路,即在单晶炉室外部进行熔料的连续直拉法,如图15所示,在主炉室外通过石英管道连接一个装料仓,内部包含石英坩埚、加热系统、保温系统及真空系统,可在装料仓内完成硅料的熔化过程再通过石英管道和阀门输送进主炉室内的坩埚中,通过监测炉室石英坩埚内部的熔体深度控制石英管道内的熔料流速,使两个坩埚内的熔体始终保持较浅的深度,降低坩埚溶解的速度,进而达到控氧的目的。为了达到更好的效果,还可以在装料仓的侧壁增加氩气的进出气口,增强氩气对熔硅液面的吹拂效率,有效提高SiO的挥发面积。除此之外该装置的应用还可以使主炉室内坩埚装置始终保持静止状态,消除了因埚升而引起的振荡扰动,降低了缺陷甚至断棱与掉苞的概率。
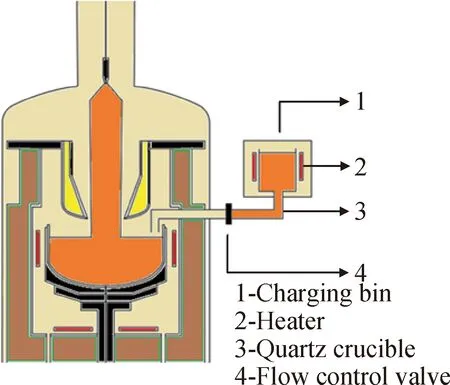
图15 带有外部装料仓的单晶炉示意图
2.5.2 磁拉法
为了达到生产更纯净的太阳能级甚至半导体级单晶硅的目的,人们开始使用更高成本的磁场拉晶技术(MCZ法)[63]。MCZ法的原理为硅熔体内部的带电粒子在磁场中受到洛伦兹力,进而抑制熔体内的对流。MCZ法的应用可以达到明显减少熔体内氧、碳、硼等杂质的目的。20世纪80年代末,Hirata[64]提出了一种先进的非均匀磁场结构,即勾形磁场(cusp magnetic field, CUSP),克服了轴向磁场或横向磁场磁感线方向单一的缺陷,CUSP中磁感线与大多数的熔体对流流向垂直,可以有效抑制坩埚内熔体的强烈对流,减少坩埚内壁的腐蚀,降低单晶硅中的氧含量。宇慧平等[65]采用数值模拟的方法研究了勾形磁场下熔体内氧含量分布,发现随磁场强度增加,熔体内紊流被抑制,降低了熔体内氧含量。常麟等[66]也通过数值模拟研究了单晶硅内氧含量随CUSP磁场的通电线圈距离和半径的变化规律,发现随着距离与半径的增加,熔体内的对流强度得到了明显的抑制,固液界面附近的氧含量明显降低,单晶硅中的氧含量也随之明显降低,最低达到了3.9×1017atoms/cm3。Chen等[67]采用数值模拟的方法研究了勾形磁场下CZ单晶硅的热场、流场和氧含量,验证了高磁场强度能够降低固液界面氧含量的结论。
CCZ法的应用不仅起到了降低单晶氧含量的作用,连续加料的生产方式也可以大大提高生产效率,且不需要对整个单晶炉体的结构进行大范围的调整,是一种可以用于实际生产的有效降氧手段。而MCZ法可以明显降低单晶硅的氧含量,但缺点在于磁场的加入需要耗费大量的电力资源,成本比传统的CZ法要提高一倍左右,因此仅建议在制备性能要求很高或者是应用于半导体领域的硅产品时使用。
3 结语与展望
单晶硅中氧杂质的存在依然是影响电池组件性能的重要因素,受CZ法制备工艺限制,在石英坩埚没有合理替代品的情况下,单晶硅内的氧杂质不可避免,寻求合理有效、低成本的降氧手段依然是目前的研究重点。本工作介绍了氧杂质的传输机理,对CZ法制备单晶硅中热场结构、工艺参数、掺杂剂、氩气气氛以及新型直拉技术的应用对氧含量的影响进行了综述:(1)选择纯度高的石英坩埚并喷涂涂层,可以减少石英坩埚受到腐蚀;(2)适当缩小加热器的内径,可以提高加热器的加热效率,将上加热器分为上下部分用以降低坩埚内壁的温度;(3)调节热屏、导流筒的形状或位置,以及改变液口距,可以使氩气流动更加顺畅,带走更多的SiO气体;(4)选择合适的晶转与埚转(晶转在10~15 r/min之间,埚转在3~4 r/min之间),降低初始埚位,可以减少熔体内部的氧含量;(5)运用掺杂剂在硅熔体中的蒸发增强机理降氧时注意选择合适的掺杂剂种类及浓度;(6)应用新型连续直拉法或选择更高成本的磁拉法,可以得到氧含量较低的单晶硅。
调整工艺参数是最简单,也是最有成效的方法,研发新型的涂层材料不仅可以减少坩埚的溶解,也可以提高坩埚组件的使用寿命,降低生产过程中的成本。将加热器的结构进行分段式设计,是降低氧含量与能源消耗的有效思路。以CCZ法为代表的新型直拉技术目前正逐渐被投入使用,在未来的工业生产中势必会对传统的直拉工艺发起冲击,带来生产效率高和性能优异的产品。新型连续直拉单晶炉结构能够解决双坩埚法中引入新氧杂质源的问题,将成为未来连续直拉法发展的一个方向。总而言之,单晶硅的降氧技术不应局限于某一方面,多种技术并用才能达到更好的生产效果。
