高速芯片封装中多平行传输线的设计与优化*
2022-05-27范宇清
范宇清,胡 晋,郑 浩
(江南计算技术研究所,江苏 无锡 214083)
1 引言
随着大规模集成电路工艺尺寸不断缩小,工作频率不断提高,IC 封装中的信号传输路径对整个系统信号完整性的影响也越来越大。由传输线、过孔和焊点等构成的互连结构所产生的寄生效应会导致衰减、反射和串扰等一系列信号完整性问题,这对高速互连设计尤其是封装基板的设计提出了严峻挑战[1]。
封装基板作为承载半导体芯片的载体,为芯片提供支撑、散热等机械物理功效与电气连接功能。随着SIP(System In a Package)、MCM(MultiChip Module)以及2.5D和3D等先进封装技术的飞速发展与应用,封装基板信号密度不断提高。对单芯片封装而言,陶瓷基板与有机基板是2种常用的基板介质材料。不同介质材料的基板,其封装内信号互连特性,尤其是传输线的反射、损耗和串扰等信号完整性问题值得重视与研究[2 -4]。
本文以陶瓷基板与有机基板封装为例,采用电磁场仿真软件建立了平行耦合的三线模型,仿真分析了基板类型、传输线线宽、线间距、线厚度与介质厚度等参数对信号完整性的影响,并对传输线进行了相应优化设计。
2 芯片封装中信号完整性问题产生机理分析
芯片信号完整性是指高速芯片中由互连线引起的所有信号问题,它主要探究互连结构与数字信号的电压电流波形相互作用时其电气特性参数如何影响芯片的性能。通常在时序、噪声和电磁干扰3方面影响信号质量[5,6]。
在芯片封装中,信号由芯片上的bump经走线与过孔扇出后连接至基板底层的BGA(Ball Grid Array),当信号沿互连结构传播时受到的瞬态阻抗发生变化,一部分信号将被反射,另一部分发生失真并继续传播,此时信号就发生了反射。
此外,受生产工艺限制,芯片封装基板有限的面积导致信号布线密度较大,传输线间的线间距减小,相邻信道间的电容、电感耦合产生有害噪声影响信号传输质量,这便是串扰形成的机理[7 -9]。对于PCIE(PCI-Express)、Serdes(Serializer-Deserializer)等高速信号,反射和串扰在封装的互连结构中产生的噪声可能会引起延时、过冲和振铃现象,使信号质量下降,甚至出现电平、时序等错误,影响封装级、板级的信号质量,从而影响整体电路的稳定性与性能[10]。
传输线线宽、耦合长度、间距、厚度与封装基板所用介质材料特性对信号完整性都有影响,在芯片封装领域对该类问题的研究多采用特定工具在基板上直接提取特定信号的网络参数分析后优化的方法;而在前仿真阶段使用电磁仿真软件对基板上互连结构设计建模也是必要的[11,12],通过建模仿真,可在基板设计初期对重要参数提前评估,从而提高封装设计整体效率与成功率。
3 陶瓷基板三平行传输线模型仿真分析
已有研究人员对平行传输线间的信号完整性问题进行了研究,但主要关注比较简单的二平行传输线模型,该模型一般为一根受害线与一根攻击线,不能有效模拟复杂环境下多平行传输线的串扰仿真。此外,大部分研究中的传输线建模一般以PCB板级封装为背景,少有对芯片级封装开展研究的。本文考虑到高速互连设计中的实际工程需要,改进了简单的二线平行耦合模型,以单芯片封装为例,建立了三平行传输线模型,下面给出陶瓷基板的模型建立与分析过程。
3.1 陶瓷基板上传输线模型
在仿真软件中建立陶瓷基板上平行传输线模型,如图1和图2所示,基板大小为10 mm×10 mm×162.4 μm,图2中layer1和layer3为金属平面,layer2为布线层,传输线类型为单端带状线,铜材质,线宽w0=48 μm,线厚t=10 μm,介质层厚度h=66.2 μm,线间距d=200 μm。仿真频率设置为0~10 GHz,在传输线2侧分别设置相对应的端口,端口类型为lumped port,阻抗设置为50 Ω,端口与传输线对应关系如表1所示。

Figure 1 Model of three parallel transmission lines图1 三平行传输线模型

Figure 2 Structure of substrate laminated图2 基板叠层结构

Table 1 Corresponding port of transmission line表1 传输线对应的端口
3.2 反射系数(S11)仿真分析
图3为信号线厚度t=10 μm,介质厚度h=66.2 μm,线间距d=240 μm时,传输线line3的反射系数S11随线宽w0(12 μm~108 μm,步长为12 μm)的变化。由图3可知,在5.7 GHz以下,线宽为24 μm时S11最小,在5.7~8.4 GHz,线宽为48 μm时S11最小,在8.4~10 GHz,线宽为36 μm时S11最小。

Figure 3 Reflection coefficient S11 of transmission line line3 changing with line width(t=10 μm,h=66.2 μm,d=240 μm)图3 传输线line3的反射系数S11随线宽的变化(t=10 μm,h=66.2 μm,d=240 μm)
产生反射的根本原因是信号传输路径上阻抗的不连续性,本文所建立的模型是较为简单的平行传输线,传输线上没有拐角、过孔和分支等结构,所以其反射系数主要与阻抗匹配程度有关。因端口阻抗设定为50 Ω,端口受到的阻抗由信号路径及与其最近的平面构成的传输线阻抗决定,2个平面间的阻抗可由式(1)求得:
(1)
其中,Z0为平面特性阻抗(单位为Ω),常数a=0.377 Ω,εr为平面间材料的介电常数,h为介质厚度,w为平面的宽度,计算可得平面阻抗为1 mΩ,可忽略不计,所以端口所受阻抗近似于信号路径阻抗。通过式(1)可近似求得24 μm、36 μm、48 μm 3种线宽下传输线line1的特征阻抗分别为 55 Ω,48 Ω和43 Ω,可见这3种线宽下的特征阻抗与设置的端口阻抗(50 Ω)的匹配程度都较好。
由图3也可以发现,不同频率下的S11也不同,这是由容性、感性负载值与介质材料介电常数在各个不同频点的值不同所致的。所以,在进行封装基板设计时要根据不同信号的频率需求来优化反射系数,如低频信号要关注其低频下反射系数;对于高频信号,如PCIE等,需关注其总线频率,通过选择合适的频率范围并结合其它设计参数来进行优化。
此外,S11还与信号线的厚度和宽度以及介质层厚度相关,相关内容将在4.2节具体讨论。
3.3 串扰仿真分析
串扰主要由传输线间的电容耦合和电感耦合引起。高速电信号传输线的串扰分为两类,分别是远端串扰FEXT(Far-End cross Talk)和近端串扰NEXT(Near-End cross Talk)。基于不同的拓扑结构,它们的形成机理和特性也不同。远端串扰(FEXT)是由攻击线的发送端激励,在传输线远端的受害线接收端观测到的串扰;而近端串扰(NEXT)是由攻击线的发送端激励,在传输线近端的受害线接收端观测到的串扰。
就本文所建立的带状传输线模型而言,电感耦合远大于电容耦合。一方面,攻击线发射的信号脉冲由于电容耦合在邻近的受害线上激励出的电流会流向传输线远端和近端;另一方面,由于电感耦合在邻近的受害线上产生的电流只会从远端流向近端,由楞次定律可知,它与攻击线或驱动线的电流方向相反。因此,远端串扰为电容耦合电流与电感耦合电流之差,近端串扰为电容耦合电流与电感耦合电流之和。通常情况下,电感耦合占主导地位,因此FEXT 和 NEXT的电压脉冲极性相反[13 -15]。
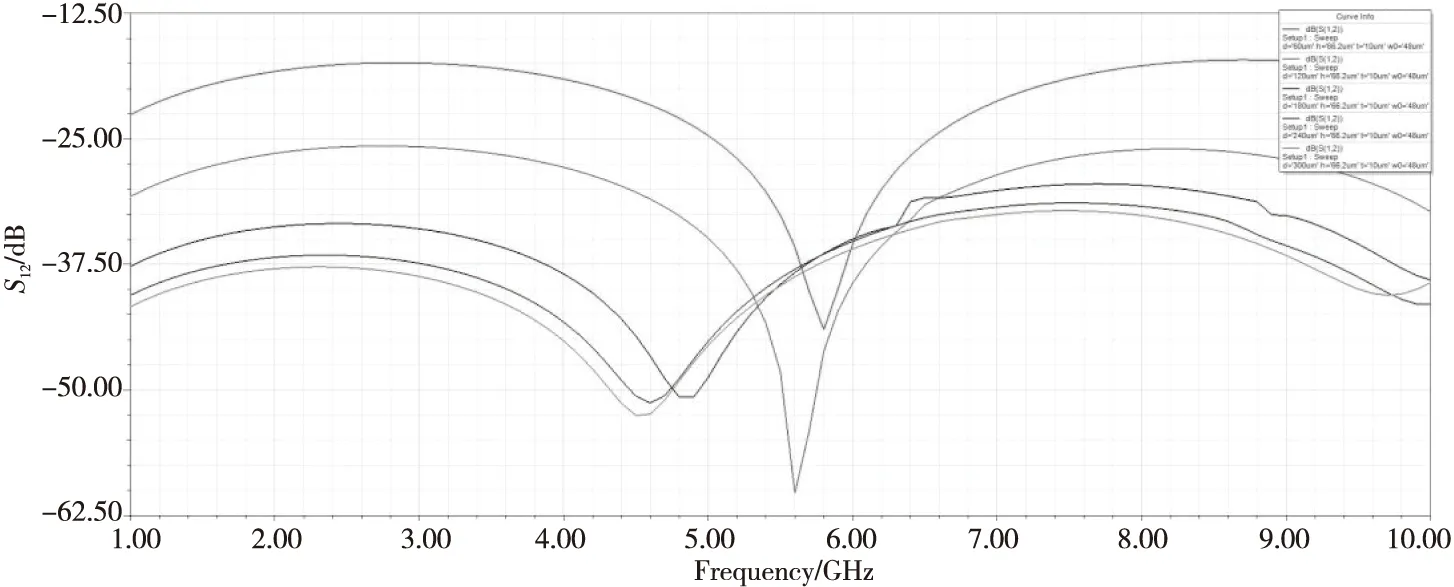
Figure 4 Near-end crosstalk S12 changing with line spacing (t=10 μm,w0=48 μm,h=66.2 μm)图4 近端串扰S12随线间距的变化(t=10 μm,w0=48 μm,h=66.2 μm)
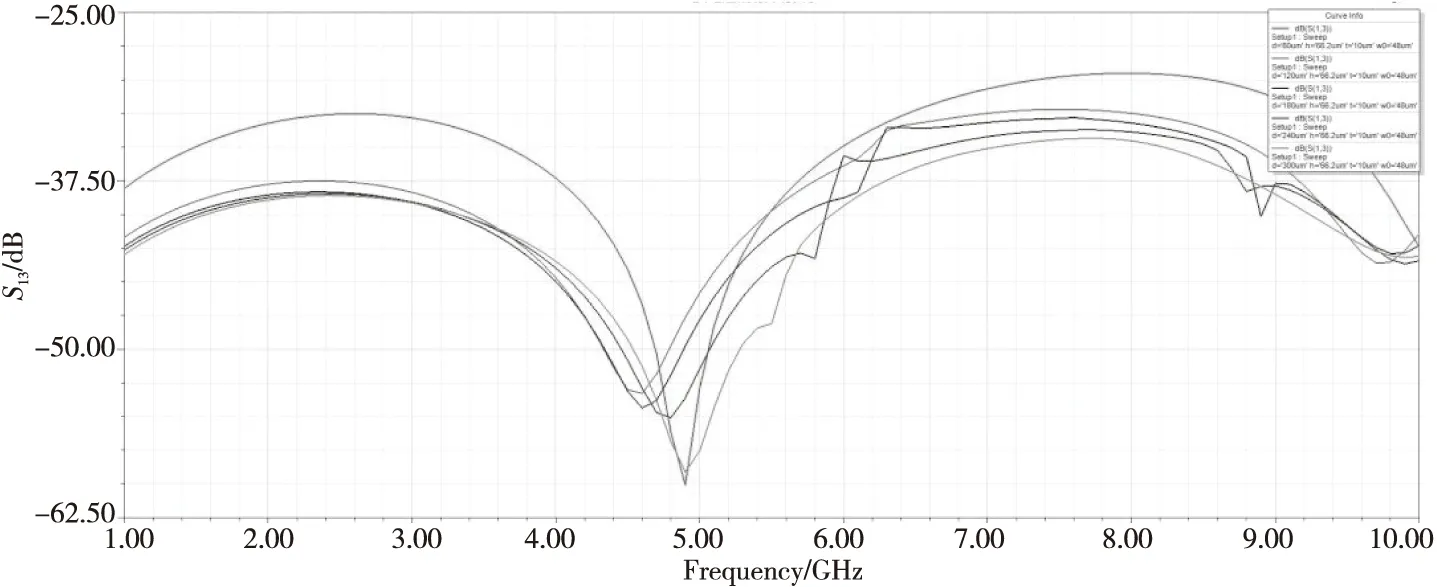
Figure 5 Near-end crosstalk S13 changing with line spacing (t=10 μm,w0=48 μm,h=66.2 μm)图5 近端串扰S13随线间距的变化(t=10 μm,w0=48 μm,h=66.2 μm)

Figure 6 Far-end crosstalk S15 changing with line spacing (t=10 μm,w0=48 μm,h=66.2 μm)图6 远端串扰S15随线间距的变化(t=10 μm,w0=48 μm,h=66.2 μm)
(1)近端串扰。
图4与图5为介质厚度h=66.2 μm,走线厚度t=10 μm,线宽w0=48 μm时,近端串扰S12和S13分别与线间距(60 μm,120 μm,180 μm,240 μm,300 μm)的关系,其中S12为传输线line2对line3的串扰,S13为传输线line1对line3的串扰。由图4和图5可知,S13与S12均在-30 dB以下,S13整体比S12小。在0~10 GHz频段内,线间距越大,近端串扰越小,这是由于边缘场分布所致,信号在传输过程中在导线两侧产生的边缘场随距离信号线的远近而发生变化,距离越远,边缘场越小。因此,在阻抗匹配的情况下,减小近端串扰的有效方法就是增大信号线的距离。
近端串扰S12比S13大,一方面是因为line2与line3的线间距比line1与line3的线间距大;另一方面,line1除了影响line3,其串扰能量有部分也耦合进了line2中,所以S12在整个频段上大于S13。
(2)远端串扰。

Figure 7 Far-end crosstalk S16 changing with line spacing (t=10 μm,w0=48 μm,h=66.2 μm)图7 远端串扰S16随线间距的变化(t=10 μm,w0=48 μm,h=66.2 μm)
图6与图7为h=66.2 μm,t=10 μm,w0=48 μm时,远端串扰S15和S16分别与线间距(60 μm,120 μm,180 μm,240 μm,300 μm)的关系,S15为传输线line2对line3的串扰,S16为传输线line1对line3的串扰。图6中,频率在0~6.2 GHz时,远端串扰与近端串扰一样,随线间距的增大而减小。当线间距d=60 μm时,远端串扰S15在6.2~10 GHz的频率范围内较其他曲线小,S16在0~10 GHz内随着线间距的增大而减小,当线间距为300 μm时,S16在5.9 GHz处有一个谐振峰,不过持续的频率范围很小,这是由于在该频率下传输线与端口阻抗失配所导致的。
近端串扰、远端串扰与线间距密切相关,间距增大可以迅速减小串扰系数,但这将导致封装基板布线密度降低,对于高密度互连基板,会大大提高设计难度与生产成本。此外,串扰同样与介质厚度、耦合长度等相关,这点将在4.3节具体讨论。
4 有机基板3平行传输线模型仿真分析
4.1 有机基板传输线建模
与陶瓷基板不同,有机基板的常用结构是顺序堆叠结构,如图8所示。该结构由三部分组成,中间是采用传统的PCB 技术制作的一个芯板层(Core),芯板层的上下两面是利用微通孔(Micro-viahole)制作的叠层(Build-up layer),中间的芯板层用来提供机械硬度,两边的Build-up layer为倒装芯片的连接提供高密度的线路,本文主要研究其上下叠层的互连特性。
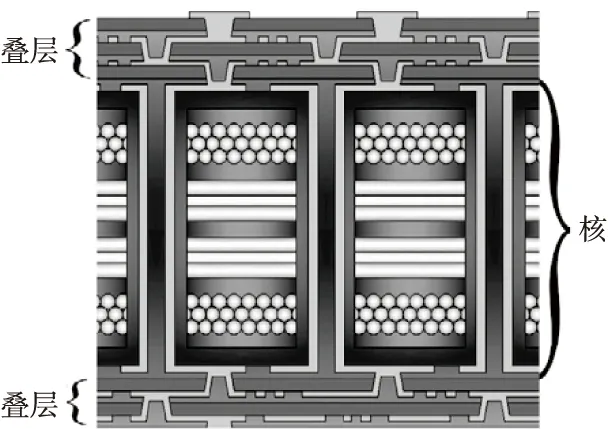
Figure 8 Structure of organic packaging substrate 图8 有机基板结构
在仿真软件中建立有机基板Build-up layger模型,如图9所示,基板大小、叠层结构均与陶瓷基板的相同,金属层厚度为15 μm,介质层厚度为30 μm。

Figure 9 Model of organic package substrate 图9 有机基板模型
4.2 反射系数(S11)仿真分析
图10为有机基板上线厚t=15 μm,介质厚度h=30 μm时,传输线line3在0~10 GHz频率范围内的S11的仿真结果。表2列举了不同频段最小S11对应的线宽。由表2可知,在线厚与介质厚度一定的情况下,线宽w0=20 μm时反射系数S11在大部分频点下均比其他几种线宽小,且对应的S11值都在-30 dB以下。

Table 2 Line width corresponding to minimum reflection coefficient of different frequency bands表2 不同频段最小反射系数对应线宽
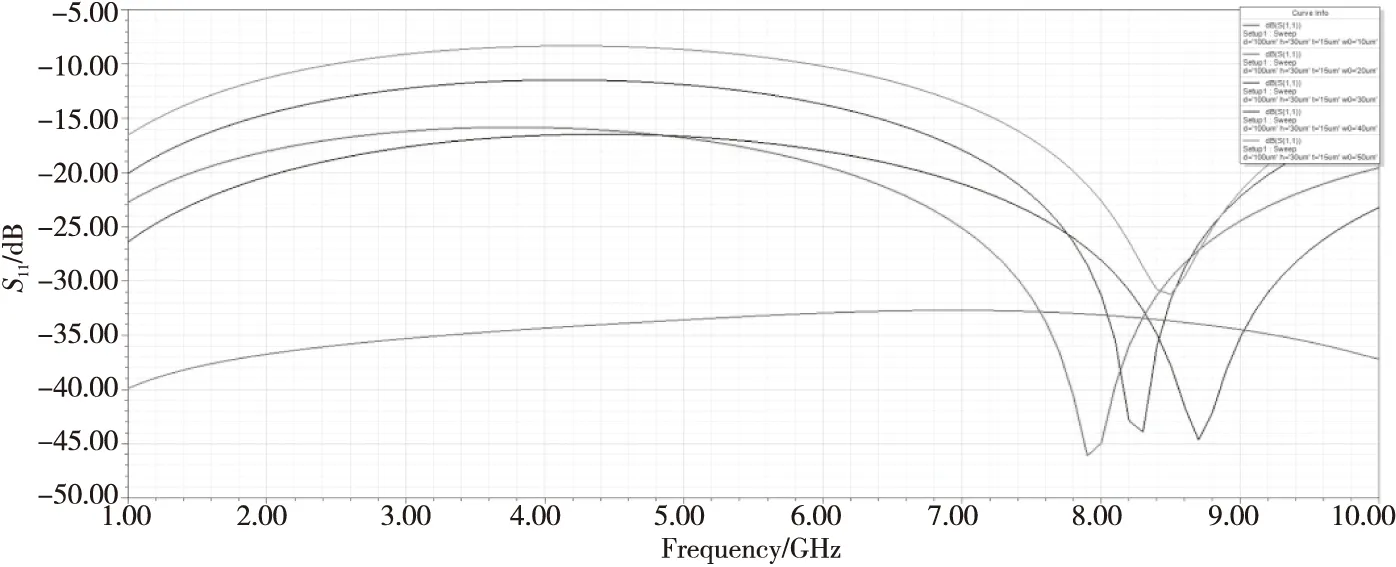
Figure 10 Reflection coefficient S11 of transmission line line3 on organic substrate changing with line width w0 (t=15 μm,h=30 μm,d=100 μm)图10 有机基板上传输线line3反射系数S11随线宽w0的变化(t=15 μm,h=30 μm,d=100 μm)

Figure 11 Reflection coefficient S11 of transmission line line3 on organic substrate changing with medium thickness h (t=15 μm,w0=20 μm,d=100 μm)图11 有机基板上传输线line3反射系数S11随介质厚度h的变化(t=15 μm,w0=20 μm,d=100 μm)

Figure 12 Reflection coefficient S11 of transmission line line3 on organic substrate changing with wire thickness t (t=15 μm,w0=20 μm,d=100 μm)图12 有机基板上传输线line3反射系数S11随线厚t的变化(h=30 μm,w0=20 μm,d=100 μm)
通常情况下,封装基板上的线宽需根据芯片上bump扇出可行性、封装基板面积与信号走线规范确定。令线宽w0=20 μm,线厚t=15 μm,将介质厚度h设置为优化参数,可以得到介质厚度分别为15 μm、30 μm和45 μm时的反射系数。如图11所示,介质厚度h=15 μm时S11在2~6 GHz频率内较大,此时反射噪声对信号质量影响较大。当h=30 μm时,S11在整个频段内的值都优于其他2种介质厚度对应的值。同理,设置线宽w0=20 μm,介质厚度h=30 μm,线厚t为参数,可得t与S11的关系,这里只列举线厚为7.5 μm与15 μm 2种情形,如图12所示,线厚t=15 μm时传输线的反射系数小于线厚t=7.5 μm时的。
4.3 串扰仿真分析
有机基板近端、远端串扰与陶瓷基板上传输线的规律类似,均随着线间距的增大而减小,这里不再赘述。考虑到封装中传输线耦合长度也是影响串扰的主要因素,同时封装基板上由芯片上bump到BGA ball的线长一般比较固定,因此将线长确定为一固定值,下面主要讨论串扰与介质厚度的关系。
(1)近端串扰。
图13为线厚t=15 μm,线宽w0=20 μm,线间距d=100 μm时,近端串扰S12、S13与介质厚度(15 μm,30 μm,45 μm)的关系。由图13可知,当h=30 μm时,整体串扰噪声幅度要优于h=15 μm的;当h=15 μm和30 μm时,在8 GHz频率以内S12均在-35 dB以下。S13对应的3种介质厚度在7 GHz频率内均在-40 dB以下。因此,介质厚度h=30 μm时有机基板上传输线近端串扰整体较小。

Figure 13 Near-end crosstalk S12 and S13 changing with medium thickness (t=15 μm,w0=20 μm,d=100 μm)图13 近端串扰S12、S13随介质厚度的变化(t=15 μm,w0=20 μm,d=100 μm)

Figure 14 Far-end crosstalk S12 and S13 changing with medium thickness (t=15 μm,w0=20 μm,d=100 μm)图14 远端串扰S15、S16随介质厚度的变化(t=15 μm,w0=20 μm,d=100 μm)
(2)远端串扰。
图14为线厚t=15 μm,线宽w0=20 μm、线间距d=100 μm时,远端串扰S15、S16与介质厚度(15 μm,30 μm,45 μm)的关系。由图14可知,h=15 μm时的远端串扰系数S15和S16均小于其他介质厚度下的。3种介质厚度对应的远端串扰系数在0~10 GHz频率内均在-30 dB以下,这也说明了远端串扰对于有机基板上传输线而言并不是构成串扰的主要因素,在设计中应优先考虑近端串扰。
5 结束语
(1)高密度互连封装基板需关注信号完整性问题。基板类型、基材厚度、导线厚度、宽度和间距等设计参数不同,对传输线上信号质量的影响也不同。
(2)反射系数S11与基板传输线端接匹配密切相关,受信号频率影响较大。在进行封装基板设计时要根据不同信号的频率需求合理设计基板各物理参数,以优化反射系数,满足系统性能要求。
(3)近端串扰和远端串扰受封装基板上传输线间距影响较大。基板采用不同的介质厚度所造成的近端串扰和远端串扰大小也不同。相同条件下,远端串扰噪声一般小于近端串扰噪声,设计时应结合基板互连密度和传输线耦合长度,合理规划串扰余量。
(4)常规有机基板介质材料介电常数较陶瓷基板的低,利于高速信号的传输,因此在端接匹配的情况下,有机基板上传输线的反射也较陶瓷基板的小。当封装内的高速信号较多时,采用有机基板可以更好地减小传输损耗。
