后退火时间对磁控溅射制备β-Ga2O3薄膜材料的影响
2022-05-11高灿灿杨发顺
杨 赉, 高灿灿, 杨发顺,2,3,, 马 奎,2,3,
(1.贵州大学 电子科学系, 贵阳 550025;2.贵州省微纳电子与软件技术重点实验室, 贵阳 550025;3. 半导体功率器件可靠性教育部工程研究中心, 贵阳 550025)
1 引 言
氧化物半导体材料氧化镓是近年来科研人员重点研究的宽禁带半导体,其禁带宽度在5 eV左右[1],而相比较前两代半导体硅(Eg=1.12 eV)、GaAs(Eg=1.43 eV)和同属一个范畴的宽禁带半导体SiC(Eg=3.3 eV)、GaN(Eg=3.4 eV)而言,氧化镓有着耐高压、大功率和低损耗等突出优势. 目前,在已确定的5种氧化镓晶体结构(α、β、γ、δ、ε)中,β-Ga2O3是最稳定的一种,其投射光谱的吸收边位于日盲紫外区(波长位于240~280 nm之间),使其在紫外光电器件、探测器等领域有广泛应用前景[2-5]. 而成熟的器件应用少不了高质量的薄膜材料,所以对于制备的β-Ga2O3薄膜材料的研究便有了极大的意义.
薄膜材料的制备随着科研技术的提高呈现出多种多样且成熟的方法. 其中金属有机化学气相沉积(Metal-organic Chemical Vapor Deposition,MOCVD)[6]、脉冲激光沉积(Pulsed Laser Deposition,PLD)[7]、磁控溅射[8, 9]等是目前常用的β-Ga2O3薄膜材料制备方法. 相较于MOCVD和PLD,磁控溅射生长出的β-Ga2O3薄膜致密均匀,且具有设备易于控制、操作简单、粘附性强、生长速率快以及低成本的优点,已被广泛应用.
后退火(Thermal Annealing)处理属于重结晶技术范畴,能够较好地帮助薄膜释放应力,消除材料内部位错等缺陷,改善薄膜晶体质量[10]. 沙特阿拉伯萨克拉大学Hassanien等[11]采用磁控溅射的方法以石英(SiO2)为衬底制备Ga2O3薄膜并对其进行退火处理,结果表明,退火温度能够有效地改善Ga2O3薄膜的微观结构质量. Sang等[12]研究了在500 ℃到800 ℃的脉冲激光沉积和退火后工艺制造的具有金属-半导体-金属结构的掺杂硅的氧化镓光电探测器,结果表明,掺杂硅的β-Ga2O3层在热退火后可以根据高光响应率或快速响应时间的应用来改变光探测器的性能. Wang J等[13]通过射频磁控溅射方法将β-Ga2O3沉积在C面蓝宝石衬底上,然后进行后退火处理. 结果表明,所有薄膜是纯β-Ga2O3,具有单 (-201) 择优取向. Zhang H[14]等报道了退火气氛对铌掺杂β-Ga2O3薄膜的结构和光学性质的影响,退火后铌掺杂β-Ga2O3薄膜的结晶性能和表面粗糙度均得到改善,不同退火气氛使得禁带宽度从退火前的5.09 eV变到了5.19~5.26 eV,退火后光致发光发射峰的红移明显. Goyal等[15]利用PLD技术在蓝宝石基底上进行β-Ga2O3薄膜的生长并进行退火处理. 结果表明,生长的β-Ga2O3薄膜是无应变的,并优先沿1/2 401定向. 薄膜的带隙随退火时间和退火温度的增加而增大.
退火工艺优点颇多,且退火工艺参数确定也至关重要,但针对于退火时间对薄膜材料的影响却鲜有报道.本文基于射频磁控溅射法制备β-Ga2O3薄膜,在工作压强、溅射功率、退火温度等不变的条件下仅改变后退火时间,研究在氧气气氛下不同退火时间对薄膜质量的影响. 通过XRD和AFM对薄膜进行表征,并对所得结果进行理论分析.
2 实 验
实验制膜设备采用JGP280双靶磁控溅射系统,后退火设备采用L4514管式高温水平管式扩散炉. 实验另需系统材料:高纯度(99.99%)的氧化镓陶瓷靶材、1 × 1 cm2的C面蓝宝石晶片衬底材料、高纯度(99.999%)的氧气和高纯度(99.999%)的氩气. 实验步骤如下:
第1,清洗衬底. 首先用去离子水将蓝宝石衬底冲洗10分钟,然后依次用无水乙醇、丙酮、无水乙醇进行超声波清洗15分钟,最后再用去离子水冲洗10分钟. 将清洗完的蓝宝石用氮气吹干并放入磁控溅射系统基台上准备薄膜的制备.
第2,制备薄膜. 磁控溅射的相关工艺参数分别为:本底真空9.0×10-4Pa,靶基距6.0 cm,工作压强1.0 Pa,溅射功率150 W,沉积时间90 min,衬底加热温度500 ℃,氧气流量2.3 sccm,氩气流量46.2 sccm(氧氩比1:20).
第3,退火处理. 将溅射制得的β-Ga2O3薄膜样品进行退火处理,退火温度为1000 ℃,退火氛围为氧气气氛(1 L/min),退火时间分别为:60 min、90 min、120 min、150 min、180 min.
第4,将不同退火时间下的薄膜样品进行XRD和AFM表征,分析薄膜晶体结构和表面粗糙程度,探究退火时间对β-Ga2O3薄膜结构特性的影响;利用积分球式分光光度计测试并研究退火时间对β-Ga2O3薄膜光学特性的影响.
3 结果与讨论
3.1 退火时间对薄膜结构特性的影响
图1所示为不同退火时间下得到的β-Ga2O3薄膜XRD图谱. 经分析,当退火时间为60 min和90 min时,在2θ=18.92°、38.46°和59.18°左右出现对应β-Ga2O3薄膜(-201)、(-402)及(-603)取向的衍射峰,同属于<-201>晶面族;同时在其对应的衍射峰处峰强较强,且半高宽较小,薄膜有较好的择优取向性. 除此以外,在2θ=30.06°出现β(-401)取向的衍射峰,原因可能是1000 ℃的退火温度使晶粒向择优取向晶面运动的同时,也向其他位置移动,并与相邻原子结合成键、成核生长,所以结晶面增多,薄膜取向性降低.
当退火时间继续延长,在退火时间为120 min、150 min和180 min时,薄膜也都同样出现β(-201)、β(-401)、β(-402)以及β(-603)取向的衍射峰. 但是相较退火60 min和90 min,衍射峰位置发生了右移,即向大角度方向移动,原因可能是在1000 ℃的退火温度下,衬底Al原子能量增强,迁移扩散能力大于外延β-Ga2O3薄膜中镓、氧原子,Al原子向外延薄膜扩散;同时随着退火时间延长,Al原子与镓原子发生替位,由于Al原子半径比镓原子小,替位后,薄膜晶格常数减小. 由布拉格方程,面间距变小,角度增大,导致衍射峰位置发生右移[15].

图1 不同退火时间β-Ga2O3薄膜的XRD图谱Fig.1 XRD patterns of β-Ga2O3 thin films with different annealing times
针对β(-201)衍射峰进行分析,利用Jade软件分析其半峰宽,利用谢乐公式计算对应薄膜的晶粒尺寸,不同退火时间薄膜的半峰宽和晶粒尺寸见表1所示. 退火60 min时,β(-201)衍射峰强度较弱,强度仅为180,并且出现杂峰,薄膜晶体质量较差. 延长退火时间至90 min,衍射峰强度最强,峰强为431,半峰宽为0.369°,在此退火时间的薄膜结晶质量最优. 原因是在退火温度和气氛固定的前提下,90 min的退火处理使薄膜进行充分的重结晶,薄膜内的镓、氧原子有足够的能量和时间运动到晶格合适位置进行重组、成核、生长,β-Ga2O3薄膜结晶质量升高.
但退火时间继续延长,薄膜的衍射峰强度反而降低. 当退火120 min和150 min时,β(-201)衍射峰强度为93和268,半峰宽分别是0.385°和0.382°,薄膜结晶度变差. 原因可能是退火时间过长,到达最佳位置的原子继续接受更高的能量,进行偏离格点的移动,从而破坏原本的晶格结构,导致原子排列的周期性和有序性降低,薄膜结晶质量降低. 继续延长退火时间至180 min,β(-201)取向的衍射峰强度为387,半高宽是0.369°,薄膜结晶质量有所升高. 原因可能是长时间的退火处理使铝原子与镓原子的替位已经充分发生,扩散运动达到了动态平衡状态,薄膜结晶质量变优.
综上所述,退火90 min和180 min的β-Ga2O3薄膜结晶质量较好.
利用ORIGIN软件绘制出不同退火时间与β(-201)衍射峰半峰宽和晶粒尺寸关系,如图2所示,红色曲线A和蓝色曲线B分别代表β(-201)
半峰宽和晶粒尺寸随退火时间变化的关系. β(-201)衍射峰半峰宽随退火时间延长先增大后减小. 晶粒尺寸先减小后增大,但是晶粒尺寸变化不大,差值在1 nm左右. 退火90 min时,晶粒尺寸为21.594 nm,原因可能是在1000 ℃的退火温度前提下,粒子有足够高能量,随退火时间延长晶粒尺寸变大. 但在一定退火温度下,晶粒尺寸有极限,所以维持在21 nm左右.
为了研究退火时间对β-Ga2O3薄膜表面形貌的影响,对薄膜进行AFM表征,图3为退火60min、90 min、120 min、150 min和180 min的β-Ga2O3薄膜的AFM图像,扫描范围是10 μm×10 μm. 分析得到,在退火温度1000 ℃、氧气气氛前提下,当退火时间从60 min增加到90 min时,薄膜表面均方根粗糙度从2.48 nm减小到2.03 nm. 延长退火时间至120 min、150 min和180 min后,薄膜表面均方根粗糙度依次是1.85 nm、1.89 nm和2.12 nm. 随着退火时间的增加,均方根表面粗糙度整体呈现先减小,后稍微增大的趋势,与前文晶粒尺寸的分析相符. 出现此现象的原因是1000 ℃的高温退火处理使薄膜内部重新结晶,当镓、氧原子获得足够高的能量时,会向合适的晶格位置运动. 薄膜晶体质量变优. 但随着退火时间继续增长,薄膜内部的小部分原子离开所属的晶格位置继续运动,薄膜均方根粗糙度增加,晶体质量变差.

图2 β(-201)衍射峰退火时间与半峰宽和晶粒尺寸关系Fig. 2 The relationship between the annealing time of the β(-201) diffraction peak and half-width and grain size
3.2 退火时间对薄膜光学特性的影响
为了研究退火时间对β-Ga2O3薄膜光学性质的影响,利用积分球式分光光度计对不同退火时间处理的薄膜进行吸收光谱测试,如图4所示. 随着波长的增加,β-Ga2O3薄膜的吸光度呈现先上升后下降再上升再下降的变化趋势,即薄膜的吸收光谱存在两个吸收峰值,分别位于250 nm和300 nm附近处. 相较于第一处的峰值,第二处峰值吸收强度大大减弱. 对于出现两个吸收峰的原因一方面可能是在1000 ℃的高温退火前提下,蓝宝石衬底中的Al离子向薄膜内部扩散,引入少许杂质,薄膜内部原子排布受到干扰,导致薄膜材料在不同波长吸收光子的能力有所改变. 另一方面还可能是由于磁控溅射中溅射功率和高能靶材原子的沉积使得薄膜晶粒尺寸变小,出现量子尺寸效应,即薄膜材料的带隙宽度变大,进一步影响薄膜材料在250 nm附近处的吸收峰值大于300 nm附近处的吸收峰值. 而且从吸收峰的位置可以看出薄膜在深紫外区域有较好的吸收特性. 另外,从图中可看出,随着退火时间的增加,β-Ga2O3薄膜的吸光度并没有随之升高,而是无规律的分布. 退火180 min时薄膜吸光度达到最大,两处的吸收强度峰值分别为0.70和0.32. 退火60 min时,薄膜吸光度较强,两处的吸收峰值分别为0.68和0.24,吸光度仅次于退火180 min的薄膜. 相较与其他退火时间,进行90 min退火处理的薄膜吸收强度峰值分别为0.59和0.27,这也体现出薄膜吸光度与退火时间呈现出不规律的增长趋势.
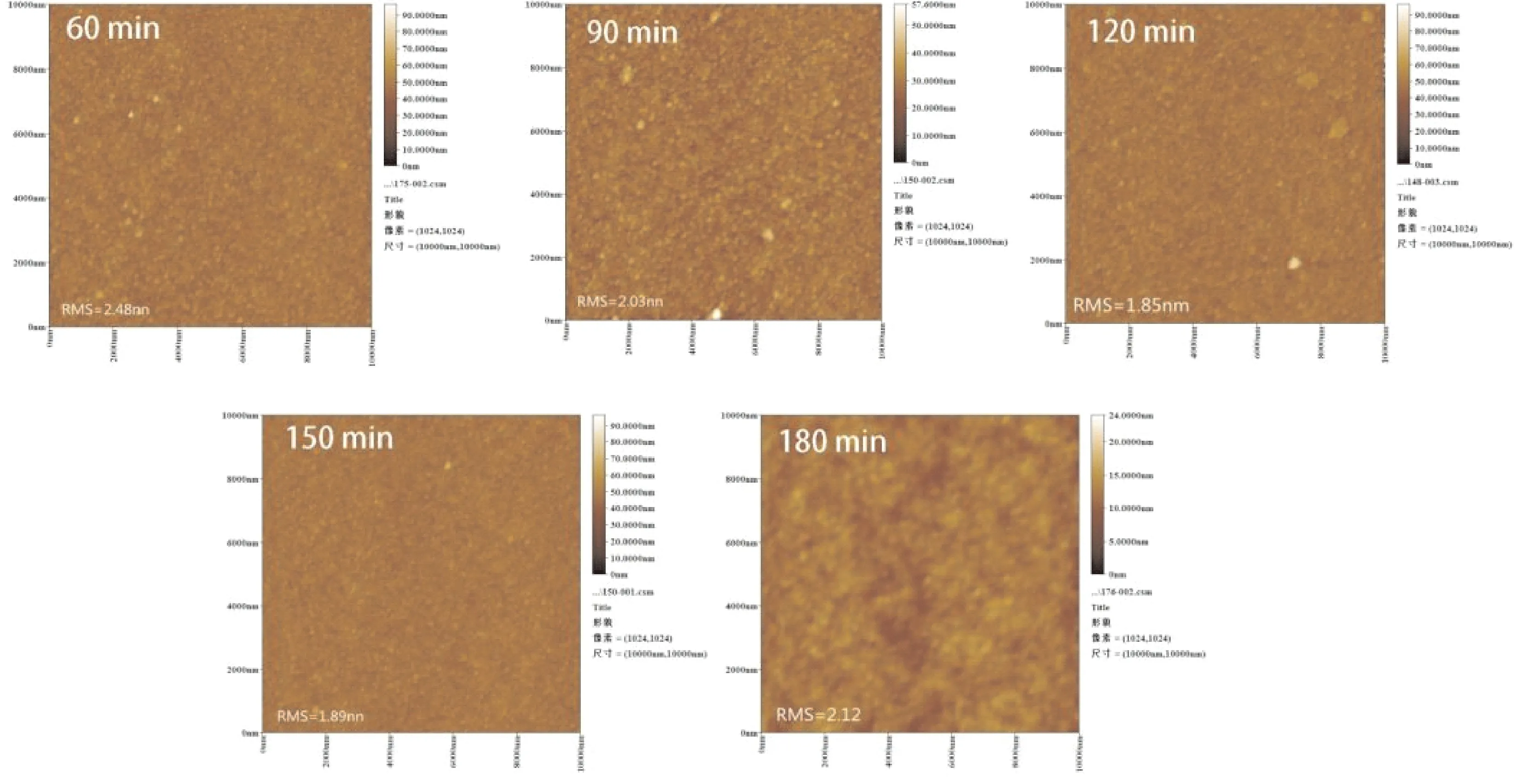
图3 不同退火时间β-Ga2O3薄膜的AFM图像Fig. 3 AFM images of β-Ga2O3 thin films with different annealing times
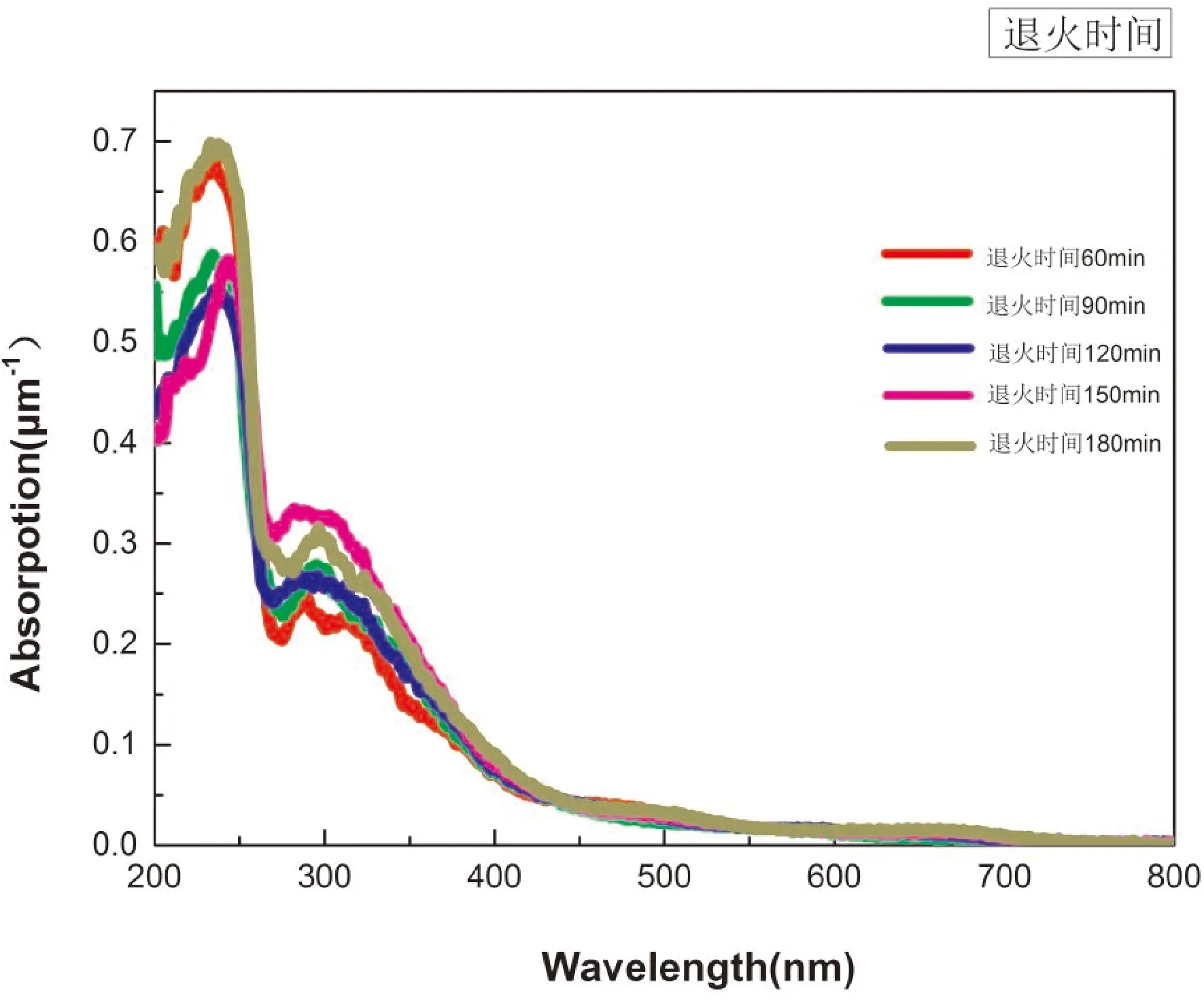
图4 不同退火时间薄膜的吸收光谱图Fig. 4 Absorption spectra of films with different annealing times
4 结 论
针对基于射频磁控溅射在C面蓝宝石衬底上制备的β-Ga2O3薄膜材料并进行一定条件退火处理,研究了不同退火时间对薄膜材料的影响. 在退火温度为1000 ℃、氧气气氛前提下,结合对不同退火时间条件下β-Ga2O3薄膜的X射线衍射和原子力图像分析得出,退火时间为60 min时,对应β-Ga2O3薄膜β(-201)、β(-402)和β(-603)取向的衍射峰强度较弱,薄膜结晶质量较差. 退火时间为90 min时,对应的峰强较强、半高宽较小,表面均方根粗糙度较低. 退火时间为180 min时,对应的衍射峰强较强、半高宽较小,但其表面均方根粗糙度较高,说明对应的薄膜质量较差. 积分球式分光光度计测试结果表明,薄膜的吸收光谱存在两个吸收峰值,分别位于250 nm和300 nm附近处,在深紫外区域有较好的吸收特性. 综合分析得出,在退火时间为90 min时,β-Ga2O3薄膜结晶性能较好,表面平整、晶粒分布均匀,薄膜吸光度较强.
