光耦在实际应用中的几种常见失效
2021-09-10徐军军黄文锋
徐军军,黄文锋
(工业和信息化部电子第五研究所,广东 广州 511370)
0 引言
光耦全称为光电耦合器,是一种将发光器、受光器和信号处理电路等封装在一起的器件[1]。其中,输入端发光器多为GaAs 红外LED,输出端受光器可能为光敏三极管、光敏场效应管或者集成电路等。其工作原理为:给输入端施加电信号,发光二极管将电信号转化为光信号,受光器捕捉到光信号后,再将其转化成电信号。由于光电耦合器输入输出间互相隔离,电信号传输具有单向性,因而其具有良好的电绝缘能力和抗干扰能力。光耦自20世纪70 年代发展起来,现在被广泛地应用于各种电路中[2]。
1 光耦的应用
由于光耦具有良好的电绝缘能力、抗干扰能力和很强的共模抑制能力,目前其已成为种类最多、用途最广的光电器件之一,主要有以下几种应用。
a)组成逻辑电路
由于光耦的抗干扰性能和隔离性能比晶体管好,因此,由它构成的逻辑电路更可靠,也更容易和逻辑电路配合。
b)线性电路中的应用
线性电路采用线性光耦,隔离性能好。
c)用作固体继电器
光耦固体继电器具有体积小、驱动功率小和动作速度快等优点,性能可靠,工作稳定。
d)在触发电路中的应用
由于发光二极管分别串入两管发射极回路,可有效地解决实际输出与负载隔离地面问题。
光耦在广泛使用过程中难以避免会发生各种失效,分析失效原因,减少故障几率对实际工作具有指导意义。本文通过实际应用光耦的失效分析,给出了光耦在实际应用中常见的失效模式,为提高光耦的可靠性提供了依据。
2 光耦失效案例分析
光耦的失效分析遵循电子器件失效分析的方法和流程,即先做无损分析,包括外观检查、X-ray透视检查和电特性测试等以定位失效发生的区域,若未发现失效原因,还应进一步地对样品进行破坏性分析。
2.1 封装缺陷导致的失效
光耦样品在现场使用约两年后发生失效,具体表现为输入端二极管开路失效,需采用X-ray 对样品进行检查,结果如图1 所示。X-ray 检查发现输入端二极管的键合丝弯曲变形,在键合球位置存在断开现象,如图2 所示;同时对同批次样品进行检查,同样发现键合丝也存在弯曲变形现象,如图3 所示。
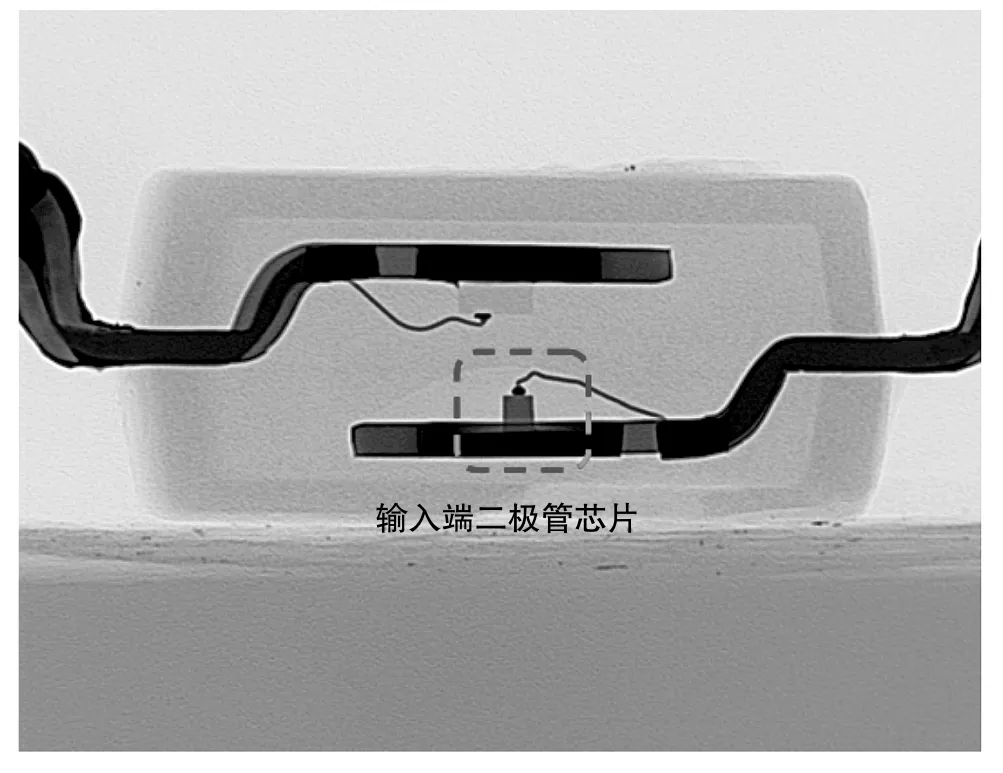
图1 失效样品的侧面X-ray 图
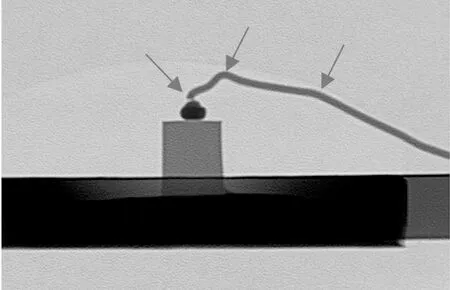
图2 输入端二极管键合丝X-ray 图(箭头示意弯曲形变)

图3 同批次样品的侧面X-ray 图(箭头示意弯曲形变)
键合丝的弯曲形变表明键合丝曾受力的作用,导致键合丝在颈部位置发生断裂。封装体内键合丝的弯曲形变是不正常的现象,造成这种现象的原因有很多,以下列举几种可能的情况:
1)键合丝压合过程中抖动过大;
2)物料转运过程中受外物拉扯;
3)压焊机设备故障;
4)键合时芯片位置不正;
5)封装注塑工序中框架出现晃动。
2.2 银迁移导致的失效
对于金属密封封装的光耦而言,内部芯片多采用银浆粘接方式连接芯片,而银浆中的银颗粒在电场和水汽的作用下易发生迁移,因此,针对此类密封封装的光耦器件,检测其内部气氛种类及含量非常重要,往往由于腔体内部水汽含量超标而引起光耦失效。
某设备的板卡采用金属密封封装的光耦如图4所示,在首次装机使用时出现故障,经故障定位确认为光耦失效,对样品的内部气氛含量进行检测,发现水汽含量值超标,为5.66%。

图4 样品外观图
对该样品进行物理开封处理,如图5 所示,在光敏场效应管芯片表面发现存在枝晶状的迁移形貌特征,如图6 所示,采用EDS 成分分析判断可知粘接芯片的银浆材料中银颗粒发生的迁移导致漏电失效。因此,该光耦的失效机理与水汽含量超标存在强相关。

图5 光敏场效应管芯片局部形貌

图6 芯片表面银迁移SEM 形貌
银发生迁移的原理如下,为水在电场的作用下发生电解:

同时,银浆中的银颗粒在电场及上述电离产生的氢氧根离子的作用下,生成银离子,银离子在电场的作用下发生迁移,并最终还原成银,形成枝晶状沉淀物。因此,对于空封光耦,内部气氛含量达标是预防此类失效的关键因素。
2.3 “爆米花效应”
“爆米花效应”指的是器件由于受潮,在焊接的过程中内部的潮湿会产生足够的蒸汽压力损伤或毁坏元件。常见的失效模式包括塑封料与芯片或引脚框分层、键合丝损伤、芯片损伤和内部裂纹等,在一些极端的情况中,还会使器件鼓胀、爆裂。
塑封光耦内部材料种类多、界面多且大,更有利于水汽进入[3]。塑封光耦发生了“爆米花效应”如图7 所示,其导致输入端二极管的键合引线在键合球位置发生拉断,使光耦输入端二极管开路失效。
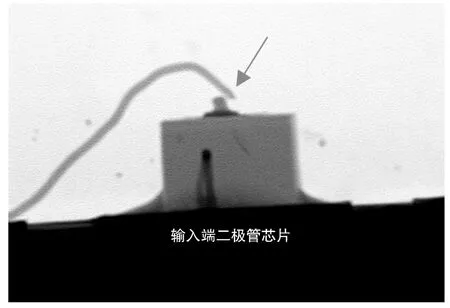
2.4 腐蚀导致的失效
部分光耦为塑料封装,塑料封装是非气密封装[4],具有亲水性,水汽可以在通过塑封材料或塑封材料与引线框架的界面进入光耦内部。若光耦在封装过程中不慎引入腐蚀性Cl-离子,则极易使芯片表面的Al 金属发生腐蚀,导致开路失效。其反应机理为:

由上式可知,Cl-在反应的过程中没有被消耗,而是在不断地参与及生成,如此循环往复,因此光耦在引入极少的Cl-时也可能产生严重的腐蚀[5]。
塑封材料的光耦输入端二极管发生Cl-腐蚀的龟裂形貌如图8-9 所示。预防措施应从芯片制程、封装和存储等各个方面入手,降低光耦中Cl-腐蚀的风险,例如:在芯片制程中相应地延长蚀刻后的化学清洗时间,减少芯片表面的氟化物残留[6]。封装时降低塑封材料料中的Cl-杂质浓度,塑封料生产工艺中可采用加入离子捕捉剂等方法[7]。

图8 输入端二极管芯片形貌

图9 输入端二极管被Cl-腐蚀形貌
3 结束语
本文总结了光耦在实际应用中的几种常见失效,并分析了失效的原因及机理。光耦的失效模式还有很多,例如:过流烧毁、电压击穿和CTR 传输比不足等等。分析并理解光耦的失效原因及机理对光耦的制造、生产和使用都具有积极的意义,可为相关行业人员提供一些经验。
