不同压强下制备镓-镁共掺杂氧化锌薄膜的性能研究
2019-04-04钟志有朱雅
钟志有, 朱雅
(中南民族大学 电子信息工程学院, 智能无线通信湖北省重点实验室, 武汉 430074)
透明导电氧化物(TCO)薄膜具有较宽的直接光学带隙、较高的载流子浓度、低阻高透,展现了优良的光电性能,因此被广泛应用于平板显示器、太阳能电池、触摸屏、电磁防护屏和红外反射涂层等许多领域中[1,2].作为TCO典型代表的掺锡氧化铟(ITO)薄膜,它不仅具有较低的电阻率、较高的可见光透射率和红外反射率,同时还具有良好的机械强度、化学稳定性和耐磨损特性,在太阳能电池[3-5]、发光二极管[6-8]、传感器[9-11]和平板显示器[12-15]等领域具有广泛应用.但是,因为元素铟的自然储存量少、成本高、有毒性、稳定性不佳、制备工艺复杂等多种原因限制了ITO的使用范围[16,17],所以,研制ITO的替代物已经成为当前TCO薄膜领域的重要课题之一.
氧化锌(ZnO)不仅储存量丰富、价格低廉、绿色环保,而且还可以采用掺杂方法制作成性能优良的TCO薄膜.因此,ZnO基TCO薄膜获得了业界的广泛关注.对于掺杂ZnO薄膜,除了研究较多的掺铝ZnO(AZO)薄膜之外,还有掺硼、镓、钛、镁、锆、钪等ZnO薄膜[18-21],主要沉积方法有磁控溅射、喷雾热分解、原子层沉积、脉冲激光沉积、溶胶-凝胶法等[26-31],其中利用磁控溅射工艺所制备的薄膜具有优良的成膜质量和光电性能,是目前最为常用的沉积方法之一[30,31].尽管如此,寻找新的ZnO基掺杂薄膜仍然具有十分重要的意义.实验表明,对于单种元素掺杂的ZnO薄膜来说,掺Mg能够提高ZnO薄膜的透射率,通过改变掺镁含量还可以调控其光学带隙;而掺镓ZnO薄膜则具有优异的电学和抗湿性能.为此本文通过在ZnO中掺入氧化镓(Ga2O3)和氧化镁(MgO)制成二元共掺杂ZnO陶瓷靶材,利用射频磁控溅射技术在玻璃基片上沉积镓-镁共掺杂ZnO(ZnO:Ga-Mg)薄膜样品,基于X射线衍射(XRD)和扫描电子显微镜(SEM)的测试表征,研究了压强对ZnO:Ga-Mg薄膜样品结构和内应力的影响.
1 实验
采用厚度为1 mm的玻璃作为基片材料,大小为3 cm×3 cm.沉积薄膜样品前首先对玻璃基片进行擦拭、冲洗,然后依次在丙酮溶液、无水乙醇和去离子水中进行超声清洗各~10 min,最后使用去离子水冲洗并自然干燥,并放在复合镀膜系统的预溅射室中待用.
在KDJ-567型高真空磁控与离子束复合镀膜系统(沈阳科友真空设备公司)中,利用射频磁控溅射工艺制备ZnO:Ga-Mg薄膜样品,系统真空度为3.0×10-4Pa,基片温度为500 K,射频功率为120 W,溅射时间为30 min,所用陶瓷靶材的直径为5 cm、厚度为0.4 cm.溅射靶材由Ga2O3(2 wt.%)、MgO(2 wt.%)和 ZnO(96 wt.%)三者均匀混合后经过高温烧结而成,所用原材料的纯度均为99.99%.实验时,靶材与基片之间的距离调节为7.0 cm.溅射时采用纯度为99.999%的氩气作为工作气体,并通过调节氩气流量来改变溅射时的压强.本实验中,在固定其它工艺参数不变时改变压强,将它分别设置为3.0 Pa、3.5 Pa、4.0 Pa和4.5 Pa制备了出薄膜样品,以研究压强对ZnO:Ga-Mg样品结构和薄膜应力的影响.
利用X射线衍射仪(D8-ADVANCE型)对薄膜样品进行物相分析,Cu靶 K线,射线源波长为0.15406 nm,采用θ-2θ连续扫描方式,扫描速度为10/min,扫描步长为0.0164,管电压为40 kV,管电流为40 mA.扫描范围为20~70°.通过扫描电子显微镜(SEM,JSM-6700F型)对样品的表面形貌进行分析,其工作电压为10 kV.
2 结果与讨论
图1为不同压强时ZnO:Ga-Mg薄膜样品的XRD图谱,图中(a)、(b)(c)和(d)分别表示压强为3.0 Pa、3.5 Pa、4.0 Pa和4.5 Pa时所制备的薄膜样品.
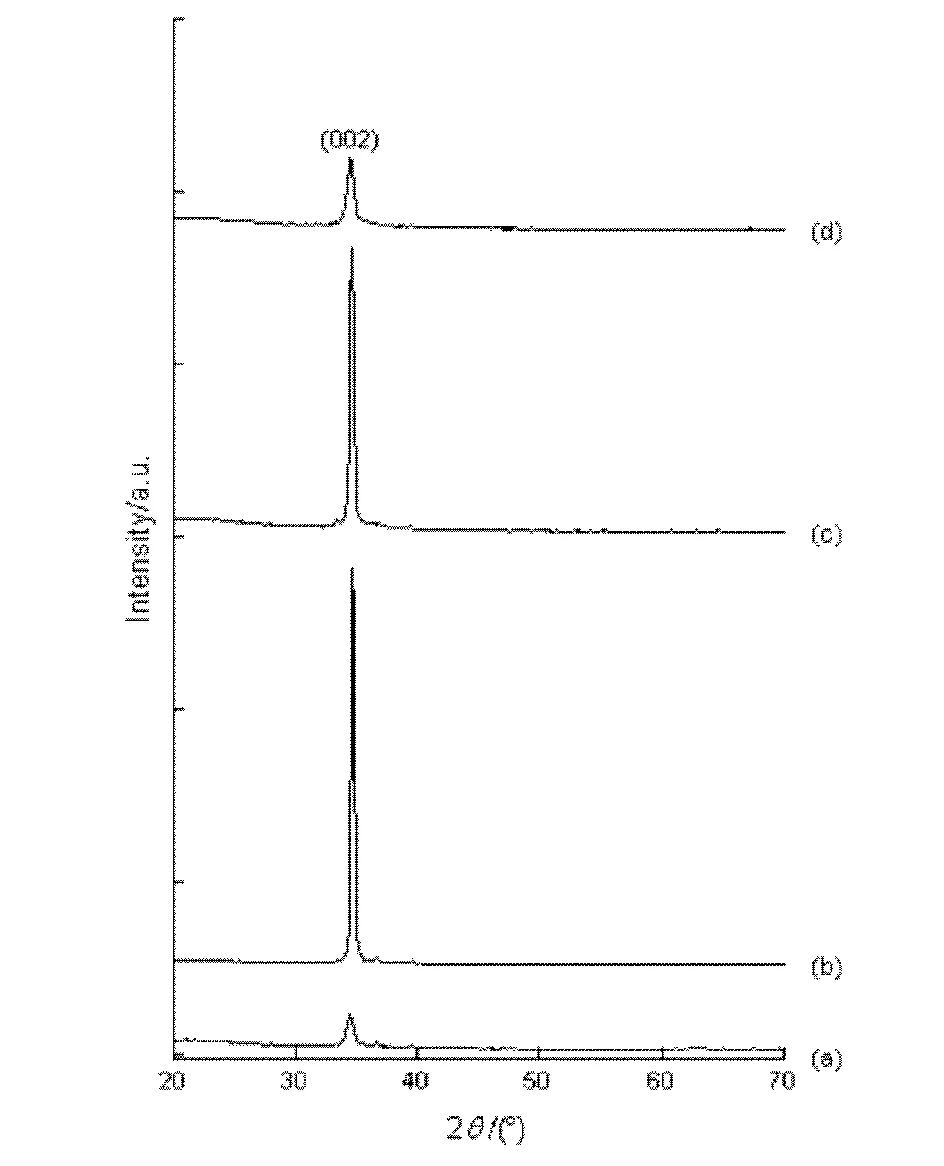
图1 不同压强时薄膜样品的XRD图谱Fig.1 XRD patterns of the samples deposited at different pressures
从图1中看到,所有样品在衍射峰位置(2θ)在34.45°附近,存在唯一的(002)晶面衍射峰,其衍射峰位置与ZnO标准试样图谱(JCPDS No. 36-1451)的衍射峰位置2θ=34.42°是非常接近的[21],这一结果表明:本实验所制备的ZnO:Ga-Mg薄膜样品都为(002)晶面择优取向的六角纤锌矿结构,镓-镁共掺杂并没有改变ZnO的晶体结构,而是取代了晶体结构中的锌,类似的研究结果在文献[18,21,22]中也有报道.另外从图1还可以看出,ZnO:Ga-Mg薄膜的(002)晶面衍射峰的强度(I(002))明显受压强的影响,当压强从3.0 Pa增加到4.5 Pa时,I(002)呈现出先增大后减小的变化趋势,当压强为3.5 Pa时,样品的I(002)值最大,这说明在此压强下所制备的ZnO:Ga-Mg薄膜具有最佳的(002)择优取向生长特性.
图2为不同压强时ZnO:Ga-Mg薄膜样品(002)晶面衍射峰半高宽(FWHM)随压强而变化的关系曲线,可以看出,随着压强的增加,半高宽FWHM先减小后增大,当压强为3.5 Pa时,ZnO:Ga-Mg薄膜样品具有最小的FWHM值,其结晶质量最好.利用(002)晶面衍射峰的XRD数据,ZnO:Ga-Mg薄膜样品的平均晶粒尺寸(L)可以根据公式(1)计算[23]:
(1)

图2 不同压强时薄膜样品的FWHM值Fig.2 The FWHM values of the sample deposited at different pressures

图3 不同压强时薄膜样品的L值Fig.3 The L values of the sample deposited at different pressures

图4 压强为3.5 Pa时薄膜样品的SEM照片Fig.4 SEM image of the sample deposited at pressure of 3.5 Pa
不同压强时ZnO:Ga-Mg薄膜样品(002)衍射峰的晶面间距(d)可以根据公式(2)计算[32]:
(2)
由于ZnO为六角纤锌矿结构,(hkl)晶面的晶格常数(c)由方程(3)确定[33]:
(3)
由方程(3)可知,对于ZnO的(002)晶面,其晶格常数c=2d.根据双轴应力模型[32],薄膜样品的内应力(σ)可以通过公式(4)计算:
(4)
(4)式中,Cij为ZnO标准试样的弹性模量值,其中C11=208.8 GPa,C12=119.7 GPa,C13=104.2 GPa,C33=213.8 GPa,ε为薄膜样品(002)方向的相对应变,其计算公式如下:
(5)
(5)式中,c0为ZnO标准试样的晶格常数(c0=0.52066 nm),c为ZnO:Ga-Mg薄膜样品的晶格常数.ZnO:Ga-Mg薄膜样品内应力σ随压强的变化关系如图5所示,由图可知,所有ZnO:Ga-Mg薄膜样品的应力σ均为正值,这说明本实验所沉积的样品均处于张应力状态,并且其张应力大小随压强增加而先减小后增大,当压强为3.5 Pa时ZnO:Ga-Mg薄膜样品的张应力值最小为8.25104Pa,其结果说明了压强对ZnO:Ga-Mg薄膜晶体结构具有明显的影响,因此选择合适的压强对于制备高质量ZnO:Ga-Mg薄膜是非常重要的.

图5 不同压强时薄膜样品的σ值Fig.5 The σ values of the samples deposited at different pressures
3 结语
以普通玻璃作为基片材料,利用磁控溅射方法制备了ZnO:Ga-Mg薄膜样品,研究了压强对ZnO:Ga-Mg薄膜生长特性和内部应力的影响.XRD研究表明,实验中所制备的ZnO:Ga-Mg样品均为六角纤锌矿型晶体结构,并且其择优取向性随压强的变化而变化;当压强为3.5 Pa时,ZnO:Ga-Mg薄膜样品不仅(002)衍射峰最强,具有最佳的(002)择优取向生长特性,而且其平均晶粒尺寸最大为52.8 nm、张应力最小为8.25104Pa,具有最好的结晶质量.这些结果表明选择合适的压强对于沉积ZnO:Ga-Mg薄膜是至关重要的.
