射频聚焦离子源熔石英高确定去除特性研究
2019-03-23惠迎雪刘卫国马占鹏
惠迎雪,刘卫国,马占鹏,张 进,周 顺
(西安工业大学 陕西省薄膜技术与光学检测重点实验室,陕西 西安 710021)
引言
离子束修形技术(ion beam figuring, IBF)建立在计算机控制光学表面成形(computer controlled optical surfacing, CCOS)基础之上[1-3],在计算机的控制下,通过控制离子束在各加工区域的驻留时间,可将对元件材料的去除量精确地控制在原子量级,具有纳米、亚纳米级别的加工精度,与传统的光学加工相比具有明显优点[4-6],无载荷效应和边缘效应,在刻蚀过程中,由于离子束与光学元件表面微弱的相互作用,几乎不会引入表面及亚表面亚损伤。
熔石英材料因其具有良好的化学稳定性、透紫外性、均匀性和耐辐射性,广泛应用于高能量激光窗口、航空航天、短波光学、微电子及其他光学领域[7]。随着光学元件口径的增大,光学系统重量大幅增加,自重变形和热膨胀变形也成为光学加工领域中的新问题[3],采用熔石英材料的熔接轻型熔石英中大口径光学元件,最大口径尺寸可达8 m以上,减重比70%,已成为重大光学系统和空间光学领域主流材料[8],因此解决熔石英光学元件的超精密加工问题,一直是光学加工领域的研究重点。
目前,可用于离子束修形的离子源主要有考夫曼(Kaufman)、射频(RF)和微波电子回旋共振(ECR)离子源三种[9-10]。其中,RF离子源可通过射频匹配网络将能量耦合至放电腔内实现气体高密度电离,获得较高的刻蚀速率,辅助于多轴运动系统,该源可在真空状况下由点及面,实现光学元件表面面形修正,因此,RF离子源已成为离子束整形加工的首选离子源。中和器是离子束抛光系统中的核心部件之一,它的作用是发射电子中和离子束电荷,防止正电荷在离子束中的堆积[11],能够用于RF离子源光学加工的中和器主要有浸没式钨丝、等离子桥、空心阴极、射频中和器等几种[12],浸没式钨丝中和器易于氧化,使用寿命较短,且由于钨丝浸入在等离子体中,会造成工件表面的金属污染,而等离子体桥亦采用钨丝,使用寿命大约仅数十个小时,空心阴极具有较长的使用寿命,但其电子发射能耗高,效率低,加热器亦需要定期更换灯丝,射频中和器优势在于无阴极,无温度效应,但是其在使用过程中需要增加一套射频激励装置,成本高,对多维运动控制系统的抗干扰性能提出更高的要求。本文采用一种新型的独有的脉冲开关式(beam switch)技术,通过一个脉冲控制开关控制单元(PLM)交替地将阳极与屏栅电源和负偏压连接,当石墨阳极与屏栅电源接通时,离子源正常工作,而当阳极接入负脉冲电压时,此时加速栅联动接地,离子源用作电子源,发射电子束对带正电荷的离子束进行中和,由此,通过调整PLM单元的频率和离子束的流脉冲占空比,实现中和器的功能。该中和方式虽然牺牲了部分效能,但是无需外置特别的器件,仅采用KHz的脉冲电源即可工作,无使用寿命问题。
要实现光学元件表面面形的高精度修正,体现在离子束对元件的刻蚀去除函数高确定性控制,为了适应加工元件各种复杂面形曲率的变化,离子束的去除函数必须在一定参数范围内实现线性调节变化,同时,去除函数必须在一定的工艺范围内保持较好的稳定性[13]。本文以一种新型脉冲开关式射频离子源离子束去除函数为研究内容,以熔石英光学元件为加工对象,通过系统的工艺实验,研究射频离子源离子束对熔石英元件材料的去除函数的形状和大小,以及材料去除效率随工艺参数变化的规律,并着重分析特定工艺参数的小扰动对去除函数的影响。
1 离子束刻蚀实验及去除函数获得
1.1 离子源及实验条件
实验在西安工业大学自行开发的IBE-3000S离子束抛光刻蚀光学平台上进行,该平台配置了德国SICA公司生产的RF40i离子源和自制的二维运动系统。离子源采用13.56 MHz的射频电源,工作气体为高纯氩(>99.999%),离子光学系统是由屏栅、加速栅和减速栅构成的三级栅网,各栅网均采用直径150 mm的高纯石墨球面栅,发射离子经过栅网系统的加速、聚焦和准直,向球面栅球心位置运动,形成高密度离子束。选择商业购置单抛平面Φ25 mm×2 mm的熔石英玻璃作为刻蚀样品,依据离子源的聚焦特性,在束腰位置会得到密度最大、能量最高的离子束束斑。在实验开始之前应提前标定好离子束束腰位置,选择斑点实验法研究熔石英的刻蚀特性。实验时,预先将离子束抛光刻蚀系统的真空腔室本底真空抽至2.0×10-4Pa,离子源点火后,将射频RF功率预设在180 W,屏栅电压1 000 V,通入6 sccm氩气,工作距离25 mm(束腰位置),调节气动阀门将工作真空维持在5.0×10-2Pa ,待离子源工作稳定后进行刻蚀实验,持续工作30 min。
1.2 去除函数
通常聚焦离子束作用于元件表面,产生的去除函数类似高斯形状[14-15]。利用ZYGO激光波面干涉仪测量可得离子束去除函数。去除函数模型为
(1)
式中:A与高斯函数中心最高点的值相等,表示离子束去除函数中心具有最大的材料去除速率,在不混淆的情况下可以称为峰值去除速率;σ是分布参数,描述了去除函数的分布情况。最终的体积去除率B为去除函数在直径范围内的积分,即:
(2)
半高宽FWHM参数,是去除函数r(x,y)取峰值一半值时对应的x方向和y方向的宽度。去除函数的形状和大小可以用上面的峰值去除率A、体积去除率B和半高宽FWHM为指标来表征[16]。图1是RF功率250 W,屏栅电压1000 V,氩气流量6 sccm条件下获得的典型去除斑点,根据斑点处的材料去除量和刻蚀时间的比值计算出去除函数。首先,采用ZYGO激光干涉仪测量刻蚀前后熔石英样品的面形分别如图1(a)和1(b)所示,将刻蚀前后的面形做差,可得去除函数的三维立体图1(c)和3D网状立体图1(d);之后得到去除函数的俯视图1(e),最后分别沿着X获得二维的高斯曲线轮廓线图1(f)。由图1(f)可获得去除函数峰值,将其与刻蚀时间相除得到峰值去除率A,之后由图1(f)可得离子束在X方向高斯曲线轮廓线图,以及Y方向得到高斯曲线轮廓线图(图中未给出),最终得到实际去除函数为
(3)
由此,通过去除函数获得最终的体积去除率B和峰值半高宽FWHM值。






图1 典型熔石英离子束刻蚀后去除函数的测量Fig.1 Measurement of removal function after typical fused quartz ion beam etching
2 熔石英离子束刻蚀特性实验
离子束对熔石英的刻蚀特性研究,着重分析气体流量、屏栅电压、入射角度及工作距离对熔石英去除函数的特征量变化的影响规律,继而分析各参数微扰变化对去除函数稳定性的影响规律。实验的基本工作条件为:保证离子束对材料的高确定性去除。理论上,5.0×10-2Pa时,氩气流量6 sccm,射频功率PRF=250 W,屏栅电压VBeam=1 000 V,工作距离d=25 mm,入射角度θ=0°。以下各项实验,则是在其他参数不变的情况下,改变某一参数,刻蚀时间30 min,分析其对熔石英的刻蚀特性变化规律。
2.1 气体流量对离子束刻蚀特性的影响
图2(a)和(b)是不同气体流量下,刻蚀获得的去除函数峰值去除率A、半峰值全宽FWHM和体积去除率的变化关系。由图2(a)可知,随着气体流量的增大,峰值去除率A逐渐变小,而峰值FWHM逐渐变大,显然,随着氩气流量的增大,去除函数的形状产生了明显的变化,离子束的作用面积增大,而刻蚀深度降低。去除函数的形状主要由束流的形状决定,可见,随着气体流量的增大离子束斑有增大的趋势,如图2(b)所示,随着氩气流量的增大,材料的体积去除率近似线性增大,这是因为单位时间内引入离子源放电腔室内气体浓度越高,离子束流密度也随之相应增大,这是导致材料去除率增大的主要原因。
在本文实验中,真空系统自动抽速调节,可将工作真空稳定在5.0×10-2Pa,如此,随着氩气流量的增大,虽然放电腔室局部的气体密度略有增加,离子束束流也会相应增大,但其增大的范围不是很大,故而材料去除速率增大的范围也极小,由图2(b)可知,即使气体流量增大了一倍,离子束对熔石英定点刻蚀的体积去除率变化也不超过5%,理论上,离子束对材料的刻蚀速率随着束流密度的增大而线性增加[17],而通过稳定工作真空度,即使工作气体流量在较大范围内波动,对材料去除速率的增大的范围也极小。
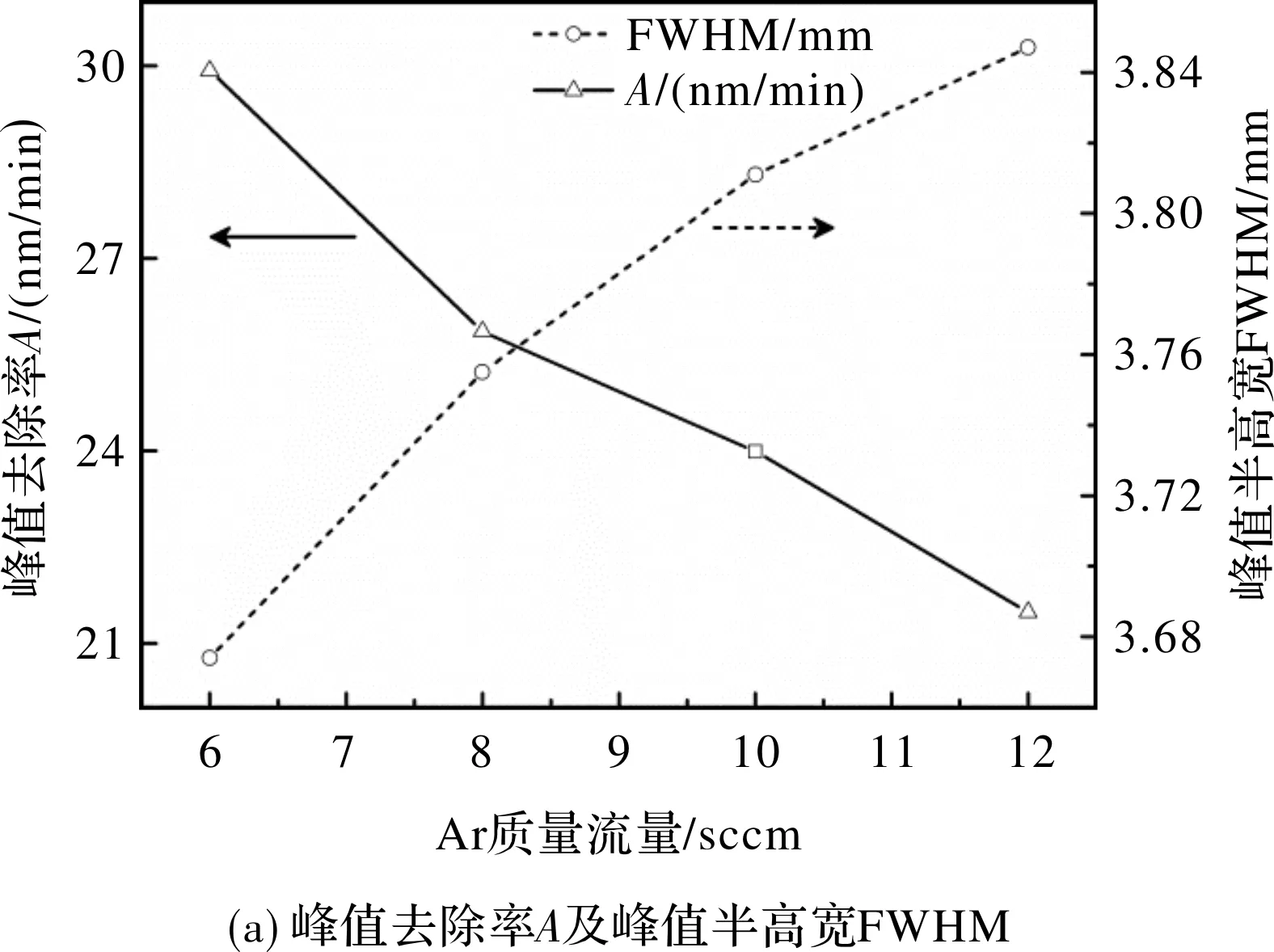

图2 气体流量与去除函数特征量的关系Fig.2 Relationship between gas flow rate and feature quantity of removal function
2.2 屏栅电压对离子束刻蚀特性的影响
图3(a)和(b)是屏栅电压依次在800 V、900 V、1 000 V和1 100 V时,去除函数的变化情况。由图可知,随着屏栅电压的增大,峰值去除率A和体积去除率B均有增大趋势,Steibruchel给出了低能量溅射条件下材料刻蚀去除率v和入射离子能量Ei的关系[18]:
(5)
式中,系数K和溅射刻蚀阈值Eth是与氩离子和材料表面分子结合能相关的常数,去除率与入射离子能量的平方根近似成正比,而离子能量可近似地认为与栅极电压正相关,因此材料峰值去除率和体积去除率均随着屏栅电压的增大而增大,二者并未体现出与(5)式相似的变化关系,主要是因为栅极电压与实际的离子束能量略有差异[3],且加速栅电压的大小与屏栅之间的结构位置关系也会对离子束流的能量造成影响。对比不同屏栅电压下去除函数峰值半高宽FWHM,发现后者随着前者的增大而有减小趋势,表明离子能量的增大,对离子束在轴向的分布有一定的约束作用,但随着离子能量的进一步增大,这种约束作用会变小,这一结论也符合Sigmund溅射理论[18]。


图3 屏栅电压与去除函数特征量的关系Fig.3 Relationship between screen grid voltage and feature quantity of removal function
为了对比屏栅电压的扰动对熔石英去除函数的影响,在同一熔石英样品表面进行三次点刻蚀对比实验,每个点刻蚀30 min,在其他工艺条件保持不变的情况下,各点刻蚀屏栅电压依次为1 095 V,1 100 V和1 105 V。以屏栅电压1 100 V的去除函数为基准,结果如图4所示。

图4 屏栅电压微扰稳定性Fig. 4 Screen gate voltage perturbation stability
由图4可知,在屏栅电压波动幅度为±5 V条件下,去除函数的峰值去除率变化小于5%,体积去除率变化小于4%,而峰值半高宽受到的影响最小,其变化不足1%,表明屏栅电压的小扰动对去除函数的影响小于5%。
2.3 入射角度对离子束刻蚀特性的影响
图5(a)和(b)是离子束入射角度依次在0°、30°、40°、50°、60°和70°,其他工艺参数保持不变时,去除函数的变化情况。由图可知,随着入射角度的增大,去除函数的各个特征指标均随之增大,在60°到达峰值,而在70°时又开始下降。这一结果与文献[20]中报道的Kaufman离子源刻蚀现象相类似,在溅射刻蚀过程中,入射离子与元件原子发生级联碰撞,入射离子的溅射产额与入射角的余弦成反比,入射角度越大,刻蚀效率越高,在入射角60°时刻蚀效率达到了最大。但是,当入射角度过大时,离子反弹效应增加,仅有少量的离子能与元件表面原子发生发生级联碰撞,这也是70°时去除函数特性参数均下降的原因。


图5 去除函数与离子束入射角度的关系Fig.5 Relationship between removal function and incident angle of ion beam
为了对比离子束入射角度的扰动对熔石英去除函数的影响,在同一熔石英样品表面进行三次点刻蚀对比实验,保持其他工艺条件不变,分别将入射角度设定为59°、60°和61°,由于入射角度60°时去除函数的各项特征值最大,以此角度为基准,角度的扰动对去除函数影响最大,其结果如图6所示。由图可知,在入射角度变化为±1°条件下,去除函数的峰值去除率变化小于2%,体积去除率变化小于3.1%,而峰值半高宽受到的影响依然最小,其变化小于0.5%,表明即使是在对角度最为敏感的60°附近,角度的小扰动对去除函数的影响不超过3%。

图6 离子束入射角度的微扰稳定性Fig.6 Perturbation stability of incident angle of ion beam
2.4 工作距离对离子束刻蚀特性的影响
图7(a)和(b)是离子源与加工元件距离分别为20 mm、25 mm和30 mm,其他工艺参数保持不变时,去除函数的变化情况。由图可知,由于在实验中采用的是聚焦离子束,故而在束腰位置25 mm附近,去除函数的半高宽最小,且峰值去除率和体积去除率最大。


图7 去除函数与离子束入射角度的关系Fig.7 Relationship between removal function and incident angle of ion beam
为了对比离子源与加工元件工作距离扰动对熔石英去除函数的影响,在同一熔石英样品表面进行五次点刻蚀对比实验,保持其他工艺条件不变,分别将工作距离设定为24 mm、24.5 mm、25 mm、25.5 mm和26 mm,以工作距离25 mm时为基准,结果如图8所示。由图可知,当工作距离扰动在±1 mm时,虽然峰值半高宽相对变化率仅为1.4%,但峰值去除率相对变化率接近15%,体积去除率相对变化率也超过了5%。当工作距离扰动控制在±0.5 mm时,峰值去除率和体积去除率的相对变化率分别下降至3%和2%。

图8 工作距离的微扰稳定性Fig.8 Perturbation stability of working distance
3 结论
在离子束抛光过程中,材料的高确定性去除是实现光学元件高精密加工的前提和基础,以峰值去除率A、峰值半高宽FWHM和体积去除率为特征量的去除函数是表征离子束材料去除函数的量化指标。本文采用一种新型脉冲式中和器射频离子源对熔石英光学元件进行刻蚀实验,研究了熔石英刻蚀去除函数随着氩气流量、栅极电压、离子束入射角度和工作距离的变化规律,进而分析了各工艺参数的扰动对去除函数稳定性的影响规律。研究结果表明,通过控制工作真空度可有效地避免工作气体流量扰动对去除函数的影响,而栅极电压、离子束入射角度和工作距离的微小扰动,在实验给定的范围内对去除函数特征参量的影响均可控制在5%以内,实验证明了这种新型的脉冲式中和器可应用熔石英光学元件的加工。
