氮化镓基绿光LED中V坑对空穴电流分布的影响
2018-05-31吴庆丰周圣军吴小明张建立全知觉
许 毅, 吴庆丰, 周圣军, 潘 拴, 吴小明, 张建立, 全知觉*
(1. 南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047;2. 武汉大学 动力与机械学院, 湖北 武汉 430072)
1 引 言

2 实验及数值模型
2.1 实验
使用金属有机化学气相沉积(MOCVD)技术生长了A、B、C 3种不同InGaN/GaN超晶格绿光多量子阱LED样品,外延层结构如图1所示。样品生长在c面蓝宝石衬底上,在生长InGaN/GaN超晶格之前,先在蓝宝石衬底上生长一层u-GaN(不掺杂)及n型GaN(厚2 μm,n型掺杂浓度1×1019cm-3)。样品超晶格(SL)由In组分约为2%的InGaN(厚4 nm)和GaN(厚30 nm,n型掺杂浓度1×1018cm-3)周期性组成,其中样品A、B、C超晶格生长温度分别为850,835,835 ℃;生长周期数分别为5,5,8。超晶格之上生长一层低温GaN(厚10 nm,n型掺杂浓度1×1018cm-3),随后生长In组分约为25%的InGaN(厚3 nm)与GaN(厚15 nm,n型掺杂浓度3×1017cm-3)组成的周期数为9的多量子阱结构的有源层。最后生长p层结构,p层结构包括低温p-GaN(厚70 nm,p型掺杂浓度5×1019cm-3)、AlGaN(厚1.5 nm)与GaN(厚2.1 nm,p型掺杂浓度2.5×1019cm-3)组成的周期数为18的超晶格以及p面盖层(厚330 nm,p型掺杂浓度5×1019cm-3)。
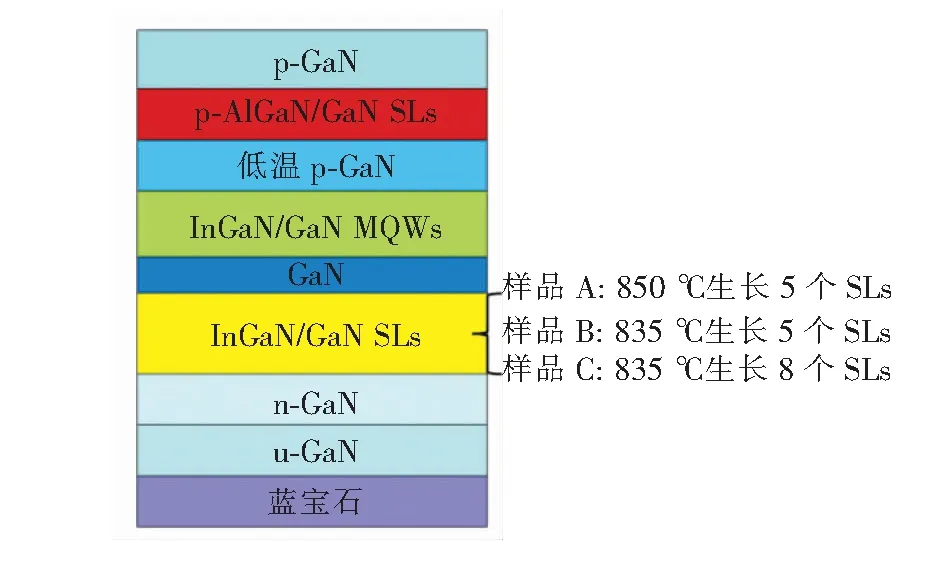
图1 样品外延结构示意图
为了观测不同超晶格生长方式生长出的V坑的表面形貌,设计生长了3种仅生长至超晶格的样品A0、B0、C0,其生长条件分别与样品A、B、C的生长条件一致;并用原子力显微镜(AFM)、扫描透射显微镜(SEM)测试样品A0、B0、C0的V坑密度及尺寸,数据见表1。样品A、B、C均被制作成1 mm×1 mm的芯片,测试其I-V和EQE。详细的材料生长、器件制作工艺及相关实验结果已发表在文献[18]中。
2.2 数值模型
本文使用商用半导体器件模拟软件Silvaco TCAD软件[20]来构建数值模型。该软件的主要物理模型[21]包括用于计算载流子输运的漂移扩散模型和BQP模型;用于计算多量子阱(MQW)能带结构的泊松方程、薛定谔方程的自洽求解以及k·p模型;用于计算内建电场的自发和压电极化模型。理论模拟计算的主要方程如下:
div(εψ)=-ρ,
(1)
(2)
(3)
Jn=qμnnψ+qDnn,
(4)
Jp=qμppψ-qDpp,
(5)
其中ε是介电常数,ψ是电势,ρ是电荷密度。Jn和Jp分别是电子和空穴电流密度,n和p分别是电子和空穴浓度,q是电荷,t是时间,Gn和Gp分别是电子和空穴产生率,Rn和Rp分别是电子和空穴复合率。μn和μp分别是电子和空穴迁移率,Dn和Dp分别是电子和空穴扩散系数。
利用 Fiorentini 等[22]发展的方法计算由于自发极化效应和压电极化效应导致的界面极化电荷。考虑到缺陷等因素对极化电荷的屏蔽效应,实际的表面电荷密度一般为理论值的20%~80%[23-24],本文中表面电荷密度采用理论值的50%进行计算[25]。Shockley-Read-Hall(SRH)载流子寿命为50 ns[26]。辐射复合率B设置为2×10-11cm3/s[17]。文献中报道的俄歇复合系数C为5×10-28~1×10-34cm6/s[27-28],本文设置为5×10-30cm6/s。
本文设计了3种不同模型分别对应于样品A、B、C。样品模型的建立基于3个假设:(1)假设V坑均匀分布;(2)假设V坑尺寸大小相同;(3)假设位错被V坑完全屏蔽,即模型中不涉及位错。为了更贴近真实情况,样品模型被设计为仅包含一个V坑的圆柱体;圆柱体的高为样品的实际厚度,半径为一变量r值,故V坑分布密度ρ=1/(πr2)。通过变化r值,可定义出不同的V坑分布密度;反过来,根据实验测得样品的ρ值可设计出对应样品模型的半径r(表1)。样品模型中各层的参数设置与实验样品一致;而V坑侧壁的各层厚度设置为c面各层厚度的1/3[11],侧壁量子阱中In组分设置为4%[12]。Mg掺杂的电离率为1%[29-30]。由于模型是对称结构,为了节约计算时间,故模拟中只需计算圆柱体的半个截面,如图2所示。该半截面以Y方向为轴,旋转360°后成为一个圆柱体模型。图2中,生长完InGaN/GaN超晶格后的V坑半径定义为L1,生长完末垒时的V坑半径定义为L2,低温n-GaN与多量子阱的厚度之和定义为H,厚度H的对应侧壁厚度定义为D。L1可通过实验直接测得,见表1,且厚度H已知;D为H的1/3,V坑夹角为56.08°;根据上述已知条件,可计算出L2值,见表1。定义L2值为V坑的半径,则V坑面积占比α=L22/r2(表1)。模型建好后,空穴有两种方式注入到c面量子阱中,一种是空穴由p层GaN经平台直接注入到c面量子阱,称之为“平台空穴注入”;另一种是空穴由p层GaN经V坑侧壁侧壁量子阱再注入到c面量子阱,称之为“V坑空穴注入”,如图2所示。
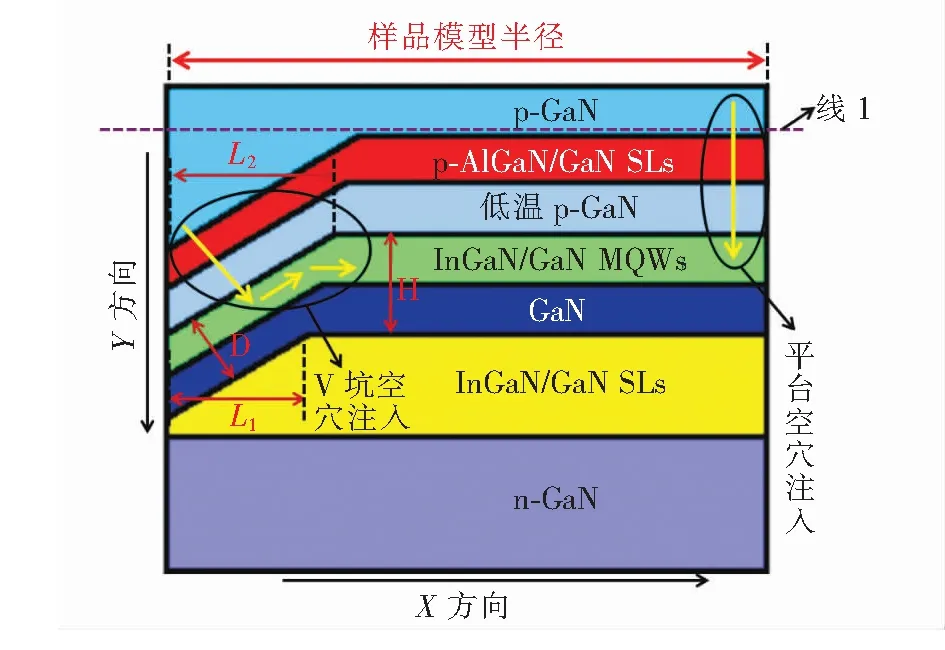
图2 样品模型截面示意图
3 结果与讨论
表1列出了样品实验及理论模型的相关参数。由SEM和AFM的测试结果可知,超晶格生长温度越低,V坑直径越大,密度也越大;超晶格生长周期数越多,V坑直径越大,密度也稍大。因此,样品A、B、C的V坑面积占比依次增大。
图3(a)为3个实验样品的EQE及I-V曲线。在大电流密度(>3 A/cm2)下,样品A、B、C(V坑面积占比依次增大)的正向电压依次减小,EQE依次增大。图3(b)为理论计算的EQE(假设抽取效率为60%)和I-V曲线。在小电流密度(<3 A/cm2)下,样品A、B、C的EQE曲线基本重合,与实验结果不相符。这是由于小电流密度下,SRH复合机制占主导[31];而在理论模型中没有考虑V坑大小及分布密度对SRH寿命的影响,样品A、B、C的模型中设置了相同SRH寿命。另外,模型中V坑的建立是基于两个假设:V坑均匀分布和V坑尺寸大小相同;然而,实际的LED样品很难满足上述假设,所以理论计算与实验之间的EQE和I-V曲线存在一些数值上的差异也是可以理解的。相比这些差异而言,更重要的是:理论计算得到了与实验相一致的变化趋势,即在大电流密度(>3 A/cm2)下,随着V坑面积占比的增大,EQE增大,正向电压减小。因此,可以认为本文建立的数值模型很好地与实验相匹配,具有较好的可信度,可以用来定量计算V坑空穴电流占比,并研究其随V坑尺寸及分布密度的变化规律。

表1 样品实验及理论模拟相关参数

图3 样品的EQE和I-V曲线。(a)实验测试;(b)模拟计算。
图4为35 A/cm2电流密度下图2线1处(沿x方向且紧贴p-AlGaN上表面)沿Y方向的空穴电流密度分布图。假设无V坑存在,整个器件空穴电流密度分布应该是均匀的,空穴电流密度应处处为35 A/cm2,如图4蓝色虚线所示。虚线L2A、L2B、L2C分别为V坑与平台的分界线,对比样品A、B、C电流密度曲线与无V坑电流密度曲线可以看出,由于V坑的存在,V坑处空穴电流密度增加,平台处的空穴电流密度减少,从而使得更多的空穴电流流经V坑。对比样品A、B、C电流密度曲线发现,V坑尺寸越小,流经V坑的空穴电流密度越大。但是这不能说明V坑尺寸越小,空穴注入能力越大。因为衡量V坑空穴注入能力的大小,最终是要看流经V坑的空穴电流与总空穴电流的比值,而该比值不仅与流经V坑的空穴电流密度大小有关,还和V坑面积尺寸有关。定义V坑空穴电流占比β=IV/Itotal(表1),其中IV为流经V坑的空穴电流,Itotal为总空穴电流。由于样品模型为圆柱体,IV可以用V坑处的电流密度曲线对以L2(V坑半径)为半径的圆的积分得到,Itotal可以用整条电流密度曲线对以r(样品模型半径)为半径的圆的积分得到。计算结果表明,V坑空穴电流占比随着V坑面积占比增大而增大(表1)。

图4 样品A、B和C在35 A/cm2电流密度下线1处计算出的空穴电流密度分布图。样品A、B、C的V坑半径分别为L2A、L2B、L2C,模型半径分别为rA、rB、rC。
图5为3个样品V坑空穴电流占比与V坑面积占比的关系曲线。样品A 、B、C的V坑面积占比为2.8%、5.8%、9.8%,其V坑空穴电流占比分别为8.9%、15.5%、23.5%。由图可知,V坑面积占比在0~10%范围内,V坑空穴电流占比远小于50%,所以本实验样品中的V坑空穴注入起到一个辅助作用。由图5还可以发现3个样品的V坑空穴电流占比与V坑面积占比之间呈线性增加关系。该线性关系的斜率为2.06,即1%的V坑面积可以获得2.06%的空穴电流。该斜率可用来表征V坑空穴注入能力的大小,当斜率大于1时,V坑则可起到增强空穴注入的作用,斜率越大说明V坑空穴注入的能力越大。该斜率值与V坑侧壁结构有关,具体关系有待于进一步研究。
值得注意的是,经V坑或平台注入到有源区的空穴并不会全部参与辐射复合,其中会有部分参与非辐射复合甚至泄露到n区;因此,注入有源区的空穴存在利用效率问题。由于V坑空穴注入与平台空穴注入的注入途径不同,导致注入的空穴在有源区的分布也不同,从而V坑空穴注入的利用效率也应该与平台空穴注入的利用效率不一样,因此V坑空穴电流占比并不等同于V坑实际对发光效率的贡献占比。
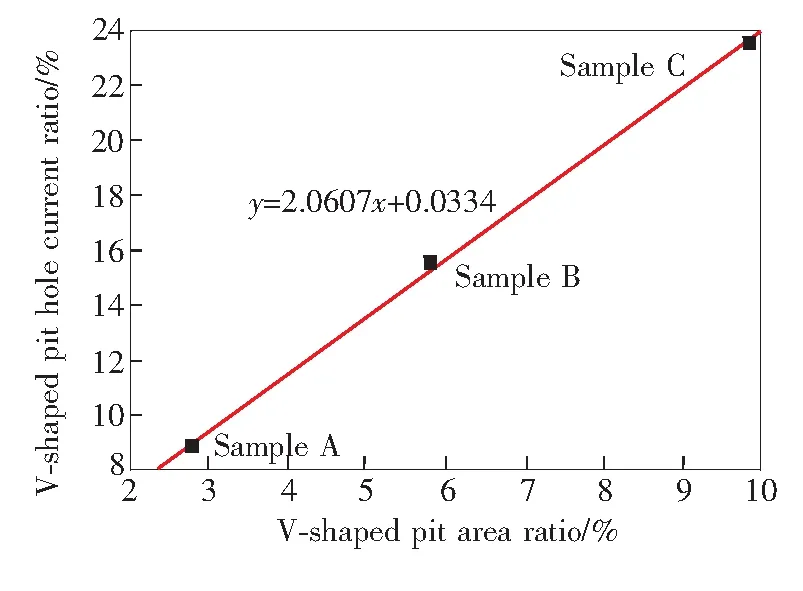
图5 在35 A/cm2电流密度下,样品A、B和C的V坑空穴电流占比与V坑面积占比的关系图。
4 结 论
采用实验与理论模拟相结合的方法,研究了氮化镓基绿光LED中V坑对空穴电流分布的影响。通过改变超晶格生长的温度及周期数,实验获得了V坑面积占比不同的3种样品;随着V坑面积占比依次增大,正向电压依次减小,EQE依次增大。建立数值模型,理论计算的EQE及I-V曲线与实验的变化趋势相匹配。利用该模型发现V坑改变了空穴电流的分布,空穴电流密度在V坑处显著增加,在平台处明显减小。进一步分析发现实验中3个样品V坑空穴注入只起到一个辅助作用;且V坑空穴电流占比随V坑面积占比线性增加。
参 考 文 献:
[1] SCHUBERT E F, KIM J K. Solid-state light sources getting smart [J].Science, 2005, 308(5726):1274-1278.
[2] LAUBSCHA, SABATHIL M, BAUR J,etal.. High-power and high-efficiency InGaN-based light emitters [J].IEEETrans.Electron.Dev., 2009, 57(1):79-87.
[3] HORIUCHI N. Light-emitting diodes: natural white light [J].Nat.Photon., 2011, 4(11):738-743.
[4] SOH C B, CHUA S J, LIM H F,etal.. Identification of deep levels in GaN associated with dislocations [J].J.Phys.Condens.Matter, 2004, 16(34):6305-6315.
[5] LE L C, ZHAO D G, JIANG D S,etal.. Carriers capturing of V-defect and its effect on leakage current and electroluminescence in InGaN-based light-emitting diodes [J].Appl.Phys.Lett., 2012, 101(25):252110-1-4.
[6] HANGLEITER A, HITZEL F, NETZEL C,etal.. Suppression of nonradiative recombination by V-shaped pits in GaInN/GaN quantum wells produces a large increase in the light emission efficiency [J].Phys.Rev.Lett., 2005, 95(12):127402-1-4.
[7] NETZEL C, BREMERS H, HOFFMANN L,etal.. Emission and recombination characteristics of Ga1-xInxN/GaN quantum well structures with nonradiative recombination suppression by V-shaped pits [J].Phys.Rev. B:Condens.MatterMater.Phys., 2007, 76(15):155322-1-6.
[8] CHOY H, KIM J Y, KIM J,etal.. Quantum efficiency affected by localized carrier distribution near the V-defect in GaN based quantum well [J].Appl.Phys.Lett., 2013, 103(26):261101-1-4.
[9] KIM J, KIM J, TAK Y,etal.. Effect of V-shaped pit size on the reverse leakage current of InGaN/GaN light-emitting diodes [J].IEEEElectronDev.Lett., 2013, 34(11):1409-1411.
[10] KIM J, CHO Y H, KO D S,etal.. Influence of V-pits on the efficiency droop in InGaN/GaN quantum wells [J].Opt.Express, 2014, 22(S3):A857-A866.
[11] HAN S H, LEE D Y, SHIM H W,etal.. Improvement of efficiency and electrical properties using intentionally formed V-shaped pits in InGaN/GaN multiple quantum well light-emitting diodes [J].Appl.Phys.Lett., 2013, 102(25):251123-1-4.
[12] WU X M, LIU J J, QUAN Z J,etal.. Electroluminescence from the sidewall quantum wells in the V-shaped pits of InGaN light emitting diodes [J].Appl.Phys.Lett., 2014, 104(22):221101-1-5.
[13] LI Y F, YUN F, SU X L,etal.. Deep hole injection assisted by large V-shape pits in InGaN/GaN multiple-quantum-wells blue light-emitting diodes [J].J.Appl.Phys., 2014, 116(12):123101-1-6.
[14] QUAN Z J, WANG L, ZHENG C D,etal.. Roles of V-shaped pits on the improvement of quantum efficiency in InGaN/GaN multiple quantum well light-emitting diodes [J].J.Appl.Phys., 2014, 116(18):181101-1-3.
[15] QUAN Z J, LIU J L, FANG F,etal.. A new interpretation for performance improvement of high-efficiency vertical blue light-emitting diodes by InGaN/GaN superlattices [J].J.Appl.Phys., 2015, 118(19):193102-1-6.
[16] WU X M, LIU J L, JIANG F Y. Hole injection from the sidewall of V-shaped pits intoc-plane multiple quantum wells in InGaN light emitting diodes [J].J.Appl.Phys., 2015, 118(16):164504-1-4.
[17] LI C K, WU C K, HSU C C,etal.. 3D numerical modeling of the carrier transport and radiative efficiency for InGaN/GaN light emitting diodes with V-shaped pits [J].AIPAdv., 2016, 6(5):055208-1-10.
[18] ZHOU S J, LIU X T. Effect of V-pits embedded InGaN/GaN superlattices on optical and electrical properties of GaN-based green light-emitting diodes [J].Phys.Stat.Sol.(a), 2017, 214(5):1600782-1-5.
[19] QUAN Z J, LIU J L, FANG F,etal.. Effect of V-shaped pit area ratio on quantum efficiency of blue InGaN/GaN multiple-quantum well light-emitting diodes [J].Opt.Quant.Electron., 2016, 48(3):195-1-8.
[20] SILVACO Inc. ATLAS [EB/OL]. [2017-09-09]. http://www.silvaco.com.
[21] SILVAC Inc. ATLAS Users Manual 2012 [EB/OL]. (2012-03-20). http://www.silvaco.com.
[22] FIORENTINI V, BERNARDINI F, AMBACHER O. Evidence for nonlinear macroscopic polarization in Ⅲ-V nitride alloy heterostructures [J].Appl.Phys.Lett., 2002, 80(7):1204-1206.
[23] RENNER F, KIESEL P, DOHLER G H,etal.. Quantitative analysis of the polarization fields and absorption changes in InGaN/GaN quantum wells with electroabsorption spectroscopy [J].Appl.Phys.Lett., 2002, 81(3):490-492.
[24] ZHANG H, MILLER E J, YU E T,etal.. Measurement of polarization charge and conduction-band offset at InxGa1-xN/GaN heterojunction interfaces [J].Appl.Phys.Lett., 2004, 84(23):4644-1-3.
[25] RINKEP, DELANEY K T, VAN DE WALLE C G. Auger recombination rates in nitrides from first principles [J].Appl.Phys.Lett., 2009, 94(19):191109-1-4.
[26] RYU H Y, LEE S H. Simulation of the effects of AlGaN electron-blocking layers on the characteristics of InGaN blue light-emitting diodes [J].J.KoreanPhys.Soc., 2012, 61(9):1395-1399.
[27] SHEN Y C, MUELLER G O, WATANABE S,etal.. Auger recombination in InGaN measured by photoluminescence [J].Appl.Phys.Lett., 2007, 91(14):141101-1-3.
[28] CHEN J R, WU Y C, LING S C,etal.. Investigation of wavelength-dependent efficiency droop in InGaN light-emitting diodes [J].Appl.Phys. B, 2010, 98(4):779-789.
[29] LIU C, REN Z W, CHEN X,etal.. Study of InGaN/GaN light emitting diodes with step-graded electron blocking layer [J].IEEEPhoton.Technol.Lett., 2014, 26(2):134-137.

[31] ZHANG Y P, ZHANG Z H, LIU W,etal.. Nonradiative recombination--critical in choosing quantum well number for InGaN/GaN light-emitting diodes [J].Opt.Express, 2015, 23(3):A34-A42.
