不同构型(In,Al)GaN合金发光机理的第一性原理研究
2018-04-19张玲玲史俊杰
张玲玲, 张 敏*, 史俊杰, 贺 勇, 安 婷
(1. 内蒙古师范大学 物理与电子信息学院, 内蒙古 呼和浩特 010022; 2. 北京大学 物理学院, 人工微结构与介观物理国家重点实验室, 北京 100871)
1 引 言
Ⅲ 族氮化物三元合金中,通过改变阳离子(In,Al)的比例,可将其直接带隙从InN的0.7 eV调至GaN的3.5 eV,直至AlN的6.2 eV,波长覆盖了近红外到紫外波段光谱范围[1-2]。相比其他材料,它们具有非常优越的电热力学和光学性质,具备击穿电压高、禁带宽、导热率高、电子饱和速率高、载流子迁移率高等特点[3-4],一直以来受到人们的持续关注。基于氮化物半导体材料研制的高亮度蓝光发光二极管(LED)和激光二极管(LD)已被广泛应用于各个领域[5-7]。
在InGaN合金中,通过改变In组分可将直接带隙从0.7 eV调至3.5 eV,带隙变化对应的波长覆盖了红外到紫外波段,不仅是光学储存、固态照明的理想材料而且还为全光显示以及合成白光提供了蓝、绿光[8-9]。同样,在AlGaN合金中,通过调节Al组分可将直接带隙从3.4 eV调至6.2 eV,带隙变化对应的波长恰好还覆盖了地球上被臭氧层所吸收的中紫外波段220~290 nm(太阳光谱盲区),因此AlGaN是制备日盲型紫外探测器结构的首选材料。AlGaN合金还具有发光光子能量高、电子漂移饱和速度高、介电常数小、导电性能好等优良特性,是高电子迁移率的p沟道晶体管和深紫外光电器件的理想材料[10-11]。
富Ga的InGaN合金中光的来源一直是困扰Ⅲ 族氮化物的重要问题。长期以来,人们曾普遍认为富In相(类量子点或纳米尺度的团簇)是主导InGaN合金光发射的载流子局域中心[12-14]。然而,Humphreys等[15]在实验上用三维原子探针分析发现InGaN是一种随机合金,富In相结构是由电子束损伤导致的In聚集。随后,Chichibu和kent等[8,16]研究表明In-N-链是辐射复合中心及发光中心。然而,目前对几个原子的In-N团簇和In-N-短链所构成的InGaN合金的研究较少,且对于AlGaN合金的发光微观机理的报道更少。为了更深层次地研究这一问题,我们对4种不同构型的(In,Al)GaN合金进行计算,探讨了(In,Al)GaN合金发光的微观机理。
2 模型构建与计算方法
基于密度泛函理论,选用了Vienna ab initio simulation package(VASP)软件包[17],使用平面波作为基组,用缀加平面波(PAW)赝势来描述离子实对价电子的作用,利用周期边界条件实现对合金基态几何结构、电子性质的计算。所有计算均采用3×3×2的72个原子的GaN超原胞,用In或Al替代GaN中Ga的位置。平面波截断能设置为550 eV,布里渊区Monkhorst-Pack[18]K-点网格选取2×2×3。为了得到与实验更匹配的数据值,结构优化过程中我们选用了AM05XC的交换关联泛函,但计算电子与电子相互作用中的交换关联效应时我们采用了GGA-PBE[19]泛函。结构优化中总能收敛于10-5eV,并确保在该平面波截断能以及K点网格下达到收敛精度。通过寻找能量和H-F力的极小值得到最优化的InGaN和AlGaN合金结构,给出了优化后的晶格常数a、c的值。在原子结构弛豫优化中参数设置为:结构迟豫总能量收敛小于10-2meV,最大的压力0.05 GPa,最大的原子位移小于10-4nm。
我们采用LDA-1/2方法对由于广义梯度近似(GGA)所导致的带隙低估问题进行了修正。在LDA-1/2方法计算中,以GaN,AlN,InN带隙实验值为参考,分别选取N,Al,Ga,In原子的n参数值为8,8,100,100,CUT值为2.67,3.33,0.00,1.23进行带隙修正计算。

图1 AlGaN和InGaN两种合金的4种不同构型
3 计算结果与讨论
为了证明计算的可靠性,在计算不同构型的两种合金的电子结构性质之前,首先对纤锌矿GaN、AlN和InN的结构性质进行优化计算。表1给出晶格参数a、c、c/a的计算值,并与其他理论值与实验值进行了对照。可以看到,我们采用AM05 XC泛函优化计算的GaN、AlN和InN的晶格参数与其他理论计算及实验值基本吻合,说明用AM05 XC泛函计算的结果完全可靠。
表1本文用AM05XC泛函计算的纤锌矿GaN、AlN和InN的晶格参量a、c、c/a与他人计算值和实验结果的对比
Tab.1 Comparison of lattice constantsa,candc/acalculated with the AM05 XC functional with other calculation and experimental results for wurtzite GaN, AlN and InN
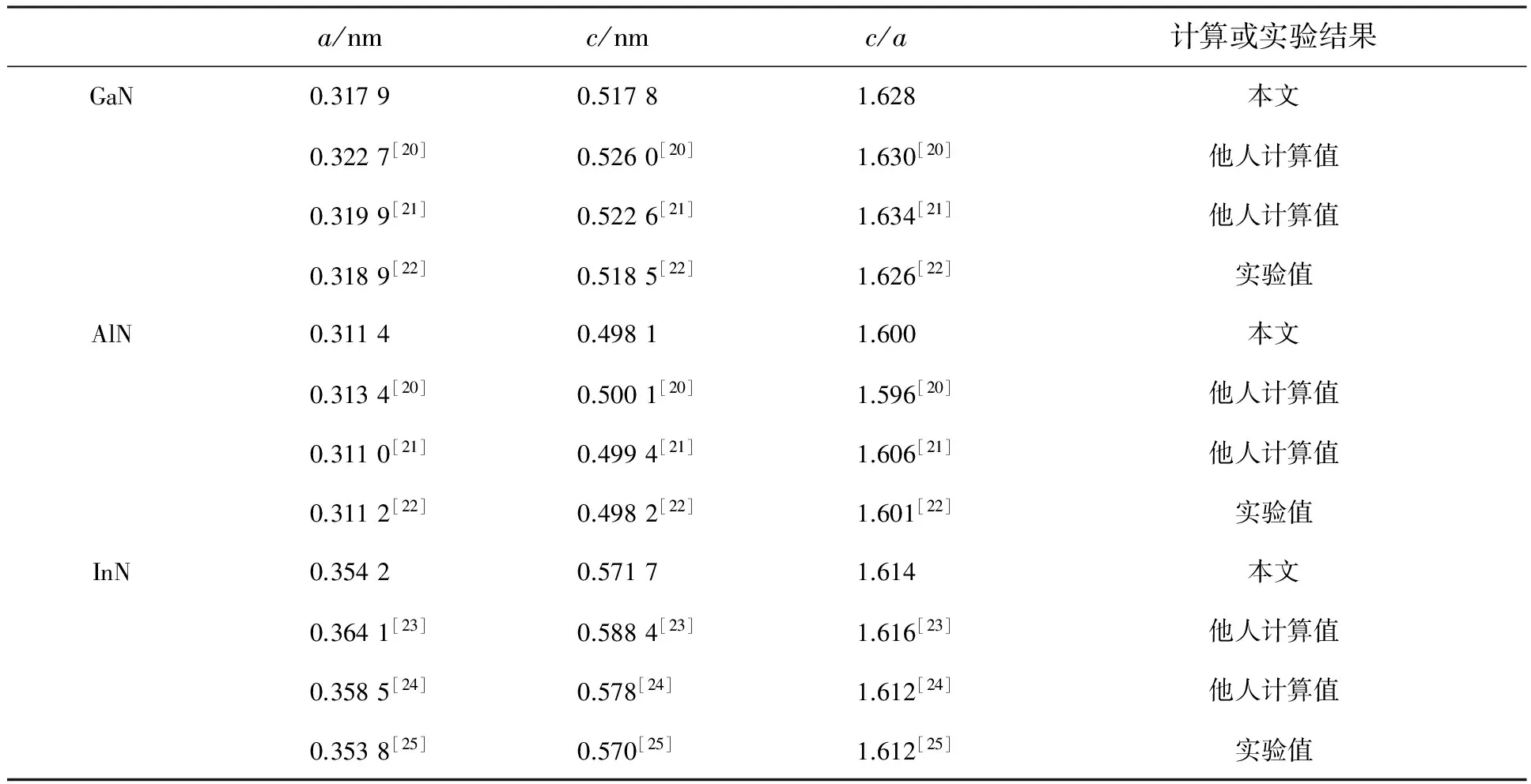
a/nmc/nmc/a计算或实验结果GaN0.31790.51781.628本文0.3227[20]0.5260[20]1.630[20]他人计算值0.3199[21]0.5226[21]1.634[21]他人计算值0.3189[22]0.5185[22]1.626[22]实验值AlN0.31140.49811.600本文0.3134[20]0.5001[20]1.596[20]他人计算值0.3110[21]0.4994[21]1.606[21]他人计算值0.3112[22]0.4982[22]1.601[22]实验值InN0.35420.57171.614本文0.3641[23]0.5884[23]1.616[23]他人计算值0.3585[24]0.578[24]1.612[24]他人计算值0.3538[25]0.570[25]1.612[25]实验值
图2是以GaN和AlN为例,分别采用GGA和LDA-1/2所计算的的能带修正对比图。如图所示,两种合金的导带底和价带顶均位于布里渊区的г点处,说明 GaN和 AlN都为直接带隙半导体材料,且光跃迁最可能出现在倒空间г点的位置,因此,合金光发射主要由来自VBM和导带底(CBM)态附近的电子空穴辐射复合产生。其中(a)、(c)图分别为GaN、AlN修正前的带隙图,(b)、(d)图分别为GaN、AlN修正后的带隙图。由图可知采用LDA-1/2方法修正后的带隙值远大于GGA方法的计算值,与实验值吻合较好。具体计算数据在表2中列出。
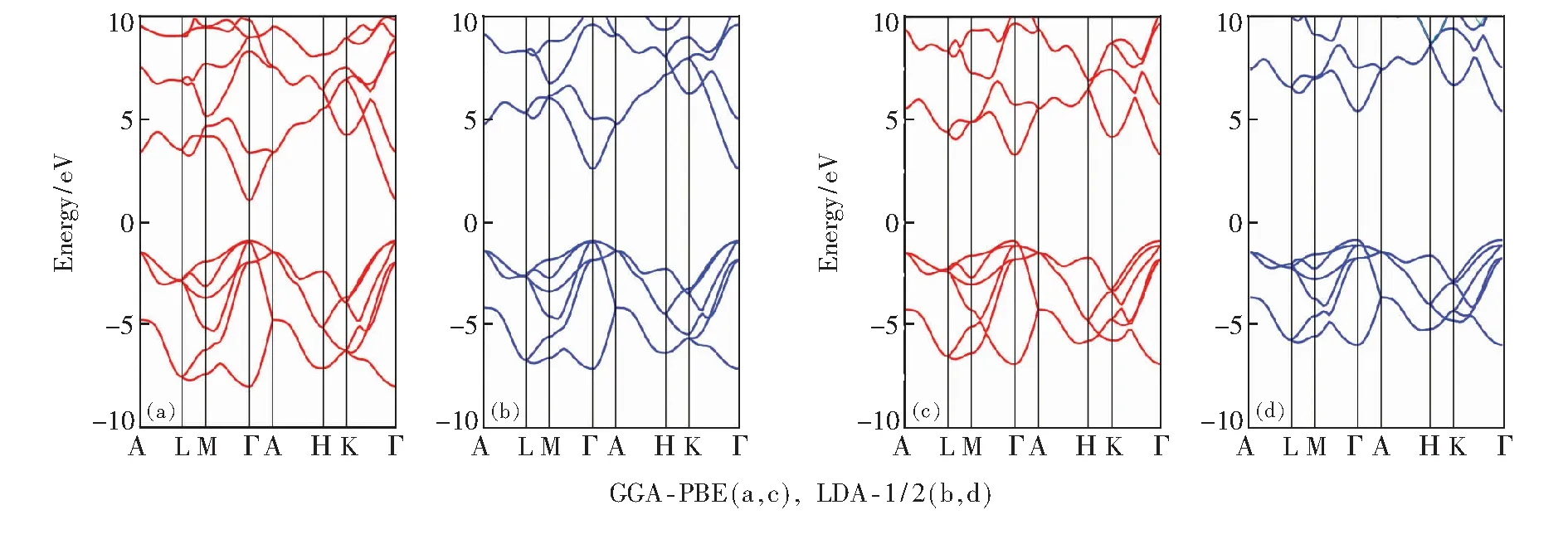
图2 GaN(a,b)和AlN(c,d)合金采用两种不同方法计算的能带结构图
表2GGA和LDA-1/2方法计算GaN,AlN和InN带隙值与其他理论计算值以及实验值的对比
Tab.2 Comparison of the band gaps by using GGA and LDA-1/2 methods with other calculations
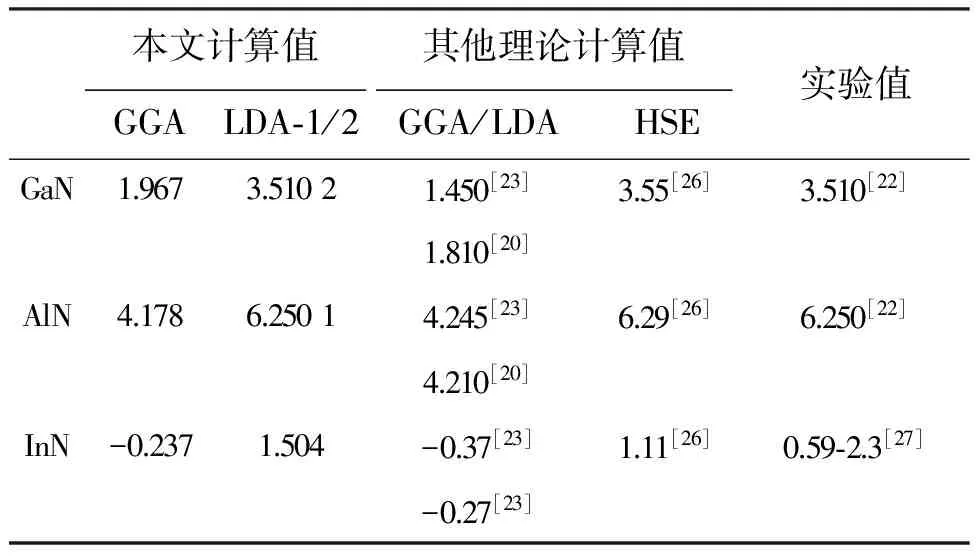
本文计算值其他理论计算值GGALDA⁃1/2GGA/LDAHSE实验值GaN1.9673.51021.450[23]3.55[26]3.510[22]1.810[20]AlN4.1786.25014.245[23]6.29[26]6.250[22]4.210[20]InN-0.2371.504-0.37[23]1.11[26]0.59⁃2.3[27]-0.27[23]
3.1 (In,Al)GaN合金中不同原子分布对电子结构的影响
众所周知,合金的光发射与晶体微观结构紧密相关[28]。几个原子的In-N团簇和短的In-N-链由于具有小的形成能而可以在实际InGaN合金中大量存在。Chichibu等[14]提出In-N-链作为电子局域中心,主导着InGaN合金的光发射。 为了进一步研究这一问题,我们在富Ga的InGaN和AlGaN两种合金中选取了4种最可能存在的构型(均匀、短链、小团簇、团簇-链共存模型)进行计算。研究何种结构能有效地影响电子的局域并提高发光效率。
表3InGaN和AlGaN合金中的4种不同构型对总能、价带、带隙、弯曲系数、体积的影响
Tab.3 Effect of the four structures on total energy, valence band width, band gap, bowing parameter and the supercell volume in InGaN and AlGaN alloys

总能/eV价带宽度/eV带隙/eV弯曲系数/eV体积/nm3InGaN均匀模型06.002.971.410.86109短链模型0.566.052.901.900.86132小团簇模型2.256.122.842.330.86261团簇⁃链共存模型2.086.072.862.1886246AlGaN均匀模型06.053.920.400.80526短链模型0.486.123.850.890.80527小团簇模型1.346.153.811.180.80520团簇⁃链共存模型1.826.133.831.030.80530
我们对(In,Al)GaN合金中4种不同构型的总能、价带、带隙、弯曲系数、体积影响进行了计算。如表3所示,4种构型的合金中均匀模型的总能最低,我们记为0 eV,其他值为相对均匀模型的总能差。结果表明,在InGaN合金中,均匀模型的总能最低,小In-N团簇的总能最高,差值为2.25 eV。可以与N空位的缺陷形成能相比拟,同时低于在InN合金中的In空位的缺陷形成能[29]。但是我们从实验上可以知道,尽管In空位具有较大的缺陷形成能,但它仍能高浓度地存在于InN合金中。在AlGaN合金中,均匀模型的总能最低,小Al-N团簇与短Al-N-链共存模型的总能最高,其差值为1.82 eV。同样,可以与N空位的缺陷形成能相比拟,同时低于在AlN合金中的Al空位的缺陷形成能[30]。由此,我们可以确信小In(Al)-N团簇与短In(Al)-N-链是可以大量存在于(In,Al)GaN合金中。
同时,从表3中还可以看到,在InGaN合金中,随着In原子的排列位置不同,其电子结构发生了明显变化。与均匀模型相比,其他3种模型价带宽度都明显变宽,其中小In-N团簇模型的价带宽度最宽。此外由于其他3种模型要比均匀模型的体积大(其中小团簇的体积最大),这样,前者的第一布里渊区体积比后者小,从而导致能带相对后者下移;导带底由于电子有效质量比价带顶的小,下移更明显,最终导致其他3种模型与均匀模型相比具有更小的带隙,其中In-N团簇模型的带隙最小,与均匀模型的带隙差为0.12 eV。由于In原子的排列位置不同,弯曲系数也在1.41~2.33 eV范围内发生相应的变化。这表明,In原子的分布方式明显影响InGaN合金的价带、带隙以及弯曲系数。在AlGaN合金中,随着Al原子的排列位置不同,其电子结构同样发生了变化。与均匀模型相比,其他3种模型价带宽度也都明显变宽,但其中小Al-N团簇与短Al-N-链共存模型的价带宽度最宽。而且,由于其他3种模型相对均匀模型有价带顶上移,同时,导带底下移的特点,导致前者具有较小的带隙, 其中Al-N团簇模型的带隙最小,与均匀模型的带隙差为0.11 eV。由于Al原子的排列位置不同,弯曲系数也在0.40~1.18 eV范围内发生相应的变化。同样可以说明,Al原子的分布方式明显影响AlGaN合金的价带、带隙以及弯曲系数。
3.2 (In,Al)GaN合金的电子局域
为了探究电子局域情况,我们进一步研究了InGaN和AlGaN合金的4种不同构型中各类原子的分波态密度,其中1代表掺杂的In或Al原子,2代表Ga原子,3代表短链中与In或Al成键的N原子,4代表不与In或Al成键的N原子,5代表小团簇中与In或Al原子成键的N原子(参见图1)。如图3所示,我们选取了在价带顶(VBM)和导带底(CBM)态附近对PDOS贡献较大的N的2p态、Ga的4s和4p态、In的5s和5p态、Al的3s和3p态,略去了在VBM(CBM)态附近对PDOS贡献较小的In的4d态、Ga的3d态、N的2s态。由于VBM态对于半导体发光具有重要的影响,所以我们主要研究VBM态。InGaN合金的分波态密度结果如图3(a,b,c,d)所示。图3(a)表示InGaN合金的均匀模型中电子均不局域;图3(b)显示短In-N-链模型中电子微弱地局域在短In-N-链结构上;图3(c)显示小In-N团簇结构上N原子的2p态在VBM态DOS图有一个峰值,则说明小In-N团簇模型中VBM态的电子主要来自于小In-N团簇结构上N原子的2p态;图3(d)显示,在小In-N团簇与短In-N-链共存模型中小In-N团簇结构上N原子的2p态在VBM态的电子局域能力比短In-N-链结构上N原子的2p态在VBM态的电子局域能力强。AlGaN合金的分波态密度结果如图3(e,f,g,h)所示。图3(e)显示,AlGaN合金中的均匀模型与InGaN合金的均匀模型相同,电子并不局域;图3(f)显示,在短Al-N-链模型中VBM态的电子主要来自于短Al-N-链结构外与Ga原子成键的N原子的2p态,说明短Al-N-链模型中VBM态电子局域在短Al-N-链以外的结构上;图3(g)显示,在小Al-N团簇模型中VBM态电子主要局域在小Al-N团簇以外的结构上;图3(h)显示,在小Al-N团簇与短Al-N-链共存模型中,VBM态电子主要局域在小Al-N团簇和短Al-N链以外的结构上。上述说明In、Al原子的分布影响InGaN、AlGaN合金的电子局域,但两种合金的电子局域情况不同,InGaN合金电子主要局域在小In-N团簇和短In-N-链结构上,且小In-N团簇结构在VBM态的电子局域能力比短In-N-链结构在VBM态的电子局域能力强,而AlGaN合金电子主要局域在小Al-N团簇和短Al-N-链以外的结构上。这表明,InGaN合金能量的最高价态倾向于局域在小In-N团簇周围,这些小In-N团簇可以作为辐射复合中心从而主导发光。而AlGaN合金是显著的均匀合金,晶体的微观结构对光发射的影响并不显著。

图3 InGaN和AlGaN两种合金中的4种构型的分波态密度图
为了更清晰地阐述电子局域能力,我们进一步绘制了两种合金不同构型的电荷局域密度图。以小In-N团簇与短In-N-链共存模型为例,如图4所示。图4(a)显示,在InGaN合金的小In-N团簇-短In-N-链共存模型中,VBM态的电子主要局域在小In-N团簇结构上,少量电子局域在短In-N-链结构上,说明小In-N团簇与短In-N-链相比,前者局域VBM态的能力明显强于后者。图4(b)显示,在InGaN合金的小In-N团簇-短In-N-链共存模型中CBM态则表现出退局域的类Bloch特性。图4(c)显示,在AlGaN合金的小Al-N团簇-短Al-N-链共存模型中,VBM态的电子主要局域在小Al-N团簇和短Al-N-链以外结构上,说明Al原子的分布基本不影响电子局域。图4(d)显示,在AlGaN合金的小Al-N团簇-短Al-N-链共存模型中,CBM态同样也表现出退局域的类Bloch特性。因此,对于InGaN合金而言,VBM态的电子高度局域在几个原子的In-N团簇周围。另外,由于导带电子有效质量以及In-N团簇尺寸均较小,CBM态很难有电子局域。但对于AlGaN合金,无论VBM态还是CBM态,电子局域状态对于结构的变化均不敏感。
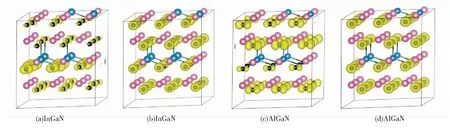
图4 InGaN (a,b)和AlGaN (c,d)两种合金的团簇-短链共存模型的VBM(a,c)态和CBM(b,d)态电荷局域密度图
Fig.4 Charge localization density of VBM(a, c) and CBM (b, d) states in InGaN(a,b)and AlGaN(c,d) alloys with a small cluster and a chain
4 结 论
本文采用基于第一性原理的密度泛函理论下的VASP软件包对(In,Al)GaN合金的4种具有代表性的构型(均匀、短链、小团簇、团簇-链结合模型)的电子结构和发光微观机理作了详细的研究。结果表明,短In(Al)-N链和小In(Al)-N团簇由于小的形成能可以大量存在富Ga的In(Al)GaN合金中。在合金中,In(Al)原子的分布明显影响合金的价带宽度、带隙值以及带隙弯曲系数。而且In原子的分布对于VBM态的电子局域能力影响很大,几个原子的In-N团簇与In-N-短链相比,前者对局域VBM能力的影响明显强于后者,强烈影响合金的发光,可以作为辐射复合中心,并高度局域激子。
参考文献:
[1] AMBACHER O. Growth and applications of Group Ⅲ-nitrides [J].J.Phys. D:Appl.Phys., 1998, 31(20):2653-2710.
[2] JAIN S C, WILLANDER M, NARAYAN J,etal.. Ⅲ-nitrides: growth, characterization, and properties [J].J.Appl.Phys., 2000, 87(3):965-1006.
[3] SIMON J, CAO Y, JENA D. Short-period AlN/GaN p-type superlattices: hole transport use in p-n junctions [J].Phys.Stat.Sol., 2010, 7(10):2386-2389.

[5] DENBAARS S P, FEEZELL D, KELCHNER K,etal.. Development of gallium-nitride-based light-emitting diodes (LEDs) and laser diodes for energy-efficient lighting and displays [J].ActaMater., 2013, 61(3):945-951.
[6] HURNI C A, DAVID A, CICH M J,etal.. Bulk GaN flip-chip violet light-emitting diodes with optimized efficiency for high-power operation [J].Appl.Phys.Lett., 2015, 106(3):031101.
[7] AKASAKI I, AMANO H. Breakthroughs in improving crystal quality of GaN and invention of the p-n junction blue-light-emitting diode [J].Jpn.J.Appl.Phys., 2006, 45(12R):9001.
[8] CHICHIBU S F, UEDONO A, ONUMA T,etal.. Origin of defect-insensitive emission probability in In-containing (Al,In,Ga)N alloy semiconductors [J].Nat.Mater., 2006, 5(10):810-1-6.
[9] KANETA A, FUNATO M, KAWAKAMI Y. Nanoscopic recombination processes in InGaN/GaN quantum wells emitting violet, blue, and green spectra [J].Phys.Rev. B, 2008, 78(12):125317.
[10] ZHANG J P, WU S, RAI S,etal.. AlGaN multiple-quantum-well-based, deep ultraviolet light-emitting diodes with significantly reduced long-wave emission [J].Appl.Phys.Lett., 2003, 83(17):3456-3458.
[11] COLLINS C J, SAMPATH A V, GARRETT G A,etal.. Enhanced room-temperature luminescence efficiency through carrier localization in AlxGa1-xN alloy [J].Appl.Phys.Lett., 2005, 86(3):031916.
[12] 朱有章, 陈光德, 谢伦军, 等. MOCVD 生长的InGaN合金的发光特 [J]. 发光学报, 2005, 26(5):602-606.
ZHU Y Z , CHEN G D , XIE L J,etal.. Optical properties of InGaN film grown by MOCVD [J].Chin.J.Lumin., 2005, 26(5):602-606. (in Chinese)
[13] 李忠辉, 杨志坚, 于彤军, 等. MOCVD 生长 InGaN/GaN MQW 紫光 LED [J]. 发光学报, 2003, 24(1):107-109.
LI Z H, YANG Z J, YU T J,etal.. InGaN /GaN violet-LED grown by LP-MOCVD [J].Chin.J.Lumin., 2003, 24(1):107-109. (in Chinese)
[14] CHICHIBU S, WADA K, NAKAMURA S. Spatially resolved cathodoluminescence spectra of InGaN quantum wells [J].Appl.Phys.Lett., 1997, 71(26):2346-2348.
[15] HUMPHREYS C J. Does In form In-rich clusters in InGaN quantum wells? [J].Philos.Mag., 2007, 87(13):1971-1982.
[16] KENT P R C, ZUNGER A. Carrier localization and the origin of luminescence in cubic InGaN alloys [J].Appl.Phys.Lett., 2001, 79(13):1977-1979.
[17] KRESSE G, JOUBERT D. From ultrasoft pseudopotentials to the projector augmented-wave method [J].Phys.Rev. B, 1999, 59(3):1758.
[18] PERDEW J P, BURKE K, ERNZERHOF M. Generalized gradient approximation made simple [J].Phys.Rev.Lett., 1996, 77(18):3865-3868.
[19] MONKHORST H J, PACK J D. Special points for Brillouin-zone integrations [J].Phy.Rev. B, 1976, 13(12):5188-5192.
[20] CUI X Y, DELLEY B, STAMPFL C. Band gap engineering of wurtzite and zinc-blende GaN/AlN superlattices from first principles [J].J.Appl.Phys., 2010, 108(10):103701.
[21] ZORODDU A, BERNARDINI F, RUGGERONE P,etal.. First-principles prediction of structure, energetics, formation enthalpy, elastic constants, polarization, and piezoelectric constants of AlN, GaN, and InN: comparison of local and gradient-corrected density-functional theory [J].Phys.Rev. B, 2001, 64(4):045208.
[22] KIM K, LAMBRECHT W R L, SEGALL B. Elastic constants and related properties of tetrahedrally bonded BN, AlN, GaN, and InN [J].Phys.Rev. B, 1996, 53(24):16310.
[23] STAMPFL C, VAN DE WALLE C G. Density-functional calculations for Ⅲ-Ⅴ nitrides using the local-density approximation and the generalized gradient approximation [J].Phys.Rev. B, 1999, 59(8):5521.
[24] LITIMEIN F, BOUHAFS B, NOUET G,etal.. Meta-GGA calculation of the electronic structure of group Ⅲ-Ⅴ nitrides [J].Phys.Stat.Sol.(b), 2006, 243(7):1577-1582.
[25] PASZKOWICZ W, ADAMCZYK J, KRUKOWSKI S,etal.. Lattice parameters, density and thermal expansion of InN microcrystals grown by the reaction of nitrogen plasma with liquid indium [J].Philos.Mag. A, 1999, 79(5):1145-1154.
[26] MOSES P G, MIAO M, YAN Q,etal.. Hybrid functional investigations of band gaps and band alignments for AlN, GaN, InN, and InGaN [J].J.Chem.Phys., 2011, 134(8):084703.
[27] BUTCHER K S A, TANSLEY T L. InN, latest development and a review of the band-gap controversy [J].Superlatt.Microstruct., 2005, 38(1):1-37.
[28] OLIVER R A, BENNETT S E, ZHU T,etal.. Microstructural origins of localization in InGaN quantum wells [J].J.Phys. D:Appl.Phys., 2010, 43(35):354003.
[29] VAN DE WALLE C G, LYONS J L, JANOTTI A. Controlling the conductivity of InN [J].Phys.Stat.Sol.(a), 2010, 207(5):1024-1036.
[30] LAAKSONEN K, GANCHENKOVA M G, NIEMINEN R M. Vacancies in wurtzite GaN and AlN [J].J.Phys:Cond.Matt., 2008, 21(1):015803.

张玲玲(1992-),女,内蒙古赤峰人,硕士研究生,2016年于集宁师范学院获得学士学位,主要从事氮化物半导体材料的电学及光学性质的研究。

E-mail: 932341576@qq.com张敏(1973-),女,山西忻州人,博士,教授,2010年于内蒙古大学获得博士学位,主要从事低维半导体材料的电学、磁学及光学性质的第一性原理的研究。
E-mail: smile_zm@126.com
