渐变层线性掺杂的InGaAs/InP场助阴极的能带结构设计与仿真
2017-05-16蔡志鹏何军锋姚军财黄文登
蔡志鹏, 何军锋, 姚军财, 黄文登
(陕西理工大学 物理与电信工程学院, 陕西 汉中 723000)
渐变层线性掺杂的InGaAs/InP场助阴极的能带结构设计与仿真
蔡志鹏, 何军锋, 姚军财, 黄文登
(陕西理工大学 物理与电信工程学院, 陕西 汉中 723000)
为了进一步提高阴极材料的量子效率,设计了一种新的InGaAs/InP转移电子(Transferred Eletron,TE)光电阴极结构,且在不同掺杂浓度、渐变层宽度、外加电压等条件下,利用Matlab仿真工具对能带曲线进行了模拟。实验结果表明:发射层与吸收层的掺杂比例应不高于50;能带曲线得到了更为严格的优化参数范围,可以使表面发射几率进一步提高;且由于计算中考虑掺杂浓度、费米能级移动对能带结构变化的影响,并对描述渐变区能带的双曲函数进行改进,使得计算结果比以往的计算更为准确。结果表明此种结构可以极大地提高阴极的量子效率,对进一步改进阴极参数和制备出更高灵敏度的TE阴极具有实际的指导意义。
InGaAs/InP结构; TE光电阴极; 渐变函数; 线性掺杂
负电子亲和势(Negative Electron Affinity,NEA)GaAs光电阴极的波长阈值在0.9 μm附近[1-7],限制了它在光通讯、激光探测器等更长波段的应用。以InGaAs/InP为代表的转移电子(Transferred Electron,TE)光电阴极突破了响应波段的限制,将光电阴极的工作波长延伸到1.7 μm附近,大大扩展了半导体光电阴极的应用领域,在0.9~1.7 μm响应波段有着不可替代的作用[7-10]。由于InGaAs/InP工作在外偏压下,所以会导致较大的暗电流,且暗电流随外偏压增大而迅速增大,从而降低了阴极的响应性能[9-11],那么,如何降低工作偏压,成为降低阴极暗电流的一项重要研究内容。InGaAs/InP异质结光电阴极具有InGaAs吸收层和InP发射层分离的结构特点,InP与InGaAs界面存在能带突变,InP的导带顶高于InGaAs材料0.22 eV,因此吸收层和发射层之间需要设计一个合适的渐变层,才能在外偏压作用下有效消除阻碍电子输运的“电子势垒”,即上述导带的能带突变。而该渐变层的设计优劣,直接影响外加偏压的大小,进而影响阴极的光电响应性能。本文基于InGaAs/InP光电阴极的能带结构特点,对阴极的结构参数,尤其是渐变层的设计结构进行改进和优化,从而在较低电压下获得了良好的电子输运性能,为优化型TE光电阴极的设计提供了必要的理论和数据支持。
1 能带的设计与计算
InGaAs/InP TE光电阴极的长波响应主要由渐变层与发射层的传输效率决定,而要达到高的传输效率[9-10,12-14],除了异质结界面具有良好的晶格匹配以外,还应当满足两个条件:(1)在工作电压下,能够有效地“拉平”发射层与吸收层间的电子势垒,以利于光生电子的渡越;(2)异质结是一个缓变结,这样才能利于电子势垒的“拉平”。因此,TE光电阴极的一个关键问题,即电子势垒的消除问题,能带渐变区势垒能否消除,直接影响到光电子的传输效率。另外,红外TE光电阴极的量子效率主要取决于发射层表面电子的逸出几率,而表面逸出几率的大小主要由发射层的掺杂浓度决定,掺杂浓度越大,逸出几率越大,相应地,量子效率也相应增大。
要提高阴极的量子效率,就需要提高表面逸出几率和增大吸收区宽度,表面逸出几率的提高,就需要增大发射区的掺杂浓度;增大吸收区宽度,可以获得更多的光生电子。因此,要想进一步增大阴极的量子效率,就需要提高表面发射层的掺杂浓度;同时,为了增大耗尽区的宽度,应使吸收层的掺杂浓度降低,以便使更多的光生电子渡越到发射层表面。为了提高量子效率,综合上述两个方面,提出用发射层掺杂浓度不低于吸收层的设计方案,并对该模型进行严格推导。另外,蒙特卡罗计算[10]表明,这种设计能够进一步提高材料的量子效率。
如图1所示,以半导体体内费米能级为势能零点,以发射层InP表面为x轴零点,方向指向半导体内。其结构分为InP发射区I、InGaAsP渐变区Ⅱ和InGaAs吸收区III三个部分,I、III区域均匀掺杂,Ⅱ区域渐变掺杂。设InP发射区宽度为l1,InGaAsP渐变区宽度l2,令l12=l1+l2,其中EF是费米能级,ψms是Ag膜与InP表面的功函数差,E0是真空能级,V为外加偏压。

(a) 无偏压 (b) 有偏压
需要注意的是,当耗尽区宽度w
为了使计算更为严格,对以往的计算[9-10,12-14]作如下改进:
(1)考虑因掺杂浓度带来的能带变化;
(2)为尽可能地减小边界处能带突变带来的电子势垒,假定渐变区掺杂浓度呈线性变化;
(3)将渐变区描述禁带宽度变化的双曲函数加以改进,使之符合实际情况。
一般地,渐变层的禁带宽度Eg(x)用简单的双曲函数[13,15]描述,为了计算更加严密,将双曲函数修改为如下形式:
(1)
其中,发射层InP的禁带宽度为Eg1,吸收层InGaAs的禁带宽度为Eg3,二者的禁带宽度差ΔEg=Eg1-Eg3。如此一来,就将渐变区边界与吸收区、发射区边界连接起来,能带边缘接触部分的误差小于0.1%,这比文献[13,15]的误差更小,从而使得计算结果更为精确。
如文献[9,12]所示,根据泊松方程,当计入由掺杂浓度带来的能带变化时,在外加电压下,得到各区域导带底相对体内费米能级的能带分布,通过Matlab作图工具仿真,得到如下参量函数:
1)InP发射Ⅰ区的能带:0≤x≤l1,
(2)
2)InGaAsP渐变Ⅱ区的能带:l1
(3)
3)对InGaAs吸收Ⅲ区的能带:l12
(4)
4)对于耗尽区的能带,即x>w时,
(5)
式中:
在外加偏压下,耗尽区宽度为
其中:
式中ψms=0.78 eV[15],kB为玻尔兹曼常数,T=300 K。
室温下,由于掺杂浓度分别在1015~1017cm-3数量级,因此,近似认为杂质全部电离。以上各式中ε1、ε2、ε3分别为InP发射区、InGaAsP渐变区、InGaAs吸收区的相对介电常数,N1、N2(x)、N3分别对应为上述三区的掺杂浓度,Nv1、Nv2、Nv3分别为上述三区价带有效态密度。
特别地,为计算方便,假定渐变区介电常数ε2、价带有效态密度Nv2为不变。由于渐变区的介电常数和价带有效态密度分别在吸收区和渐变区之间变化,且差别不大,因此,计算时取近似平均值,令ε2=13、Nv2=9×1018cm-3。并将参数ε1=12.35、ε3=13.9、Nv1=1.1×1019cm-3、Nv3=7.7×1018cm-3,Eg1=1.35 eV、Eg3=0.75 eV[9-10]以及设定的l1、l2分别代入(1)—(5)即可得到掺杂浓度、外偏压V、耗尽区宽度w、l1、l2以及导带相对体内费米能级之间的关系。
2 计算结果及分析
前人研究[9-10,12-14]表明,发射层宽度越小,外加电压相应地减小,由于暗电流随外加电压的增大而迅速增大,所以为减小暗电流,发射层的厚度设计应越小越好。由于掺杂浓度越大,电场的梯度越大,适当高掺杂下,能够有利于消除势垒,为了有利于消除发射层与渐变层之间的势垒,发射层相对于吸收层有高的掺杂浓度是合适的。另外,红外材料的吸收长度较大,为了获得更多的光生电子以提高阴极的灵敏度,应尽可能地增大耗尽层的宽度,因此,吸收层应尽可能地低掺杂。
根据计算很容易知道,只要渐变区能带被“拉平”,发射区也一定被“拉平”,因此,本文的计算中,只对渐变区和吸收区能带的变化进行讨论,不考虑发射区的影响。由上述分析及前人的研究结果,为了尽可能地提高表面逸出几率和便于讨论,计算时基于以下原则展开:
1)发射层掺杂浓度的设计不小于吸收层;
2)假定发射区宽度l1为零。
由公式(1)—(5),即可得到半导体体内能带结构分布Ec随外加电压的关系曲线。如图2和图3,给出不同偏压下,不同掺杂浓度下渐变区能带和吸收区能带的结构变化示意图。
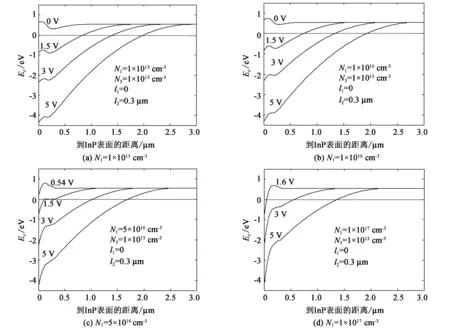
图2 发射层掺杂浓度N1变化时,不同偏压下的半导体能带分布
由图2仿真结果表明,N1=1×1015cm-3时,l2只有达到约0.3 μm,电子势垒才能被有效地消除。由图2(a)、(b)、(c)可以看出,随着发射层浓度的增加,消除势垒的临界电压有缓慢减小的趋势,且N1/N3越大,该趋势越加明显。但是,当N1/N3=50时,在渐变区靠近吸收区边界处,有一阻碍电子的微小“凸起”,模拟曲线表明,N1/N3越大,该微小势垒将越难以消除。而且,其它掺杂浓度条件下的计算也发现了这种情况。因此,N1/N3不能太大,以小于50为宜。
特别地,由于只讨论w≥l12时的情况,因此图3(d)中电压为2.1 V时,才满足w=l12,图3中也有类似的情况,余不赘述。
由图3可以知道,在相同的临界电压下,当吸收层浓度适当增加时,渐变层厚度大大减小。当吸收层浓度不变时,渐变层随N1/N3变化与图2而有类似的变化趋势。而当吸收层掺杂浓度过大时,消除势垒的临界电压将增大,所以,吸收区的掺杂浓度应当综合考虑。
在吸收区浓度在2×1016~1×1017cm-3之间变化时,随着渐变区掺杂浓度的适当增加,能够消除势垒的临界电压降逐渐减小,甚至在较小的外加电压下(如图图3(b)、(c)1.5 V附近),就能消除势垒,这对暗电流的减小是十分有利的。因此,在设计TE光电阴极时,吸收层掺杂浓度应在2×1016~1×1017cm-3之间选择,而且渐变层的宽度在0.2 μm。
当吸收层浓度大于1×1017cm-3时,相同渐变层厚度下,由于掺杂浓度过大,导致能够将耗尽区达到吸收层边界的外加电压将增大,且浓度越大越明显。另外,由于掺杂浓度过大,导致耗尽层宽度大大减小,这对载流子输运也是不利的,因此,吸收层的的掺杂浓度应不超过1×1017cm-3。
同时应当注意,当N1/N3足够大时,在渐变区靠近吸收区边界处,出现阻碍电子的微小“凸起”,对该现象也进行了讨论:仿真结果表明,该微小势垒是由掺杂浓度的变化引起的。由于渐变区内掺杂浓度的非均匀变化,引起费米能级随掺杂浓度的变化而变化,从而导致了这种现象的发生。

图3 吸收层和发射层掺杂浓度同时增大时,外加偏压下的半导体能带分布
3 外延层的设计
根据计算结果及分析可知,对发射和吸收层均匀掺杂,渐变线性掺杂的红外响应TE光电阴极,吸收层的浓度在1016~1017cm-3数量级之间选择,发射层的浓度选择在~5×1016cm-3,渐变层厚度选择在~0.2 μm。为了实现在较小电压下正常工作,N1/N3应当小于50。
对红外响应的TE光电阴极,其特点是:禁带宽度越窄,光吸收系数越小,为了增加光的吸收,吸收层宽度应大些,这就要求吸收层掺杂尽可能降低,使耗尽层宽度尽可能地增大,以便更多的光生电子渡越到阴极表面,提高阴极的灵敏度。特别地,在低温工作状态时,暗电流大大降低,可以适当增加外电压,以增大耗尽层的宽度。
另外,上述计算没有考虑发射层厚度的影响,在制作材料时,生长一定厚度的发射层就可以了。一般地,在相同外加电压下,发射层掺杂浓度越大,越利于电子向L能谷跃迁,发射层厚度就可以做得越薄。但是应当注意,当表面掺杂浓度过大时,肖特基结特性向欧姆接触特性转化,因此,对表面发射层的掺杂浓度不能过大,发射层厚度的选取应当综合考虑。
4 结 论
由上述分析可知,吸收层的浓度应取在1016~1017cm-3数量级之间,而发射层适当高掺杂,较为适合的浓度为~5×1016cm-3,是利于消除电子势垒的,这时渐变层的合适厚度在~0.2 μm。计算结果得知,发射层与吸收层的掺杂比例应不高于50。模拟曲线得出了InGaAs/InP场助光电阴极更为优化的参数设计,可以使量子效率进一步提高,这对进一步改进阴极参数和制备出更高灵敏度的TE阴极具有实际的指导意义。
[1] KAEKARE S,BOULET L,CULTRERA L,et al.Ultrabright and ultrafast III-V semiconductor photocathodes[J].Physical Review Letters,2014,112(9):219-233.
[2] KAEKARE S,DIMITROV D,SCHAFF W,et al.Monte Carlo charge transport and photoemission from negative electron affinity GaAs photocathodes[J].Journal of Applied Physics,2013,113(10):104801-1-12.
[3] SCHWEDE J W,SARMIENTO T,NARASIMHAN V K,et al.Photon-enhanced thermionic emission from heterostructures with low interface recombination[J].Nature Communications,2013,4(4):67-88.
[4] DOWELLl D H,BAZAROV I,DUNHAM B,et al.Cathode R&D for future light sources[J].Nuclear Instruments & Methods in Physics Research,2010,622(3):685-697.
[5] JIAO G C,XU X B,ZHANG L D,et al.InGaAs/InP photocathode grown by solid-source MBE[J].Proceedings of SPIE,2013,8912(10):891216.
[6] SOUMMER H.光电发射材料[M].侯洵,译.北京:科学出版社,1979.
[7] 孙巧霞,徐向晏,安迎波,等. InP/InGaAs/InP红外光电阴极时间响应特性的模拟研究[J].红外与激光工程,2013,42(12):3163-3167.
[8] GREGORY P E,ESCHER J S,HYDER S B,et al.Field-assisted minority carrier electron transport across a p-InGaAs/p-InP heterojunction[J].Journal of Vacuum Science & Technology,1978,15(4):1483-1487.
[9] 李晋闽.场助红外半导体光电阴极的研究[D].西安:中国科学院西安光学精密机械研究所,1990.
[10] 李相民.半导体近红外TE光电阴极的理论研究与制作[D].西安:中国科学院西安光学精密机械研究所,1994.
[11] LI J M,GUO L H,HOU X.Theoretical calculation of dark current for a field-assisted semiconductor photocathode[J].J Phys D:Appl Phys,1989(22):1544-1548.
[12] 王存让,郭里辉,李晋闽,等.1.3 μm场助TE光阴极In1-xGaxAsyP1-y的能带计算及外延层的设计[J].光子学报,1992,21(1):73.
[13] ESCHER J S,GREGORY P E,HYDER S B,et al.Photoelectric imaging in the 0.9—1.6 micron range[J].Electron Device Letters IEEE,1981,2(5):123-125.
[14] ESCHER J S,BELL R L,GREGORY P E,et al.Field-assisted semiconductor photoemitters for the 1~2 μm range[J].IEEE Transactions on Electron Devices,1980,27(7):1244-1250.
[15] OLDHAM W G,MILNES A G.n-nSemiconductor heterojunctions[J].Solid-State Electronics,1963,6(2):121-132.
[责任编辑:魏 强]
Band structure design and simulation of linear-doping grading layer for InGaAs/InP field-asisted pothocathode
CAI Zhi-peng, HE Jun-feng, YAO Jun-cai, HUANG Wen-deng
(School of Physics and Telecommunication Engineering, Shaanxi University of Technology,Hanzhong 723000, China)
For further improving quantum efficiency of cathode material, a special InGaAs/InP field-asisted pothocathode structure is designed, which doped concentration of absorbing layer is not more than that of emmitting layer. And energy band structure of the TE photocathode is calculated at applied bias in detail, the curves of conduction-band profile are simulated at different parameters, such as doped concentration, length of grading layer and bias. The simulation results show that the ratio of doped concentration emitting layer and absorbing layer should be not more than 50; the optimized parameters ranges of the photocathode are obtained, which will make further improvement on the surface escape probability; because doped concentration, motion of Femi level to conduction-band profile are considered, what's more, hyperbolic tangent function of grading layer is revised, the calculated results are more precise. The discussion results indicate that this structure will greatly increase the quanntum efficiency, and it has practical guidance significance to improve the parameters of photocathode and fabrication of TE photocathode with higher sensitivity.
InGaAs/InP structure; TE photocathode; grading function; linear doping
2016-10-17
2016-11-19
陕西省教育厅专项科研计划项目(16JK1132);陕西理工学院科研基金资助项目(SLGQD14-07)
蔡志鹏(1980—),男,河南省叶县人,陕西理工大学讲师,博士,主要研究方向为半导体材料及光电子学。
1673-2944(2017)02-0087-06
O462
A
