氧气等离子处理对MIM结构ZrAlO薄膜电容性能的影响
2017-04-20徐文彬任高潮
徐文彬,任高潮
氧气等离子处理对MIM结构ZrAlO薄膜电容性能的影响
徐文彬1,任高潮2
(1. 集美大学 信息工程学院,福建 厦门 361021;2. 浙江大学 信息与电子工程系,浙江 杭州 310027)
探讨了氧气等离子处理法对基于ZrAlO薄膜的MIM结构电容电学性能的低温工艺优化。ZrAlO薄膜用射频磁控溅射法制得,之后在不改变真空条件的情况下进行ZrAlO薄膜的氧气等离子处理。氧空位是影响薄膜电容性能的主要因素,通过改变氧气流量和等离子功率等处理条件可以影响氧空位的分布状态。通过分析受氧空位影响的电容电学性能,最终确定的等离子处理工艺可以使薄膜漏电流降低三个数量级以上,同时非线性电压系数减小约60%。
MIM电容;氧空位;ZrAlO;等离子;溅射;漏电流
近十年来,高介质薄膜在各类电介质应用领域的研究已取得了长足进步[1-5],高薄膜的各方面性能也在不断突破。对高薄膜的工艺研究也逐步从沉积时优化向兼具沉积后处理的工艺方向拓展。在已见报道的高薄膜沉积后处理工艺中,除了传统的热处理方式,等离子处理、紫外优化处理等具有低温特征的工艺正得到越来越广泛的重视[6-12]。
本文选取ZrAlO这一典型的高介质材料,利用磁控溅射法制备得到ZrAlO薄膜后,在保证真空条件不变的情况下,进一步利用等离子处理工艺对薄膜进行沉积后优化,重点论述等离子功率和氧气流量等典型参数对ZrAlO基薄膜电容电学性能的影响。
1 实验
ZrAlO薄膜在有金属Pt覆盖的硅衬底上通过射频磁控溅射法制备得到,所用靶材为ZrO2/Al2O3摩尔比为1:1的陶瓷靶。溅射时本底真空度优于10–3Pa,并设置衬底偏压为–40 V,靶基距为100 mm,溅射功率保持800 W,溅射过程中在腔体内加入3.0 mL/min氩气流和2.0 mL/min氧气流的气体组合,所有的ZrAlO薄膜溅射时间均为90 min。
在ZrAlO薄膜溅射完成之后,关闭氩气流并保持真空条件不变,继续对薄膜进行氧气等离子处理。等离子工艺的主要参数是氧气等离子功率(Oxygen Plasma Power:OPP)和氧气流量(Oxygen Plasma Treatment:OPF),根据现有的实验条件,等离子功率不能超过150 W,共设计了如下六组处理条件(含对应简写):[OPP:50 W,OPF:1.0 mL/min](P5F1),[OPP:100 W,OPF:1.0 mL/min](P10F1),[OPP:150 W,OPF:1.0 mL/min](P15F1),[OPP:50 W,OPF:2.0 mL/min](P5F2),[OPP:100 W,OPF:2.0 mL/min](P10F2),[OPP:150 W,OPF:2.0 mL/min](P15F2)。
在完成ZrAlO薄膜制备后,继续以金属Pt做电极制备面积小于5×10–2cm2的MIM结构电容。并在制备完成后用HP4294A和HP4145A等设备进行了电容-电压特性和漏电特性的测试。
2 结果与分析
2.1 漏电特性分析
图1给出了对应不同氧气等离子处理条件的ZrAlO薄膜电容漏电流密度同外加偏压之间的关系,每条漏电曲线都大致包含了偏压较低时的陷阱辅助区和偏压较高时的击穿区,两者的衔接点(如图中A点所示)可以认为是薄膜的击穿发生点。同没有施加等离子处理的薄膜电容相比,氧气等离子处理使得薄膜漏电流密度显著降低。
等离子功率提高是薄膜漏电流降低的因素之一,在本文实验条件下,当采用50 W功率进行等离子处理时,漏电特性已经略有改善,降低了一个数量级;当提高到100 W时,漏电流密度进一步降低了一个数量级以上,击穿点电压也有显著增大;而当功率进一步增大到150 W,低压区的漏电曲线却没有明显变化,击穿点电压则出现了反向下降。
另一个需要关注的因素是氧气流量,从图1中曲线的变化来看,在功率不变的条件下,增大氧气流量都可以进一步降低漏电流。但值得注意的是当功率提高到150 W时,氧气流量为1.0 mL/min和2.0 mL/min的两条曲线的低压漏电特性较为接近,可认为跟P10F2条件对应的曲线处于同一数量级。
已有诸多研究指出[6-12],薄膜的沉积后处理效果关键在于有效的氧离子流数量。增大等离子处理时的氧气流量可以增加薄膜中的氧离子供应,而等离子功率的增大则有助于提高氧气流的离化效率,进一步提高等离子处理的效果。因此P10F2,P15F1和P15F2三者比较接近的低压漏电特性说明氧气流已经得到了比较充分的离化,并可为ZrAlO薄膜提供接近饱和的氧离子流。另外一组漏电曲线比较接近的情况是在50 W等离子功率条件下得到,都位于10–2A/cm2的量级,说明此时的等离子离化效率较低,无法充分离化1.0~2.0 mL/min的氧气流。而当等离子功率增加到100 W后,离化效率得到有效提高,漏电流显著降低,达到了1×10–3~1×10–4A/cm2的量级,并且在流量增加到2.0 mL/min后,漏电流也进一步降低到1×10–5A/cm2的量级,击穿电压也达最高值。
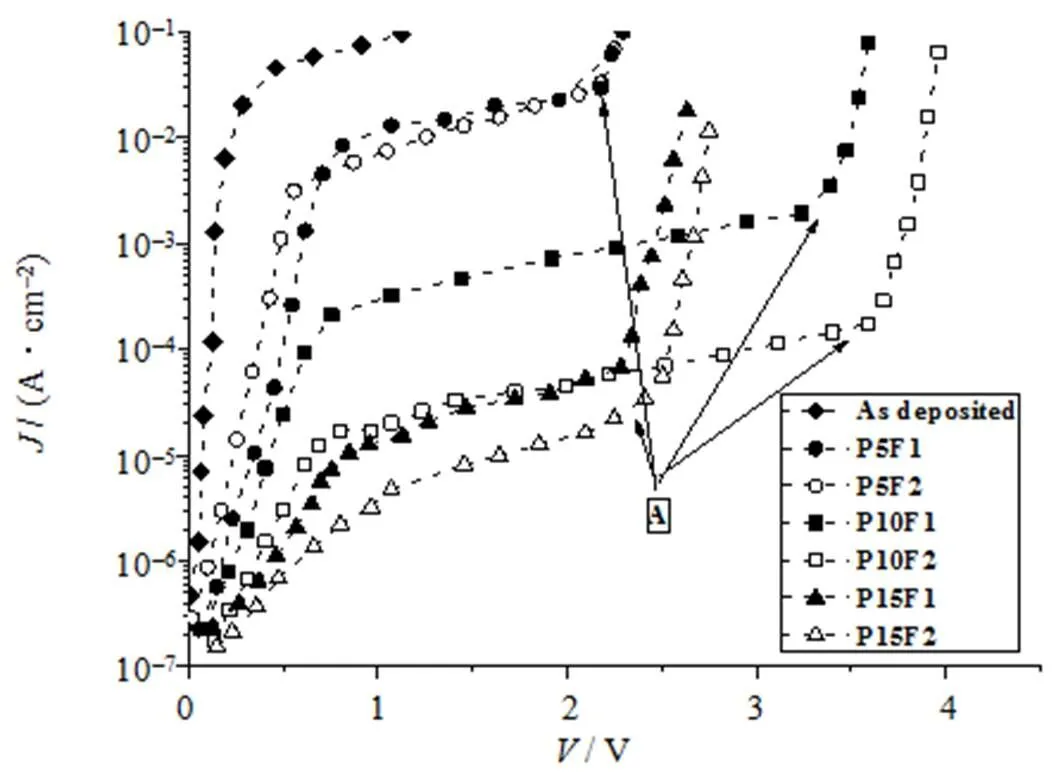
图1 ZrAlO薄膜电容中漏电流和等离子处理工艺之间的关系
等离子处理工艺的影响并非总是正面,150 W功率下相对更显著的击穿电压变化印证了这一点,击穿电压从100 W时的5.5~6.0 V降低到150 W时的3.5~4.5 V,说明更大的功率条件给ZrAlO薄膜造成了新的破坏,带来了新的膜层缺陷。这些变化通过电容-电压曲线也能体现出来。
2.2 电容-电压特性分析
图2给出了不同等离子处理条件对应的ZrAlO薄膜电容分别在100 kHz和1 MHz条件下测试得到的(归一化)电容-电压特性曲线。在外加偏压作用下,电容特性均显示出较明显的非线性特征,对这一非线性关系的经典描述是[1-5]:

式中用于描述线性部分的-关系,则用于描述非线性部分,也是介电薄膜性能中受工艺条件影响最大的一部分。在相关报道以及本文的前期研究中已经发现[1-5,13-14],薄膜制备过程中非线性效应同膜层中氧空位数量正相关。从图2结果来看,在保持氧气流量不变的条件下,随着等离子功率的增加,-曲线中的非线性效应都有比较明显的减弱。这一变化主要源于功率增加后氧气离化效率提高,有效增加了参与修复氧空位的离子数量,从而抑制了薄膜的非线性电容特性。
图2值得关注的另一方面是,高频特性(1 MHz)相较于低频特性,有更为明显的非线性特征。尤其是随着等离子功率的提高,这一频率相关的弛豫现象也相应增强。其中150 W功率条件下进行等离子处理时,1 MHz电容值比100 kHz电容值提高了40%以上。这一变化说明随着等离子处理功率的增加,ZrAlO薄膜中出现了缺陷等级的提高(缺陷尺寸、维度的增加)。虽然氧空位数量的降低抑制了电容-电压非线性效应,但新出现的高等级缺陷无法完全跟上外加交流偏压信号的频率变化,从而导致了电容在外加偏压作用下的非线性增长。因此可以认为,本实验条件下150 W的等离子处理功率容易导致ZrAlO膜层中缺陷分布程度的加剧,与此相呼应的就是漏电特性中相应功率条件下击穿电压的降低。
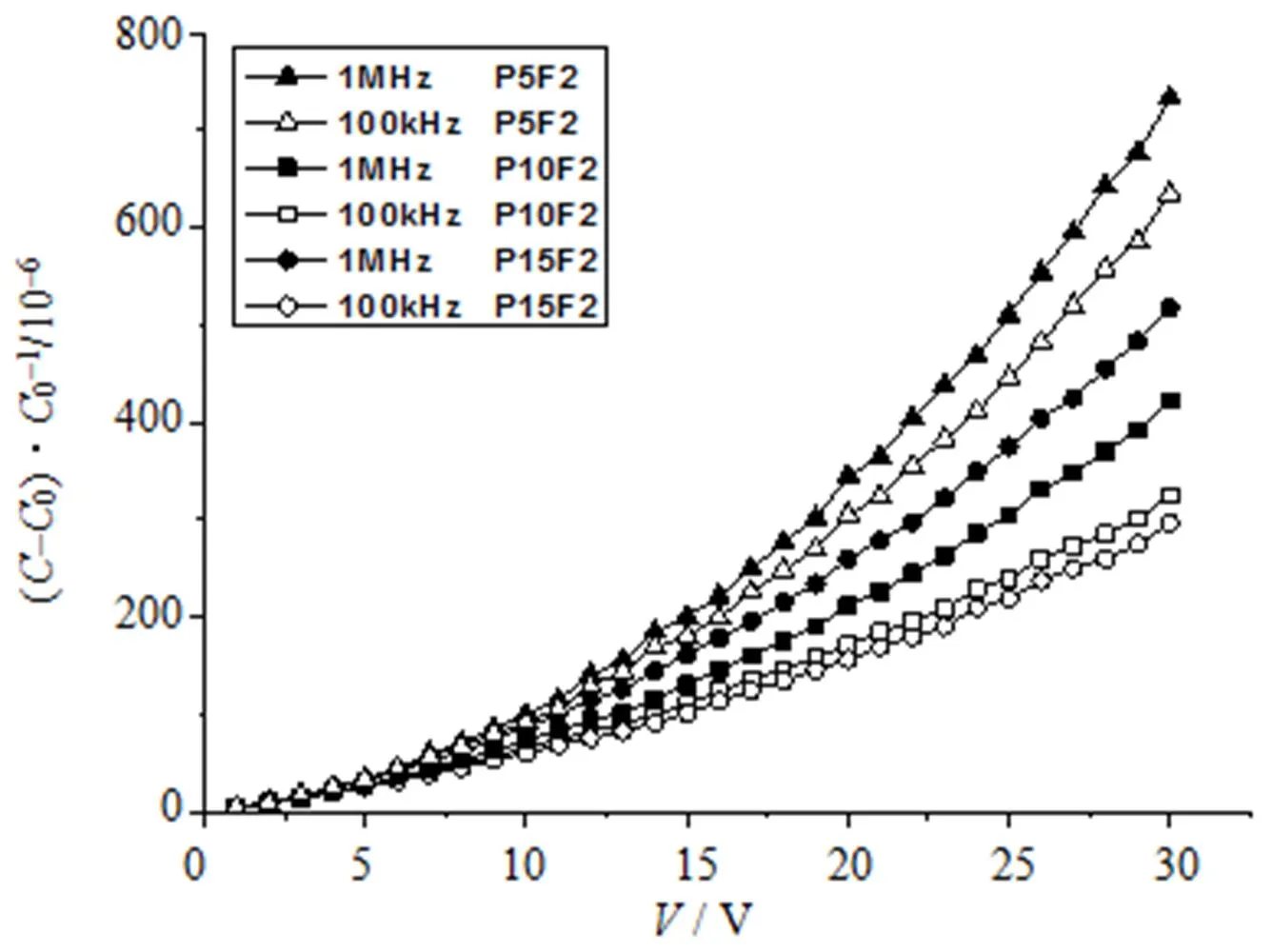
图2 不同等离子处理工艺制得到的ZrAlO薄膜电容非线性比较(测试频率:1 MHz,100 kHz)
2.3 最优化工艺确定
图1、图2的结果表明在本实验条件下,电容-电压特性和漏电特性在反映受氧空位影响的电学性能方面是相近的。为了进一步横向比较,图3将等离子处理(P10F2)后的薄膜同增加沉积时氧气流量(提高到3.0 mL/min)和沉积后氧气气氛下热处理(氧气流量2.0 mL/min,温度100 ℃,时间60 min)等情况进行了漏电特性对比。在相同的氧气流量(2.0 mL/min)下,等离子优化后的漏电流低于热处理后的情况,也低于氧气流量更高(3.0 mL/min)的未处理薄膜。这一结果表明在本实验条件下,等离子处理是最佳的薄膜性能优化工艺。在等离子体的作用下,氧分子的离化作用得到显著增强,相较于单纯的热处理工艺更能有效地修复薄膜中的氧空位缺陷。原位溅射中的等离子气氛也起到了类似的作用,使得仅增加沉积时氧气流量而未经沉积后处理的薄膜漏电流甚至还低于热处理后的薄膜。
综合漏电特性和电容-电压特性来看,本实验条件下,最合适的等离子处理条件是100 W等离子功率和2.0 mL/min氧气流的组合。100 W等离子功率可以充分离化2.0 mL/min流量的氧气流,并能够对ZrAlO膜层中的氧空位进行比较充分的修复而不会增加新的缺陷分布。并实现了二次非线性电压特性参数降低60%以上,漏电流降低约三个数量级以上。

图3 不同工艺条件下ZrAlO薄膜电容漏电特性比较
3 结论
氧气等离子处理方法显著提高了ZrAlO薄膜电容的电学性能,同增加沉积时氧气流量和沉积后热处理等工艺相比,等离子处理在优化薄膜性能方面具有更高的效率。在本实验条件下,采用100 W等离子功率和2.0 mL/min氧气流组合能得到离化较为充分的氧离子流,可以实现对ZrAlO薄膜的最优化沉积后处理,并能同时避免高功率条件下薄膜缺陷问题的加剧。最终实现了二次非线性电压特性参数降低60%以上,漏电流降低三个数量级以上,进而实现薄膜电容电学性能的有效改善。
[1] WU Y H, KAO C K, CHEN B Y, et al. High density metal-insulator-metal capacitor based on ZrO2/Al2O3/ZrO2laminate dielectric [J]. Appl Phys Lett, 2008, 93(3): 033511-1-033511-5.
[2] KIM S Y, HAM M H, OH B Y, et al. High-TiSi1-xO2thin films prepared by co-sputtering method [J]. Microelectron Engin, 2008, 85(1): 100-103.
[3] VALLEE C, GONON P, JOREL C, et al. High k for MIM and PRAM applications: impact of the metallic electrode and oxygen vacancies [J]. Microelectron Engin, 2009, 86(7/9): 1774-1776.
[4] GONON P, VALLEE C. Modeling of nonlinearities in the capacitance-voltage characteristics of high-metal-insulator-metal capacitors [J]. Appl Phys Lett, 2007, 90(14): 142906-1-4.
[5] WEINREICH W, REICHE R, LEMBERGER M, et al. Impact of interface variations onand-polarity asymmetry of MIM capacitors with amorphous and crystalline Zr1-xAlO2films [J]. Microelectron Engin, 2009, 86(7/9): 1826-1829.
[6] ALWIN S, SAHAYA S X, MENON R, et al. Surface modification of titania aerogel films by oxygen plasma treatment for enhanced dye adsorption [J]. Thin Solid Films, 2015, 595: 164-170.
[7] CHENG Y L, BO T C. Effect of RF power of post-deposition oxygen treatment on HfO2gate dielectrics [J]. Surf Coat Technol, 2014, 260: 198-204.
[8] CUONG H B, LEE B T. Effects of oxygen partial pressure on the characteristics of magnetron-sputtered ZnMgBeO thin films [J]. Appl Surf Sci, 2015, 355: 582-586.
[9] SCHEFFEL B, MODES T, METZNER C. Reactive high-rate deposition of titanium oxide coatings using electron beam evaporation, spotless arc and dual crucible [J]. Surf Coatings Technol, 2016, 287: 138-144.
[10] SINGH M, KUMAR P, SHARMA R K, et al. Plasma assisted synthesis and growth mechanism of rare V2O5nanostructured thin films [J]. J Alloys Compd, 2017, 690: 532-541.
[11] NMEZ T, FAZELI J M, KAZMANLI K, et al. Role of different plasma gases on the surface chemistry and wettability of RF plasma treated stainless steel [J]. Vacuum, 2016, 129: 63-73.
[12] TABUCHI T, TOYOSHIMA Y, TAKASHIRI M. Effect of reducing impurity concentration of microcrystalline silicon thin films for solar cells using radio frequency hollow electrode enhanced glow plasma [J]. Vacuum, 2014, 101: 125-129.
[13] 徐文彬, 任高潮. 氧空位对ZrSiO基MIM结构电容电学性能的影响 [J]. 集美大学学报(自然科学版), 2013, 18(2): 157-160.
[14] 徐文彬. 一种基于叉指电极结构的新型三维电容 [J]. 电子元件与材料, 2013, 32(1): 45-47.
(编辑:曾革)
Influence of oxygen plasma treatments on electrical properties of metal-insulator-metal (MIM) structure capacitors based on ZrAlO thin films
XU Wenbin1, REN Gaochao2
(1. College of Information Engineering, Jimei University, Xiamen 361021, Fujian Province, China; 2. Department of Information Science & Electronics Engineering, Zhejiang University, Hangzhou 310027, China)
Oxygen plasma treatments were used for the low temperature improvement of electrical properties of metal-insulator-metal (MIM) structure capacitors based on ZrAlO thin films. The ZrAlO films for these capacitors were deposited by magnetron sputtering, and then treated by oxygen plasma without changing the vacuum conditions. Oxygen vacancies are considered as the main factors affecting electrical properties. Different plasma treating conditions including oxygen flow rate and plasma power result in variation of oxygen vacancies. The optimized plasma conditions are determined based on the analyses of oxygen vacancies related electrical properties. The leakage current is finally reduced by more than three orders of magnitude, and nonlinear voltage coefficient finally decreases by more than 60%.
MIM capacitor; oxygen vacancies; ZrAlO; plasma; sputtering; leakage current
10.14106/j.cnki.1001-2028.2017.04.012
TN604
A
1001-2028(2017)04-0060-04
2016-12-22
徐文彬
福建省自然科学基金资助项目(No. 2010J05136);福建省教育厅基金资助项目(No. JA11158)
徐文彬(1980-),男,福建三明人,讲师,现主要从事薄膜电子技术领域的教学及科研,E-mail: zuyinxwb@163.com 。
网络出版时间:2017-04-11 10:49
http://kns.cnki.net/kcms/detail/51.1241.TN.20170411.1049.012.html
