1 310 nm垂直腔面发射激光器芯片制备技术的研究进展
2017-01-05刘丽杰吴远大安俊明胡雄伟
刘丽杰, 吴远大*, 王 玥, 安俊明, 胡雄伟, 王 佐
(1. 中国科学院半导体研究所 集成光电子学国家重点实验室, 北京 100083;2. 河南仕佳光子科技有限公司, 河南 鹤壁 458030)
1 310 nm垂直腔面发射激光器芯片制备技术的研究进展
刘丽杰1, 吴远大1*, 王 玥1, 安俊明1, 胡雄伟1, 王 佐2
(1. 中国科学院半导体研究所 集成光电子学国家重点实验室, 北京 100083;2. 河南仕佳光子科技有限公司, 河南 鹤壁 458030)
垂直腔面发射激光器(VCSELs)在光纤通讯领域有着广泛的应用前景,国际上对VCSELs需求逐年增加,而国内目前VCSELs的产业化尚属空白。本文从两方面着手综述1 310 nm VCSELs制备方法。将可以制备出1 310 nm VCSELs的4种材料,从理论、制备、量产时需要考虑的因素等方面进行较为全面的汇总分析;同时对两种主流的制备方法从工艺步骤分析其在产业化方面的优势与不足。
垂直腔面发射激光器; 1 310 nm; 产业化
1 引 言
因特网和“互联网+”的高速增长,极大地推动了城域网(MAN)、局域网、光互联等高速光通讯领域对带宽的需求[1-2]。垂直腔面发射激光器(VCSELs)具有圆形输出光斑、发散角小、低阈值电流、高传输速率、高功率转换效率、低电功率损耗、高工作温度、高可靠性和低成本[3]等优点,而且它与光纤耦合效率高,易于制成二维阵列,可在位检测[4-5],非常适合大规模生产,是国际上公认的光纤通讯领域最有潜力的低成本激光光源之一。
基于材料体系的发展、开发难易程度和器件成本的考量,最初局域网采用的是GaAs基的850 nm VCSELs[6],传输速率为0.1~10 Gbit/s。该器件采用同样的激光输出功率时,100 Mbit/s速率下的传输距离是7~8 km;当传输速率提高至10 Gbit/s时,其传输距离仅为50 m。光纤在该波长时衰减最小约为2 dB/km,多模光纤的衰减又大于单模光纤,衰减较多,所以850 nm VCSELs已不能满足高速局域网的通信需求。而在1 310 nm波段时,光纤衰减最小约为0.5 dB/km,在1 550 nm波段时光纤衰减最小为0.2 dB/km。可见,采用1 310~1 550 nm长波长激光器是光纤通讯领域发展的必然趋势。1 550 nm 分布反馈式激光器(DFB)[7]在长距离传输中有着很强的优势,但是,相对于量大面广的城域网或局域网应用来说,DFB激光器的成本稍高。这给1 310 nm VCSELs的研究与开发提供了很好的契机。
目前,1 310 nm长波长VCSELs芯片的制备主要存在以下技术难点[8]:
(1) 由于In1-xGaxAsyP1-y/InP材料体系中,与InP晶格匹配的不同组分间的折射率差太小,所以难以制备出长波长VCSEL所需的高质量的DBR结构。
(2) 要满足VCSELs器件的激射条件,用In1-xGaxAsyP1-y/InP制备分布布拉格反射镜(DBR)结构时,需要生长几十对甚至上百对不同组分的材料[9],这对各生长层的层厚均匀性和组分均匀性以及组分控制提出了极其苛刻的要求。
(3) 在长波长领域,p层的自由载流子的吸收相当高,导致光损较大。
(4)如何降低器件串联电阻,提高器件的热导系数实现电流的有效注入。
针对这些难点,本文将从有源区材料体系和制造方法两方面说明1 310 nm长波长VCSELs芯片的制备技术要点,并从产业化的角度分析各自的优势与不足。
2 1 310 nm VCSELs芯片的材料体系
VCSELs的结构和工作原理如图1所示。有源区材料的选取是制备激光器的关键,不同有源区材料体系会产生不同的导带、阶带结构和电子限制。目前能实现1 310 nm长波长VCSELs的有源区材料体系主要有GaAs 基的GaInNAs/GaAs、GaAsSb/GaAs和InP基的InGaAsP/InP、InAlGaAs/InP。

图1 VCSEL原理示意图
2.1 GaInNAs/GaAs材料体系
激射波长为1 310 nm的半导体激光器,其有源区材料的带隙是0.95 eV,如图2所示。GaInNAs四元材料中的“N”具有电负性大、共价半径较小的特点,会引起负的弯曲系数。因此,“N”并入GaAs或者InGaAs中会大大减小材料的带隙,使材料的激射波长延长至1 310 nm。GaInNAs的优点是:
(1)GaInNAs/GaAs QWs 的导带差ΔEc高达300~400 meV,较深的量子阱对电子有很好的限制[10]。
(2) 可以采用技术成熟的AlGaAs/GaAs 作为DBR反射镜[11]。
(3) 采用MBE生长,与InP基材料相比,其组分和均匀性控制相对容易。
(4) 可以采用AlAs 氧化技术来进行电流和光限制[12]。
(5) 可以直接与GaAs 基微电子电路及其他器件集成。
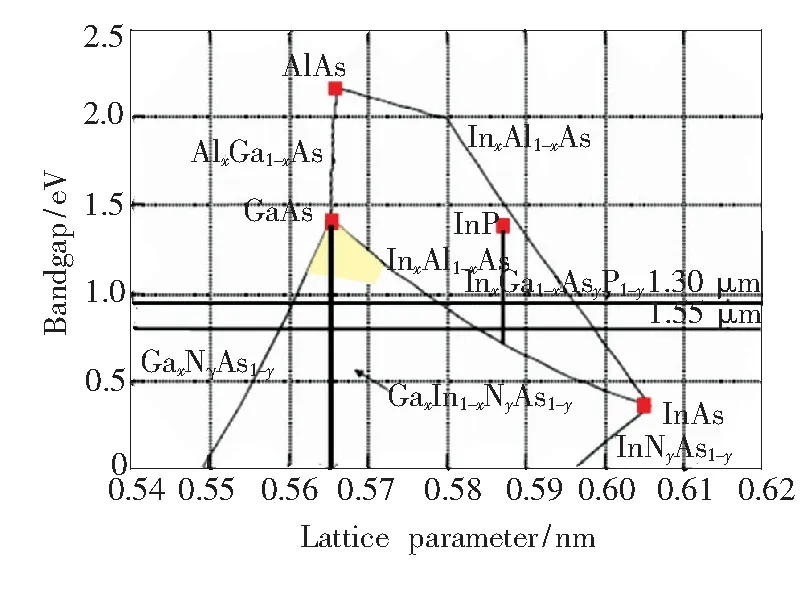
图2 Ⅲ-Ⅴ族元素合金相图
采用GaInNAs材料体系产业化的公司主要有:美国Picolight公司,发射波长为1 280 nm,10 Gbit/s传输速率下的单模传输距离为20 km[3];日本Sumitomo公司,25 ℃下的最大输出功率为4.2 mW,10 Gbit/s的传输速率,发射波长约为1 260 nm[13]。但是,GaInNAs在实际外延生长技术中仍存在以下问题[7]:
(1)完全不同的边界状态将影响外延技术选择,所以目前量产上使用MBE外延技术较多。
(2)不同组分合金在生长过程中的匹配。GaInN晶体生长需要相对较高的生长温度,而InGaAs需要相对较低的生长温度,容易形成易混的合金带隙。
2.2 GaAsSb/GaAs材料体系
另一个GaAs基材料体系是GaAsSb/GaAs。含Sb化合物覆盖的波长比较宽,可以从900 nm延展至4 500 nm。GaAsSb/GaAs系材料有以下几个特点:
(1)GaAsSb和GaAs的晶格常数不匹配, GaAsSb外延层存在压应力,在GaAs 衬底上生长的GaAsSb/GaAs是应变量子阱结构,发光波长可接近1 310 nm[14]。
(2)可以采用技术成熟的AlAs/GaAs 作为DBR 反射镜[15]。
(3)GaAs1-xSbx和GaAs 界面的能带不连续性主要降落在价带,在导带边的不连续性较少,可能形成Ⅱ类异质结界面[16]。Ⅱ类异质结有两个重要特性[17]:一是由晶格常数不同造成的应变特性,二是由能带交错排列产生的独特电学和光学特性。
日本NEC公司的VCSEL器件的激射波长为1 295 nm,阈值电流为1.2 mA,最大工作温度可达70 ℃[18]。美国Lyfek 公司用MBE生长技术制备了激射波长为1 266 nm、单模输出功率为0.3 mW(工作温度为10 ℃)、最大工作温度为70 ℃、边模抑制比(SMSR)为42 dB 的VCSEL器件[19]。GaAs1-xSbx材料在生长方面还需考虑以下几个因素:
(1)由于Ga-Sb和Ga-As间的结合能差别较大,Ⅴ族元素之间存在强烈竞争。
(2)GaAs1-xSbx外延生长质量和组分取决于生长参数。
(3)砷化物的化学键普遍强于锑化物,Sb原子在GaAs表面无法通过Ga—As断键方式置换出As原子来形成稳定的GaSb,所以GaAs1-xSbx外延生长中精确的组分控制和外延中关键工艺技术掌握至关重要,一旦控制不好则高质量的材料制备将变得非常困难。
2.3 InGaAsP/InP材料体系
InGaAsP/InP是长波长光电器件研究及生产的首选材料。InxGa1-xAsyP1-y四元材料体系的晶格常数与带隙的关系如图3[20]所示。横坐标和纵坐标是组分变化,实线是Eg值,虚线是晶格常数a。对于半导体激光器而言,最主要的是光电转化效率要高,即注入的电子空穴直接辐射复合,产生较大增益,达到激射阈值,所以制备半导体激光器的材料需选直接带隙材料。图中上部粗实线表示与GaAs晶格匹配,下部粗实线表示与InP晶格匹配。由图可以看出,对于GaAs(a=0.565 3 nm),匹配的化合物的带隙能量为l.4~1.9 eV。对于InP(a=0.586 9 nm),匹配的化合物的带隙能量为0.75~1.45 eV。对于1 310 nm VCSELs所对应的材料带隙,InGaAsP/InP有源区材料占据优势地位。美国Agilent公司采用MOCVD生长方法,制备出InGaAsP长波长VCSELs。该器件在室温持续工作时的电流密度为1.1 kA/cm2,量子效率大于30%,最大工作温度为85 ℃,单模输出功率为1.6 mW[9]。该结构材料生长过程中需要考虑的主要问题是:
(1)InxGa1-xAsyP1-y与InP衬底匹配时,x、y满足的关系式为x=0.4526/(1-0.031y)[21],在外延生长过程中通过调整,可以得到比较理想的材料组分。
(2)InP晶格匹配的不同组分InxGa1-x-AsyP1-y的折射率差太小,DBR结构材料将有几十对甚至上百对,这对各生长层的层厚均匀性和组分均匀性都提出了极其苛刻的要求,需优化DBR结构体系[22]。

图3 Eg和晶格常数a与材料组分的关系图
2.4 AlInGaAs/InP材料体系
为提高激光器在恶劣环境下的工作的可靠性,人们提出了AlInGaAs/InP材料体系。它的主要优势是:
(1)AlInGaAs在室温下带隙能量在0.75~1.45 eV范围内,基本与InGaAsP相同。它的电子有效质量为0.041~0.083,空穴的有效质量为0.47~0.87,与InGaAsP(电子有效质量0.041~0.08,空穴有效质量0.47~0.85)相似。它们的室温霍尔迁移率和折射率也基本相同。
(2)AlInGaAs的导带偏差大:ΔEc=0.72ΔEg[23],此结构有利于提高激光器量子阱有源区在高温及高注入电流密度情况下对电子的限制能力。
(3)由于价带空穴的有效质量远大于导带电子的有效质量,对AlInGaAs/InP材料系中相应的价带偏量小,价带空穴注入一致性好,光谱调制特性得以改善。
(4)AlInGaAs只有一个Ⅴ族元素,在高温处理时,不会发生Ⅴ族元素互扩散和混晶现象,更容易得到一个陡峭的异质界面[24],这也是AlInGaAs器件高温工作稳定的一个重要因素[25]。
(5)AlInGaAs/InP材料可以选用MBE或MOCVD生长技术生长。
美国康宁公司采用MOCVD方法生长了VCSELs器件,单模输出功率为1.7 mW(工作温度25 ℃),85 ℃下的单模输出功率为0.6 mW,最大工作温度大于100 ℃, 10 Gbit/s传输速率下的传输距离达10 km[26]。德国VERTILAS 公司制备了1 330 nm InGaAlAs/InP VCSEL器件,室温输出功率为3 mW,80 ℃时的输出功率为0.6 mW,TOSA光纤耦合效率大于50%,20~80 ℃温度范围内的器件阈值电流为2.7 mA,SMSR为40 dB[27-28]。由于Al和Ga原子半径相差很小,因此可以利用In源控制外延材料的应变量,交互调节Al源和Ga源流量使AlInGaAs量子阱的激射波长至所需波长。线性调节Al源和Ga源流量可以方便地得到带隙渐变的分别限制异质结限制层,这可以进一步提高激光器有源区两侧对电子的限制能力,提升器件性能。
综上所述,1 310 nm VCSELs量产虽有4种材料体系可选用,但GaInNAs/GaAs及GaAsSb/GaAs材料由于带隙和异质结量子阱类型等原因,造成GaAs材料体系在长波段不占优势。另外,从产业化商用标准来说,目前 VCSEL光纤通讯领域的标准有SONET、IEEE802.3ae、ANSI和ITU等,根据传输距离的不同,由于光纤的色散和衰减,各标准需要不同的最小波长。例如,OC-192(传输速率9.953 Gbit/s),需求的最小波长为1 290 nm。 所以GaAs基两种材料体系不是长波长器件的首选。InP基的InGaAsP/InP、InAlGaAs/InP两种材料体系虽在DBR制备时有不足之处,但器件在长波长1 310 nm甚至1 550 nm[29]波段有很大优势:一是如前所述的带隙方面的优势,二是高速特性方面的优势。增大有源区微分增益可以提高有源区弛豫振荡频率,提高器件高速特性。实验证实,量子阱结构中的填充态和限制因子对微分增益有很重要的影响,而InP基两种材料在这方面较GaAs基具有优势。在外延技术方面,GaAs基器件多数采用MBE生长技术制备,MBE生长N材料和Sb的合金具有生产速率低、产量小、设备及辅助材料成本高等劣势。而InP基器件可采用MOCVD方法制备,该方法生长过程最为灵活,可获得陡峭的材料界面,具有杂质少、点缺陷水平低、均匀性好、重复性高、生长速率快、可选择性生产和实时监控等优点。总之,InP基两种材料体系在1 310 nm VCSELs器件的产业化方面更有发展前景。
3 1 310 nm VCSELs芯片的制备方法
通常人们根据DBR结构的制备方法将1 310 nm长波长VCSELs的制备方法分成全外延生长法和键合法两大类。图4是全外延生长氧化限制型VCSELs的制备工艺流程示意图[30]。(a) 外延片的一次生长包括:在半导体衬底上依次生长出掩埋层、晶格匹配过渡层、下n-DBR层、下光学和电流限制层、有源层、上光学和电流限制层、上p-DBR层、电极层等;(b) 利用光刻和湿法腐蚀技术进行器件结构刻蚀;(c) 采用湿氧氧化工艺形成电流限制区域;(d) PECVD介质材料生长;(e)填充腐蚀沟;(f)通过光刻和刻蚀工艺制作出p面欧姆电极的窗口;(g)通过电子束蒸发和lift off技术在制作p型电极的同时形成出光孔;(h) 外延片减薄、背面溅射制备出n型电极以及电极合金。随后,进行管芯解理、芯片烧结等器件制管工艺和器件特性测试分析。
晶片键合是使两个具有平整或互补形态表面的固体在不存在任何中间层的情况下,通过化学键作用力结合成为一个整体的过程[31]。采用键合法制备VCSELs可以结合GaAs基DBR优势和InP基有源区的优势,从而制备高性能的长波长VCSELs器件[32]。例如:AlInGaAs材料具有较好的可靠性和低的温度敏感性,但是需要生长在InP衬底上。采用晶片键合技术将更多外延的两元材料GaAs-AlAs DBR堆垛到有源区,提供最优的热和光学镜面结构、性能优异的1 310 nm的VCSELs[28]。再如,键合法能将AlGaAs/GaAs材料制备的优质DBR结构和AlInGaAs-InP材料制备出的优质高增益材料巧妙地结合在一起,并将长波长VCSELs的激射波长涵盖1 250~1 650 nm范围,很适合CWDM应用需求[33]。

图4 氧化限制型VCSEL制作工艺
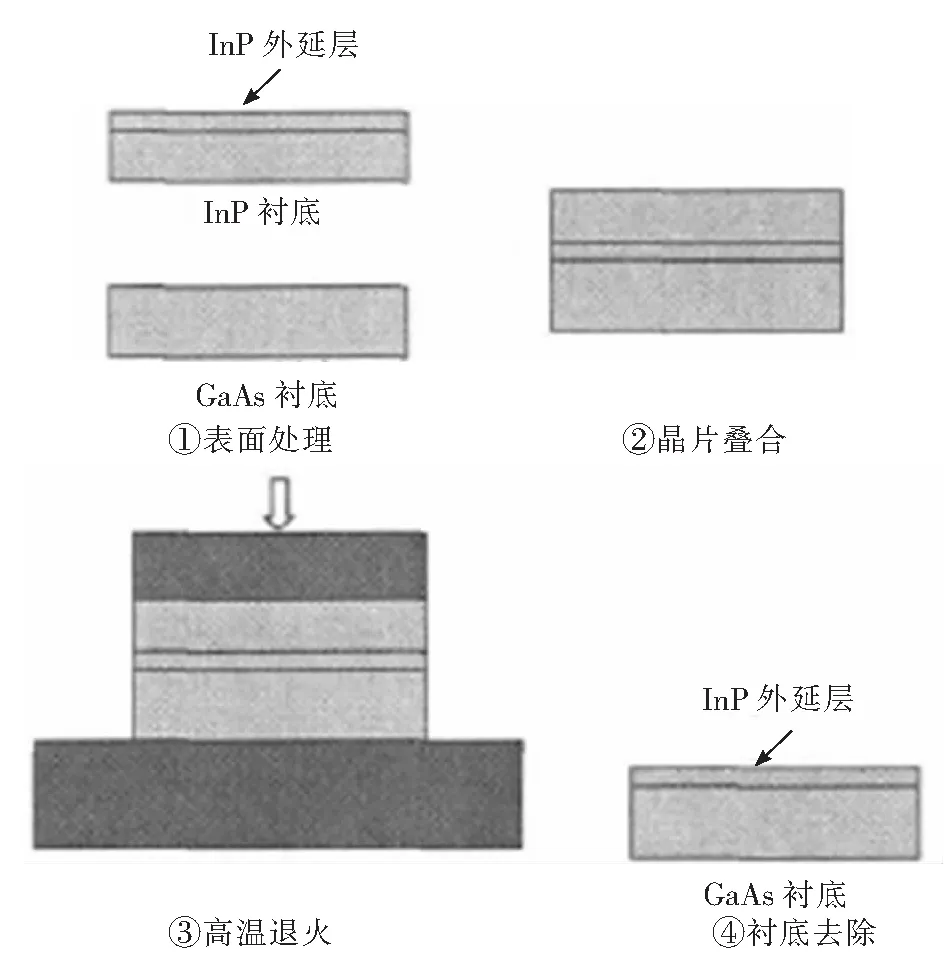
图5 晶片键合工艺示意图
键合法可以得到性能优良的VCSELs器件,但是键合工艺复杂,不容易扩展成大规模和高良率生产。晶片键合至少包含4个主要步骤[10],如图7所示,每步工艺控制不好都将会降低产品良率。国际VCSEL产业中只有为数不多的Vertilas、EPFL、Corning等公司有过键合法制备产品的报道,而大多数企业为全外延生长法。所以,全外延生长法在产业化方面更具前景。
4 结 论
依据光纤通讯领域国际有影响力的OFC会议等最新发布出来的数据分析,VCSELs在光纤通讯领域有着光明的应用前景,国际上对VCSELs的需求逐年增加,但国内的VCSELs产业尚属空白。本文从材料和技术两方面综述了1 310 nm VCSELs的制备方法。汇总分析得出,InP基尤其是AlInGaAs/InP是制备长波长1 310 nm和1 550 nm VCSELs的首选材料,同时,全外延生长法比键合法更具产业化前景。
[1] 张祥伟,宁永强,秦莉,等. 氧化光栅型垂直腔面发射激光器的研究 [J]. 发光学报, 2013, 34(11):1517-1520. ZHANG X W, NING Y Q, QIN L,etal.. Study of oxide-grating vertical-cavity surface-emitting lasers [J].Chin.J.Lumin., 2013, 34(11):1517-1520. (in Chinese)
[2] Finisar Corporation. Datacom & Telecom Network Diagrams [EB/OL]. [2015-12-07]. https://www. finisar. com/sites/default/files/resources/datacom_telecom_diagrams_handout_apr2015.pdf.
[3] JEWELL J, GRAHAM L, CROM M,etal.. 1 310 nm VCSELs in 1-10 Gb/s commercial applications [J].SPIE, 2006, 6132:613204.
[4] 王立军,宁永强,秦莉,等. 大功率半导体激光器研究进展 [J]. 发光学报, 2015, 36(1):1-19. WANG L J, NING Y Q, QIN L,etal.. Development of high power diode laser [J].Chin.J.Lumin., 2015, 36(1):1-19. (in Chinese)
[5] 贾鹏,秦莉,张星,等. 大功率VCSEL三角列阵的空间相干性 [J]. 发光学报, 2015, 36(6):673-678. JIAP, QIN L, ZHANG X,etal.. Spatial coherence of high power VCSEL triangular-array [J].Chin.J.Lumin., 2015, 36(6):673-678. (in Chinese)
[6] KOYAMA F, KINOSHITA S, IGA K. Room temperature CW operation of GaAs vertical cavity surface emitting laser [J].IEICETrans., 1988, E71(11):1089-1090.
[7] JR HARRIS J S. GaInNAs long-wavelength lasers: progress and challenges [J].Semicond.Sci.Technol., 2002, 17(8):880-891.
[8] 江剑平.半导体激光器 [M]. 北京:电子工业出版社, 2000:187-188. JIANG J P.SemiconductorLasers[M]. Beijing: Publishing House of Electronics Industry, 2000:187-188. (in Chinese)
[9] LIN C K, BOUR D P, ZHU J T,etal.. High temperature continuous-wave operation of 1.3- and 1.55-μm VCSELs with InP/air-gap DBRs [J].IEEEJ.Select.Top.Quant.Electron., 2003, 9(5):1415-1421.
[10] 佟存柱. 1.3 μm GaAs基量子阱、量子点垂直腔面发射激光器 [D]. 北京:中国科学院研究生院, 2005. TONG C Z. 1.3μmGaAsBasedQuantumWellsandQuantumDotsVerticalCavitySurfaceEmittingLasers[D]. Beijing: Graduate School of Chinese Academy of Sciences, 2005. (in Chinese)
[11] ONISHI Y, SAGA N, KOYAMA K,etal.. High power and low resistive GaInNAs-VCSELs with buried tunnel junctions [C].ProceedingsofThe21stInternationalSemiconductorLaserConference,Sorrento, 2008:53-54.
[12] KONDOW M, KITATANI T, NAKATSUKA S,etal.. GaInNAs: a novel material for long-wavelength semiconductor lasers [J].IEEEJ.Select.Top.Quant.Electron., 1997, 3(3):719-730.
[13] ONISHI Y, SAGA N, KOYAMA K,etal. Long-wavelength GaInNAs vertical-cavity surface-emitting laser with buried tunnel junction [J].IEEEJ.Select.TopicsQuant.Electron., 2009, 15(3):838-843.

[15] KLEM J F, BLUM O, KURTZ S R,etal.. GaAsSb/InGaAs type-Ⅱ quantum wells for long-wavelength lasers on GaAs substrates [J].J.Vac.Sci.Technol. B, 2000, 18(3):1605-1608.
[16] 江德生,王江波,NAVARRO C,等. GaAsSb/GaAs量子阱激光器结构的发光研究 [J]. 红外与毫米波学报, 2002, 21(S):7-10. JIANG D S, WANG J B, NAVARRO C,etal.. Luminescence properties of GaAsSb/GaAs quantum well laser structures [J].J.InfraredMilim.Waves, 2002, 21(S):7-10. (in Chinese)
[17] LUO X D, BIAN L F, XU Z Y,etal.. Study of optical properties in GaAs1-xSbx/GaAs single quantum wells [J].ActaPhys.Sinica, 2003, 52(7):1761-1765.
[18] ANAN T, YAMADA, NISHI K,etal.. Continuous-wave operation of 1.30 μm GaAsSb/GaAs VCSELs [J].Electron.Lett., 2001, 37(9):566-567.
[19] DOWD I, JOHNSON S R, FELD S A,etal.. Long wavelength GaAsP/GaAs/GaAsSb VCSELs on GaAs substrates for communications applications [J].Electron.Lett., 2003, 39(13):987-988.
[20] 张妍. InGaAsP/InP多量子阱激光器的研究 [D]. 北京:北京邮电大学, 2012. ZHANG Y.ResearchonInGaAsMultiplyQuantumWell(MQW)Lasers[D]. Beijing: Beijing University of Posts and Telecommunications, 2012. (in Chinese)
[21] ZHU Z, ZHANG X, LI P X,etal.. Voltage reduction of 808 nm GaAsP/(Al)GaInP laser diodes with GaInAsP intermediate layer [J].J.Semicond., 2015, 36(1):014011-1-3.
[22] JAYARAMAN V, MEHTA M, JACKSON A W,etal.. High-power 1 320-nm wafer-bonded VCSELs with tunnel junctions [J].IEEEPhoton.Technol.Lett., 2003, 15(11):1495-1497.
[23] IGA K. Vertical-cavity surface-emitting laser: its conception and evolution [J].Jpn.J.Appl.Phys., 2008, 47(1):1-10.
[24] ZUO Z Y, XIA W, WANG G,etal.. Wafer-bonding AlGaInP light emitting diodes with pyramidally patterned metal reflector [J].J.Semicond., 2015, 36(2):024011-1-5.
[25] 陈博. 长波长AlGaInAs/InP应变多量子阱激光器研制 [D]. 北京:中国科学院半导体研究所, 1999. CHEN B.LongWavelenghtAlGaInAs/InPStrainedLayerMulti-quantumWellLaser[D]. Beijing: Institute of Semiconductors, Chinese Academy of Sciences, 1999. (in Chinese)
[26] NISHIYAMA N, CANEAU C, HALL B,etal.. Long-wavelength vertical-cavity surface-emitting lasers on InP with lattice matched AlGaInAs-InP DBR grown by MOCVD [J].IEEEJ.Select.Top.Quant.Electron., 2005, 11(5):990-998.
[27] HOFMANN W, ORTSIEFER M, RÖNNEBERG E,etal.. 1.3 μm InGaAlAs/InP VCSEL for 10G ethernet [C].ProceedingsofThe21stInternationalSemiconductorLaserConference,Sorrento, 2008:11-12.
[28] SIRBU A, IAKOVLEV V, KELLER S T,etal.. Advanced 1.3 μm vertical cavity lasers based on AlInGaAs/InP-AlGaAs/GaAs fused structures [C].ProceedingsofThe17thInternationalConferenceonTransparentOpticalNetworks,Budapest, 2015:1-3.
[29] KE Q, TAN S Y, LIU S T,etal.. Fabrication and optimization of 1.55-μm InGaAsP/InP high-power semiconductor diode laser [J].J.Semicond., 2015, 36(9):094010-1-4.
[30] 岳爱文. 1.3 μm GaInNAs/GaAs垂直腔面发射激光器的优化设计与制作 [D]. 武汉:武汉大学, 2004. YUE A W.TheDesignOptimizationandTheFabricationofThe1.3μmGaInNAs/GaAsVerticalCavitySurfaceEmittingLaser[D]. Wuhan: Wuhan University, 2004. (in Chinese)
[31] LAO Y F, CAO C F, WU H Z,etal.. Fabrication of InAsP/InGaAsP quantum-well 1.3 μm VCSELs by direct wafer-bonding [J].J.Semicond., 2008, 29(11):2286-2291.
[32] NAKAGAWA S, HALL E, ALMUNEAU G,etal.. 1.55-μm InP-lattice-matched VCSELs with AlGaAsSb-AlAsSb DBRs [J].IEEEJ.Select.Top.Quant.Electron., 2001, 7(2):224-230.
[33] MEREUTA A, SIRBU A, CALIMAN A,etal.. Fabrication and performance of 1.3-μm 10-Gb/s CWDM wafer-fused VCSELs grown by MOVPE [J].J.Cryst.Growth, 2015, 414:210-214.

刘丽杰(1981-),女,河北秦皇岛人,博士研究生,2008年于河北工业大学获得硕士学位,主要从事垂直腔面发射激光器方面的研究。
E-mail: liulijie@semi.ac.cn

吴远大(1974-),男,湖北阳新人,研究员,博士生导师,2003年于吉林大学获得博士学位,主要从事“三网融合”、“光纤到户”核心光子器件芯片产业化技术的研究。
E-mail: wuyuanda@semi.ac.cn
Research Progress of 1 310 nm VCSELs Chip Technology
LIU Li-jie1, WU Yuan-da1*, WANG Yue1, AN Jun-ming1, HU Xiong-wei1, WANG Zuo2
(1.StateKeyLaboratoryonIntegratedOptoelectronics,InstituteofSemiconductors,ChineseAcademyofSciences,Beijing100083,China;2.HenanShijiaPhotonsTechnologyCo.,Ltd.,Hebi458030,China)
The vertical-cavity surface-emitting laser(VCSEL) is becoming a key device in the gigabit, local-area networks(LANs) and optical interconnets. Its volumn is increasing ever year in the world. However, there is no company to produce this promising device in China. In this paper, we review its material system properties and fabrication technology of 1 310 nm long-wavelength band and analyse the advantage and disadvantage from production. Lastly,we give a conclusion which method is better choice in the industrlization.
vertical cavity surface-emitting lasers; 1 310 nm; industrialization
1000-7032(2016)07-0809-07
2016-02-19;
2016-03-29
“863”国家高技术研究发展计划(2015AA016902)资助项目
TN248.4
A
10.3788/fgxb20163707.0809
*CorrespondingAuthor,E-mail:wuyuanda@semi.ac.cn
