硅通孔电镀填充铜的蠕变性能
2016-09-05宇慧平
武 伟,秦 飞,安 彤,陈 沛,宇慧平
硅通孔电镀填充铜的蠕变性能
武伟,秦飞,安彤,陈沛,宇慧平
(北京工业大学机械工程与应用电子技术学院,北京100124)
为了研究TSV-Cu的蠕变性能,首先利用典型的TSV工艺制作了电镀Cu的TSV试样,然后利用纳米压痕法对TSV-Cu进行了压痕蠕变测试.采用恒加载速率/载荷与恒载荷法相结合的方式,对TSV-Cu的蠕变行为进行了研究,测量了TSV-Cu在不同压入应变速率和最大压入深度条件下的蠕变行为.通过对保载阶段的数据进行处理,得到了不同加载条件下的蠕变速率敏感指数m.结果表明:压入应变速率和最大压入深度等加载条件对m的影响不很明显.
硅通孔;TSV-Cu;纳米压痕;蠕变速率敏感指数
硅通孔(through silicon via,TSV)技术被认为是3D集成封装的核心,TSV可以在垂直方向上实现信号导通和传热等作用,还具备低功耗、高密度等诸多优势[1-2].Cu具有高电导率、高抗电迁移能力以及低焦耳热等优点,同时具备相对成熟的电沉积工艺,因此,常被选作TSV的填充材料[3].TSV的孔径一般从几微米到几十微米,由于表面效应、组织结构及加工工艺等的影响,其内填充的Cu(TSV-Cu)材料的力学性能与体相时相比会有显著的不同[4].Liu等[5]的研究指出,由于TSV-Cu被周围的Ta/SiO2等材料所包裹,其力学行为与普通的Cu明显不同,需要对其力学参数进行测量.
目前,关于TSV-Cu的力学性能已有了一些研究.Dixit等[6]通过纳米压痕实验得到弹性模量和硬度分别为124 GPa和1.8 GPa.李君翊等[7]基于单轴微拉伸法测得其弹性模量约为块体纯Cu的23%;而抗拉强度则约为后者的2.32倍.Wu等[8]采用纳米压痕实验和有限元数值模拟反演相结合的方法,得到TSV-Cu的弹性模量与屈服强度分别为155.47 GPa和47.91 MPa.
然而,对于TSV-Cu的蠕变性能研究则鲜有报道,而Cu的蠕变性能是电子器件可靠性分析的重要参数之一[9].Heryanto等[10]指出,TSV-Cu的蠕变还是造成Cu胀出或缩进Si表面,进而导致TSV顶部金属互连结构破坏的原因之一.因此,本文重点研究并表征TSV-Cu的蠕变性能.蠕变应力指数是评价金属材料蠕变能力的主要指标[11].纳米压痕仪由于其具备极高的载荷和位移分辨率,同时测试方法快速便捷,已经被用于不同材料的蠕变行为测试[12-14].
本文采用纳米压痕法,对基于典型TSV工艺制备的TSV-Cu试样进行了纳米压痕蠕变性能测试.首先采用恒加载速率/载荷实现一个恒压入应变速率的稳态加载,当加载达到预定的最大深度后,采用恒载荷法进行保载.通过利用经验公式对保载阶段的蠕变位移-时间曲线进行拟合,研究了TSV-Cu的蠕变行为,并分析了不同压入应变速率以及最大压入深度等加载条件对TSV-Cu蠕变速率敏感指数m的影响.
1 纳米压痕实验
1.1试样制备
制备试样所选用的硅片直径为200 mm,厚度为700 μm.TSV的主要结构参数分别为:直径20 μm,深度180 μm,间距260 μm.具体的试样制备流程为:1)在硅表面涂布一层光刻胶并将其图形化;2)采用深反应离子刻蚀工艺在硅片上形成TSV孔;3)利用等离子体增强化学气相沉积在TSV孔内沉积一层绝缘层;4)利用物理气相沉积在绝缘层上继续沉积阻挡层和种子层;5)电镀填充Cu并进行退火处理;6)采用化学机械抛光去除硅表面多余的电镀Cu.制作完成的TSV结构示意图如图1所示.
将制作完成的TSV硅片切割成1 cm×1 cm,并利用环氧树脂和凝固剂对试样进行镶嵌固定.对试样表面采用粒度递减的抛光液进行机械抛光,最后再用稀硝酸溶液对表面进行腐蚀,以满足纳米压痕测试的条件.处理完的TSV试样表面如图2所示.
1.2实验方法
本文采用恒加载速率/载荷法[12]与恒载荷法[13]相结合方式,首先采用前者实现一个恒压入应变速率的稳态加载;当加载达到预定的最大深度后,采用后者进行保载,通过对保载阶段的蠕变变形进行分析,最终得到TSV-Cu的室温蠕变速率敏感指数m.实验采用G200型纳米压痕仪,系统的位移分辨率为0.01 nm,载荷分辨率为50 nN.实验采用金刚石Berkovich压头,对TSV-Cu顶部表面靠近Cu圆心位置处进行压痕实验.
在对试样进行实验前,通过大约1 h使仪器达到热平衡状态以减小热漂移带来的影响,最终使热漂移趋于稳定且达到或小于0.01 nm/s.由于测试过程中的蠕变应变率变化很大,通过对不同压入应变率下保载阶段的蠕变位移-时间曲线提取蠕变参数,可以改善其分散性,得到较好的结果[12].
本文的纳米压痕蠕变实验主要包含:1)压头以10 nm/s的速率接近试样表面.2)采用恒加载速率/载荷(P·/P)的方式压入样品,直到达到设定的最大压入深度hmax.为了考察不同P·/P和hmax对蠕变速率敏感指数 m值的影响,实验采用的 P·/P= 0.01、0.10、0.20 s-1.hmax=500、1 000、1 500 nm.而恒定P·/P会导致恒定的压入应变速率ε·,并且ε·=0.5/P,即相当于压入应变速率分别为 0.005、0.05、0.10 s-1.3)当达到hmax时(载荷P也达到最大),然后采用恒载荷法进行保载100 s,以获得材料的蠕变特征.4)以10 mN/s的速率进行卸载,当卸载到最大载荷的10%时,保载1 min以消除热漂移的影响.
为了考察实验的可重复性,在每组测试条件下对试样重复测试3次.图3所示为光学显微镜下TSV-Cu的纳米压痕形貌,可见试样表面并未出现明显的凸起或凹陷,不会出现接触面积被低估的情况,从而保证实验的精度.
2 实验结果与讨论
2.1压痕实验结果
图4为当最大压入深度hmax为1 500 nm时,/P从0.05 s-1增加到0.20 s-1时TSV-Cu的载荷位移曲线(P-h).可以看出,在压入深度达到1 500 nm时,随着/P的增加,所需的最大载荷 Pmax也从81.3 mN增加到96.9 mN.这是由于随着/P的增加,压入应变速率也随之增大,加载到预定最大压入深度时的历时也越短,导致滞弹性和蠕变等依赖于时间的变形减小,进而需要进一步增大载荷以达到预定的压入深度.在保载阶段,蠕变位移也随之增加,从37.4 nm增加到71.5 nm,这是由于随着/P的增加,材料中储存的弹性变形也相对越大,导致试样在保载阶段会有更多的弹性势能转换为塑性变形,从而使得蠕变位移增加.由此可知TSV-Cu对压入应变速率比较敏感.
2.2蠕变速率敏感指数m的确定
通常采用Weertman-Dorn方程[14]来描述试样在稳态蠕变阶段的稳态蠕变速率与时间和温度相关性,其表达式为式中:A为材料相关常数;Q为蠕变表面活化能;n为应力指数(即1/m,m为蠕变速率敏感指数);R为通用气体常数;T为热力学温度.由于测试温度等条件保持恒定,因此式(1)可以简化为
由于Berkovich压头具有几何相似性,即在一定载荷范围内,不同载荷所形成的压痕形貌相似,仅在数值上相差一个特定的尺寸因子.压入应变速率也可定义为瞬时压入速率与当前位移的比/h,即
对于Berkovich压头,保载阶段的等效应力可以定义为[15]
将式(3)(4)代入式(2)中,可得到
对式(5)两边取对数即得到m值为
图6为当hmax为1 500 nm时,在3种不同/P(对应的最大载荷Pmax=38.48、20.67、6.23 mN)情况下保载100 s的蠕变位移-时间曲线.为了得到准确的压入应变速率,需要将保载阶段后期无效的数据点去除,同时,对保载阶段起始的压入深度和时间都进行了归零处理.实验结果表明:在保载初始阶段,蠕变位移有一个快速增加的区间,随着保载时间的增加,蠕变位移的增加速率越来越小并逐渐趋于稳定.这是由于在保载初期,试样的弹性变形逐渐转变为塑性变形,并在压头的下方形成稳态塑性区.随着时间的增加,试样中逐渐形成稳定的变形结构,各种缺陷的形成和湮没逐渐达到一个动态平衡,从而使变形进入准稳态阶段.
在达到设定的最大压入深度后,可采用经验公式[16]对保载阶段的蠕变位移-时间曲线进行拟合
图8、9分别为当hmax=1 500 nm和/P为0.2 s-1时,在不同的P·/P和hmax加载条件下,等效应力σ和压入应变速率·ε的双对数曲线及其线性拟合情况.从图中可以看出,其线性相关度均在0.981以上.图中每条直线的斜率即代表TSV-Cu在该加载条件下确定的蠕变速率敏感指数m值.
由图8中3条直线斜率的平均值确定的m值为0.015 2±0.000 4,并且其值受加载时所用的P·/P值的影响不是很明显.由图9中3条直线斜率的平均值确定的m值为0.014 4±0.001 5,加载时采用最大压入深度hmax对其影响也不是很明显.最后,将图8、9得到的m值进行平均,得到了TSV-Cu的m平均值为0.014 9±0.002 0.
2.3结果讨论
与传统的单轴拉伸蠕变测试相比,纳米压痕蠕变中的应变速率要明显高于前者,并且压头下方区域的应力状态更加复杂.表1对比了本文测得的TSV-Cu蠕变速率敏感指数m值和其他研究者采用纳米压痕蠕变测试测得的结果.可以看出,对于采用不同方式制作的Cu,测得的m值也有所不同.
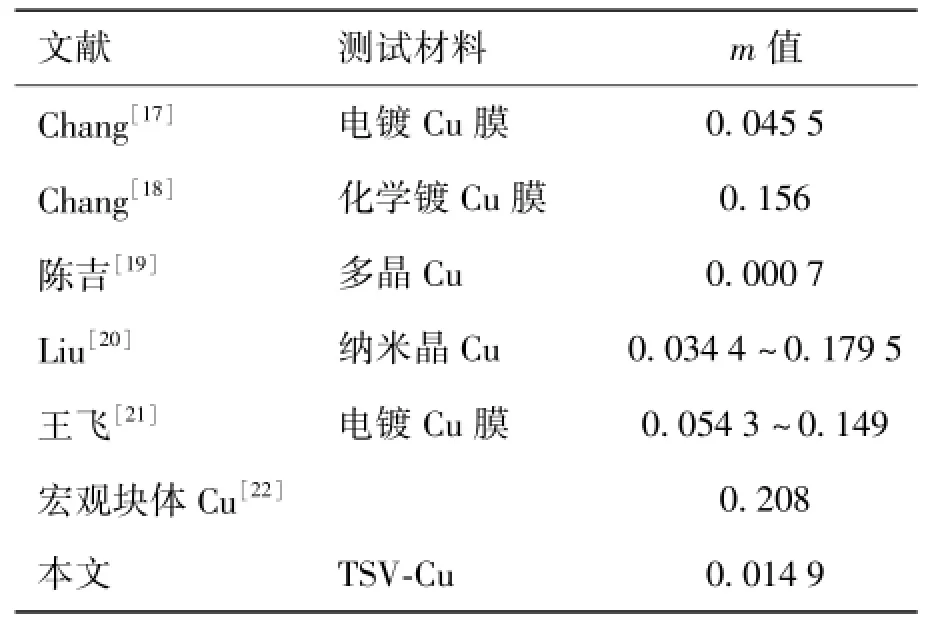
表1 不同m值的对比Table 1 Comparison of different values of m
Chang等[17-18]分别采用电镀沉积和化学镀的方式制备了厚度为6 μm和2~3 μm的2种Cu膜,利用恒载荷法的纳米压痕实验研究了其力学性能,得到Cu膜的 m值分别为0.045 5和 0.1560.陈吉等[19]采用恒加载速率/载荷法与恒载荷法相结合方式研究了单晶、多晶及纳米晶Cu块体材料的蠕变性能,指出晶界增加会使蠕变速率增加,但测得多晶Cu的m值仅为0.000 7,同其他文献中所报道的差距较大.王飞等[21]采用恒载荷法对采用电镀工艺制备的不同晶粒尺寸的Cu膜进行了测试,发现当晶粒尺寸小于200 nm时,m值对晶粒尺寸变得敏感,随晶粒尺寸的降低而降低,得到的 m值在0.054 3~0.149 0.本实验得到TSV-Cu的m平均值为0.014 9±0.002 0,要远小于传统蠕变测试得到的宏观块体Cu的m值(0.208[22]).
关于m值的差异,除了测试方法和试样制备工艺的不同、环境噪音等引起的试验误差外,还可能有几个主要原因:根据Goodall等[15]的研究,保载时间对测试结果也是重要的一个指标,许多测试中较短的保载时间不仅受设备热稳定的限制,还要考虑减小试样基体带来的影响.初期蠕变阶段对研究蠕变行为有着重要的影响.对于TSV-Cu试样,电镀工艺造成的工艺残余应力以及非均匀的微结构同样会影响其复杂的蠕变行为.
由于本实验在室温下进行,测试温度仅为0.23Tm(Tm=1 083℃),而扩散蠕变和晶界滑移机制发生的条件一般在0.7Tm,甚至更高.因此,原子的热运动受到限制,外界应力只能激活数量有限的位错.位错的运动又容易被晶界或者杂质原子所阻挡,从而导致蠕变速率降低.此外,随着晶粒尺寸减小,压头在压入过程中所涉及的晶粒数目增加,晶界对位错运动的阻碍作用逐渐增强,容易在晶界处形成位错塞积造成蠕变速率降低[21].由于TSV-Cu的晶粒尺寸在100~200 nm[23],小于一般的块体Cu,因此得到的TSV-Cu蠕变速率敏感指数是合理的.
3 结论
1)所有试样在保载阶段均发生了明显的蠕变变形,不同加载条件下得到的压痕蠕变位移有明显的尺寸效应,最终得到的TSV-Cu的蠕变速率敏感指数m的平均值为0.014 9.
2)在采用恒加载速率/载荷法与恒载荷法相结合方式对TSV-Cu的蠕变速率敏感指数m进行测试时,发现加载段所用的恒P·/P以及最大压入深度hmax对最终m值的影响不是很明显.
3)由于晶界对位错运动的阻碍作用,分析认为由于TSV-Cu中晶粒尺寸的减小会引起晶界数量的增加,最终导致TSV-Cu的m值与宏观Cu不同.
[1]LAU J H.Overview and outlook of through-silicon via(TSV)and3Dintegrations[J].Microelectronics International,2011,28(2):8-22.
[2]秦飞,王珺,万里兮,等.TSV结构热机械可靠性研究综述[J].半导体技术,2012,37(11):825-831.
QIN F,WANG J,WAN L X,et al.Review on the thermal mechanical reliability of TSV structures[J]. Semiconductor Technology,2012,37(11):825-831.(in Chinese)
[3]ANDRICACOS P C,UZOH C,DUKOVIC J O,et al. Damascene copper electroplating for chip interconnections[J].IBM Journal of Research and Development,1998,42(5):567-574.
[4]苏才均,吴昊,郭占社,等.微构件材料力学性能测试方法[J].实验力学,2005,20(3):441-447.
SU C J,WU H,GUO Z S,et al.Mechanical testing methods of micro structures[J].Journal of Experimental Mechanics,2005,20(3):441-447.(in Chinese)
[5]SHEN Y L,RAMAMURTY U.Constitutive response of passivated copper films to thermal cycling[J].Journal of Applied Physics,2003,93(3):1806-1812.
[6]PRADEEP D,XU L H,MIAO J M,et al.Mechanical and microstructural characterization of high aspect ratio through-wafer electroplated copper interconnects[J]. Journal of Micromechanics and Microengineering,2007,17(9):1749-1757.
[7]李君翊,汪红,王溯,等.基于单轴微拉伸的TSV铜力学性能研究[J].复旦学报(自然科学版),2012,51(2):184-189.
LI J Y,WANG H,WANG S,et al.Investigation of mechanical properties of Cu-TSV by uniaxial micro-tensile test[J].Journal of Fudan University(Natural Science),2012,51(2):184-189.(in Chinese)
[8]WU W,QIN F,AN T,et al.Experimental and numerical investigation of mechanical properties of electroplating copperfilledinthroughsiliconvias[J].IEEE Transactions on Components Packaging and Manufacturing Technology,2016,6(1):23-30.
[9]MURARKA S P.Multilevel interconnections for ULSI and GSI era[J].Materials Science and Engineering R,1997,19(3/4):87-151.
[10]HERYANTO A,PUTRA W N,TRIGG A,et al.Effect of copper TSV annealing on via protrusion for TSV wafer fabrication[J].Journal of Electronic Materials,2012,41(9):2533-2542.
[11]HAN Y D,JING H Y,NAI S M L,et al.Temperature dependence of creep and hardness of Sn-Ag-Cu lead-free solder[J].Journal of Electronic Materials,2010,39(2):223-229.
[12]LUCAS B N,OLIVER W C.Indentation power-law creep of high-purity indium[J].Metallurgical and Materials Transactions A,1999,30(3):601-610.
[13]RAMAN V,BERRICHE R.An investigation of the creep processes in tin and aluminum using a depth-sensing indentation technique[J].Journal of Materials Research,1992,7(3):627-638.
[14]LI W B,HENSHALL J L,HOOPER R M,et al. Mechanisms of indentation creep[J].Acta Metallurgica et Materialia,1991,39(12):3099-3110.
[15]GOODALL R,CLYNE T W.A critical appraisal of the extraction of creep parameters from nanoindentation data obtained at room temperature[J].Acta Materialia,2006,54(20):5489-5499.
[16]LI H,NGAN A H W.Size effects of nanoindentation creep[J].Journal of Materials Research,2004,19(2): 513-522.
[17]CHANG S Y,CHANG T K,LEE Y S.Nanoindentating mechanical responses and interfacial adhesion strength of electrochemically deposited copper film[J].Journal of the Electrochemical Society,2005,152(10):c657-c663.
[18]CHANG S Y,LEE Y S,CHANG T K.Nanomechanical response and creep behavior of electroless deposited copper films under nanoindentation test[J].Materials Science and Engineering A,2006,423(n1-2):52-56.
[19]陈吉,汪伟,卢磊,等.纳米压痕法测量Cu的室温蠕变速率敏感指数[J].金属学报,2001,37(11): 1179-1183.
CHEN J,WANG W,LU L,et al.Measurement of creep rate sensitivity of copper at room temperature by using nanoindentation[J].Acta Metallurgica Sinica,2001,37(11):1179-1183.(in Chinese)
[20]LIU Y,HUANGCX,BEIHB,etal.Room temperature nanoindentation creep of nanocrystalline Cu and Cu alloys[J].Materials Letters,2012,70(1):26-29.
[21]王飞,徐可为.晶粒尺寸与保载载荷对Cu膜纳米压入蠕变性能的影响[J].金属学报,2004,40(10): 1032-1036.
WANG F,XU K W.Effect of grain size and holding load onnanoindentationcreepofCufilm[J].Acta Metallurgica Sinica,2004,40(10):1032-1036.(in Chinese)
[22]FROST H J,ASHBY M F.Deformation mechanism maps-the plasticity and creep of metals and ceramics[M].Oxford:Pergamon,1982.
[23]OKORO C,VANSTREELSK,LABIER,etal. Influence of annealing conditions on the mechanical and microstructural behavior of electroplated Cu-TSV[J]. Journal of Micromechanics and Microengineering,2010,20(4):045032.
(责任编辑杨开英)
Creep Behavior of Electroplated Cu for Through-Silicon Via Filling
WU Wei,QIN Fei,AN Tong,CHEN Pei,YU Huiping
(College of Mechanical Engineering and Applied Electronics Technology,Beijing University of Technology,Beijing 100124,China)
As through-silicon via(TSV)is the core structural element of 3D integration or packaging,and the performance of TSV-Cu is critical for TSV reliability.This paper studied the creep behavior of TSV-Cu comprehensively.TSV-Cu sample was prepared by regular TSV process,and then nanoindention was used to determine the creep behavior of TSV-Cu at room temperature.A method of combining the constant loading rate/load test and the constant load test was introduced for the creep behavior testing. Therefore,the creep behaviors of TSV-Cu under various loading conditions were analyzed.The creep strain rate sensitivity m can also be obtained by processing the data from constant loading stage.Results show that m is independent with indentation strain rates and maximum indentation depths.
through-silicon-via(TSV);TSV-Cu;nanoindentation;creep rate sensitivity
U 461;TP 308
A
0254-0037(2016)06-0837-06
10.11936/bjutxb2015030040
2015-03-13
国家自然科学基金资助项目(11272018)
武伟(1985—),男,博士研究生,主要从事先进电子封装技术与可靠性方面的研究,E-mail:wuweimoto@163.com
