金层厚度对沉金PCB焊锡延展性及焊点可靠性的影响
2015-09-09李伏李斌汕头超声印制板公司广东汕头515065
李伏,李斌(汕头超声印制板公司,广东 汕头 515065)
金层厚度对沉金PCB焊锡延展性及焊点可靠性的影响
李伏*,李斌
(汕头超声印制板公司,广东 汕头 515065)
通过锡球延展性、常规可焊性、黑盘和焊盘拉脱强度测试验证了金层厚度对沉金(ENIG)印刷电路板(PCB)焊锡延展性的影响,并用扫描电镜评估了金属间化合物(IMC)。结果表明,金层越厚,焊锡延展性越好。但金层只起保护镍层的作用,沉金 PCB焊点的可靠性建立在IMC基础上,只要能在镍层与焊料之间能形成良好的金属间化合物,即可保证焊点的可靠性。另外,金层越厚,黑盘的风险越高,且有可能引起金脆问题,因此不能一味地追求沉金层的厚度以提高焊锡延展性。
电路板;沉金;厚度;焊锡延展性;金属间化合物;可靠性
First-author’s address: China Circuit Technology (Shantou) Corporation, Shantou 515065, China
沉金也叫无电镍金或沉镍浸金,是一种在印制线路板(PCB)裸铜表面涂覆可焊性涂层的工艺,其集焊接、接触导通、打线、散热等功能于一身,满足了日益复杂的PCB装配焊接要求,受到PCBA(printed circuit board assembly,即PCB装配)客户的广泛亲睐。但在实际装配过程中,偶尔也有客户反映沉金焊锡延展性差,进而怀疑沉金板件存在可焊性不良的问题。图 1是某客户反馈的沉金焊锡延展性差的图片,从中可见锡膏在屏蔽框位置表现出较明显的延展性差异[其余BGA(球栅阵列)结构及较大焊盘的锡膏均润湿良好]。测试时发现金厚差异较大,焊锡性好的板件,金厚在2.50 μ″左右;较差的板件金厚大约为1.10 μ″。那么,是不是金厚导致焊锡延展性

图1 客户反馈锡膏延展性好及较差的板对比Figure 1 Comparison of boards with good and bad solder spread from customers
编者注:图1原为彩色,请见C1页。出现差异呢?为此,通过寻找合适的焊锡延展性测试方法,并制作不同金厚的试验板,验证了金厚对焊锡延展性的影响,也评估了金厚对沉金PCB焊点可靠性的影响。
1 评估方法
采用浸锡法测试客户反馈锡膏延展性不良的样品,其焊盘润湿均良好,未显示出差异,因此只能寻找其他方法评估沉金PCB的焊锡延展性。由于PCB厂内部无法采用印锡膏的方式,拟通过锡球延展性测试来模拟评估锡膏在沉金焊盘回流焊接后的延展性。
1.1试验
选择客户反馈锡膏延展性较好及较差的样板,先用油性松香涂抹焊盘,再植上直径0.6 mm的锡球,然后放到回流焊机内进行回流焊接,通过测量锡球焊接后的延展尺寸来评估此法是否可行。由于锡球大小固定,在足够大的焊盘上,只需对比回流焊接后锡球延展面积即可。
1.2结果
试验结果如表1所示。可见客户端模拟装配后锡膏延展性较差的板件(焊盘尺寸约1.2 mm × 1.2 mm),其锡球延展性测试也较差,而客户端模拟装配较好的板件,锡球延展性也较好,二者延展面积相差约0.22 mm2。故采用锡球延展性的方法可有效评估不同金厚沉金板件的焊锡延展性。需说明的是:测试样品是客户已完成双面焊接后,PCB上未焊接位置,因受一定的回流焊接热影响及污染等,所以润湿性较差。
2 金厚对锡球延展性的影响
通过控制沉金时间制作了不同金厚的试验板(焊盘尺寸约1.8 mm × 1.8 mm),实际金厚及镍厚如表2所示。

表2 样板的金厚及镍厚Table 2 Thicknesses of gold and nickel layers of sample boards
不同金厚板件锡球延展性测试结果如表3所示。可见当金厚仅1.15 μ″(1#样品)时,锡球延展性较差,其润湿后的面积约1.10 mm2;对比2#和3#样品发现二者锡球延展面积相差约0.30 mm2,可知金厚较薄且厚度相近时,镍层厚些也有利于提高延展性;当金厚达到3.00 μ″(4#与5#样品)左右,焊锡已将整个焊盘润湿,面积大于3.24 mm2。上述结果表明,金厚对焊锡延展性有非常显著的影响。
3 不同金厚板件的可靠性测试
3.1常规可焊性测试
不同金厚板件常规可焊性测试结果见表4。采用浸锡法测试可焊性,不同金厚板件的焊盘润湿能力未见明显差异,均表现良好。但用漂锡法测试孔的可焊性时,还存在一定差异:金层较薄时,锡基本无法润湿孔环(如1#、2#、3#样品),但当金层较厚时,锡可完全爬到孔环并润湿(如5#样品)。上述结果进一步证明金厚会显著影响焊锡的延展性。

表3 金厚与锡球延展面积的关系Table 3 Relationship between gold thickness and solder ball coverage area

表4 不同金厚板件常规可焊性测试结果Table 4 Normal weldability test results of boards with different gold thicknesses
3.2金属间化合物(IMC)测试
用SEM(日本岛津SSX-550)测试了不同金厚板件IMC,结果见表5。从结果可知,无论是采用锡球法还是浸锡法,均可形成良好的IMC层。但金层太厚时,IMC层也较厚,如4#样品。由于IMC层较脆,过厚的IMC反而会降低焊点强度,同时过多的金熔入焊点中还会带来金脆问题,因此金层太厚不利于IMC的形成及焊点强度。
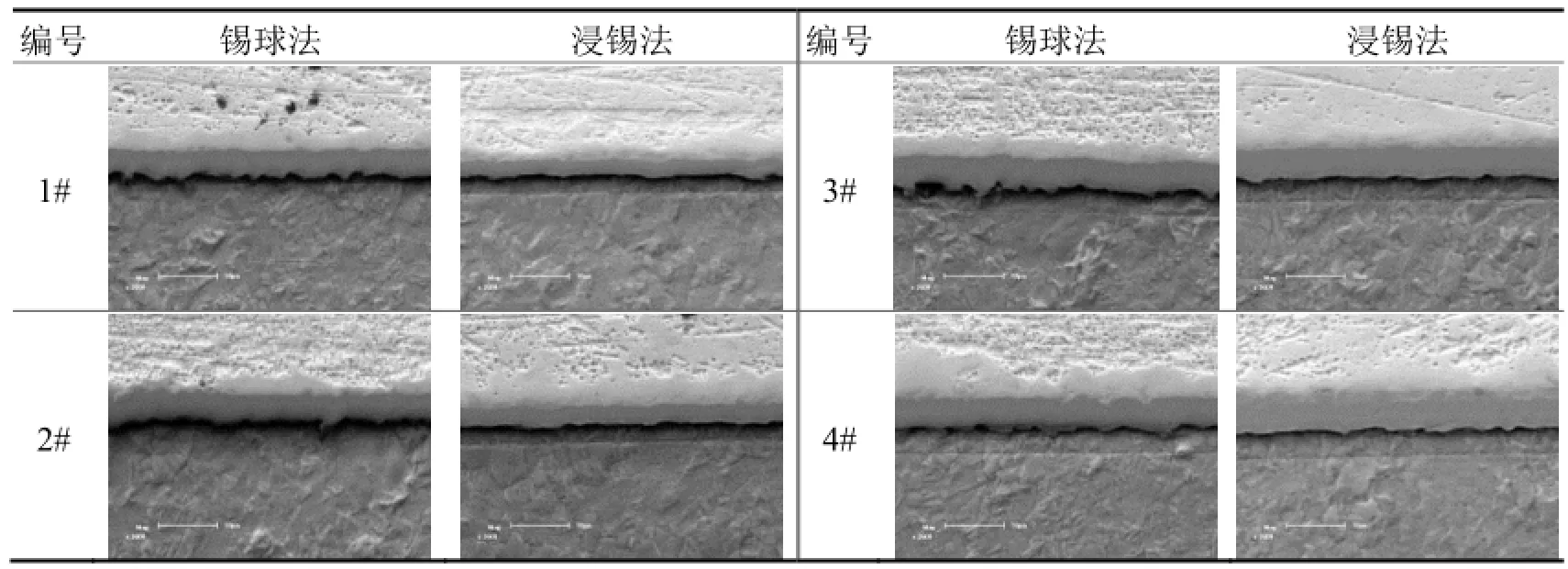
表5 不同金厚样品IMC的SEM图Table 5 SEM images of IMCs in boards with different gold thicknesses
3.3黑盘测试
不同金厚板件黑盘SEM测试结果见图2。从本次结果可见无论是薄金还是厚金,均未发现明显黑盘。

图2 不同金厚样品黑盘测试SEM照片Figure 2 SEM images of boards with different gold thickness after black pad test
3.4焊盘拉脱强度测试
不同金厚板件焊盘拉脱测试结果见表6。从表6可见,金厚1.10 ~ 3.70 μ″的焊盘均合格,不论是孤立的标靶点,还是有连线的方形焊盘,拉脱测试后焊盘均与基材分离,表明焊接强度良好。
4 金厚影响沉金PCB焊锡延展性的原因探讨
为什么不同金厚的沉金PCB焊锡延展性会有如此大的差异?这还得从金属的焊接特性进行分析。众所周知,金与银焊锡性都很好是因为它们在强热中能快速形成IMC(AuSn4与Ag3Sn),且IMC还能迅速分散溶入液态的焊料中。金溶进高锡量SAC305焊料的速率可达117.90 μ″/s,银也能快到43.60 μ″/s,远超过铜(4.10 μ″/s)和镍(0.05 μ″/s)这2种基底金属形成IMC的速率[1]。但实际上沉金PCB焊接后真正的焊点强度建立在镍基底上,金只作为表面防锈的皮膜而已。“焊锡延展性”不过是焊接瞬间金与焊料的热烈互动,真正确保焊点强度的还是取决于焊料与镍层能否形成良好的IMC层。
5 结论
(1) 锡球延展性测试可有效评估沉金PCB焊锡延展性。结果表明金厚对焊锡延展性有显著影响,即金层越薄,焊锡延展性越差;金层越厚,焊锡延展性越好。

表6 不同金厚样品焊盘拉脱强度测试结果Table 6 Pull strength test results of pads on boards with different gold thicknesses
(2) 金厚为1.15 ~ 3.70 μ″的样品均有IMC生成,焊盘拉脱测试结果均为焊盘与基材分离。金厚仅影响焊锡延展性,并不影响焊接强度,只有当无法形成可靠的IMC层时,才会影响焊接强度。
(3) 沉金PCB的焊点强度建立在镍基底上,金只是镍层表面防锈的皮膜。“焊锡延展性”不过是焊接瞬间金与焊料的热烈互动,真正确保焊点强度的还是建立在镍层上的IMC。
(4) 一般通过延长沉金时间或提高沉金温度获取沉金PCB的金厚,而由于金缸对镍层的攻击十分猛烈,过度追求金厚势必增加黑盘风险,从而影响焊点可靠性,因此在保证金层能完全覆盖镍层的情况下,金厚控制得薄些反而更有利于确保焊点强度。
[1]白蓉生.看图说故事(15)[J].电路板会刊, 2009 (45): 4-17.
[ 编辑:杜娟娟 ]
Effect of gold thickness on ENIG PCB solder spread and joint reliability
LI Fu*, LI Bin
The effect of gold thickness on solder spread of electroless nickel/immersion gold (ENIG) printed circuit board (PCB) was verified through solder ball spread test, normal weldability test, black pad test, and pad pull strength test.The intermetallic compounds (IMCs) were assessed by scanning electron microscope.The results showed that the solder spread gets better with increasing thickness of gold layer.However, gold layer is only used to protect the nickel layer.The reliability of solder joint is built on the basis of IMCs, and can be guaranteed as long as good IMC can be formed between nickel layer and solder.The thicker the gold layer, the higher risk of black pad will be, and gold embrittlement problem may be caused.The thickness of immersion gold should not be blindly pursued for improving the solder ductility.
printed circuit board; electroless nickel/immersion gold; thickness; solder spread; intermetallic compound;reliability
TN405; TG40
A
1004 - 227X (2015) 04 - 0196 - 05
2014-08-20
2014-12-08
李伏(1978-),女,辽宁锦州人,硕士,高级工程师,主要负责PCB产品及新材料新工艺的可靠性评估,在PCB产品尤其是焊接失效分析方面具有较丰富的经验。已在国内外刊物及国际会议上发表论文10余篇。
作者联系方式:(E-mail) fuli@cctc-pcb.com。
