一种高di/dt栅控晶闸管的三重扩散工艺优化*
2014-12-05孙瑞泽陈万军彭朝飞阮建新
孙瑞泽 ,陈万军 ,彭朝飞 ,阮建新 ,张 波
(1. 电子科技大学电子薄膜与集成器件国家重点实验室,成都 610054;2. 东莞电子科技大学电子信息工程研究院,广东 东莞 523808)
1 引言
电容式能量存储器具有稳定的能量存储、高功率密度和高传输速度等优点,在具有高瞬时功率的脉冲功率系统中,系统的能源供给通常由电容式能量存储提供[1~3]。脉冲宽度是由电路的时间常数决定的,因此电容式能量存储器需要足够低的负载阻抗以产生短脉冲大电流,从而实现脉冲功率系统中的高电流上升速率[4,5]。火花隙等传统开关器件具有开关速率低、使用寿命短和效率低下等缺点,而固体开关器件因其优越轻便性、低成本和高效率等特点在脉冲功率系统中得到了应用[6]。栅控晶闸管(MOS Controlled Thyristor,简称MCT)具有高电导调制效应与极低的导通电阻,因此MCT在脉冲放电应用中具有明显的优势[7]。但是在短脉冲操作中,特别是在快速开启时,器件有可能根本无法完成操作,或者即使完成也会导致过早失效[8~10]。
当MCT应用在脉冲放电电路中时,更高的正向工作电流意味着器件能够承受具有高电流上升率的浪涌电流。一个有效提高此特性的方法就是增加器件浓度梯度以实现阴极侧的载流子注入增强。MCT的传统制造工艺是基于DMOS技术的三重扩散工艺[11]。由于阴极侧的P阱与N阱都是通过注入扩散形成,其浓度受器件正向导通能力与耐压要求所限制,制造工艺中无法针对高电流上升率特性进行浓度分布的调整。因此,本文提出了一种优化型三重扩散工艺(Optimized Triple Diffusion,简称OTD)以实现高电流上升率MCT器件。
2 浓度分布与di/dt的折中关系
传统MCT制造工艺是通过修改DMOS工艺菜单而实现,同时MCT的结构决定了要采用三重扩散工艺来制造开启与关断沟道。图1显示了传统MCT的结构与其等效电路。高di/dt特性MCT首先要拥有足够高的正向电流能力,这可以通过增大MCT中寄生三极管的电流增益以加快MCT闩锁状态的建立而实现。另外,降低器件的导通电阻能够实现更高的电流上升率,这需要在器件结构设计中增大阴极电流注入效率以实现更强的电导调制。
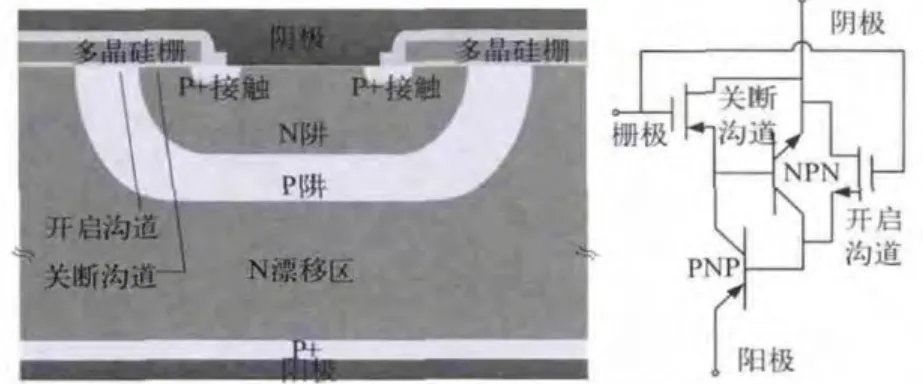
图1 MCT的结构横截面与等效电路图
增加寄生晶体管的放大系数与注入效率都可以通过调整P阱与N阱间的浓度梯度来实现。通常调整阱区与沟道区的浓度都是通过调整整体的注入剂量与扩散时间。低导通电阻可以通过简单的增加N阱的注入剂量来实现,但是这种方法存在以下折中关系:
(1)关断沟道是由N阱的注入扩散形成的,因而器件关断阈值电压会随着N阱剂量的提高而增加。在DMOS工艺中栅氧层厚度通常低于100 nm,过高的关断阈值电压会降低栅极驱动的可靠性并且加速栅氧化层老化,同时系统保持关断状态所需的功耗也会上升。
(2)在正向耐压状态时,耗尽区更倾向于向低掺杂区扩展,因此P阱一侧的P阱/N阱结的耗尽区宽度会展宽。随着N阱剂量的提高,此侧的耗尽区会进一步扩展,导致P阱内未耗尽区被压缩,这就产生了穿通击穿的危险。虽然可以通过将P阱剂量同时提高50%来应对N阱剂量提高带来的缺点,但是考虑到MCT的传统工艺中P阱由单步注入扩散形成,并且器件的高耐压要求已经导致P阱浓度非常高,不适合再提高。如果通过增加扩散时间来提高P阱结深与开启沟道的宽度,这样虽然可以降低P阱浓度,但是过长的高温退火会影响其他阱区的浓度分布并增加生产成本。
正向能力的提升与关断操作对器件的要求之间存在折中关系,单独增大N阱的剂量会导致诸如更高的阈值电压与穿通击穿等性能退化。
3 优化型三重扩散工艺
本文设计了基于DMOS工艺的优化型三重扩散工艺(Optimized Triple Diffusion,简称OTD),包括重新设定掩模板参数、引入深N阱、复用场限环的掩模板来制造P阱等优化措施。该措施在深N阱制造中使用结终端工艺中的N型截止环的高浓度注入,修改其掩模板使N型截止环工艺同时实现元胞中的深N阱。如果器件结终端工艺中未使用截止环,则需要增加一层光刻层次。该措施在深P阱制造中使用结终端工艺中的P型场限环的高浓度注入,修改其掩模板使P型场限环工艺同时实现元胞中的深P阱。器件结终端工艺中通常具有此步骤,因此深P阱不需要增加光刻层次。图2与图3展示了OTD工艺与其他传统工艺的对比以及制造出的MCT的结构对比。

图2 OTD工艺与传统工艺流程对比

图3 传统工艺与OTD工艺制造的MCT的横截面对比
3.1 场限环掩模板复用与P阱的窗口组合
利用场限环注入的高剂量P型杂质与重新设计的掩模板,在形成场限环的同时在P阱中心范围实现深P阱。此道工艺在栅形成工艺之前,因此形成的P阱可以通过后续的高温过程得到充分扩散。深P阱可以将P阱中心部分的扩散边界向体内推进更深,同时又不影响开启沟道处较低的P阱浓度,从而保证开启阈值电压不变。深P阱还可以在关断沟道处于N阱进行杂质补偿,进一步降低关断沟道的浓度,降低关断阈值电压。此道工艺将场限环掩模板复用实现P阱的横向浓度的准确控制,同时又不增加额外热过程,该步骤实现的结构如图4左所示。
3.2 大注入窗口的深N阱与N阱的窗口组合
深N阱的注入窗口设计为小于N阱的自对准注入窗口。N阱与深N阱注入窗口之间的非重叠部分可以保证关断沟道处只有N阱的注入,进而保持关断沟道处较低的浓度,而元胞中心区域有深N阱与N阱的叠加注入,注入总剂量为N阱的5倍以上,这样可以在元胞中心区域获得较大的浓度梯度。如图4所示,此道工艺可以实现对N阱横向浓度的准确控制。该步骤实现的结构如图4右所示。
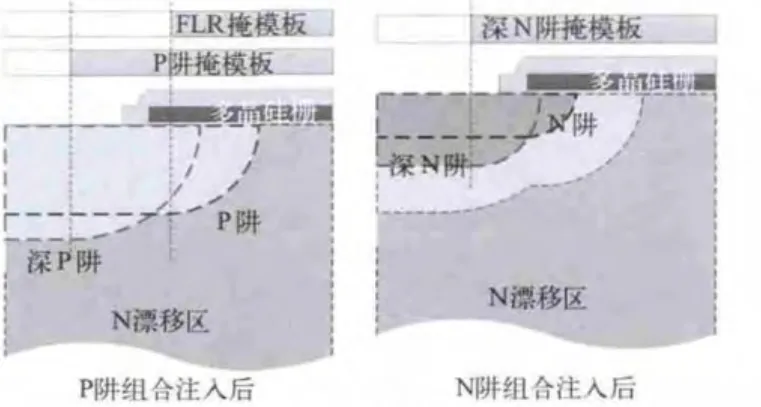
图4 器件截面结构图
4 结果与讨论
本文通过半导体器件仿真软件MEDICI对MCT进行工艺仿真与电学性能测试以证实OTD工艺对MCT的性能改进。将传统MCT作为基准参考组(标记为Con.MCT),将N阱剂量提高50%以作为比对组(标记为N+MCT),将改进型三重扩散工艺制造的MCT作为目标组(标记为OTD-MCT)。主要器件参数如下:元胞宽度为30 μm,MOS栅长为7 μm,N漂移区的厚度与掺杂浓度分别为200 μm与8×1013cm-3,P阱的峰值浓度与结深分别为2×1017cm-3与4 µm,N阱的峰值浓度与结深分别为1×1018cm-3与1.5 µm,背面P型重掺杂阳极区的掺杂浓度与结深分别为1×1019cm-3与2 µm,电子与空穴的寿命都是10 µs。
4.1 静态参数对比
三种不同工艺下制造的MCT器件的表面浓度分布如图5所示,OTD-MCT在元胞中心区域具有高浓度梯度同时在沟道区具有较低的浓度。从x=0到x=4 μm处,深N阱的存在使得N阱的整体浓度较高。在x=7 μm附近的关断沟道处,由于N阱剂量未改变,沟道浓度能够保持与传统MCT一致。N+MCT器件组拥有最高的N阱浓度,在关断沟道区始终高于Con.MCT,这对阈值电压是十分不利的。
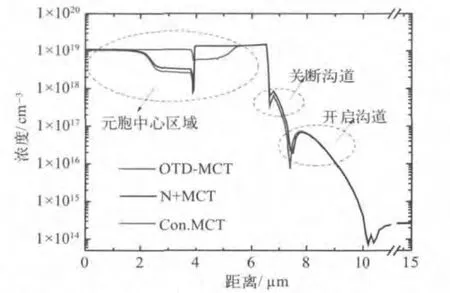
图5 不同工艺下制造MCT器件的表面浓度分布对比
图6显示了三种MCT器件在阳极电压+2 V以及栅压+7 V的情况下的I-V曲线,得益于OTD工艺中实现的元胞中心区域的高浓度梯度,OTD-MCT的电流能力甚至超过了N+MCT,与传统MCT相比提高了20%。

图6 不同工艺下制造MCT器件的I-V特性
图7左与图7右分别显示了MCT器件的开启与关断沟道的转移特性曲线。可以看出,相比于其他工艺,OTD工艺可以将关断阈值电压控制在-10 V左右,开启阈值仅比Con.MCT高0.1 V。从图8中MCT器件在正向耐压时的等势线可以看出,N+MCT将N型阱区与P型阱区组成的正偏二极管的耗尽区边界推向P型阱区深处,器件易发生穿通击穿;而OTD-MCT能够实现N阱/P阱结与P阱/N漂移区结的耗尽区边界间足够的未耗尽区域宽度,能够有效防止穿通击穿。
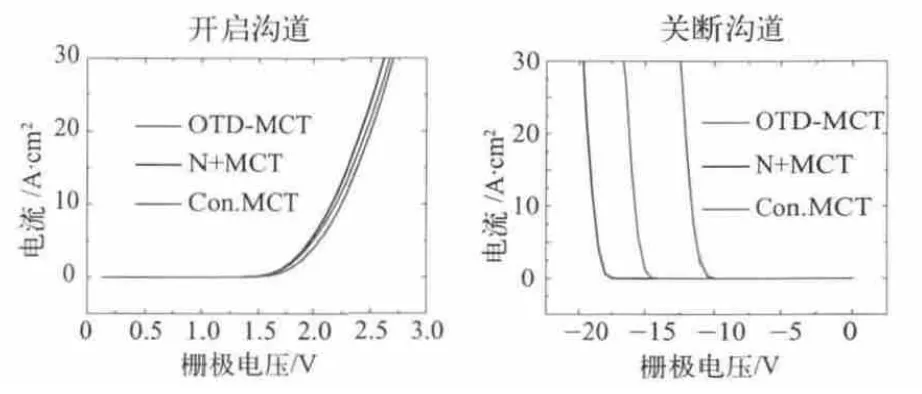
图7 不同工艺MCT器件的开启沟道与关断沟道的转移特性
4.2 脉冲放电特性对比
为了验证OTD-MCT在脉冲放电应用中的高脉冲特性效果,搭建了如图9所示的电容测试平台。利用MEDICI设置了一个5 μF的电容放电试验,其中电容两端电压预先设置为1 000 V,串联电感值设置为9 nH以模拟实际应用中的寄生电感,栅极电阻设置为4.7 Ω。

图9 脉冲电流仿真测试中的电容放电电路

图10 不同工艺下制造的MCT的脉冲放电曲线
在电容充电完成后断开Vcc,此时电路中的能量全部存储于电容中。在给MCT栅极提供开启电压后,电路实现脉冲放电,其I-V曲线如图10所示。对于上升沿来说,OTD-MCT与Con.MCT实现了同样的脉冲峰值,然而OTD-MCT的上升时间较短,因而实现了更高的di/dt。对于下降沿来说,OTD-MCT拥有较长的拖尾,这可以由此时两种器件不同的载流子浓度分布来解释。从图11中的载流子分布图可以看出,从开启时刻到脉冲峰值之前,图11(a)中的OTD-MCT拥有高于Con.MCT的载流子浓度,其电流上升速度与阳极电压上升速度都快于Con.MCT;在达到峰值电流之后,OTD-MCT的载流子浓度小于Con.MCT并且快速下降,如图11(b)所示。这使得整个脉冲过程中OTD-MCT器件损耗的能量小于Con.MCT。
对于不同的载流子寿命,OTD-MCT的电流上升率与脉冲放电中器件的最高温度显著变化。从图12可以看出,载流子寿命从0.1 μs增大到100 μs时,di/dt值持续上升,并且当寿命值大于1 μs后保持不变。这说明了要使制造出的MCT器件具有较高的di/dt值,制造工艺应当保证器件的载流子寿命至少为1 μs以上。从最高温度的变化关系也看出,较低的载流子寿命会导致器件在脉冲放电过程中温度显著提高。

图11 脉冲放电开启后不同时刻的MCT器件中载流子分布
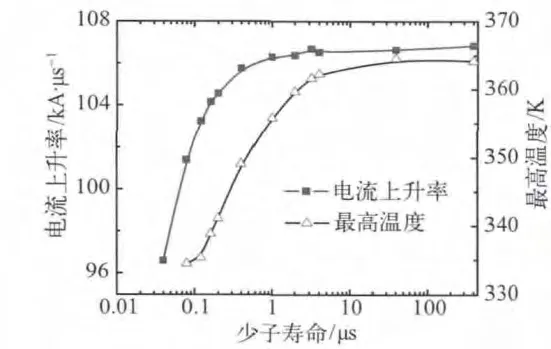
图12 载流子寿命对器件的电流上升率和最高温度的影响
图13展示了在电容值为0.2 μF到20 μF的脉冲电路中Con.MCT与OTD-MCT的脉冲放电特性对比。其中“电流上升率”为脉冲电流上升沿的最大斜率;“最高温度”定义为整个下降时间内的温度最大值;“下降时间”参数定义为从脉冲放电开始时刻到器件温度再次恢复至300 K初始温度的时刻;“脉冲能量”代表的是整个脉冲操作中的能量消耗。
与正向电流能力的对比一致,OTD-MCT得益于更快速建立的闩锁效应与更大的正向电流容量而表现出更高的电流上升率。这正验证了本文提出的对于传统三重扩散工艺的优化方法对于制造具有高电流上升率MCT的有效性。对于增加的电容值,也意味着电路中的总存储能量的增加,以上4个参数都会增加。OTD-MCT的电流上升率较高,同时最大温度与下降时间都较小,这都与其较强的注入效应带来的低有效电阻密不可分。相比于传统MCT,OTD-MCT的电流上升率提高了15%。对于不同电容值,两者总消耗的能量相同,而OTD-MCT的最高温度始终低于Con.MCT。在高电容值(C=15 μF与C=20 μF)的情况下,Con.MCT的最高温度达到了600 K以上,远远超过最大工作温度,而OTD-MCT为420 K,仍在安全工作范围内,相比于Con.MCT降低了33%。OTD-MCT由于工作状态下较高的载流子浓度,其温度下降时间为11 ms,相比Con.MCT降低36%。OTD-MCT表现出更高的热稳定性、更快的热逸散速度与更优异的动态特性。
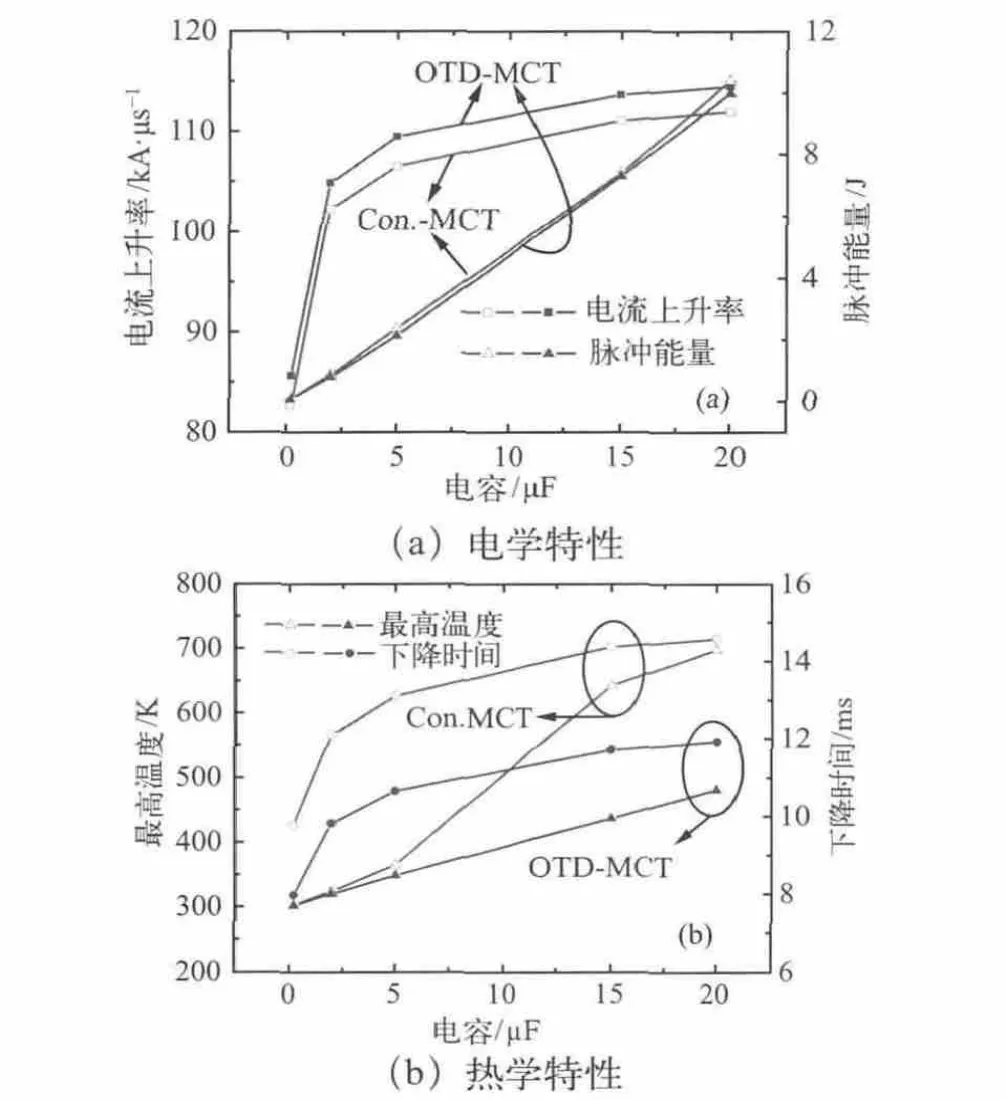
图13 不同电容值的脉冲放电电路中传统MCT与OTD-MCT对比
5 结论
由以上分析结论可知,本文提出的优化型三重扩散工艺克服了传统工艺中的阱区浓度调整与器件性能最大化之间的矛盾,实现了更优化的浓度分布。该工艺所制造的MCT器件拥有更强电导调制效应,更高的正向工作电流与更低的阈值电压,并且在脉冲放电应用中实现了电流上升率15%的提高,同时其热稳定性也得到显著提高。
[1] M A Elsayed, A A Neuber, J C Dickens, J W Walter, M Kristiansen, L L Altgilbers. An explosively driven highpower microwave pulsed power system [J]. Review of Scientific Instruments, 2012, 83(2):024705-024711.
[2] B E Fridman, A A Drozdov, V G Kuchinski, V T Prokopenko,V V Vesnin. 5 kV, 300 kJ Capacitive Energy Storage [Z].
[3] C Fahrni, A Rufer, F Bordry, J Burnet. A novel 60 MW pulsed power system based on capacitive energy storage for particle accelerators [Z].
[4] E Schempp, W D Jackson. Systems considerations in capacitive energy storage [C]. Proceedings of the 31st Intersociety Energy Conversion Engineering Conference,1996, 666-671.
[5] T Yokoo, K Saiki, K Hotta, J Weihua. Repetitive Pulsed High-Voltage Generator Using Semiconductor Opening Switch for Atmospheric Discharge [J]. IEEE Transactions on Plasma Science, 2008, 36(5):2638-2643.
[6] S C Glidden, H D Sanders. Solid state spark gap replacement switches [M]. New York:IEEE, 2006.
[7] S D Arthur, V A K Temple. Special 1400 volt N-MCT designed for surge applications [Z].
[8] A Welleman, W Fleischmann. High current, high di/dt semiconductor devices for single and repetitive pulse applications [M]. New York:IEEE, 2003.
[9] I V Grekhov, T T Mnatsakanov, S N Yurkov, A G Tandoev,L S Kostina. tatic and dynamic characteristics of an MOSControlled high-power integrated thyristor [J]. Technical Physics, 2005, 50(7):896-903.
[10] D D Wang, K F Liu, J Qiu. Investigation on the Performance of Thyristors for Pulsed Power Applications[J]. IEEE Transactions on Dielectrics and Electrical Insulation, 2012, 19(2):623-631.
[11] 李学宁,唐茂成,李肇基,李原,刘玉书. MOS控制晶闸管的三重扩散工艺研究[J]. 电子学报,1996,(5):63-66.
