非制冷型中长波铟砷锑探测器*
2014-09-19高玉竹龚秀英吴广会冯彦斌
高玉竹,洪 伟,龚秀英,吴广会,冯彦斌
(1.同济大学电子与信息工程学院,上海 201804;2.陕西华星电子工业公司,西安 712099)
1 引言
非制冷型红外光子探测器具有高速响应、体积小、可靠性好的优点,这对于许多特殊领域中的应用是非常吸引人的。目前,在5~12 μm波长范围,主要使用的光子探测器是制冷型的Ⅱ-Ⅵ族的HgCdTe(碲镉汞)探测器。但是,由于材料生长过程中的高Hg(汞)蒸汽压,HgCdTe晶体还存在着结构完整性差、合金组份不均匀等缺点。而工作在这一波段的热探测器,虽然近年来其性能得到了改善,但是其响应速度仍然比光子探测器慢3个数量级以上。
Ⅲ-Ⅴ族InAsSb三元合金具有高温工作特性好、高电子和空穴迁移率、良好的化学稳定性和机械强度等优点,因此InAsSb材料的生长和特性及其研制长波红外光电器件的前景在国际上引起了极大的兴趣[1]。但是,波长6.5 μm以上的InAsSb外延层与二元化合物衬底之间的晶格失配度较大(与InAs之间的晶格失配度> 6 %,与GaAs之间的晶格失配度为7.2~ 14.6 %)。因此,用常规技术很难生长出高质量的中长波InAsSb单晶材料。国外用分子束外延(MBE)[2]、金属有机化学气相淀积(MOCVD)[3]及液相外延(LPE)[4]技术生长出了8~12 µm波段的InAsSb薄膜,外延层的厚度约为2~10 µm,由于薄的外延层严重受到较大晶格失配的影响,导致这些薄膜中的位错密度高达107cm-2量级,降低了探测器的最终性能。
我们用熔体外延(melt epitaxy,简称ME)法在InAs及GaAs衬底上生长了长波InAsSb厚膜单晶[5~10]。外延层的厚度达到数十至100 µm,这个厚度有效地抑制了外延层与衬底之间晶格失配的影响,从而使外延层中的位错密度下降到104cm-2量级,提高了材料的晶体质量。本文用ME法在InAs衬底上生长的InAs0.05Sb0.95厚外延层,制作了非制冷型、2~9 µm波段响应的光导型探测器。室温下,浸没型InAsSb探测器的光谱响应特性显示,在波长6.5 µm处的峰值探测率Dλp*达到5.4×109cm·Hz1/2·W-1,在波长8.0 µm处的探测率D*为9.3×108cm·Hz1/2·W-1,在9 µm处的D*为1.3×108cm·Hz1/2·W-1,指示了探测器在红外系统中的可能应用。
2 实验
在液相外延(LPE)生长系统及高纯氢气氛中,在(100)晶向的n-InAs衬底上生长InAsSb外延层。原材料采用99.999 99%的Sb、In及非掺杂的InAs单晶。用熔体外延(ME)法生长InAsSb厚膜单晶的过程见前文[6]。关键点如下:在合适的生长温度(约500 ℃)下,使熔液与衬底接触,然后立即将多余的熔液从衬底上推走。重要的是,在生长温度下,需在衬底表面残留一层熔液,然后将衬底推到液槽尾部的压块下,使这层残留的熔液在压块下以0.5 ℃/min的降温速率降温结晶,生成外延层。外延层的厚度取决于衬底的厚度与石墨舟的衬底槽的深度之差。通常,生长层的厚度可达数十至100 µm。生长后的样品,用Al2O3(三氧化二铝)粉末研磨、抛光,获得平整、镜面光滑的表面。用傅里叶变换红外光谱仪(FTIR,Nicolet Nexus 670)测量了InAsSb材料的吸收光谱。
基于用ME法生长的InAs0.05Sb0.95厚膜,制作了浸没型光导探测器。在器件工艺中,彻底去除了InAs衬底,从而消除了外延层与衬底之间晶格失配的影响。在探测器上安装了Ge浸没透镜。灵敏元的面积为0.05 cm×0.05 cm,用In作电极。
在滨松光子公司,室温下用FTIR光谱仪测试了InAsSb光导型探测器的光谱响应,并用温度为500 K、调制频率为1 200 Hz的标准黑体源校准了探测器的绝对响应率。探测器上的外加偏置电流为10 mA。
3 结果与讨论
图1示出InAs0.05Sb0.95样品的吸收光谱。在图1中,材料的本征吸收边出现在波长8 μm以后。用InAs0.05Sb0.95外延层制作的光导型探测器,在8 μm以后出现了明显的光电响应(见图3)。图2给出 (αhν)2随hν的变化关系,其中α是材料的吸收系数,hν是入射光子能量。在图2中,通过线性拟合,估算出InAs0.05Sb0.95的禁带宽度为0.14 eV。三元合金的吸收带尾现象,可能对从吸收光谱估算的禁带宽度有影响[4]。
表1给出了室温下,浸没型中长波InAs0.05Sb0.95光导探测器的测试性能。表中,Rd是探测器的电阻,S是信号电压,N是噪声电压,S/N是信噪比,R(500 K) 是黑体响应率,D*(500 K) 是黑体探测率,Rλp是波长6.5 µm处的峰值响应率,Dλp*是峰值探测率。黑体D* ≥1.0×109cm·Hz1/2·W-1,峰值探测率Dλp*为2~5×109cm·Hz1/2·W-1。

表1 非制冷型中长波InAs0.05Sb0.95光导型探测器的测试性能
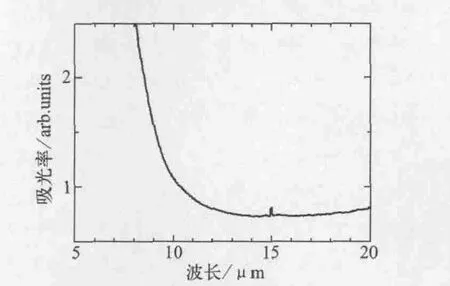
图1 InAs0.05Sb0.95样品的吸收光谱
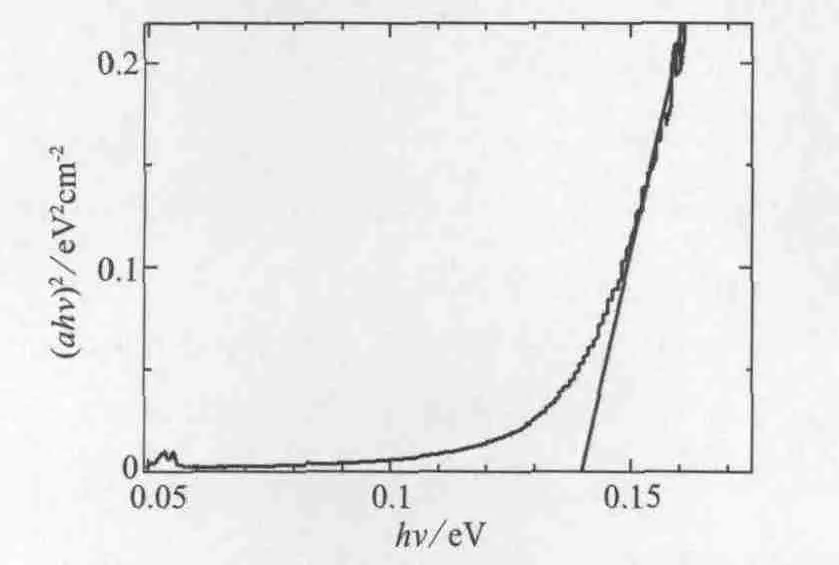
图2 InAs0.05Sb0.95样品的 (αhν)2随 hν的变化关系
图3显示出室温下,浸没型InAs0.05Sb0.95光导探测器(样品编号为A)的光谱响应。探测器A在波长6.5 µm处的峰值响应率Rλp为235.4 V/W,导致峰值探测率Dλp* (6.5 µm,1200 Hz) 为5.4×109cm·Hz1/2·W-1,指示了非制冷型中长波红外光子探测器的高灵敏度。如图3所示,在波长8.0 μm处的探测率D*为9.3×108cm·Hz1/2·W-1,在9.0 μm处的D*为1.3×108cm·Hz1/2·W-1,在3~5 μm及5~8 μm波段的灵敏度较高,在波长8.0 μm以后仍然观察到了明显的光电响应。

图3 室温下浸没型InAs0.05Sb0.95光导探测器A的光谱响应
我们研制的InAsSb光导型探测器,室温下在波长8 μm处的光电响应明显高于美国最近发表的200 K下的Ⅱ-型超晶格InAs/InAsSb光导型探测器[11]。这是由于以下两点原因:(1)我们的探测器上安装了锗浸没透镜,由于入射的红外辐射被透镜聚焦,从而提高了光敏面上的辐射能量密度,浸没透镜使探测器的探测率提高了1个数量级;(2)用熔体外延法生长的窄禁带InAsSb厚膜具有体单晶的性质,由于本征半导体的价带及导带中高的态密度,导致了对红外辐射的强烈吸收,因此更适合制作在室温下工作的中长波光子探测器[12]。
通常,探测器的截止波长被定义在峰值响应的20%处。图3中InAs0.05Sb0.95探测器的截止波长为8.3 µm,对应的禁带宽度为0.149 4 eV。InAsxSb1-x三元合金的禁带宽度Eg与组份x的依存性关系,用式(1)表示[13]:

用这个公式计算出,温度T =300 K下,当x=0.05时,Eg= 0.150 0 eV,这与从探测器的光谱响应测得的禁带宽度0.149 4 eV较为一致。用ME法生长的InAsSb材料的禁带宽度变窄现象,主要是由于As原子结合进了晶格,导致材料的晶格压缩引起的能带弯曲。此外,晶格中原子的不规则排列、三元合金的吸收带尾特性对材料的禁带宽度可能也有影响。
4 结论
基于用ME技术在InAs衬底上生长的InAs0.05Sb0.95厚膜,制作了非制冷型中长波InAsSb光导型探测器,在探测器上安装了锗浸没透镜。探测器的光谱响应得到的禁带宽度,与理论计算得到的禁带宽度基本上一致,证明了InAsSb材料的禁带宽度变窄现象。室温下,浸没型探测器在波长6.5 µm处的峰值Dλp*达到5.4×109cm·Hz1/2·W-1,在波长8.0 µm和9 µm处的D*分别为9.3×108cm·Hz1/2·W-1和1.3×108cm·Hz1/2·W-1,测量结果显示InAsSb探测器具有优良的性能和广阔的应用前景。
[1]Lackner D,Steger M,Thewalt M L W,et al.InAs/InAsSb strain balanced superlattices for optical detectors: Material properties and energy band simulations [J].Journal of Applied Physics,2012,111 (3): 034507-1-034507-8.
[2]Chyi J -I,Kalem S,Kumar N S,et al.Growth of InSb and InAs1-xSbxon GaAs by molecular beam epitaxy [J].Applied Physics Letters,1988,53 (12): 1092-1094.
[3]Kim J D,Wu D,Wojkowski J,et al.Long-wavelength InAsSb photoconductors operated at near room temperatures (200-300 K) [J].Applied Physics Letters,1996,68 (1): 99-101.
[4]Bansal B,Dixit V K,Venkataraman V,et al.Alloying induced degradation of the absorption edge of InAsxSb1-x[J].Applied Physics Letters,2007,90 (10):101905-1-101905-3.
[5]Gao Y Z,Gong X Y,Kan H,et al.InAs1-ySbySingle Crystals with Cutoff Wavelength of 8-12 μm Grown by a New Method [J].Japanese Journal of Applied Physics,1999,38(4A): 1939-1940.
[6]Gao Y Z,Kan H,Gao F S,et al.Improved purity of longwavelength InAsSb epilayers grown by melt epitaxy in fused silica boats [J].Journal of Crystal Growth,2002,234(1): 85-90.
[7]Gao Y,Kan H,Yamaguchi T.The Improvement of Low Temperature Mobility of InAs0.04Sb0.96Epilayers with Cut Off Wavelength of 12.5 μm by Annealing [J].Crystal Research and Technology,2000,35 (8): 943-947.
[8]Gao Y Z,Kan H,Aoyama M,et al.Germanium- and Zinc-Doped P-type InAsSb Single Crystals with a Cutoff Wavelength of 12.5 μm [J].Japanese Journal of Applied Physics,2000,39 (5A): 2520-2522.
[9]Gao Y Z,Gong X Y,Chen Y H,et al.High Quality InAs0.04Sb0.96/GaAs Single Crystals with a Cutoff Wavelength of 12 μm Grown by Melt Epitaxy [J].Proceeding of SPIE,2006,6029: 357-363.
[10]Postava K,Gao Y Z,Gong X Y,et al.Spectroscopic ellipsometry of anodized layer on single crystal InAsSb layer grown by melt epitaxy [J].physica status solidi (c),2008,5 (5): 1316-1319.
[11]Steenbergen E H,Huang Y,Ryou J-H,et al.Structural and optical characterization of type-ⅡInAs/InAs1-xSbxsuperlattices grown by metalorganic chemical vapor deposition [J].Applied Physics Letters,2011,99 (7):071111-1-071111-3.
[12]Piotrowski J,Rogalski A.Uncooled long wavelength infrared photon detectors [J].Infrared Physics &Technology,2004,46: 115-131.
[13]Wieder H H,Clawson A R.Photo-electronic properties of InAs0.07Sb0.93 films [J].Thin Solid Films,1973,15(2): 217-221.
