应用材料公司近期推出全新PVD沉积系统和全新Endura VoltaTM系统
2014-09-17
应用材料公司近期推出全新PVD沉积系统和全新Endura VoltaTM系统
应用材料公司于2014年6月12日在北京召开了媒体见面会,由应用材料中国半导体产品事业部技术总监赵甘鸣博士就应用材料公司新近推出的两款全新系统进行了全面宣讲,从技术角度详细介绍了两款全新系统的创新性和先进性。
1.应用材料公司推出Endura VoltaTMCVD Cobalt系统,是现今唯一一款在逻辑芯片铜互连工艺中能够通过化学气相沉积实现钴薄膜的系统。钴薄膜在铜工艺有两种应用,平整衬垫(Liner)与选择性覆盖层(Capping Layer),将铜互连的可靠性提高了一个数量级。这一应用是15年来铜互连技术材料方面最显著改变。
●全新Endura VoltaTM系统独特的钴制程可减少互连的瓶颈,助力摩尔定律的延续
●钴制程两项突破性互连应用支持下一代高性能、低能耗芯片
●工业界首次应用选择性化学气相沉积(CVD)金属制程,展示了应用材料公司在精密材料工程中的领导地位。
随着摩尔定律的推进,线路尺寸越来越小,减少影响器件工作的空隙与防止电迁移失效就显得更加必要。基于应用材料公司业界领先的精密材料工程技术所建立的Endura Volta系统,可通过提供以CVD为基础的平整衬垫与选择性覆盖层,克服了良率极限,帮助我们的客户将铜互连技术推进到28 nm及以下。

基于Endura Volta CVD系统的钴工艺包括两个主要的工艺步骤。第一步是沉积一层平整的薄钴衬垫膜,相对于典型的铜互连工艺,钴的应用可为有限的互连区域填充铜提供更大的空间。这一步骤通过在同一平台,超高真空下整合预清洗(Pre-clean)/阻挡层(PVD Barrier)/钴衬垫层(CVD Liner)/铜种子层(Cu Seed)制程,以改进器件的性能与良率。
第二个步骤在铜化学机械研磨(Cu CMP)之后,沉积一层选择性CVD钴覆盖膜,改善接触界面,进而提高器件的可靠性,可达到80倍。

2.应用材料公司全新推出Endura VenturaTMPVD系统。该系统沿袭了应用材料公司在业内领先的PVD技术,并融入了公司最新创新成果,能够完成连续薄阻挡层和种子层的硅通孔(TSV)沉积,帮助客户以更低廉的成本制造出更小、功耗更低的高性能集成3D芯片。结合应用材料公司在精密材料工程领域的专业技术,该系统还与众不同地采用了钛作为阻隔材料,从而实现降低成本的目的。Ventura系统的推出进一步完善了应用材料公司的硅片级封装(WLP)设备产品线,适用于硅通孔、再分布层(RDL)和凸块等各类应用。

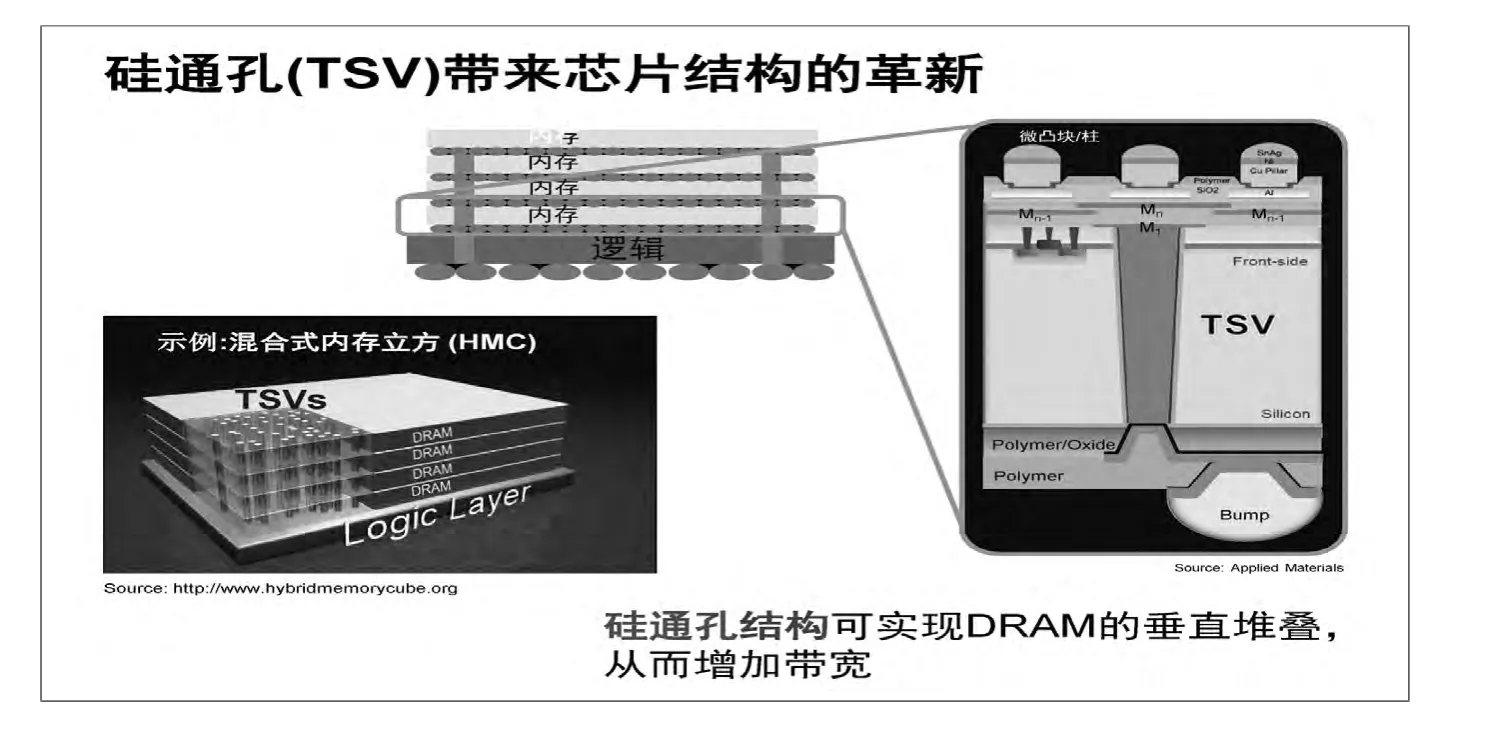
集成3D堆叠设备需要将大于10:1深宽比的TSV互连结构用铜进行金属化。利用创新的材料和先进的沉积技术,全新的Ventura设备可有效解决这一问题,从而显著降低TSV制造成本。
Ventura系统采用更先进的离子PVD技术,确保阻挡层和种子层的完整性,这对实现芯片的可靠间隙填充和互连尤为重要,因而能够有效提高3D芯片的良率。此外,这些技术上的新突破能够显著改善离子的方向性,可在硅通孔中完成均匀连续的薄金属层沉积,从而实现TSV所需的无空隙填充。由于方向性的改善,沉积速率得以大幅提高,同时还能显著减少阻挡层材料和种子层材料的用量。此外,Ventura系统采用钛作为阻挡材料,可提高设备稳定性,降低TSV金属化过程中的整体成本。

