高频硅PNP晶体管3CG120高温失效机理研究
2012-08-14王立新单尼娜宋李梅韩郑生
王立新,单尼娜,夏 洋,宋李梅,韩郑生
(中国科学院 微电子研究所,北京 100029)
失效分析的目的是通过总结失效现象,分析失效模式,研究其失效原因和失效机理,为器件的可靠性设计,工艺改进及可靠性增长提供有益的信息。
电子器件有时需要在宇宙空间中运行的卫星、火箭等高温、高辐射等极端条件下使用,条件非常恶劣,超出了正常使用温度范围。并且,随着技术的进步,对电子器件所要求的可靠寿命也越来越长。这就使得研究器件高温特性和高温下的退化特性,分析其高温下的失效机理及失效原因,从而保证器件在各种温度条件下正常工作具有重要意义。
文中使用温度斜坡法[1-4],对样品硅PNP型晶体管3CG120进行170~340℃温度范围内序进应力加速寿命试验,得到样品在不同温度下电流增益、击穿电压、反向漏电流等电参数的退化规律。并通过对不同电参数退化规律的分析,初步分析在不同温度范围内的样品失效机理。
1 试 验
为了研究样品3CG120在高温下的失效模式,失效机理等,文中对样品3CG120进行序进应力加速寿命试验,试验条件及测试参数如表1所示。

表1 3CG120的序进应力加速寿命试验的试验条件及测试参数Tab.1 Experiment conditions and test parameters of process stress accelerated life test
2 结果与分析
试验的样本量为3支,在Tj=170~340℃温度范围内,试验样品372#、373#、374#表现出的退化规律比较一致。测试数据hFE如图1所示。
如图1,参数 hFE的退化过程可分为 A、B、C、D 4段。各温度段内参数的退化规律如表2所示。
分析各参数的退化规律,直流增益hFE仍然是第一位的失效敏感参数,下面从理论上分析其退化机理,同时,参照其他参数的变化规律对其进行分析。

图1 序进应力下,3CG120的敏感参数hFE的退化曲线Fig.1 Degenerate curve of hFE under progress-stress condition

表2 3CG120各参数的退化规律Tab.2 Degradation laws of parameters of 3CG120

式中,IC、IB分别为收集极、基极电流。
根据半导体物理关于PN结的理论可知:PN结的正向电流由扩散电流和复合电流Ire两部分组成。当晶体管工作在有源放大区时,发射结势垒区内存在着净复合,这股复合电流的表达式为:

式中:xm为发射结耗尽层厚度;AJ为发射结面积;VE为正向电压。
由(2)式可知,复合电流Ire和耗尽区的体积 xmAJ成正比;由(1)式可知,直流增益与复合电流成反比。当存在表面电场时,就会影响耗尽层总的体积,从而影响到发射结正向电流中复合电流的成分变化,进而影响直流增益hFE的大小。
根据文献[5],pn结总的反向电流IR为:

式中 ,Igen,MJ为 结 耗尽 区 中形成 的产生电 流 ;Igen,FIJ为 栅 电极下的表面耗尽区产生电流;Igen,s为Si-SiO2界面陷阱引起的产生电流。
下面结合试验情况对样品的失效机理进行分析。
第1段:175~240℃,在进行序进应力加速寿命试验时,发射结通过正向大电流,由于基区浓度远小于发射区浓度,故正向电流主要由空穴组成。这些空穴通过发射结耗尽层时形成正的空间电荷,这种正空间电荷在发射结Si-SiO2界面形成的电场,将排斥SiO2层中的可动正离子趋向远离Si-SiO2界面。故可动正离子会被排斥到SiO2上表面,相当于在SiO2上表面加一负电场VGBE,如图2所示。试验过程中的温度上升会促使正离子的这种运动,而且时间愈长在正离子在SiO2上表面堆积愈多,也即相当于VGBE愈大,这将使基区表面从堆积到耗尽。集电结也通过反向空穴大电流,在集电结耗尽层Si-SiO2界面形成相对于SiO2层的正向电场,排斥SiO2层中的可动正离子趋向远离Si-SiO2界面,使集电结基区表面逐渐耗尽,集电区表面逐渐堆积。
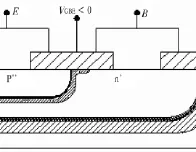
图2 第一个温度段(170~240℃)BE结剖面示意图Fig.2 Profile of BE contact of first temperature range
随着温度的升高,发射结基区耗尽层逐渐扩展,表面复合电流也逐渐增加,导致基极电流IB随之增加。由公式(1)可得,hFE随着试验的进行在第一个温度段(170-240℃)逐渐下降如图1所示。
而由于IEBO的测试条件是反向电压2 V,2 V反压造成的耗尽层宽度大于表面感应耗尽层的宽度,故表面耗尽层的变化没有影响到ICEO的大小,如图3所示。而ICBO的测试条件是反向电压10 V,由于集电结基区表面耗尽,集电区表面堆积,对漏电流影响不大,故ICBO在此温度段变化也不大,如图4所示。
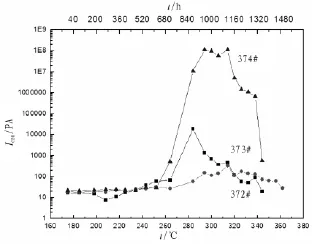
图3 序进应力下,3CG120的敏感参数ICEO的退化曲线Fig.3 Degradation curve of ICEO of 3CG120 under process stress
击穿电压BVCEO、BVCBO形成的耗尽层都大大超过试验条件下产生表面耗尽层的宽度,故在本温度段耗尽层的变化不能影响BVCEO、BVCBO,即二者在此温度段变化不大,如图5所示。

图4 序进应力下,3CG120的敏感参数ICBO的退化曲线Fig.4 Degradation curve of ICBO of 3CG120 under process stress

图5 序进应力下,3CG120的敏感参数BVBE的退化曲线Fig.5 Degradation curve of BVBE of 3CG120 under process stress
第2段:240~290℃,进入第二段后,温度达到240℃以上,结温达到270℃以上,集电区掺杂密度为1 015。在此条件下,集电区产生本征激发,出现大量热电子、空穴,在反向偏压VBC及第一段积累形成的VGBC的作用下,BC结上方Si-SiO2界面发生热空穴注入[5],SiO2界面中空穴的积累,将导致集电区表面耗尽。而ICBO随温度上升指数增加[6],同时由于集电区本征激发产生的大量电子及集电结耗尽层的增加,进一步加大了ICBO。在试验条件下,过大的ICBO大大超过了IB,造成大量电子在基区堆积,使基区电位下降,与发射区形成正向压降,降低发射结势垒,基区大量电子扩散过发射结。此时,发射结电流不再主要由空穴组成,而由电子、空穴共同组成,即空穴在发射结Si-SiO2界面形成的电场被抵消。这就导致在高温下,发射结SiO2层中的可动正离子将逐渐恢复正常分布,从而使第二段hFE恢复到正常值附近如图1所示。
在此温度段,发射结空穴注入,并在SiO2界面处形成堆积,使集电结基区表面耗尽层逐渐消失,集电区表面逐渐耗尽。由于集电结表面耗尽层的增大,由公式(3)可知,栅电极下的表面耗尽区产生电流Igen,FIJ和Si-SiO2界面陷阱引起的产生电流Igen,s都大大增加,从而导致了ICBO的大大增加,如图4所示。
击穿电压BVCEO、BVCBO形成的耗尽层都大大超过试验条件下产生表面耗尽层的宽度,故在本温度段耗尽层的变化不能影响BVCEO、BVCBO,即二者在此温度段变化不大。
第3段:290~340℃,随着温度继续升高,BC结上方Si-SiO2界面热空穴持续注入,在SiO2界面空穴继续堆积,使集电区表面反型,如图6所示。欧姆接触的金属Al离子开始融入发射结,造成结损伤,使hFE重新下降。
在这一试验温度段,漏电流ICBO和ICEO出现了围绕初始值减小的现象,如图3、图4。分析认为:BC结表面出现反型层,由于失掉了Si-SiO2界面处复合中心,所以反向电流变成了:IR=Igen,MJ+Igen,FIJ,所以反向电流相对于第二温度段(240~290 ℃)的反向电流大大减小,但仍大于Igen,MJ。
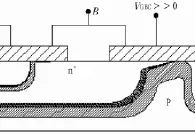
图6 第3个温度段(290~340℃)结剖面示意图Fig.6 Profile of contact of the third temperature range
第4段:340℃-,试验温度在340℃之后,直流增益hFE表现出迅速减小的现象。使得该电流骤增,造成发射结局部发生不可逆的损伤,直流增益hFE迅速减小。同时造成了漏电流IBEO迅速增大,而击穿电压BVBEO快速减小的退化现象,如图5所示。
3 结 论
文中通过对硅PNP型晶体管3CG120进行170~340℃温度范围内序进应力加速寿命试验,对3CG120在不同温度段的失效机理进行了研究,发现在170~240℃温度段内,样品的失效机理是:发射结中通过的正电荷,排斥SiO2层中的可动正离子趋向远离Si-SiO2界面,这将使基区表面从堆积到耗尽,导致复合电流增大,而引起增益的下降。
而在240~290℃温度段内,集电区产生本征激发,出现大量热电子、空穴,在反向偏压VBC的作用下,BC结上方Si-SiO2界面发生热空穴注入,导致增益改变;在290~340℃温度段内:BC结上方Si-SiO2界面热空穴持续注入,在SiO2界面空穴继续堆积,使集电区表面反型,导致增益的迅速下降。与室温失效机理一致的范围为:室温至240℃。
[1]Pasco R W,Schwarz J A.Temperature-ramp resistance analysis to characterize electromigration[J].Solid-State Elec-tronics,1983,26(5):445-452.
[2]NelsonWB.Acceleratedlifetesting-step-stressmodelsand data analysis[J].IEEE Trans,Reliability,1980,R-29(2):103-108.
[3]LI Zhi-guo,SONG Zeng-chao,CHENG Yao-hai.A study on GaAs FET’s failure mechanism and experimental technology of rapid evaluation of reliability[J].Reliability Physics Symposium Proceedings.2003 IEEE International,2003:576-577.
[4]ZHANG Wan-rong,LI Zhi-guo,MU Fu-chen.A rapid evaluation method for degradation activation energy of n-GaAs ohmic contacts with and without TIN diffusion barrier layers[C]//Proceedings of 8 IPFA,2001:134-137.
[5]郭维廉.硅-二氧化硅界面物理[M].北京:国防工业出版社,1989.
[6]高光渤,李学信.半导体器件可靠性物理[M].北京:科学出版社,1987.
