双AlN插入层法在Si图形衬底上进行AlGaN/GaN HEMT的MOCVD生长
2011-09-18王勇余乃林王丛舜刘纪美
王勇,余乃林,王丛舜,刘纪美
(1.长春理工大学 高功率半导体激光国家重点实验室,长春 130022;2香港科技大学 电子及计算机工程系 光电子中心,香港)
GaN基宽禁带化合物半导体材料,被广泛应用于光电子器件,高功率微波器件及高温电子器件等领域,并以其优越的电子、机械及化学特性,在微机电系统(MEMS)领域引起了广泛兴趣[1-2]。GaN材料以其较宽的带隙、大的弹性模量、高的压电系数,以及好的化学稳定性,已经成为一种理想的用于环境探测的微传感器[1-3]。AlGaN/GaN高迁移率晶体管(HEMT)由于其高的电子迁移率和高的击穿电压,在微波功率器件和微传感器方面展示了优越的特性。
降低HMET生产成本的方法之一是尽可能使用成熟的Si基技术。然而,和蓝宝石、SiC衬底相比,在Si衬底上生长GaN薄膜面临着巨大的挑战,因为在GaN和Si之间存在着大的晶格失配和热失配,尤其是56%的热膨胀系数通常会导致Si衬底上生长的GaN薄膜在降温时产生大量裂纹,这严重影响了器件的应用[4-5]。另外,Si衬底上的不规则图形也会使应力状态变差,导致更多裂纹的形成。
许多技术已经被尝试用来消除外延生长的GaN薄膜表面的裂纹。在Si衬底上制备规则方块图形,以及在GaN外延层中插入单AlN插入层法,可释放张应力,减少裂纹[6]。本文采用双AlN插入层法,在Si(111)不规则图形衬底上进行AlGaN/GaN HEMT的MOCVD外延生长,以减小应力和消除GaN薄膜表面的裂纹,以达到HEMT器件在MEMS领域的有效应用。
1 实验
在本实验中,Si图形衬底采用SiO2掩膜和湿法腐蚀(无掩膜)两种方法进行制备。对于SiO2掩膜情况,GaN只能在非掩膜区的Si表面外延生长。AlGaN/GaN HEMT采用MOCVD外延生长,衬底为没有图形(平面衬底)、湿法刻蚀图形、SiO2掩膜图形的Si(111)衬底。
在GaN生长之前,Si衬底上先1150℃高温生长20nm AlN成核层,然后再1160℃生长1μmGaN缓冲层。为了比较插入层个数对GaN外延层应力的影响,单AlN插入层和双AlN插入层分别插入此1 μmGaN缓冲层,AlN插入层的生长温度为960℃,生长厚度为20nm,两种生长结构如图1(a)和1(b)所示。最后,在1μmGaN缓冲层上面进行HEMT结构外延生长,HEMT结构包括2nm非掺的AlGaN空间层,15nm Si掺的AlGaN调制掺杂层,和3nm非掺的AlGaN盖层。

图1 HEMT结构简图Fig.1 The schematic figure of the HEMT structure with
双晶X射线衍射(XRD)、光学显微镜、扫描电子显微镜(SEM)、微拉曼测试、以及水银探针电容-电压(C-V)测试等用来表征GaN薄膜的质量、应力、表面形貌以及异质结界面等信息。AlN和GaN层的厚度是通过一种薄膜测量装置(Filmetrics)进行原位监测,光源采用600nm激光源。
2 结果和分析
高温AlN作为成核层用来初始化GaN外延生长。AlN成核层可以降低GaN外延层中的失配位错,并通过成核过程中岛的聚合控制GaN的内部应力,从而补偿张应力[6-7]。
AlN插入层则是用来减少在GaN外延生长过程中引进来的张应力。当1μmGaN外延层中只有单AlN插入层时,结构如图1(a)所示,样品表面会产生大量裂纹,如图2(a)、2(b)和2(c)所示。这说明单AlN插入层不足以提供足够的压应力,以致于大的张应力通过形成裂纹的方式释放出来。

图2 Si衬底上生长HEMT样品的光学显微镜照片Fig.2 The microscope images of HEMTs grown on Si substrates
为了更好的释放张应力和消除裂纹,在1μ mGaN外延层中插入了双AlN插入层,如图1(b)所示。通过在1μmGaN外延层中插入了双AlN插入层,所生长的样品表面光滑闪亮,无裂纹,光学显微镜照片如图2(d)和图4(a)-(d)所示。这说明双AlN插入层可以有效的释放张应力,消除了由于张应力的存在而产生的裂纹。
图3(a)和(b)分别比较了无图形Si衬底上生长的1μmGaN外延层的XRDw扫描的GaN(0002)和GaN(10-12)半高宽,比较结果如表1所示。其中样品A结构为1μmGaN外延层中无AlN插入层,样品B结构为1μmGaN外延层中插入单AlN插入层,样品C结构为1μmGaN外延层中插入双AlN插入层。结果显示随着AlN插入层的增加,GaN的半高宽也增加,这说明AlN插入层的增加可以有效的降低GaN外延层的张应力,但却牺牲了GaN外延层的生长质量。

表1 1μmGaN外延层中无AlN插入层、有单AlN插入层和有双AlN插入层的XRD w扫描比较结果Tab.1 The comparison of XRD results

图3 1μmGaN外延层中无AlN插入层、有单AlN插入层和有双AlN插入层的XRD w扫描结果Fig.3 The XRD results of the HEMT structures without AlN interlayer,with single AlN interlayer and with double AlN interlayer.
图4展示了采用双AlN插入层方法在Si图形衬底上生长的无裂纹HEMT样品表面的光学显微镜照片。如图4(c)所示,对于SiO2掩膜图形Si衬底上生长的HEMT样品,在样品表面较大的掩膜台面区上,存在着大块黑色的不定形GaN,这是由于Ga和N吸附原子的扩散长度远小于掩膜台面区的长度,以致于这些吸附原子没有充足的能量占据合适的晶格位置,结果在这些大的掩膜台面区生成了不定形GaN。而对于湿法刻蚀Si图形衬底上生长的HEMT样品,没有观测到不定形GaN。

图4 采用双AlN插入层法在Si图形衬底上生长的HEMT样品表面的光学显微镜照片Fig.4 The microscope images of the patterns of the HEMTs with double AlN interlayers grown on Si.
在使用优化的双AlN插入层之前,在HEMT样品表面会观察到很多的裂纹,如图2(a)-(c)所示。尤其对于生长在图形衬底上的HEMT样品,在沿[1-100]方向比沿[11-20]方向观察到了更多的裂纹,这是由于GaN(1-100)面比GaN(11-20)面更稳定[8]。见于此,我们在Si衬底上沿着这两个方向制备了条形图案。图5展示了沿[1-100]和[11-20]方向生长的HEMT样品的SEM照片,在沿[1-100]方向观察到了很多裂纹,而在沿[11-20]方向却没有。建议在图形设计中,长边应沿着[11-20]方向进行制备,如此在GaN(1-100)面制备得到的条形图案有助于抑制裂纹的形成。
图6展示了一个图形上不同位置的GaN薄膜的拉曼峰位置。从图中可以看出,在图形凹角处GaN拉曼峰位置为564.5cm-1,在图形凸角处GaN拉曼峰位置为565.5cm-1,而对于应力完全释放的GaN拉曼峰位置为568cm-1,如此可以计算出在图形凹角处和在图形凸角处GaN拉曼位移分别为3.5cm-1和2.5cm-1。因此,可以认为在图形凹角处比在图形凸角处有更大的GaN拉曼位移,说明在图形凹角处有更大的张应力。然而,在一处有裂纹的图形凹角处的GaN拉曼峰位置为565.1cm-1,大于其它没有裂纹的图形凹角处的GaN拉曼峰位置,如图5所示,这是由于裂纹使该凹角处的部分应力得到释放。

图5 沿[1-100]和[11-20]生长的HEMT样品的SEM照片(250倍)Fig.5 SEM photos of the patterns along the[1-100]and[11-20]orientations under the magnification of 250
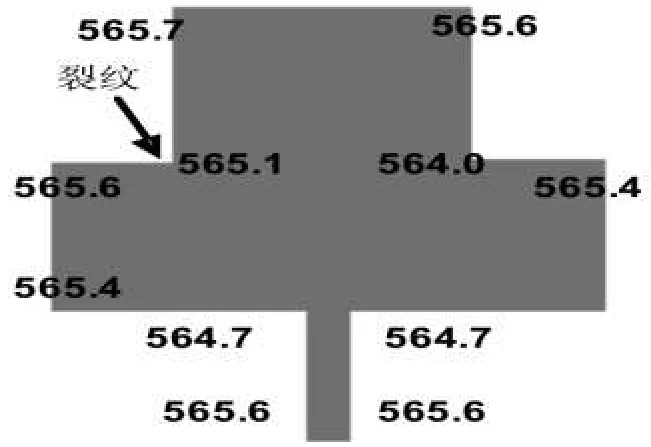
图6 一个图形上不同位置的GaN薄膜的拉曼峰位置Fig.6 Raman peak positions of the pattern at the concave corners and convex corners.

图7 采用双AlN插入层生长的HEMT样品的C-V测试曲线Fig.7 The C-V results of the HEMT structure with double AlN interlayer
图7展示了采用双AlN插入层生长的HEMT样品的水银探针电容-电压(C-V)测试曲线。如图所示,HEMT器件的阈值电压为-3.5V,电容最大和最小的比值近似为20。在阈值电压时陡峭的电容变化曲线暗示外延得到了较好的GaN/AlGaN异质界面。
3 结论
通过采用双AlN插入层法,在非图形和图形Si(111)衬底上获得了无裂纹的AlGaN/GaN HEMT结构。双AlN插入层可有效的释放张应力,但却牺牲了GaN外延层的生长质量。
由于GaN(1-100)面比GaN(11-20)面更稳定,因此在生长过程中沿[1-100]方向比在沿[11-20]方向更容易产生裂纹。对于在图形衬底上生长的HEMT样品,在同一个图形的不同位置上,凹角处比凸角处有更大的GaN拉曼位移,说明在图形凹角处有更大的张应力。水银探针C-V测试曲线暗示外延得到了较好的GaN/AlGaN异质界面。
[1]Pearton S J,Zoper J C,Shul R J,et al.GaN:processing defect,and devices[J].Appl Phys,1999,86(1):1-78.
[2]Pearton S J,Kang B S,Kim S,et al.GaN-based diodes and transistors for chemical,gas,biological and pressure sensing[J].J Phys:Condens Matter,2004,16(29):961-994.
[3]Han S,Jin W,Tang T,et al.Controlled growth of gallium nitride single-crystal nanowires using a chemical vapor deposition method[J].J Mater Res,2003,18(2):245-249.
[4]Katona T M,Speck J S,Denbaars S P.Effect of the Nucleation Layer on Stress during Cantilever Epitaxy of GaN on Si(III)[J].Phys Stat Sol(a),2002,194(2):550-553.
[5]Krost A,Dadgar A.GaN-based optoelectronics on silicon substrates[J].Materials Science and Engineering.2002,B93:77.
[6]Zhang B S,Liang H,Wang Y,et al.High-performance III-nitride blue LEDs grown and fabricated on patterned Sisubstrates[J].Journal of Crystal Growth,2007,298:725-730.
[7]Wang Y,Yu N S,Deng D M,et al.Improved breakdown voltage of AlGaN/GaN HEMTs grown on Si substrates using partially Mg-doped GaN buffer layer by MOCVD[J].SCIENCE CHINA,Physics,Mechanics& Astronomy,2010,53(9):1578-1581.
[8]Nitta S,Kashima T,Kariya M,et al.Mass transport,faceting and behavior of dislocations [J].GaN MRS Internet J Nitride emicond Res,2000,5S1:W2.8.
