等离子体刻蚀建模中的电子碰撞截面数据*
2024-05-13陈锦峰朱林繁
陈锦峰 朱林繁
(中国科学技术大学近代物理系,合肥 230026)
半导体芯片是信息时代的基石,诸如大数据、机器学习、人工智能等新兴技术领域的快速发展离不开源自芯片层面的算力支撑.在越来越高的算力需求驱动下,芯片工艺不断追求更高的集成度与更小的器件体积.作为芯片制造工序的关键环节,刻蚀工艺因此面临巨大的挑战.基于低温等离子体处理技术的干法刻蚀工艺是高精细电路图案刻蚀的首选方案,借助等离子体仿真模拟,人们已经能够在很大程度上缩小实验探索的范围,在海量的参数中找到最优工艺条件.电子碰撞截面是等离子体刻蚀模型的关键输入参数,深刻影响着模型预测结果的可靠性.本文主要介绍了低温等离子体建模的基本理论,重点强调电子碰撞截面数据在数值模拟中的重要作用.与此同时,本文概述了获取刻蚀气体截面数据的理论与实验方法.最后总结了刻蚀相关原子分子的电子碰撞截面研究现状,并展望了未来的研究前景.
1 引言
刻蚀(etching)是半导体芯片制造流程中的重要工艺环节.芯片制造的第一步是加工得到晶圆(wafer),即单晶硅圆片.晶圆经历氧化、光刻(photolithography)、刻蚀、薄膜沉积、掺杂、互连、测试、封装等几百道复杂且精细的工序后,才能成为最终的成品芯片.在整个流程中,刻蚀这一环节可多达上百次.可以看到,刻蚀是和光刻紧密结合的一道工序.形象地说,光刻技术是利用光束将掩模版上的电路图“画”到涂有光刻胶的晶圆表面上,而刻蚀则是在晶圆表面按特定方式去除氧化膜等材料,将画好的电路图“刻”入晶圆表面[1,2].因此,刻蚀工艺对集成电路的制造至关重要——刻蚀图案的精细程度直接影响集成电路器件的尺寸和性能,刻蚀速率、选择性、关键尺寸、均匀性等也是半导体产业所追求的关键指标.
从1958 年第一块集成电路问世开始,刻蚀工艺就支撑着集成电路产业的发展.早期的刻蚀方法是所谓的湿法刻蚀(wet etching),即利用化学溶液(例如氢氟酸溶液)溶解基底上的特定材料,达成刻蚀的目的.在20 世纪60 年代,湿法刻蚀以其刻蚀速率快、选择性好、产率高、成本低等优势获得了人们的青睐.但是,湿法刻蚀具有各向同性的特点[1-4],即在纵向与横向具有相同的刻蚀速率,使得刻蚀后的氧化膜不能与光刻胶(掩膜版)完全对齐,导致刻蚀电路失真,见图1.在20 世纪70 年代左右,随着摩尔定律[5]的预言成为现实,集成电路的集成度越来越高,在微米甚至亚微米级的集成电路制造中,各向同性的湿法刻蚀逐渐难以胜任高精细电路图案的处理工序.与此同时,一种新的刻蚀工艺——干法刻蚀(dry etching)应运而生.
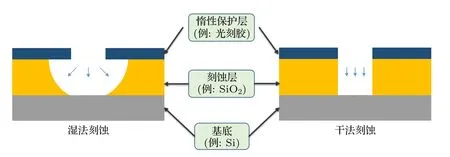
图1 湿法刻蚀(各向同性)与干法刻蚀(各向异性)示意图Fig.1.Schematic diagram of wet etching (isotropic) and dry etching (anisotropic).
干法刻蚀使用等离子体作为刻蚀剂,因此又称等离子体刻蚀(plasma etching).干法刻蚀的机制主要分为三类[3,4,6-8]: 1) 纯化学反应刻蚀.等离子体中的活性自由基(例如HF 或F)可以与晶圆表面特定材料(例如SiO2或Si)发生化学反应,生成易挥发的产物(SiF4气体或SiF 等前体反应物),推动刻蚀进程.与湿法刻蚀类似,纯化学反应没有优先的刻蚀方向,因此刻蚀轮廓是各向同性的;2) 纯物理溅射刻蚀.利用等离子体中的正离子(例如Ar+)轰击晶圆表面产生的溅射效应,可以去除薄膜材料,达成刻蚀效果.物理刻蚀是各向异性的,因为离子可以垂直晶圆表面加速,几乎只沿着纵向撞击晶圆,导致纵向刻蚀速率远大于横向刻蚀速率;3) 反应离子刻蚀(reactive ion etching).反应离子刻蚀结合了化学反应速率快与物理溅射各向异性两大优势.在刻蚀过程中,离子沿纵向轰击基底,在溅射刻蚀的同时大幅度增加活性自由基与刻槽底面的化学反应速率,有利于形成与基底垂直的刻槽结构.反应离子刻蚀在很大程度上推动了干法刻蚀工艺的进步,为干法刻蚀取代湿法刻蚀奠定了坚实的技术基础.早在20 世纪70 年代末,人们就认识到了反应离子刻蚀的优越性[6],干法刻蚀开始逐渐取代湿法刻蚀,成为超大规模集成电路制造中刻蚀高精细电路图案的首选工艺[3,4].时至今日,干法刻蚀已经发展成为了半导体芯片制造产业中不可或缺的关键技术[1,2,8].
干法刻蚀技术的产生与发展,对深刻理解刻蚀用等离子体中发生的基本物理化学过程提出了新的要求[3,4,6,8,9].由于等离子体中的物理化学反应是驱动刻蚀进程的内在动力,因此充分认识相关反应过程,是增强刻蚀系统的可控性、优化系统输入参数、提高刻蚀质量的必要前提.然而,在实际的干法刻蚀工艺腔室中,不同位置、不同尺度的物理化学反应相互耦合,导致发生的过程极为复杂.干法刻蚀用等离子体属于低温等离子体(low-temperature plasma),也称非平衡等离子体,特征是电子温度远大于离子温度[2,8],且电离度很低(小于10-3).在低温等离子体中,电子从外部电磁场获得能量,通过碰撞将能量传递给其他粒子,经过一系列复杂的物理化学反应后,最终产生大量的电子、离子、激发态原子分子、解离自由基等活性粒子,为刻蚀晶圆基底提供物质条件.根据低温等离子体的产生和控制方式的不同,目前广泛使用的干法刻蚀工艺可以大致分为三类[1,2,8]: 电容耦合等离子体(capacitively coupled plasma,CCP)、电感耦合等离子体(inductively coupled plasma,ICP)和电子回旋共振等离子体(electron cyclotron resonance,ECR).CCP 通过射频源供能,主体类似于平行板电容器,射频电源与平行板相接,在板间产生周期性变化的纵向电场,电子在电场中获得能量导致板间气体放电,从而产生等离子体.ICP 也是利用射频源供能,不同的是ICP 的电源接在线圈上,线圈中的射频电流在腔室中产生急剧变化的感应磁场,进而诱导出涡旋电场为电子加速.由于能量传递机制类似于两个电感线圈相互耦合形成的变压器,有时ICP 又被称为变压器耦合等离子体(transformer coupled plasma,TCP).ECR 则是基于电子在磁场中的回旋频率与微波电场频率相匹配时的共振加速现象,利用高频微波源供能产生等离子体.
在不同的干法刻蚀工艺中,等离子体内部及晶圆表面发生的物理化学过程是类似的,图2 展示了基于ICP 腔室的干法刻蚀工艺.为了方便讨论,原料气体为单一成分的CHF3,刻蚀材料为Si 基底上的SiO2薄膜.需要强调的是,图2(a)中等离子体与晶圆表面间存在的鞘层(sheath)结构是产生各向异性刻蚀轮廓的关键[1,2,4,8,9].由于低温等离子体中的电子运动速度远大于离子运动速度,电子会首先运动到晶圆表面,造成晶圆表面的负电荷累积,从而产生相对等离子体的低电势.表面电荷会排斥电子而加速离子,当两者到达表面的电流相同时电荷不再累积,达到平衡状态,此时等离子体边界与晶圆表面之间的薄层区域形成了稳定的电势差,称为直流自偏压(DC self-bias voltage),该薄层区域即为鞘层,厚度在微米至毫米量级.因此,除了铜线圈在等离子体内部产生的涡旋电场外,鞘层区域还有指向晶圆表面的电场,正离子在电场作用下定向加速轰击晶圆表面,促进各向异性刻蚀.相应地,除了激励电源外,可以在晶圆处放置另一射频电源,用于控制鞘层电压进而控制离子轰击能量,实现离子能量与密度的去耦合.图2(c)列出了等离子体内部与晶圆表面发生的主要物理化学反应.在涡旋电场的激励下,部分原料气体CHF3放电,产生快速运动的自由电子,电子与中性的CHF3分子发生弹性和非弹性碰撞,其中非弹性碰撞可分为激发和电离,生成激发态分子和离子,处于激发态的分子或离子有可能发生进一步解离,进而生成中性自由基、离子碎片等产物,所有这些产物共同构成了低温等离子体.

图2 (a)以CHF3 为原料气体的ICP 刻蚀腔室(作图参考了文献[12]),匹配器用于匹配电源输出阻抗与等离子体阻抗,红色与蓝色线条分别代表磁场与电场,鞘层区域的偏压可以将离子加速到几百eV,高能离子垂直轰击表面导致各向异性刻蚀.使用两个射频源,可实现离子密度与能量的去耦合: 上方电源通过电感耦合供能,可以控制离子密度;下方电源通过电容耦合调节鞘层偏压,可以控制离子的轰击能量;(b) 表面刻蚀部分,CmFn 聚合物的钝化效应有助于各向异性刻蚀;(c) 等离子体内部及晶圆表面发生的主要物理化学过程Fig.2.(a) ICP etching chamber with CHF3 as feed gas (this picture was made with reference to Ref.[12]),the matching device is used to match the output impedance of the power supply and the plasma impedance,the red and blue lines represent the magnetic and electric fields respectively,the bias voltage in the sheath region can accelerate the ions to several hundred eV,and the high energy ions can vertically bombard the surface,leading to anisotropic etching.Using two RF sources,the decoupling of the ion density and energy can be achieved: the upper power supply can control the ion density through inductive coupling;the lower power supply can control the ion bombardment energy by adjusting the sheath bias through capacitive coupling.(b) The surface etching part,the passivation effect of CmFn polymer contributes to anisotropic etching.(c) The main physical and chemical processes that occur inside the plasma and on the wafer surface.
如图2(b)所示,在晶圆表面,F/HF 会与SiO2或Si 反应生成易挥发的SiF4,与此同时CFx等自由基可以沉积形成聚合物[8,10-13].在刻蚀轮廓的侧面,沉积受刻蚀的影响较小,聚合物薄膜形成所谓的“钝化层”(passivation layer),阻止反应的发生[8,12].刻蚀轮廓底面的情形则有所不同,经过鞘层偏压加速的高能离子轰击底面,不仅能通过溅射过程刻蚀材料,还有抑制聚合物的产生、通过断开C—F 键提供F 原子、帮助反应产物从表面扩散释放等作用,进而增大化学刻蚀速率[8,10].此外,对SiO2而言,高能离子轰击产生的O 原子会与CFx反应生成易挥发的CO,CO2,COF2等产物,进一步抑制聚合物薄膜形成,使SiO2的刻蚀速率大于Si 的刻蚀速率[11,12].除上述反应过程外,腔室中还有电子贴附解离、超弹性散射、离子碰撞、电子-离子复合、二次电子发射等其他过程.由以上介绍可见,干法刻蚀工艺腔室是一个多时空维度、多反应层级、高复杂度的非线性系统,涉及电动力学、原子分子物理、等离子体物理/化学、流体力学、分子动力学、表面物理/化学等学科.相应地,干法刻蚀过程可以概括为系统在腔室结构(形状、尺寸)和材料(电极、器壁、晶圆基底)参数、电源参数(电压、功率、频率)、原料气体参数(组分、气压、流量)等输入参数的控制下,经过内部反应的处理,最终输出晶圆的刻蚀参数(刻蚀轮廓、速率、选择性、精度、均匀性等可度量参数)[9].面对如此复杂的刻蚀系统,只有充分理解刻蚀过程的基本物理化学反应,才能优化工艺参数、改善刻蚀条件,进而实现半导体表面的精密加工,满足半导体芯片产业对刻蚀速率与良品率日益增长的需求.
在干法刻蚀技术发展的早期,探索最优工艺条件的方法是试探试错法(trial and error)[3,14-16].试探试错法是一种基于反复实验的经验方法,极其耗时且效率低下,工艺开发成本很高.随着晶圆半径的逐渐增大与芯片特征尺寸的不断缩小,为了保持全晶圆刻蚀的均匀性以及减小缺陷密度、提高生产效率,对工艺条件控制的精确性要求越来越严苛.在这种情况下,高成本低收益的试探试错法逐渐走到了独木难支的境地[15,16].为了提高效率和降低成本,在20 世纪80 年代末90 年代初,人们将目光转向了等离子体刻蚀建模仿真,即基于第一性原理或半经验的理论模型,结合已有的基础数据库,数值模拟等离子体刻蚀腔室中的反应过程,从而预测刻蚀条件与刻蚀结果[4,7,14-23].进入21 世纪,数值模拟已经能够在很大程度上缩小实验探索的范围,指导人们在海量的参数中找到最优工艺条件,大大缩短了工艺开发周期,因而成为了实验探索方法的重要补充,在设计新型工艺腔室和控制工艺过程的实践中起到了不可替代的作用[1,2,9,12].
建立等离子体刻蚀模型的基础是充分认识发生在低温等离子体内部以及晶圆表面的基本物理化学过程.这种认识体现在定量的数值模拟上,就是建立一个准确且完备的数据库,为模型提供可靠的输入参数.实际上,一个可靠的仿真结果不仅依赖于反映基本理论的物理模型与合适的计算代码,更需要表征基本物理化学过程的大量数据.反之,关键数据的偏差或缺失,是限制等离子体模型预测结果精度和影响等离子体建模领域进一步发展的主要障碍[14-17,24-27].针对腔室内的不同模块,模型需要不同的输入参数,主要包括原子分子的电子碰撞截面、等离子体输运系数和反应速率系数、表面反应速率系数、离子(弹性)散射截面、原子分子光谱参数等.其中,原子分子的电子碰撞截面(electron collision cross section)是最重要的输入参数之一,在数据库的构成中拥有非常高的优先级[15,25,27,28].这是由电子碰撞过程在低温等离子体中的重要地位决定的——由于重粒子难以对射频(或微波)电场作出响应,电源输入的能量主要转换为电子的动能,电子通过碰撞过程将能量传递给其他粒子,驱动整个低温等离子体的形成.更重要的是,电子与原料气体的碰撞过程能够生成正离子与自由基等活性反应粒子,它们在表面刻蚀部分起到了关键作用(见图2).正是因为电子碰撞截面的极端重要性,在等离子体刻蚀建模兴起至今的30 多年中,有大量工作聚焦于相关原子分子截面数据的理论与实验研究[13,14,16,24,26,29-41],其中包含了许多阶段性的综述文章[14,16,24,26,31,32,38,40],为建模工作的开展提供了很大便利.
本文主要介绍电子碰撞截面数据在等离子体刻蚀建模中的应用以及获取截面数据的方法.在第2 部分,简要介绍低温等离子体建模理论以及基于这些理论开发的建模软件,强调电子碰撞截面在其中担任的重要角色;第3 部分将介绍刻蚀常用的气体分子,以及针对这些刻蚀气体建模所需的截面数据类型;第4 部分给出获取截面数据的理论与实验方法,特别是在电子能量损失谱学和非共振非弹性X 射线散射谱学方面的实验进展;最后,在第5部分对本文作一个简短的总结,并展望刻蚀相关原子分子的电子碰撞截面研究前景.
2 电子碰撞截面在等离子体刻蚀建模中的应用——低温等离子体建模理论简介
为了模拟真实的半导体刻蚀过程,等离子体刻蚀模型需要兼顾刻蚀系统的各个部分.如图3 所示,完整的等离子体刻蚀模型除了外部参数的输入模块外,还应包括处理等离子体、鞘层和晶圆表面的模块,其中等离子体模块耦合有电磁场与气相反应等功能,是建模的核心部分[9,17],也是本节重点介绍的对象.等离子体理论模型主要包括以下三类[27,42]:流体动力学(fluid dynamics)模型(简称流体模型)、动理学(kinetics)模型和混合(hybrid)模型.流体模型将等离子体中的电子、离子等看作流体,通过流体动力学的理论方法考察其宏观性质和整体行为,计算速度快但精度较低;动理学模型在相空间中考察微观粒子的统计学性质,重点是求解粒子的分布函数,计算精度高但比较费时;混合模型结合两者优势,使用流体力学定律描述电子行为,同时通过动理学方法研究其他重粒子的演化,综合考虑了精度与效率.此外,当需要描述详细的等离子体化学反应且不用考虑等离子体在时空上的非均匀性时,全局模型(global model)是一个很好的解决方案,它不需要复杂的计算代码,在很短的时间内就可以得到化学反应通道的分析结果,有助于大范围工艺条件的快速搜索[27,43,44].对低温等离子体建模而言,上述模型均需要电子碰撞截面等相关数据作为输入参数.

图3 干法刻蚀系统与各部分对应的处理模块,各个模块的理论模型见文献[42,43]Fig.3.Dry etching system and the processing modules corresponding to each part,theoretical models of each module can be found in Refs.[42,43].
2.1 动理学模型
2.1.1 求解电子玻耳兹曼方程
动理学模型是最详细的低温等离子体模型,它直接描述电子或离子在相空间内的演化.相空间中的一个点(r,v) 代表单个粒子的状态,包含坐标r与速度v共6 个维度,可通过牛顿方程描述其演化过程.然而,N粒子系统有6N个维度,宏观系统包含的粒子数N在1023数量级,因此追踪每个粒子的行为是不可能的.一个替代方案是结合统计学原理发展动理学理论,以分布函数来描述粒子的状态.对低温等离子体这样的非平衡系统,电子或离子不遵从热平衡态的麦克斯韦-玻耳兹曼分布,此时需要求解玻耳兹曼方程(Boltzmann equation)来获取分布函数信息[27,42,43,45].其中,求解电子能量分布函数(electron energy distribution function,EEDF)是重中之重,这是因为电子能量分布直接影响低温等离子体的组成(例如分布在电离阈值以上的高能电子与中性气体碰撞可以产生正离子),而且低温等离子体内部的非平衡状态也由电子诱导产生.
电子的玻耳兹曼方程为[27,42,43,45]
其中fe(r,v,t) 是电子的(速度)分布函数,代表相空间的一点(r,v) 处单位体积内的电子数.a=-e·(E+v×B)/me是总电磁场作用下的电子加速度,E和B分别是电场强度和磁感应强度,而-e和me代表电子的电荷与质量.∇r和∇v分别是三维坐标与三维速度的梯度算符.(1)式左侧第2项相当于自由运动条件下单位时间内流出(r,v) 处单位体积的电子数,因此[v·∇r+a·∇v] 被称为对流(convection)算符[42].注意到等号左边相当于fe(r,v,t)对时间t的全导数.是碰撞项,表示两体碰撞引起的分布函数演化.可以看到,玻耳兹曼方程有着明确的物理意义,即分布函数随时间的演化等于自由运动和碰撞过程引起的相空间单位体积内的粒子数变化.对电子与重粒子s 碰撞的情形,如图4 所示,碰撞前电子速度为v,粒子s 速度为vs,相对速度vr=|v-vs|≈|v|=v.碰撞后电子速度变为v′,散射角为θ.由于粒子s 质量远大于电子质量,可认为其速度保持不变,仅考虑内禀能级从l变为l′,此时碰撞项可表示为[42]

图4 电子与粒子s 的两体碰撞示意图,粒子s 可视为静止.右图为左图的逆过程Fig.4.Diagram of binary encounter between an electron and a particle s which can be regarded as stationary.The right picture is the inverse process of the left picture.
求解电子玻耳兹曼方程的常用方法是取两项近似(two-term approximation)[27,42,43,45,46].在两项近似的框架下,分布函数被拆分为两个部分[42]:
f0与f1分别代表速度分布中各向同性与各向异性的部分.在大部分情况下,对低温等离子体中的电子,两项近似能够得到很好的结果[27,45].相应地,碰撞项也分为两部分:
对应碰撞引起的f0与f1变化.结合(1)—(3)式,可得到关于f0与f1的两个微分方程,此时碰撞项的贡献一分为二,分别对应两个方程中的源项(source term)S0∝δf0和S1∝δf1,具体有[42]
理论上,计算S0与S1时需要考虑所有的弹性、非弹性和超弹性散射过程.考虑弹性散射对S1的贡献,此时v′≈v,l=l′,容易求得
结合(5b)式与(7)式,可得非弹性和超弹性散射的贡献:
在大多数情况下,非弹性和超弹性散射的截面很小,弹性散射截面的贡献占主导,计算S1时与可以忽略,只需考虑
S0中弹性散射的贡献不能简单地利用(5a)式计算,那样会导致结果为0.具体的计算步骤较为复杂(见文献[42]),这里只简单给出结果.将单位为eV 的电子动能写为ε=mev2/(2e),分布函数(3)式转换为能量分布[42]:
相应地,S0变为:
其中弹性散射的贡献为[42]
这里kB与T分别是玻耳兹曼常数和温度.结合(5a)式、(7)式、(9a)式、(10)式可得非弹性与超弹性散射的贡献为
其中gs,l和gs,l′分别是能级l和l′的简并度,ε-ε′=εs,l′-εs,l为跃迁能.
在求解电子玻耳兹曼方程时,除了两项近似,直接数值求解(direct numerical solution)也是广泛应用的方法,例如Kolobov等[49-51]发展的相空间自适应网格(adaptive mesh in phase space,AMPS)方法.在AMPS 中,坐标与速度空间被划分为笛卡尔网格,其中坐标网格是自动生成的,可根据局部解的性质自动调整,速度网格则是在坐标网格中实时生成.类似于两项近似方法,AMPS 同样需要电子碰撞截面作为输入参数,用于计算玻耳兹曼方程中的碰撞积分,两者的区别仅在于计算方法不同,此处不再赘述.
2.1.2 PIC-MCC 模型
除了直接求解玻耳兹曼方程外,另一种广泛采用的动理学模型是PIC-MCC(particle-in-cell and Monte Carlo collision)模型[42,43,52-55].PIC-MCC模型分为PIC 与MCC 两部分,其中PIC 模型处理带电粒子在电磁场中的运动,而MCC 方法处理带电粒子与其他粒子的碰撞过程.
PIC 是一种针对粒子的建模方法,这里的粒子不是物理意义上的单个粒子(追踪单个粒子是不可能的),而是相空间内靠得很近的同种粒子的集合,称为宏粒子(superparticle)或计算粒子(computational particle).宏粒子的权重Np是其包含的实际粒子个数,一般为104—106个[54],它们拥有相近的位置与速度.考虑电子的模拟,宏粒子质量为meNp,所带电荷量为-eNp,荷质比为-e/me.相同的荷质比意味着电磁场中的宏粒子与电子拥有相同的加速度.因此,用宏粒子取代电子成为相空间的计算单元,既保留了原本的物理意义,也大大降低了计算负担.但是,单独的PIC 模型只能处理电磁场作用下带电粒子的自由运动,因此还需引入MCC 方法来描述带电粒子与其他粒子的碰撞过程[43,52-55].MCC 方法在每次更新宏粒子速度vp时引入粒子的碰撞,并由蒙特卡罗方法确定碰撞的具体类型.需要强调的是,处理碰撞过程时考虑的是单个带电粒子而不是宏粒子,但仍然将碰撞后更新的速度赋予宏粒子,这意味着在单粒子碰撞事例足够多的条件下,宏粒子的散射行为将类似于单粒子的散射行为[52].在时间步长Δt内,考虑速度为vp的电子与粒子s 的碰撞,发生碰撞的概率可以表示为[43,52,53,55]
这里νe是电子的总碰撞频率:
其中V是系统的体积,若气体是均匀的,则Ns(r)是常数.εlim是低温等离子体中电子能量的上限.νc还可以表示为[43]
即对不同能量下的νe,选取一个同样依赖于ε的碰撞频率νnull,使两者加和得到的总碰撞频率νc为常数.νnull可视为“伪碰撞”(null collision)过程的碰撞频率,此过程中电子的速度不发生改变,因而上述选择恒定碰撞频率的方法被称为伪碰撞方法[43,53-55].有了νc后,只需计算出最大碰撞概率
就可以确定每次发生碰撞的最大电子数
这里Ntot是总电子数,也可以视作宏粒子的总数.通过伪碰撞方法,在每次考虑碰撞过程时,只需随机选取Nmax个电子作后续处理.由于Pmax一般在10-2量级,相比于处理Ntot个电子,伪碰撞方法能够节省相当多的计算量[53].
接下来需要判断Nmax个电子的碰撞类型,并根据具体的碰撞过程改变每个电子的速度.将每个电子能发生的所有碰撞过程排序{ν1,ν2···νk···νn=νnull},第k个碰撞过程对应的频率为
则该电子发生第m种碰撞过程.相应地,散射后的电子速度大小就可以确定下来,例如弹性散射过程电子速度大小不变,非弹性散射过程电子损失激发能,速度减小.最后需要判断散射电子的速度方向,即计算方位角ϕ和极角(散射角)θ.同样选用随机取样的方法.方位角是各向同性的,其取样比较简单:
R2∈[0,1]是另一个随机数.散射角的取样通过第3个随机数R3∈[0,1] 完成[52,55]:
这样就确定了碰撞后电子的速度.对Nmax个电子进行上述操作,即可处理完一轮碰撞过程,各个电子(宏粒子)的速度vp也将完成一次更新.需要指出,在各向同性散射的情况下,弹性碰撞频率需要用动量转移截面而不是弹性积分截面来计算,此时PIC-MCC 方法得到的EEDF 将和求解玻耳兹曼方程(两项近似)得到的结果一致[54].事实上,PIC-MCC 模型与求解电子玻耳兹曼方程是等价的,PIC 与MCC 分别对应电子玻耳兹曼方程(1)中的自由演化项与碰撞项[54,55].
可以看到,在PIC-MCC 模型中,电子碰撞截面数据是MCC 方法处理碰撞过程时必要的输入参数.输入的截面数据用于计算碰撞频率与碰撞概率,随后结合随机方法确定碰撞类型并更新宏粒子的速度.而且,与求解两项近似下的电子玻耳兹曼方程相同,此时需要的是弹性碰撞的动量转移截面与其他过程的积分截面.
以上简单介绍了动理学模型中的电子玻耳兹曼方程(两项近似)和PIC-MCC 模型,重点强调了电子碰撞截面在其中的应用.需要的截面数据包括弹性碰撞的动量转移截面以及非弹性散射的积分截面.实际计算时还可以考虑电子-电子碰撞、电子-离子复合等其他反应过程[42],但是这些过程发生的概率较小,此处不再赘述.总之,一个普遍的假设是: 一个完备的截面数据集{σs}只需要包括弹性过程的动量转移截面与所有非弹性过程的积分截面{} 就足以用来描述电子的能量分布[27].这个假设大大减少了在获取截面数据上的工作量,尽管建立一个准确且完备的截面数据库仍然是一个艰巨的任务.
2.2 流体模型与全局模型
流体模型将等离子体看作由电子、离子和中性粒子组成的宏观多组分流体系统,通过求解流体动力学方程来获取其中各类粒子s 的密度与通量等信息,同时结合泊松方程求解空间电荷势.流体动力学方程对应一组守恒定律,任意守恒量χ(r,vs,t)满足的守恒方程由χ与玻耳兹曼方程的乘积对速度空间积分得到,这些方程被称为玻耳兹曼方程的矩(moments)[43].考虑等离子体中的电子,玻耳兹曼方程见(1)式,取χ=1,得到电子数密度的守恒方程(连续性方程):
这里µe称为电子迁移率(mobility),De是扩散系数(diffusion coefficient),两者共同决定了电子的输运性质——µeE和(De∇rNe)/Ne分别是电子的漂移速度和扩散速度,因此(26)式又被称为漂移-扩散(drift-diffusion)方程[27,42,43,45].在流体模型中,迁移率与扩散系数等输运系数(transport coefficients)是求解动力学方程必需的输入参数,它们可以由EEDF 结合截面数据计算得到[27,42,43,45]:
其中总碰撞频率νe包含所有电子碰撞过程的贡献,对应的数据需求为弹性碰撞的动量转移截面与非弹性碰撞的积分截面(或者总截面,见(15)式).实际计算时也可以仅考虑弹性碰撞频率(见(6)式).F0(ε)=n0(ε,r,t)/(Ne(r,t)ε1/2)是不依赖于时空坐标的EEDF,单位为eV-3/2.
除了输运系数外,电子碰撞反应速率系数(reaction rate coefficients)kj(单位:m3·s-1)也是流体模型必不可少的输入参数.kj用于计算源项中的反应速率,即单位时间在单位体积内通过反应生成的粒子数.对电子碰撞诱导的激发、电离、解离等反应过程,kj同样可以由EEDF 和截面数据计算得到[27,43,45]:
其中σj(ε) 是反应j的积分截面.
需要强调的是,在详细考虑等离子体化学反应的全局模型中,电子碰撞反应速率系数显得尤为重要[56].全局模型忽略了流体模型中的输运项,粒子数密度的守恒方程(如(25)式)退化为简单的化学反应平衡方程[43].考虑电子与粒子s 的碰撞反应:
Ci是生成物i(包含可能生成的e 与s)对应的化学计量系数.粒子i的数密度Ni满足的平衡方程为
其中ΔCij是反应j中物种i右端与左端计量系数的差,求和遍历所有涉及物种i的反应.从(30)式可以看到,kj可以用于计算目标物种的粒子数密度.例如,对低温等离子体中的F,HF 等活性自由基,在电子碰撞解离截面与特定解离通道信息完备的情况下,可以计算出原料气体的解离速率,进而确定活性自由基的数密度,为晶圆表面的刻蚀反应模型提供输入参数.
2.3 混合模型
混合模型的特点是将处理不同物理过程的计算模块有机地结合起来,且同一物理过程可以由不同的技术来处理[57].在混合模型中,不同模块之间通过输入与输出数据相联系.各个模块是相互独立的,可以根据需求进行交换、替代和嵌套,以达到最优的模拟结果.此外,使用不同的技术处理同一物理过程时,混合模型中的其他模块并不会受到影响.因此,混合模型具有非常高的灵活性,适用于多种条件下的低温等离子体模拟.在实际应用中,混合模型不仅可以用于等离子体相关的基础物理研究,还能用于实际等离子体设备的仿真设计[57].
混合模型的一个典型例子是Kushner 团队[21,57]开发的HPEM(hybrid plasma equipment model)程序.HPEM 主要由电磁场模块(electromagnetics module,EMM)、电子能量输运模块(electron energy transport module,EETM)、流体动理学-泊松模块(fluid kinetics-Poisson module,FKPM)等部分组成.EMM 负责给出电磁场E和B,在EETM中作为求解EEDF 的输入参数.利用EEDF,EETM可以计算得到电子碰撞反应速率系数、输运系数等参数,将这些参数输入FKPM,就可以得到中性和带电粒子的密度、通量等数据.其中,在EETM中计算EEDF 时,除了直接求解玻耳兹曼方程外,还有一种广泛使用的方法,即电子蒙特卡罗模拟(electron Monte Carlo simulation,EMCS)方法[18,21,54,57].EMCS 类似于PIC-MCC 模型中的MCC 方法.在与其他粒子碰撞前,电子在电磁场的作用下自由运动.碰撞过程同样采用“伪碰撞”方法来处理,在恒定的碰撞频率νc下,两次碰撞的时间间隔(电子的自由飞行时间)由下式给出[18,54]:
其中R是区间(0,1) 内的随机数.碰撞时间确定后就可以更新碰撞前电子的速度与位置.在处理碰撞,过程时,EMCS 中判断碰撞类型以及确定散射角的方法与MCC 是一致的(见2.1.2 节),此处不再赘述.可以看到,EMCS 与MCC 两种方法的区别在于碰撞时间的确定.MCC 方法以PIC 模型中的固定时间步长Δt为基准,每隔Δt处理一次碰撞过程,而EMCS 则是利用碰撞频率,结合随机方法来确定电子发生碰撞的时间.显然,EMCS 方法(或HPEM 程序)同样需要电子碰撞截面作为输入参数.输入的截面数据不仅可以用于计算碰撞频率与碰撞概率,还能结合EEDF 计算输运系数与电子碰撞反应速率系数.
以上介绍了低温等离子体建模常用的理论模型,这些模型为模拟等离子体中的物理化学过程提供了不同层级的解决方案,实际建模研究时可以根据需求选取特定的模型或交叉使用不同的模型.可以看到,截面数据的重要性表现为等离子体模型对相关输入参数(包括电子碰撞截面、输运系数、反应速率系数)的强烈需求.由于电子碰撞动力学描述的弹性、非弹性以及反应过程在微观层面上主导了低温等离子体系统的时间演化行为,相关截面数据的准确性和完备性成为了影响等离子体模型仿真结果的重要因素,建立一个准确且完备的截面数据库也因此成为了极端重要且富有挑战性的任务.幸运的是,现今已有一些数据库可用,例如LXCat[27,58].LXCat 是一个开放访问的网络数据库,隶属于等离子体数据交换项目(plasma data exchange project),该项目在2010 年由低温等离子体领域的重要国际会议——气体电子学会议(gaseous electronics conference)发起,类似于一个数据共享平台,能够随着研究人员的补充而不断更新升级.LXCat包含了低温等离子体建模所需的许多数据,包括气体分子的电子碰撞截面、输运系数、反应速率、能量分布函数等.然而,现有数据的准确性和完备性仍有欠缺.获取准确的截面数据补足数据库,以及高精度实验交叉检验已有数据的准确性,对低温等离子体建模领域而言是一个长期且重要的课题.
2.4 等离子体建模仿真软件
可用于刻蚀等离子体建模的软件有BOLSIG+,LOKI,COMSOL Multiphysics,ANSYS Fluent,CFD-ACE,PEGASUS,Vsim,OOPIC 等.其中BOLSIG+[45]与LOKI[59]是在两项近似的框架内数值求解电子玻耳兹曼方程的免费软件.此外,它们还可以结合EEDF 与已有的截面数据计算出电子输运系数以及电子诱导反应过程的速率系数,进而为流体模型提供输入参数[42].例如,BOLSIG+计算时使用的电子碰撞截面数据来自于LXCat,求解得到的输运系数等参数还可以作为LXCat 数据库的补充[27,58].COMSOL Multiphysics,ANSYS Fluent,CFD-ACE 是基于计算流体动力学(computational fluid dynamics,CFD)代码开发的软件,其基本理论框架为流体模型;而PEGASUS,Vsim,OOPIC 则是基于PIC-MCC 方法的动理学仿真软件.实际上,COMSOL Multiphysics 与PEGASUS等成熟的商业软件功能已十分完善,这些软件往往不会局限于单一的理论模型,而是根据实际情况选取不同的建模方案.以COMSOL 为例[60],COMSOL是一款功能齐全的多物理场仿真软件,软件内置有等离子体模块,用于模拟等离子体受到各种电磁激励时的行为,其中包含有与刻蚀相关的CCP 与ICP模拟.在描述EEDF 时,针对热平衡等离子体或仅需建立粗略模型的情况,用户可选择麦克斯韦函数等内置函数.对于更细致的研究,COMSOL 提供了“玻耳兹曼方程(两项近似)”接口用于求解电子玻耳兹曼方程.为了求解两项近似下的电子玻耳兹曼方程,软件需要预设一些等离子体参数(例如组分密度、电离度),而这些参数又可通过流体模型求得,因此这是一个迭代过程: 预设参数求解玻耳兹曼方程→将EEDF 和电子输运系数、反应速率系数导入流体模型→计算得到新的等离子体参数→利用新参数再次求解玻耳兹曼方程······重复这些步骤直到收敛.应当强调的是,无论是否需要求解玻耳兹曼方程,使用COMSOL 进行低温等离子体模拟时,都需要列出所有反应并且输入相应的截面数据或反应速率系数.一个简单的范例是Ar 气体的等离子体建模,Ar 共有7 个反应,其中包含弹性、激发、电离等5 个电子碰撞反应,COMSOL 内置有Ar 的电子碰撞截面数据和反应式,可以直接调用.对于一般的分子,用户需要自行定义反应和输入相应的截面数据.
3 刻蚀气体与建模所需的截面数据类型
刻蚀气体种类繁多,选择合适的原料气体是刻蚀工艺的关键环节.前文提到,在半导体器件加工过程中,从晶圆到成品芯片需要经历几百道复杂且精细的工序,其中包括反复的薄膜沉积、光刻与刻蚀过程.实际上,为了制造芯片内部的晶体管等微型器件,进而形成三维的半导体结构,需要通过薄膜沉积技术在晶圆表面交替堆叠多层金属膜和介电膜,并采用光刻与刻蚀工艺对各层薄膜进行加工处理.此外,在互连工艺中,如果使用铝作为半导体元件之间的连接材料,多余的铝也是通过刻蚀工艺去除的.因此,为了满足不同应用场景下的刻蚀需求,需要在多种原料气体中选择合适的搭配方案,以达到最佳的刻蚀效果,这也是探索最优工艺条件的应有之义.
用于等离子体刻蚀的原料气体并不与刻蚀材料直接反应,而是靠等离子体环境下解离生成的活性自由基与材料反应生成稳定的挥发性产物,进而去除材料.换言之,原则上包含相应自由基的气体分子都可以用作原料气体.对于在半导体产业中应用最为广泛的硅基材料(Si,SiO2,Si3N4),由于刻蚀的温度条件(晶圆温度100—1000 K,气体温度300—600 K)可以超过SiH4,SiF4,SiCl4,SiBr4等分子的沸点,H2,CH4,CF4,SF6,NF3,HBr,Cl2等分子都可以用作刻蚀气体[4,7,8,11,26].同理,刻蚀Al需要用BCl3(或HBr)等含Cl(Br)分子,刻蚀Ti,Mo,W 则可用SF6或Cl2[8,11].在刻蚀硅基材料的众多气体中,含氟气体因其刻蚀速率快、化学稳定性好、产物挥发性高、安全性高等优点受到了人们的广泛关注,它们主要包括氟碳化合物CxHyFz,NF3,SF6和SiF4[2,7,11,12,40].这些气体在刻蚀过程中表现出不同的性质.例如,NF3有较高的Si 刻蚀速率,因此有更高的Si 对光刻胶的刻蚀选择性(即刻蚀速率的比值)[2];常温下SF6对Si 的刻蚀是各向同性的,但在-120 ℃的低温下水平方向刻蚀速率会大大降低,表现出各向异性[7].作为一类重要的刻蚀气体,氟碳化合物的等离子体刻蚀有着独特的机制: 解离产生的F 原子主导刻蚀过程,同时CFx等自由基主导聚合物薄膜的沉积过程——如前所述,后者对刻蚀轮廓的各向异性有重要贡献.因此,常常使用氟碳比F/C 来描述氟碳化合物,判断刻蚀与沉积的相对强弱,氟碳比越低,意味着表面沉积过程越来越重要,刻蚀速率也会变小.例如,CF4具有最高的氟碳比4,因此刻蚀占主导,而氟碳比小于2 时则观察到了Si 表面的沉积过程[7,12].
除了直接用于产生反应物种的刻蚀气体外,通入刻蚀工艺腔室的原料气体往往还包含其他成分,以提高各向异性、选择性、均匀性等指标.常用的附加气体包括O2,H2,N2,CHmFn,He,Ar等[2,7].在干法刻蚀工艺发展的早期,CF4+O2/H2的组合就被广泛应用于Si 基材料的刻蚀[3,4,6].在通入少量O2的情况下,O2/O 会与CFx/CF4反应生成CO2,COF2以及F 原子,在增大F 原子密度的同时抑制了聚合物薄膜的形成,等价于氟碳比增大.继续增加O2,SixOyFz钝化膜开始形成,导致刻蚀速率降低.过多的O2则会降低F 原子密度.加入H2的效果与O2相反,H 与F 反应生成相对惰性的HF,降低了F 原子密度,而H2与CF3(CF4的主要解离产物)反应则可以生成聚合前体CF 与CF2,导致聚合物沉积速率增加,等价于氟碳比减小.因此,CF4+H2的气体组合可用于提高SiO2相对于Si 的刻蚀选择性[3].CHmFn既可直接用于刻蚀,也可用作附加气体以调节氟碳比,其效果类似于H2,但其解离产物可以形成聚合物.稀有气体Ar 相对原子质量较大,用于在等离子体中产生Ar+离子,增强溅射效应;He 则常用于降低等离子体的温度······多种气体混合为调节各项刻蚀指标提供了更多的可能性,同时也扩大了不同刻蚀气体电子碰撞截面数据的需求,为建立等离子体刻蚀模型引入了更多的复杂度.
一般而言,低温等离子体中电子与背景气体(原料气体)的碰撞占主导地位,通常仅需考虑原料气体的电子碰撞截面.然而,在某些情况下,电子与其他粒子的碰撞过程变得重要——例如电子与解离自由基以及亚稳态原子分子的碰撞,此时会引入新的截面数据需求[16,42].等离子体刻蚀工艺的其中一个发展方向是产生低气压高密度的等离子体,以提高刻蚀速率与均匀性[1].在这种情况下,尽管低温等离子体的电离度较低,但电子与原料气体的碰撞频率很高,加上激发态的原料气体倾向于解离,导致等离子体中的自由基密度可能会高于原料气体的密度,例如C4F8等离子体中的F 原子与CF2[12,23],此时就需要考虑自由基的电子碰撞截面.对于常见的CxFy自由基,Gupta[40]总结了部分电子碰撞截面数据的实验与理论研究结果,同时指出目前仍然缺乏许多氟碳化合物及其解离碎片的相关数据.除了与解离自由基的碰撞外,当气体分子被激发到亚稳态时,如果亚稳态寿命大于两次碰撞的时间间隔,电子与亚稳态分子间的碰撞过程也会影响等离子体的性质.由于低温等离子体中电子的平均能量在3 eV 左右[8],低于大部分分子的解离(电离)能,仅有分布在高能区的少量电子能够通过单次碰撞使气体分子解离(电离).如果气体分子存在激发阈值较低的亚稳态,低能电子就可以通过多次碰撞激发传递足够的能量,诱导靶分子发生阶梯式的多步解离(电离)过程.而且,在和亚稳态原子分子碰撞时,电子也可以通过超弹性散射获得能量,从而转变为满足一步解离(电离)阈值要求的高能电子.类似的亚稳态包括偶极禁戒的振动激发态和电子激发态[16,42].总之,解离自由基和亚稳态原子分子的电子碰撞截面也是建模时需要考虑的因素,其重要性视具体情况而定.
刻蚀气体种类的多样性是影响截面数据完备性的关键因素之一,另一个重要因素是单一分子截面数据类型的多样性.在低温等离子体中,电子与原子分子的碰撞可分为初级(primary)过程与次级(secondary)过程.如图5 所示,初级过程是指电子与原子分子的直接碰撞过程,包括弹性散射、电子贴附、非弹性的激发、超激发和电离.电子与原子分子的弹性和非弹性散射是最重要的电子碰撞反应过程,而电子贴附则在某些低共振能量处有较大的截面[61-63].需要说明的是,电子贴附是电子的损失过程,因而会影响低温等离子体中的电子能量分布函数,同时氟碳化合物有较大的贴附解离截面,因此刻蚀分子的电子贴附解离过程也受到了人们的广泛关注[62,64-66].次级过程则是散射后处于激发态、电离态或负离子共振态的原子分子(离子)的弛豫过程,包括荧光发射、自电离、中性解离、电离解离、库仑爆炸、电子脱附、贴附解离等.其中,作为普遍的退激过程,荧光发射被视为影响原子分子能级布居的重要因素,在等离子体建模时可用碰撞辐射模型(collisional-radiative model)来处理,此时需同时考虑发射光子作用下的光吸收与受激辐射等过程[42],且在实际应用中要结合已知的光吸收截面或光学振子强度等光谱学参数.另外,发射光谱也常常用于等离子体诊断[9,15].考虑到绝大部分刻蚀气体容易解离,以及解离过程在等离子体刻蚀中的重要性,本文重点关注中性解离、电离解离和贴附解离三类次级过程.如果图5 中最初的原子分子处于激发态,还有可能发生超弹性碰撞,此过程中电子获得能量而原子分子退激回到其基态.另外,电子与原子分子作用后产生的亚稳态原子分子和解离自由基也能与电子发生碰撞,其作用过程与图5 类似,在此不再赘述.电子也可与图5 所示反应产生的离子发生相互作用,例如电子-离子复合,这是电子的另一损失过程.低温等离子体的电离度通常小于10-3,一般不需考虑电子-离子复合过程.最后,需要强调的是,刻蚀用等离子体中的自由基是由次级过程(见图5 中的解离过程)产生的,与初级过程无关,即解离母体的退激通道性质仅取决于所处激发态的性质,见图6.与上述过程相对应,等离子体刻蚀所关注的电子碰撞截面包括弹性(或动量转移)截面、激发(振动、转动、电子态激发)截面、电离截面、贴附截面以及各解离(中性、电离、贴附解离)通道的截面.

图5 电子与双原子分子AB 相互作用的初级过程①与次级过程②,原子或多原子分子的情况是类似的.注意到②中产生的处于激发态的原子分子或离子还会进一步演化Fig.5.Primary process ①and secondary process ② of electron interaction with diatomic molecule AB,and the interaction processes for atoms or polyatomic molecules are similar.Note that the excited atoms,molecules,and ions produced in ② will evolve further.

图6 双原子分子AB 的电子碰撞中性解离的两步过程示意图.处于基态的分子AB 首先被激发到解离态AB*,随后沿着激发态势能曲线解离生成A*+B.图示表明了次级过程的演化与初级过程无关,只与原子分子所处激发态的性质(势能曲线)有关Fig.6.Schematic diagram of the two-step processes of electron-impact neutral dissociation of diatomic molecule AB.AB in the ground state is first excited to the dissociative state AB*,and then dissociates along the potential curve to form A*+B.The diagram indicates that the evolution of the secondary process is independent of the primary process,which is only related to the properties of the corresponding excited states (e.g.the potential curve).
综上所述,表1 和表2 分别列举了常用的刻蚀气体与刻蚀建模所需的截面数据类型,不同类型的截面在低温等离子体建模中的具体应用见第2 节.在所有的电子碰撞截面中,解离截面对刻蚀来说有着特殊的意义,因为它决定了等离子体中活性自由基的种类与密度.然而,解离截面特别是中性解离截面的实验测量非常困难,往往需要求助于理论计算.解离截面的准确与否也是影响数值模拟结果可信度的主要因素.例如,对CHF3等离子体的研究表明,电子碰撞的中性解离反应通道是模拟结果误差的最大来源[67].

表1 常用刻蚀气体.等离子体刻蚀建模涉及的对象包含表格中的刻蚀气体本身、相应的解离碎片以及处于亚稳态的原子分子.Table 1. Commonly used etching gases.The objects involved in plasma etching modeling include the etching gases in the table,the corresponding dissociation fragments,and the atoms and molecules in metastable states.

表2 等离子体刻蚀建模所需的电子碰撞截面类型.表格中的截面描述了低温等离子体中主要的电子碰撞过程Table 2. Types of electron collision cross sections required for plasma etching modeling.The cross sections in the table describe the main electron collision processes in low temperature plasma.
4 获取刻蚀气体电子碰撞截面数据的理论与实验方法
考虑到电子碰撞截面数据库的完备性需求,相关研究应该涵盖各种刻蚀气体的各类截面.实验上,测量原子分子截面数据的方法主要包括电子群(electron swarm)实验和电子束(electron beam)散射实验.需要指出,实验研究本身有其局限性.一方面,实验测量具有高成本低效率的特点,单次实验仅能获取单一分子的部分截面数据.例如,在电子-分子散射实验中,测量激发态积分截面的传统方法是在特定碰撞能量下测量各个角度的散射电子信号,获取相应的微分散射截面信息,随后积分0°—180°的微分散射截面获得积分截面.通过改变入射电子能量,就可以得到等离子体建模感兴趣(激发阈值到100 eV)的宽能区态分辨积分截面.显然,这种兼顾多个碰撞能量与各个散射角度的实验需要耗费大量的时间,难以满足大量的数据需求.另一方面,部分截面数据的实验测量非常困难.例如,激发阈值附近的散射实验因电子能量太低而难以开展;分子中性解离碎片的探测很困难,导致解离通道难以鉴别;实验上难以有针对性地制备刻蚀相关的自由基与亚稳态原子分子,与之相关的实验数据因而极度稀缺.基于以上原因,目前建模所使用的绝大部分截面数据来自理论计算,特别是那些实验上难以测量的截面.然而,虽然现在计算物理、量子化学及相关计算方法取得了巨大进步,但多原子分子激发态的动力学参数计算仍然极具挑战性,这是因为分子是多中心和多电子系统,各个自由度之间的耦合极其复杂,且计算量巨大.因此,高精度的实验数据同样不可或缺,它们常被用作基准数据来与计算结果对比,以验证理论模型与计算代码的可靠性,并给出经交叉检验的可靠数据.总之,在实验与理论的协同发展下,截面数据不断被优化,到目前为止已经给出了许多可用的结果,以满足刻蚀工艺建模的需求[26,42].
4.1 理论方法
低温等离子体中的电子能量主要分布在3 eV附近几个eV 的范围内,高能端可延伸至几十eV甚至上百eV,因此碰撞能量在0—100 eV 范围内的截面数据都是重要的[40].在这一能量区间内,最常用的从头算理论方法包括R 矩阵(R-matrix)[68]、Schwinger 多通道变分(Schwinger multichannel variation)[69]、复Kohn 变分(complex Kohn variation)[70]和收敛密耦合(convergent close-coupling)[71]方法.这些方法基于量子力学原理,结合量子化学理论描述的原子分子波函数,采用不同的假设与近似处理散射过程,其核心都是求解系统(入射电子+靶原子分子)的定态薛定谔方程,或者说跃迁矩阵元的Lippmann-Schwinger 方程.例如,R 矩阵和收敛密耦合方法都是基于系统总波函数的密耦合展开,随后在坐标空间(R 矩阵)或动量空间(收敛密耦合)内求解展开系数或跃迁矩阵元的耦合方程.此外,一些采用更多近似的、甚至是半经验的理论方法常常被用来获取特定的截面信息,其中包括球复光学势(spherical complex optical potential)方法(弹性与总的非弹性截面)[72],BEfscaling(binary encounter f-scaling)方法(允许跃迁的态分辨激发截面)[73]和BEB(binary-encounter-Bethe)方法(电离截面)[74].与精确的计算方法相比,简化的理论模型虽然应用场景受限,但降低了计算负担,能够在短时间内给出较为可信的计算结果.例如,BEf-scaling 方法采用经验的、非第一性原理的放缩系数对Born 截面σBorn进行修正:
其中E0,B和En分别是碰撞能量、靶电子束缚能和激发能;f是计算得到的光学振子强度(optical oscillator strength,OOS),而facc则是准确的OOS,后者通常来自于高精度的实验.众所周知,玻恩近似(Born approximation)是处理散射过程的微扰展开方法,由于高阶项的计算很复杂,通常仅考虑展开式中的第1 项,即一阶玻恩近似(first Born approximation,FBA).FBA 具有理论体系简洁、计算速度快的优点,但它仅适用于高能碰撞情形——FBA 框架下计算的Born 截面在低能时会显著偏离真实值.为了使计算结果适用于低能碰撞,BEfscaling 方法引入放缩系数E0/(E0+B+En) 来修正Born 截面的这种低能缺陷,另一系数facc/f则是为了修正计算σBorn时由波函数不准确引起的偏差.修正后的截面σBEf在低能情况下和非微扰理论计算以及实验结果符合得很好[75].由(32)式可见,BEf-scaling 方法可以批量获得各个碰撞能E0下的激发截面数据,这无疑是很方便的.
关于处理电子碰撞问题的各种理论细节以及具体的计算方法,从文献[38,42,76]中可以找到全面且详细的介绍,此处不再赘述.到目前为止,人们已经利用上述理论方法计算了常用刻蚀气体(见第3 节)的各种截面数据.需要再次指出,虽然现在计算物理和量子化学发展得很快,计算能力也得到了极大提高,但是对于像NF3,SF6,SiF4,CxHyFz这类复杂的多原子分子,其截面的从头算仍旧很困难,且所得数据的精度不高.例如对于上述分子中最简单的NF3,从头算的激发能与实验值差别高达2 eV,激发截面与实验值相差2—5倍[39].在此情形下,实验上获得精确的截面数据对于应用而言就尤显重要.
4.2 实验方法
4.2.1 电子群实验方法
电子群实验是获取截面数据的一种实验方法.如图7 所示,在电子群实验中,电子在施加了电场(场强E)的稀薄背景气体(数密度N)中运动,通过测量和分析对应的电流,可以得到群参数(swarm parameter),这些参数包含迁移率、扩散系数、电子贴附系数、激发系数、电离系数等,它们是约化电场E/N的函数[24,46,77].从群参数反推截面数据的方法被称为群分析(swarm analysis)方法:首先,从已有数据中汇总一组截面数据作为初始截面集,随后根据玻耳兹曼方程分析或者蒙特卡罗模拟计算得到群参数,最后将计算的群参数与实验结果比较,如果两者符合程度不够好,则对初始截面集进行调整,直到计算与测量的群参数相符合[36,46].显然,电子群实验获得的截面具有较高的完备性,可直接用于等离子体模拟,并且能够很好地重现出电子输运等宏观性质.但其缺陷也是显而易见的,由实验结果反推得到截面数据是一个复杂的间接过程,结果的精度高度依赖于采用的分析方法,随着电子能量增加(大于2 eV),打开通道越来越多,数据分析越来越复杂,推导出的截面误差也越来越大.不仅如此,这种方法导出的截面数据甚至是非唯一的.为了改进这些缺陷,常常选用理论计算或者散射实验得到的截面作为初始数据集[46].因此,相比于测量新的截面数据,电子群实验更像是对已有截面数据的一种优化,使其更适用于等离子体宏观性质的预测.例如,在CHF3等离子体的研究中就采用了群分析方法重新标定后的中性解离截面[67].

图7 电子群实验(脉冲汤森装置)示意图[46,77].被激光照射后,阴极放出的电子在电场作用下向阳极漂移,与背景气体碰撞发生贴附、激发、电离等过程.产生的电流(包括电子电流和离子电流)由探测电路监控,背景气体的气压则由气压计检测Fig.7.Schematic diagram of swarm experiment (pulsed Townsend apparatus)[46,77].The electrons released by photoemission drift towards the anode under the electric field,and the collision with the background gas leads to attachment,excitation,ionization,etc.The generated currents (including electronic current and ion current) are monitored by the detection circuit,and the pressure of the background gas is detected by the manometer.
4.2.2 电子束散射实验方法
与电子群实验不同,电子束散射实验是获取电子碰撞截面数据的直接测量方法.如图8 所示,电子束散射实验使用单一能量的准直电子束与气体靶碰撞,随后探测透射电子、特定角度的散射电子或靶的散射产物.其中,由透射电子的强度可以得到不区分散射类型的总截面信息,而散射电子强度则与微分散射截面一一对应,且散射电子的能量损失值可用于识别靶分子的激发态并区分散射类型,包括弹性散射、非弹性激发与电离,因此探测散射电子的实验方法又被称为电子能量损失谱学(electron energy loss spectroscopy,EELS)方法[78].对于需要区分中性激发通道、电离通道和解离通道的情形,仅仅探测散射电子是不够的,此时需要引入其他测量手段来识别不同的产物,例如图8 就展示了用于探测产物离子的飞行时间质谱.结合不同的测量手段,电子束散射实验可以用于获取不同类型的截面数据,下面将一一介绍.
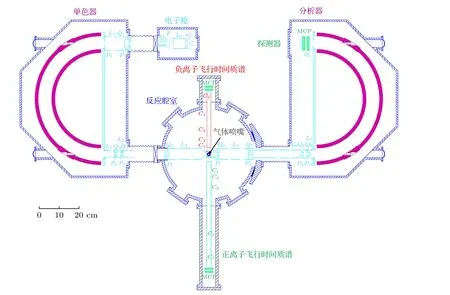
图8 典型的电子束散射实验装置: 高分辨快电子能量损失谱仪[78].由电子枪发出的电子被静电半球单色器单色后在反应腔室中与样品气体碰撞(交叉束布局),散射电子经过静电半球能量分析器后被位置灵敏探测器探测.转动分析器可改变测量的散射角.透镜(F,L)、偏转板(Q)、膜孔(P)等电子光学器件用于电子束的聚焦、准直、加(减)速与监测.图中还展示了用于测量正、负离子的飞行时间质谱Fig.8.A typical apparatus for electron beam scattering experiment: high-resolution fast electron energy loss spectrometer[78].The electrons emitted by the electron gun are monochromized by the electrostatic hemispherical monochromator and then collide with the sample gas in the reaction chamber (cross-beam layout),and the scattered electrons are detected by a position sensitive detector after passing through the electrostatic hemispherical energy analyzer.The measured scattering angle can be varied by rotating the analyzer.Electron optics such as lens (F,L),deflection plate (Q),and aperture (P) are used for focusing,collimating,acceleration (deceleration) and monitoring of the electron beam.Time-of-flight mass spectrometers used to measure positive and negative ions are also shown.
4.2.2.1 总截面
在电子束散射实验中,单能电子束穿过靶气体时,与原子分子发生相互作用的电子被吸附或散射到各个角度上,没有发生相互作用的透射电子则保持原来的速度不变,这样就从角度与能量上区分开了散射与未散射电子.在这个过程中,入射电子强度I0和透射电子强度It满足比尔-朗伯定律(Beer-Lambert law)[79-82]:
其中N是靶气体的密度,L是电子与靶气体的有效作用长度,p和T分别是靶气体的气压和绝对温度,kB是玻耳兹曼常数.注意到第二个等号用到了理想气体近似p=NkBT.可以看到,实验中测量It,I0,L ,p和T,就可以得到总截面σt.为了方便确定有效作用长度L,将样品气体装在气室中并维持一定的温度T和压强p,气室两端沿入射电子束方向开有小孔,小孔间距即为有效作用长度.最后,分别测量气室中有无样品气体时的透射电子强度就可以得到It和I0.这种测量透射电子强度来获取电子碰撞总截面的方法被称为线性透射电子束(linear transmission-beam,LTB)方法[81,82].
另一种类似LTB 的测量电子碰撞总截面的方法使用了磁约束电子束(magnetically confined electron beam,MCEB)[79,80,82].MCEB 装置为“电子枪-作用室-探测器”的直线构型,这是为了方便在电子运动路径上引入强磁场来约束电子束.装置各区域的磁场方向沿轴向(电子前进方向),磁场大小则可以独立调节.MCEB 同样基于(33)式测量总截面σt.但是,与LTB 不同,在强磁场约束条件下,气室中的所有电子(散射和未散射电子)都被约束在轴向磁场附近,这些电子在磁场中的回旋半径小于气室两端的小孔孔径,因此它们都能通过末端小孔进入探测区(包括散射角大于90°的电子,它们能被电场再次推向前).通过在探测区域引入减速电场,就可以在能量上区分散射与未散射电子,从而得到未散射(透射)电子的强度.原则上,类似于磁约束正电子束散射实验[83],从气室进入探测区域的所有电子都保存有散射能量和角度的完整信息,因此通过调节探测区域的减速电场和约束磁场的大小,就可以选择性地探测不同的电子,获得其他类型的截面[79,83].
需要指出,LTB 和MCEB 方法测量透射电子强度时,仪器有限的能量与角度分辨会引起系统误差[79-82].实际上,进入探测器角分辨Δθ范围内的电子不仅有未发生作用的透射电子,还包含散射角在Δθ(MCEB 还要考虑180°-Δθ)范围内的散射电子,如果仪器的能量分辨不足以区分这两种电子,则测量的透射电子强度会偏大,使得总截面测量值小于真实值.一般而言,无法区分的散射电子包括弹性散射电子以及能损值很小的(转动和振动激发)非弹性散射电子,将这些过程的微分散射截面对角分辨积分,可以评估并修正上述系统误差[79-82].
4.2.2.2 弹性(动量转移)截面、转动或振动激发截面
如前所述,在低温等离子体建模感兴趣的低能和中能碰撞区,传统上人们通过测量各个角度的微分散射截面随后对其积分来获得态分辨的积分截面,不同碰撞能量下的截面数据测量则通过改变入射电子能量来实现.例如,在测量弹性散射积分截面或动量转移截面时,需要先测量样品在多个角度下的电子散射谱,根据能损值为0 的条件判断弹性散射信号,随后将弹性散射强度绝对化(通常用He 的弹性微分散射截面作为绝对化标准)来获得微分散射截面.在多数情况下,受限于仪器的角度测量范围,一般需要将实验测量的结果外推到0°和180°,最后再对散射角θ积分得到积分截面或动量转移截面[84-86].然而,通过在碰撞区施加外部磁场来调节入射电子束的入射角度,已有装置能够实现0°—180°全角度范围的散射电子探测(限低能碰撞情形)[87,88].此外,大多数分子的转动能级间隔很小,当转动激发能小于谱仪的能量分辨时,实验测得的弹性截面会包含转动激发的贡献[16].基于同样的原因,纯转动激发截面的实验测量对仪器的能量分辨提出了很高的要求(meV 量级)[89],使得刻蚀分子的相关实验研究较少.对于振动激发,由于其激发能较小,常常与弹性截面在同一实验中一起测量,对应散射电子能损谱上位于弹性峰右侧(能损值大于0)的振动结构[16,84,85,90].
4.2.2.3 电子态激发截面
在测量电子态激发截面时,上述多角度测量再积分的传统方法遇到了困难.这是因为,在中低能电子入射时,相比于入射电子能量,非弹性散射电子的能量变化不能忽略.此时,校正谱仪对不同能量电子的收集和探测效率变得非常困难,所得实验结果的误差往往很大.但这一困难在高能碰撞时则不存在.人们发现,在满足FBA 的高能碰撞区,有一种更为便捷的获取全能区电子碰撞激发截面的实验方法.根据Bethe 理论[91],当FBA 成立时,微分散射截面可以转化为广义振子强度(generalized oscillator strength,GOS) (原子单位,下同):
这里f(K,En) 是激发态的GOS,En是其激发能,K=p0-pa是散射过程中的动量转移,p0与pa分别是入射和散射电子的动量,dσn/dΩ是微分散射截面,Ψ0和Ψn分别代表靶分子(共N个电子)的初末态波函数,rj是靶中第j个电子的位置矢量.是跃迁矩阵元的模方,又被称为形状因子平方(squared form factor,SFF).实际上,(34)式将实验测量的微分散射截面分解成了两个因子的乘积——与入射电子相关的运动学因子以及与靶相关的动力学因子,后者即为GOS.剔除了运动学效应的GOS 是一个相对纯粹的量,只与靶分子有关,因此非常有利于检验理论计算模型及其所用波函数.
由实验所测量的GOS,结合不同碰撞能量所对应的动量转移范围,可以获得从激发阈值到几千eV 宽能量范围的Born 截面:
这样,只需在某一高碰撞能量下测量GOS,就可获得不同碰撞能量下的积分截面,在很大程度上减少了实验成本.但是,研究发现,虽然高能区的Born积分截面与真实值一致,但是低能区的结果要比真实值大很多.造成这种偏差的原因不难理解——FBA 的理论体系仅适用于高能碰撞.因此由(35)式获得的Born 积分截面不能直接应用于低温等离子体建模.幸运的是,由Kim[73,92]提出的BE-scaling方法克服了实验Born 截面的低能缺陷,在放缩系数E0/(E0+B+En) 的修正下(见(32)式),由玻恩截面σBorn就可获得从低能阈值到数千eV 宽能量范围内可信的积分截面σBE.需要指出,此处的Born 截面σBorn是在高能(E0)下测量的准确结果,因此仅需一次修正就能获得可信的积分截面,不像理论计算时需要使用实验的OOS 值做二次修正(f-scaling).在BE-scaling 方法的发展过程中,作者所在的研究组也做出了重要贡献[75,93].自提出至今的20 多年来,人们已经应用BE-scaling 方法获得了几十个原子分子的电子碰撞激发截面,且在所有碰撞能量下都与其他实验符合,通过了实验的严格检验.特别需要强调的是,BE-scaling 方法获得的低能电子碰撞积分截面与常规积分0°—180°微分散射截面得到的结果完全符合,见图9 中CO 的例子[94-98],且该方法能够提供从激发阈值到数千eV 宽能量范围、精度好于30%的批量数据[75],是实验获取刻蚀气体电子碰撞激发截面数据的强有力工具[13,39,41,93,99].遗憾的是,BE-scaling 方法仅适用于允许跃迁.图10 展示了CHF3分子总的中性解离截面的测量结果[13].由于激发态均为解离态,BE-scaling 方法得到的中性解离截面是电离阈以下的各个激发态积分截面加和的结果,这意味着结果中缺少了超激发态中性解离的贡献(估计为20%—40%).在低能碰撞实验中,研究人员通过测量中性解离产物来得到解离截面[100,101].由图10可以看到,由于解离阈值附近截面很小,中性解离产物难以测量,此时测得的解离阈值并不准确.此外,低能碰撞测得的解离截面(修正后)[101]显著偏小,Morgan等[102]在对CHF3的截面数据进行综合评估时也指出了这一问题.
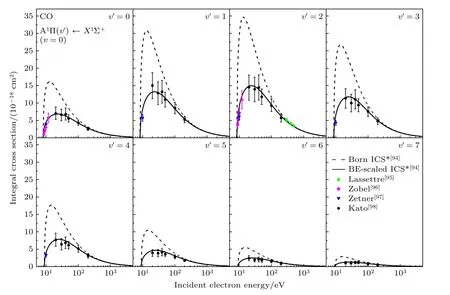
图9 CO 分子A1Π 电子激发态不同振动能级的积分截面.*由文献[94]中测量的GOS 计算得到.可以看到,虽然Born 积分截面(虚线)在低能区比积分0°—180°微分散射截面得到的实验值(点)[95-98]大很多,但是BE-scaled 积分截面(实线)与实验值符合得很好Fig.9.Integral cross sections of the vibrational states of A1Π in carbon monoxide.* calculated from the GOSs reported in Ref.[94].It can be seen that although the Born cross sections (dashed line) at the low energy region are much larger than the experimental values obtained by integrating the differential cross sections in the region of 0°-180° (dots)[95-98],the BE-scaled integral cross sections (solid line) agree very well with the experimental values.

图10 CHF3 总中性解离截面的测量结果[13].Sugai等[101]重新标定了他们之前的测量结果[100],由于测量仅考虑了中性碎片CFx (x=1—3),加入了解离到CHF2 和CHF 的贡献进行修正Fig.10.Measured total dissociation cross sections into neutral species for CHF3[13].Sugai et al.[101] recalibrated their previous experimental results[100].Since their measurement only considered neutral fragments CFx (x=1-3),the contributions of dissociation to CHF2 and CHF were added for correction.
与电子类似,光子也可以作为散射实验中研究靶分子微观性质的探针.在非共振非弹性X 射线散射(non-resonance inelastic X-ray scattering,NRIXS)过程中,靶分子对光子的作用势可以看作微扰,即FBA 总是成立.但是,光散射的截面非常小,约10-30m2,比电子散射截面小了约10 个数量级,因此IXS 技术长期以来主要用于高密度靶的凝聚态物理研究[103].对于低密度的气体靶,由于散射截面很小,早期实验很难获得足够高的信号强度,这成为了制约IXS 技术在原子分子物理中应用的最主要原因.近年来,同步辐射和X 射线分析器及探测器的快速发展,为基于气体靶样的原子分子物理实验创造了条件.2010 年,NRIXS 技术首次应用于原子分子的动力学参数研究,揭示了非弹性X 射线散射与高能电子散射之间的内在联系[104,105]:
其中ζ(q,ωn) 即(34)式中的形状因子平方SFF,此处沿用了光散射领域的常用记号;q=K是动量转移;ωi,ωf和ωn=ωi-ωf=En是入射和散射光子能量以及能量损失(激发能);r0是经典电子半径;εi和ε*f则是入射与散射光子的偏振方向.由(36)式易知,虽然光散射微分截面dσγ/dΩ与电子散射微分截面dσe/dΩ有很大区别,但是它们可以通过SFF 相互转换,特别是NRIXS 实验与EELS实验均可用于测量GOS,即f(q,ωn) .实验上,NRIXS实验测量的He 原子价壳层激发的GOS 和EELS实验结果吻合很好,证明了高分辨的NRIXS 技术是研究原子分子激发态动力学参数的强有力工具[104,105].与高能电子碰撞实验类似,在所测GOS 的基础上,应用BE-scaling 方法就可以获得可靠的积分截面数据,此处不再赘述.需要强调的是,应用BEscaling 方法的前提是获取可靠的GOS,而利用EELS 和NRIXS 两种完全不同的实验方法,可获得经过交叉检验的、排除潜在系统误差的GOS实验基准,进而获得刻蚀气体分子可靠的积分截面.对需求高精度数据的低温等离子体建模而言,通过交叉检验获得基准截面数据无疑是非常重要的.图11展示了结合NRIXS 与EELS 两种实验方法得到的Ar 原子4s[3/2]1,4s′[1/2]1激发态的积分截面[93].图11 还显示了低(中)能电子碰撞实验结果[106-110]和LXCat 数据库内收集的(半)理论数据[27,58],可以看出无论是实验点还是理论曲线之间都有较大的区别.对于典型的允许跃迁4s′[1/2]1,BE-scaling 方法得到的结果与高精度计算(BSR-500)符合得很好,可以作为评估其他数据质量的基准.而对于含有较多禁戒跃迁成分的4s[3/2]1,低能电子碰撞中必须考虑三重态激发(自旋交换跃迁)的贡献.
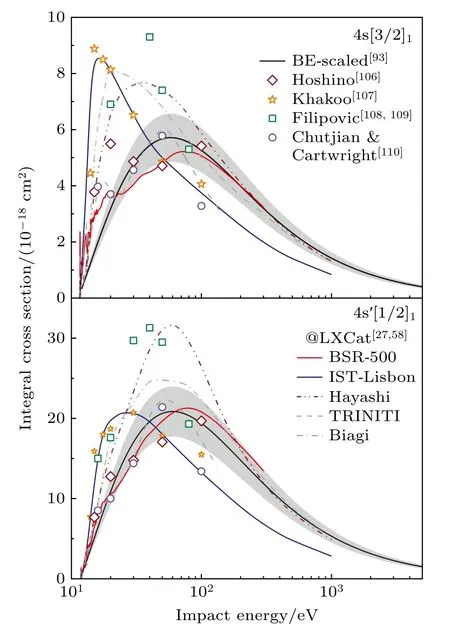
图11 Ar 原子4s[3/2]1,4s′[1/2]1 激发态的积分截面[93].数据点是低(中)能电子碰撞的实验结果[106-110].阴影区代表了BE-scaled 积分截面(黑色实线)15%的实验误差[93],其他曲线来自LXCat 数据库[27,58]Fig.11.Integral cross sections for the 4s[3/2]1 and 4s′[1/2]1 states of Ar[93].Dots are the experimental results measured by low (medium) energy electron impact[106-110].The shaded areas indicate an experimental uncertainty of 15% of the BE-scaled integral cross sections (black solid lines)[93].The other lines are the data from the LXCat database[27,58].
4.2.2.4 电离截面
当电子散射过程中传递给原子分子的能量达到或超过其电离阈值时,原子分子可以被激发或电离,前者对应于具有多种退激通道的原子自电离态或分子超激发态,后者则会直接生成正离子(见图5).原子自电离态或分子超激发态进一步演化生成的中性原子分子难以探测,相应的散射截面也很难直接测量.反之,带电粒子比较容易操控和探测,因此常规的做法是测量电离阈以上的非弹性散射总截面和电离截面,两者相减即可得到自电离态或超激发态中性退激通道的电子碰撞截面.常用的测量电子碰撞电离总截面的方法有两种[16,111,112].第1种方法直接测量碰撞后的正离子电流,不去区分产物离子的种类,电离截面则与电流大小一一对应,这样得到的电离截面称为“全电离截面”(gross ionization cross section).这种方法的缺点是双重电离的离子会计两次,导致结果偏离真实值.第2种方法是利用质谱仪分辨产生的离子种类(分子的电离解离会产生不同种类的离子),每种离子在质谱上的计数对应该离子的“分支截面”(partial cross section),将分支截面加和即可得到总电离截面.这种方法相当于数电离事例,因此测得的总电离截面称为“计数电离截面”(counting ionization cross section).由于双重电离的分子离子有可能通过库仑爆炸分裂成两个单电离离子,导致单次电离事例被计算两次,计数电离截面也可能偏离实际值.需要说明,理论计算的总电离截面通常是计数电离截面,而且大部分理论(例如BEB)认为只要能损值达到电离阈就会发生电离过程,这显然会高估实验结果.虽然电子碰撞单电离截面比双电离截面大一个量级以上,使得上述三种方法得到的电离截面可以相互比较,但是在对比时仍需仔细考虑它们之间的区别[16,111,112].
4.2.2.5 解离截面
在解离截面中,得益于带电粒子探测技术的发展,电离解离截面与贴附解离截面的测量较为简单,只需要在常规的电子散射实验装置上加入探测正(负)离子的质谱仪即可[62,63,111,112].常用的质谱仪包括四极(quadrupole)质谱与飞行时间(time of flight,TOF)质谱,两者的区别在于四极杆一次只能通过一种离子,而飞行时间质谱可以同时记录单个碰撞能下的所有产物离子.由特定离子的信号强度分析得到的解离截面即前述的分支截面,对应原分子离子的其中一个退激通道.在测量电离解离截面时,由于每个通道的分支截面加和结果等于原分子的总电离截面,因此常用后者来对前者进行绝对化[111,112].在测量贴附解离截面时,也可以直接测量总离子电流而不区分产生的离子种类,前提是已知各个碰撞能下的解离通道信息.例如,在HCl与HBr 的电子贴附解离实验中,入射电子能量在1.5 eV 以下时产生的是Cl-和Br-,而在6—10 eV的碰撞能量范围内则会生成H-离子[66].
测量中性解离截面的困难之处在于没有合适的方法直接探测中性解离产物.为了回避这一难点,可以将解离产物再电离,把中性粒子的探测转化为较易的带电粒子探测.基于这种思想,研究人员发展了结合双电子束(dual electron beam)与阈值电离技术(threshold ionization technique)的实验方法[100,101,113].在该类实验中,首先需要利用一束电子与样品分子碰撞使其解离,随后调节第二束电子的能量,使之与解离碎片的电离能相匹配,从而有针对性地电离相应的碎片粒子,电离产物则用四极质谱来探测.可以想象,实验技术的复杂度会给数据分析带来困难.例如,这种方法需要已知相关解离碎片的电离截面数据,才能定量分析电离过程中的离子产率,进而获得绝对的中性解离截面,否则只能给出相对值[100,101].显然,上述方法得到的是区分解离通道的分支截面,各通道的截面加和后即为总的中性解离截面.另一种测量中性解离碎片分支截面的方法利用了解离产物容易被碲吸收的特性[114].实验时在碰撞反应腔室里加入碲作为吸收体,电子碰撞解离产生的中性碎片被吸收后生成易挥发的碲化物,生成的碲化物随后被四极质谱仪电离并探测,根据探测得到的质谱可以分析与碲结合的碎片粒子种类以及相应碲化物的分压,从而推断出碎片粒子的产率和截面,测得的相对分支截面则利用已知的总中性解离截面来绝对化[114].除了分支截面外,总的中性解离截面也是重要的.实验上采用钛作为吸收体测量总中性解离截面[115-117].与碲不同,钛对解离碎片的吸收不会生成易挥发的产物.因此,通过测量分子解离后密闭腔室中的气压变化率可以反推出解离碎片的产率,进而得到总的解离截面.忽略贴附解离的贡献(在较高碰撞能下是合理的),测得的电离阈以上的总解离截面包含电离解离与中性解离的贡献,需要减去总电离解离截面才能得到最终的总中性解离截面[115].当然,如果样品分子的电离都是解离性质的(例如绝大多数氟碳化合物),那么总解离截面减去总电离截面就可得到总的中性解离截面[116,117].应用上述实验方法,人们已经获得了部分刻蚀分子的中性解离截面,但是不同方法获得的截面数据之间仍然缺乏较好的一致性[16].
4.2.3 其他实验方法
目前,识别特定的解离产物进而获得区分通道的中性解离截面,仍然是一个具有挑战性的任务.通过改进实验方案和发展新的实验技术,研究人员已经取得了一些进展.例如,反应显微谱仪(reaction microscope)[118]和速度成像(velocity map imaging,VMI)谱仪[119]能够4π 立体角探测带电粒子,重构碰撞后带电粒子的能动量信息,有望应用于电离截面与电离解离截面的探测.最近,研究人员利用VUV 波段可调谐的自由电子激光将H2S分子激发到不同解离态,随后引入另外的几束单色激光将解离碎片电离,并采用TOF(H+)与VMI(S+)探测相应的带电粒子,阐明了H2S 分子VUV 波段电子激发态的全通道解离产物特性[120],为刻蚀分子中性解离产物的鉴别提供了启发性的解决方案.尽管光吸收截面与电子碰撞截面有很大区别,但是同一激发态的次级过程演化是相同的,与光激发还是电子碰撞激发无关.因此,光吸收实验提供的解离碎片种类与解离分支比等信息对电子碰撞解离截面的实验测量有重要的指导意义.特别地,结合BE-scaling 方法获得的态分辨激发(解离)截面和光吸收方法测得的各激发态的退激分支比,就能得到解离到各个碎片的分支截面.
5 总结与展望
半导体芯片是信息时代的基石,诸如大数据、机器学习、人工智能等新兴技术领域的快速发展离不开源自芯片层面的算力支撑.时至今日,芯片先进制程已经发展到了2 nm 级别.可以预见,在越来越高的算力需求的驱动下,芯片工艺将继续追求更高的集成度与更小的器件体积,作为芯片制造工序的关键环节,刻蚀工艺也因此面临着巨大的挑战.基于低温等离子体处理技术的干法刻蚀工艺是高精细电路图案刻蚀的首选方案.然而,由于干法刻蚀系统的非线性与高复杂度,最优工艺条件需要理论模拟与实验研究共同探索.本文主要介绍了干法刻蚀低温等离子体建模的基本理论,重点强调电子碰撞截面数据在数值模拟中的重要作用,同时概述了获取刻蚀气体截面数据的理论与实验方法.
低温等离子体模型的预测能力高度依赖于描述其基本物理化学过程的原子分子数据.电子碰撞截面作为描述其中最重要的基本过程——电子与原子分子碰撞过程的关键参数,在数据库的建设中有着很高的优先级.获取和评估刻蚀相关原子分子的电子碰撞截面并建立一个准确且完备的刻蚀分子截面数据库,提高建模仿真结果的准确性,对半导体刻蚀工艺的应用和发展至关重要.在过去的几十年内,人们通过各种理论与实验方法获得了许多原子分子的截面数据.然而,由于目前绝大多数的截面数据来自理论计算,缺少实验的检验与标定,可作为基准的截面数据仍很缺乏.此外,随着等离子体刻蚀工艺的发展,解离自由基和亚稳态原子分子等特殊体系以及许多复杂分子的截面数据需求成为了新的挑战.例如C4F6等全球变暖潜能(global warming potential)较低的分子被看作是传统刻蚀气体的替代物,对其截面数据的系统性研究有助于促进这些气体在刻蚀工艺中的应用,满足未来的环保要求[2,40].
为低温等离子体建模领域提供高质量的、全面的电子碰撞截面数据需要理论与实验工作者的共同努力.理论方面,在高性能计算机的协助下,基于第一性原理的量子化学方法与散射模型已经能够给出许多截面数据,一些半经验的方法也被用来获取特定类型的截面.但是,多原子分子激发态的理论计算仍然很困难,且复杂体系计算精度的提高往往需要以高昂的时间成本为代价,有时这种代价甚至是不可接受的.因此,通过优化计算代码,在保证精度的同时缩短时间成本,是理论计算的一个发展方向.实验方面,现有的实验方法仍有很多局限性.例如,BE-scaling 方法仅适用于偶极允许跃迁,无法获得可靠的禁戒跃迁低能积分截面,特别是自旋交换的禁戒跃迁只有在低碰撞能量下才能测量;完整的中性解离截面应考虑分子电离阈以上超激发态的中性解离,这需要进一步鉴别电离通道、电离解离通道和中性解离通道;亚稳态原子分子或自由基制备困难,相关截面的实验研究很少······.更重要的是,识别特定的解离产物进而获得区分通道的中性解离截面,仍然是一个具有挑战性的任务.最后,考虑到刻蚀分子截面数据的研究任务体量巨大,未来需要有更多的理论和实验科研人员投身该领域,为数据库的建立添砖加瓦.需要指出,除了半导体刻蚀外,低温等离子体还广泛应用于生化、环境、材料、能源等工业领域[121],描述其中基本物理化学过程的电子碰撞截面毫无疑问在这些领域也有广阔的应用前景.
特别感谢曾在本课题组读研究生和工作的徐远琛、汪书兴博士以及王东徽、李恒辉硕士的贡献.
朱林繁,中国科学技术大学教授,博士生导师.1999 年毕业于中国科学技术大学近代物理系,获学士和博士学位.长期从事电子能量损失谱学的研究工作,在国际上首次把基于第三代同步辐射的高分辨非弹性X 射线散射技术拓展到原子分子物理领域,近年来在国内率先开展了X 射线波段量子光学研究.在原子分子动力学参数、X 射线波段腔量子光学等方面做出了有特色的工作.主持国家自然科学基金重点项目、面上项目等课题多项,发表SCI 论文150 余篇,编写《原子物理学》教科书一部,入选“安徽省教学名师”.
